总剂量辐照与热载流子协同效应特性分析★
付兴中,何玉娟,郑婕,章晓文
(1.中国电子科技集团公司第五十四研究所,河北 石家庄 050000;2.工业和信息化部电子第五研究所,广东 广州 510610)
0 引言
在空间长时间运行的设备和器件,在受到空间辐射效应影响的同时,也会由于热载流子效应的影响而使得器件的寿命降低。在进行地面模拟试验时,一般采用单机理的试验模拟方式,但空间总剂量辐照效应对器件热载流子效应甚至其使用寿命的影响究竟如何,国内外却研究得较少。
本文针对特征尺寸为0.35 μm的NMOS器件,研究总剂量辐照效应对NMOS器件热载流子测试的影响,结果发现:在经过总剂量辐照后进行热载流子测试,阈值电压随着总剂量的增大而减小,随着热载流子测试时间的增大而增大,并且变化值远远超过未经过总剂量辐照的器件。
1 试验结果
试验所用的NMOS器件为SMIC公司的流片,其特征尺寸为0.35 μm,器件的栅氧化层厚度为6.5 nm,宽长比为50。
总剂量辐照剂量率为50 rad(Si)/s,偏置为ON偏置 (VG=VDD,VD=VS=VB=0 V),总剂量为100 krad(Si),试验是在中科院新疆理化所的钴-60总剂量辐射源处进行的。
热载流子测试采用的试验条件为VD=4.0 V,VG=1.6 V,VS=VB=0 V,测试时间为10 000 s,采用keithley 4200半导体参数测试系统进行NMOS器件的I-V测试。
条栅器件100 krad(Si)总剂量辐照后热载流子试验的ID-VG曲线如图1所示,其阈值电压的变化情况如图2所示,最大跨导Gm的变化情况如图3所示。
从图1中可以看出,NMOS器件在经过100 krad(Si)总剂量辐照后,ID-VG曲线向负向漂移,并且辐照后在VG截止态时存在泄漏电流,总剂量辐照使得器件漏极的泄漏电流从E-11量级上升到E-6量级,提高了5个量级。同时,从图2-3中可以看出,总剂量辐照使得NMOS器件的阈值电压Vth减小,最大跨导Gm减小。
在总剂量辐照后,NMOS器件经过了10 000 s的热载流子试验,试验结果如图1所示。从图1中可以看出,热载流子试验使得NMOS器件的ID-VG曲线向正向漂移,这与总剂量辐照结果相反;另外,热载流子试验也使得NMOS器件的泄漏电流恢复到辐照前,泄漏电流减小到初始状态。

图1 条栅N1器件100 krad(Si)辐照后热载流子试验的ID-VG曲线
从图2-3中可以看出,热载流子试验使得NMOS器件的阈值电压Vth增大,最大跨导Gm减小。
因而可知,对于NMOS器件的阈值电压Vth而言,总剂量辐照与热载流子试验使得Vth先减小,再增大,是互相部分抵消的结果;对于最大跨导Gm而言,总剂量辐照与热载流子试验使得Gm一直减小,是互相叠加的结果。
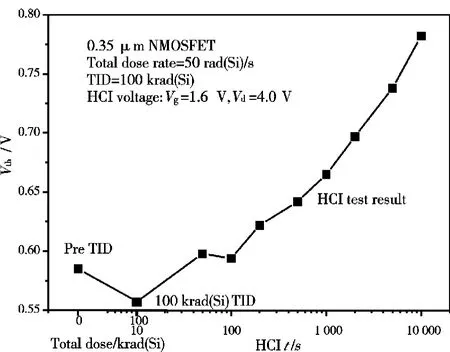
图2 条栅器件100 krad(Si)辐照后热载流子试验前后Vth参数变化曲线图

图3 条栅器件100 krad(Si)辐照后热载流子试验前后Gm参数变化曲线图
2 试验分析
0.35 μm的NMOS器件经过 100 krad (Si) 总剂量辐照后,其热载流子测试前后Vth变化情况与未经过辐照的相同样品在相同的热载流子测试电压下的Vth变化情况的对比如图4所示。从图4中可以看出,未经过辐照的样品,在热载流子测试时,其阈值电压Vth的变化极小,在经过9 000 s热载流子测试后,阈值电压只增加了0.04 V,相比于初始的阈值电压0.55 V,变化比例不超过10%。而经过100 krad(Si)总剂量辐照后,在器件热载流子测试时,阈值电压Vth变化很大,在经过10 000 s热载流子测试后,阈值电压增加了0.18 V,相比于初始阈值电压0.58 V,变化比例超过30%。

图4 经过总剂量辐照后的样品与未辐照样品的热载流子测试Vth变化曲线
未经辐照的样品与经过总剂量辐照的样品在热载流子试验时其Vth相差这么明显,究其原因可能与总剂量退火效应,以及总剂量和热载流子协同效应有关。
首先,100 krad(Si)总剂量辐照后,NMOS器件进行热载流子试验,由于总剂量辐照后未进行退火试验,并且热载流子试验时NMOS器件栅极和漏极施加电信号,因此,在热载流子试验时,器件是同时进行总剂量退火试验和热载流子测试的。
常温下的总剂量退火效应曲线如图5所示,常温加偏置总剂量的退火效应会使得NMOS器件的氧化层陷阱电荷内的正电荷与电子复合,从而使得辐射感生的氧化层陷阱电荷减少;但在常温下,总剂量的退火效应却无法使NMOS器件的界面态电荷发生退火效应,反而由于部分慢界面态在总剂量辐照后仍在慢慢地建立,因此,常温加偏置退火会使得NMOS器件的界面态仍存在少量的增长,在50 rad(Si)/s的高剂量率下的100 krad(Si)总剂量辐照下,在NMOS器件的界面处的界面态增加较少,退火后界面态仍在缓慢地增加,但增加得极少。
然而,总剂量的退火效应只是使得NMOS器件的氧化层陷阱电荷的复合部分增加,并且界面态增加得较少,因此,NMOS器件总剂量退火后的阈值电压正向增加的数值要小于其总剂量辐照导致的阈值电压负向漂移的数值;也就是说,NMOS器件总剂量退火后,其阈值电压无法恢复到未辐照前的情况。
而我们从图2中可以看出,NMOS器件阈值电压从未辐照时的0.586 V变化到了辐照后的0.524 V,阈值电压漂移了-0.06 V,但10 000 s热载流子试验后,阈值电压变化到0.791 V,阈值电压相比于热载流子试验前增大了0.26 V,相比于辐照前,阈值电压则增大了0.2 V。可见,NMOS器件在总剂量辐照后进行热载流子效应,其阈值电压变化相比于只进行热载流子试验,以及只进行总剂量和总剂量辐照效应,其变化值要大得多。由此可见,总剂量辐照和热载流子的协同效应使得参数变化比单一效应时更加明显,可以说是1+1>2。
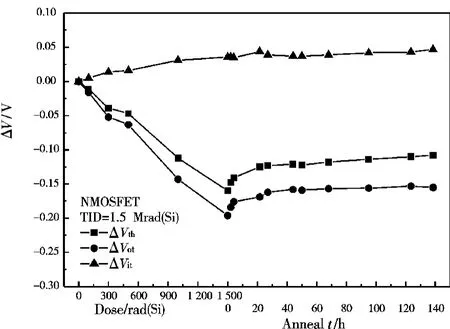
图5 NMOS器件在常温ON偏置下辐照与退火前后的Vth变化情况
总剂量辐照和热载流子协同效应,使得器件的参数变化更加明显,其原因可能是总剂量辐照使得NMOS器件的氧化层靠近Si界面处的Si-Si键断裂,形成悬挂键,在总剂量辐照时俘获空穴,形成带正电的氧化层陷阱电荷,但在热载流子测试中,由于热电子注入氧化层中,悬挂键中的空穴被电子复合,并且,由于热电子的数量较多,其复合的速度要远远大于退火时氧化层陷阱电荷复合的速度,这也使得器件的阈值电压正向漂移[1-2];另外,由于总剂量辐照效应,Si-SiO2界面处形成Si-悬挂键,俘获电子,形成辐射感生界面态电荷,由于辐照后热载流子测试时,热电子注入界面处,悬挂键俘获的电子更多,使得界面态电荷持续地增加,因此使器件的阈值电压向正向漂移[3-6]。总剂量和热载流子试验前后由氧化层陷阱电荷和界面态电荷引起的阈值电压变化情况如图6所示。从图6中可以看出,热载流子试验时,NMOS器件的氧化层陷阱电荷缓慢地增加,这是由于氧化层陷阱中的空穴电荷被热电子复合而导致的,但界面态增加得很快,总剂量辐照导致界面态的增加而引起阈值电压变化值为0.03 V,而10 000 s热载流子试验却使得界面态导致的阈值电压变化值达到0.2 V,阈值电压正向漂移值基本上都是由于界面态的增加而导致的。

图6 NMOS器件辐照与热载流子氧化层陷阱电荷与界面态电荷的变化情况
3 结束语
本文研究了100krad(Si)总剂量辐照对0.35 μm NMOS器件热载流子效应的影响情况,结果发现:在经过总剂量辐照后进行热载流子测试,阈值电压随着总剂量的增大而减小,随着热载流子测试时间的增大而增大,并且其变化值远远地超过未经过总剂量辐照的器件。分析发现:总剂量辐照对热载流子效应的影响主要是辐射感生界面陷阱俘获热电子形成负的界面态电荷,导致阈值电压持续向正向漂移,并且其数值远高于总剂量辐照引起的。
[1]FLEETWOOD D M,XIONG H D,LU Z Y,et al.Unified modle of hole trapping, 1/f Noise, and thermally stimulaterd current in MOS device[J].IEEE Transactions on Nuclear Science, 2002, 49 (6): 2674-2683.
[2]OLDHAM T R,MCLEAN F B.Total ionizing dose effects in MOS oxides and devices[J].IEEE Transactions on Nuclear Science, 2003, 50 (3): 483-499.
[3]SCHWANK J R, SHANEYFELT M R, FLEETWOOD M,et al.Radiation effects in MOS oxides[J].IEEE Transactions on Nuclear Science, 2008, 55 (4): 1833-1853.
[4]CHENMING HU, SIMON C, FU-CHIEN Hsu et al.Hot electron-induced MOSFET degradation model, monitor,and improvement[J].IEEE Transactions on Electron Devices, 1985, 32 (2): 375-386.
[5]吴清才.航天电子产品热环境试验策略研究 [J].装备环境工程, 2015, 12 (3): 80-86.
[6]沈自才,弁永强,吴宜勇.电子辐照Kapton/AC薄膜力学性能退化规律与机理研究 [J].装备环境工程,2015, 12 (3): 42-44; 69.
《电子产品环境与可靠性试验》杂志2012-2013、2017年增刊出版和征订信息
随着工业和信息化科技与产品的迅速发展,质量与可靠性的科学技术渗透到工业和信息化的各个领域,可靠性与环境适应性问题也越来越受到广泛的关注。为了扩大可靠性与环境适应性技术的应用范畴,探讨技术发展趋势,推动科技工作的不断创新和持续发展以及成果交流,起到总结、提高、借鉴和促进的作用;并解决文稿积压过多、文章发表周期过长的问题,由工业和信息化部主管、工业和信息化部电子第五研究所主办的国内外公开发行、可靠性与环境适应性领域中具有权威性、影响力的专业科技期刊——《电子产品可靠性与环境试验》杂志在2012年5月、2013年11月、2017年7月以增刊的形式,出版论文集。增刊所收录的论文,专业性强、技术先进、内容和信息丰富、设计精美,欢迎订阅。
《电子产品可靠性与环境试验》编辑部

