InP 衬底上的双载流子倍增雪崩光电二极管结构设计*
赵华良 彭红玲 周旭彦 张建心 牛博文 尚肖 王天财 曹澎
1) (曲阜师范大学物理工程学院,曲阜 273165)
2) (潍坊先进光电芯片研究院,潍坊 261071)
3) (中国科学院半导体研究所,北京 100083)
4) (山东理工大学物理与光电工程学院,淄博 255049)
5) (潍坊学院物理与电子信息学院,潍坊 261061)
1 引言
雪崩光电二极管(APD)目前已经广泛应用于商业、军事和科研领域,推动了光通信、成像[1−3]和单光子探测[4−6]等技术的发展.APD 结构主要经历了分离吸收和倍增(separate absorption and multiplication,SAM)结构[7−9]、分离吸收、渐变和倍增(separate absorption,grading and multiplication,SAGM)结构[10,11]、分离吸收、渐变、电荷和倍 增(separate absorption,grading,charge and multiplication,SAGCM)结构[12−14]等几个阶段的演变,其中SAGCM 结构因其性能优越而成为当前使用最广泛的APD 结构.如果在一种倍增层材料中,电子和空穴碰撞电离系数接近,则会产生较大的过剩噪声[15,16],因此为降低APD 的噪声,在一种倍增层材料中,一般采用单种载流子倍增[17,18],例如空穴注入型[19]结构通常采用InP 等作为倍增层材料,而电子注入型[20,21]结构通常采用In0.52Al0.48As 等作为倍增层材料.正因如此,对于当前各种结构的APD,在吸收层内产生的光生载流子只有其中一种进入倍增层发生雪崩倍增,另外一种载流子则没有参与倍增.
APD 内部能够发生雪崩倍增效应,可以提供更高的灵敏度[22−24],更适合于对微弱光信号的探测.增益是表征APD 对光电流放大作用的性能参数,在电场强度一定的条件下,增益的大小由材料的碰撞电离系数以及倍增层的厚度所决定[16,25,26],其中增大倍增层厚度虽然可以提高增益,但也会导致响应速度的下降以及过大的击穿电压.因此,目前提高APD 增益的主要方式是优化制备工艺,以及选择具有更佳碰撞电离系数的倍增材料[18,27,28],而很少有通过改进结构来提高APD 增益的报道.2013 年,Huang 等[29]有效地利用了倍增层中的死区空间[30],通过在此区域中交替生长不同载流子倍增纳米结构,实现了在SAM 结构基础上的双载流子倍增,通过模拟对比,显示出更薄的倍增纳米结构可以获得更高的增益,且不会引起过剩噪声的明显增加.因此,如何在采用工艺成熟的材料前提下,通过设计新的APD 结构以获得大的倍增增益,是值得去解决的问题.
本文在传统SAGCM-APD 的基础上进行改进,设计了两种不同载流子都参与倍增的结构,将两个倍增层分别置于吸收层上下两侧,并通过电荷层来控制吸收层和两个倍增层内部的电场强度,使得器件在一定的电场条件下,光生电子和空穴分别进入各自的倍增层后同时发生倍增,因此器件具有更大的增益值.另外,以工艺较为成熟的InGaAs/InP/InAlAs 材料体系为例来介绍双倍增层结构,根据入射波长等不同应用需求,可以在此结构上使用其他材料体系.
2 APD 器件设计
器件结构中以Si 和Be 分别作为n 型和p 型掺杂.器件外延结构见图1.在p+InP(100)衬底上外延生长0.2 μm p+InP 缓冲层(8×1018cm−3),用来防止衬底杂质向外延层的扩散;再依次外延生长0.3 μm p+InP 欧姆接触层(8×1018cm−3)、0.4 μm n− InP 空穴倍增层(2×1015cm−3)、0.06 μm n+InP 电荷层(3.4×1017cm−3)、0.05 μm n−InGaAsP渐变层(1×1015cm−3)、0.8 μm 非故意掺杂的In0.53Ga0.47As (下文称为InGaAs)吸收层、0.05 μm p−InGaAsP 渐变层(1×1015cm−3)、0.08 μm p+In0.52Al0.48As (下文为InAlAs)电荷层(3.6×1017cm−3)、0.4 μm p−InAlAs 电子倍增层(2×1015cm−3)、0.08 μm n+InAlAs 电荷层(2.4×1017cm−3),此处n+电荷层设计目的为增大电子倍增层的电场强度,这是因为InAlAs 材料具有比InP 材料更高的碰撞电离阈值[19−21].接着外延生长0.2 μm n+InAlAs帽层(8×1018cm−3)、0.05 μm n+InGaAs 欧姆接触层(8×1018cm−3),至此,完成主体结构的外延设计.

图1 双载流子倍增APD 结构示意图Fig.1.Schematic diagram of double carrier multiplication APD structure.
光信号波长为1.55 μm,采用从背面入射,结构的阴极和阳极分别与外电路的正极和负极连接,在反向偏压下耗尽过程首先从两个倍增层开始,随着偏压的增大,耗尽区逐渐向吸收层扩展,直至完成低掺杂区域的耗尽.依靠多个电荷层控制吸收层和两个倍增层的电场强度大小,使得光生电子和空穴可以顺利从吸收层进入两个倍增层发生雪崩倍增.图2 为拉通后器件的能带示意图,光入射后,在吸收层产生光生电子和空穴(实心圆表示电子,空心圆表示空穴),如图中的红色实线箭头所示,在电场的作用下,电子漂移至InAlAs 倍增层,空穴漂移至InP 倍增层,两种载流子分别在两个倍增层发生雪崩倍增效应,均产生大量的电子和空穴.红色虚线箭头表示在InP 倍增层碰撞电离产生的电子,又在电场的作用下,经过吸收层后漂移至InAlAs倍增层,电子在这里发生了二次倍增;同样,在InAlAs 倍增层碰撞电离产生的空穴经过吸收层后,漂移至InP 倍增层,空穴在此处发生了二次倍增,相比于初次从吸收层产生进入倍增层的光生载流子,进行二次倍增的载流子经过吸收层时会有相近或更大的漂移速度,因此参与二次倍增的载流子中更多的会进入倍增层发生倍增效应,而不是在吸收层漂移过程中发生复合湮灭.虽然新结构利用了两种载流子参与倍增过程,但是对于其中任何一个倍增层而言,仍然为单载流子倍增形式,所以过剩噪声不会急剧增加.

图2 双载流子倍增APD 能带示意图Fig.2.Band diagram of the double carrier multiplication APD.
3 仿真模拟
使用Silvaco TCAD 的Athena 和Atlas 分别对结构进行工艺和器件仿真,其中器件仿真中用到的物理模型有: 浓度依赖迁移率模型(conmob)、载流子统计模型(Fermi-Dirac)、复合模型(srh,auger,optr)、能带变窄模型(bgn),碰撞模型采用了Selb,Selberherr 和Zappa 模型.表1 列出了InAlAs 和InP 的碰撞电离系数的参数,其中an,ap,bn和bp为碰撞模型中计算碰撞电离系数时的参数值.

表1 InAlAs 和InP 碰撞电离系数的仿真参数Table 1.Simulation parameters for the ionization coefficients of InAlAs and InP.
碰撞电离系数的计算公式为
这里,
(1)式、(2)式分别为Selberherr 模型和Zappa模型中计算碰撞电离系数的数学表达式,其中α,β分别为电子碰撞电离系数和空穴碰撞电离系数;En和Ep分别为电子和空穴能量;λn,λp分别为电子和空穴的平均自由程;E为电场强度;k为玻尔兹曼常数;T为开尔文温度值.
下文将双载流子倍增APD 结构定义为结构Ⅰ.如图3 所示,在零偏压条件下,耗尽过程首先从两个倍增层开始,内建电场使能带在这两个区域发生了弯曲,并且弯曲方向一致;另外,靠近吸收层两侧的p+电荷层和n+电荷层也构成一个PN 结,使得吸收层也发生一定程度的耗尽,所以吸收层能带也发生一定的弯曲,只不过此处与两个倍增层的内建电场方向相反,能带弯曲方向也就不同.

图3 结构Ⅰ零偏压能带分布Fig.3.Energy band distribution under zero bias of structure I.
图4 和图5 分别为结构Ⅰ在击穿电压下的电场分布和碰撞电离系数分布.由图4 可以看出,通过电荷层的调节,使得两个倍增层的电场均高于吸收层的电场,且吸收区电场低于其隧穿电场,这样的电场分布有以下优势: 光生载流子可通过吸收区内的电场越过势垒进入倍增层,而不在此处发生倍增效应;同时,这种较低的电场也减少了在吸收层产生的隧穿暗电流;倍增层的高电场使进入此区域的载流子与晶格发生碰撞电离,从而引起雪崩倍增效应,产生大的光电流输出.因为InAlAs 材料比InP 材料的碰撞电离阈值高,所以需要让InAlAs倍增层的电场高于InP 倍增层的电场.需要注意的是,倍增层的电场并非越大越好,过大的电场会使倍增层能带更加弯曲,从而会产生过大的隧穿暗电流.

图4 结构Ⅰ在击穿电压下的电场分布Fig.4.Distribution of electric field at breakdown voltage for structure Ⅰ.

图5 结构Ⅰ在击穿电压下的电离系数分布Fig.5.Distribution of ionization coefficient at breakdown voltage for structure Ⅰ.
图6 为模拟得到的结构Ⅰ的I-V特性曲线和增益曲线,图7 为结构Ⅰ在不同电压下对应的电场分布,在反向偏压为15 V 时,首先完成了InP 倍增层至吸收层下边缘的耗尽过程,此时暗电流的急剧增加由产生-复合暗电流的突变引起[31],由于吸收层内无电场,光生载流子无法越过势垒进入倍增层发生倍增效应,因此无光电流产生;当反向偏压为36 V 时,完成了InAlAs 倍增层至吸收层上边缘的耗尽过程,此时吸收层电场和光电流仍为零;随着反向偏压的继续增大,吸收层内部开始耗尽而产生电场,光电流也因此开始产生,直至反向偏压为38 V 时,完成了整个器件的拉通,对应穿通电压Vp=38 V;器件的击穿电压Vb=69 V,在95%Vb反向偏压下,直径100 μm 的器件暗电流为1.5 nA,光电流为35 nA,对应的增益M为35 左右.

图6 结构Ⅰ的I-V 特性与增益曲线Fig.6.Currrent-voltage characteristics and gain of the structure Ⅰ.
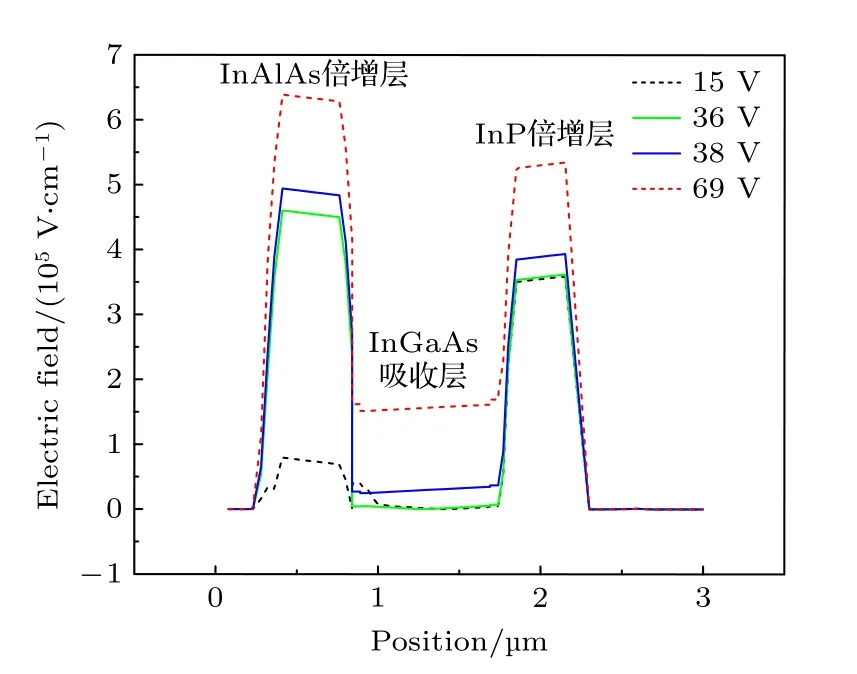
图7 不同反向偏压下结构Ⅰ的电场分布Fig.7.Electric field distribution of structure Ⅰ under the different reverse bias voltage.
将传统单载流子倍增APD 仿真结果与本文新结构进行对比,为方便表述,下文将传统单InP 倍增层结构和单InAlAs 倍增层结构分别定义为结构Ⅱ和结构Ⅲ.需要注意的是,在仿真单载流子倍增APD 结构时,采用的仿真模型、材料参数、器件尺寸等与结构Ⅰ保持一致,以保证对比结果的可靠性.另外也要使结构Ⅱ和Ⅲ的性能参数达到文献[32]报道的正常水平,其中倍增层厚度为0.4 μm 和提供足够碰撞电离所需要的电场强度的条件下,理论计算的单InP 倍增层结构的平均增益范围为4—18,实验测试的增益为10 左右[33,34].相同的条件下,理论计算的单InAlAs 倍增层结构的平均增益范围为3—20[32],实验测试的增益为15 左右[33].图8 为模拟得到的结构Ⅱ和结构Ⅲ的I-V特性以及增益曲线,表2 为3 种结构的特性对比结果: 由于结构Ⅰ耗尽区宽度的增大,要想获得与结构Ⅱ和结构Ⅲ耗尽区相同的电场,结构Ⅰ需要更大的反向偏压,所以结构Ⅰ的穿通电压和击穿电压都会比结构Ⅱ和结构Ⅲ大.图9 为简化后的结构Ⅰ电场分布图,其中忽略了厚度较薄的电荷层和渐变层,以及无电场分布的帽层和接触层,(3)式为与图9 对应的结构Ⅰ电压Vapd表达式:

表2 三种结构特性对比Table 2.Comparison of the characteristics of three structures.

图8 I-V 特性与增益曲线 (a)结构Ⅱ;(b)结构ⅢFig.8.Curve of I-V characteristics and gain: (a) StructureⅡ;(b) structure Ⅲ.

图9 简化的结构Ⅰ电场分布Fig.9.Electric field distribution of the simplified structure Ⅰ.
式中,Vm1,Va,Vm2分别为InP 倍增层、吸收层、InAlAs 倍增层的电压降,Exm1,Exa,Exm2为这3 个区域的电场强度.可以看出,对比结构Ⅱ和结构Ⅲ,在保证各对应功能层厚度和电场分布相同的条件下,落在耗尽区各部分的电压降基本没有变化.也就是说,表2 中结构Ⅰ相对于结构Ⅱ或结构Ⅲ高出的击穿电压值,主要是所增加的一个倍增层的电压降.关于暗电流,结构Ⅰ相对于结构Ⅱ和结构Ⅲ而言,增加一个倍增层后并没有引起暗电流的显著增大,这是因为在倍增层内产生的暗电流主要成分为高电场下的隧穿暗电流,而本文在仿真过程中,对两个倍增层的电场进行一定的控制,避免过高电场而导致的带间隧穿暗电流的增大.因此,增加一个倍增层后的结构,可以保持与单倍增层结构相近的暗电流水平.
增益方面,由于结构Ⅰ中空穴倍增层与结构Ⅱ中倍增层的材料和厚度相同,并且调节后两层的电场大小接近,所以可以推测,在结构Ⅰ的空穴倍增层中产生的增益应该接近结构Ⅱ产生的增益;同理,在结构Ⅰ的电子倍增层中产生的增益应该接近结构Ⅲ产生的增益.另外,在结构Ⅰ中的空穴倍增层碰撞形成的电子进入到电子倍增层后也会参与电子主导的雪崩倍增而增加光电流输出.同理,在电子倍增层碰撞形成的空穴进入空穴倍增层后也会参与空穴主导的雪崩倍增,进而也会增加结构Ⅰ增益.总之,由于结构Ⅰ实现了两种载流子分别在两个倍增层内同时倍增,因此会产生比结构Ⅱ和结构Ⅲ更大的光电流增益.从理论上来说,结构Ⅰ的增益值应该接近结构Ⅱ和结构Ⅲ的增益值之和,仿真结果基本符合此理论预测.
4 结论
在传统SAGCM 单载流子倍增结构的基础上,设计了双载流子倍增的APD 新结构,其中电子倍增层选用的材料为InAlAs,空穴倍增层选用的材料为InP,可以实现电子和空穴在两个倍增层分别进行倍增,在不增加暗电流的基础上,显著提高了光电流增益.使用Silvaco TCAD 软件对3 种结构分别进行了仿真,在95%击穿电压和器件直径为100 μm 条件下,三者的暗电流水平几乎相同,结构Ⅰ的暗电流为1.5 nA,结构Ⅱ的暗电流为2 nA,结构Ⅲ的暗电流为1.5 nA.增益方面,结构Ⅰ相对于后两种结构有明显优势,结构Ⅰ增益值为35,结构Ⅱ和结构Ⅲ增益值分别为15 和18,显示出双载流子倍增APD 在探测极微弱信号领域具有较大应用潜力.
本文使用的结构是InP 衬底上的InP/InGaAs/InAlAs 材料体系,基于此结构设计框架,可以对衬底、电子倍增层、空穴倍增层等外延层进行材料替换,同样能够实现对应材料体系下的双载流子倍增.
感谢中国科学院半导体研究所和潍坊先进光电芯片研究院给予的技术和资金支持,感谢曲阜师范大学的培养和支持.

