一种低插损高频导热覆铜板的研制
颜善银 介星迪 朱泳名 杨中强
(广东生益科技股份有限公司,国家电子电路基材工程技术研究中心,广东 东莞 523808)
0 前言
随着印制电路板(PCB)向着高密度、多层化方向的不断发展,元器件在PCB上搭载、安装的空间大幅减小,整机电子产品对功率元器件的功率要求越来越高,小空间、大功率不可避免地产生更多的热量聚集。另一方面,随着现代通讯技术的快速发展,电子设备的工作频率越来越高,发热量越来越大,这两大因素驱使着PCB的工作温度急剧上升。
如果积聚的热量不能及时排出,将使设备的工作温度升高,长此以往会造成元器件电气性能下降甚至损毁,严重损害设备的寿命和可靠性。大量试验和统计数据表明,电子元器件(最佳工作温度后)温升2 ℃其可靠性便下降10%,温升50 ℃的使用寿命只有温升25 ℃的1/6,因此PCB工作温度已成为影响可靠性和使用寿命的最重要的因素[1][2]。
本文重点介绍国家电子电路基材工程技术研究中心,新开发的一款应用于高频导热领域的覆铜板S7135D,介绍板材的开发思路、介电性能、导热系数、谐振环Dk、插损及常规基本性能等。
1 开发思路
提高线路集成度及PCB功率密度的需求与日俱增,高频PCB热管理的重要性更加突出。如表1所示,将厚度、导热系数(TC)不同的几种材料进行比较,其它如输入测试功率、频率等重要参数相同,不同材料对温升的影响显而易见。三种材料的介电常数(Dk)和损耗因子(Df)的值相近,频率(3 GHz)、功率(30 W)相同,但是三种材料超过环境温度的温升各不相同,具体取决于材料厚度及导热系数。最厚、导热系数最小的材料超过环境温度的温升最大[3]。树脂,大量填充氧化铝、硅微粉等无机填料,同时使用普通的E玻纤布作为增强材料。由于氧化铝的Dk比较高,大量填充氧化铝填料,虽然可以提高导热系数,但是同时也会增加板材的Dk,为此,我们必须减少复合基材中玻纤布的比例,因为E玻纤布的Dk比较高,减少玻纤布的比例就能降低板材的Dk,而且玻纤布的导热系数低,减少玻纤布比例有利于提高导热系数。同时,为了降低导体损耗,S7135D采用了表面粗糙度小于3.0 μm的低轮廓铜箔。
2 实验部分
2.1 样品制备
使用的S7135D样品来自于生产线生产的大板,常规的厚度为0.525 mm(20.7 mil)和0.780 mm

表1 厚度、导热系数不同的微带传输线的预计温升
高频PCB有效得当的热管理还包括线路损耗、输入功率、热效应之间的关系。高频PCB的热量本质上与线路的损耗密切相关,例如,在微带线路上,有导体损耗、介质损耗及辐射损耗几种损耗类型。导体损耗与PCB的设计及基材的选择有关,铜箔的选择会影响损耗性能,例如,表面粗糙的铜箔比表面光滑的铜箔损耗大。另一种影响损耗是材料的损耗因子,损耗因子越低,介质损耗越小,PCB产生的热量也会越少。
简而言之,改进热管理理想材料的性能参数包括导热系数、损耗因子、铜箔表面粗糙度,基材厚度以及介电常数。一般而言,选择具有良好性能的材料,如高导热系数,较低的损耗因子,光滑的铜箔表面以及低介电常数,不仅有助于设计出高性能高频PCB,还能够改善热管理。
国家电子电路基材工程技术研究中心新开发的应用于高频导热领域的覆铜板S7135D,正是基于上述思路,采用低极性的热固性树脂作为主体(30.7 mil),铜箔厚度为35 μm(1 oz),尺寸为914×1219 mm(36×48 in),测试前将样品全部裁剪为标准的457×610 mm(18×24 in),一部分样品用来测试板材的基本性能,一部分样品外发到PCB厂制作线路,来测试插损等性能。
2.2 测试方法
Dk/Df按IPC-TM-650中2.5.5.13的测试方法进行测试;带状线按IPC-TM-650中2.5.5.5.1的测试方法进行测试;剥离强度按IPC-TM-650中2.4.8的测试方法进行测试;导热系数采用导热系数测试仪,按照ASTMD5470方法进行测试;燃烧性测试按IPCTM-650中2.3.13的测试方法进行测试;Z轴CTE按IPCTM-650中2.4.24的测试方法进行测试;X、Y轴CTE按IPC-TM-650中2.4.24.5的测试方法进行测试;TGA按IPC-TM-650中2.4.24.6的测试方法进行测试;DSC按IPC-TM-650中2.4.25的测试方法进行测试;板材插损按照IPCTM-650中2.5.5.12A所规定的方法进行测定。
3 结果与讨论
3.1 介电性能测试
温度会影响PCB层压板的相对介电常数,由介电常数的热系数这一参数所定义。该参数描述了介电常数的变化(单位通常是×10-6/℃)。由于高频传输线的阻抗不仅取决于基板材料的厚度等参数,而且还取决于其介电常数,因此作为温度函数的介电常数的变化,会显著影响在这种材料上制作的微带和带状传输线的阻抗。当然,微波电路依赖于元器件和电路结点之间紧密匹配的阻抗,来最大限度地减小可能导致信号损失和相位失真的反射。由大功率信号的温度效应引起的传输线阻抗的变化,可能改变高频放大器的频率响应,因此,应通过仔细选择PCB层压板来尽可能减小这些效应[4]。
图1是S7135D在不同温度下(-55 ℃~85 ℃)的Dk/Df(10 GHz,SPDR),介电常数的热系数(TcDk)是95×10-6/℃,损耗因子的热系数(TcDf)是2001×10-6/℃。我们也测试了某款碳氢产品B在不同温度下(-55 ℃~85 ℃)的Dk/Df(10 GHz,SPDR),测试的TcDk是90×10-6/℃,跟S7135D在同一水平。TcDf通常比较大,是因为Df本身比较小,Df的轻微变化都会导致TcDf比较大。此外,采用不同的测试方法,测试结果也会有差异。
3.2 导热系数测试
作为高频导热覆铜板产品,除了介电性能和剥离强度,导热系数也是最重要的性能指标之一。表2是S7135D的导热系数测试结果,从表中可以看出,S7135D的导热系数达到导热PTFE(聚四氟乙烯)产品A的同一水平,带铜箔测试介质导热系数为0.82 W/m.K,不带铜箔测试介质导热系数为0.74 W/m.K。其Dk与碳氢产品B接近,Df甚至要略优于导热PTFE产品A的Df(10 GHz/SPDR)。

图1 S7135D在不同温度下的Dk、Df(10 GHz,SPDR)
3.3 热膨胀系数测试
PCB在高温下会像大多数材料一样,随温度变化而热胀冷缩,当温度上升时,PCB会在三个轴向上(长度、宽度和厚度)膨胀。这种随温度变化导致的膨胀程度,可以用PCB材料的热膨胀系数(CTE)来表征。因为PCB通常由覆铜(用于形成传输线和地平面)电介质形成,所以该材料在X和Y方向上的线性CTE,通常设计得与铜的CTE(约17×10-6/℃)相匹配。通过这种方法,这些材料就会随温度的变化而一起膨胀和收缩,从而最大程度地减小了两种材料连接处的应力。电介质材料Z轴(厚度)的CTE,通常设计为较低的值,以便最大程度地减小随温度而发生的尺寸变化,并保持电镀通孔(PTH)的完整性。PTH为接地和多层电路板互连,提供所需的从电路板顶层到底层的路径。图2、图3分别是S7135D的X轴、Y轴、Z轴CTE,CTE分别为12×10-6/℃、10×10-6/℃、18 ×10-6/℃,CTE都比较低,是因为配方体系中填充了大量的填料,可以极大的降低板材的CTE值。

表2 S7135D的导热系数(W/m.K)测试结果

图2 S7135D的X轴、Y轴CTE

图3 S7135D的Z轴CTE
3.4 DSC测试
玻璃化转变温度(Tg)是高聚物从玻璃态转变为高弹态的温度。在聚合物使用上,Tg一般为塑料使用温度的上限,橡胶使用温度的下限。在玻璃化温度下,高聚物处于玻璃态,分子链和链段都不能运动,只是构成分子的原子(或基团)在其平衡位置作振动,而在玻璃化温度时,分子链虽不能移动,但是链段开始运动,表现出高弹性质。温度再升高,就使整个分子链运动而表现出粘流性质。在玻璃化温度时,高聚物的比热容、热膨胀系数、粘度、折光率、自由体积以及弹性模量等都要发生一个突变。DSC测定Tg就是基于高聚物在玻璃化温度转变时,热容增加这一性质。在DSC曲线上,其表现为在通过玻璃化转变温度时,基线向吸热方向移动。
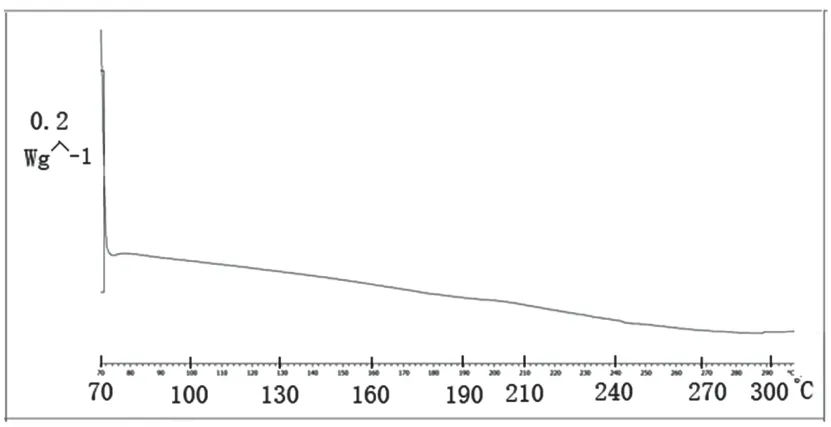
图4 S7135D的DSC图
图4是S7135D的DSC图,从图上看到扫描到300 ℃,并没有出现玻璃化转变温度。从高分子理论的角度分析如下:
(1)当分子间存在化学交联时,链段活动能力下降,Tg升高。交联点密度愈高,Tg增加愈甚。例如苯乙烯与二乙烯基苯共聚物的Tg随后者的用量增加而增加;
(2)对于高度交联的聚合物,交联点之间分子链比链段还小,则没有明显玻璃化转变。S7135D使用的树脂就属于高度交联的聚合物,所以在300 ℃以下没有出现玻璃化转变温度。如果进一步升高温度至400 ℃,则有可能会引起高度交联聚合物的降解。

表3 S7135D的插损测试 (插损单位为:dB/5in)

表4 S7135D的其它基本性能
3.5 插损测试
材料的热量管理主要包括两个方面:一方面是使产生的热量能够尽快的散出去,这主要是跟材料的导热系数有关,材料的导热系数越大,越容易将热量散出去;另一方面尽量减少热量的产生,线路中热量的产生主要与线路的损耗密切相关。材料的介质损耗和导体损耗是与材料产生的热量有一定关系的重要参数。损耗因子(Df)值越小意味着损耗越小,也意味着功率源产生的热量越小。线路中导体的损耗越低,也会使得在线路中产生的热量越小。而插损测试正是材料的介质损耗和导体损耗的一个综合表征结果。表3是S7135D的插损测试结果,同时也测试了导热PTFE产品A和某款碳氢产品B的插损结果,通过24组样品测试的插损平均值来看,S7135D的插损结果最优,主要是因为S7135D产品使用了非常低轮廓的铜箔(Rz约3.0 μm),同时板材的Df(10 GHz,SPDR)低至0.0024,所以综合性能表现更优。
3.6 其它性能
S7135D的其他基本性能,都能满足覆铜板使用要求(见表4)。
4 结论
国家电子电路基材工程技术研究中心新开发的应用于高频导热领域的覆铜板S7135D,具有良好的综合性能,板材的Dk(带状线)为3.50左右,板材的Df(10 GHz,SPDR)低至0.0024。使用低轮廓铜箔在接收态和热应力后的PS(剥离强度)均可以达到1.1 N/mm的水平,不带铜箔测试介质导热系数为0.74 W/m.K,达到导热PTFE产品A的同一水平。尤其是板材的插损测试结果表现更优。

