金辅助催化方法制备GaAs和GaAs/InGaAs纳米线结构的形貌表征及生长机理研究∗
苑汇帛 李林 曾丽娜 张晶 李再金 曲轶 杨小天迟耀丹 马晓辉 刘国军
1)(长春理工大学,高功率半导体激光国家重点实验室,长春 130022)
2)(海南师范大学物理与电子工程学院,海口 571158)
3)(吉林建筑大学,吉林省建筑电气综合节能重点实验室,长春 130118)
1 引 言
以GaAs基材料为代表的半导体纳米线结构在新一代光电子器件的研究及制备领域具有广泛的应用前景[1−6],近年来一直是国内外的研究热点.在GaAs基材料中,InGaAs材料因其窄带宽、复合中心少及载流子迁移率高等特性而被以异质结的形式应用到纳米线结构中.然而,由于生长机理复杂、失配和应变等原因,会导致纳米线结构呈现“锥状”和“扭折”等现象[7−10],不利于控制样品形貌.为了获得高质量的纳米线结构,当前多采用遵循气-液-固(vapor-liquid-soild,VLS)机理的金(Au)辅助催化法制备纳米线.该方法使用Au作为催化剂导引纳米线生长,具有流程短、成本低和操作简单等优点.例如Gustiono等[7]运用金辅助催化法制备了InGaAs纳米线,纳米线与衬底垂直,且长度和直径随着生长温度的升高而增加.为了改善纳米线异质结构的形貌特征,北京邮电大学叶显等[10]利用InGaAs材料晶格常数可调的特性,将InGaAs材料作为GaAs与InAs纳米线的缓冲层,提高了纳米线的生长质量.Othaman等[11]对InGaAs纳米线结构的组分进行了研究,发现纳米线的“锥状”程度会随着材料中In组分的上升而增加.由国内外研究结果可见,对于纳米线的相关研究多集中在制备工艺、形貌及组分表征上,对于生长过程中造成纳米线形貌不规则的机理尚且缺乏研究.
本文利用金属有机化学气相沉积(metalorganic chemical vapor deposition,MOCVD)技术,遵循VLS机理制备了GaAs纳米线和GaAs/InGaAs纳米线异质结构,生长过程中采用Au作为辅助催化剂.通过调整生长温度,获得了具有不同形貌特征的GaAs纳米线,并对形貌形成的机理进行分析.在GaAs纳米线的基础上制备了GaAs/InGaAs纳米线异质结构,扫描电子显微镜(scanning electron microscope,SEM)结果显示纳米线呈“柱状”结构,未出现由于晶格失配导致的“倾倒”、“扭折”等现象,InGaAs与GaAs之间的界面清晰可见.
2 实 验
在外延生长过程中,MOCVD的反应室压力设置为100 mbar(1 bar=105Pa),三甲基镓(TMGa)和三甲基铟(TMIn)作为反应的III族源,砷烷(AsH3)作为V族源.纳米线制备的退火和生长过程都在MOCVD的反应室中进行.实验过程中使用GaAs(111)B衬底进行纳米线生长,选用氢气(H2)作为载气.在外延生长开始之前,首先利用磁控溅射技术在衬底上镀一层Au薄膜.随后将镀有Au膜的GaAs衬底置于MOCVD反应室中,在650◦C高温下加热退火,并通入AsH3作为保护气体.经过退火,Au薄膜在高温下已经熔融并和衬底当中的Ga原子发生作用形成Au-Ga合金颗粒,催化剂Au和衬底上的Ga原子发生反应形成二元合金.反应方程式[12]如下:

该过程中Ga原子完全来自衬底,As则从合金颗粒表面扩散出来被蒸发掉,所得Au-Ga的二元化合物成为纳米线生长的液滴催化剂.在合金颗粒已经形成的前提下,将反应室温度降低至纳米线的生长温度,并通入TMGa进行反应制备GaAs纳米线.如图1所示,步骤一是利用磁控溅射在GaAs(111)B衬底上镀Au膜;步骤二需要将镀有Au薄膜的衬底置于MOCVD反应室中进行退火;步骤三是在退火完成的情况下,直接将反应室环境调整至生长条件,然后进行纳米线的生长,图中轴向为垂直于衬底方向,径向为平行于衬底方向.为了讨论生长温度对纳米线形貌的影响和生长机理的变化,设定生长温度为500,550和600◦C,分别对应记为样品N1,N2和N3,其Au膜厚度均为5 nm,生长时间为500 s.整个制备过程中始终通入H2作为载气,生长结束后持续通入AsH3保护,直至降温至300◦C以下.InGaAs材料的生长需要同时通入TMIn和TMGa进行生长,记为样品N4和N5,生长温度分别为550◦C和750◦C.GaAs/InGaAs异质结构生长结束之后,保持持续通入AsH3,直至反应室降温至300◦C以下.

图1 VLS机理金催化方式制备GaAs纳米线过程示意图Fig.1.Schematic for the process of fabricating Au-catalyzed GaAs nanowires via VLS mechanism.
3 实验结果与分析
在遵循VLS机理制备纳米线时,合金催化剂颗粒的尺寸及分布对于纳米线形貌特征有重要影响.通常,合金颗粒的尺寸直接影响纳米线的直径大小[13],且随着Au膜厚度的增加,高温退火后得到的Au-Ga合金颗粒的平均直径也随之增大,但是合金颗粒密度减小[14].由样品N1的SEM截图可见,纳米线绝大部分呈圆柱状并且垂直于衬底.纳米线长度约为3µm,直径约200 nm,顶端可见球形Au-Ga合金颗粒,说明该纳米线结构是在VLS机理下通过合金颗粒催化生长出来的.随着生长温度的升高,如样品N2的SEM图像所示,“柱状”纳米线已经消失,所有纳米线都已经呈现“锥状”,并且长度约为样品N1的1/3.纳米线底部的直径约为500 nm,顶端不存在球形的Au-Ga合金颗粒,证明此时的纳米线不是经由金催化生长出来的.由样品N3的SEM图像可知,当生长温度升高至600◦C后,纳米线长度减小至约为200 nm,且纳米线呈现“金字塔状”.
通过图2(a)—(c)可知,样品N1,N2和N3的生长速率分别约为21.6,10.8和2.9µm/h.这是因为随着生长温度升高,合金颗粒的过饱和度升高,导致纳米线的生长速率降低.轴向生长速率与温度的关系可以表示为

其中v代表纳米线生长速率,b是结晶运动学系数,k为玻尔兹曼常数,T代表温度,∆µ0表示平面限制中的过饱和度,Ω代表反应物原子体积,d代表纳米线直径,αvs表示纳米线的平均表面能密度[15].由(2)式可知,随着生长温度的升高,纳米线的生长速率降低,即轴向生长受到抑制.当温度超过临界值之后,合金颗粒的过饱和度将升高至无法支持纳米线继续生长.

图2 (a)N1,(b)N2,(c)N3的SEM截面扫描图片Fig.2.SEM images of sample N1(a),N2(b)and N3(c).
由图2可见,随着生长温度的增加,N1,N2和N3样品中纳米线由轴向生长逐渐转变为径向的侧壁生长,纳米线的形貌由“柱状”变为“锥状”直至“金字塔状”.出现这种现象的原因是:当生长温度较低时,侧向生长通常优先出现在Au和GaAs(111)B的界面处.此时界面相当于一个沟槽,沟槽内的过饱和度更低,因此纳米线呈现柱状[13];当生长温度相对较高时,Au与衬底的界面处原子析出较少,无生长或生长较慢,此时生长发生在纳米线侧壁及未与合金颗粒接触的GaAs(111)B衬底表面,故纳米线顶端未见催化剂颗粒,且纳米线的根部半径大,呈现“锥状”形貌特征[16],这与Borgström等[13]和Hiruma等[17]的结论完全一致.随着高温下纳米线的径向生长,靠近衬底的根部尺寸变大,此时纳米线根部扩散流量与半径的关系可表示为

在“柱状”GaAs纳米线的生长条件下,制备了GaAs/InGaAs纳米线轴向异质结构.北京邮电大学的Lü等[19]曾制备了轴向的GaAs/InGaAs/GaAs双异质结构,得到的纳米线均垂直于衬底,但异质结界面并不清晰.由图3(a)可见,所制备的GaAs/InGaAs纳米线结构异质界面清晰,分布随机,形貌规则,并未出现“断裂”或“倾倒”等现象,且纳米线绝大部分垂直于衬底.在GaAs/InGaAs异质结构顶端的深色球形部分是Au-Ga合金颗粒,说明该纳米线是在金辅助催化机理下生长的.合金颗粒下方依次是GaAs段纳米线和InGaAs段纳米线,两种材料的界面清晰可见,异质结构整体呈“柱状”.其中GaAs部分长度约为2.2µm,InGaAs段长度约为0.35µm,纳米线直径约为170 nm.在GaAs/InGaAs纳米线异质结构的底端,靠近衬底的位置发生了少部分径向侧壁生长,这是由于550◦C下原子迁移率降低造成的[20].
根据图1所示,在纳米线生长过程中,Ga原子和As原子由载气H2携带并注入反应室.由于Au-Ga合金颗粒表面粗糙,所以更容易吸附原子,故Ga原子先被合金颗粒吸附,然后又由于过饱和而析出,并与As反应生成“柱状”GaAs纳米线.由此推断,InGaAs段纳米线应该出现在Au-Ga合金颗粒和GaAs段纳米线之间的位置,如图3(b)“生长模式一”所示.然而由于In原子的迁移作用,导致除了图3(b)中的“生长模式一”之外,还有另外一种可能,即根据图3(b)“生长模式二”所示,In-GaAs段纳米线出现在GaAs段底端,靠近衬底的位置.这是由于在使用Au催化VLS方法制备纳米线的过程中,主要包括两种生长机理:其一是反应源气体直接撞击催化剂合金颗粒并进行反应;其二是当衬底上的原子迁移距离大于合金颗粒尺寸时,衬底上解吸的原子或气体源中落在衬底上的原子通过迁移运动来接近纳米线并参与反应.由于In原子的迁移长度远大于Ga原子,所以当制备InGaAs段纳米线时,绝大多数In原子选择通过衬底迁移进入纳米线,使得InGaAs段纳米线生长在GaAs段的底部[21],此时由生长模式二占主导.

图3 (a)样品N4的SEM截面图;(b)GaAs/InGaAs纳米线轴向异质结构生长模式示意图Fig.3.(a)SEM image of sample N4;(b)schematic of growth modes for GaAs/InGaAs nanowires with axial heterostructures.

图4 GaAs/InGaAs纳米线异质结构的EDX扫描图像 (a)从D点开始到E点结束的径向方向;(b)从F点开始到G点结束的轴向方向Fig.4.(a)Axial EDX line-scans of GaAs/InGaAs nanowires;(b)EDX line-scans of GaAs/InGaAs nanowires from the very bottom towards the top.
图4为图3(a)中纳米线的X射线能谱(energy dispersive X-ray spectroscopy,EDX)线分析曲线图,其中图4(a)表示从D点到E点的径向线分析扫描曲线.由图4(a)可见,As,Ga和In元素均未见明显起伏,表明该生长条件下,纳米线由轴向生长占主导.其中出现In元素的信号是由于In原子在靠近异质结的界面处扩散引起的.如图4(b)所示,在从F点开始到G点结束的方向上,As元素的含量并未出现明显的变化趋势;Ga元素含量随着距离增加呈现上升趋势,在约0.2µm之后趋于平缓,这是在生长InGaAs段的过程中降低Ga源流量导致的;In元素的含量随着距离增加而逐渐降低,并在约0.3µm处开始趋于平缓,说明此处的纳米线材料已由InGaAs材料变为GaAs材料.
进一步研究了GaAs/InGaAs纳米线径向异质结构,其中GaAs是“芯”,而InGaAs是“壳”. 根据(3)式,需要通过提高生长温度来控制纳米线生长方向,使其沿着径向方向生长,故InGaAs纳米线壳层的生长温度为750◦C,远高于InGaAs材料的一维轴向生长温度和二维平面结构的生长温度.同时升高温度,可以使得金属有机源TMGa的热解更加充分,可供反应的原子更多,导致原子迁移率降低,从而促进径向侧壁生长[20].GaAs/InGaAs纳米线径向异质结构示意图见图5,GaAs纳米线长度不变,同时InGaAs材料生长在GaAs纳米线侧壁.
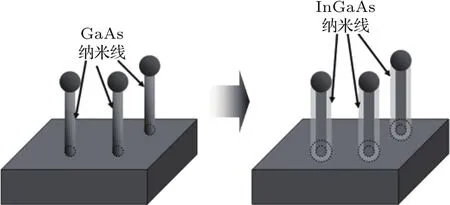
图5 样品N5 GaAs/InGaAs纳米线径向异质结“芯-壳”结构示意图Fig.5.Schematic of GaAs/InGaAs nanowires with radial heterostructures.
图6(a)是GaAs/InGaAs纳米线径向异质结构的截面示意图,图中纳米线“芯”部分为GaAs材料,两侧“壳”部分为InGaAs材料,其中图6(b)为部分纳米线的放大图,图中的“x”和“z”区域表示纳米线“壳”层厚度,“y”表示GaAs纳米线直径.样品的SEM图像如图6(c)所示,纳米线高度约为4.7µm,直径约为300 nm.纳米线轴向异质结构呈圆柱形,且绝大部分垂直于衬底.对图6(c)中的一部分进行放大,如图6(d).通过观察,发现纳米线在沿着径向方向上存在着不同颜色深度的区域,将其分为“x”,“y”和“z”三个区域,与图6(a)所示结构一致.通过SEM图像的颜色判断,“y”区域对应着纳米线径向异质结的“芯”,即GaAs部分.而“x”和“z”区域,则对应着“芯”外部包裹的“ 壳”,即InGaAs部分,图6(d)为“芯-壳”异质结界面局部SEM放大图.
图6(e)为图6(c)中沿CD方向的EDX线分析径向扫描曲线,图6(f)为图6(c)中从E点开始到F点结束的轴向扫描曲线.由图6(e)可见,沿着径向方向,距离约为0.27µm,元素In的含量未呈现明显变化趋势,说明在径向方向上,In元素的含量没有明显的起伏;而元素Ga和As的含量则是沿着箭头方向,出现先升后降的趋势,其中[0.75,0.2]µm的部分约对应于图6(c)中所示的纳米线“芯”的位置,其余部分与纳米线的“壳”位置相对应.这一趋势可以说明,在径向方向上,Ga元素和As元素的含量分布存在变化,其原因可以归结为纳米线“芯-壳”异质结的存在.由于纳米线结构的“壳”部分为InGaAs,“芯”部分为GaAs,导致Ga元素和As元素在“芯”的两侧含量较低,在中间部分则较高.
从图6(f)可以看出,In,Ga和As元素含量在[0,3.5]µm范围内并没有沿着纳米线的轴向方向出现明显的变化,说明纳米线没有发生轴向的伴随生长,纳米线长度即为GaAs“芯”的长度.在3.5µm之后,In元素的含量上升,Ga元素和As元素的含量下降.造成该现象的原因是,在制备GaAs/InGaAs纳米线径向异质结的过程中,绝大部分In原子选择通过衬底扩散的机理参与纳米线侧壁的径向生长,另有一小部分In原子参与了纳米线顶端Au-Ga合金颗粒的吸附与解析,并与Ga,As原子反应,即图6(a)中的“w”区域.高温下纳米线的轴向生长受到抑制,故只有少部分Ga,As原子与In原子反应发生轴向生长.该段InGaAs纳米线与下面的GaAs段纳米线组成了轴向异质结,导致In元素的含量上升,同时Ga和As元素的含量下降.在SEM图片中,并未能够清晰地观察到GaAs/InGaAs轴向异质结的界面,原因可能是因为In元素在高温下迁移导致的界面模糊.根据温度对纳米线生长规律的影响,可以通过继续升温来限制In原子在纳米线顶端与Ga,As原子的反应,从而进一步抑制伴随发生的轴向生长.

图6 (a)GaAs/InGaAs纳米线径向异质结构的截面示意图;(b)为(a)的局部放大图;(c)样品N5的SEM截面图像;(d)为(c)的局部放大图;(e),(f)分别为(c)中从C点开始到D点结束的EDX线分析径向扫描曲线和从E点开始到F点结束的轴向扫描曲线Fig.6.(a)and(b)are the sectional schematics of GaAs/InGaAs nanowires with radial heterostructures.(c)and(d)are SEM images of GaAs/InGaAs nanowires with radial heterostructures.(e)Axial EDX line-scans of GaAs/InGaAs nanowires with radial heterostructures.(f)EDX line-scans of GaAs/InGaAs nanowires from bottom towards top.
4 结 论
通过金辅助催化法,利用MOCVD技术制备了GaAs纳米线及GaAs/InGaAs纳米线异质结构.对不同温度下生长的GaAs纳米线形貌进行SEM测试表征,发现随着生长温度升高,纳米线长度减小,并且由轴向生长逐渐转变为径向的侧壁生长,纳米线的形貌由“柱状”变为“锥状”直至“金字塔状”.制备了高质量的GaAs/InGaAs纳米线异质结构,纳米线整体呈“柱状”,且与衬底垂直,未出现“倾倒”、“扭折”等现象.由于In原子扩散长度大,导致InGaAs材料出现在GaAs段以下,两种材料的界面清晰可见,EDX测试结果显示未发现明显的径向伴随生长.通过升高生长温度,使纳米线沿径向方向生长,制备了GaAs(芯)/InGaAs(壳)纳米线径向异质结构.SEM测试结果表明纳米线异质结呈现均一的“柱状”结构且垂直于衬底,异质结界面清晰可见.EDX测试结果表明纳米线的轴向生长在高温时受到抑制,但仍有少部分In原子进入Au-Ga合金颗粒,并与Ga,As原子发生反应生成InGaAs轴向纳米线.
感谢长春理工大学纳米操纵与制造国际联合研究中心王作斌教授、张文晓老师在本文研究过程中提供的SEM测试支持,感谢长春理工大学化学与环境工程学院董相廷教授、于文生老师提供的EDX测试技术支持.

