GaSb/InSb/InP异质结构的漏电流机制
徐佳新,徐德前,庄仕伟,李国兴,张源涛,董 鑫,吴国光,张宝林
(吉林大学电子科学与工程学院集成光电子学国家重点实验室,吉林长春 130012)
1 引 言
目前,在气体监测、遥感技术、红外通讯等诸多领域,对3~5 μm波段的半导体红外探测器均有着迫切的需求。InSb材料作为一种典型的窄禁带半导体材料,具有量子效率高、响应速度快、稳定性好的优点,但是其在室温条件下的高复合噪声制约了器件的探测性能,难以满足第三代红外探测器的发展要求[1-2]。近年来,以微机电技术(MEMS)为基础的微测辐射热计[3]与锑化物Ⅱ型超晶格结构[4],由于工作温度高、覆盖波段范围广等特点而成为近年来的研究热点,但是微测辐射热计的响应速度较低,而超晶格结构则需要在器件表面制备复杂的光栅结构以提高量子效率,InSb光伏型器件则不具备这样的缺点,因此仍具有一定的竞争力。
为了提高探测器的工作温度,人们从器件的结构设计入手,提出MSM结构、nBn结构以及非平衡探测器等[5-12],以解决窄带隙材料复合率高的问题。其中,非平衡探测器结构被证明是一种降低俄歇复合噪声的有效手段[11,13],器件的 R0A可以达到1.5×10-2Ω·cm2。但是,这种非平衡探测器采用InSb同质结构,俄歇复合效应在有源区以外并未被抑制,复合率依然很高。而且N+区与P+区内高浓度的杂质,在InSb中将会引发严重的肖克莱-瑞德复合过程,使得漏电流很大。
为此,本文提出采用GaSb与InP两种宽禁带材料分别作为器件的P+区与N+区,制备一种GaSb/InSb/InP异质PIN结构,利用TCAD工具对器件进行建模及仿真,并采用低压金属有机化合物(LP-MOCVD)技术制备样品,研究其反向漏电流及品质因子。测试结果表明,理论模型与实验结果相吻合,器件品质因子R0A相比于同质InSb结构提高了一个数量级,达到了0.1 Ω·cm2。由于InSb有源区内的复合机制是限制器件工作性能的主要因素,因此对有源区内的复合机制进行研究,对降低器件的漏电流具有指导性意义,同样对提高器件的工作温度有着重要的意义。
2 器件仿真模型
2.1 InSb 能带
由于GaSb和InP两种材料与InSb同属Ⅲ/Ⅴ族半导体,在能带结构方面具有一定的相似性[14],因此以InSb为例说明能带参数的计算方法。InSb是一种直接带隙材料,其能带结构如图1所示。
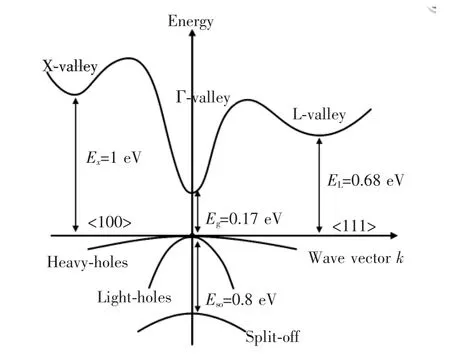
图1 InSb能带结构图Fig.1 Band structure of InSb
对于InSb的Γ能谷,由于其曲率很大,需要在抛物线模型的基础上添加一个修正系数α[15],以提高拟合精度,此时状态密度可写为

并且,在室温附近,由于本征费米能级接近导带底,即使未掺杂的InSb材料也会呈现出简并半导体的特性。本征费米能级与导带底的距离可以通过下式来估算

可以计算得出,300 K下InSb材料的本征费米能级位于导带底以下0.02 eV的位置[16],处于弱简并区。此时玻尔兹曼近似不再成立,因此必须采用费米-狄拉克分布来计算导带中的电子浓度。利用热平衡时的电子浓度公式

将费米分布函数f(E)进行泰勒展开并忽略高阶项可以得到

其中Nc=2(mekT/2π2)3/2是 InSb导带的有效状态密度,F1/2、F3/2、F5/2分别为 1/2、3/2、5/2 阶费米积分。

值得说明的是,在InSb材料中,Γ能谷中心附近重空穴带的曲率远小于导带,因此在计算俄歇复合系数的过程中,可以对重空穴带进行“平带”近似,从而简化计算过程[17]。
2.2 InSb有源区的俄歇复合模型
俄歇复合是一种非辐射复合过程,是影响器件性能的一种重要机制[18]。根据参与俄歇复合的载流子在能带中的分布情况,俄歇复合及对应的碰撞电离过程可以分为10种类型,其中在InSb材料中起主要作用的是CCCH与CHHL这两种过程[13]。
对于价带,抛物线近似依然成立,同时由于费米能级距价带顶较远,满足玻尔兹曼近似的3kT条件,因此价带中空穴的浓度p0可由下式计算

图2 CCCH及CHHL俄歇机制示意图Fig.2 Schematic representation of CCCH and CHHL Auger processes
在CCCH复合过程中,发生复合的电子和空穴分别位于导带底与重空穴带上,获得能量的电子在导带中被激发到更高的能级。该过程的复合率Rn与载流子浓度的关系为

其中,Rn0为热平衡条件下的复合率。
与CCCH过程类似,CHHL过程中的电子和空穴同样位于导带底与重空穴带,但获得能量的电子从轻空穴带被激发到重空穴带。CHHL过程的复合率Rp为

因此,总的净复合率RAuger为上述两种机制复合率的和,即

其中,Cn与Cp分别称为CCCH过程与CCHL过程的俄歇复合系数。量子力学计算结果表明,Cn与Cp的值与温度及禁带宽度有关,计算过程中综合考虑了理论计算[17]与实验测量[18]的结果来确定二者的大小。在np的条件下,俄歇复合率可近似地写为

此时净复合率为负值,代表着产生率。因此,在载流子浓度较低时,俄歇复合的净产生率与载流子浓度成正比,GaSb/InSb/InP结构正是利用这一原理来达到抑制俄歇复合的目的。
2.3 InSb有源区的肖克莱-瑞德复合模型
肖克莱-瑞德复合是另一种重要的复合机制,是低温条件下限制探测器性能的重要因素。在室温下,当俄歇复合受到抑制,或材料的杂质和缺陷的浓度很高时,肖克莱-瑞德复合可能成为决定器件漏电流的主要因素。由于窄带隙材料的禁带宽度较小,即便是浅能级杂质也能够呈现出明显的复合中心效应,对载流子的寿命影响很大。
肖克莱-瑞德复合过程的净复合率[19]可以表示为

其中Et为复合中心能级,τn、τp类似于少子寿命,分别反映了复合中心对电子与空穴的最大俘获能力,其与复合中心浓度的关系分别为

其中Nt为复合中心的浓度,cn与cp分别称为电子与空穴的俘获系数。由于制备工艺与具体材料生长环境的不同,材料中的杂质种类难以确定,对复合中心的参数Et、Nt以及俘获系数cn、cp的确定造成了困扰,计算中采用了实验测量的结果[20-21]。
2.4 GaSb/InSb/InP结构的电荷输运模型
在对GaSb/InSb/InP结构的电学特性进行仿真时,从连续性方程入手,结合漂移扩散模型进行建模[22],并通过TCAD 工具实现。
连续性方程可写为

其中,q为电子电荷量,Jn、Jp分别为电子电流与空穴电流,R与G分别代表复合率与产生率。
在扩散漂移模型下,电子电流Jn与空穴电流Jp可以表示为

其中,E为电场强度,μn、μp分别为电子与空穴的迁移率,Dn、Dp分别为电子与空穴的扩散系数。
在无外界激励的条件下,产生率G为0。同时可以证明,直接辐射复合与隧穿效应的影响可以忽略[13-14]。因此复合率R由俄歇复合与肖克莱-瑞德复合两种机制决定,即

将式(12)、(13)带入到式(11)中,便得到完整的电荷输运方程:

3 GaSb/InSb/InP结构
在GaSb/InSb/InP结构中,采用禁带较宽的重掺杂GaSb与重掺杂InP分别作为P+区与N+区,作为空穴传输层与电子传输层。非故意掺杂的InSb材料作为有源区,吸收红外辐射并发射光生载流子。GaSb较低的电子亲和势使得GaSb的价带顶略低于InSb的导带底,位于InSb的禁带之间。InP的电子亲和势与InSb相近,因此InP的导带底与InSb的导带底基本持平。这使得GaSb/InSb/InP结构在热平衡时,能带呈现出一种类似于图3(a)中所示的“阶梯”形态。在这种能带结构下,电子与空穴在沿“阶梯”而下的方向上可以自由地流动而不受限制,而在反方向上的运动则受到高势垒的阻碍,使得扩散效应产生的噪声电流密度很低。
如果InSb与GaSb、InP间的费米能级差很大,将导致平衡时InSb有源区异质结界面处的能带强烈弯曲。为避免这种情况,GaSb与InP两种材料应分别重掺杂为P+型和N+型,以减小与InSb费米能级的差异。这将导致GaSb与InP处于弱简并区,因此在计算两种材料中的载流子浓度时,可参考讨论InSb材料能带时的式(4)与式(5)。
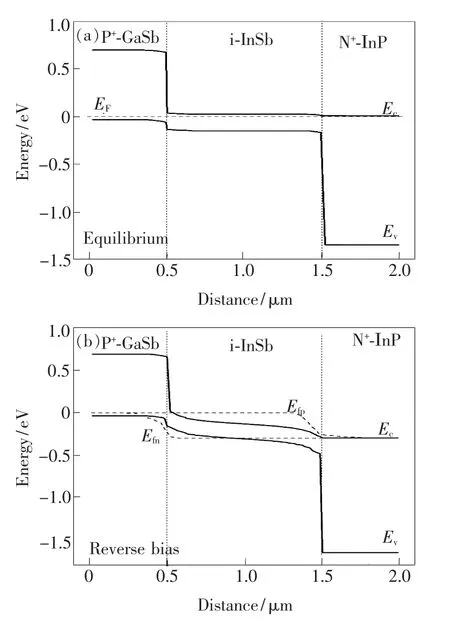
图3 GaSb/InSb/InP PIN结构的能带图。(a)平衡条件下;(b)-0.3 V反偏压下。Fig.3 Band diagram of GaSb/InSb/InP PIN structure under equilibrium(a)and -0.3 V bias(b)
当施加反偏压时,由于N+区与P+区内杂质浓度很高,空间电荷区的扩展很小,耗尽层基本扩展在InSb有源区,反偏压基本全部被有源区分担,内建电场被增强。这有利于光生载流子快速分离,在电场的作用下迅速漂移并穿过有源区,从而具有较高的响应速度。光生电子与空穴在电场的作用下分别漂移至N+区与P+区,并以多子的“身份”继续向两侧扩散,在小注入条件下不会引起N+区与P+区内载流子浓度的变化。因此,光生载流子在N+区与P+区内复合率很低。计算结果表明,在不计表面复合的情况下,超过95%的光生载流子可以被两侧的电极收集。
同时,在一定的反偏压下,有源区将被完全耗尽,载流子的浓度很低。根据(9)式,俄歇复合率与载流子的浓度呈线性关系,反偏压的增加可降低载流子的浓度,因而可以抑制俄歇复合过程,从而达到降低器件噪声的目的。
4 结果与讨论
4.1 载流子分布
反偏压下GaSb/InSb/InP PIN结构中电子与空穴的浓度分布如图4所示。在-0.3 V的反向偏压下,InSb有源区几乎完全耗尽,载流子的浓度相比热平衡时的浓度1.8×1016cm-3下降了近两个数量级。

图4 GaSb/InSb/InP PIN结构-0.3 V反偏压下的载流子分布Fig.4 Carrier concentration of GaSb/InSb/InP PIN structure under -0.3 V reverse bias
值得说明的是,在N+区与P+区中少子的浓度很低,分别为106cm-3与104cm-3数量级。相比于InSb材料,即使在杂质浓度为1018cm-3的重掺杂情况下,少子浓度依然高达1014cm-3量级。因此,采用GaSb与InP两种宽禁带材料作为N+区与P+区,可以有效地削弱反偏压下有源区的少子注入效应,从而降低器件的漏电流。
4.2 GaSb/InSb/InP结构的俄歇复合电流
在仅考虑俄歇复合时,GaSb/InSb/InP异质结构在不同工作温度下的漏电流如图5所示。在负偏压增加到-0.2 V以后,漏电流逐渐下降。在高温时这种衰减过程十分明显,温度为300 K时漏电流的饱和值相比于极大值有近一个数量级的下降。随着工作温度的降低,这种衰减效应逐渐减弱。
在反偏压从零开始递增时,反偏压的增加导致空间电荷区逐渐扩展,有源区内的载流子迅速被耗尽。此时,式(8)中的(np-)一项迅速减小,由于其为载流子浓度的二次方项,使产生率远大于复合率,漏电流也随之迅速增加。
当反偏压超过-0.2 V以后,有源区内载流子浓度已经很低,此时(np-)≈,因此俄歇复合率可由式(9)表示,由载流子浓度n与p决定,并随着反偏压的增加而逐渐下降,漏电流也随之下降,呈现出负阻效应。
最后,有源区被完全耗尽,此时尽管反向偏压的增加仍然能够将更多的载流子从有源区“抽离”,但从图4可以看出,在结的附近载流子的浓度仍然很高,此时俄歇复合过程集中发生在结的附近,并使漏电流呈现出饱和趋势。
尽管反偏压下有源区内的载流子浓度相比于热平衡时下降了两个数量级,但是300 K下的漏电流仅有一个数量级的下降,这与式(9)的计算结果相矛盾。这种矛盾的结果,是结附近高浓度的载流子造成的。通过计算有源区内的平均俄歇复合率:

可知,结附近高浓度的载流子在一定程度上抵消了有源区内部低浓度载流子的作用。
当温度降低时,俄歇复合系数与载流子浓度均以指数形式下降[17],此时俄歇复合率基本只由结附近高浓度的载流子决定,导致低温时俄歇复合的抑制效果减弱。在温度下降到200 K时,俄歇复合电流的衰减现象已十分微弱。
4.3 GaSb/InSb/InP结构的反向漏电流
与俄歇复合过程不同,根据式(10),肖克莱-瑞德过程的净产生率随载流子浓度的降低而单调增加,与俄歇复合率的衰减效应相反。因此在反偏压下,这两种复合机制相互制约,并共同决定了漏电流的大小。
考虑到肖克莱-瑞德复合的影响,在InSb有源区内的有效复合中心浓度为1.0×1012,1.0×1013,1.0 ×1014cm-3三种条件下分别计算 PIN 结的漏电流,结果如图6所示,虚线为仅考虑俄歇复合的漏电流。

图6 不同反偏压下GaSb/InSb/InP PIN结构的漏电流Fig.6 Leakage current of GaSb/InSb/InP PIN structure under various reverse bias
当复合中心浓度在1.0×1012cm-3以下时,俄歇复合的作用占据着主导地位,在反偏压超过-0.2 V后,漏电流随着反偏压的增大而逐渐下降并饱和。当复合中心浓度超过1.0×1012cm-3以后,肖克莱-瑞德复合的影响逐渐显现出来,在一定程度上抵消了漏电流的衰减效应,并决定了反向饱和电流的大小。在复合中心浓度达到1014cm-3数量级以后,肖克莱-瑞德复合的影响已经完全覆盖了俄歇复合,并直接决定了漏电流的大小。
通过以上分析可知,俄歇复合机制决定了器件漏电流的下限,因此决定了器件在室温下工作性能的极限。同时,杂质与缺陷的浓度对漏电流的影响很大,浓度达到1014cm-3数量级时,肖克莱-瑞德复合将成为影响工作性能的主要因素。
4.4 GaSb/InSb/InP结构的制备与测试
通过LP-MOCVD技术,使用三甲基镓(TMGa)、三甲基铟(TMIn)、三乙基锑(TESb)作为反应源,二乙基锌(DEZn)作为p型掺杂源,在InP衬底上依次生长i-InSb外延层与p+-GaSb外延层,工艺参数见表1。

表1 GaSb/InSb/InP PIN结构的生长参数Tab.1 Parameters of the epitaxial growth of GaSb/InSb/InP PIN structure
最后,通过蒸发工艺在外延层表面制备电极。利用Agilent B2900A型半导体测试仪,对样品反偏压下的漏电流进行了测试,结果如图7所示。
图7中虚线为实验测量结果,实线为复合中心浓度为5.0×1014cm-3时的仿真结果。由于InSb外延层与InP衬底的晶格适配较大,达到10%,导致InSb外延层界面处的缺陷浓度高,肖克莱-瑞德复合为器件漏电流的主要影响因素,因此实验中未观察到由于俄歇复合受到抑制所引起的负阻效应。通过漏电流的大小来估计复合中心浓度,近似推算样品InSb外延层内的缺陷浓度在2×1014~7 ×1014cm-3范围内,与报道的结果吻合[20]。

图7 GaSb/InSb/InP PIN结构不同反偏压下漏电流测试结果Fig.7 Measured data of leakage current of GaSb/InSb/InP PIN structure under various reverse bias
光伏器件的品质因子R0A常被用来评价器件的工作性能及工艺水平,其与器件饱和漏电流Isat的关系可表示为

样品的反向饱和漏电流为0.26 A·cm-2,由此计算出样品的R0A值为0.1 Ω·cm2。研究表明,利用低温生长或缓冲层技术可以有效地降低InSb外延层中的缺陷浓度[23-24],因此通过优化外延层的生长工艺,可以进一步降低器件的漏电流,使器件接近俄歇复合机制所决定的性能极限。根据仿真结果,俄歇复合机制引发的饱和漏电流为5.3×10-3A·cm-2,因此 GaSb/InSb/InP 结构在室温下R0A的极限值为4.9 Ω·cm2,对应的归一化探测率为1010cm·Hz1/2·W1/2量级。
5 结 论
为提高室温下InSb红外探测器的工作性能,本文设计了GaSb/InSb/InP异质PIN结构,利用TCAD工具对器件进行建模及仿真,研究了InSb有源区内载流子的复合机制对器件漏电流的影响。研究发现,俄歇复合机制引发的噪声在反偏压下呈现出一定的衰减效应,并决定了器件探测性能的极限。当InSb有源区内的缺陷浓度高于1.0×1014cm-3后,肖克莱-瑞德复合成为影响漏电流的主要机制。通过LP-MOCVD技术制备样品并对其漏电流进行测试分析,实验结果表明,理论模型与实验结果相吻合,样品的漏电流为0.26 A·cm-2,品质因子R0A达到了0.1 Ω·cm2,相比于同质InSb结构提高了一个数量级,已接近实用化水平。

