C离子对AlGaAs/InGaAs异质结的辐照影响



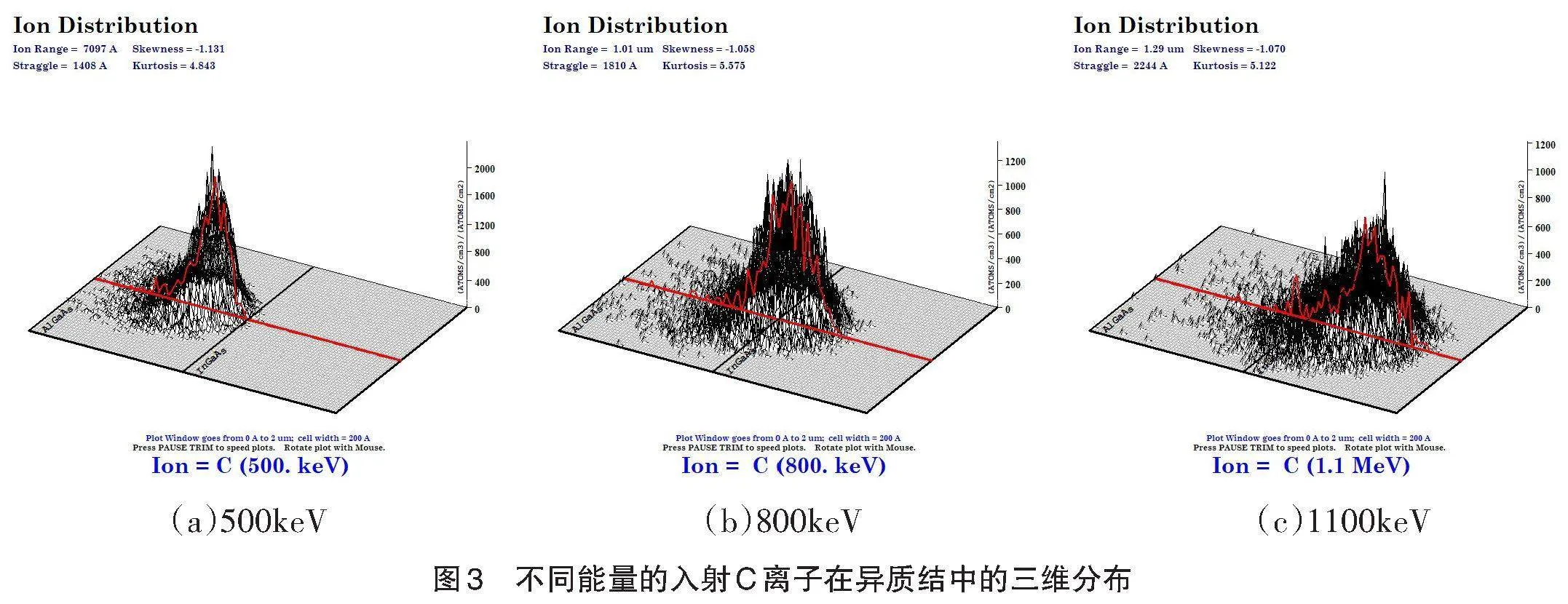




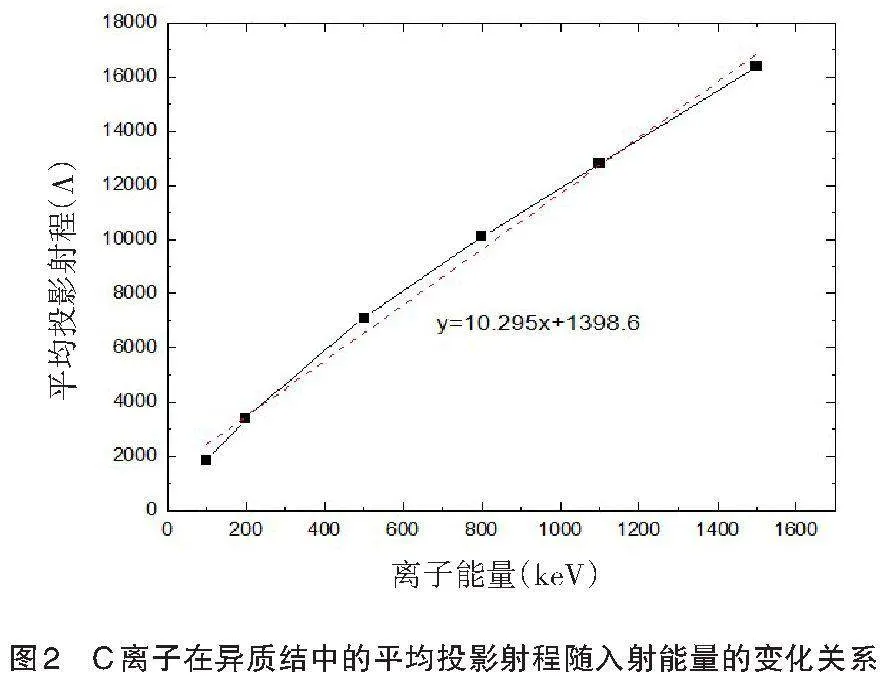


摘 要:基于SRIM软件计算了不同能量的C离子在AlGaAs/InGaAs异质结中的平均投影射程和辐照损伤区,仿真了能量为500keV、800keV、1100keV的C离子入射到AlGaAs/InGaAs异质结中的能量损失情况,发现随着入射离子能量的增加,电离能比例增加,非电离能比例降低,入射离子产生的电离能损远大于反冲原子产生的电离能损,反冲原子产生的声子能损远多于入射离子产生的声子能损;通过仿真还发现,当C离子的能量为800keV时,辐照损伤区在异质结处且在异质结处产生的空位缺陷最多。
关键词:C离子辐照;AlGaAs/InGaAs异质结;电离能损;非电离能损;空位
中图分类号:TN304.2" "文献标识码:A" "文章编号:1007 - 9734 (2024) 04 - 0066 - 06
0 引 言
近年来,随着科技的进步,人们对空间技术的探索日益增强[1],微电子系统越来越广泛地应用在航天飞行器、卫星雷达、空间通讯、外太空探索等领域[2-5],高温、高压、高频和大功率半导体器件是国际半导体研究的热点,也是当今微电子领域的战略制高点之一[6]。半导体器件是微电子系统的重要组成部分,异质结是半导体器件的核心元件,以AlGaAs/InGaAs异质结为核心的高电子迁移率晶体管(HEMT)在高频、低噪和大功率应用等方面展现出了得天独厚的优势和无限的潜力[7-9]。太空中有大量的粒子辐照,包括r射线、电子、中子和一些带电离子等[10],运行在空间中的器件将不可避免地遭受太空中极其复杂的辐照环境的影响[11],长时间的辐照会导致器件功能退化,甚至性能失效[12-14]。因此,研究空间粒子对器件的影响势在必行[15]。然而,国内外众多辐照研究大都集中在质子、电子和中子上[16-17],对重离子的辐照影响研究相对较少。由于C离子在空间辐照环境中的重离子中所占比例较高,而研究异质结的辐照作用又可以为器件辐照的研究指引方向,所以本文基于SRIM软件对C离子对AlGaAs/InGaAs异质结的辐照损伤进行了研究,为其抗辐照加固提供理论依据。
1 仿真结构
本文采用的仿真结构为AlGaAs/InGaAs异质结,如表1所示。
2 仿真结果
本文采用的仿真软件为SRIM,SRIM程序是目前国际上通用的计算带电离子在靶材料中入射和能量传递的计算程序。入射离子的个数设置为104个,入射角度为0度,即垂直于材料表面。
2.1" 辐照损伤区仿真
入射离子在入射方向上的射程和其在靶材中的终止位置反映出其对材料的辐照损伤区,本文仿真了不同能量的C离子入射到AlGaAs/InGaAs异质结中的情况,入射离子的能量分别为100keV、200keV、500keV、800keV、1100keV、1500keV,如图1所示。
从图1中可以看出:当入射离子的能量为100keV、200keV时,由于入射离子能量低,穿透力弱,全部离子都停留在AlGaAs层,并距离异质结较远;当离子能量为500keV时,平均投影射程为7097埃,大多数离子停留在异质结左侧的AlGaAs层;当入射离子的能量为800keV时,平均投影射程为10100埃,大部分离子停留在异质结处;当离子能量为1100keV时,平均投影射程为12 800埃,离子大多停留在异质结右侧的InGaAs层;当入射离子的能量增加到1500keV时,几乎全部离子都停留在距离异质结较远的InGaAs层,转移出异质结附近。
图2给出了离子在异质结中的平均投影射程随入射离子能量的变化关系,可以看出,随着入射离子能量的增加,平均投影射程逐渐增加,近似呈线性关系。由于停留在异质结附近的离子才会对异质结产生非常大的影响,因此,我们应该重点关注500keV-1100keV之间的C离子辐照情况。
图3给出了能量为500keV、800keV、1100keV的C离子最终在异质结中的三维分布图,从图中可以看出,入射离子在靶中并不是做直线运动,其最终在停止位置与入射点是偏离的,最终在靶中呈离散分布。从图中还可以看出,虽然500keV的C离子平均投影射程距离异质结较远,但也有极少数C离子到达InGaAs层,对InGaAs层造成影响。这是由于带电离子与靶材相互作用时,会在各个方向上与靶原子发生碰撞,从而使入射离子朝各个方向运动。
2.2" 能量损失计算
在带电离子与靶材的相互作用过程中,自身能量会通过电离和非电离的方式损失,损失的能量分别为电离能量损失和非电离能量损失。电离能损对靶材产生电离损伤,非电离能损则对靶材产生位移损伤和激发声子。由于带电离子在与靶材原子碰撞时,会把能量传递给靶材原子,从而使靶材原子成为反冲原子,因此,能量损失由入射离子和反冲原子两部分组成。
本文研究了能量分别为500keV、800keV、1100keV的C离子入射到AlGaAs/InGaAs异质结中的能量损失情况,如表2所示。从表中可以看出,随着入射离子能量的增加,电离能比例增加,非电离能比例降低。
本文又具体分析了入射离子和反冲原子产生的电离能损分布情况。如图4和图5所示。
图4反映的是能量分别为500keV、800keV、1100keV的C离子在AlGaAs/InGaAs异质结中的电离能损,从图中可以看出,入射离子产生的电离能损远远大于反冲原子产生的电离能损,并且入射离子能量越大,电离能损越多。并且,当入射C离子的能量为500keV时,能量损失集中在AlGaAs层,当C离子的能量为800keV时,能量损失集中在异质结附近,当C离子能量为1100keV时,能量损失则集中在InGaAs层,这与辐照损伤区仿真一致。
图5反映的是能量分别为500keV、800keV、1100keV的C离子在AlGaAs/InGaAs异质结中的声子能损,从图中可以看出,反冲原子产生的声子能损远远多于入射离子产生的声子能损,这与电离能损正好相反,但同样是C离子能量为800keV时,能量损失集中在异质结附近,这也与辐照损伤区仿真结果一致。
2.3" 空位计算
由于非电离能损产生的位移损伤会在靶材中引入空位缺陷,而空位缺陷会对半导体中载流子的寿命、浓度和迁移率产生影响,从而导致器件电学性能的退化,对器件损伤严重,因此,本文重点关注了能量分别为500keV、800keV、1100keV的C离子在异质结中产生的空位个数。图6反映的是在入射离子与靶材相互作用过程中,发生的总位移次数。
从图6可以看出,随着离子能量的增加,每个入射离子从与靶材原子相互作用到最终停止在靶材中,发生的碰撞次数和产生的位移次数是增加的,产生的空位个数也是增加的。
图7、图8和图9显示的是异质结两侧的空位种类随深度的变化,可以看出,当离子能量为500keV时,产生空位的峰值在AlGaAS层,但InGaAs层也会产生极少空位缺陷。当离子能量为800keV时,空位个数峰值正好在异质结处,当离子能量为1100keV时,空位个数峰值在InGaAs层。从图7、图8和图9还可以看出,在AlGaAs层,产生的Ga空位和As空位个数相同,远远多于Al空位;在InGaAs层,In空位个数最多,Ga空位和As空位个数依然相同。这是由于Al原子的位移阈能较大,In原子的位移阈能较小,产生的空位个数与原子位移阈能密切相关。
3 结 论
本文基于SRIM软件计算了不同能量的C离子在AlGaAs/InGaAs异质结中的平均投影射程和辐照损伤区,发现当C离子能量为800keV时,辐照损伤区在异质结处,并且在异质结处产生的空位缺陷最多。随着入射离子能量的增加,电离能比例增加,非电离能比例降低,电离能损主要由入射离子产生,声子能损主要由反冲原子产生。
参考文献:
[1]卢万杰. 空间目标态势认知与服务关键技术研究[D]. 郑州:战略支援部队信息工程大学, 2020.
[2]王一凡. AlGaN/GaN HEMT在电场与温度作用下辐照损伤效应研究[D]. 哈尔滨:哈尔滨工业大学, 2022.
[3]张佳佳,丁芃,靳雅楠,等. A comparative study on radiation reliability of composite channel InP high electron mobility transistors[J]. Chinese Physics B, 2021, 30(7):137-142.
[4]钟英辉,杨博,常明铭,等. Enhancement of radiation hardness of InP-based HEMT with double Si-doped plane[J]. Chinese Physics B, 2020, 29(3): 532-536.
[5]王海丽,吉慧芳,孙树祥,等.InAlAs/InGaAs/InAlAs量子阱质子辐照损伤机理[J].西安电子科技大学学报,2017,44(4):151-155+161.
[6]贾利芳,樊中朝,颜伟,等. GaN基HFET电力电子器件的研究[J]. 微纳电子技术, 2012, 49(11): 716-725.
[7]SAFONOV D A, KLOCHKOV A N, VINICHENKO A N, et al. Electron effective masses, nonparabolicity and scattering times in one side delta-doped PHEMT AlGaAs/InGaAs/GaAs quantum wells at high electron density limit[J/OL]. Physica E: Low-dimensional Systems and Nanostructures,2021(133): 114787.
[8]MOHAMMAD A A, ALI A R, CHRISTOPHE G. Small signal model parameters analysis of GaN and GaAs based HEMTs over temperature for microwave applications[J]. Solid-State Electronics,2016(119):11-18.
[9]DONG J H, CHEN X, HE W D, et al. A v-band integrated receiver front-end based on 0.15 µm gaas phemt process for passive millimeter-wave imaging[J]. IEEE Access 2022(10):59933-59941.
[10]李凌乐,陈子睿,文建湘,等.面向太空环境应用的抗辐照有源光纤特性研究[J].飞控与探测, 2022,5(3): 58-62.
[11]刘翠翠, 郭刚, 李治明,等. SiC MOSFET单粒子效应研究现状[J]. 核技术, 2022, 45(1):3-16.
[12]CHANG SUNGJAE, KIM DONGSEOK,KIM TAEWOO, et al. Mechanisms of the device property alteration generated bythe proton irradiation in GaN-Based MIS-HEMTs using extremely thin gate insulator[J]. Nanomaterials, 2023,13(5): 898-916.
[13]WAN P F, YANG J Q, YING T, et al.. Effects of ionization and displacement damage in AlGaN/GaN HEMTs devices caused by various heavy ions[J]. IEEE Trans. Nucl. Sci., 2021(68): 1265-1271.
[14]张正选,邹世昌.SOI材料和器件抗辐射加固技术[J]. 科学通报, 2017, 62(10): 1004-1017.
[15]段微波, 刘保剑, 庄秋慧等.应用于空间遥感系统的红外光学薄膜研究进展(特邀)[J]. 光子学报, 2022, 51(9): 11-27.
[16]YUE S H, LEI Z F, PENG C, et al. High-fluence proton-induced degradation on algan/gan high-electron-mobility transistors[J]. IEEE Trans. Nucl. Sci., 2020(67): 1339-1344.
[17]WANG Y S, LIU L, REN F, et al. Effect of electron irradiation on AlGaN/GaN and InAlN/GaN heterojunctions[J/OL]. J Vac Sci Technol B, 2013(31): 022206.
Effect of C Ion Irradiation on AlGaAs/InGaAs Heterojunction
Abstract:In this paper, the damage caused by C ion irradiation on AlGaAs/InGaAs heterojunction was investigated. The projection ranges of C ions and irradiation damage area with varying energies in the AlGaAs/InGaAs heterojunction were calculated by SRIM. In addition, the energy loss caused by 500keV, 800keV, and 1100keV C ions incident on the basic structure of AlGaAs/InGaAs heterojunction was also simulated. It was observed that with the increase of incident ion energy, the proportion of ionizing energy loss increases, while the proportion of non-ionizing energy loss decreases, and the ionizing energy loss induced is mainly comes from incident ion rather than recoil atom, while the phonon energy loss mainly comes from recoil atom rather than incident ion. Additionally, it was found that when using 800keV energy for C ions, the irradiation damage area is the heterojunction, and a higher number of vacancy defects are generated.
Key words: C ion radiation; AlGaAs/InGaAs heterojunction; ionization energy loss; non-ionizing energy loss; vacancies

