金属基极紫外光刻胶
陈昊,陈鹏忠,2,彭孝军,3
(1 大连理工大学精细化工国家重点实验室,智能材料化工前沿科学中心,辽宁 大连 116024; 2 大连理工大学宁波研究院,浙江 宁波 315016; 3 大连理工大学深圳研究院,广东 深圳 518057)
引 言
自1947 年贝尔实验室发明了第一支晶体管开始,集成电路产业历经七十多年的迅猛发展,已经彻底改变了人类的生活方式,与诸多领域的发展息息相关[1]。在集成电路的器件制造过程中,光刻(lithography)是其中最为关键的环节之一,决定了产品的最终性能。在光刻加工流程中,透过掩膜版的光照射在涂有光刻胶薄膜的硅晶圆上,引发光刻化学反应,实现曝光区域溶解性的改变,经过后烘(post exposure bake,PEB)、显影、刻蚀等过程之后,将掩膜版上的图案转移到硅片基底上[2](图1),最终经过后序工艺制备得到所需的微纳器件。
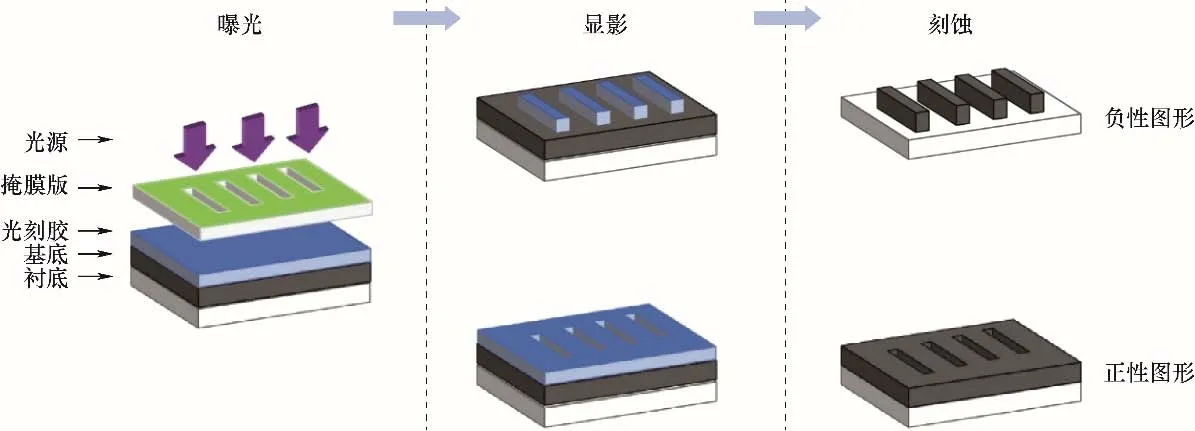
图1 光刻工艺示意图Fig.1 Schematic illustration of the photolithography process
光刻胶是光刻工艺的核心基础材料,主要成分由树脂、光敏剂、溶剂和其他助剂组成[3]。光刻胶溶剂主要为丙二醇甲醚醋酸酯(PGMEA),其作用是溶解或者分散光刻胶主体成分,使光刻胶具有一定的流动性;树脂和光敏剂是光刻胶具有光敏活性的主要组分,二者通常搭配使用,通过调节成分比例,实现对曝光光源的最优灵敏度。树脂主体发生光刻化学反应,并且在稳定剂、中和剂等助剂的协同作用下,得到预期的精细光刻图案。在过去的几十年里,芯片晶体管集成度伴随着与光刻图案最小特征尺寸的缩小而不断提升,大约每18 个月翻一倍,即遵循摩尔定律[4],其得益于光刻胶材料和光刻工艺的不断创新和发展。本文将简要介绍光刻技术及光刻胶的发展历程,着重论述最先进的EUV 光刻胶的设计和性能评价,以及EUV 作用下光刻胶发生光刻反应的机理,并探讨了光刻技术的未来发展和挑战。
1 光刻胶的发展历程
由瑞利公式可知,光刻图案的最小特征尺寸(critical dimension,CD)与光刻工艺因子k1和曝光波长λ成正比,而与光源镜头的角孔径θ和镜头-光刻胶膜之间介质的折射率n成反比关系。因此提升光刻图案分辨率最为有效的方法是缩短曝光波长[5]。光刻工艺的曝光波长先后经历了436 nm(G 线),365 nm(I线),发展到248 nm(KrF),193 nm(ArF),再到目前的13.5 nm(EUV)。与之对应的光刻胶在灵敏度、分辨率等方面不断地优化,以实现对曝光光源的最优匹配。

式中,NA 表示成像系统数值孔径。436 nm(G线)和365 nm(I 线)光刻工艺使用的光刻胶主体结构主要由光敏剂重氮萘醌(diazonaphthoquinone, DNQ)和酚醛树脂(novolac)组成,为紫外正性光刻胶。DNQ 中的重氮基团受到光照后发生Wolff 重排,生成烯酮,进一步转变成茚羧酸,使酚醛树脂在碱性显影液中溶解度升高(图2)[6-8]。Kahanna 等[9]在树脂中引入对甲苯酚、3,5-二甲苯酚、间苯二酚等组分,提高了光刻胶热稳定性和分辨率。20世纪80~90年代,G 线和I 线光刻是集成电路主流工艺,可分别实现0.5 μm以上和0.5~0.35 μm线宽图案[9]。

图2 重氮萘醌/酚醛树脂体系光刻胶示意图Fig.2 Schematic illustration of DNQ/novolac photoresist system
光刻工艺进入深紫外(deep ultraviolet, DUV)准分子激光KrF 248 nm 后,原来的酚醛树脂对光源有很强的吸收,并且DNQ 在248 nm 的光敏性也无法满足曝光需求。为了进一步提高敏感度,KrF 光刻胶开始采用化学放大原理[10-11],成分主要由光致产酸剂(photo acid generator,PAG)和含有酸不稳定保护基的聚合物以及一些助剂组成。化学放大光刻胶(CAR)中的PAG 在光照下产生光酸,光酸在脱掉聚合物中保护基团的同时,又会继续产生酸(H+),继续脱掉聚合物中的保护基团,而脱掉了保护基团的聚合物可以溶解于碱性的显影液中,所以只需要较低的光剂量来产生最初少量的光酸,就可以引发完整的光刻反应[12-13]。最早出现的CAR是由聚4-叔丁氧基羰氧基苯乙烯(4-tert-butoxycarbonyloxystyrene,PBOCST)和PAG 三苯基硫六氟锑酸盐组成[14]。PBOCST 聚合物上连接亲脂性叔丁氧羰基(tbutyloxy carbonyl,t-BOC)作为保护基使其不溶于碱性显影液。而PAG 在光照后产生酸(H+),催化t-BOC 基团脱保护后,使PBOCST 溶解于碱性显影液中。与此同时,新的酸(H+)会继续产生并催化反应,直到反应结束(图3)。为避免酸扩散程度过大,通常需要在CAR 中加入一定浓度的碱,与H+结合中止反应,提高图像的对比度,可实现0.25~0.13 μm 工艺节点。

图3 PBOCST光刻胶实现化学放大的原理Fig.3 The principle of PBOCST chemical amplification photoresist
当曝光波长进一步缩小至193 nm(ArF)后,由于PBOCST树脂的芳香结构对193 nm光具有很强的吸收,无法用于193 nm 的光刻工艺。聚甲基丙烯酸甲酯(polymethyl methacrylate,PMMA)对193 nm 的光基本透明,是构筑ArF 光刻胶的基础材料[15]。为了增强PMMA 的抗刻蚀性,研究人员将PMMA 主链和侧链基团进行结构改性,例如在侧链连接降冰片烯和金刚烷等脂肪环,制备多元共聚PMMA,或者利用脂肪环替换柔性的丙烯酸酯主链。由此得到的光刻胶材料抗刻蚀性可达到248 nm PBOCST 光刻胶水平[16]。193 nm光刻工艺采用的光致产酸剂主要是硫盐或碘盐系列,抗衡离子为磺酸根负离子,同样可实现化学放大效果(图4),可实现65 nm 工艺节点。

图4 193 nm光刻胶和193 nm浸没式光刻胶中PAG和聚合物的化学结构Fig.4 The chemical structure of PAG and polymer in 193 nm and 193 nm immersion photoresist
进入21世纪初,中国台湾积体电路制造股份有限公司(TSMC)提出了193 nm 浸没式(193 immersion,193i)光刻工艺的概念,并由荷兰阿斯麦尔公司(ASML)成功推出了首台193 nm 浸没式光刻机,其核心是在透镜元件和光刻胶膜之间使用折射率大于空气的水(n= 1.44)作为介质,可使成像系统的数值孔径NA 大于1,增加焦深(depth of focus,DOF),理论分辨率提升44%[17]。而193i光刻工艺所需的材料在原来干式光刻的基础了进行了诸多改进,例如在光刻胶上引入隔水涂层以避免水分子对光刻材料的影响[18],采用大分子疏水性PAG 降低酸(H+)向水体系的扩散[19](图4),加入碱中和剂降低酸(H+)扩散程度等,可实现10 nm 工艺节点,如果采用多重曝光等技术可实现7 nm工艺节点(图5)[20-21]。

图5 光刻特征尺寸与光源波长的发展[21](R表示分辨率,k为工艺参数)Fig.5 The development of lithography critical dimension and light source wavelength[21]
为了延续摩尔定律,根据国际半导体制造技术联盟制定的半导体技术路线图(ITRS),13.5 nm 极紫外光(EUV)被选作下一代光刻技术使用的光源,EUV光刻机已在ASML 公司实现了产业化(图6)。EUV(13.5 nm)比DUV(193 nm)波长减少一个数量级,根据式(1),其可实现的关键线宽大幅缩小。光源系统的进步,对EUV 光刻胶材料提出了更高的要求。目前产业上主流的化学放大型光刻胶在EUV 应用上有很大的局限性[23-29],研发新型的专用EUV 光刻胶已迫在眉睫,但是面临诸多挑战。

图6 ASML公司的193 nm浸没式光刻机和EUV光刻机[22]Fig.6 193 nm immersion and EUV lithography machine from ASML[22]
2 EUV光刻胶的挑战
目前,产生EUV 光的技术方案主要有自由电子激光器(FEL)、激光等离子体(LPP)和气体放电等离子体(DPP)等,技术复杂,设备昂贵,并且EUV 光能量利用率低。而且当曝光波长从193 nm(6.4 eV)转为13.5 nm(92 eV)时,光刻反应的机理发生了彻底改变,从光化学转变为辐射化学,机理尚不明确。由于92 eV 的EUV 光子能量远大于光刻胶分子电离势,当EUV 作用于光刻胶材料后,光子的吸收,高能电子的产生、衰减[30],二次电子引发的光刻化学反应等一系列过程需要探索。
为了满足芯片的大规模生产(high volume manufacturing, HVM),EUV 光刻胶需要达到更高的服役性能,面临着RLS 的挑战:分辨率(resolution,R),即关键线宽(CD)<20 nm;线宽粗糙度(line width roughness, LWR),即LWR<CD 的20%;光敏性(sensitivity,S),即 光 剂 量<20 mJ/cm2[31]。传 统CAR 中酸(H+)的迁移以及聚合物体系较大的尺寸,使传统CAR 已经无法满足EUV 光刻胶对分辨率和线宽粗糙度的要求,所以新型EUV 光刻胶的尺寸需要尽可能地小[32]。
非化学放大(n-CAR)体系光刻胶失去了光子“重复利用”的机制,降低了光子的使用率;EUV 光的单个光子能量高,在曝光量相同时,EUV 光子的密度只有193 nm 光子密度的约1/14,这就导致了随机效应的产生,因此要求EUV 光刻胶具有更高的灵敏度[33-35],而C、H、N 等元素对13.5 nm 几乎没有吸收[36]。
另外,不足20 nm的CD限制EUV光刻胶的膜厚度,防止图案在显影时因显影液的表面张力而塌陷(图7)[37]。但是在降低膜厚度的同时,光刻胶薄膜在刻蚀工艺中可以保护图案下的硅晶圆,这对光刻胶膜的抗蚀性也有了更高的要求。与此同时,因为EUV 对空气有很强的吸收,所以曝光在真空下进行,这就要求EUV光刻胶在曝光时的产气量较低。

图7 显影时较厚的膜导致图案因显影液的表面张力而倒塌Fig.7 Thicker films cause the pattern to collapse due to the surface tension
目前已报道的EUV 光刻胶类型主要包括聚合物基光刻胶[38-39]、有机分子玻璃光刻胶[40-41]、金属基光刻胶[5,42-44]等。聚合物基光刻胶是将含有高EUV吸收元素基团和光致产酸剂引入到聚合物侧链,改性后材料的EUV 吸收效率有望显著提高。与聚合物相比,有机小分子光刻胶具有单分散的结构基元,便于精准合成,可保障批次稳定性,同时避免了聚合物材料体系分子链的缠绕和膨胀,有利于降低线边缘粗糙度(LER),提高光刻图案分辨率。相比于聚合物和有机分子玻璃,金属基光刻胶得到了更为广泛的研究,主要是由于金属基光刻胶的尺寸小、EUV 吸收率高以及抗刻蚀性强。尤其是含有d轨道电子的Sn、Sb、Te等元素,其对EUV的吸收截面积是碳的十几倍(图8),可以弥补因为化学放大机制的失效而降低的光敏性。目前构建金属基光刻胶的方案主要有金属氧簇(metal-oxo clusters,MOCs)[46-47],金属氧化物纳米粒子(NPs)[48-49],金属-有机小分子[50](molecular organometallic resists for EUV, MORE)。EUV 与光刻胶的作用过程可以利用电子束光刻进行模拟,在一定程度上有助于EUV 光刻胶性能的研究。除了研究光刻胶的服役性能(分辨率、线宽粗糙度、光敏性、抗刻蚀性等),文献中以不同能量的电子(20~30000 eV)来辐照光刻胶的薄膜,通过X射线光电子能谱(XPS)、红外光谱(IR)、原子力显微镜(AFM)、扫描电子显微镜(SEM)等实验来观察并量化光刻胶薄膜在曝光前后、显影前后的元素含量、价键等关键信息的变化,试图分析光刻胶薄膜与EUV 的作用机理,就可以根据对光刻胶服役性能的要求来设计光刻胶的分子结构和配方[51-57]。

图8 对EUV光的吸收横截面积[45]Fig.8 Absorption cross-sectional area for EUV light[45]
3 金属基光刻胶
3.1 金属氧簇光刻胶
金属氧簇最大的优势就是其结构可以准确确定,粒径很小且统一,只有1~2 nm,可以满足EUV光刻胶对线宽粗糙度的要求。同时,结构中一般含有多个金属原子,光敏性更好。在曝光时,金属氧簇会形成金属氧化物(MOx)聚合物或者金属-有机聚合物,溶解度降低,所以一般为负性光刻胶[45]。其抗刻蚀性也高于传统的有机聚合物,可以满足膜厚度的要求[58-60]。另外,金属氧簇在吸收EUV 光后,自身直接聚合,导致溶解度转变,所以光刻胶中组分比较单一,相比于CAR 含有光致产酸剂(PAG)、聚合物、碱性添加剂等多种组分,在实际生产和应用中有较大的优势[61-62]。下文将从团簇中含有的金属进行分类,介绍当前的研究进展。
3.1.1 锡-氧团簇光刻胶 金属锡(Sn)对EUV 的吸收截面积是碳的10.5 倍[61]。团簇中,每个Sn 原子上连接一个烷基链,一般6 个或12 个锡原子通过氧原子相连,形成带电或者不带电的团簇核心(图9)。

图9 几种常见的锡-氧团簇[62-64]Fig.9 Several common tin-oxygen clusters[62-64]
Cardineau 等[61]以Sn12作为研究对象探究EUV 光刻性能。Sn12团簇含有12个Sn原子,每一个Sn原子上连接一个有机配体,通过氧原子连接成一个球状的团簇核心,带有两个正电荷,需要两个抗衡阴离子(counter-ion)X-。他们测试了不同抗衡阴离子的Sn12团簇在曝光时CD 达到50 nm 时所需要的光剂量(Esize)。结果显示Esize与X-中活泼氢的键能之间无必然联系,而与X-的分子量呈现相关性,说明Sn12在曝光时,X-并不发生光刻反应,而是仅仅作为非反应性的间隔基团。同时测试了Sn12含有不同有机配体(丁基、烯丙基、苯基)时的Esize,发现配体的C—H 键能越低,光敏性越强,其中烯丙基Sn12具有最强的光敏性。
Bespalov 等[36]用低能电子显微镜(LEEM)模拟了光刻胶薄膜在曝光时激发出的二次电子(Eland= 0~40 eV),对Sn12光刻胶进行了曝光实验。发现能量低至1.2 eV 时的电子可引发明显的化学变化,光刻胶薄膜转化成较低交联度的低聚物B。而随着电子进一步的累积,光刻胶材料交联度更高,生成了更致密的膜C,这可能是由于Sn—C 键的断裂引起的碳损失和SnOx无机聚合物的形成所导致的(图10)。另外,还估计每个Sn12分子需要少于10 个2~38 eV 的电子来实现溶解度转换,这相当于每个电子的平均反应体积为0.15 nm3。
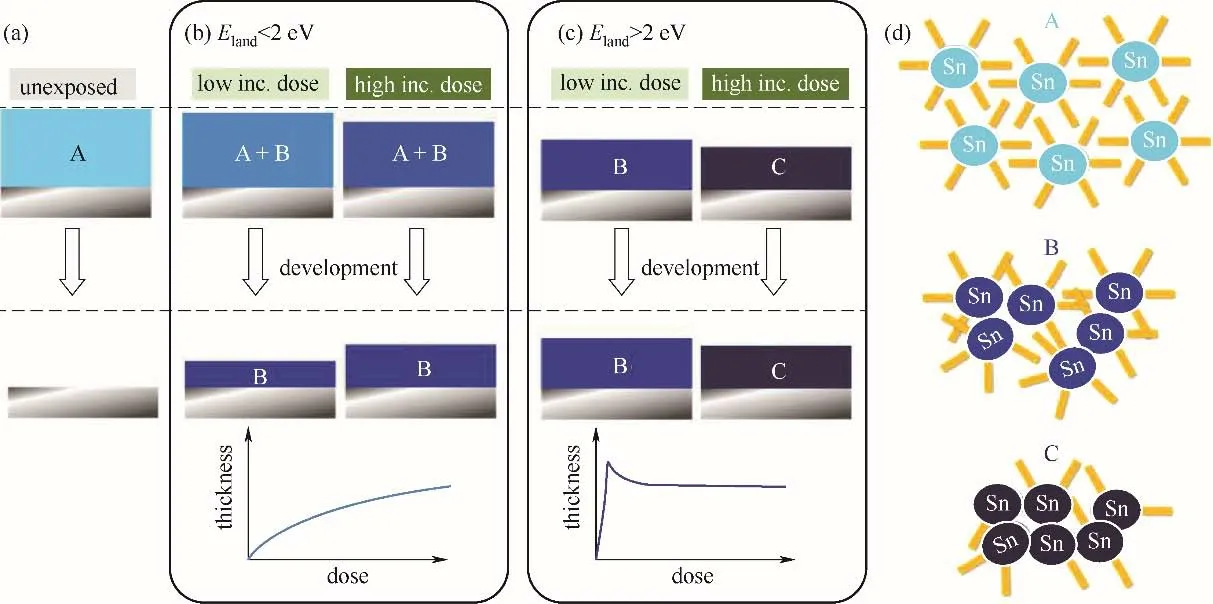
图10 光刻胶膜从A→B→C的转变示意图[36]Fig.10 Schematic illustration of the transition of photoresist film from A→B→C[36]
Frederick 等[64]报道了具有Keggin-NaSn13结构特性的光刻胶材料,其结构的中心有1个钠离子,13个Sn原子通过氧原子连接成团簇,每一个Sn原子上都有一个丁基配体。团簇是电中性的,不需要阴离子来平衡电荷。他们用低动能电子(Ekin= 80 eV)模拟了光刻胶膜在曝光时产生的二次电子,并分别在超真空(UHV)和氧气(PO2=1×10-7Torr,1 Torr=1.33322×102Pa)环境下进行了电子激发脱附实验(ESD),检测薄膜在曝光时脱附的物质。实验表明,氧气的存在会增加丁基的脱吸附,而减少含氧化合物的脱吸附。
在上述工作的基础上,Diulus 等[65]进一步直接使用Al KαX 射线作为光源(Ekin=1486.6 eV),并分别在超真空(UHV),氧气(PO2=1 mbar, 1 mbar=100 Pa),水(PD2O= 1 mbar),甲醇(PMeOH= 1 mbar),氮气(PN2= 1 mbar)环境下对Keggin-NaSn13进行曝光实验。他们对比了五种环境下光刻胶的D0和D100值(表1),(D0和D100分别是引起光刻胶薄膜厚度发生变化的最低和最高光剂量)。结果表明,与超真空(UHV)相比,氧气环境下所需的光剂量更低,灵敏度更高。D2O 或MeOH 与低能电子(40~100 eV)的相互作用可能产生反应性羟基物质,会氧化光刻胶并影响光刻胶的灵敏度。但是,D2O 和MeOH 都需要增加溶解度转变所需的剂量,结果降低了光刻胶的敏感性。可能是因为氢供体的存在,导致了氧化和还原Sn之间的竞争机制,也可能在表面上形成有害的碳氢化合物或醇,降低了光刻胶的灵敏度。在XPS 中也观察到了C—O 的增加,说明了膜中生成或者吸附了醇。而N2作为惰性分子,会吸收光子或者清除二次电子,从而导致灵敏度降低。

表1 五种环境下Keggin-NaSn13光刻胶的D0和D100值Table1 D0 and D100 values of Keggin-NaSn13 photoresist in five environments
他们结合前期实验结果,提出了Keggin-NaSn13光刻反应的原理(图11),曝光时产生的二次电子可能导致Sn—C 键的断裂,或者在氧气环境下生成活性氧;配位不足的Sn离子直接与相邻的团簇发生反应,生成Sn—O—Sn无机网络聚合物;而活性氧与丁基发生抽氢反应,形成自由基,接着发生自由基偶联反应,形成金属-有机聚合物,达到溶解度转变的目的。

图11 Keggin-NaSn13发生光刻反应的机理示意图[65]Fig.11 Schematic illustration of photolithographic mechanism of Keggin-NaSn13[65]
Sharps 等[66]对比了三种不同的锡-氧团簇(分子)(图12),其结构中的羧酸以三种不同的方式与Sn 相连,进行了曝光实验,得到了敏感度曲线。结果表明,团簇1 所需要的光剂量最低,光敏性越好,这可能是因为含有最多的Sn 原子,并且羧酸与Sn 的结合力也最弱。XPS 实验表明,在曝光后的每个样品中都有至少50%的丁基配体的残留,而AFM 图像和价带X 射线光电子能谱(VB XPS)数据表明,1 和2 的薄膜几乎没有发生形貌和电子结构上的变化,并生成了相似的结构。1 和2 薄膜的选区电子衍射(SAED)轮廓中没有衍射点或环,这表明材料是无定形的;透射电子显微镜(TEM)图像也只显示出较小的结晶区域。所以,团簇在曝光时更可能形成的是金属-有机交联的聚合物,而不是致密的金属氧化物。

图12 三种锡-氧团簇的化学结构[(a)~(c)];三种锡-氧团簇的敏感度曲线(d)[66]Fig.12 Chemical structures of three tin-oxygen cluster[(a)—(c)];their sensitivity curvers(d)[66]
Kenane等[67]报道了一种含有2个Sn原子的团簇Sn2,在旋涂后将样品浸泡在氨水中,将样品中的Cl-置换成OH-,避免Cl-影响实验结果。在400 μC/cm2的光剂量下(Ekin= 30 kV),得到了8 nm 的线条(间隔60 nm),发现曝光和显影之间的时间间隔对溶解度转变率(dissolution rates)有很大影响。在程序升温脱附-质谱(TPD-MS)实验中,H2O 和丁基信号因时间间隔引起了相似的迁移,证明了丁基分解时产生了水;而时间间隔使CO2的TPD-MS 实验中新出现了HCO-3和CO2-3的峰,推测光刻胶膜吸收了CO2,并形成碳酸(氢)盐(图13),而这种碳酸盐桥的极性会降低Sn—C 键的强度,可能是导致TPD-MS 实验中信号峰左移的原因。并且PEB 的温度越高,吸收的CO2越多,这都在一定程度上减少了所需的光剂量,提高了光敏性。

图13 锡-氧团簇吸收CO2并生成碳酸盐的示意图[67]Fig.13 Schematic illustration of tin-oxygen clusters absorbing CO2 and forming carbonates[67]
Wang 等[68]报道了一系列由吡唑及其衍生物作为配体的、没有烷基链与Sn原子相连的锡-氧团簇,TOC-22、TOC-37、TOC-38、TOC-39(图14)。这种无烷基锡-氧团簇的优点是毒性小,Sn、O相对含量大,结构简单有利于机理的研究。其中TOC-38 有着很好的成膜性,均方根粗糙度Rq= 0.31 nm,且光刻效果良好,可在100 μC/cm2的电子束曝光下实现50 nm线宽的分辨率。相比于配体结构相似的TOC-37和含Sn无机核更大的TOC-39,TOC-38拥有很好的成膜性和光刻效果的原因,可能与团簇的堆积方式有关。TOC-38 的4-甲基吡唑配体恰好可以紧密地交织在一起,使团簇的堆积方式更为紧密,TOC-38的溶剂可及体积比(solvent-accessible volume ratio,SAV)仅为2.9%,而TOC-39 的SAV 为17.1%(图14)。这也为预测光刻胶分子的成膜性和光刻表现提供了新的方法和思路。

图14 TOC-22(a)、TOC-37(b)、TOC-38(c)、TOC-39(d)的结构示意图和堆积方式示意图[68]Fig.14 Schematic illustration of the structure and packing models of TOC-22(a),TOC-37(b),TOC-38(c),TOC-39(d)[68]
3.1.2 其他金属团簇光刻胶 除了常见的Sn原子,其他金属原子例如Zn、Zr、Sb 等同样对EUV 有很高的吸收(图8)。这些金属形成的团簇具有类似于锡-氧团簇的优异性质,可为研究曝光反应的机理提供新的思路[69-71]。
Jiang 等[72]以6 个Zr 原子为核、12 个甲基丙烯酸为配体的金属团簇ZrMc 为母体,引入F 元素,以三氟甲基丙烯酸代替原先的配体,制备得到ZrMcF。F元素的引入将团簇的EUV 吸收系数提高了10%,曝光效果也有明显的提升,在36 mJ/cm2剂量下完成30 nm 线宽分辨率。XPS 实验结果显示,C 1s →π*(C C)的信号下降速率明显变快,团簇的光敏性显著增加。在曝光时ZrMcF的C—F键几乎全部断裂,并形成了Zr—F 键,而在此过程中产生的自由基将引发交联反应,使溶解度降低。
Wu 等[73]继续在ZrMc 的基础上引入咔唑的衍生物作为配体,得到了一种具有一定程度荧光特性的团簇ZrMC-CB。敏感度曲线显示,ZrMC-CB 的敏感度大幅下降,推测可能是空穴被束缚在咔唑上,或者是配体使分子间的距离增加,阻碍了聚合反应(图15)。IR、紫外-可见吸收光谱(UV-Vis)和荧光光谱(FL)表明,大部分咔唑的结构完好无损,但是荧光强度有所下降,可能是在EUV 曝光后,会形成部分荧光量子产率低于完整配体的咔唑衍生物。由于EUV 照射导致Mc 配体部分丧失后,无机核充当电子受体,因此咔唑单元的激发态通过电子转移弛豫,这是与发射弛豫竞争的路径。这可以解释荧光强度随着剂量的降低而逐渐降低。在低剂量下,会发生脱羧和交联反应,一旦末端双键耗尽(曝光剂量高于D100),进一步的脱羧和后续过程促使荧光猝灭。

图15 ZrMC-CB发生光刻反应的机理示意图[73]Fig.15 Schematic illustration of lithographic reaction mechanism of ZrMC-CB[73]
Thakur 等[31,74]以4 个Zn 原子为核、12 个三氟乙酸(TFA)为配体的金属团簇为母体,并用甲基丙烯酸(MA)部分取代原来的配体,得到Zn(MA)(TFA)(图16),可在15 mJ/cm2剂量下实现30 nm 线宽分辨率,灵敏度优于ZrMcF。UV-Vis 和傅里叶红外光谱(FTIR)表明在曝光后C C 的信号随着曝光剂量增加而明显下降,说明发生了交联反应。XPS 实验结果显示,Zn—O 信号增强,说明了团簇聚集成ZnOx。而C—F 键信号在曝光后减少50%,同时出现了Zn—F 信号,所以F 原子在曝光时转移到了无机核中,并产生了自由基,引发了自由基聚合反应。
Rohdenburg 等[75]对两种含锌金属团簇Zn(MA)(TFA)和Zn(TFA)进行了研究,分别用能量为80 eV和20 eV 的电子模拟EUV 和EUV 曝光时产生的二次电子,并通过质谱来监测在辐射过程中薄膜解吸的挥发性物质。结果发现,解吸的气体主要是CO2,而在相同的剂量下,相比于80 eV 的电子,20 eV 的电子引发配体断裂的效率较低,但两者仍保持在同一个数量级上。而反射吸收红外光谱(RAIRS)表明,在辐照期间,C C 信号比羧酸中的C O 信号消失得更快,说明金属团簇在辐照时发生了链式反应,促进溶解度转换。
Thakur 等[74]在上述含锌金属团簇的配体中引入2-(三氟甲基)丙烯酸(TFMA)(图16),得到了一种新的团簇Zn(TFMA)。因为氟原子的引入增强了团簇的疏水性和电负性,使得其在空气中的稳定性增强。虽然氟原子的引入使Zn(TFMA)的EUV 吸收系数提高至14.3 μm-1,高于Zn(MA)(TFA)的10.6 μm-1,但是Zn(MA) (TFA)在对比度曲线中的表现更好,可能是因为TFMA配体中C C的电子云密度因为CF3而变低,降低了TFMA 配体发生共聚反应的速率。与之前的发现一样,XPS 和扫描透射X 射线显微镜(STXM)的结果表明,随着曝光剂量的增加,C—F 键的断裂和Zn—F 的生成,再次印证了在EUV 辐照下薄膜发生了自由基诱导的聚合反应,使溶解度产生了变化。基于此,他们提出了一种Zn(TFMA)在曝光时发生光刻反应的机理(图17)。Zn(TFMA)除了会发生羧酸配体的分解和聚集,C—F 键也会发生断裂,生成新的自由基。

图16 不同配体的含锌团簇的结构示意图[74]Fig.16 Schematic illustration of chemical structure of zincbased clusters with several ligands[74]

图17 Zn(TFMA)发生光刻反应的机理示意图[74]Fig.17 Schematic illustration of lithographic reaction mechanism of Zn(TFMA)[74]
Wu 等[76]合成了一系列以8 个Ti 原子为核、含有不同芳香结构的羧酸为配体的含Ti 金属氧团簇Ti8L16。配体中不同的芳香结构,可以调节材料的HOMO 能级。HOMO 升高,降低了光刻胶在曝光时的电离能,并产生自由基阳离子,以此用于探索掺杂了芳香结构的配体对电离和电离产物的影响,进而理解曝光时的化学过程。使用真空紫外-质谱(VUV-MS) 进行光碎裂研究证明,具有芳香结构的有机配体可以降低材料的光电离阈值并稳定被电离的活性物质。Ti8L16仅在超过11 eV 能量的光照射时发生解离电离,而掺杂了配体之后,可在2.0~2.5 eV能量的光照射时发生解离电离。
Frederick 等[77]对HfSOx进 行 了 程 序 升 温 脱 附(TPD)、ESD 和X 射线全散射(XTS)等实验,以Ekin=80 eV 模拟了HfSOx在EUV曝光时产生的二次电子。实验结果表明,在曝光时硫酸盐配体不发生作用,仅作为间隔基;而过氧化物配体以O2的形式解吸,剩下未配位的Hf,然后发生缩合反应形成Hf—O—Hf的交联网络,导致溶解度下降。
3.2 金属氧化物纳米粒子光刻胶
Ober 课题组报道了金属氧化物纳米粒子在EUV 光刻胶中的应用。金属氧化物纳米粒子一般由金属氧化物MOx的核和有机羧酸配体的壳组成。反应机制是曝光时纳米粒子发生聚集,溶解度降低,成为一种负性光刻胶(图18)。纳米粒子核中的金属对EUV 有较强的吸收,而纳米粒子的粒径及粒径分布决定了光刻效果,粒径越小分布越窄越有利于获得高分辨和低LWR 的图案。粒径在3 nm 以下的纳米粒子光刻胶有望获得20 nm 以下的分辨率,而含有双键的羧酸配体也可以在一定程度上提高光刻效果。其合成的ZrO2-NP 和HfO2-NP 的纳米粒子可以在4.2 mJ/cm2剂量下实现26 nm 线宽的分辨率[78-81]。

图18 金属氧化物纳米粒子光刻胶发生光刻反应的机理示意图[81]Fig.18 Schematic illustration of lithographic mechanism of metal oxide nanoparticle photoresist[81]
Mattson 等[82]合成了两种Hf 基金属氧化物纳米粒子,HfMAA 和HfIBA,并发现前烘处理会导致羟基的损失、Hf—O 键的形成以及部分甲基丙烯酸酯配体的桥接-螯合转变,使部分薄膜的溶解度降低,这不利于之后的图案化。所以在不进行PAB 的情况下进行了后续实验。基于同步加速器的红外显微光谱显示,甲基丙烯酸配体(MAA)在吸收EUV 后产生阳离子自由基并分解成CO2和丙烯基自由基,并引发了交联过程。而生成的自由基继续与烯丙基发生交联反应,形成更大的交联结构。
Ober 课题组[83]合成了一种以ZnOx为核、甲基丙烯酸为配体的纳米粒子光刻胶ZnO-MAA-NP。DLS测试表明其粒径在0.9~3 nm 之间,小于之前报道的以HfO2为核的纳米粒子(3~4 nm),并且粒径分布窄。在DUV(248 nm)曝光时,150 mJ/cm2光剂量下实现500 nm线宽分辨率,带有PAG的ZnO-MAA-NP曝光后的图案发生了坍塌和短路,而带有光自由基发生器(photo-radical generator, PRG)的ZnO-MAA-NP有很好的表现,可能是因为PRG 可以引发有机配体的双键发生聚合反应,提高了光刻效果。
3.3 金属-有机小分子
金属-有机小分子是构建EUV 光刻胶的另一种策略,既可以单独作为光刻胶主体,也可以连接在聚合物上发挥作用,是降低LWR的策略之一[84]。
Belmonte 等[85]合成了一种新型含锡杂化聚合物光刻胶MAPDST-co-ADSM,经过电子束曝光(EBL)和氦离子曝光(HIBL)的分辨率可分别达到14 nm 和12 nm。XPS 结果显示,不稳定的硫盐在EUV 曝光下部分损失,但是在曝光10 min 后,仍存在C—S和信号。XPS 结果显示,在曝光后出现了对应于SnO 和SnO2的信号峰,信号峰的强度随着曝光时间的延长而不断增加,同时也观察到了Sn—C 和Sn—O 的断裂。S—C 键信号的明显增加以及S 2p信号基本保持稳定,说明在曝光时膜的结构发生了明显的重排。
Peter 等[86]报道了三种有机-无机杂化非化学放大共聚物光刻胶(n-CAR),是通过含光敏硫有机单体MAPDST 与含Sn 单体ADSM 在不同进料比下的自由基共聚制备合成的(图19)。这些共聚物在电子束曝光下可实现小于15 nm 线条分辨率。不同的ADSM 进料比会生成不同锡含量的MAPDST-co-ADSM 共聚物,导致灵敏度的变化。新的官能团与C—S、C—F 等在曝光区域键合,这表明光刻胶从亲水性(离子)整体转变为疏水性(共价),可以实现良好的12 nm负性图案。

图19 MAPDST-co-ADSM的合成步骤示意图[86]Fig.19 Schematic illustration of the synthesis steps of MAPDST-co-ADSM[86]
Enomoto 等[87]合成了一种利用极性变化和自由基交联的负性n-CAR 光刻胶,由作为极性改变剂和自由基产生剂的三芳基硫阳离子、作为自由基产生剂的2-羟基-2-甲基苯乙酮和作为EUV 吸收增强剂的三苯基(4-乙烯基苯基)锡烷(TPSnSt)组成。TPSnSt 使光刻胶的EUV 吸收系数提高了约30%,灵敏度提高了2.5倍(Esize降低了60%)。
Passarelli 等[88]合成了一系列含锑金属有机小分子[R3Sb(O2CR′)2],并进行了光刻实验(图20),其中JP-20 具有较好的效果,可在5.6 mJ/cm2光剂量下实现35 nm 线宽分辨率。通过相互比较,R′中含有可聚合取代基的光刻胶光敏性更强(Esize低),而光敏性随着R′体积的增加而减弱。

图20 [R3Sb(O2CR′)2]光刻实验的结果[88]Fig.20 The lithographic effect of[R3Sb(O2CR′)2][88]
Hasan等[89]对将曝光后的JP-18和JP-30薄膜从硅晶圆上刮下来进行了凝胶渗透色谱分析,发现剂量和低聚物峰值增长之间具有强相关性,证明了EUV 曝光后聚合,产生高分子量产物。Murphy 等[90]利用同位素标记与EUV 曝光时放气相结合,以确定在曝光过程中薄膜产生的气体是如何产生的。产生苯所需的氢只有约15%来自光刻胶分子本身,有80%以上来自于空气。通过将不同位置的氢取代为氘,提出了[R3Sb(O2CR′)2]在曝光时生成苯或者苯酚的机理(图21)。

图21 [R3Sb(O2CR′)2]发生光刻反应的机理示意图[90]Fig.21 Schematic illustration of lithographic mechanism of[R3Sb(O2CR′)2][90]
4 基于6.x nm波长的光刻技术
纵观整个光刻工艺的发展史,光源的波长永远是决定材料和设备的基准,科学工作者们对6.xnm波长的光源(beyond extreme ultraviolet, BEUV)以及光学器件同样产生了兴趣[91-95]。高度电离的Gd 和Tb 等离子体是BEUVL 光源的主要候选者[96-97],可以在La/B 多层镜的反射区域内产生强烈的发射,其近垂直入射反射率理论上可以达到80%[98-100]。
Oyama 等[101-102]对EUV、BEUV 和更短波长的几种光刻胶的敏感性进行了开创性研究。Anderson等[103]比较了两种已经商业化的极紫外CAR在BEUV的敏感度,发现其敏感度只有原来的1/6,这可能和传统C、H、N 等元素在BEUV 下吸收效率进一步降低有关。Mojarad 等[104]对比了含Si 光刻胶HSQ 和一种极紫外CAR 在BEUV 下的光刻表现,单从剂量方面来说,HSQ 需要的剂量更小,展现出了更好的敏感性,在BEUV应用中具有很大的潜力。
5 结论与展望
金属基EUV 光刻胶可以解决传统有机CAR 在EUV 工艺下遇到的难题,有望在EUV 工艺中实现5 nm以下工艺节点。但是在光刻胶的研发与应用中,金属基EUV 光刻胶仍面临许多挑战。金属基光刻胶在EUV 下发生光刻反应导致溶解度转变的机理尚不清楚,需要加强该领域的应用基础研究,进一步明确EUV 光刻胶分子的设计原理。在实际生产中,金属基EUV 光刻胶的服役性能与光刻胶结构的关系尚不清楚,尤其R(resolution)-L(line of width roughness)-S(sensitive)之间的相互制衡(trade-off),以及抗蚀性、曝光产气控制和随机效应等是其产业应用之前必须解决的难题。
除了加强EUV 光刻胶的前沿技术研究,我国同样亟需突破高端KrF、ArF 光刻胶技术封锁,掌握自主知识产权,这是我国集成电路产业健康可持续发展的关键,因为一条完整的半导体生产线上需要数十支光刻胶的相互配合,任何一支光刻胶出问题都会影响产品的良率和性能。而要实现光刻胶产业自主可控,需要持续加大研发力度,整合企业和高校资源,建立世界级光刻胶研发平台,实现光刻胶理论基础、应用性能和服役特性的贯穿式研究。

