感光栅极GaN基HEMT器件的制备与栅极优化
朱彦旭, 李赉龙*, 白新和, 宋会会 , 石 栋 , 杨 壮 , 杨 忠
(1. 北京工业大学 光电子技术教育部重点实验室, 北京 100124;2. 中国移动通信集团广东有限公司 惠州分公司, 广东 惠州 516000)
1 引 言
近年来,铁电材料的红外器件研究十分活跃[1-4],由于铁电材料具有良好的压电、铁电、热释电、光电及非线性光学特性,以及能够与半导体工艺相集成等特点,在微电子和光电子技术领域有着广阔的应用前景,成为一种新颖的功能材料,受到人们的广泛关注和重视[5-6],其中,锆钛酸铅(PZT)铁电薄膜是迄今为止研究最多、应用最广的一类铁电薄膜材料。
PZT薄膜的反常光伏效应在一定波长的光照下可以产生稳定的光诱导电流和远大于晶体禁带宽度(Eg)的光生电压,尤为特别的是其光伏响应可以通过外加电场来进行调控,这些特点使其在红外光伏探测器领域有广泛的应用前景[7-9]。特别是与GaN基高电子迁移率晶体管(High electron mobility transistor,HEMT)器件相结合,由PZT薄膜的光电及热电特性将吸收的光子转换为电子,从而改变HEMT器件的栅压,使输入电流发生变化,达到对辐射光探测的目的。通过铁电材料不同性质与GaN基HEMT器件相结合所制备的红外探测器,其探测的红外波段非常宽广,从可见光至远红外波段都可以探测,而且,由于AlGaN/GaN 异质结利用自发极化和压电极化效应所形成的高密度二维电子气(Two dimensional electrongas,2DEG),其迁移率高达2 000 cm2/(V·s)[10],基于该特点,用AlGaN/GaN HEMT器件制备的探测器不仅灵敏度高、响应速率快,而且探测面积广泛,可以适应恶劣的环境。但是,GaN基HEMT器件自身的研究依然存在着很多影响器件性能的问题[11-13]。
本文将铁电薄膜PZT与AlGaN/GaN HEMT器件结合,在HEMT器件的栅极处淀积一层导电金属电极,其上淀积一定厚度具有光伏效应的敏感单元PZT,成功地制备出具有光敏感栅极的HEMT器件。并使用365 nm的可见光测试其I-V特性,通过改变HEMT器件栅极长度、栅极与漏极之间的距离等参数,分析光照后I-V曲线以及转移曲线的变化,从而达到优化光敏感栅极HEMT器件性能的目的。
2 感光栅极GaN HEMT器件制备与理论分析
2.1 器件制备
感光栅极HEMT的结构示意图如图1所示,外延片采用硅(Si)衬底AlGaN/GaN异质结外延片,其中GaN层厚度为1.7 μm,AlGaN层厚度为20 nm。感光薄膜PZT采用锆钛酸铅(PbZr0.52-Ti0.48O3)靶材,纯度99.99%,直径75 mm,厚度3 mm,铜背板厚度3 mm。器件制备工艺步骤流程图如图2 所示。

图1 感光栅极 GaN HEMT 器件结构示意图
Fig.1 Structure schematic of the photosensitive gate GaN based HEMT
具体制备工艺主要包括光刻套刻器件结构,反应耦合等离子体(ICP)刻蚀出有源区台面,等离子体增强化学气相沉积(PECVD)200 nm SiO2隔离保护有源区,溅射生长源漏电极(Ni/Au 50 nm/50 nm),源漏电极退火(高纯N2气830 ℃ 30 s),使其形成欧姆接触,溅射生长栅极电极(Ti/Pt 40 nm/200 nm),溅射制备感光栅极薄膜PZT。使用MSP-300B全自动磁控溅射镀膜机,采用斜靶溅射,衬底加温100 ℃,真空度为5×10-4Pa,工作气体为高纯Ar气,溅射功率100 W,工作气压1 Pa,溅射时长2 h,溅射厚度为350 nm。以650 ℃ 300 s进行退火使PZT薄膜极化,并且使栅极电极形成肖特基接触,而后溅射Ni/Cr(20 nm/200 nm)作为上电极金属,Ni/Cr合金具有较好的红外吸收能力,既可作为上电极也可作为吸收层以吸收一定波长的光,有利于光吸收和光探测[14-15],其中每一步电极的溅射制备与PZT薄膜的溅射制备均建立在套刻的基础上。感光栅极GaN HEMT器件实物图如图3 所示。
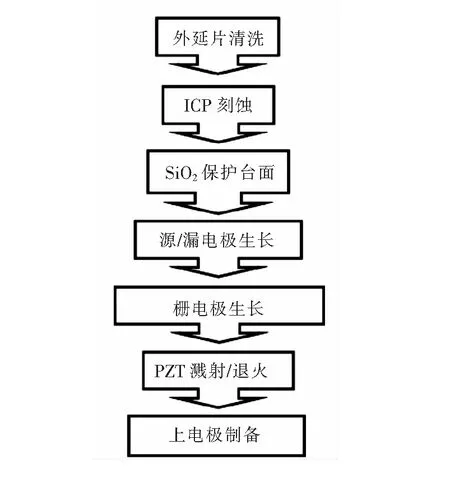
图2 感光栅电极 GaN HEMT 器件制备工艺流程图
Fig.2 Process flow chart of photosensitive device grid electrode GaN HEMT device

图3 感光栅极 GaN HEMT。 (a)测试样品;(b)测试单元。
Fig.3 Photosensitive gate electrode GaN based HEMT. (a) Test sample. (b) Test cell.
2.2 理论分析
AlGaN/GaN HEMT作为一种栅控器件,由AlGaN势垒层上的肖特基栅施加偏压来改变耗尽区的厚度,从而控制沟道2DEG及器件的工作状态。AlGaN/GaN异质结处的2DEG一方面受栅极电压的控制,一方面又非常接近表面,对表面的状态非常敏感,因此,可以通过改变栅压以及表面态两种方式来调控2DEG的浓度,从而改变源漏之间的电流[16]。
HEMT器件栅极上的光感应层PZT在受到辐射光的照射时会产生光伏效应,使感光层表面电荷发生变化,引起HEMT器件栅压的变化,从而导致半导体内2DEG浓度的改变,使器件源漏沟道的电流发生变化,达到对辐射光探测的目的。源漏沟道的电流受栅压变化的影响,而栅长的大小可以调控栅压对沟道电流的影响。减小栅长可以提高器件跨导,进而提高器件的栅控能力,同时器件阈值电压也发生变化,但是栅长过短会影响栅下电势的二维分布,并且导致漏致势垒降低效应(DIBL)[17],从而引起短沟道效应。本实验共设计6种器件参数,选取不同的栅长、源栅与栅漏间距,在统一测试条件下测试其光照后的I-V特性曲线以及转移特性曲线,分析在不同的器件参数条件下,感光栅极HEMT的光响应变化,从而达到优化器件性能和提高器件探测效率的目的。器件参数如表1、表2所示 。
制备的器件结构在显微镜下如图4所示。
表1不同栅长的3组器件结构参数
Tab.1 Different gate length of the three groups of device structure parameters

样品编号栅长Lg/μm栅源间距Lgs/μm栅漏间距Lgd/μmA1 34B2 34C3 34
表2不同栅漏间距的3组器件结构参数
Tab.2 Three different gate to drain pitch device structure parameters

样品编号栅长Lg/μm 栅源间距Lgs/μm 栅漏间距Lgd/μmD135E1310F1315

图4 6组不同器件结构的测试单元
3 结果与讨论
对制备的6种不同器件参数的感光栅极GaN HEMT器件在波长为365 nm的光照及无光照条件下进行I-V特性曲线以及转移特性曲线测试,其中Vgs为栅极电压,Ids为漏极电流,Vds为漏极电压。首先对不同栅长的3组器件A、B、C进行测试,转移特性中Vgs选取-4~2 V,I-V特性测试中Vds取0~15 V,Vgs取-2 V。测试所得I-V特性曲线以及转移特性曲线如图5所示。

图5 (a)不同栅长的器件对转移特性的影响;(b)不同栅长的器件对I-V特性曲线的影响。
Fig.5 (a)Effects of different gate length devices on the transfer characteristic curve.(b)Effect of devices with different gate lengths on theI-Vcharacteristic curve.
分析图5,其中虚线为器件A在无光条件下的曲线图,从图中可以明显看出,感光栅极GaN HEMT器件在365 nm的光照射下有明显的响应,在漏极电压达到10 V时,无光照时器件A的漏极饱和电流为16 mA,光照条件下提高至28 mA。分析其原因,首先为感光薄膜PZT 的光伏效应,另外,GaN基材料禁带宽度覆盖从可见光到紫外光的范围,365 nm的光为紫外光波段,激发了GaN基材料产生电子空穴对[18]。从图5(a)中可以看出随着栅长的增大,器件的阈值电压增大。另外从图5(b)中可以看出漏极电压达到10 V时,器件B、C的漏极饱和电流分别为23 mA、17 mA,随着栅长的增大,器件的漏极饱和电流减小,这是由于栅极越长,栅下方耗尽层宽度越大,使该处的2DEG浓度降低,导致漏极电流下降。栅长的增加同时又导致沟道电阻越来越大,载流子运输路径越来越长,以及膝点电压效应等,这些都将导致漏极电流下降[19-20]。

图6 (a)不同栅漏间距的器件对转移特性的影响;(b)不同栅漏间距的器件对I-V特性曲线的影响。
Fig.6 (a)Influence of devices with different gates and leeds on the transfer characteristic curve. (b)Effect of different gate-drain spacing devices on theI-Vcharacteristic curve.
其次对不同栅漏间距的3组器件D、E、F在相同的测试条件下进行测试,所得I-V特性曲线以及转移特性曲线如图6所示。
分析图6,其中虚线为器件D在无光条件下的曲线图,在漏极电压达到10 V时,其漏极饱和电流为9 mA,作为与光照条件下的器件曲线的对比,显而易见,器件D、E、F在波长为365 nm的光照射下有明显的响应。从图6(a)中可以看出,栅漏间距的变化对阈值电压的影响并不大,当栅极电压持续增大时,栅漏间距较大的器件漏极电流减小,这是由于栅漏间距增大,器件的等效电阻也增大,在相同的栅极电压下电流便减小。另外,图6(b)中在非饱和区,器件D、E、F的输出电流依次减小,这是由于漏极电压较小时,GaN基HEMT器件的耗尽层可以看作阻值受栅压控制的线性电阻器[21],当栅漏间距变小时,电阻越来越小,输出电流越来越大。当漏极电压越来越大,在漏极电压达到10 V时,曲线进入饱和区,此时器件D、E、F的饱和电流均在21 mA左右,变化并不大,这是由于漏极电压的增大导致了类似于MOSFET预夹断的现象,所以栅漏间距对饱和电流的影响并不大。
4 结 论
本文制备了6种不同结构参数的感光栅极GaN基HEMT器件,分别选取栅长为1,2,3 μm,保持源漏间距不变,分别在有光和无光条件下测试其转移特性与I-V输出特性曲线。发现在光照条件下,器件的饱和输出电流达到28 mA,较无光条件下提高12 mA,另外,随着栅长的增大,器件的饱和输出电流依次减小,这是由于栅长的增大导致2DEG浓度下降以及沟道电阻的增大所引起。另外,选取栅漏间距为5,10,15 μm,保持栅长与源栅间距不变,测试结果表明,有光照时器件的饱和输出电流达到21 mA,较无光条件下提高12 mA,另外,栅漏间距的变化对阈值电压以及饱和电流的影响并不大。因此,感光栅极GaN基HEMT器件作为一种新结构器件对可见光有较高的探测效果,并且改变器件的结构参数,可以更好地提高器件的性能以及探测效率。接下来可以从材料的结构以及制备工艺等方面入手,进一步探究器件对不同光波段的响应度以及对铁电薄膜表面产生的影响。

