弛豫半导体的表征与应用研究进展
余竞一,介万奇
(西北工业大学材料学院 辐射探测材料与器件工信部重点实验室,陕西 西安 710072)
1 前 言
自晶体管和集成电路发明以来,各类半导体器件对人类社会的科技和经济发展起了重要的推动作用。随着对半导体材料研究的深入,人们发现在低电阻率和高电阻率的半导体中载流子的输运规律显著不同。由此可以将半导体分为两类,即对应于低电阻率的寿命半导体(lifetime semiconductor)和对应于高电阻率的弛豫半导体(relaxation semiconductor)。寿命半导体和弛豫半导体划分的依据是材料的介电弛豫时间(dielectric relaxation time,τd)和载流子寿命(lifetime,τ0)的相对大小。一般通过3种方法可提高电阻率,得到弛豫半导体:① 制备极为纯净的材料;② 同时引入施主和受主杂质进行补偿;③ 通过低温减少载流子的热激发。目前已可以制备同位素级纯度的Ge晶体[1]和通过引入深能级缺陷补偿得到高阻的GaAs[2]和CdTe[3]晶体。另外,非晶半导体,如氢化非晶硅(a-Si∶H)[4],由于具有较高的电阻率,也可能是弛豫半导体。因为低电阻的寿命半导体在半导体器件中应用广泛,如Si基集成电路等,所以对其载流子输运行为已经有大量研究[5]。而对于高电阻的弛豫半导体,由于晶体生长和材料测试方面的困难,对其载流子输运规律的理解仍十分匮乏。本文总结了弛豫半导体的研究进展,包括弛豫半导体的物理原理及其分析测试手段以及弛豫半导体的应用。
2 弛豫半导体的物理原理
2.1 弛豫半导体的定义

在半导体恢复到热平衡态的过程中,介电弛豫时间和少子寿命未必相等。美国贝尔实验室的van Roosbroeck于1961年指出[8],半导体的介电弛豫时间和少子寿命的相对大小对材料内载流子的输运过程有根本性的影响,并在1970年的第十届半导体物理国际会议上提出[9]应将半导体划分为两类:介电弛豫时间小于少子寿命的半导体为寿命半导体,反之为弛豫半导体。由于介电弛豫时间正比于电阻率,所以弛豫半导体一般为高阻半导体。另外,理论上任何半导体在足够低的温度下都能转变成弛豫半导体。由于寿命半导体的介电弛豫时间很短,可假设材料中时时处处保持电中性,并在此基础上推导了理想p-n结模型肖克莱方程和肖特基结扩散电流理论等[6]。然而,对于弛豫半导体,由于介电弛豫时间大于少子寿命,电中性假设不再成立,必须考虑空间电荷对载流子输运的影响。
2.2 弛豫半导体的特征现象
弛豫半导体与空间电荷有关的特征之一是在少子注入条件下的多子耗尽效应(majority carrier depletion)。少子注入一般通过正偏的p-n结实现,会造成寿命半导体多子增加,弛豫半导体多子耗尽,如图1所示。假设半导体为p型,当半导体处于热平衡状态时(O点),电子浓度(ne)和空穴浓度(pe)满足质量作用定律且材料为电中性。t=0时,在半导体中注入浓度为Δn0的少数载流子,使得载流子浓度偏离热平衡态至I点,之后半导体将通过介电弛豫和复合两个过程恢复到平衡状态。在典型的寿命半导体中,τd/τ0≪1,可以认为介电弛豫过程是瞬时完成的,即多子会迅速中和掉多余少子使半导体内部保持电中性,之后半导体中的载流子通过复合逐渐恢复到热平衡浓度,如图1中路径I→B→O和图1中的插图(a)所示。与寿命半导体相反,在典型的弛豫半导体中,τd/τ0≫1,复合过程可以认为是瞬时完成的。因此,在少子注入后多子被迅速复合使得载流子浓度满足质量作用定律,之后再介电弛豫至电中性状态,如图1中路径I→C→O和图1中的插图(b)所示。介电弛豫时间和少子寿命相等时,半导体沿路径I→O恢复至热平衡态,受电子吸引而来的空穴恰好被复合,因此空穴浓度保持不变。易于证明,当注入少子的浓度接近其热平衡浓度时,在弛豫半导体中会造成多子耗尽。

图1 少子注入后半导体载流子浓度在N-P平面恢复到热平衡态的过程,双曲线为满足质量作用定律的载流子浓度,(a)和(b)分别为寿命半导体和弛豫半导体中载流子浓度的变化Fig.1 Recovery of equilibrium after minority carrier injection in the N-P plane, carrier concentrations on the hyperbola satisfy the mass action law, (a) and (b) are time evolution of recovery processes for the lifetime and relaxation semiconductor, respectively
弛豫半导体的另一个特征现象是中性注入(例如光注入)后载流子的漂移方向与寿命半导体不同,如图2所示。在寿命半导体中,根据电中性假设可推导出注入的多余电子和空穴以相同的双极性迁移率和双极性扩散系数作双极性输运(ambipolar transport)[7],在非本征半导体和小注入情况下多子按少子的运动方向逆电场漂移。然而在弛豫半导体中,同时注入的电子和空穴会沿电场方向分别向阳极和阴极漂移[10, 11]。

图2 p型寿命和弛豫半导体中注入的电子和空穴的漂移方向Fig.2 Drift direction of injected electrons and holes in the p-type lifetime and relaxation semiconductor
2.3 陷阱的影响
半导体中介电弛豫的本质是电荷对电场的屏蔽作用。当半导体中含有陷阱时,被陷阱俘获的电荷同样可以屏蔽电场。对弛豫半导体的进一步研究发现,半导体中的俘获电荷对其弛豫特性有重要影响[12, 13]。根据陷阱对空间电荷的贡献,可将弛豫半导体分为低陷阱浓度和高陷阱浓度两类。低陷阱浓度的弛豫半导体中的空间电荷主要为自由载流子,而在高陷阱浓度的弛豫半导体中,陷阱中的电荷浓度远大于自由载流子浓度。少子注入时陷阱会俘获多余少子并吸引周围的多数载流子,但复合过程被阻碍。因此在高陷阱浓度的弛豫半导体中注入少子反而可能会增加多子的浓度。


表1 GaAs和Si作为寿命半导体或弛豫半导体时相应的特征时间和长度[15]Table 1 Estimates of characteristic time and length illustrating lifetime and relaxation semiconductor cases in GaAs and Si[15]
3 弛豫半导体的表征
虽然针对高阻半导体的测试已经有广泛报道,但是大部分测试忽略了弛豫半导体独特的物理性质,所以对测试条件的设置和测试结果的解读存在不准确之处。另一方面,由于电极制备工艺上的困难、缺陷分布及材料均匀性的问题以及测量中较长的瞬态过程和较大的噪声,对于弛豫半导体的实验研究一直较为困难,目前专门针对弛豫半导体特征现象的测试仍十分有限。另外,为了描述实验结果,使用的物理模型必须综合考虑电子和空穴的漂移和扩散以及较大的俘获电荷浓度。处理如此复杂的物理模型,只能使用数值模拟或在小信号下对载流子的输运方程进行线性化处理[16]。
3.1 电流-电压测试
对于弛豫半导体,少子注入引发的多子耗尽效应会直接影响器件的电流-电压(I-V)特性。多子耗尽区的宽度一般为微米量级,难以直接观测,故一般通过宏观I-V特性间接进行表征。图3是低陷阱浓度和高陷阱浓度的弛豫半导体在少子注入下的I-V特性示意图[16]。可以看出,弛豫半导体I-V特性的变化规律由低电压下的扩展线性区和高电压下的超线性区两部分构成。对于低陷阱浓度的弛豫半导体,扩展线性区的电流小于热平衡体材料对应的电流,说明少子注入增大了电阻;对于高陷阱浓度的弛豫半导体,少子注入总是会减小电阻。需要说明,图3只是理想情况下弛豫半导体的I-V特性,对于实际样品,还需要考虑少子注入比、载流子迁移率比、样品大小等许多参数。目前,已见诸报道的实验使用的材料包括结型结构(p+-v-n+结或肖特基结)的高阻GaAs[17-22]、高纯Si[23, 24]、Ge[25]等。
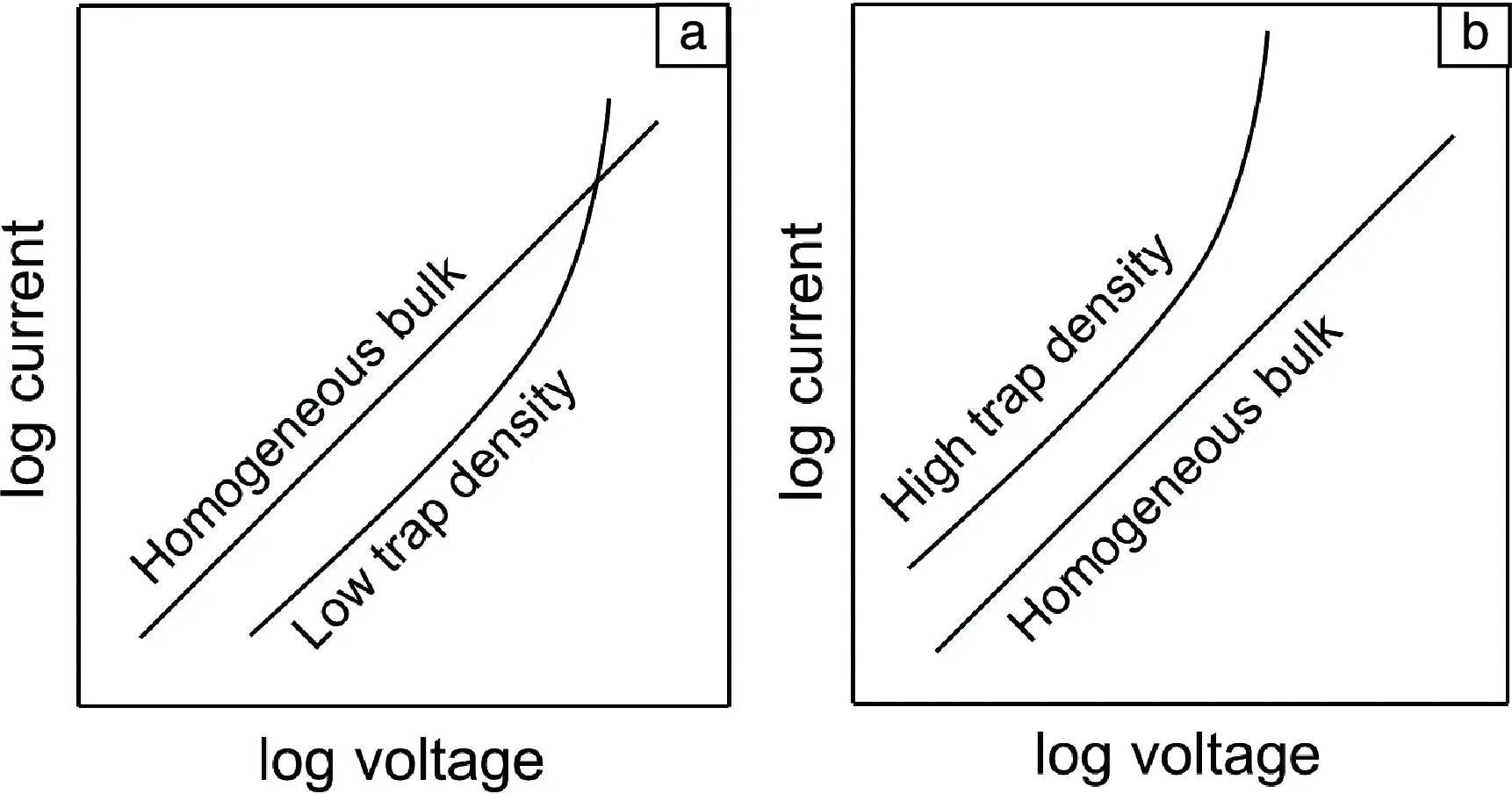
图3 n型高电子迁移率弛豫半导体及相应无扰动体材料的I-V特性:(a) 低陷阱浓度,(b) 高陷阱浓度[16]Fig.3 I-V relationships of n-type relaxation semiconductors with μn>μp, the undisturbed bulk characteristic is given for comparison: (a) low trap density, (b) high trap density[16]
1989年,研究者将高纯Si冷却到16 K,发现I-V特性的变化符合理论预测[26],第一次得到了低陷阱浓度的弛豫半导体中多子耗尽的直接证据[24],实验结果如图4所示。当Si n+-p结通过降温过程由寿命半导体变为弛豫半导体时,低电压下的电导率相对升高,而高电压下的电导率相对下降。这是由于低电压下的电流主要由扩散电流构成。当Si变为弛豫半导体时,在少子注入区域发生多子耗尽,产生了较大的载流子浓度梯度,因此扩散电流分量增加。而电压较高时,电流以漂移电流为主,降温导致材料内的载流子浓度降低,从而使总电流减小。
3.2 交流响应测试
I-V测试是基于材料的直流响应,若在材料上施加交流电压,可以得到更丰富的信息。典型的电容-电压(C-V)测试利用结电容效应作为测试基础,可得到材料的掺杂浓度、结势垒高度等参数[27]。对于弛豫半导体,由于需要同时考虑电子和空穴、不能使用电中性假设且材料内部常常有大量陷阱,因此其交流响应特性的分析存在一定困难。Shulman[28]在小注入条件下求解了GaAs弛豫半导体的低频响应,得到了不同频率下的器件中自由电荷和俘获电荷分布,发现电中性总不成立。Green[29]详细分析了半绝缘InP的低频介电响应特性,发现在频率小于10 Hz时材料表现出寿命半导体特性,而更高频率下表现出弛豫半导体特性。McPherson[30]对中子辐照的Si二极管进行了C-V测量,发现其表现出反偏下耗尽层电容与频率相关、正偏下出现负扩散电容等特性,可用弛豫半导体理论进行解释。
3.3 载流子动力学测试
早期的载流子动力学测试主要为瞬态电流测试(transient charge technique,TCT)[31],也被称作飞行时间测试(time of fly)。测试的原理是通过光或带电粒子在材料中局部注入多余载流子,当多余载流子在电场作用下运动时,会在电极处感应出正比于漂移速度的电流。通过载流子运动的距离、时间和材料内部的电场强度可计算出载流子的迁移率。近来,随着技术进步,一系列高空间和时间分辨率的载流子输运动力学测试技术为直接观察弛豫半导体和寿命半导体中载流子的输运行为提供了可能。Ruzicka等[32]使用超快激发-探测技术(ultrafast pump-probe technique)观察到GaAs体材料中光生载流子的双极性扩散。Liao等[33]使用4D电子显微镜技术在a-Si∶H中首次直接观察到了弛豫半导体中多余电子和空穴的分离现象。模拟得到的光生载流子输运过程如图5所示。对于寿命半导体,如果材料是非本征的,则会发生双极性漂移过程;对于弛豫半导体,电子和空穴被外电场分开向两极移动。在寿命半导体和弛豫半导体的边界附近,可以观察到光生载流子的输运由分离向双极性漂移转变。

图5 光生载流子的输运过程模拟: (a) 模拟使用的初始热平衡载流子浓度在N-P平面上的位置, (b)光生载流子分布的演化过程,时间间隔为0.1τ0,使用的初始热平衡载流子浓度如图(a)所标示Fig.5 Simulation of the photocarrier evolution: (a) equilibrium carrier concentrations used in the simulation are marked on the N-P plane,(b) simulated photocarrier evolution with a 0.1τ0 time interval after excitation using the equilibrium carrier concentrations marked in (a)
4 弛豫半导体的应用
4.1 辐射探测器
由2.2节可知,在弛豫半导体中等量注入的电子和空穴会被外加电场分开各自向两极移动,这正是半导体辐射探测器的基本工作原理。因此可以认为半导体辐射探测器需用弛豫半导体。半导体辐射探测器按器件工作状态可分为3类:以p-n结或肖特基结空间电荷区作为有效工作区域的结型探测器;需要工作在低温状态下的高纯晶体探测器;可在室温下工作的高阻半导体探测器。可以看出,这3种工作状态的物理本质都是提高部分或全部器件的电阻率,从而使材料变为弛豫半导体,以通过电场分开辐射产生的电子空穴对并进行电荷收集。
以室温下的CdZnTe核辐射探测器为例,假设材料电阻率为1×1010Ω·cm,电子和空穴迁移率[34]为1000和100 cm2/V·s,可计算得介电弛豫时间约为1 ms。结合Hecht方程[35]拟合的μτ积和TCT测得的载流子迁移率[36],得到CdZnTe的体少子寿命在1 μs左右。因此,探测器级的CdZnTe材料在室温下已经是弛豫半导体。通过深能级补偿得到的弛豫半导体内往往含有高浓度的陷阱。CdZnTe中的陷阱浓度可达1×1015cm-3以上[37],而自由载流子浓度仅约1×106cm-3,远小于陷阱浓度,所以CdZnTe属于高陷阱浓度的弛豫半导体。
4.2 抗辐照器件
在大剂量辐照下工作的半导体器件面临的主要问题是射线在材料体内产生的辐照损伤可能引发掺杂状态的改变,进而引发载流子浓度变化,导致器件失效。然而,对于深能级补偿得到的弛豫半导体,由于材料中大量的陷阱对费米能级有钉扎作用,所以辐照产生的缺陷难以改变材料的弛豫半导体输运特性[38],因此可用作抗辐照器件。使用中子辐照Si[39]或液相外延GaAs[40]制得的二极管,可以在器件内部引入大量深能级缺陷,使得材料变为弛豫半导体,在抗辐照器件领域具有潜在应用价值。
4.3 光电导开关
半导体光电导开关(photoconductive switch)结合了超快脉冲激光和光电半导体,通过触发光控制半导体的电导率从而实现导通和断开两种状态,在脉冲功率技术和超快电子学等领域取得了广泛应用[41]。为了增加器件的开关速度、效率和耐高压能力,需要使用暗电阻率大的材料,如半绝缘的GaAs、SiC和金刚石等,因此光电导开关有可能是弛豫半导体。对于半绝缘GaAs而言,材料中的大量深能级缺陷对光电导开关的响应特性,如击穿电压、上升时间、开关延迟等,有重要影响[42]。
4.4 温度传感器
一般而言,Si热敏电阻的最大工作温度约200 ℃,超过这个温度会在材料内产生大量热载流子从而导致器件失效。Si扩展电阻温度传感器[43]利用弛豫半导体中的少子排出(exclusion)效应[44]和绝缘层上硅技术(silicon-on-insulator),可将器件工作温度提高到350 ℃[45]。
4.5 其它应用
基于弛豫半导体独特的载流子输运特性,学者提出了多种潜在的应用方向。在弛豫半导体的多子耗尽区,可能存在一个高复合区域,可以利用该区域制备电流调控发光二极管[46]。弛豫半导体还可以作为半绝缘衬底用于器件制造,并对器件的部分电学特性产生影响。例如半绝缘GaAs衬底上制造的金属-半导体场效应管(MESFETs)的许多电学参数具有低频相关特性[28],这些特性不仅仅同表面态有关,也取决于半绝缘衬底的弛豫态半导体特性。
5 结 语
弛豫半导体是半导体材料所处的一种状态,即材料的介电弛豫时间大于载流子复合寿命。因为介电弛豫时间是材料恢复电中性的特征时间,所以在弛豫半导体中必须考虑空间电荷对载流子输运过程的影响。与寿命半导体相比,弛豫半导体中的多子耗尽和载流子分开漂移是两个有重要理论和应用价值的特征现象。目前,对弛豫半导体中载流子输运过程的认识还十分有限,已有研究大多集中在少子注入方面,对于其他物理过程,例如材料对交变电场、光照、磁场的响应仍缺少系统研究。弛豫半导体除了与大量器件的工作原理密切相关,还决定了高阻半导体的生长与性能优化、性能表征方法、器件设计、模拟与测试等诸多方面。弛豫半导体独特的物理性质具有广阔的应用前景。

