新型碱性清洗液对CMP后残留SiO2颗粒的去除
杨 柳,刘玉岭,檀柏梅,高宝红,刘宜霖
(1. 河北工业大学 电子信息工程学院,天津 300130;2. 天津市电子材料与器件重点实验室,天津 300130)
随着芯片集成度的增加(每隔三年翻两番)和半导体器件特征尺寸的不断缩小(每隔三年缩小1/3),极大规模集成电路金属布线层数不断增加,低电阻率的Cu代替Al成为90nm以下IC的互联金属[1-4]。Cu互联采用双大马士革工艺制备,通过化学机械抛光去除多余的铜和阻挡层,获得平坦化表面[5],铜布线CMP实现晶圆表面高度平坦化的同时,会在晶圆表面残留大量的金属离子、颗粒、有机物等污染物,需要通过CMP后清洗工艺将其彻底有效地去除,进而得到无缺陷、无玷污的晶圆表面[6-7]。为了提高产品的良率,业界对化学机械抛光工艺提出了更高的要求,尤其是芯片表面CMP后吸附颗粒的数量和尺寸方面的要求也越来越苛刻[8]。
针对铜线条上吸附的 SiO2颗粒,Yeh等[9]提出的清洗方法则是利用HF、HNO3等强酸将铜氧化层和氢氧化层腐蚀掉,使吸附在其上的SiO2颗粒脱附进入溶液中,达到清洗的目的。这种化学刻蚀的方法会加重微划痕缺陷、造成细小线条的塌陷,已不能满足线条进一步变窄时的需要[10]。酸性清洗液已不能适应集成电路的发展,碱性清洗液的研发和应用成为一个重要研究方向[11]。氢氧化铵(NH4OH)和四甲基氢氧化铵(TMAH)已经被用于研究。然而,NH4OH对铜的腐蚀速率较高,特别是对图形片,因此NH4OH不再被作为碱性清洗剂研究[12]。TMAH在抛光后清洗中应用范围较广,但是作为胺类化合物在高压下分解,容易蒸发到环境中。胺基在光刻蚀过程中污染晶圆。另外,TMAH通过呼吸或者黏附在皮肤上会引起若干健康问题[13-15]。
针对上述问题,本课题组研发出一种新型清洗剂。实验表明,课题组自主研发的清洗剂对CMP后残留杂质的去除能力比主流的NH4OH、TMAH碱性清洗剂效果要好。其主要成分是自主发明的 FA/OII螯合剂和O-20非离子表面活性剂,成分简单,清洗工作压力低。与其他碱性螯合剂相比,FA/OII螯合剂具有十三个以上螯合环,稳定性高,有较强的螯合能力。O-20非离子表面活性剂是一种大分子非离子表面活性剂,表面张力小,对颗粒的去除效果较好,并且能保护铜表面不被腐蚀。
1 实验
实验选用的铜布线片是由直径为300 mm的晶圆切割成的7 cm×7 cm的铜布线片。使用法国的Alpsitec公司生产的 E460E抛光机对实验样品进行预处理得到光鲜的铜布线片,抛光液采用河北工业大学微电子研究所自主研发不含BTA的FA/O碱性抛光液。其中抛光时间30 s,抛光头与抛光垫转速分别为65 r/min和60 r/min;抛光液流速为300 mL/min。氮气吹干后使用安捷伦公司研发生产的Aglient 5600LS原子力显微镜(AFM, Atom Force Microscope)测量新鲜的晶圆表面的粗糙度为3.56 nm。
清洗采用聚乙烯醇(PVA)刷擦洗的方法[15],清洗液的流量为2 L/min,清洗时间为1 min,清洗液采用河北工业大学自主研发的FA/O清洗液。通过改变清洗液中螯合剂和活性剂的体积分数得到最佳的清洗液配比。
用安捷伦公司生产的原子力显微镜(Aglient 5600LS)观察表面状态。同时,利用海中晨数字技术设备有限公司生产的JC2000D接触角测试仪测试清洗液表面张力的大小,利用扫描电子显微镜(SEM)对铜光片清洗前后布线片表面进行扫描统计,得到晶圆的缺陷分布图及缺陷总数。然后随机取100个点,并统计其中颗粒及缺陷的个数,利用公式(1)N=Mn/m,统计颗粒的个数,其中N表示整个晶圆颗粒总数;M表示整个晶圆的缺陷总数;n表示100个点中颗粒的个数;m表示100个点中缺陷的个数。
2 结果及分析
在CMP过程中,二氧化硅(SiO2)作为磨料是抛光液中的主要成分,同时也是CMP后残留在表面的主要颗粒[16-18]。图1是CMP后吸附在表面的硅溶胶颗粒图。SiO2颗粒最初以物理吸附的形式存在,如果不立即进行清洗,物理吸附的SiO2颗粒会慢慢转变为化学吸附[19]。此时,SiO2颗粒通过一个氧原子同Cu原子连接在一起,形成Si—O—Cu共价键。特别是当抛光液中有过氧化氢(H2O2)等氧化剂时,Cu线条表面会生成一层Cu的氧化物/氢氧化物,更易与SiO2颗粒反应生成Si—O—Cu共价键[20]。只有将共价键破坏才能去除SiO2颗粒,这导致清洗难度增加。
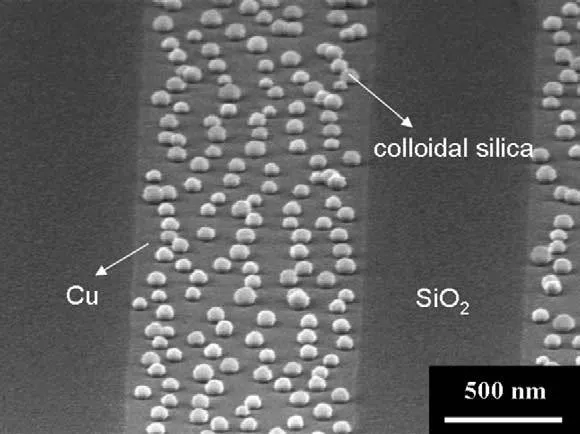
图1 CMP后铜线条上硅溶胶颗粒吸附SEM照片Fig.1 SEM image of colloidal silica abrasive on Cu interconnection post CMP
2.1 FA/OII型螯合剂对颗粒的去除
由于抛光后残留SiO2颗粒的存在,会使晶圆表面的粗糙度增大,因此,在本文中通过表面粗糙度的大小来判断颗粒的去除效果。FA/OII型螯合剂去除颗粒的原理是化学刻蚀。FA/OII型螯合剂是多羟多胺碱性大分子,可简写为R(NH2)2,配位原子是氧原子和氮原子,具有十三个以上螯合环、十二个氧原子、十六个羟基。在碱性条件下,可与 CuO和Cu(OH)x生成稳定可溶的铜胺络离子,使得部分SiO2颗粒随氧化物的脱落而从铜线条表面脱离,如图2所示。图3所示为清洗液中FA/OII型螯合剂的体积分数分别为0.01%,0.015%,0.02%清洗后晶圆表面状态图,粗糙度分别为2.41,1.06,1.75 nm,明显小于抛光后晶圆表面的粗糙度3.56 nm。由此可知,当清洗液中螯合剂的体积分数为0.015%时,此时的表面粗糙度较低,表明去除了部分残留的SiO2颗粒。虽然提高FA/O II型螯合剂的浓度有助于SiO2颗粒的清洗,但清洗液中螯合剂浓度过高时,铜线条上出现比较严重的腐蚀现象。
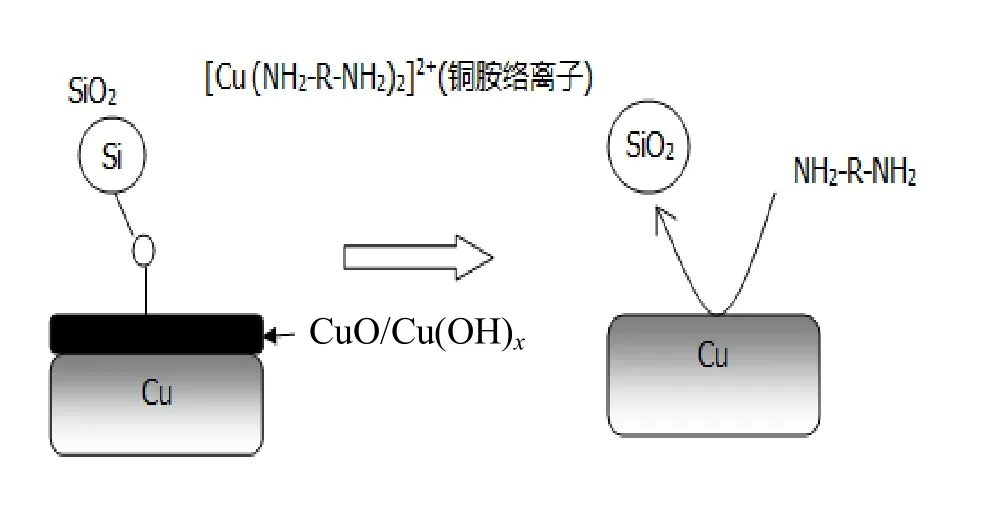
图2 FA/O II型螯合剂去除化学吸附SiO2颗粒示意图Fig.2 Schematic illustration of the removal chemical adsorbed SiO2 particles by FA/O II
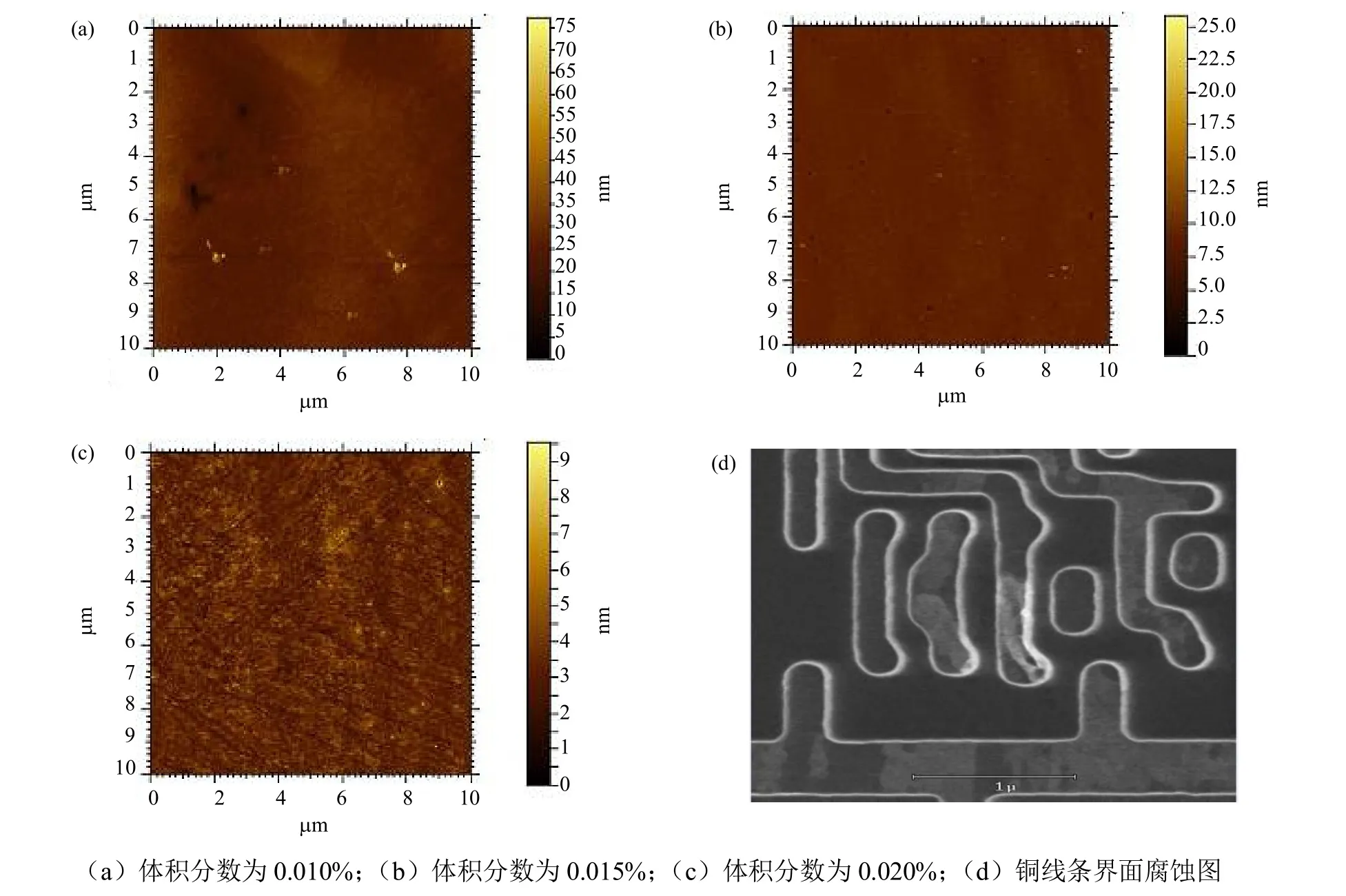
图3 不同浓度FA/OII下的表面状态图Fig.3 The surface state graphs with different concentrations of FA/OII
表面粗糙度的增大主要是由于清洗液浓度过高,晶圆表面产生了非均匀腐蚀。金属的腐蚀速率可用腐蚀电流表示,腐蚀电流越大,金属发生腐蚀的速率就越大,图4即为NH4OH、TMAH和FA/OII的自腐蚀电流图。由图可知,FA/OII型螯合剂的腐蚀速率要明显小于NH4OH和TMAH,但是FA/O II螯合剂的浓度越高,腐蚀现象越严重,当体积分数达到0.020%时,铜线条界面出现明显的腐蚀如图3(d)所示,表面粗糙度增大,会严重影响器件的性能。因此当FA/OII型螯合剂的体积分数为0.015%时去除颗粒的效果最佳,与NH4OH及TMAH相比,不仅腐蚀速率低,而且无毒、环保。
2.2 非离子型表面活性剂对颗粒的去除
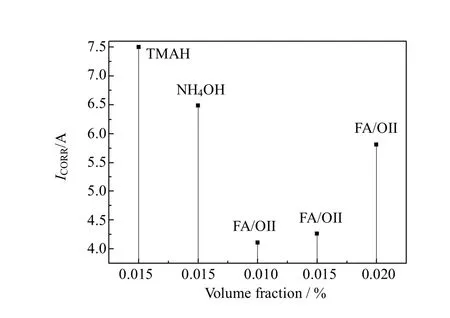
图4 不同清洗液的自腐蚀电流Fig.4 The corrosion currents of different cleaners
为了提高清洗效果,通常引入表面活性剂降低清洗液的表面张力,从而将物理吸附在晶圆表面的颗粒更好地去除。本文所用的是O-20型非离子表面活性剂,其优点是在清洗过程中不会引入其他离子。O-20非离子表面活性剂的引入会使清洗液的表面张力降低,使得表面活性剂分子渗透进SiO2颗粒与晶圆表面之间,逐渐将SiO2颗粒托起,从而减弱了SiO2颗粒与晶圆表面的物理吸附作用,使其在PVA刷洗和清洗液的冲击作用下从晶圆表面脱离,如图5所示。同时,O-20型表面活性剂分子吸附在晶圆表面形成一个保护层。

图5 O-20非离子表面活性剂去除SiO2颗粒示意图Fig.5 The mechanism of the surfactant to remove SiO2 particles
图6(a~f)表示固定清洗液中FA/OII型螯合剂体积分数为0.015%,改变清洗液中O-20活性剂的体积分数分别为0,0.10%,0.15%,0.20%,0.25%,0.3%时,晶圆表面颗粒、金属氧化物、有机物以及腐蚀等所有缺陷(图中的红点即为缺陷)的分布图。由图可知,随着清洗液中活性剂体积分数的增加,晶圆表面的总缺陷数先是逐渐减少,当体积分数达到0.3%时,缺陷数反而增加。图7是根据公式(1)得出的总缺陷及颗粒个数的折线图。由图可知,当活性剂的体积分数达到0.25%时,颗粒数由3200降到611,得到较好的清洗效果。

图6 不同体积分数O-20活性剂清洗后表面缺陷的分布图Fig.6 The single defect maps of wafer after post-CMP cleaning with different volume fractions of the O-20 surfactant
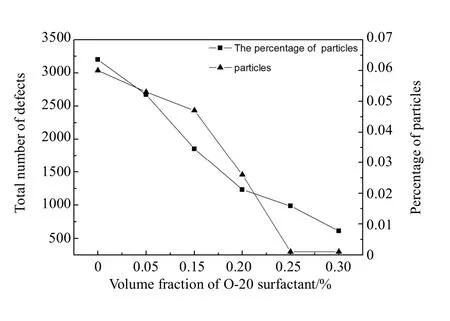
图7 缺陷总数及SiO2颗粒占总体缺陷比例分布图Fig.7 The total number of defects and the proportion of SiO2 particles
但是,随着活性剂浓度的提高,就会有更多的活性剂吸附在表面,造成有机物二次污染,如图8所示,图中黑色阴影为有机物。因此,清洗液中活性剂的浓度不宜过高。

图8 吸附在表层的薄层有机物质Fig.8 SEM image of organic contamination
图9所示为在不同体积分数O-20活性剂表面张力的变化曲线。由图可知,表面张力随着活性剂浓度的增大而逐渐减小。当活性剂的体积分数大于0.25%时,表面张力达到平衡即临界胶束浓度,此时,表面活性达到最强,去污能力和可溶性最强。与此同时,在表面活性剂和多价Cu+和Cu2+在FA/OII型螯合剂的作用下,颗粒和晶圆表面负电荷增加,颗粒的质点和固体表面带相同的电荷,相互排斥力增强,粘附强度下降。此外,在颗粒和晶圆表面上的Cu2+使颗粒松散。表面活性剂的吸附可使颗粒从晶圆表面卷离,进而引起界面张力降低。总之,活性剂的吸附,导致颗粒和晶圆的界面性质发生改变,使颗粒质点容易脱落。因此,当螯合剂和活性剂的体积分数分别为0.015%和0.25%时,对颗粒的去除效果最好。
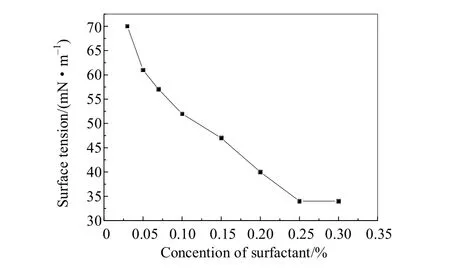
图9 不同浓度O-20活性剂的表面张力Fig.9 The surface tensions with different concentrations of O-20 surfactant
3 结论
通过以上实验得出,当 FA/O清洗液中 FA/OII型螯合剂的体积分数为0.015%,O-20非离子表面活性剂的体积分数为0.25%时,能够有效去除以物理、化学吸附在布线条表面的SiO2颗粒。此时的表面粗糙度较低,为1.06 nm,颗粒数由抛光后的3200降到611,颗粒数目显著降低。与其他碱性清洗液相比,不仅腐蚀速率低,去除效果好,而且成分简单、环保、无毒。
参考文献:
[1]GOSWAMI A, KOSKEY S, MUKHERJEE T, et al. Study of pyrazole as copper corrosion inhibitor in alkaline post chemical mechanical polishing cleaning solution [J]. ECS J Solid State Sci Technol, 2014, 10(3): 293-297.
[2]GELMAN D, STAROSVETSKY D, EIN-ELI Y. Copper corrosion mitigation by binary inhibitor compositions of potassium sorbate and benzotriazole [J]. Corros Sci, 2014,82(2): 271-279.
[3]STEIGERWALD J M, MURARKA S P, GUTMANN R.Chemical mechanical planarization of microelectronic materials [M]. NY, USA: Wiley, 2007.
[4]雷红. CMP后清洗技术的研究进展 [J]. 半导体技术,2008, 33(5): 369-373.
[5]SANG W L, BAE K H, KWON O J, et al. The effect of TAD based cleaning solution on post Cu CMP process [J].Microelectron Eng, 2016, 162: 17-22.
[6]TSENG W T, CANAPERI D, TICKNOR A, et al. Post Cu CMP cleaning process evaluation for 32nm and 22nm technology nodes [C]// Advanced Semiconductor Manufacturing Conference. NY, USA: IEEE, 2012: 57-62.
[7]LIN C S, LEE Y C. Chemical mechanical planarization operation via dynamic programming [J]. Microelectron Eng,2007, 2(3): 1-15.
[8]贾英茜, 刘玉岭, 牛新环, 等. ULSI多层互连中的化学机械抛光工艺 [J]. 微纳电子技术, 2006, 43(3): 397-401.
[9]YEH C F, HAISO C W, LEE W S. Novel post CMP cleaning using buffered HF solution and ozone water [J].Appl Surf Sci, 2003(216): 46-53.
[10]CHEN P L, CHEN J H, TSAI M S, et al. Post-Cu CMP cleaning for colloidal silica abrasive removal [J].Microelectron Eng, 2004, 75(4): 352-360.
[11]STEIGERWALD J M, MURARKA S P, GUTMANN R J,et al. Chemical processes in the chemical mechanical polishing of copper [J]. Mater Chem Phys, 1995, 41(3):217-228.
[12]NOGUCHI J, KONISHI N, YAMADA Y. Influence of post-CMP cleaning on Cu interconnects and TDDB reliability [J]. IEEE Trans Electron Device, 2005, 52(5):934-941.
[13]MANIVANNAN R, CHO B J, XIONG H L, et al.Characterization of non-amine-based post-copper chemical mechanical planarization cleaning solution [J].Microelectron Eng, 2014, 122: 33-39.
[14]VENKATESH R P, KWON T Y, PRASED Y N, et al.Characterization of TMAH based cleaning solution for post Cu-CMP application [J]. Microelectron Eng, 2013, 102(1):74-80.
[15]SMOLEN’S, SADY W. Influence of iodine fertilization and soil application of sucrose on the effectiveness of iodine biofortification, yield, nitrogen metabolism and biological quality of spinach [J]. Acta Sci Pol Hortorum Cultus, 2011,10(4): 51-63.
[16]HONG J K, BOHRA G, YANG H, et al. Study of the cross contamination effect on post CMP in situ cleaning process[J]. Microelectron Eng, 2015, 136(1): 36-41.
[17]杨飞, 檀柏梅, 高宝红, 等. 多层铜布线表面 CMP后颗粒去除研究 [J]. 微纳电子技术, 2012(12): 829-832.
[18]邓海文, 檀柏梅, 张燕, 等. FA/O碱性清洗液对GLSI多层 Cu布线粗糙度的优化 [J]. 电子元件与材料, 2015,34(10): 91-94.
[19]AHMED A B, HONG L, NAIM M. Particle adhesion and removal mechanisms in post-CMP cleaning processes [J].IEEE Trans Semiconduct Manuf, 2002, 15(4): 374-38.
[20]MERIKHI J, FELDMANN C. Adhesion of colloidal SiO2particles on ZnS-type phosphor surfaces [J]. J Colloid Interface Sci, 2000(228): 121-126.

