高Al组分AlGaN多量子阱结构材料发光机制探讨
李金钗, 季桂林, 杨伟煌, 金 鹏, 陈航洋, 林 伟, 李书平, 康俊勇
(1. 厦门大学 物理系, 福建省半导体材料及应用重点实验室, 半导体光电材料及其高效转换器件协同创新中心, 福建 厦门 361005;2. 中国科学院半导体研究所 半导体材料科学重点实验室, 北京 100083)
高Al组分AlGaN多量子阱结构材料发光机制探讨
李金钗1*, 季桂林1, 杨伟煌1, 金鹏2, 陈航洋1, 林伟1, 李书平1, 康俊勇1
(1. 厦门大学 物理系, 福建省半导体材料及应用重点实验室, 半导体光电材料及其高效转换器件协同创新中心, 福建 厦门361005;2. 中国科学院半导体研究所 半导体材料科学重点实验室, 北京100083)
紫外LED的发光功率和效率还远不能令人们满意,波长短于300 nm的深紫外LED的发光效率普遍较低。厘清高Al组分AlGaN多量子阱结构的发光机制将有利于探索改善深紫外LED的发光效率的新途径、新方法。为此,本文通过金属有机气相外延技术外延生长了表面平整、界面清晰可辨且陡峭的高Al组分AlGaN多量子阱结构材料,并对其进行变温光致发光谱测试,结合数值计算,深入探讨了AlGaN量子阱的发光机制。研究表明,量子阱中具有很强的局域化效应,其发光和局域激子的跳跃息息相关,而发光的猝灭则与局域激子的解局域以及位错引起的非辐射复合有关。
AlGaN; 多量子阱结构; 深紫外LED; 发光机制
CHEN Hang-yang1, LIN Wei1, LI Shu-ping1, KANG Jun-yong1
1 引 言
AlGaN半导体材料具有很宽的直接带隙,禁带宽度从3.4~6.2 eV连续可调,使其光响应波段覆盖从近紫外(UVA)到深紫外(UVC)波段(200~365 nm)。此外,AlGaN基半导体材料具有高热导率、高电子饱和速率、高击穿电压、低介电常数、抗辐射、以及稳定的物理化学性质等诸多优异性能,因而成为制备紫外乃至深紫外发光二极管(Light-emitting diodes, LED)、激光二极管(Laser diodes, LD)以及探测器(Photo detector, PD)等光电子器件的不可替代的半导体材料[1-2]。相比于传统紫外光源(如汞灯和氙灯),紫外LED具有无汞污染、波长可控、体积小、耗电低、寿命长等优点,在高显色指数白光照明、防伪识别、紫外聚合物固化、杀菌消毒、医疗卫生、水与空气净化、高密度光学数据存贮等领域都有着广阔的应用前景和巨大的市场需求。尽管在众多研究工作者持续不断的努力下,AlGaN基紫外LED取得了一定的发展,然而相较于成熟的GaN基蓝光LED,其发光功率和效率仍有很大的提升空间,尤其是波长短于300 nm的深紫外LED的发光效率普遍较低,且随波长的减小急剧下降[2]。
LED的发光效率取决于内量子效率(电子空穴对辐射复合转换成光子的效率)、载流子注入效率(电荷输运至有源层的效率)以及光提取效率(光传播出器件的效率)3个因素。其中内量子效率与有源层的电子结构、特别是量子态密切相关[3-4]。因此,厘清AlGaN多量子阱结构的发光机制将有利于探索改善深紫外LED的内量子效率的新途径、新方法。为此,本文通过对AlGaN多量子阱结构的变温光致发光谱测试,结合数值计算,深入探讨了AlGaN量子阱的发光机制。
2 实 验
为获得界面平整的AlGaN多量子阱结构,我们采用本研究组开发的分层生长MOVPE技术[4]在蓝宝石衬底上首先外延生长了1 μm左右的高质量AlN层、由AlN到n-AlGaN组分渐变的AlGaN应力释放层以及1.3 μm左右的n-AlGaN层,最后外延生长了5个周期的Al0.35Ga0.65N(2 nm)/Al0.45Ga0.55N(10 nm)多量子阱层。由于在分层生长过程中,金属有机化学以TMAl和NH3生长源交替通入,化学计量比失衡容易导致会成为非辐射复合中心的点缺陷和间隙位的产生[5-6]。对于厚度只有几十纳米的量子阱有源区,点缺陷和间隙位的产生会大大降低其发光效率。因此,在外延生长AlGaN量子阱结构时,我们未继续采用分层生长法,而改为同时通入Ⅲ族金属源和NH3的传统外延生长法,并同时通入TMIn以引进In作为表面活性剂,增强原子的表面迁移。生长结束后,通过原子力显微镜(Atomic force microscopy, AFM)和高分辨透射电子显微镜(Transmission electron microscope, TEM)对量子阱的表面和界面进行观察。AFM表面形貌图(图1(a))显示,量子阱表面完全结合且光滑平整,可观察到原子台阶,表面粗糙度仅为0.56 nm;TEM截面图(图1(b))表明,5个周期的量子阱结构完整,阱层呈现为暗区,垒层则为亮区,两者的衬度对比鲜明,界面清晰可辨且平整陡峭。对所获得的表面平整、界面陡峭的AlGaN量子阱样品,我们进行了变温光致发光谱(Photoluminescence, PL)测试以分析AlGaN量子阱的发光机制。实验以钛蓝宝石(Ti∶Sapphire)激光器的三倍频236 nm激光作为激发光源,激光光功率设置为10 mW,温度变化范围为7~300 K。

图1AlGaN量子阱结构材料的AFM表面形貌图(a)和高分辨TEM截面图(b)
Fig.1AFM surface image (a) and TEM interface morphology (b) of AlGaN MQW
3 结果与讨论
所测得的一系列变温归一化PL光谱如图2所示。从图中可以看出,随着温度的降低,PL光谱变化显著。室温下,光谱中仅有位于4.42 eV附近、对应于阱层带边能量的发光带,标记为P1。随着温度的降低,发光峰位发生移动且半高宽变窄。而从140 K开始,在高能位置(4.58 eV附近)出现了一个新的发光峰,标记为P2,且其强度随温度的进一步降低而增大。

图2 AlGaN量子阱的变温PL光谱
为了解P1和P2的起源,我们通过数值计算对AlGaN量子阱中量子能级的跃迁发光进行分析和指认。众所周知,AlGaN材料具有很强的自发极化和压电极化效应,其数值大小足以和传统的铁电材料相比拟;另外,通常AlGaN材料采用异质外延,异质衬底上外延生长将导致AlGaN量子结构通常存在显著的应变,这严重地加剧了量子结构内的压电极化效应[7]。因此,我们在数值计算过程中,采用极化电场作用下的三角势阱Shrödinger方程,计算分析Al0.35Ga0.65N/Al0.45-Ga0.55N量子阱中的量子能级。在三角势阱中,电子或者空穴量子能级的束缚能为[8]:
(1)
且其基态能级的跃迁能量可由下式估算:
(2)
由以上两式可得电子基态能级到空穴激发态的跃迁能量为:
(3)
电子激发态能级到空穴基态的跃迁能量为:
(4)
式中,Eg为阱层的禁带宽度,m*为电子或空穴的有效质量,Fw和Lw分别为阱层的极化场和厚度。其中,Eg和m*的计算均根据Vegard定则在GaN和AlN相应的值间进行线性内插。GaN和AlN中电子和重空穴的有效质量采用Kim等报道的值[9],而低温下的带隙则采用本研究小组在阴极发光中测得的实验值3.51 eV和6.05 eV。
根据(3)和(4)两式可计算出不同极化场下,Al0.35Ga0.65N/Al0.45Ga0.55N量子阱中电子基态到重空穴基态和激发态的跃迁能量E1e-1hh和E1e-2hh,以及电子激发态能级到重空穴基态的跃迁能量E2e-1hh,如图3所示。由图可见,当极化场为1.628 MV/cm时,E1e-1hh、E1e-2hh和E2e-1hh分别为4.454,4.584,4.733 eV。变温PL光谱中,P1和P2在7 K下分别为4.455,4.581 eV,与E1e-1hh和E1e-2hh的值吻合。因此,P1为量子阱中电子基态到重空穴基态的最可几跃迁(1e-1hh),而P2来自于电子基态到更高的重空穴激发态的跃迁(1e-2hh),跃迁示意图如插图所示。
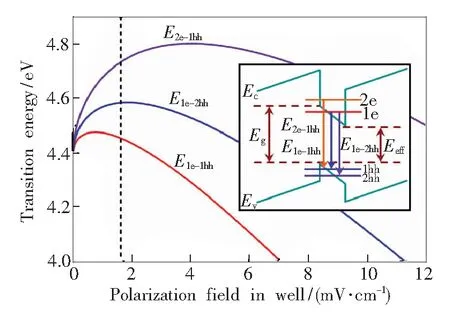
图3AlGaN多量子阱主要量子能级间的跃迁能量与极化场的关系曲线,插图为极化场下量子阱能带结构和电子跃迁示意图。
Fig.3Transition energies between different quantized levels as a function of the polarization field in AlGaN MQW. The inset illustrates the schematic quantized level transitions in a triangular well.
为更加详细地分析AlGaN量子阱的发光机制,我们对图2中的变温PL光谱进行多峰高斯拟合,得到各发光峰在不同温度下的峰位、半高宽(Full width at half maximum, FWHM)以及积分强度等信息。考虑到P2在较高温度下并没有出现明显的发光,我们主要对P1的发光特性和温度特性进行分析,其峰位和半高宽随温度的变化如图4所示。可以看到,P1的发光峰位随温度升高而呈现明显的S型(S-shaped)变化:当温度由7 K升高至160 K时,峰值能量由4.455 eV红移至4.419 eV;随着温度的继续升高(160~240 K),其峰位反而发生蓝移,往高能方向移动约8 meV,最后又红移至室温下的4.419 eV。这种PL谱峰值能量随温度升高的S型变化现象在InGaN[10-11]、AlGaN[12-14]、InAlGaN[15-16]材料以及InGaN/GaN量子阱结构[17-18]中已经被大量的文献报道,而在AlGaN量子阱中则鲜为报道[19-20]。此外,由图可见,PL发光峰位置随温度增加呈S型变化的同时,其半高宽随温度增加呈现W型(W-shaped)变化。这种不寻常的发光行为被认为是局域激子跳跃的特征[15,21-23]。由此可判断,在我们的AlGaN量子阱中,P1发光不是单纯的基态量子能级间的跃迁发光,而是伴随着局域激子的跳跃。其峰位产生S型温度曲线的原因可以解释为:
(1)在7~160 K区间,温度很低,辐射复合占主导,载流子寿命较长且随温度的升高而变长[8],使得非热化激子在复合之前有更多机会通过跳跃(Hopping)重新分布到由阱层厚度和组分起伏导致的势能波动而产生的低能带尾态(Band-tail state),然后发生复合,致使发光峰能量随着温度升高而红移;
(2)随着温度的升高,非辐射复合变得显著,载流子的寿命开始缩短并逐渐趋于不变,激子在复合之前并没有充分的时间跳跃到低能带尾态,而是与晶格达到热平衡即热化而逐渐占据高能态,增加了高能态的复合,于是发光峰能量随着温度的升高而增大,即蓝移;
(3)当温度进一步升高时,非辐射复合占主导,载流子寿命已经降低到一个稳定值,受其影响的蓝移效应减弱,而另一方面局域激子因为热扰动而挣脱了局域势阱的束缚即解局域,变为自由载流子,使温度引起的能带收缩效应(Band-gap shrinkage)增强,表现出普通半导体材料的温度特性,发光峰能量随温度的升高再一次红移。
由此可知,PL发光峰能量随温度变化的第二个拐点代表着绝大多数载流子脱离局域势阱束缚。该拐点的温度值越高,说明所产生的局域势阱越深、激活能越大,密度也越大,载流子脱离局域束缚所需要的热扰动能越大。我们的样品的第二个拐点温度高达240 K,说明量子阱中由于组分和厚度起伏而产生的是较深的局域态。此外,虽然局域化效应表明量子阱中存在着一定的组分和厚度起伏,但同时也带来了好处,因为这类似于InGaN中富In区会形成类量子点的情况,使载流子弛豫并束缚到由此产生的局域态,从而降低了其被非辐射复合中心俘获的几率,有利于提高量子阱的发光效率。

图4 P1的峰值能量和半高宽与温度的关系
Fig.4Temperature dependence of emission energies and FWHM of P1
由于量子阱中存在许多非辐射复合中心,其激活能小于电子和空穴的束缚能,因此,一般而言,PL发光峰积分强度随温度的变化曲线应满足多通道Arrhenius方程[24]:
(5)
其中,I0为低温下的PL发光峰积分强度,Ei为相应的非辐射复合中心的激活能,Ai为与该非辐射复合中心密度相关的常数,kB为玻尔兹曼常数。
单通道的Arrhenius方程并无法和我们的实验数据产生良好的拟合,表明样品中不是只有一种主要的非辐射复合中心。因此,我们考虑两个非辐射复合通道:

(6)
来进行拟合。结果如图5所示。采用双通道Arrhenius方程可以很好地拟合我们的实验数据。由此得到的两种非辐射复合中心的激活能E1和E2分别为48.4 meV和5.4 meV,相应的A1和A2分别为176.9和2.6。激活能E1较大说明量子阱具有较强的量子限制效应,图3中所示的室温下PL光谱半高宽值仅为8.2 nm也说明了这一点。为方便讨论,我们同时在图中以虚线画出两个通道的曲线。对于量子阱,辐射复合的猝灭通道通常被认为与载流子的逃逸和激子的热猝灭有关[25]。采用线性差值估算阱和垒层的带隙并考虑导带和价带带阶比例为7∶3,可算得Al0.35Ga0.65N/Al0.45Ga0.55N量子阱导带带阶为186 meV,远大于激活能E1。因此,激活能较大的非辐射复合并不是因为载流子克服量子阱势垒而溢出。虽然我们的量子阱样品表面完全接合且很平整,但其表面仍显示出密度约为3.12×1010cm-2的位错露头点(图1)。结合激活能E1对应的A1值为176.9,表明此种非辐射中心密度较高,我们推断该非辐射复合与载流子通过位错而流失出量子阱有关。对于第二个猝灭过程,其激活能E2为5.4 meV,与发光峰能量S型移动中的第二段蓝移量8 meV接近,而这第二个温度拐点代表着绝大多数载流子脱离局域势阱束缚,所以该过程描述的是局域激子因温度升高解局域而使自身发光强度减弱。这与其Arrhenius方程在7~80 K的低温区域内与实验数值吻合得很好相一致,同时也表明局域激子解局域引起的发光强度减弱在低温下占主导。而第一个猝灭过程的Arrhenius方程在温度高于100 K后与实验数值吻合得很好,则表明100 K后载流子通过位错引起的非辐射复合占主导。
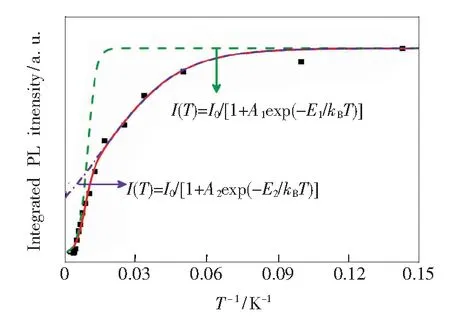
图5 P1的PL积分强度与温度的关系
Fig.5Temperature dependence of integrated PL intensity for P1
4 结 论
采用MOVPE技术,以高质量厚AlN薄膜为模板,成功外延了表面完全接合且原子级平整、界面清晰可辨且陡峭的高Al组分AlGaN多量子阱结构材料。通过对AlGaN多量子阱结构的变温光致发光谱测试,结合数值计算,深入探讨了AlGaN量子阱的发光机制。研究表明:在较高温度时,AlGaN量子阱的发光为电子基态到重空穴基态的跃迁;随着温度的降低,出现了电子基态到重空穴激发态的跃迁辐射。PL发光峰峰位和半高宽随温度的升高分别呈现S型和W型变化,表明量子阱中具有很强的局域化效应,其发光和局域激子的跳跃息息相关,而发光的猝灭则与局域激子的解局域以及位错引起的非辐射复合有关。
[1] 陈航洋,刘达艺,李金钗,等. 高AI组分Ⅲ族氮化物结构材料及其在深紫外LED应用的进展 [J]. 物理学进展, 2013, 33(2):43-56.
CHEN H Y, LIU D Y, LI J C,etal.. Development of high Al content structural Ⅲ nitrides and their applications in deep UV-LED [J].Prog.Phys., 2013, 33(2):43-56. (in Chinese)
[2] 王军喜,闫建昌,郭亚楠,等. 氮化物深紫外LED研究新进展 [J]. 中国科学: 物理学 力学 天文学, 2015, 45(6):067303-1-20.
WANG J X, YAN J C, GUO Y N,etal.. Recent progress of research on Ⅲ-nitride deep ultraviolet light-emitting diode [J].Sci.SinicaPhys.Mech.Astron., 2015, 45(6):067303-1-20. (in Chinese)
[3] BRYAN Z, BRYAN I, XIE J Q,etal.. High internal quantum efficiency in AlGaN multiple quantum wells grown on bulk AlN substrates [J].Appl.Phys.Lett., 2015, 106(14):142107.
[4] ZHUO X L, NI J C, LI J C,etal.. Band engineering of GaN/AlN quantum wells by Si dopants [J].J.Appl.Phys., 2014, 115(12):124305-1-4.
[5] ZHUANG Q Q, LIN W, YANG W H,etal.. Defect suppression in AlN epilayer using hierarchical growth units [J].J.Phys.Chem. C, 2013, 117(27):14158-14164.
[6] BANAL R G, FUNATO M, KAWAKAMI Y. Extremely high internal quantum efficiencies from AlGaN/AlN quantum wells emitting in the deep ultraviolet spectral region [J].Appl.Phys.Lett., 2011, 99(1):011902-1-3.
[7] LEROUX M, GRANDJEAN N, LAÜGT M,etal.. Quantum confined stark effect due to built-in internal polarization fields in (Al, Ga)N/GaN quantum wells [J].Phys.Rev. B, 1998, 58(20):R13371-R13374.
[8] BASU P K.TheoryofOpticalProcessesinSemiconductors:BulkandMicrostructures[M]. New York: Oxford University Press Inc., 2003.
[9] KIM K, LAMBRECHT W R L, SEGALL B,etal.. Effective masses and valence-band splittings in GaN and AlN [J].Phys.Rev. B, 1997, 56(12):7363-7375.
[10] SCHENK H P D, LEROUX M, DE MIERRY P. Luminescence and absorption in InGaN epitaxial layers and the van Roosbroeck-Shockley relation [J].J.Appl.Phys., 2000, 88(3):1525-1534.
[11] MOON Y T, KIM D J, PARK J S,etal.. Temperature dependence of photoluminescence of InGaN films containing In-rich quantum dots [J].Appl.Phys.Lett., 2001, 79(5):599-601.
[12] CHO Y H, GAINER G H, LAM J B,etal.. Dynamics of anomalous optical transitions in AlxGa1-xN alloys [J].Phys.Rev. B, 2000, 61(11):7203-7206.
[13] LI J, NAM K B, LIN J Y,etal.. Optical and electrical properties of Al-rich AlGaN alloys [J].Appl.Phys.Lett., 2001, 79(20):3245-3247.
[14] CHUNG S J, SENTHIL KUMAR M, LEE H J,etal.. Investigations on alloy potential fluctuations in AlxGa1-xN epilayers using optical characterizations [J].J.Appl.Phys., 2004, 95(7):3565-3568.
[15] CHEN C H, HUANG L Y, CHEN Y F,etal.. Mechanism of enhanced luminescence in InxAlyGa1-x-yN quaternary alloys [J].Appl.Phys.Lett., 2002, 80(8):1397-1399.
[16] KAZLAUSKAS K, TAMULAITIS G, ŽUKAUSKAS A,etal.. Localization and hopping of excitons in quaternary AlInGaN [J].Phys.Stat.Sol.(c), 2002(1):512-515.
[17] CHO Y H, GAINER G H, FISHER A J,etal.. “S-shaped” temperature-dependent emission shift and carrier dynamics in InGaN/GaN multiple quantum wells [J].Appl.Phys.Lett., 1998, 73(10):1370-1372.
[18] KAZLAUSKAS K, TAMULAITIS G, POBEDINSKAS P,etal.. Exciton hopping in InxGa1-xN multiple quantum wells [J].Phys.Rev. B, 2005, 71(8):085306.
[19] WANG T, LIU Y H, LEE Y B,etal.. 1 mW AlInGaN-based ultraviolet light-emitting diode with an emission wavelength of 348 nm grown on sapphire substrate [J].Appl.Phys.Lett., 2001, 81(14):2508-2510.
[20] YASAN A, MCCLINTOCK R, MAYES K,etal.. Photoluminescence study of AlGaN-based 280 nm ultraviolet light-emitting diodes [J].Appl.Phys.Lett., 2003, 83(20):4083-4085.
[21] KAZLAUSKAS K, ŽUKAUSKAS A, TAMULAITIS G,etal.. Exciton hopping and nonradiative decay in AlGaN epilayers [J].Appl.Phys.Lett., 2005, 87(17):172102-1-3.
[22] TARASENKO S A, KISELEV A A, IVCHENKO E L,etal.. Energy relaxation of localized excitons at finite temperature [J].Semicond.Sci.Technol., 2001, 16(6):486-492.
[23] BARANOVSKII S D, EICHMANN R, THOMAS P. Temperature-dependent exciton luminescence in quantum wells by computer simulation [J].Phys.Rev. B, 1998, 58(19):13081-13087.
[24] DEAN P J. Absorption and luminescence of excitons at neutral donors in gallium phosphide [J].Phys.Rev., 1967, 157(3):655-667.
[25] SUN Y P, CHO Y H, KIM H M,etal.. High efficiency and brightness of blue light emission from dislocation-free InGaN/GaN quantum well nanorod arrays [J].Appl.Phys.Lett., 2005, 87(9):093115-1-3.

李金钗(1979-),女,福建漳平人,高级工程师,硕士生导师,2008年于厦门大学获得博士学位,主要从事Ⅲ族氮化物半导体材料及其器件应用的研究。
E-mail: jinchaili@xmu.edu.cn
Emission Mechanism of High Al-content AlGaN Multiple Quantum Wells
LI Jin-chai1*, JI Gui-lin1, YANG Wei-huang1, JIN Peng2,
(1.FujianProvincialKeyLaboratoryofSemiconductorsandApplications,CollaborativeInnovationCenterforOptoelectronicSemiconductorsandEfficientDevices,DepartmentofPhysics,XiamenUniversity,Xiamen361005,China; 2.KeyLaboratoryofSemiconductorMaterialsScience,InstituteofSemiconductors,ChineseAcademyofSciences,Beijing100083,China)
*CorrespondingAuthor,E-mail:jinchaili@xmu.edu.cn
The quantum efficiency of deep UV light emitting diodes (LED) drops dramatically with the increasing of Al content. Understanding the emission mechanism of high Al-content AlGaN multiple quantum wells (MQW) is the one of the most important objects for improving the quantum efficiency of deep UV LED. In this work, high Al-content AlGaN MQW structure with atomically flat hetero-interfaces was grown and characterized by photoluminescence (PL) measurements at different temperatures. The results indicate that there is a strong exciton-localization effect in the MQW structure and the emission is closely related to the hopping of the excitons. Due to the exciton delocalization and nonradiative recombination at defects, the PL intensity is strongly quenched at high temperatures.
AlGaN; MQW; deep UV-LED; emission mechanism
1000-7032(2016)05-0513-06
2016-01-18;
2016-03-03
“973”国家重点基础研究发展计划(2012CB619300); “863”国家高技术研究发展计划 (2014AA032608); 国家自然科学基金(U1405253,61227009,11204254,11404271); 福建省自然科学基金(2015J01028)资助项目
O472
A
10.3788/fgxb20163705.0513

