硅抛光片表面疏水改性工艺研究
黄 彬,冯琬评
(中国电子科技集团公司第四十六研究所,天津 300220)
硅抛光片表面疏水改性工艺研究
黄 彬,冯琬评
(中国电子科技集团公司第四十六研究所,天津 300220)
采用稀释HF溶液对亲水性的硅抛光片表面进行了疏水改性,并对HF腐蚀硅片表面氧化层、钝化表面的机理进行了分析。研究了HF溶液浓度和反应时间对硅抛光片表面颗粒度和接触角的影响,通过对比分析,得到了HF溶液疏水改性的最佳浓度和最佳反应时间,HF体积比为3%,反应时间为120 s时,HF能够与样品表面充分反应,并且二次吸附颗粒数量最少。采用兆声溢流方式可以大大减少样品表面吸附颗粒数量,而不影响疏水性能。
疏水改性;接触角;颗粒度;兆声溢流
随着半导体技术中电子元器件尺寸的逐步减小,对衬底材料表面洁净度的要求越来越高。亲水性的硅抛光片表面以OH离子为终端,暴露在空气中表面会形成一层本征氧化层,该氧化层存在着不稳定性,容易引起电荷缺陷中心,从而影响器件的电学参数,增加器件的串联电阻等。疏水性的硅抛光片表面以低化学势能的原子为终端,形成一个钝化的表面,可以避免氧化层的生成。在一些高压大功率器件的硅-硅键合工艺中,功率器件的电流从键合界面流过,要求键合界面像外延界面那样没有本征氧化层作为中间夹层,是完全意义上的硅与硅的连接,这就要求衬底材料在应用于器件制造前,先要去除表面的氧化层,进行疏水改性。在湿化学清洗方法中,采用稀释HF溶液清洗是除去硅片表面自然氧化层、形成疏水表面的有效方法,采用这种方法清洗可使硅抛光片表面钝化,抑制自然氧化膜的形成。
本文对HF腐蚀硅片表面氧化层,形成钝化表面的机理进行了分析。研究了HF酸溶液浓度和浸泡时间对硅抛光片表面颗粒度和润湿性的影响,进一步通过改进方案,有效减少了疏水化改性过程中造成的二次污染颗粒数量。
1 实验过程
1.1 实验流程
本实验所用硅片为采用SC-1清洗,并在聚光镜式强光灯下检验合格的硅单面抛光片,将合格片分组,进行正交实验,分别在不同浓度HF酸溶液浸泡一定时间,或在一定浓度HF酸溶液中浸泡不同时间,再用QDR快排喷淋4次,冲去表面残留化学试剂,甩干后检验表面,并进行表面颗粒度和接触角测试。
1.2 改进方案
将QDR快排喷淋4次改为去离子水兆声溢流清洗8 min,其他实验条件不变。
1.3 实验和测试用仪器设备
QDR采用VERTEQ小型清洗机;表面颗粒度测试采用Topcon Wm-7S表面分析仪;接触角测试用承德金和仪器制造有限公司JY-PHB型接触角测定仪。
2 实验结果与分析
2.1 HF腐蚀及钝化硅抛光片表面机理分析
根据热力学和动力学原理,H2O的参与,可以有效降低HF腐蚀硅氧化层的能量势垒,所以HF腐蚀硅片表面氧化层的过程是在H2O的催化作用下进行。图1所示为HF腐蚀硅抛光片表面过程示意图,反应过程可分为四步:前两步是HF在H2O的催化作用下与硅片表面最外层硅原子反应,使Si-OH键断开,形成2个Si-F键脱去2分子H2O(图1中(a)~(e)),后两步是打开最外层和次外层Si之间形成的Si-O-Si键,在次外层两个Si上分别形成一个Si-OH键,最外层Si最终生成SiF4从表面脱落(图1中(e)~(i)),完成了表面剥离过程。HF腐蚀硅表面氧化层的反应依上述步骤反复进行,最终完全剥离表面氧化层,形成以F离子为终端的硅抛光面,使硅片表面能降低,形成疏水表面。该表面钝化,不能与H2O发生反应,从而避免了表面暴露在空气中再次被氧化。
2.2 HF溶液浓度对改性硅抛光片表面接触角和颗粒度的影响
表1中所示为不同浓度HF改性硅抛光片接触角的数据,其中1号样品为未用HF溶液改性的样品,2-6号样品分别为在体积比为0%、1%、2%、3%、4%、5%HF溶液中浸泡60s的样品,从数据可以看出,经过HF改性后,样品表面接触角明显增大,并且随着HF溶液浓度的增大,样品接触角逐渐增大,在HF溶液浓度增大为3%时,接触角为58.9°,进一步增大HF浓度,接触角变化不明显。这是因为当HF浓度较小时,样品表面与HF反应不充分,表面的-OH键没有完全被-F键取代,而当浓度增大的3%时,反应较为充分,再进一步增大HF溶液浓度对样品表面化学键的改变影响不大。图2(a)(b)分别为未用HF改性和采用3 Vol%HF浸泡60 s的样品接触角测试图片。
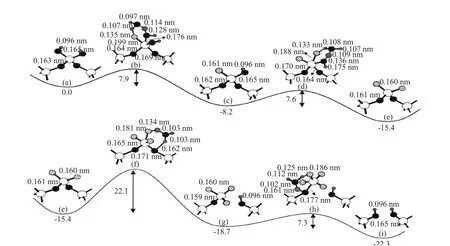
图1 HF腐蚀硅片表面氧化层过程示意图

表1 不同浓度HF改性硅抛光片接触角数据
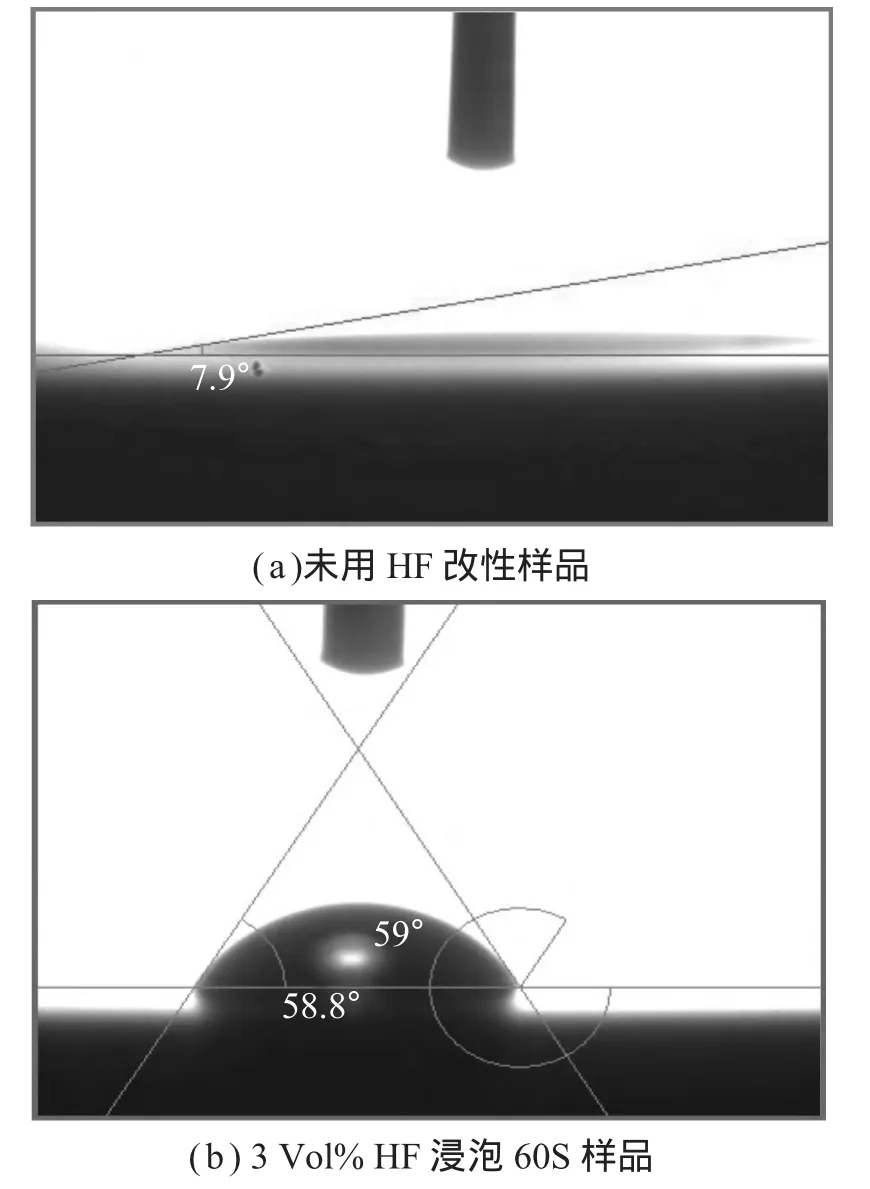
图2 样品表面接触角测试图片
采用酸性试剂清洗硅片时,由于硅片表面本身带负电,而溶液中的颗粒带正电,在样品表面与溶液中的颗粒之间的库伦引力作用下,硅片表面很容易吸附大量颗粒,形成二次污染,而样品表面吸附颗粒的能力与颗粒所带正电荷以及样品表面负电荷多少均有关。表2为不同浓度HF改性硅抛光片表面颗粒度数据,我们可以看到,随着HF溶液浓度的增大,硅片表面吸附颗粒的数量呈先增大后减小再增大的趋势。这是因为HF浓度较小时,样品表面未能与HF充分反应,表面悬挂的-F键未达到饱和,而溶液中颗粒所带正电荷会随着溶液中H+浓度的增大而增大,所以与样品表面的静电吸引力会增强,吸附在样品表面的颗粒数量会增多;而当HF溶液浓度增大到3%时,反应充分,表面-OH键基本完全被-F键取代,表面能达到最低,使得样品表面的电负性减弱,削弱了样品表面与颗粒间的静电吸引力。进一步增大HF浓度,样品表面的电负性基本不变,而溶液中颗粒所带正电荷增多,与表面静电引力增强,表面附着颗粒数量也进一步增多。综合上述分析,当HF浓度为3%时,表面吸附颗粒数量最少。
2.3 HF反应时间对硅抛光片表面颗粒度和接触角的影响
本组实验将1-5号样品在3%HF溶液中分别浸泡了 30 s、60 s、90 s、120 s、180 s,研究了反应时间对样品接触角和表面颗粒度的影响。表3所示为改组样品的接触角数据,表4是本组样品表面颗粒度测试数据,从结果可以看到,随着反应时间的延长,样品表面吸附颗粒数量逐渐减少,反应时间为120 s时,样品表面吸附颗粒数量最少,进一步延长反应时间,表面吸附颗粒数量增多。这是因为适量延长反应时间,有利于H+在样品表面聚集,减弱表面的电负性,而HF溶液浓度不变,溶液中颗粒表面所带正电荷的数量不变,从而使样品表面和颗粒之间的静电吸附能力减弱,有利于减少表面颗粒的吸附量。当样品表面弱束缚的H+数量达到饱和后,样品表面和颗粒之间的静电吸引力不会再有太大变化,进一步延长浸泡时间,会增大颗粒附着在样品表面几率,所以颗粒数量会增多。样品的接触角除了与样品表面能大小有关系外,还与样品表面粗糙度有一定关系,增大表面粗糙度,接触角会增大,样品表面颗粒度增多,会使样品粗糙度增大,所以随着反应时间(≥60 s)的延长,样品表面接触角会随颗粒度出现先减小后增大的趋势,而当浸泡时间为30 s时,样品与HF反应不充分,所以接触角较小。

表1 不同浓度HF改性硅抛光片接触角数据

表3 HF浸泡不同时间硅抛光片接触角数据

表4 HF浸泡不同时间硅抛光片颗粒度
2.4 不同冲水方式对样品表面颗粒度和接触角的影响
将在3 Vol%HF溶液中浸泡60 s的样品,分别采用QDR快排喷淋4次和兆声溢流8 min两种方式冲去样品表面残留化学试剂。通过对两组样品表面颗粒度和接触角的测试,对比了不同冲水方式对样品影响。表5所示为两种方案所得样品表面颗粒度测试数据,从结果可知,采用兆声溢流可以明显减少样品表面吸附颗粒,这是因为采用兆声溢流时,兆声时间延长,有利于二次污染颗粒的去除;而采用QDR喷淋时,晶片表面与空气接触,由于表面疏水,没有水膜起到保护作用,容易沾染空气中的颗粒。图3(a)、(b)分别为两种方式得到样品表面颗粒分布图。图4(a)、(b)分别是两种方案所得样品接触角测试图片,采用QDR快排喷淋样品为58.9°,采用兆声溢流8 min样品为58.4°,无明显变化,说明采用兆声溢流的方法不仅可以有效减少晶片表面颗粒,同时对晶片表面的疏水性能无影响。

表5 不同冲水方式对硅抛光片表面颗粒度
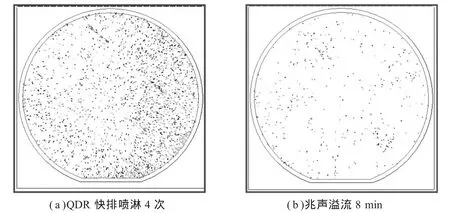
图3 不同冲水方式样品表面颗粒分布图
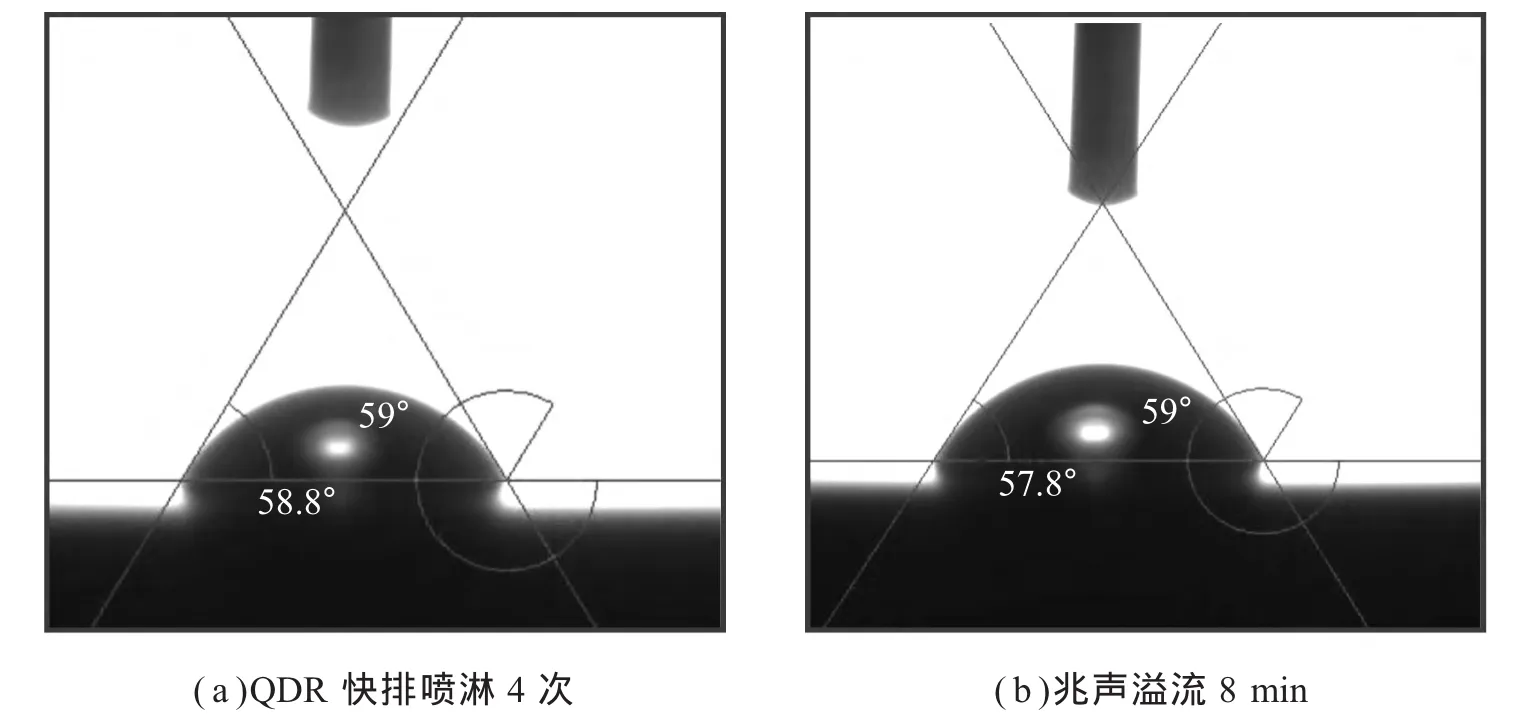
图4 不同冲水方式样品表面接触角
3 结 论
本文通过改变HF溶液浓度和反应时间,研究了这两个参数在HF腐蚀硅抛光片表面氧化层过程中的作用规律。实验结果表明,适当增大HF溶液浓度、延长反应时间,可使反应进行充分,得到表面颗粒吸附量较小,接触角较大的疏水硅抛光片,当HF Vol%为3%,反应时间为120 s时,实验效果最佳。将QDR快排喷淋的冲水方式改为兆声溢流,可大大减少二次污染颗粒的数量,并对样品表面疏水性没有明显影响。
:
[1]Jeung Ku Kang,Charles B.Msgrave.The mechanism of HF/H2O chemical etching of SiO2[J].Journal of Chemical Physics,2002(116):275-280.
[2]T.Hoshino,Y.Nishioka.Etching process of SiO2by HF molecules[J].Journal of Chemical Physics,1999(111):2109-2114.
[3]G.W.Trucks,Krishnan Raghavachari,G.S.Higashi,et al.Mechanism of HF Etching of Silicon Surfaces:A Theoretical Understanding of Hydrogen Passivation[J].Physical Review Letters,1990(65):504-507.
[4]何进,王新,陈星弼.硅-硅直接键合的亲水处理及界面电特性[J].微电子学,1999,29(5):178-181.
[5]何国荣,陈松岩,谢生.Si-Si直接键合的研究及应用[J].半导体光电,2003,24(3):149-153.
Modification of Silicon Surface Hydrophobic Wafers
HUANG Bin,FENG Wanping
(The 46thResearch Institute,CETC ,Tianjin 300220,China)
Abstract:In this paper,the surface of silicon wafers dilute HF solution on the hydrophilicity of the hydrophobic modification,and the HF oxidation silicon surface layer,surface passivation mechanism was analyzed.The effects of HF concentration and reaction time on the particle surface of silicon wafers and contact angle,through the comparative analysis,the optimal concentration of HF aqueous solution of hydrophobically modified and the optimal reaction time,HF volume ratio is 3%,reaction time was 120 seconds,HF can fully react with the surface of the sample,and two times of adsorption the least number of particles.The megasonic overflow can greatly reduce the number of adsorption of sample surface particles,without affecting the hydrophobic properties.
Keywords:Hydrophobically modified;Contact angle;Particle size;Megasonic overflow
TN305
A
1004-4507(2014)07-0013-06
2014-06-26
黄彬(1986-)男,天津人,助理工程师,现从事半导体材料晶体加工及晶片表面处理工作。
冯婉评(1987-)女,天津人,硕士研究生,主要从事半导体材料研究及集成电路用单晶抛光片的加工工作。

