基于光致抗蚀干膜的掩膜制备及其应用研究
曾永彬,蔡伟伟,李寒松,陈晓磊,张西方
(南京航空航天大学机电学院/江苏省精密与微细制造技术重点实验室,江苏南京 210016)
基于光致抗蚀干膜的掩膜制备及其应用研究
曾永彬,蔡伟伟,李寒松,陈晓磊,张西方
(南京航空航天大学机电学院/江苏省精密与微细制造技术重点实验室,江苏南京 210016)
在传统工艺流程中,必须先将干膜贴于工件表面,然后进行光刻,但干膜不可重复使用。现提出一种新型干膜光刻工艺流程,在干膜贴于工件表面之前,先对干膜单独进行光刻试验研究。基于该新型工艺流程,研究了杜邦干膜GPM220的曝光及显影特性。经过对曝光量(曝光时间)及显影时间的参数优化,最终在干膜上获得了平均直径为99.7 μm的通孔阵列,并将其作为掩膜应用于微细电解加工,通过选择合理的加工参数,在工件表面获得了平均直径为125 μm、平均深度为10 μm的微坑阵列。电解实验后的干膜易与工件分离,可实现重复使用,提高了干膜的利用率。
光致抗蚀剂(干膜);曝光;显影;掩膜电解
机械运动中总是不可避免地产生摩擦,研究表明,物体表面具有一定的表面织构,会对其摩擦特性产生明显影响[1-2]。目前,表面织构的加工技术有机械振动加工[3]、电火花加工[4]、激光加工[5]、磨料气射流加工[6]及掩膜电解加工[7]等。其中,掩膜电解加工将光刻工艺与电解加工相结合,是一种高品质的无应力加工方法。光刻胶作为光刻工艺的核心材料,主要分为液态光刻胶和固态光刻胶两种。目前,光刻以液态光刻胶为主,如SU-8胶等;但液态光刻胶需经过匀胶、前烘、曝光、后烘、显影等步骤,工序较复杂,且经常出现光刻胶厚度不均匀的现象[8]。
光致抗蚀干膜(俗称干膜)作为一种新型光敏有机材料,属于固态光刻胶,光刻时避免了匀胶、前烘、后烘等工序,且厚度较均匀。自1968年杜邦公司提出干膜以来,其已被成熟地应用于印刷线路板(printed circuit board,PCB)的制造工艺中[9]。近年来,国内外学者对干膜的研究做了较多的探索。Petr Smejkal等[10]利用干膜光刻工艺制造出了嵌入式微流控芯片,并成功应用于人类血清乳酸的检测分析。Steven等[11]提出使用干膜进行基于显微镜的无掩膜微成像研究。秦健等[12]对一种新型的丙烯酸酯干膜光刻胶的曝光及显影特性进行了研究,并将其成功应用于微沟道结构的制造。朱昊枢等[13]对干膜光刻的贴膜、曝光和显影等工艺参数进行优化,并将其应用于深槽刻蚀。琚金星[14]提出采用光致抗蚀干膜代替传统光刻胶作为微细掩膜电解加工的掩膜,在工件表面获得了平均直径为319.3 μm、群凹坑直径标准差为25.7 μm的15×15圆形凹坑阵列。上述关于干膜的光刻工艺都需先将干膜与工件贴紧,再进行干膜曝光等步骤。该传统工艺中,干膜与工件经高温贴合,加工后的干膜不易与工件分离,因此干膜仅为一次性使用,利用率较低。本文提出一种新型干膜光刻工艺流程,直接对干膜单独进行曝光、显影工艺研究,制出满足要求的干膜,再将其作为掩膜应用于微细电解加工试验。经光刻后的干膜硬度提高,粘性下降,电解试验后易与工件分离,可实现干膜的重复使用,提高了其利用率。
1 试验原理
干膜光刻工艺主要包括曝光和显影两大步骤。由于本试验在干膜曝光之前无需贴膜,为保证干膜曝光时能放置平整,设计了干膜夹持装置(图1)。将干膜平铺于基台上,并用压紧环压紧。基于干膜的掩膜制备及掩膜电解加工工艺流程见图2。

图1 干膜曝光前的夹持装置
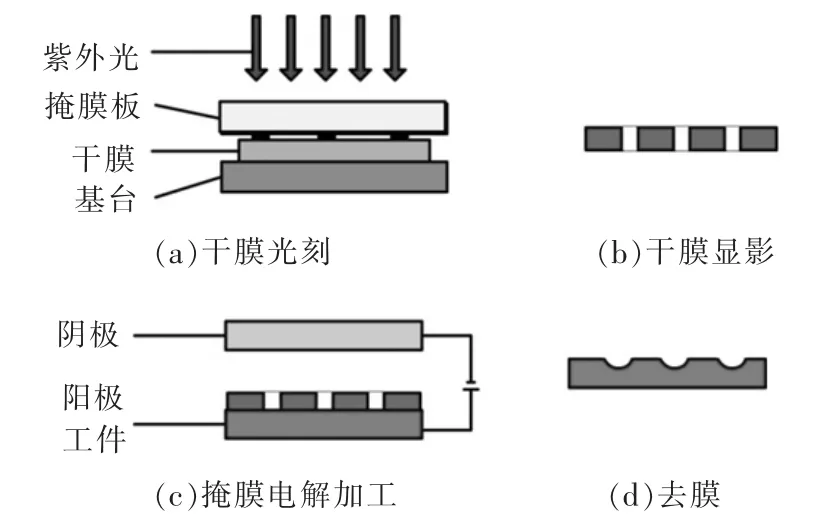
图2 掩膜制备及电解加工工艺流程图
本试验采用的掩膜板可分为阵列分布的圆形不透光区域及其余的透光区域。进行曝光时,紫外光线无法穿透不透光区域,故相应区域的干膜无法照射到紫外光线。由于选用的干膜是一种负性光刻胶,干膜被紫外光线照射的区域会发生交联反应,形成不溶于显影液的大分子结构,其余未被照射的区域可溶于显影液。因此,显影后的干膜上便会出现阵列通孔结构。
2 试验研究
本试验采用杜邦干膜GPM220系列(图3),干膜主要由三部分组成:聚乙烯膜是一层保护膜,防止灰尘等污物玷污干膜,避免在卷膜时感光胶层的相互粘连;感光胶层是干膜的主体,黏性较大,厚度为50 μm;聚酯薄膜是支撑感光胶层的载体,具有一定的硬度。

图3 干膜结构图
试验选取规格为4英寸的掩膜板,板面阵列分布着直径100 μm、中心距300 μm的圆形不透光区域。按GPM220系列的给定参数,本试验采用的显影液为质量分数1%、温度25℃的碳酸钠溶液。
3 工艺参数试验及分析
3.1 曝光试验
由于本工艺流程在曝光前不用去除干膜的保护膜,而试验中紫外光对底层聚乙烯保护膜会产生反射、折射等现象,对感光胶层产生影响,与传统曝光工艺有一定区别。因此,本工艺流程必须研究曝光参数对干膜成像的影响。
试验采用BG-401型的曝光机,高压汞灯的功率为350 W,波长为365 nm。试验选择接触式曝光,其曝光功率密度I为70 mW/cm2,则总曝光量E的表达式为:

式中:T为曝光时间。
根据式(1)可知,由于I为定值,曝光量将随着曝光时间的增加而增大。本试验分别选取曝光时间为1、2、3、4、5、6 s,干膜显影时间为90 s,进而研究不同曝光时间对干膜上阵列通孔尺寸的影响。
曝光后,干膜曝光的部分颜色较深,与未曝光部分区别明显,曝光后的感光胶层硬度有一定提高,黏性相对下降。由图4可知,曝光1 s时,干膜已曝光充分;当曝光时间达到2 s后,圆孔周围开始出现明显的黑影区域;当曝光时间达到6 s时,感光胶层的脆性增加,圆孔直径尺寸变小。

图4 不同曝光时间干膜上的圆孔
图5是不同曝光时间下,在干膜各个区域随机选取20个阵列通孔中的最大及最小尺寸变化趋势。可看出,曝光前2 s,干膜上的阵列通孔直径变化不明显,均可满足要求;但随着曝光时间继续增加,干膜表面的通孔直径有减小的趋势。这是由于紫外光线经底层聚乙烯薄膜时,会有少部分的能量反射到干膜被掩膜板遮住的区域上;曝光时间较短时,反射总能量较低,无法使干膜发生交联反应。随着时间的增加,反射光聚集的总能量达到交联反应要求,致使显影后的通孔孔径变小。此外,随着曝光时间的增加,干膜上各个区域孔径的均匀性降低。相关研究表明[15]:干膜的分辨率会随着其曝光度增大而降低,因而采用1 s的曝光时间最佳。

图5 不同曝光时间的干膜通孔尺寸
3.2 显影试验
显影时间是干膜显影质量的重要影响因素。在本工艺流程中,显影前先将干膜的两层保护膜剥去,由于干膜在显影时并未贴着工件,干膜的两面均会接触显影液,而根据传统的工艺方法,干膜只有单面接触显影液,因而必须研究显影时间对干膜的影响。
试验中的掩膜板规格不变,曝光时间选取1 s,分别选用10、30、60、90、120、240 s的显影时间进行显影。不同显影时间测量的干膜上的圆孔见图6。可看出,显影前30 s,由于显影时间不充分,光致抗蚀剂层未感光部分的活性基团与稀碱溶液还不能进行充分反应,无法全部溶解;当显影时间达到60 s时,大部分未曝光部分已溶解,但边缘仍会有些许残留;当显影时间达到90 s时,显影已很充分;当显影时间为240 s时,孔径明显变大。

图6 不同显影时间干膜上的圆孔
图7是不同显影时间下,在干膜各个区域随机选取20个阵列通孔中的最大及最小尺寸变化趋势。可看出,当显影时间在90~120 s区间时,干膜孔径变化不明显,体现了干膜的耐显影性(耐显影性指干膜显影时间可超过的程度,反映了显影工艺的宽容度);随着显影时间继续增加,干膜通孔直径有增大的趋势。这是因为干膜作为一种负性光刻胶,具有溶胀性,显影时间过长,干膜已曝光部分开始溶胀,而使通孔直径变大,干膜分辨率和重现性降低;当显影时间超过240 s,干膜曝光的部分开始逐渐溶解于显影液,无法再作为后续电解的掩膜使用。考虑到显影时间短,可提高加工效率,故采用90 s的显影时间最佳。

图7 不同显影时间的干膜通孔尺寸
3.3 参数优化
根据上述试验所得结果,本文得出优化后的参数为曝光时间1 s、显影时间90 s,在干膜上加工出阵列通孔结构,微孔平均直径为99.7 μm。图8是显微镜下观察到的干膜通孔阵列的二维形貌。图9是在干膜各个区域随机选取20个通孔测得的孔径尺寸图,可见在测量误差允许的范围内,使用优化参数制备的干膜上的通孔尺寸均匀,符合要求。
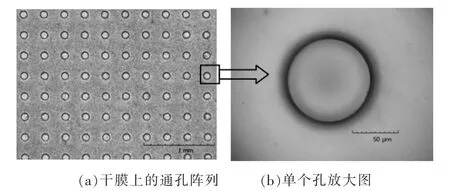
图8 干膜上的通孔阵列结构

图9 干膜上随机抽样的通孔尺寸
4 干膜在掩膜电解中的应用
将经过参数优化制备的干膜作为电解加工的掩膜,采用压紧装置保证干膜与工件的贴合,再将其放入烘箱(控制温度为50℃),经1 min烘干处理后进行电解加工。电解加工试验系统见图10,该系统主要包括机床主体、电解液循环系统、电源系统、过滤系统及夹具。

图10 电解加工试验系统图
实验所用的电解液是10%的NaNO3溶液,电解加工温度控制在(30±2)℃,加工电解液压力为0.04 MPa。当加工电压为14 V、加工时间为10 s时,测得工件表面微坑形貌的SEM照片见图11。利用三维视频显微镜测得单个微坑的三维形貌及截面见图12。
5 结论
(1)提出了一种新型干膜光刻工艺流程,在干膜贴于工件表面之前,先对干膜单独进行光刻试验研究。

图11 工件表面微坑形貌SEM图

图12 单个微坑的三维形貌及截面图
(2)研究了曝光量(曝光时间)、显影时间对干膜上的阵列通孔的影响。结果表明:曝光量和显影时间对微孔影响显著。采用优化参数,在干膜上加工出平均直径为99.7 μm的通孔阵列。
(3)成功地将经过光刻的干膜作为掩膜应用于电解加工,在工件表面加工出平均直径为125 μm、平均深度为10 μm的微坑阵列,并可实现干膜的重复使用。
[1]历建全,朱华.表面织构及其对摩擦学性能的影响[J].润滑与密封,2009,34(2):94-97.
[2]马晨波,朱华,张文谦,等.往复条件下织构表面对摩擦学性能的影响[J].摩擦学学报,2011,31(1):51-55.
[3]钟美鹏,张云电.振动冲击微坑加工原理及微坑结构参数的确定[J].内燃机工程,2004,25(2):81-83.
[4]Pham D T,Dimov S,Bigot S,et al.Micro-EDM recent developments and research issues[J].Journal of Materials Processing Technology,2004,149(1):50-57.
[5]Voevodin A A,Zabinski J S.Laser surface texturing for adaptive solid lubrication[J].Wear,2006,261(11-12):1285-1292.
[6]任延岿,吕玉山,孙建章.微磨料气射流加工机理实验研究[J].沈阳理工大学学报,2007,26(5):6-9.
[7]Qian Shuangqing,Zhu Di,Qu Ningsong,et al.Generating micro-dimples array on the hard chrome-coated surface by modified through mask electrochemical micromachining[J].International Journal of Advanced Manufacturing Technology,2010(47):1121-1127.
[8]Abgrall P,Conedera V,Camon H,et al.SU-8 as a structural material for labs-on-chips and micro electromechanical systems[J].Elecrophoresis,2007,28(24):4539-4551.
[9]Dietz K H.Dry film photoresist processing technology[M]. USA:Eletrchemical publications ltd,2001.
[10]Smejkal P,Breadmore M C,Guijt R M,et al.Analytical isotachophoresis of lactate in human serum using dry film photoresist microfluidic chips compatible with a commercially available field-deployable instrument platform[J]. Analytica Chimica Acta,2013,803:135-142.
[11]Leigh S Y,Tattu A,Mitchell J S,et al.Microscope-based maskless micropatterning with dry film photoresist[J]. Biomed Microdevices,2011,13(2):375-381.
[12]秦健,刘泽文,钟艳,等.丙烯酸酯干膜光刻胶曝光特性及其应用[J].微纳电子技术,2011(7):454-459.
[13]朱昊枢,胡进,朱新生.用于微电子机械系统的干膜光刻工艺研究[J].苏州大学学报,2011,27(4):53-56.
[14]琚金星.阳极掩膜微细电解加工微小凹坑试验研究[D].大连:大连理工大学,2013.
[15]董岩.光致抗蚀干膜的制备及性能研究[D].广州:华南理工大学,2012.
The Fabrication of Mask Base on Dry-film Photoresist and its Application
Zeng Yongbin,Cai Weiwei,Li Hansong,Chen Xiaolei,Zhang Xifang
(Nanjing University of Aeronautics and Astronautics,Nanjing 210016,China)
In the traditional process,the dry-film is photoetched after it is sticked on the surface of the workpiece,but it can not be used repeatly.A new technological process of the dry-film is put forward,which the photoetching is proceeded with the dry-film before it pasting.Based on this process,the properties of exposure and development are studied.Optimizing the parameters,the micro throughhole array with diameter 99.7 μm is well generated in the dry-film,and it is successfully employed in the through-mask electrochemical micromachining.Selecting reasonable parameters,the micro-dimple array with diameter 125 μm and 10 μm deepth is well prepared on the workpiece.The dry-film is liable to separate from the workpiece and is used repeatly,thus its utilization is higher.
dry-filmphotoresist;exprosure;development;through-maskelectrochemical micromachining
TG662
A
1009-279X(2014)05-0024-04
2014-06-04
广东联合基金重点项目(U1134003);航空科学基金资助项目(2012ZE52068)
曾永彬,男,1978年生,副教授。

