一款数字信号处理器的失效分析研究
王月玲,黄旭东
(中国电子科技集团公司第58研究所,江苏 无锡 214035)
1 引言
集成电路在实际应用中,经常会出现工作异常甚至失效的情况。当电路发生失效时,需要采用各种手段尽快定位问题所在,随后在本地复现相关现象,明确问题原因,进而提出针对性的解决方案。本文介绍了一款数字信号处理器电路的失效分析过程,对于相关集成电路的失效分析具有一定的参考价值和借鉴意义。
2 电路简要工作原理
失效芯片是一款高性能32位定点数字信号处理器,电路规模大约100万门,采用0.18 μm工艺制造,端口电压3.3 V,内核电压1.8 V。端口间插入去耦电容以提升电路的ESD性能。
3 问题反馈
用户反馈,该DSP电路在使用时,在两种不同的供电方式下,电路工作状态出现不同。用户的基本应用框图如图1所示。电源与电路板之间接有开关S1,电路板上有三个电源电路LDO1、LDO2、LDO3。其中LDO1、LDO2实现5 V转3.3 V,LDO3实现5 V转1.8 V。应用板上U1为DSP电路,其他三个器件U2、U3、U4分别连接至U1的IO口及总线上,LDO1为U1的端口及U2提供3.3 V的电源,LDO2为U3及U4供电,LDO3为U1的内核部分提供1.8 V电源。
用户采用以下两种方式供电,方式1:开关S1保持常开,通过电源上下电,电路板工作正常。供电方式2:电源一直开启,通过闭合开关S1进行上电控制,这时电路板工作异常,U1发热,电源电流翻倍,从原来的520 mA增大至1.2 A。

图1 用户线路板供电示意图
现场通过示波器监控发现,LDO2的3.3 V输出较LDO1的3.3 V输出早300 μs左右。LDO2是给U1电路的外围电路U3、U4供电,外围电路如果先于DSP上电,将出现先有信号后上电的情况。从故障现象以及我们以往的经验,怀疑是否因为上电顺序造成DSP电路内部某些结构触发,从而形成电流通路,造成电流瞬间变大。我们在现场将LDO2拆掉,按照供电方式2再次上电,虽然系统功能失去了,但是电流恢复正常,电路发热现象消失,初步证实电流变大和电路上电顺序存在关系。
上电先后顺序会造成系统板上电流突然变大,从而影响电路正常工作,我们怀疑是DSP电路端口出现闩锁,因此进行了进一步的失效分析。
4 失效分析
根据在用户现场的试验分析,我们怀疑失效DSP电路的端口出现闩锁,首先制定了针对该电路端口特点的Latch-up试验方案,接着又从应用角度对该现象进行复现,借助EMMI设备协助定位故障点,并结合理论,对该现象产生的合理性进行了分析,定位了失效点,并最终确定合理的改版方案。
4.1 Latch-up实验
组织了三个同批次的DSPFXXXX电路进行了Latch-up试验,试验时为了确定所有端口的状态,在片内 fl ash中固化了程序,使得数据总线接口始终为输入态,地址总线为输出态,其他I/O口为输入态。为了使程序能够正常运行,增加了相应的复位电路以及时钟电路。试验对三个批次中选取了三颗电路,编号为1#、2#、3#,表1为 Latch-up试验结果统计。
从试验的数据来看,该电路在100 mA即发生闩锁,表明该电路的抗Latch-up能力在100 mA以下,端口很容易触发。这使得电路在测试和使用过程中,一旦器件引出端(包括输入端、输出端和电源端)受到外部电压和电流信号的触发,VDD和VSS之间就会出现很大的导通电流。该电流一旦开始流动,即使除去外来触发信号也不会中断,而且这个电流可增大到使器件内部电路或地的金属布线熔断,器件彻底烧毁。这就进一步说明用户在使用过程中由于上电顺序改变,很容易就触发内部的寄生结构,从而出现电流异常,影响用户正常使用。需要进一步的试验手段来找到触发结构,分析故障机理。

表1 Latch-up实验结果统计
4.2 EMMI实验
EMMI即微光显微镜,借助EMMI是目前在进行电路的失效分析时一种相当有效且效率较高的分析手段,可侦测到IC内部所放出的光子。在IC器件中,EHP(Electron Hole Pairs)会放出光子,部分情况会产生亮点。产生亮点的情况有漏电结、接触毛刺、闩锁效应、氧化层漏电等。
为了借助EMMI实验定位故障点,必须在触发闩锁的同时进行EMMI实验,但是在使用Latch-up设备触发电路发生闩锁的同时借助EMMI设备观测发光点是不可能的,因此必须找到其他方法使电路触发,并且必须是逐个点进行触发。分析过程中制定了如图2所示的模拟实验方案,使用双路电源(电源1和电源2)为DSP电路的3.3 V端口和1.8 V内核供电,电源3作为触发源施加于不同的IO端口。试验过程中,逐步抬升触发源的电压水平,同时监测双路电源中电源1的电流变化情况,如果电流突然变大,说明电路进入触发状态,关闭电源3即撤掉触发源,此时如果电源1的电流值维持不变,表明电路内部的寄生结构触发且进入闩锁状态。实验现场如图3所示。
通过EMMI试验设备我们发现芯片内部亮点,这有可能是闩锁发生的部位或者是受到闩锁结构影响引起电流异常的区域,如图4所示。下一步的分析应从亮点着手,从版图上了解发亮部位的结构,从结构和机理上来判断此结构是否具备闩锁发生的条件。

图2 Latch-up模拟实验方案

图3 Latch-up模拟实验现场照片

图4 EMMI实验照片
4.3 实验分析
对EMMI数据进行统计发现,在EMMI照片上出现亮点的区域存在一去耦结构,如图5所示为版图上的去耦结构,是否是该结构引发闩锁?仅从EMMI照片的发亮点还不能完全确定,失效区域发亮的原因是电流密度足够高,在失效区产生电压降。这一电压降导致发光显微镜光谱区内的场加速载流子散射发光,但发光点存在不稳定,有时真正的失效区由于局部电流过高将其熔化,击穿区扩大使电流密度下降,而不一定发亮。又对Latch-up的试验数据进行了分析,发现性能偏弱的端口在版图上都和去耦电容相邻,并且端口的抗闩锁能力和去耦电容的距离存在一定的关系,距离小的端口最先出现触发,随着距离增大,端口的抗闩锁能力有所抬高,大约在150~200 mA之间触发。从EMMI的现象和Latch-up的试验数据来分析,可基本确定端口的抗闩锁能力偏低和相邻的去耦电容存在关系。下一步将着手从器件的纵向结构和触发机理来查找失效原因。
如图6为去耦电容和相邻端口驱动管P管的纵向剖面图。该电容为滤波电容常用的一种版图结构,由阱和多晶构成两个极板,当去耦电容摆放在两个端口之间时,和端口的驱动P管就形成了容易触发的PNPN结构,在结构上具备了闩锁发生的条件。版图上该去耦电容也和驱动管N管相邻,但并不构成PNPN结构,也就是说,去耦电容和大尺寸的驱动管P管是真正的故障点。图7为故障点等效电路图。
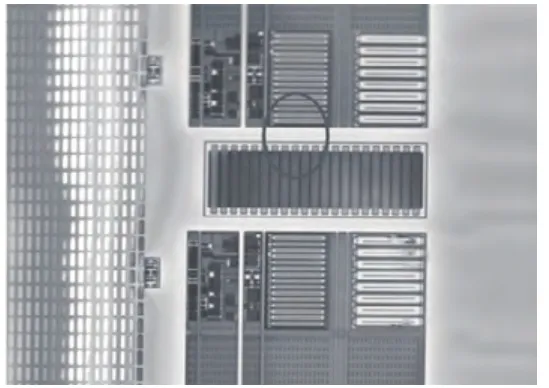
图5 EMMI实验亮点对应版图位置
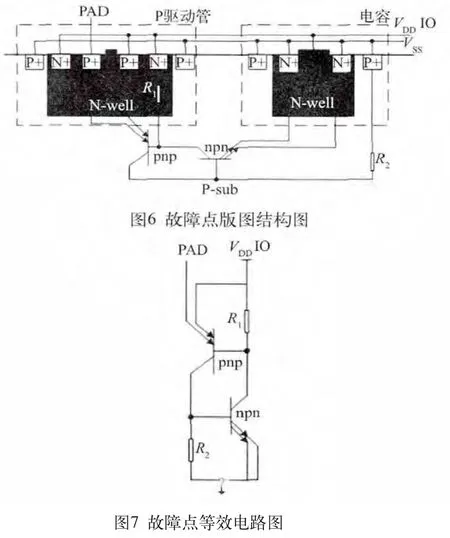
在分析中我们还发现去耦电容的阱和驱动P管的阱之间的距离对端口的可靠性有着一定的影响,当两个阱之间的距离足够大时,触发也不容易发生,表现在端口的抗Latch-up能力可达到150 mA以上。但是在实际设计中,受版图布局和芯片面积的限制,我们不可能将这个距离放至足够大,因此最好从结构上摒弃这样的设计。
5 问题的解决方案
从上述分析中得出如下结论:在这款DSP电路中,由于去耦电容与端口的某些结构距离过近,正好形成了易触发Latch-up的PNPN结构,从而导致电路在使用中容易闩锁,电流增大而导致电路无法正常使用。
若要提升电路Latch-up性能,必须对端口间的去耦电容采取措施,避免出现Latch-up结构。因此必须从结构上彻底消除发生闩锁的可能,对版图做了改动,如图8所示。具体措施有:
(1)增大端口逻辑与滤波电容的距离;
(2)改变去耦电容的结构,采用N-Diff作为电容的一个极板,摒弃N阱板;
(3)电容与IO之间插入隔离岛;
(4)增加端口P+隔离环宽度。
调整后的版图如图9所示。
6 验证结论
根据失效分析后确定的改版方案,我们对电路进行了改版及重新流片,调整了去耦电容,目前重新流出的片子经过测试,端口的抗闩锁能力得到提升,所有端口都达到200 mA以上,部分端口可达到250 mA。经实装验证和用户试用,原先的失效现象消除,不再出现异常情况。

图8 解决方案示意图

图9 改版前后照片对比

