ZnO紫外光电阴极制备及激活工艺技术
徐华腾
(厦门大学信息科学与技术学院,福建厦门361005)
ZnO紫外光电阴极,在紫外探测技术领域具有广泛的应用前景。ZnO是一种新型的宽禁带化合物半导体材料,其室温禁带宽度为3.37 eV,熔点为1 975 K,具有良好的热稳定性和化学稳定性以及更短的激射波长,是制作短波长激光器以及紫外探测器的理想材料[1]。ZnO最大的优点是其高的激子束缚能(60 MeV),比ZnSe(21 MeV)及GaN(20 MeV)高出许多,高的激子束缚能使其在室温下具有强的激子发光特性。而掺Al的ZnO(ZAO)薄膜在室温紫外光电器件方面有巨大的应用潜力,但现有研究的紫外敏感性很少能满足太阳盲区紫外光电阴极的要求。文中主要从ZnO薄膜制备的最佳工艺和样品激活两个方面进行了探索。
1 样品的制备
1.1 ZnO薄膜的基本性质
ZnO薄膜具有C轴择优生长的六角形纤锌矿结构[2],由氧的六角密堆积和锌的六角密堆积反向嵌套而成,这种结构比较开放,半径较小的原子容易变成间隙原子,可通过掺入B,F,Al等不同的杂质元素来改变薄膜的性能。ZAO薄膜正是通过ZnO薄膜掺入A1元素而获得,具有与ZnO薄膜相同的六角形纤锌矿结构,并呈(002)面择优取向。因为A1离子半径比Zn离子半径小,A1原子容易成为替位原子而占据Zn原子的位置,也容易成为间隙原子而存在。
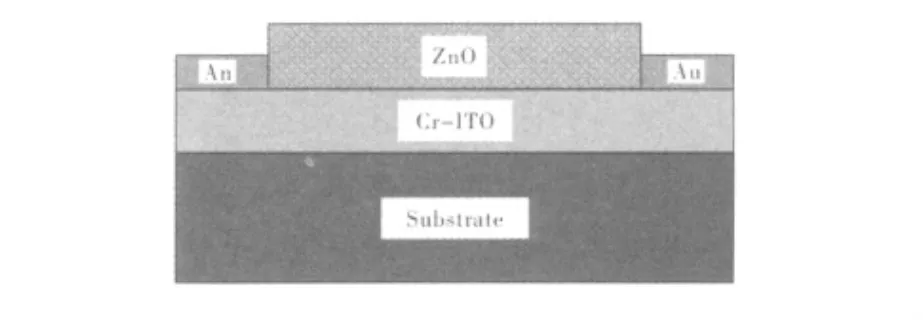
图1 薄膜样品剖面图
1.2 ZnO薄膜的制备方法
ZnO薄膜的制备方法多种多样,可以适应不同的需求。主要有化学气相沉积法、喷雾热解法、溶胶凝胶法、分子束外延、脉冲激光沉积、磁控溅射法等。本文采用的射频溅射法[3]是适用于各种金属和非金属的一种溅射方法。该方法的优点是溅射工艺可控,溅射薄膜与衬底具有良好的附着力,而且溅射镀膜密度高,薄膜性能好。溅射实际上是一个动量传递的过程,也就是使高能粒子冲击固体表面,固体表面的原子或分子在与这些高能粒子交换了动能后,从固体表面飞出来的现象。磁控溅射又称为高速、低温的溅射技术。它在本质上是按磁控模式运行的二极溅射。在磁控溅射中不是像三级溅射那样依靠外加的源来提高放电中的电离率,而是利用了溅射产生的二次电子本身的作用。直流二极溅射产生的二次电子有两个作用:一是碰撞放电气体的原子,产生为维持放电所必需的电离率;二是到达阳极时撞击基片引起基片的发热,在磁控溅射中,增设了和电场正交的磁场。二次电子在这正交的电场和磁场的共同作用下,不再是作单纯的直线运动,而是按特定的轨迹作复杂的运动。这样二次电子到达阳极的路程大大增加,碰撞气体并使气体电离的几率大大增加,因此二次电子的第一个作用也大大地提高。二次电子在经过多次碰撞之后本身的能量已基本耗尽,对基片的撞击作用也就明显地减少。此外,磁控溅射中的阳极置于磁控靶的周围,基片并不放于阳极上而是在靶对面处于悬浮电位的基片架上,所以二次电子主要是落在阳极上而并不轰击在基片上。在磁控溅射中,正是利用了正交的磁场和电场的作用,使二次电子对溅射的有利作用充分地被发挥出来,并使其对基片升温的不利影响尽量地压抑下去。这就是磁控溅射之所以能成为一种实用的高速、低温溅射源的原因。
1.3 实验参数及过程
1.3.1 实验流程

图2 实验流程图
1.3.2 参数选择
实验中,选取背底真空、溅射功率、靶基距、溅射时间为固定参数,而选取不同的VO2∶VAr比和基片温度作为调节参数,来研究分析不同VO2∶VAr比对结晶质量的影响,不同的基片温度对晶粒质量的影响。根据不同参数选择共制得如表1所示的7种样品。

表1 按照不同参数制备的样品
1.3.3 溅射过程
(1)实验准备。首先打开电源和冷却水装置开关,关闭所有进气口和出气口,放入已经清洗好的基片,打开机械泵,将真空抽至6 Pa以下,启动分子阀,将背底真空抽至0 Pa。
(2)起辉、调节功率及预溅射。打开高压气瓶,用气体流量控制器慢慢充入高纯氩气和氧气。打开射频电源,调节板压,使溅射室出现辉光,然后使溅射功率达到100 W,预溅射5 min。
(3)溅射开始,旋转基片到溅射辉光下,溅射计时开始。
(4)溅射时间到后,关闭射频电源,再关闭进气阀,最后关闭分子泵和机械泵,电源和水。
2 样品测试及结果分析
2.1 氧氩比对结晶质量的影响
在不同的工艺条件下制备了一系列样品,其中编号为1~3的典型样品的工艺条件列于表2中。

表2 典型样品的工艺条件
由图3可知,当VO2∶VAr在3∶1时,即图3(a),在XRD图谱2θ=34.7°处得到比较强的(002)衍射峰并且得到的半高宽也比较窄。VO2∶VAr过大2∶1(如图3(b))和过小4∶1(如图3(c))时,都不能得到理想的(002)峰,当氧氩比加大时,由于氩气增多,导致轰击锌靶的氩离子增多,使得游离态的Zn原子增多导致氧气相对不足,从而破坏了薄膜结构,影响了ZnO薄膜的生长。VO2∶VAr增大时,氧分压增大,过多的氧停留在晶界上,使晶粒尺寸减小,结晶质量下降,影响了薄膜的结构,这与参照K.eller,F.kudella等人研究结果[4]和本实验室的前期研究工作。同时氧氩比对溅射率也有一定影响,氧氩比减小时,溅射率增大,原因是由于溅射产额增多,粒子到达基片的几率增大,从而溅射率增加。所以在实验制备过程中,一般选用VO2∶VAr为120∶40作为优化的实验条件。

图3 不同氧氩比下样品的XRD图
2.2 基片温度对晶粒质量的影响
基片的温度对于薄膜中的晶轴取向至关重要,基片温度影响基片吸附原子的迁移和再次蒸发。在实验中选VO2∶VAr为120∶40分别在100℃,250℃,450℃,600℃的衬底温度下制备ZnO薄膜,其他工艺条件不变,对生成的ZnO薄膜进行SEM扫描电镜分析。
基片温度偏低时,溅射的锌原子和氧原子在硅衬底上吸附后,由于原子的能量较低,在到能量最低的位置前就进入晶格位置,使薄膜的取向性变差;温度适当时,可以使结合不好的原子再次蒸发,吸附原子有适当的能量迁移到能量最低的晶格位置,同时又有较低的解析速率,有利于沿C轴方向垂直基片的晶粒生长,得到较好结晶性能的薄膜;但温度太高,虽然吸附原子有较大的动能,氧原子在衬底表面的脱附加剧,同样会引起结晶质量的下降,还有温度过高使ZnO分子有多余的能量沿其它晶向生长,造成晶体取向混乱[5]。
从薄膜的SEM图来看,晶粒尺寸随基片温度的升高逐渐变大,到450℃时,晶粒尺寸达到最大,基片温度再升高时,晶粒尺寸变小,这种变化和结晶质量的变化一致。所以在实验过程中一直采用450℃作为基片温度,以达到最理想的效果。
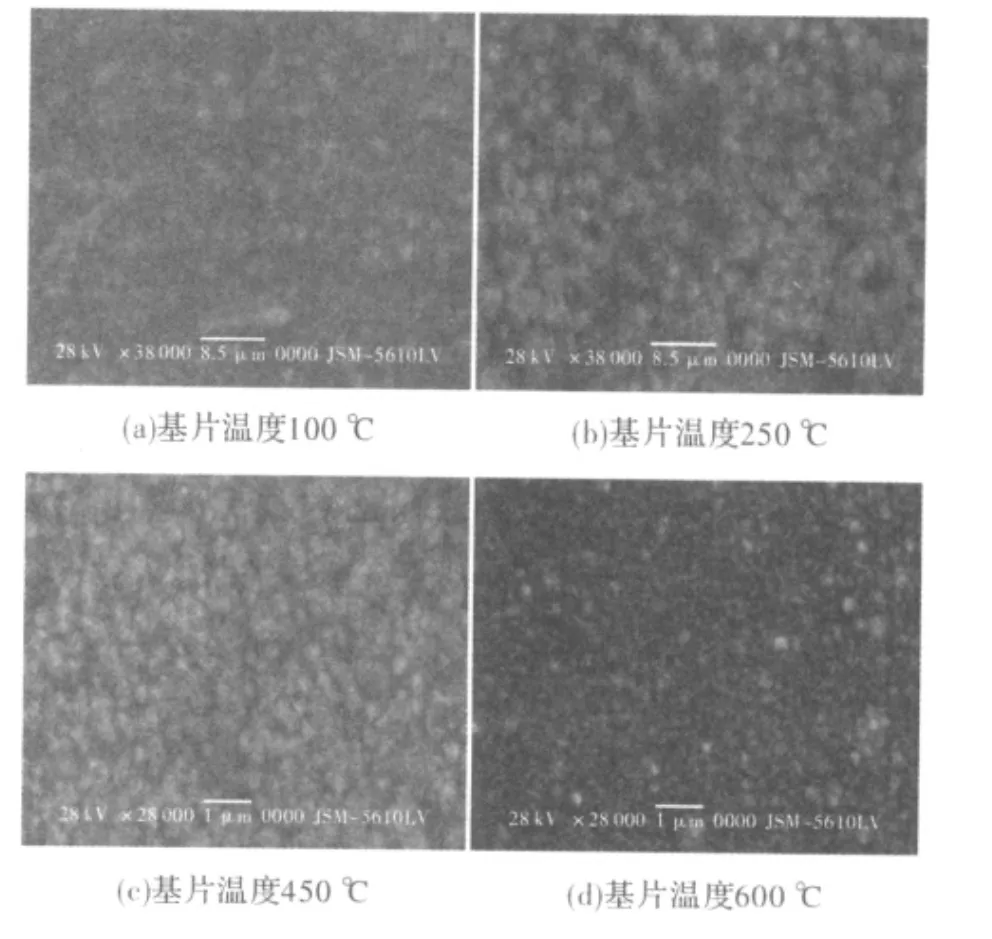
图4 样品在不同温度下的SEM图
2.3 表面电阻与溅射时间的关系
在集成电路和各类半导体器件的科研与生产中,四探针技术在测量扩散层和其他薄膜的薄层电阻中,得到了广泛应用。即使在超大规模集成化的今天,微区及微样品薄层电阻的测量仍然采用此方法[6]。直线四探针和方形四探针是最常用的方法,如图5所示,薄层电阻可以从式(1)求得[7]

其中,I是通过两电流探针的电流强度;V是两电压探针间的电势差;K称修正系数,是与样品的形状、大小以及探针在样品上的位置有关。

图5 四探针测薄层电阻
溅射条件:基片温度450℃;真空度2×10-3Pa;溅射功率10 W;Ar流量150 ml/min。在以上溅射条件下,研究了透光率与溅射时间的关系,通过四探针法测Cr电极表面电阻得到如表2所示的关系。
由表3可以看到,随着溅射时间的增加,Cr电极表面电阻随之减小。而在制作光电阴极时,要求电阻越小越好,但由于随着溅射时间的增加,Cr电极厚度会随之不断增加,因而不能保证实验所需的最低为80%的透光率[8]。由图6可以看出,在400 nm以下的紫外光区域,溅射时间为20 s的Cr电极的透光率最高在80%以上。在制备Cr电极的过程中,选择了20 s的溅射,以保证地电阻率和高透光率的双重要求。

表3 表面电阻与溅射时间的关系

图6 溅射时间与透光率的关系
3 样品的激活
激活是制作ZnO光电阴极的关键步骤,采用标准的“yo-yo”技术[9],即待经热清洁的ZnO表面冷却到室温时,进铯,同时检测光电流的变化,控制进铯量使光电流达到最大并下降到峰值的70%;停止进铯,同时开始进氧,使光电流达到新的最大值,进一步进氧使光电流超过最大值后略有下降;再进使光电流达到最大,停铯进氧,如此交替进铯、氧,直到光电流不再明显增加为止。如图7为光电流、暗电流在激活前后的比较。可以看见激活后的光电流提升了1~3个数量级以上,并且在激活后暗电流也大大减小,所以样品激活后的光暗电流比高于激活前的光暗电流比。
4 结束语
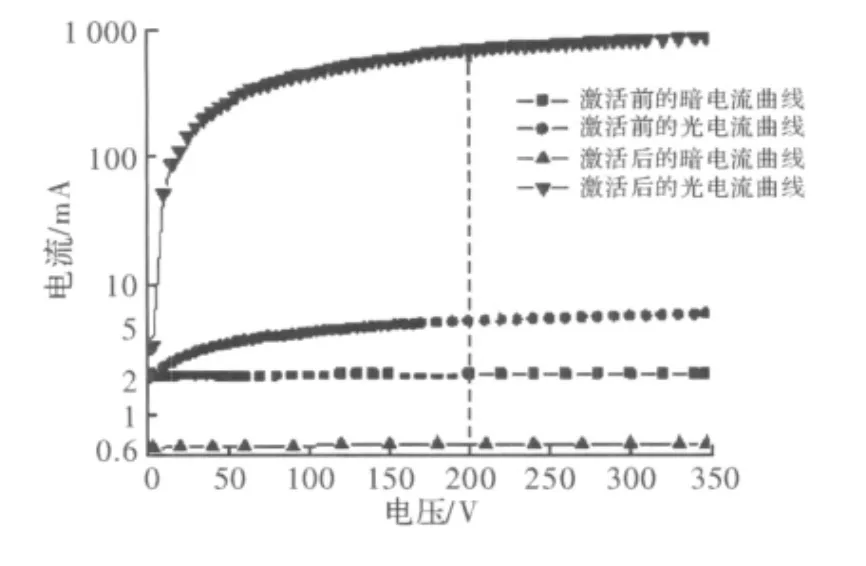
图7 激活前后光暗电流对比
采用磁控溅射的方法制备了ZAO薄膜,探讨了ZnO紫外光电阴极的制备条件及性能,熟悉了ZnO紫外光电阴极相关知识。探索了ZAO紫外光电阴极制备工艺,确立VO2∶VAr为120∶40、45 0℃基片温度的实验条件。通过蒸Au和制作Cr电极,实现透明导电层。对ZnO紫外光电阴极的激活做了初步的探索,发现激活后的光暗电流比得到了提高。
[1] 李树玮,小池一步.ZnO材料的生长及表征[J].液晶与显示,2004(3):5-6.
[2] 洪伟铭.ZnO∶Al薄膜的制备及表征[J].半导体光电,2007(3):18-19.
[3] 彭少麒,章佩娴,叶贤京.射频溅射无定形硅性质研究[J].中山大学学报:自然科学版,1982(3):14-15.
[4] HONG R J,SHAO J D,HE H B,et al.Effects of oxygen partial pressure on optical absorption edge and UV emission energy of ZnO films[J].Chinese Optics Letters,2005,3(7):428-431.
[5] 郑丁葳,倪晟,赵强.不同氧分压下直流反应溅射ZnO薄膜的结构和光学特性[J].光学学报,2007,27(4):739-743.
[6] 德国标准化学会.DIN 50431-1988[S].德国:DEDIN,1988.
[7] 晏敏.智能四探针电阻率测试仪研究及开发[D].长沙:湖南大学,2005.
[8] 俞振南,姜乐,熊志华,等.磁控溅射技术制备ZnO透光薄膜[J].南昌大学学报:理科版,2007(5):10-12.
[9] 李倩,郝亮,庞文宁.GaAs极化电子源激活的yo-yo过程研究[J].物理学报,2008,57(1):30-31.

