倍增层Si浓度对β-FeSi2/Si红外探测器性能的影响研究


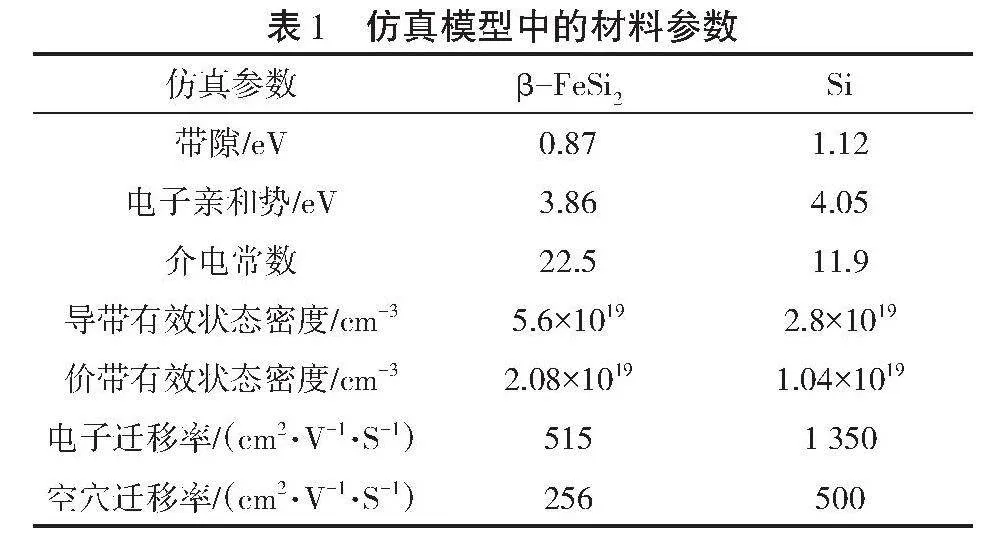

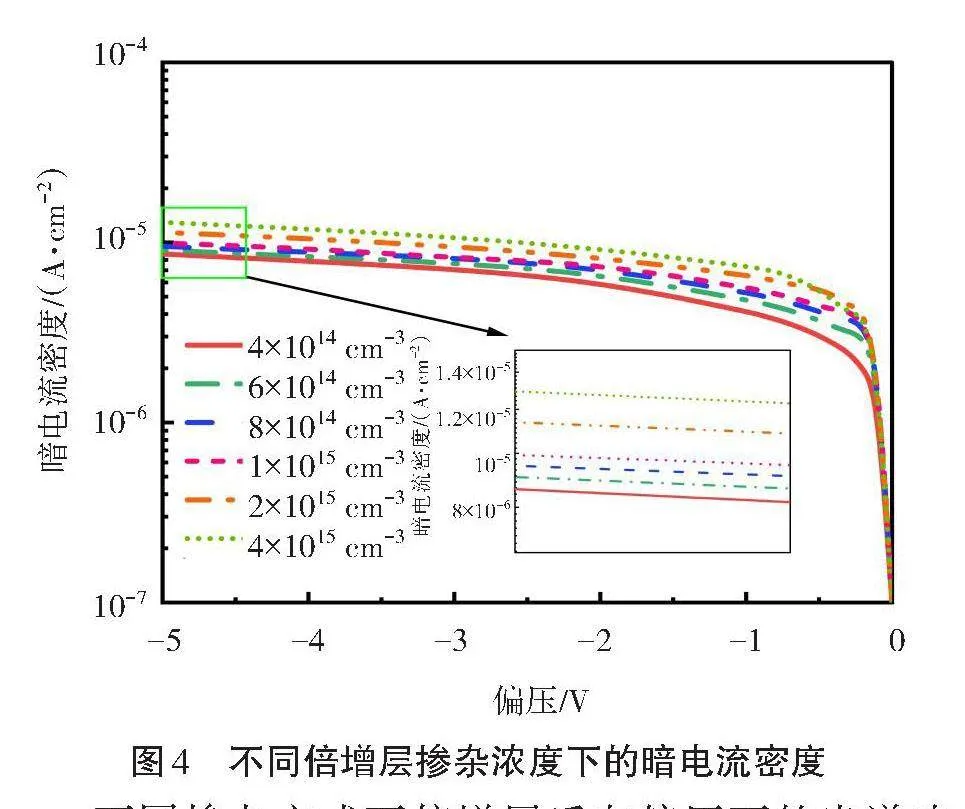


摘 要:【目的】为降低暗电流,改善器件性能,对不同的倍增层Si掺杂浓度在电场分布、暗电流和响应度等性能方面的影响进行探讨,以获得掺杂浓度的最优值。【方法】利用半导体仿真软件Silvaco-TCAD深入探讨了倍增层Si掺杂浓度对β-FeSi2/Si近红外探测器性能的影响规律。【结果】随着倍增层掺杂浓度的提升,倍增层内部电场强度峰值逐渐增加,暗电流密度与电容值也将相应提高,光响应度基本保持不变。进一步研究表明,当倍增层掺杂浓度为1×1015 cm-3时,器件获得良好的性能,暗电流密度为9.93×10-6 A/cm2,在波长为1.5 μm时,光响应度和比探测率分别为0.445 2 A/W和1.77×1011 cm·Hz1/2W-1。【结论】研究结果对制备高性能的β-FeSi₂/Si红外探测器具有指导意义。
关键词:掺杂浓度;倍增层;暗电流;红外探测器
中图分类号:TN215" " " 文献标志码:A" " 文章编号:1003-5168(2025)01-0073-05
DOI:10.19968/j.cnki.hnkj.1003-5168.2025.01.014
Study of the Effect of Si Concentration in the Multiplication Layer on the Performance of β-FeSi2/Si Infrared Detectors
ZHU Zhaoyang YE Wei PENG Huilong CHEN Yukun
(School of Mechanical Engineering, Shaanxi University of Science and Technology, Hanzhong 723001, China)
Abstract: [Purposes] In order to reduce the dark current and improve the performance of the device, the effects of different multiplication layer Si doping concentration on its performance in terms of electric field distribution, dark current and responsivity are explored to obtain the optimal value of doping concentration. [Methods] The influence of the multiplication layer Si doping concentration on the performance of β-FeSi2/Si near-infrared detector is deeply explored by using the semiconductor simulation software Silvaco-TCAD. [Findings] The results show that with the increase of the doping concentration of the multiplication layer, the peak electric field intensity inside the multiplication layer gradually increases, and the dark current density and capacitance value will be increased accordingly, while the optical responsivity remains basically unchanged. Further studies show that when the doping concentration of the doubling layer is 1×1015 cm-3, the device obtains good performance with a dark current density of 9. 93×10-6 A/cm2, and the photoresponsivity and specific detectivity at a wavelength of 1.5 μm are 0.445 2 A/W and 1. 77×1011 cm·Hz1/2 W-1, respectively. [Conclusions] The results of the study are of guiding significance for the future preparation of high-performance β-FeSi₂/Si infrared detectors.
Keywords: doping concentration; multiplication layer; dark current; infrared detector
收稿日期:2024-10-31
基金项目:陕西省教育厅重点实验室项目(16JS016);陕西省教育厅专项科研计划(18JK0151);陕西“十四五”教育科学规划2022年度课题(SGH22Y1351)。
作者简介:朱朝阳(1999—),男,硕士生,研究方向:半导体光电器件。
通信作者:叶伟(1977—),男,博士,副教授,研究方向:功能材料与器件、储能材料与器件、传感器。
0 引言
红外探测技术作为一项重要的信息获取和传感技术,在军事、安防、医学、工业和科学研究等领域中发挥着不可替代的作用[1]。随着社会进步与科技发展,人们对环境感知、目标识别和无损检测[2]的需求日益增加,对高性能、高灵敏度的红外探测器的需求也不断增长。目前,近红外探测器主要由CdTe[3]、PbS[4]、InGaAs[5]等材料制成,这些材料在近红外波段具有优良的光电特性,但均含有重金属元素且在地壳中含量较低,大量运用可能导致资源短缺和环境污染等问题[6]。
在这一背景下,β-FeSi₂因其优异的光电性能、生态友好的特性和低成本优势 [7],以及与Si的晶格失配小 [8],因而与成熟的Si工艺兼容性极高的特点[9],使得β-FeSi₂/Si红外探测器广受关注。倍增层的内部参数对红外探测器的电学和光学性能均有显著影响,为进一步提升β-FeSi₂/Si红外探测器的性能,倍增层的设计和优化显得尤为关键。王航等[10]研究了倍增层的厚度对In0.53Ga0.47As/InP雪崩二极管性能的影响,减少了击穿电压和贯穿电压;蒋毅等[11]通过研究了倍增层对InAlAsSb SACM雪崩光电二极管的暗电流和增益的影响,降低了器件的暗电流并提升了增益;Naseem等[12]通过对倍增层In 0.52 Al 0.48 As进行优化,使得APD 的暗电流降低、响应速度提升。
目前,关于倍增层Si掺杂浓度对SAM结构β-FeSi2/Si红外探测器性能的影响鲜有报道。因此,本研究通过仿真模拟方法,研究6种不同的倍增层Si掺杂浓度,分别为4×1014 cm-3、6×1014 cm-3、8×1014 cm-3、1×1015 cm-3、2×1015 cm-3和4×1015 cm-3,对其在电场分布、暗电流和响应度等性能方面的影响进行探讨,并通过比较不同掺杂浓度下的性能表现,获得掺杂浓度的最优值。
1 器件与仿真模型
β-FeSi2/Si SAM-APD的结构如图1所示。使用高掺杂的3.5 µm厚的N型Si衬底可提供良好的电子传输性能和较低的电阻。为平滑界面并减少由晶格不匹配引起的应力,采用1 µm厚的N型Si缓冲层。同时,为了增强电子倍增效应,引入了2 µm厚的N型Si倍增层。此外,4 µm厚的P型β-FeSi2吸收层用于吸收入射光并产生电子空穴对。掺杂浓度较高的0.5 µm厚的P型β-FeSi2薄膜作为接触层,可以实现低电阻的欧姆接触。
本研究综合考虑了红外探测器器件的电学和光学性能,选择了与器件特性相符的俄歇复合模型和Shockley-Read-Hall(SRH)复合模型等。在统计分布方面,采用了费米-狄拉克统计,并使用Newton迭代法进行计算[13]。具体的材料参数见表1。
2 结果与讨论
器件的能带结构如图2所示。图2采用的是一维坐标系,其中p-β-FeSi2接触层的顶部被设为坐标原点。吸收层位于接触层下方,其相对于原点的位置可以描述为负向。吸收层的厚度为La,表示了它在垂直方向上的尺寸。同时,倍增层位于吸收层下方,其厚度为Lm。倍增层的位置和尺寸可以描述为相对于吸收层的相对位置。在器件的仿真过程中,假设入射光在耗尽区域内被完全吸收,随后的载流子会通过漂移过程到达倍增层的位置,并在Lm范围内发生倍增效应。
器件性能受倍增层内部电场的调节极为重要,吸收层和缓冲层在内部电场调节方面的作用相对较小,主要的影响因素在于倍增层的内部参数[14]。不同倍增层掺杂浓度下的电场分布如图3所示。由图3可知,在不同倍增层掺杂浓度条件下,器件
中的电场分布呈现出不同的特征。研究结果表明,当掺杂浓度从4×1014 cm−3增加到4×1015 cm−3时,倍增层电场强度峰值从1.02×105" V/cm增加到1.36×105" V/cm。随着掺杂浓度的提高,电场强度在倍增层中的峰值也随之增加。然而,掺杂浓度一旦超过1×1015 cm-3,器件的电场分布随着掺杂浓度的增加而变得陡峭和不均匀,这是由于随掺杂浓度的增加,耗尽区宽度减小,使得部分区域电场强度不足,从而导致电场分布变得陡峭和不均匀 。因此,为保证器件电场的稳定性,倍增层掺杂浓度不宜超过1×1015" cm-3。
不同倍增层掺杂浓度下的暗电流密度如图4所示。由图4可知,掺杂浓度从4×1014 cm−3增加到6×1014 cm−3时,对应的暗电流密度增长5.3%,从8.62×10-6 A/cm2增加到9.08×10-6A/cm2。进一步增加掺杂浓度至8×1014 cm−3,暗电流密度继续增加,增幅为4.6%,从9.08×10-6A/cm2增至9.5×10-6A/cm2。随后,当掺杂浓度从8×1014cm−3增至1×1015cm−3时,暗电流密度再次上升,增幅为4.5%,从9.5×10-6 A/cm2增至9.93×10-6A/cm2。然而,从1×1015cm−3增加至2×1015cm−3时,暗电流密度显著增加,增幅达到14.7%,从9.93×10-6A/cm2急剧上升至1.14×10-5A/cm2,。从2×1015cm−3上升至4×1015cm−3时,暗电流密度从1.14×10-5A/cm2增大到1.29×10-5A/cm2时,增幅达到13.16%。这是由于掺杂浓度的增大,导致倍增层内部电场分布变得不均匀,影响了载流子的有效分离和收集,从而无法有效抑制复合电流的生成,使得器件的暗电流增加。倍增层掺杂浓度的增加对器件暗电流性能产生了显著影响,因此需要在器件设计和优化中进行精确控制,以实现性能与稳定性的平衡。
不同掺杂方式下倍增层反向偏压下的光谱响应如图5所示。结果表明,在gt;1.8µm的波长范围内,光谱响应与掺杂无关。在倍增层掺杂浓度为1×1015cm−3时,在0.4~1.8 µm波长范围内,光响应度在0.4 µm的值为0.0158 9 A/W,在波长1.5 µm处达到峰值0.4 452 A/W,最后在波长1.8 µm处截止,并且随着倍增层掺杂浓度从4×1014 cm−3增大到4×1015 cm−3时,光谱响应在波长为1.5 μm处的光响应度峰值从0.445 13 A/W增大到0.445 4 A/W,仅增加了0.000 27 A/W。出现这种变化的原因是随着倍增层掺杂浓度的提高,耗尽区向P型β-FeSi2吸收层的扩展会减小,较小的耗尽区意味着更少的光生载流子通过耗尽区扩散进入倍增区,从而限制了光信号在器件中的扩散和放大,导致光响应度峰值略微增加。
不同倍增层掺杂浓度的瞬态响应如图6所示。结果表明,随着掺杂浓度从4×1014cm−3增大到4×1015cm−3,器件的稳态电流从2.278×10-12A增大到2.478×10-12A。图6中的嵌入图显示了随掺杂浓度从4×1014cm−3增大到4×1015cm−3时,器件的响应时间也逐渐缩短。出现这种变化的原因是高掺杂浓度导致载流子浓度增多,进而提高了导电性,从而增加了稳态电流。然而,较高的掺杂浓度也会导致电场分布不均匀,增加载流子的散射概率,从而降低器件的响应时间。
品质因子(R0A)是一项关键指标,用于衡量光电器件的性能。其值为零偏压下的RdA值,计算公式为式(1)。
[RdA=KT/qJ0] (1)
式中:[K]被称为玻尔兹曼系数;[T]代表温度;[q]表示电荷的单位量;[J0]代表饱和暗电流密度。
室温下的R0A值由式(1)进行计算。不同倍增层掺杂浓度下的微分电阻面积如图7所示。研究结果表明,随着掺杂浓度从4×1014 cm−3增大到4×1015 cm−3,其R0A值从3 001.5 Ω·cm2减小到200 2.8 Ω·cm2。这种变化可以通过式(1)来解释,随着掺杂浓度的提高,器件的暗电流密度也随之增加。因此,根据式(1),暗电流密度的增加直接导致R0A值降低。
光敏度是评估光电器件性能的关键指标之一,通常用比探测率来进行广泛参数化。这个参数能更进一步表征光电器件的性能水平。因此,室温下的比探测率D*的计算公式为式(2)。
D*=R[R0A4KT] (2)
式中:[K]是玻尔兹曼常数;[T]是温度;[R0A]为零偏置电阻面积;[R]是波长1.5 µm处的峰光响应度峰值。
根据前文分析,当倍增层掺杂浓度超过1×1015cm−3时,在图3中倍增层内的电场分布不均匀,并且局部电场峰值过高时容易导致击穿效应,从而缩短器件的寿命,在图4中暗电流密度会显著增加,在图6中,响应时间变长,开关急剧变差。因此,对不同倍增层掺杂浓度的电场分布、暗电流密度、瞬态响应的影响进行综合分析,选择器件倍增层掺杂浓度为1×1015cm−3。
将β-FeSi2/Si红外探测器与近年来国际上报道的GeSn PIN[15]、OPD[16]、Ge/Si[17]、SnS[18] 红外探测器的比探测率值进行比较,结果见表2。可以看出,器件的比探测率在范围之内,验证了β-FeSi2/Si近红外光电探测器的应用潜力。
3 结论
本研究对β-FeSi2/Si近红外光电探测器中倍增层Si掺杂浓度对器件特性影响进行了仿真分析。仿真结果显示,随着掺杂浓度的增加,倍增层内的电场强度峰值逐渐提高,器件的电场分布也会更加不均匀。在此基础上,探讨了器件其他性能的变化趋势,随着掺杂浓度的增加,器件的暗电流和光响应度也随之上升,但对光响应度的影响很小。进一步研究表明,倍增层掺杂浓度应在1×1015cm−3以内,器件表现出良好的性能。研究结果对未来制备高性能的β-FeSi₂/Si红外探测器具有指导意义。
参考文献:
[1] JIN C, CHEN J X, XU Q Q, et al. Electrical and optical performances of InGaAs/GaAsSb superlattice short-wavelength infrared detectors[J]. Optical Engineering, 2017,56(5): 057102-057102.
[2] 周建,周易,倪歆玥,等.偏振集成红外光电探测器研究进展与应用[J].光电工程,2023,50:66-84.
[3]WANG Y, HUANG X W, WU D, et al. A room-temperature near-infrared photodetector based on a MoS2/CdTe p–n heterojunction with a broadband response up to 1700 nm[J]. Journal of Materials Chemistry C, 2018, 6(18): 4861-4865.
[4] ZHANG X, YANG C, LI P, et al. Growth of Si/PbS Heterostructure Infrared Photodetectors for NIR Detection[J]. ACS Photonics, 2024, 11(3): 1197-1204.
[5]LIU H, WANG J, GUO D, et al. Design and fabrication of high performance InGaAs near infrared photodetector[J]. Nanomaterials, 2023, 13(21): 2895.
[6] EL-AMIR A A M, OHSAWA T, NABATAME T, et al. Ecofriendly Mg2Si-based photodiode for short-wavelength IR sensing[J]. Materials Science in Semiconductor Processing, 2019, 91: 222-229.
[7] ZOU X Y. Simulation of n-β-FeSi2/p-Si heterojunction solar cells based on AFORS-HET[J]. Modern Physics Letters B, 2017, 31(19-21): 1740026.
[8] TAMURA D, NAGAI R, SUGIMOTO K, et al. Melt growth and characterization of Mg2Si bulk crystals[J]. Thin Solid Films, 2007, 515(22): 8272-8276.
[9] PROMROS N, BABA R, TAKAHARA M, et al. Epitaxial growth of β-FeSi2 thin films on Si (111) substrates by radio frequency magnetron sputtering and their application to near-infrared photodetection[J]. Japanese Journal of Applied Physics, 2016, 55(6S2): 06HC03.
[10] 王航,袁正兵,谭明,等.倍增层厚度对In_(0.53)Ga_(0.47)As/InP雪崩二极管器件特性的影响[J].光学学报,2020,40(18):16-20.
[11] 蒋毅,陈俊.基于异质结倍增层的InAlAsSb SACM雪崩光电二极管的优化[J].红外与毫米波学报,2019,38(5):598-603.
[12] NASEEM P S, WANG P S, AHMAD Z, et al. Top-illuminated avalanche photodiodes with cascaded multiplication layers for high-speed and wide dynamic range performance[J]. Journal of Lightwave Technology, 2022, 40(24): 7893-7900.
[13]ALIANE A, OUVRIER-BUFFET J L, LUDURCZAK W, et al. Fabrication and characterization of sensitive vertical PiN germanium photodiodes as infrared detectors[J]. Semiconductor Science and Technology, 2020, 35(3): 035013.
[14]叶伟,杜鹏飞,萧生, 等.InAlAs浓度对In0.83Al0.17As/ In0.83Ga0.17As红外探测器特性的影响[J].应用光学, 2022,43(2):317-324.
[15] LEE K C, LIN M X, LI H, et al. Planar GeSn photodiode for high-detectivity photodetection at 1550 nm[J]. Applied Physics Letters,2020,117(1):012102.
[16] LU Z, SHEN X, LI Z, et al. Flexible sandwich structure MXene-Aramid Nanofiber-MXene film for adjusting infrared camouflage and multifunctional application[J]. Composite Structures, 2024: 118299.
[17] HSU C Y, LAI B, GUAN-YU L, et al. High detectivity Ge photodetector at 940 nm achieved by growing strained-Ge with a top Si stressor[J]. Optics Express, 2024, 32(6): 10490-10504.
[18] GU C F, CHENG Y C, DAI Q Y, et al. Towards high-performance near-infrared photodetectors based on SnS nanowires[J]. Europhysics Letters, 2022, 136(2): 27003.

