功率循环下GaN器件栅极可靠性研究

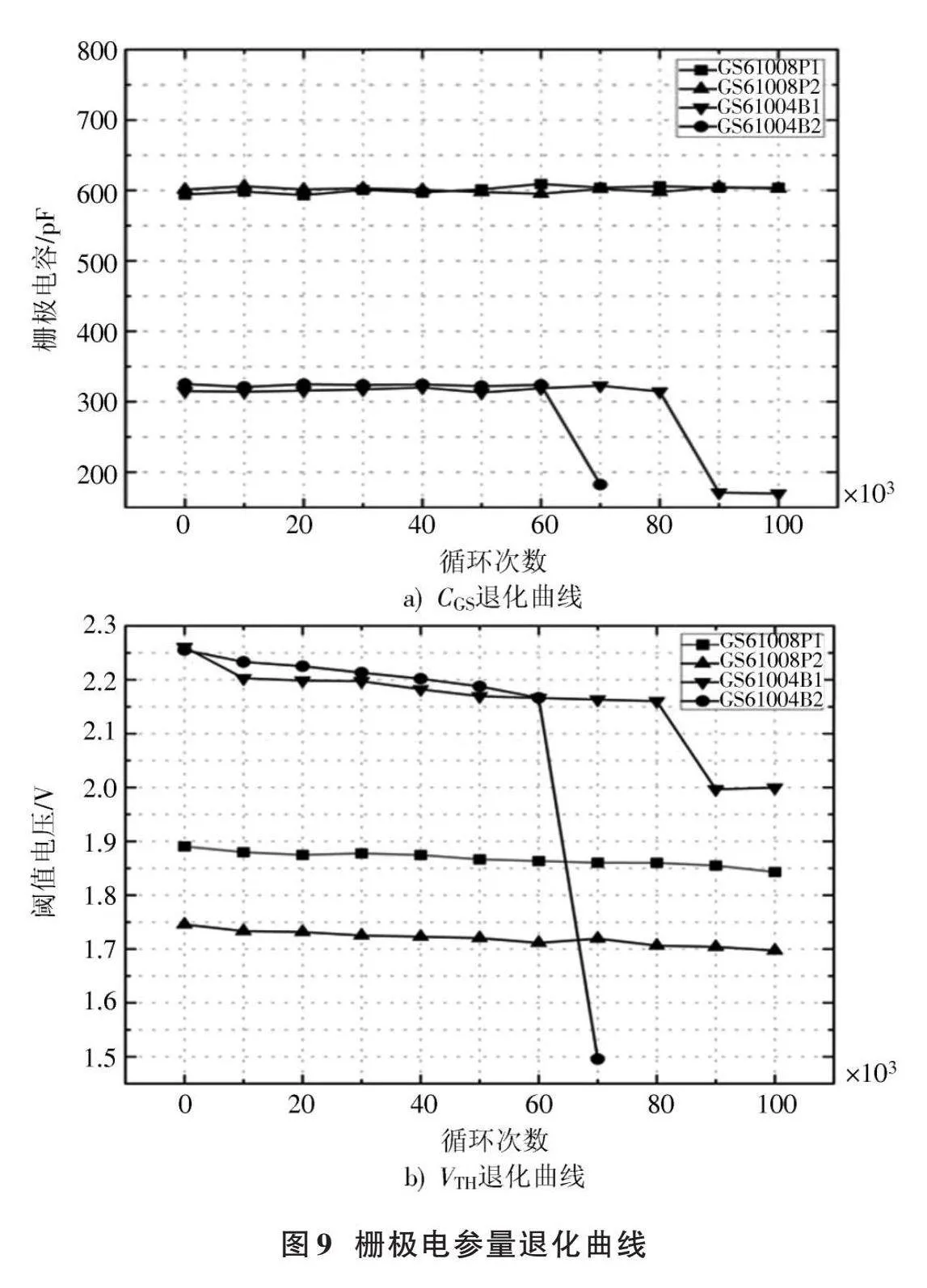
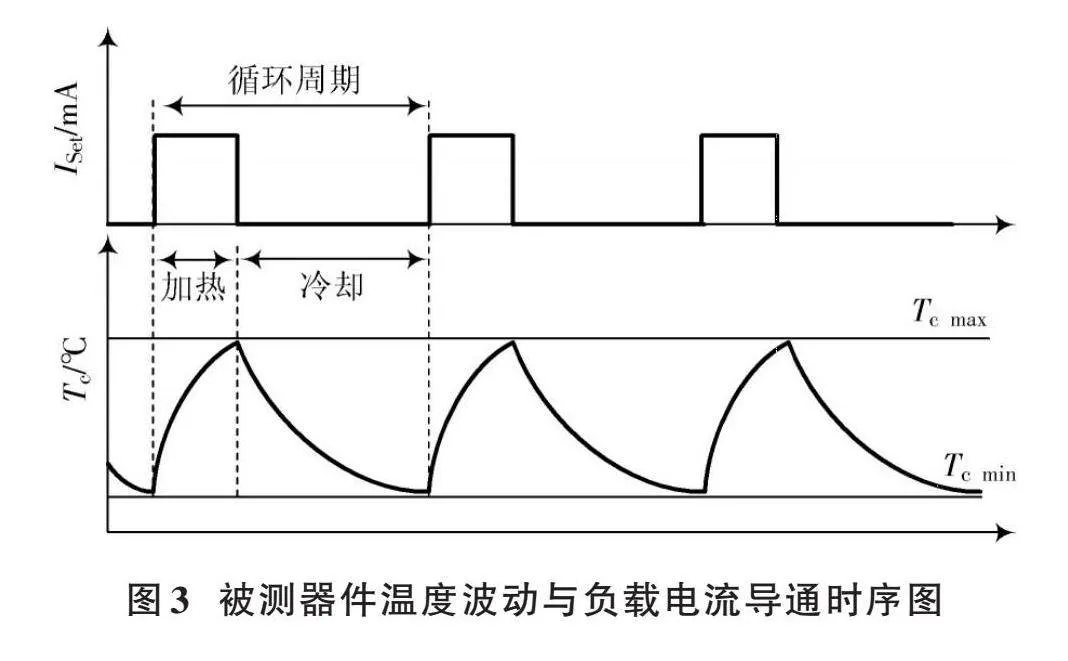
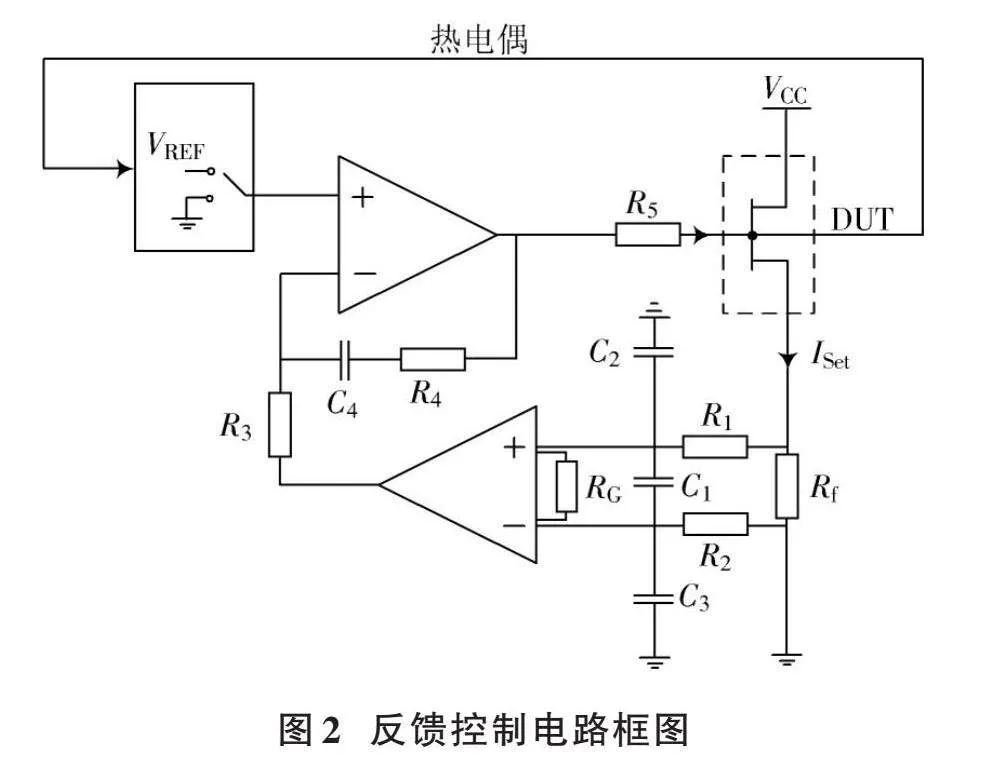
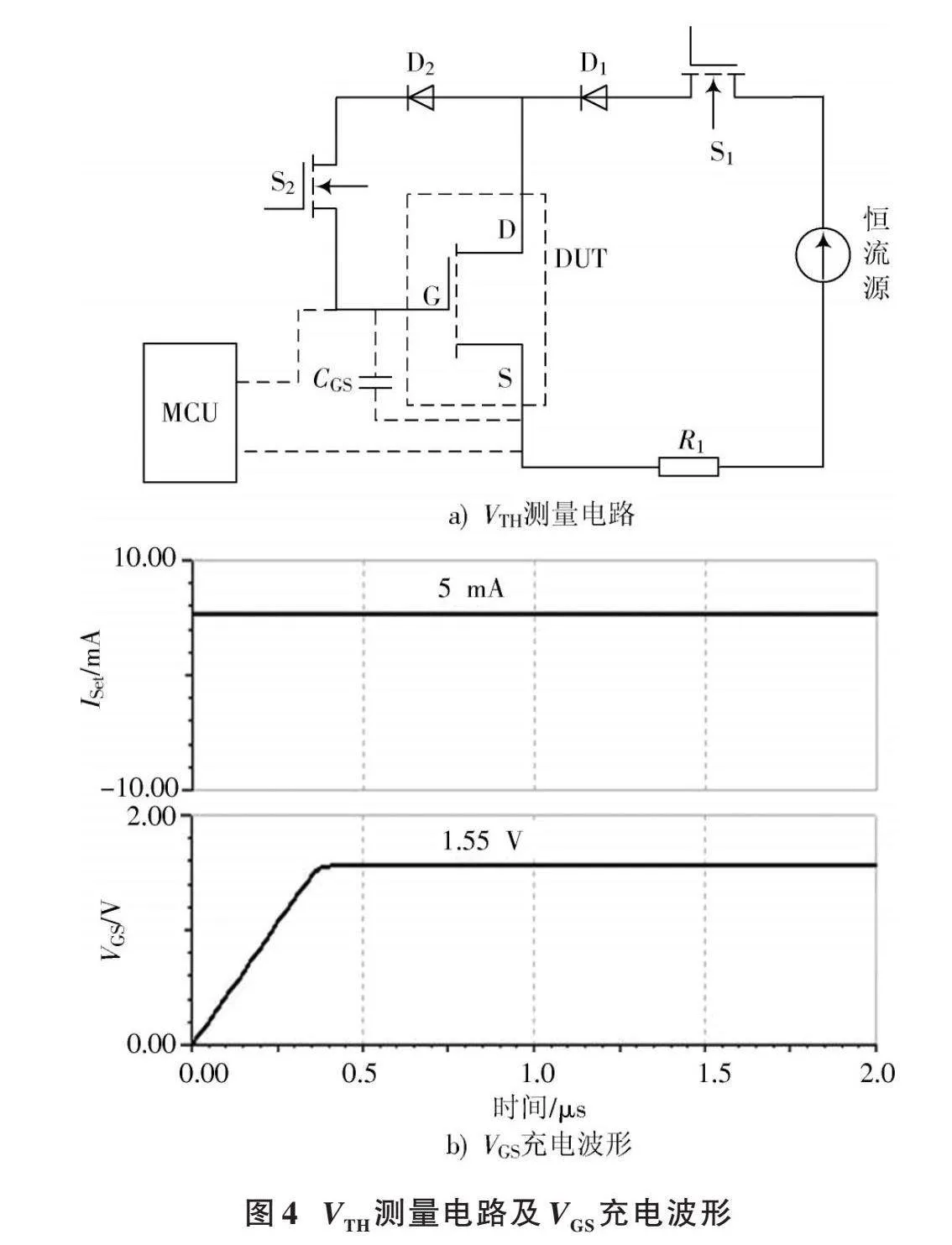


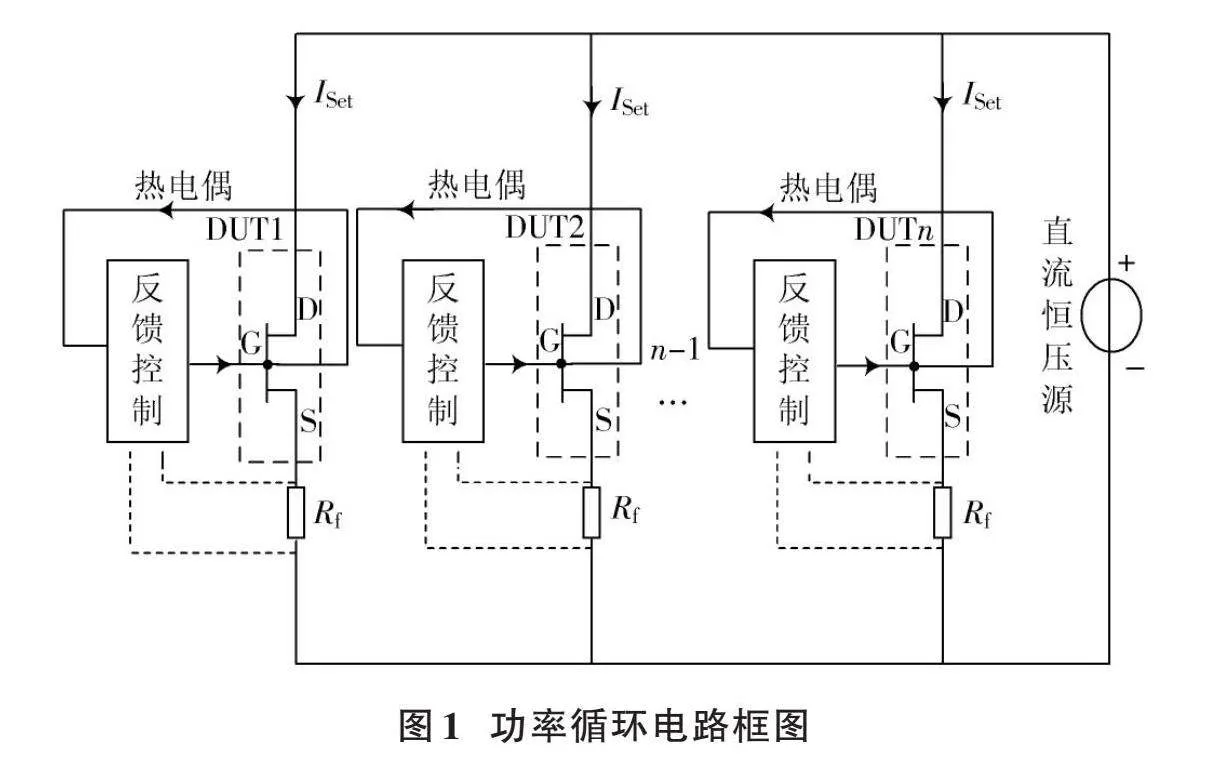
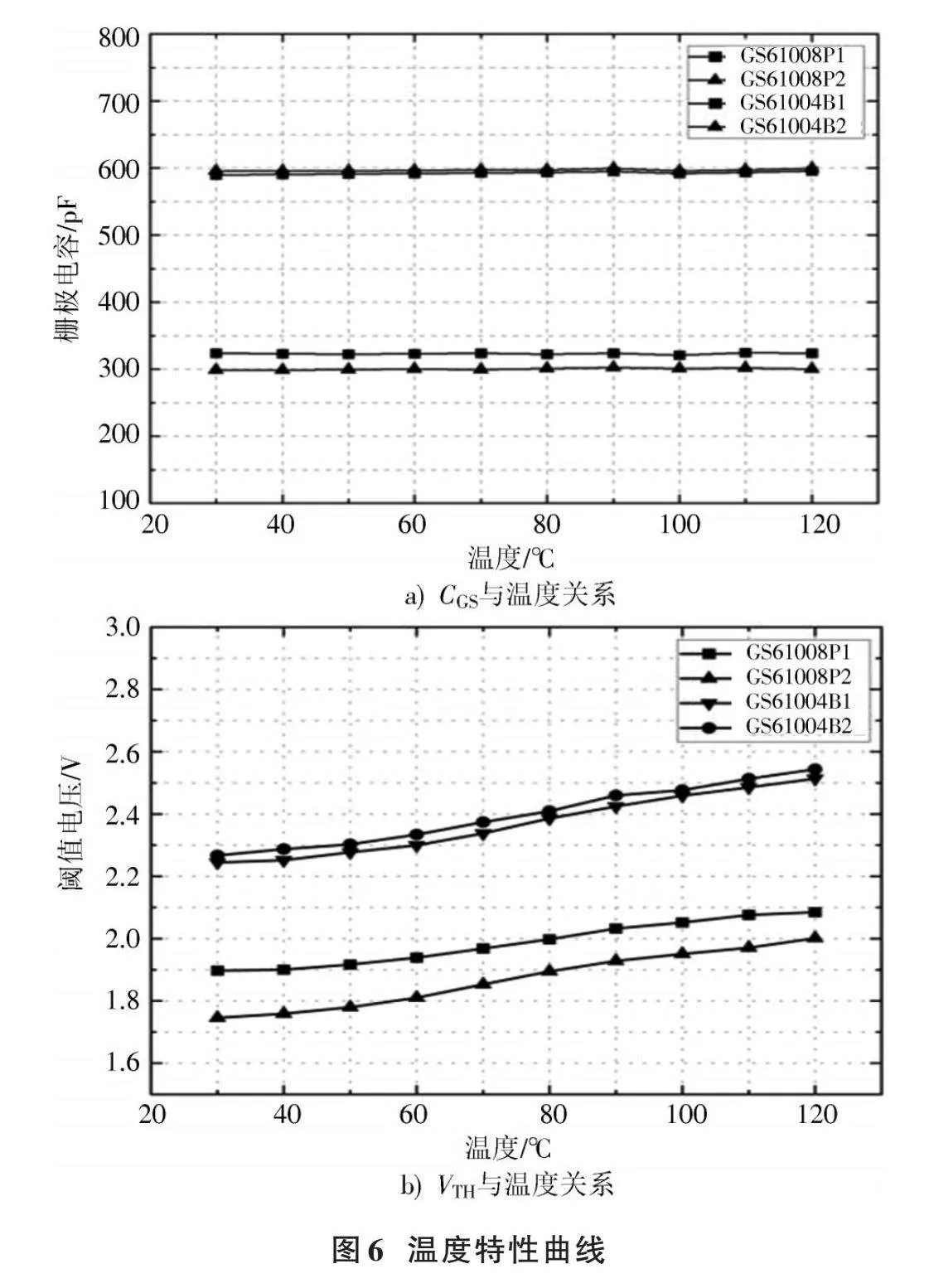
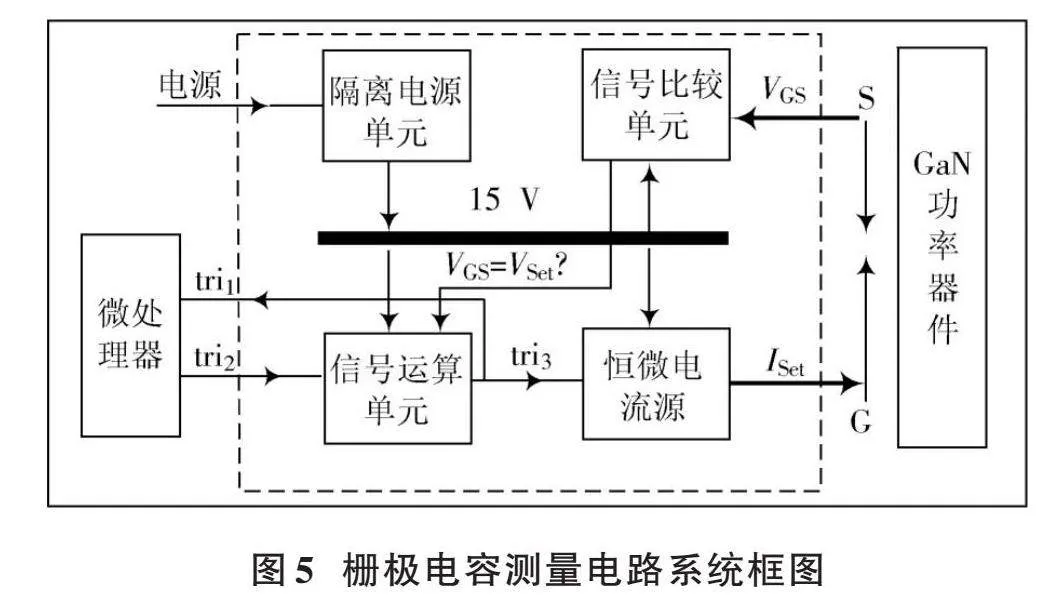
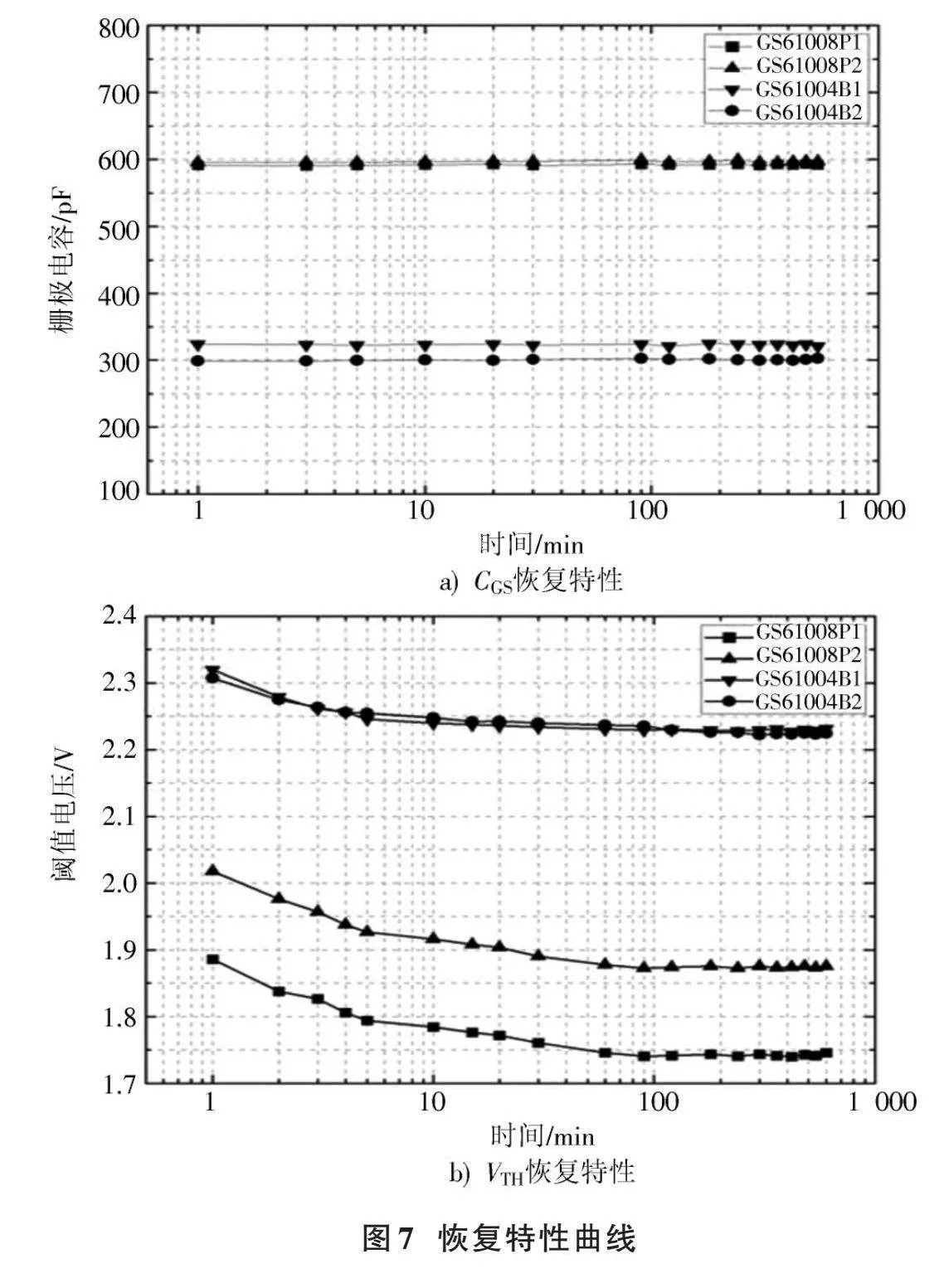
摘" 要: 氮化镓(GaN)功率器件长期在高功率密度工况下运行,其栅极可靠性一直是关注的重点,栅极的退化会造成器件误导通以及导通损耗增加等问题。为此,设计一个直流功率循环装置,通过功率循环的方式加速器件老化。同时为了评估栅极可靠性,采用与栅极紧密相关的阈值电压(VTH)以及栅极电容(CGS)作为特征参量,设计VTH与CGS监测电路。通过实验研究了器件栅极的温度特性、恢复特性以及在100 000次功率循环后的退化情况。结果表明,随着温度的增加,VTH正向漂移,漂移量超过10%,CGS则与温度解耦保持不变。器件在功率循环后VTH存在恢复现象,前10 min恢复超过70%,在3 h后保持稳定,CGS不存在恢复特性。所选两款GaN在100 000次功率循环后特征参量发生不同程度的变化,表明器件栅极在功率循环后发生了一定程度的退化。因此,有必要在设计器件及应用时考虑温度及热应力冲击所造成的栅极性能退化,优化设计工艺以提高GaN器件的可靠性。
关键词: GaN器件; 栅极可靠性; 功率循环; 阈值电压; 栅极电容; 加速老化
中图分类号: TN386⁃34" " " " " " " " " " " " " " "文献标识码: A" " " " " " " " " " " 文章编号: 1004⁃373X(2025)02⁃0041⁃05
Research on GaN device gate reliability under power cycling
GUO Shilong, XUE Bingjun, YAN Yanjin, WANG Wentao
(College of Electrical and New Energy, China Three Gorges University, Yichang 443000, China)
Abstract: Gallium nitride (GaN) power devices have been operating under high power density conditions for a long time, and the reliability of their gates has always been the focus of attention, and the degradation of the gates can cause problems such as device mis⁃conduction and increased conduction loss. A DC power cycling device is designed to accelerate the device aging by means of power cycling. In order to evaluate the reliability of the gate, the threshold voltage (VTH) and the gate capacitance (CGS) are used as the characteristic parameters to design the VTH and CGS monitoring circuits. The temperature characteristics, recovery characteristics, and the degradation of the gate after 100 000 power cycles are investigated experimentally. The results indicate that, as the temperature increases, VTH can drift forward, with a drift amount exceeding 10%, while CGS can remain decoupled from temperature and remains unchanged. After the power cycle, the VTH of the device can recover more than 70% in the first 10 min, and can remain stable after 3 h. CGS do not have recovery characteristics. The characteristic parameters of the two selected GaNs can change in different degrees after 100 000 power cycles, which indicates that the gate can degenerate to some extent after the power cycle. Therefore, it is necessary to consider the degradation of gate performance caused by temperature and thermal stress impacts when designing devices and applications, and optimize the design process to improve the reliability of GaN devices.
Keywords: GaN device; gate reliability; power cycling; threshold voltage; gate capacitance; accelerated aging
0" 引" 言
当前硅(Si)基半导体器件性能已经逼近其物理材料的极限,愈发难以满足电力电子设备的发展需求。与硅基器件相比,GaN器件具有击穿电压高、热稳定性好、功率损耗低和开关速度快等优点[1⁃2],已被广泛应用于航天航空、新能源汽车、电力传输等领域。但目前以增强型为主的GaN器件存在阈值电压漂移和栅极电容变化等栅极可靠性问题,限制了该器件的安全长期应用。器件工作需要承受高电压和大电流应力,工作频率会高达几百kHz甚至数MHz,在这种高功率密度工况下,器件会反复承受交变热应力冲击,这会对器件栅极可靠性产生较大影响。
GaN器件栅极退化可能导致阈值电压漂移和栅极电容退化等问题。阈值电压正漂会增大导通电阻,造成更大的开关损耗;负漂则易造成器件误导通,给设备带来安全隐患[3⁃4]。栅极电容的变化会对器件的开关响应速度造成影响,因此,研究功率循环加速老化下的栅极退化现象,对于了解栅极参数变化特性和器件可靠性具有重要意义。
国内外学者对GaN器件的栅极可靠性已进行了一些研究。文献[5]研究了p⁃GaN由长期正向栅极应力引起的栅极退化,随着栅极应力作用时间增加,会导致栅极击穿。文献[6]通过高温环境下的栅极应力实验,验证了温度与栅极电压偏置是影响器件栅极击穿的关键因素。文献[7]的研究结果表明,栅极电容在电压应力下具有明显的变化现象,但是大部分只考虑了电压应力对栅极的影响,忽略了热应力。功率循环是施加热应力的常见方式,文献[8]通过大电流注入进行分时老化,研究了在直流功率循环下p⁃GaN的退化情况。文献[9]在器件导通时注入不同等级电流进行功率循环,探究不同电流及循环温度下的退化结果。以上加速老化方案只能实现大电流下单个器件老化,效率低下。
基于以上研究,本文提出了一种高效率直流功率循环电路,通过对被测器件进行功率循环老化,探究在交变热应力作用下GaN栅极的退化情况。同时对于电参量的监测不再依赖于半导体分析仪等昂贵设备,而是采用恒流注入法测量阈值电压与栅极电容。
1" 功率循环平台
1.1" 被测器件选择
本文选用GaN System公司生产的GS61008P、GS61004B两款商用100 V GaN作为被测器件(Device Under Test, DUT)。器件采用GaNpx嵌入式封装结构,与传统的键合线工艺相比,其没有引线和芯片的链接,也就避免了封装方面的常见故障,包括键合线断裂、封装焊料层分层等。其中GS61008P有开尔文源极(Kelvin⁃Source),起到了增加开关导通速度、减小开关损耗的作用。
1.2" 功率循环电路及原理
功率循环测试通常用于加速老化,通过结温波动、剪切应力、热膨胀系数不匹配等问题触发各种故障机制[10]。
本文所搭建的功率循环电路框图如图1所示。该电路由恒压源、DUT、反馈控制电路、热电偶以及采样电阻Rf等组成,其中器件加热所需的功率由恒压源提供。此装置中各个DUT相互独立,可以实现小电流下DUT的同时老化,具有高效率及可扩展性。
反馈控制电路框图如图2所示,由仪表放大器和运算放大器构成。通过积分电路调节栅源极电压VGS,此时GaN的沟道电阻仅受VGS控制,DS间相当于一个受电压VGS控制的可变电阻。采集Rf两端的电压,经放大后输入给积分电路调节DUT的VGS,从而调节ISet。当ISet调节到设定值,VGS保持稳定。
加热电流ISet可表示为:
[ISet=VREFRf·G] (1)
式中:[VREF]是参考电压;[Rf]是采样电阻;G是仪表运放的放大倍数。
热电偶贴于器件下表面采集DUT壳温,通过壳温来控制器件加热或冷却。被测器件温度波动与负载电流导通时序图如图3所示。
2" 测试平台及原理
目前,GaN可靠性研究中的参数测量过度依赖于半导体分析仪等大型设备,成本高昂且体积巨大。本文针对栅极电参量,采用恒流注入法分别设计了阈值电压与栅极电容测量电路。
2.1" 阈值电压测量电路及原理
阈值电压(VTH)测量电路如图4a)所示,由被测器件DUT、恒流源、二极管D1和D2、采样电阻R1、开关管S1和S2以及微处理器MCU等构成。该系统通过恒流源注入电流实现VTH测量。MCU负责VTH采集和电路工作时序控制,电阻R1用于验证恒流源大小是否与设定一致。
测量时,导通S1、S2,恒流源输出电流经过S1、S2和D1、D2给DUT栅极电容充电。VGS充电波形如图4b)所示,栅极电压在电流注入下逐渐增大,当栅极电压增大到VTH时DUT导通,输入电流通过DUT漏源沟道流过,此时栅极电压将会维持不变,采集该电压值作为VTH。
2.2" 栅极电容测量电路及原理
栅极电容(CGS)测量电路系统框图如图5所示,包括恒微电流源、信号比较单元、信号运算单元、微处理器、GaN功率器件和隔离电源单元。由电容的电压、电流约束关系可得式(2),可知在恒流源I作用下只要确定电容电压变化范围ΔuC及对应的充电时间Δt,即可推出电容值。
[C=IdtduC=IΔtΔuC] (2)
由于GaN器件的CGS为pF级,充电电流取值过大可能难以监测出CGS的微小变化,为此,本文选择μA级恒流源对CGS充电。
3" 实验分析
3.1" 温度对阈值电压与栅极电容的影响
GaN器件常工作于高功率密度场合,温度波动大,可能会对器件栅极特性造成影响。本文研究了VTH和CGS在30~120 ℃内的温度特性。通过加热台控制DUT温度,待器件达到热稳态后进行测量,测量结果如图6所示。随着温度增加,VTH呈现正向漂移。研究中4个被测器件VTH分别正向漂移了9.88%、12.77%、11.99%、12.21%;对于CGS,在30~120 ℃内不随温度变化,电容值与温度无关。
VTH的变化与p⁃GaN层中的电荷存储效应及栅极堆叠中的电荷捕获过程有关[11]。二维电子气(2DEG)中的载流子在热激发下溢出AlGaN势垒层,与p⁃GaN中的空穴结合,或被AlGaN与p⁃GaN界面处产生的缺陷所捕获,从而引起净负电荷增加,使得栅氧化层内原有的电场减弱,导致VTH正偏[12]。
3.2" 阈值电压与栅极电容的恢复特性
由上述GaN器件的温度特性研究可知,温度对VTH是有影响的,所以需要明确VTH和CGS在功率循环后是否存在漂移恢复现象。本文首先对DUT进行2 000次功率循环,待DUT恢复室温后测量VTH与CGS,恢复特性曲线如图7所示。由图7可知,4个DUT的VTH均存在明显恢复现象,分别恢复了144 mV、142 mV、87 mV、83 mV,其中前10 min恢复超过70%,在3 h后基本保持稳定。CGS循环后的值不随着时间而恢复。
VTH的恢复现象表明存在载流子的去捕获过程。功率循环过程中存在热激发效应,形成陷阱态,导致载流子在其中积累[13];功率循环结束后,这些电荷逐渐被释放,从而表现出VTH的恢复现象。
3.3" 功率循环下阈值电压与栅极电容的退化特性
搭建的GaN功率循环及测试平台实物图如图8所示。通过两款器件数据手册给出的连续网络热路模型(Cauer模型)和最大结温,确定功率循环的壳温波动范围为35~120 ℃。本文对两款GaN进行100 000次功率循环,探究其栅极特性退化情况,每循环10 000次后测量VTH和CGS。由于阈值电压存在恢复特性,每次测量前使器件静置12 h,减小因恢复特性而带来的误差。栅极电参量退化曲线见图9。
在交变热应力冲击下,两款GaN器件栅极出现了不同程度的退化。两个GS61004B器件分别在70 000、90 000次时发生了较为明显的退化,VTH与CGS呈现不同程度的陡降且不存在恢复。GS61004B1的VTH下降11.68%,CGS下降46%,GS61004B2的VTH下降33.56%,CGS下降44%,其中GS61004B2的VTH下降超过失效标准[14]20%,认为器件失效停止老化;VTH与CGS的同时陡降说明被测器件发生了不可逆的退化,器件随时有损坏风险。2个GS61008P器件的VTH也呈下降趋势,但程度较小,分别下降2.5%、2.8%,CGS则保持稳定。100 000次功率循环后GS61008P没有发生明显老化,其VTH的下降可能是由于栅极内的可移动电子受交变热应力影响,在空间位置上发生漂移,使得栅氧化层内原有的内电场增强,造成了阈值电压的负方向漂移。
4" 结" 论
本文设计了一种高效率直流功率循环电路以及采用恒流注入的VTH与CGS测量电路。基于设计的功率循环及测量平台,研究了两款GaN器件在功率循环下的栅极可靠性。实验结果表明,温度增加会引起VTH正向漂移,CGS则不随温度变化。功率循环中会因为存在热激发效应而造成VTH短暂正向漂移,之后随着载流子的去捕获过程出现恢复现象。功率循环测试结果表明,栅极会因交变热应力冲击发生一定程度的退化,研究中GS61004B的VTH与CGS都表现出不可逆的明显变化,说明器件栅极可能发生了较大程度的退化,增加了器件损坏风险,从而使得整个电路都会产生危险。本文研究有助于更好地了解和预测GaN器件栅极在应用中的老化行为,为其可靠性评估提供依据。
注:本文通讯作者为郭世龙。
参考文献
[1] KOZAK J P, ZHANG R, PORTER M, et al. Stability, reliability, and robustness of GaN power devices: a review [J]. IEEE transactions on power electronics, 2023, 38(7): 8442⁃8471.
[2] NAUTIYAL P, PANDE P, KUNDU V S, et al. Trap⁃assisted degradation mechanisms in E⁃mode p⁃GaN power HEMT: a review [J]. Microelectronics reliability, 2022, 139: 114800.
[3] TALLARICO A N, STOFFELS S, POSTHUMA N, et al. Threshold voltage instability in GaN HEMTs with p⁃Type gate: Mg doping compensation [J]. IEEE electron device letters, 2019, 40(4): 518⁃521.
[4] WU H, FU X, GUO J, et al. Time⁃resolved threshold voltage instability of 650⁃V schottky type p⁃GaN gate HEMT under temperature⁃dependent forward and reverse gate bias conditions [J]. IEEE transactions on electron devices, 2022, 69(2): 531⁃535.
[5] TALLARICO A N, STOFFELS S, POSTHUMA N, et al. Gate reliability of p⁃GaN HEMT with gate metal retraction [J]. IEEE transactions on electron devices, 2019, 66(11): 4829⁃4835.
[6] MILLESIMO M, FIEGNA C, POSTHUMA N, et al. High⁃temperature time⁃dependent gate breakdown of p⁃GaN HEMTs [J]. IEEE transactions on electron devices, 2021, 68(11): 5701⁃5706.
[7] LAI Y C, ZHONG Y N, TSAI M Y, et al. Gate capacitance and off⁃state characteristics of E⁃Mode p⁃GaN gate AlGaN/GaN high⁃electron⁃mobility transistors after gate stress bias [J]. Journal of electronic materials, 2021, 50(3): 1162⁃1166.
[8] XU C, UGUR E, YANG F, et al. Investigation of performance degradation in enhancement⁃mode GaN HEMTs under accelerated aging [C]// Proceedings of the 2018 IEEE 6th Workshop on Wide Bandgap Power Devices and Applications. Atlanta, GA, USA: IEEE, 2018: 98⁃102.
[9] NAYDIN Y, JAHDI S, YU R, et al. Electrothermal power cycling of GaN and SiC cascode devices [J]. Microelectronics reliability, 2023, 150: 115117.
[10] 唐伯晗.GaN HEMT功率循环参数退化的测量与分析[D].北京:北京工业大学,2019.
[11] ZHONG K, XU H, ZHENG Z, et al. Characterization of dynamic threshold voltage in schottky⁃type p⁃GaN gate HEMT under high⁃frequency switching [J]. IEEE electronic device letters, 2021, 42(4): 501⁃504.
[12] WEI J, XIE R, XU H, et al. Charge storage mechanism of drain induced dynamic threshold voltage shift in p⁃GaN gate HEMTs [J]. IEEE electron device letters, 2019, 40(4): 526⁃529.
[13] 维哲,周琦,陈佳瑞,等.自热效应下P⁃GaN HEMT的阈值漂移机理[J].电子与封装,2022,22(8):68⁃73.
[14] EMPIAK C, LINDEMANN A. A method for the measurement of the threshold⁃voltage shift of SiC MOSFETs during power cycling tests [J]. IEEE transactions on power electronics, 2021, 36(6): 6203⁃6207.

