面向芯片三维封装的低成本玻璃基深沟电容技术
电容作为集成电路芯片应用的重要元件,广泛用于滤波、振荡、去耦、开关等场景。近年来,高密度集成对高性能、微型化无源器件的需求急速增加,并且耦合阻抗匹配电路对电容提出了更高的要求。研究结果表明,集成深沟电容(DTC)的2.5D/3D 封装芯片具有优越的电源完整性(PI)。硅基深沟电容虽然可以满足对高电容密度和高集成化的要求,但存在高损耗和高工艺成本等问题。玻璃具有优异的高频电学性能、良好的绝缘性、可调节的热膨胀系数(CTE)和面板级尺寸,已成为低损、低成本2.5D/3D 封装及集成无源器件的理想基板。
厦门大学于大全教授团队报告了基于玻璃通孔(TGV)技术的玻璃基深沟电容工艺,设计并实现了一款金属-绝缘体-金属(MIM)的三维电容。通过激光诱导湿法刻蚀(LIWE)技术实现玻璃基上阵列的盲槽结构,使用原子层沉积和化学气相沉积技术制成了MIM电容叠层,玻璃基板电容加工工艺如图1 所示。LIWE与使用专用掩模在硅深反应离子刻蚀(DRIE)中形成沟槽不同,LIWE 利用激光辐照直接在玻璃基板上形成沟槽轨迹。选择性蚀刻是因为受损区域中的纳米孔增加了与蚀刻溶液的玻璃接触面积,并导致与未受损区域的蚀刻间隙。盲孔在后续的HF 蚀刻中形成,这比Si DRIE 更高效和经济。在孔径较小的深盲孔中,能得到锥形底部,盲孔的壁面很光滑。通过原子层沉积技术在顶部沉积TiN/Al2O3/TiN 堆叠层,以确保优异的阶梯覆盖和均匀性,并制造MIM 电容器堆叠。为了降低TiN 层的等效串联电阻(ESR),使用2 000 个循环的预反应进行室内氮化处理,然后在450 ℃、TiCl4和NH3气氛下沉积TiN 层。结果显示,TiN 电极的ESR 通常小于130 mΩ。低电阻的TiN 层不仅直接降低了电极厚度、优化了引出电路的设计,还进一步降低了电容器的寄生电感和寄生电容,实现拥有更低损耗、更高性能的高密度电容器。
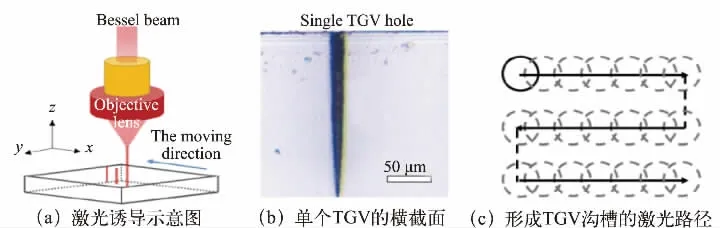
图1 玻璃基板电容加工工艺
研制出的玻璃沟槽电容器在360 μm×360 μm 的尺寸下实现了8.85 nF 的电容值、10 pH 的等效串联电感值(ESL)和315 mΩ 的等效串联电阻值,谐振频率在0.54 GHz,其射频特性如图2 所示。电容值与沟槽单元的数量和深度成正比。测得TGV 和RDL 的寄生电容值低至100 fF,沟槽电容的击穿电压为(7.83±2.3)V。所开发的玻璃基三维电容器具有经济、高效、高电容密度和易于三维集成的优点,有望在玻璃转接板和异构集成应用中发挥关键作用。(胡芝慧 钟毅 窦宇航 于大全)
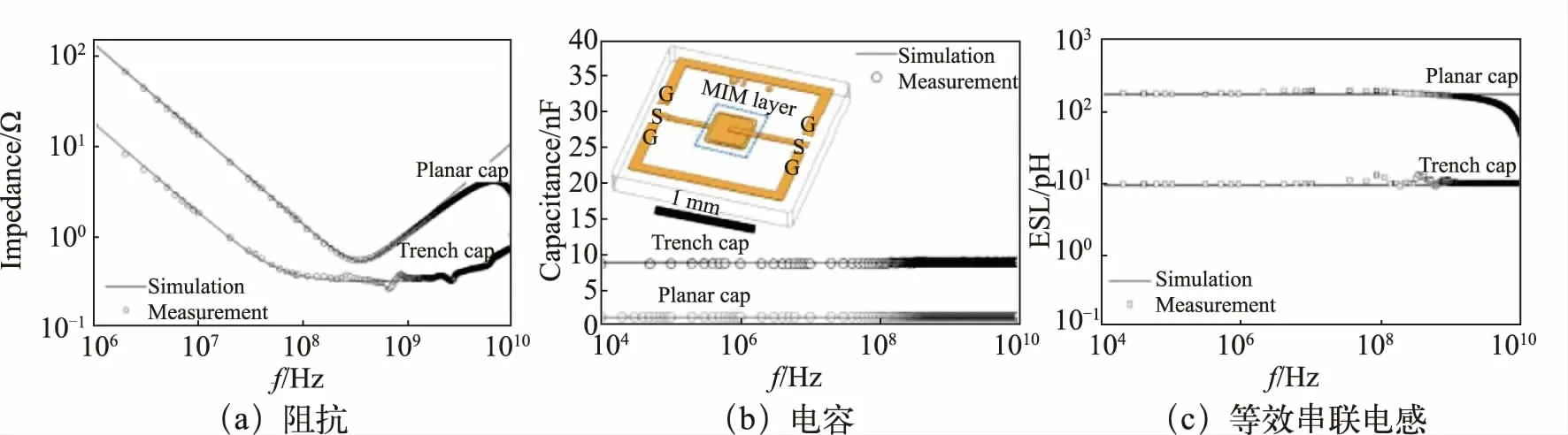
图2 玻璃沟槽电容器的射频特性
原始文献:
HU ZH H,ZHOU Q,MA H ZH,et al.Development of low cost glass based deep trench capacitor for 3D packaging[J].IEEE Electron Device Letters,2023,44(9):1535-1538.

