中子辐射导致的SiC 功率器件漏电增加特性研究*
彭超 雷志锋 张战刚 何玉娟 马腾 蔡宗棋 陈义强
(工业和信息化部电子第五研究所,电子元器件可靠性物理及其应用技术重点实验室,广州 511370)
基于14 MeV 中子辐照研究了碳化硅(silicon carbide,SiC)肖特基势垒二极管(Schottky barrier diode,SBD)和金属氧化物半导体场效应晶体管(metal oxide semiconductor field effect transistor,MOSFET)器件的位移损伤退化特性.结果表明: 总注量为1.18×1011 cm-2 的中子辐照不会引起SBD 正向I-V 特性的明显退化,但会导致反向漏电流出现显著增大.通过深能级瞬态谱测试发现中子辐照在SiC 中引入的缺陷簇形成了能级位置EC-1.034 eV 处的缺陷.该深能级缺陷可能导致SiC 漂移层费米能级向禁带中央移动,引起了肖特基势垒的降低,最终导致反向漏电流的增大.此外,中子辐照也会导致SiC MOSFET 栅漏电增大.对应栅电压Vgs=15 V时,辐照后器件栅电流比辐照前增大了近3.3 倍.中子辐照在氧化层中引入的施主型缺陷导致辐照前后MOSFET器件的栅氧导电机制发生了变化.缺陷对载流子越过栅氧化层势垒有辅助作用,从而导致栅漏电的增加.深能级瞬态谱测试结果表明中子辐照还会导致MOSFET 器件沟道附近SiC 材料中本征缺陷状态的改变,同时形成了新的Si 空位缺陷能级,但这些缺陷不是导致器件性能退化的主要原因.
1 引言
碳化硅(silicon carbide,SiC)材料具有禁带宽度大、击穿场强高、热导率高、耐高温等优势,使得其在高功率应用领域极具优势[1-3].此外,得益于其宽禁带和高临界位移能,SiC 材料还具有优良的抗电离辐射和抗位移损伤辐射性能,因此SiC 基功率器件在航天电子系统中有重要应用需求.在空间应用中,辐射环境是影响SiC 功率器件可靠性的关键因素.国内外针对SiC 功率器件的电离辐射效应开展了深入研究,已有大量文献报道了辐射导致的SiC 功率器件的单粒子烧毁(single event burnout,SEB)[4-9]和总剂量退化[10-12].可见,尽管SiC 材料在理论上具有优良的抗电离辐射性能,但基于SiC材料的器件仍然存在电离辐射失效风险.目前关于SiC 功率器件的位移损伤辐射效应的研究相对较少,SiC 器件能否充分发挥SiC 材料在抗位移损伤方面的优势还存在疑问,其抗位移损伤性能有待进一步评估.Hazdra 等[13]针对SiC 肖特基二极管(Schottky barrier diode,SBD)开展了注量达4 ×1014cm-2的1 MeV 中子辐照,发现辐照引入的点缺陷对器件阻断和动态特性的影响可以忽略不计,但会导致导通电阻的显著增大.Omotoso 等[14]研究发现注量为8.9×1011cm-2的α 离子辐照会导致SiC SBD 器件理想因子和串联电阻的显著增大,经过300 ℃退火后又能大幅恢复.Yang 等[15]的研究表明注量为1.5×1010cm-2的Si 离子辐照会在SiC SBD 器件中引入高密度深能级缺陷,导致器件肖特基势垒降低、载流子浓度降低.Chao 等[16]报道了中子位移损伤引起的有效载流子浓度降低导致SiC MOSFET 器件的性能退化.
基于此,本文以SiC SBD 和金属氧化物半导体场效应晶体管(metal oxide semiconductor field effect transistor,MOSFET)器件为对象,利用14 MeV中子辐照进一步探索位移损伤辐射导致的性能退化特性.结合电容深能级瞬态谱(capacitance deep level transient spectrum,C-DLTS)技术表征中子辐射在器件引入缺陷的微观特征,从微观机制上解释SiC 功率器件的退化行为.
2 实验描述
试验样品包括Cree 公司的SiC MOSFET(C2M0080120D,额定电压1200 V,额定电流36 A)以及泰科天润公司的三款SiC 结势垒肖特基(junction barrier Schottky,JBS)二极管(G3S06505A,650 V,5 A;G3S12005A,1200 V,5 A;G3S17005A,1700 V,5 A).SiC MOSFET 器件采用TO-247-3封装,所有JBS 二极管均采用TO-220AC 封装.试验用SiC 器件表面形貌和纵切截面分别如图1和图2 所示.

图1 试验用SiC 结势垒肖特基二极管器件 (a)表面形貌的光学显微镜图;(b)截面示意图Fig.1.SiC JBS diode used in our experiment: (a) Optical microscope diagram of surface morphology;(b) diagram of cross-section.
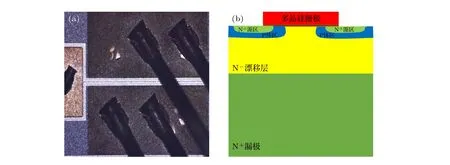
图2 试验用SiC MOSFET 器件 (a)表面形貌的光学显微镜图;(b)截面示意图Fig.2.SiC MOSFET used in our experiment: (a) Optical microscope diagram of surface morphology;(b) diagram of cross-section.
中子辐照在中国原子能科学研究院的14 MeV单能中子源上进行.器件安装在测试板上,调整测试板的位置保证中子垂直入射到待测器件.由于中子的穿透性很强,所有器件均采用带封装辐照.每款器件均选用3 件样品开展辐照试验.辐照过程中,所有样品均处于无偏置状态.选用的中子注量率为1 × 106cm-2·s-1,累积中子总注量为1.18×1011cm-2.根据Geant4 仿真[17,18]可计算14 MeV中子在SiC 材料中的非电离能损(non-ionization energy loss,NIEL)为1.758 × 10-7MeV·cm2/mg.当中子总注量达到1.18×1011cm-2时,可计算辐照过程中的总位移损伤剂量为2.07×104MeV/mg.
辐照前后,通过Keysight B1500A 半导体参数分析仪对全部样品的I-V特性曲线进行测试.I-V特性曲线在室温下进行.基于I-V特性曲线提取的器件肖特基势垒、理想因子等参数均为3 件样品的平均值.同时,每款器件选取一件样品开展了辐照前后C-DLTS 测试,该测试基于PhysTech 公司的FT1230 HERA-DLTS 测试系统开展.对于JBS器件,重点针对肖特基结开展深能级瞬态谱测试和分析,获取其缺陷特性.测试过程中阳极接低电位,阴极接高电位.DLTS 测试过程中设定的主要参数为: 反向偏压VR=-10 V,脉冲电压VP=0 V,测试周期TW=100 ms,脉冲宽度TP=1 ms.对于MOSFET 器件,重点针对栅电容开展深能级瞬态谱测试和分析,获取其缺陷特性.测试过程中栅极接高电位,源极和漏极接低电位.DLTS 测试过程中设定的主要参数为: 反向偏压VR=0 V,脉冲电压VP=6 V,测试周期TW=4 ms,脉冲宽度TP=1 ms.深能级瞬态谱测试中的温度扫描范围均为50–450 K.
3 实验结果及讨论
3.1 中子辐射导致的SiC JBS 器件退化
3.1.1I-V特性退化
图3–5 显示了3 款SiC 二极管中子辐照前后的正向和反向I-V特性,其中VAnode为阳极电压,IAnode为阳极电流.可以看到,辐照后二极管的正向电流有轻微的增加,而反向电流(绝对值)的增加更明显.对应反向偏压为-50 V 时,辐照后额定电压为650 V,1200 V 和1700 V 的器件反向电流分别为辐照前的5.2 倍、11.6 倍和4.0 倍.SiC 肖特基势垒二极管的正向电流传输满足热电子发射模型,其正向电流密度可表示为

图3 额定电压为650 V 的二极管辐照前后正向(a)和反向(b) I-V 特性Fig.3.Forward (a) and reverse (b) I-V characteristics of 650 V SiC diode before and after irradiation.

图4 额定电压为1200 V 的二极管辐照前后正向(a)和反向(b) I-V 特性Fig.4.Forward (a) and reverse (b) I-V characteristics of 1200 V SiC diode before and after irradiation.

图5 额定电压为1700 V 的二极管辐照前后正向(a)和反向(b)I-V 特性Fig.5.Forward (a) and reverse (b) I-V characteristics of 1700 V SiC diode before and after irradiation.
其中,A为有效理查逊常数,对于4H-SiC,A=146 A/(cm2·K2);T为温度(K);φB为肖特基势垒高度(eV);n为理想因子;V为正向偏压;k为玻尔兹曼常数;V为器件正向电压;q为单位电荷量.利用(1)式对肖特基二极管正向电流进行拟合,可提取每款器件辐照前后的肖特基势垒φB和理想因子n,如表1 所列.辐照前后,3 款器件的理想因子几乎保持不变,肖特基势垒均出现了0.01 eV 左右的降低.

表1 根据I-V 特性提取的二极管肖特基势垒高度Table 1. Schottky barrier height of SiC diodes extracted by I-V characteristics.
SiC 肖特基势垒二极管的反向电流传输满足热电子场发射模型,其反向电流密度可表示为[19]
其中,CT为隧穿系数,约为8×10-13cm2/V2;φB0对应反向电场为零时的肖特基势垒高度;Es为肖特基结表面电场强度;εs为SiC 介电常数.根据(2)式可知,反向电流(绝对值)反比于肖特基势垒高度,正比于肖特基结电场强度.辐照后器件肖特基势垒高度降低了0.01 eV,会导致反向电流增大1.5 倍左右,这小于实际观察到的反向电流增大量.因此,中子辐照导致的反向电流增大有一部分也可能来源于肖特基结附近电场强度的增大.
3.1.2 辐射损伤缺陷表征
图6 为1700 V 额定电压的二极管中子辐照前后的深能级瞬态谱测试结果.深能级瞬态谱上的每一个信号峰对应一个缺陷能级.在50–450 K 的温度扫描范围内,辐照前的DLTS 谱上观察到两个正信号峰,分别标记为DT1和DT2.其对应两个本征的多子缺陷中心.根据DLTS 谱的峰值位置可拟合得到缺陷中心的发射时间常数随温度的变化关系,即阿伦尼乌斯曲线,可表示为

图6 (a)额定电压为1700 V 的二极管辐照前后的深能级瞬态谱特性,其中内嵌图为温度300–400 K 之间曲线的放大图;(b)阿伦尼乌斯曲线Fig.6.(a) DLTS spectra of 1700 V SiC diode before and after irradiation,the inset graph is the enlarged curve between 300-400 K;(b) Arrhenius plot.
其中,NC为导带底有效状态密度,vth,n为电子热速度,τe为缺陷俘获电子的热发射时间常数,Xn为熵因子,σn为缺陷俘获截面,EC为导带能将,ET为缺陷能级.根据(4)式,由阿伦尼乌斯曲线的斜率可以计算得到缺陷能级ET,由曲线与y轴的截距可计算得到俘获截面σn.基于阿伦尼乌斯曲线进行拟合,可提取辐照前器件的缺陷信息,如表2所列.缺陷DT1能级位置为EC-0.071 eV.根据能级位置判断该缺陷为占据晶格位置的氮杂质缺陷[14,20].该缺陷接近导带顶,为浅能级缺陷,其对器件性能的影响要远小于缺陷DT2.缺陷DT2能级位置为EC-0.864eV,俘获截面为2.19×10-15cm2,其对应SiC 器件中的RD1/2缺陷.该本征缺陷为高能离子注入引入的缺陷[21].

表2 基于深能级瞬态谱提取的SiC 二极管辐照前后的缺陷信息Table 2. Trap information of SiC diode extracted by DLTS before and after irradiation.
中子辐照后的DLTS 谱上仍然观察到两个正信号峰.但中子辐照导致DT2峰值强度增加,其对应的缺陷能级由EC-0.864 eV 变为EC-1.034 eV,更接近于禁带中心,俘获截面由2.19×10-15cm2增大为8.34×10-13cm2.该缺陷能级对应EH4 缺陷,为中子辐照导致的缺陷簇[13,22,23].该缺陷同样在5 MeV 的质子辐照(总注量1012cm-2)[22]以及2.5 MeV 的电子辐照(总注量1014cm-2)[23]中被观察到.中子辐照引入的EH4 缺陷可能是导致二极管辐照后电特性退化的主要原因.该缺陷引起了肖特基势垒的降低,最终导致反向饱和电流的增大.值得注意的是,中子辐照后DT1峰值强度减弱.这与辐照后SiC 漂移层中费米能级降低相关.图7 显示了DLTS 测试过程中SiC 二极管的能带示意图.在辐照前的DLTS 测试过程中,二极管上施加一个反偏电压VR.对于n 型漂移层中的多子浅能级缺陷ET,其在费米能级EF以下的部分被电子填充,而在空间电荷区内ET能级位于EF以上的部分无电子填充.随后二极管上加一个正向电压脉冲VF.空间电荷区内缺陷能级ET降到EF以下,缺陷能级被电子填充.在正向脉冲移除恢复反向偏压的瞬间,空间电荷区内缺陷能级ET重新上升到EF之上,但缺陷上填充的电子仍然来不及释放.中子辐照后会在器件内部引入更深能级的EH4 缺陷,导致费米能级ET向禁带中央移动.此时开展DLTS 测试时,在加正向脉冲电压期间只有部分缺陷能级被电子填充.因此导致了DLTS 测试得到的DT1缺陷峰值强度减弱.
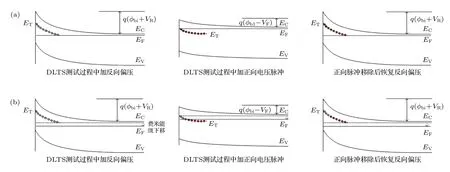
图7 DLTS 测试过程中SiC 二极管的能带示意图(EV 为价带能级) (a)辐照前;(b)辐照后.Fig.7.Schematic diagram of the energy band of SiC diode during DLTS testing process: (a) Pre-irradiation;(b) after-irradiation.
3.2 中子辐射导致的SiC MOSFET 器件退化
3.2.1I-V特性退化
图8(a)显示了14 MeV 中子辐照前后SiC MOSFET 的I-V特性曲线.当辐照总注量达到1.18×1011cm-2 时,器件的转移特性有轻微负向漂移,栅电流出现了明显增大.对应栅电压Vgs=15 V时,辐照后器件栅电流比辐照前增加了近3.3 倍.根据Frenkel-Poole 发射理论,MOS 栅电流与电压的平方根满足如下指数关系[24]:

图8 (a) SiC MOSFET 器件辐照前后的转移特性和栅电流特性,测试条件为源端电压Vs=0 V,漏端电压Vd=0.1 V;(b)辐照后SiC MOSFET 器件栅电流拟合,测试条件Vd=Vs=0 VFig.8.(a) Transfer and gate-current characteristics of SiC MOSFET before and after irradiation (test condition,Vs=0 V,Vd=0.1 V);(b) gate current fitting of SiC MOSFET after irradiation (test condition Vd=Vs=0 V).
其中,εi为氧化层介电常数,d为氧化层厚度,ϕB为氧化层势垒高度.利用(5)式对辐照后MOSFET器件栅电流进行拟合,吻合很好,如图8(b)所示.这说明辐照后栅电流满足Frenkel-Poole 导电特性.因此可推断中子辐照可能在SiC MOSFET 的氧化层中或氧化层界面附近引入了额外的施主型缺陷,如图9 所示.这些缺陷对载流子通过势垒层具有辅助作用,从而导致辐照后栅电流增大.中子辐射引入的缺陷在俘获电子后呈中性,其俘获的电子可以越过一个较低的势阱后进入导带参与导电.当MOSFET 器件栅端加一个正向偏压后,氧化层中的势垒进一步降低,使得缺陷俘获的电子更容易跃迁到导带,从而使得栅电流随着栅氧电场增加而增加,如图9(c)所示.当施主型缺陷俘获的电子进入导带后,在氧化层中留下带正电的缺陷,从而导致器件的转移特性出现了负向漂移.
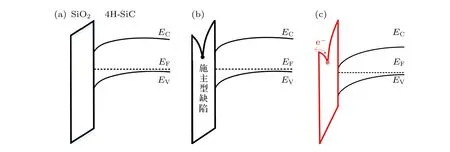
图9 (a)辐照前未加栅偏压下的SiC MOSFET 器件能带图;(b)辐照后未加栅偏压下的SiC MOSFET 器件能带图;(c)辐照后加正栅偏压下的SiC MOSFET 器件能带图Fig.9.(a) Energy band diagram of SiC MOSFET without gate bias before irradiation;(b) energy band diagram of SiC MOSFET without gate bias after irradiation;(c) energy band diagram of SiC MOSFET with positive gate bias after irradiation.
3.2.2 辐射损伤缺陷表征
图10 为辐照前后SiC MOSFET 器件的深能级瞬态谱测试结果.针对栅电容的深能级瞬态谱测试结果反映的是沟道附近SiC 耗尽层中的缺陷特性.在辐照前的SiC MOSFET 的深能级瞬态谱中出现了一个明显的正信号峰MT1,其对应一个多子缺陷中心.基于阿伦尼乌斯曲线拟合,可提取辐照前器件的缺陷信息见表3.该缺陷能级位置EC-1.112 eV.中子辐照后的DLTS 谱上观察到两个正信号峰,分别标记为MT1和MT2.相比于辐照前,中子辐照导致MT1峰向低温区漂移,同时峰值强度增大,这反映了缺陷密度的增大,而其对应的缺陷能级由EC-1.112 eV 变为EC-0.980 eV.辐照后的缺陷能级变得比本征缺陷更浅且密度增加有限,不会对SiC MOSFET 器件的性能产生较大影响.此外,中子辐射在MOSFET 器件中引入一个新的缺陷MT2,其能级位置为EC-0.376 eV.该缺陷能级对应于Si 空位缺陷,这说明中子辐照在SiC 中引入了额外的Si 空位.但该新增缺陷的密度很低,远小于器件中的本征缺陷密度,预期也不会影响器件电学性能.因此,SiC 有源区中的缺陷不是导致MOSFET 器件性能退化的主要原因.

表3 基于深能级瞬态谱提取的SiC MOSFET 辐照前后的缺陷信息Table 3. Trap information of SiC MOSFET extracted by DLTS before and after irradiation.

图10 (a)辐照前后SiC 功率MOSFET 器件的深能级瞬态谱;(b)阿伦尼乌斯曲线Fig.10.(a) DLTS spectrums of SiC MOSFET before and after irradiation;(b) Arrhenius plot.
4 结论
本文针对SiC 肖特基二极管和MOSFET 器件开展了14 MeV 中子辐照试验.当中子总注量达到1.18×1011cm-2 时(对应总位移损伤剂量为2.07×104MeV/mg),未观察到二极管正向I-V特性有明显退化,但反向漏电流出现了显著增大.深能级瞬态谱的测试结果表明,中子辐照导致的缺陷簇在器件内形成了深能级缺陷EH4,其缺陷能级EC-1.034 eV.该缺陷导致了n 掺杂漂移层中费米能级向禁带中央移动,引起了肖特基势垒的降低,最终导致二极管反向漏电流的增大.对于SiC MOSFET 器件,中子辐照后的转移特性未出现明显退化,但栅电流有明显增加.辐照后器件的栅氧化层导电满足Frenkel-Poole 发射特性.这表明辐照前后MOSFET 器件的栅氧导电机制发生了变化,中子辐照在氧化层中引入的额外缺陷对载流子越过栅氧化层势垒有辅助作用,从而导致了栅漏电的增加.

