同位素10B靶的制备
樊启文,王 华,孟 波
(中国原子能科学研究院 核物理研究所,北京 102413)
10B材料被广泛应用于核工程领域与核物理研究中,10B(n,α)7Li反应在中子核反应中占有特殊重要的地位。各种反应堆(核电站、核动力堆等)在初装燃料时,需在堆芯布置由B-B化合物制成的可燃毒物组件,用10B(n,α)7Li反应来补偿部分过剩反应,抑制功率峰,该反应截面的精度会影响过剩反应性的计算与控制精度。基于上述反应,含B物质对慢中子有较大的吸收截面,常被用作中子的防护与屏蔽材料[1]。几乎所有与中子有关的核装置(如反应堆、加速器、防中子辐射的坦克等)的设计都需要中子与10B发生核反应的准确截面信息。中子不带电,中子与10B发生核反应10B(n,α)7Li产生带电粒子,通过测量带电粒子即可间接测量中子。在核物理研究、核能开发与裂变材料的检查中,常利用10B(n,α)7Li反应对中子进行探测。在生物医学研究中,用10B(n,α)7Li反应产生的带电粒子治疗癌症(BNCT)[2]。基于长期的实验测量、理论计算与评价工作,由热中子到1 MeV能量范围的10B(n,α)7Li反应截面已被准确确定下来,成为IAEA推荐中子核反应的一级标准截面。在标准中子场测量和中子核数据测量[3-7]中,10B也是重要的探测介质材料,主要是针对MeV以下低能区的测量,一般是在几十μm的薄衬底上镀10B靶。
在同位素核靶研制领域,10B靶是最难制备的稳定同位素靶之一,适合制备10B靶的方法很少。10B材料是一种昂贵的同位素核材料,国外采购的10B通常为粉末形态,且数量稀少(百mg级别),显然不适合采用磁控溅射等需大块靶材料的制备方法。10B材料熔点高(约2 075 ℃),蒸发温度也高(约2 300 ℃),采用电阻加热蒸发技术也难以制备10B靶。10B材料为脆性半导体,在高温受热过程中极易分裂、飞溅,采用商业大电子枪轰击法也难以成功制备满足实验要求的10B靶,同时造成材料的极大浪费。10B材料的溅射速率极低,采用聚焦重离子溅射法制备10B靶时间效率非常低,且聚焦重离子溅射法难以制备大面积的10B靶(均匀性极差)。为此,针对10B靶的特点,课题组自主研制一台间歇式静电聚焦微调电子轰击装置,本文介绍利用该装置制备同位素10B靶的技术方法。
1 实验装置
采用间歇式静电聚焦微调电子轰击法制备10B靶,其装置如图1所示,该装置主要由电子枪、灯丝电源、高压电源和真空系统组成。该设备中的电子枪及其配套电源均为自行加工和组装,镀膜室及过渡法兰均在现有镀膜机上改造。该电子枪与商用电子枪[8]的主要区别为:1) 本文电子枪的功率(灯丝电源0~120 W、高压电源0~900 W)可间歇式连续微调,而商用电子枪为档位调节,档位功率大(3 kW、6 kW),不适合制备10B这样的半导体易飞溅的贵重同位素材料;2) 本文电子枪可调控电子束轰击的x、y和z3个方位的位置。间歇式静电聚焦微调电子轰击与热蒸发的区别为:热蒸发为自下而上加热,电子枪自上而下加热,且普通热蒸发难以达到10B的蒸发温度(约2 300 ℃)。

图1 间歇式静电聚焦微调电子枪装置示意图Fig.1 Schematic diagram of intermittent electrostatic aggregation fine-tuning electron gun device
2 工艺方法
采用间歇式静电聚焦微调电子轰击法制备同位素10B靶,总体工艺为三步法:压片-烧结-蒸发。
首先,将粉末状同位素10B材料通过特定的模具在压力机上压成10B柱,长度通常为12 mm,直径由模具的内径确定。10B柱的直径越大,所需蒸发功率越大。10B柱直径对应的蒸发功率如图2所示。

图2 10B柱直径与功率的关系Fig.2 Relationship between 10B column diameter and power
其次,安装电子枪灯丝(直径为0.5 mm的W丝弯成直径为30 mm的圈),将压好的10B柱放入特制的BN/C坩埚并装进电子枪中,在高真空(低于2×10-4Pa)下启动电子枪将10B柱自上至下烧结。
最后,将灯丝圈平面与10B柱之间的垂直距离调至10.5~11 mm。若该距离过大,会导致蒸发时高压电源功率大,从而使电子枪法兰温度过高,损坏绝缘材料,蒸发无法持续;若该距离过小,会导致电子束聚焦到10B柱下半部分、坩埚位置甚至W支撑杆上,最终导致10B柱塌陷或W支撑杆熔断,蒸发失败。将真空抽至低于2×10-4Pa,再次启动电子枪,逐步升高高压(即间歇式微调升压)使10B柱顶端温度升高至蒸发温度(约2 300 ℃),使10B开始蒸发并沉积在基衬上。蒸发速率必须控制在0~0.02 μg/(cm2·s)(通常为0.01 μg/(cm2·s)),蒸发速率若大于0.02 μg/(cm2·s),将导致10B材料飞溅,致使生长的10B靶表面出现大量宏观液滴甚至将薄基衬击破,如图3所示。

图3 蒸发速率大于0.02 μg/(cm2·s)时制备的10B靶SEM图Fig.3 SEM picture of 10B target with evaporation rate greater than 0.02 μg/(cm2·s)
3 基片温度对10B靶结构和性能的影响
采用间歇式静电聚焦微调电子轰击法制备10B靶时,基片温度是影响10B靶生长过程和10B靶与基衬之间结合力的关键因素。在4片2英寸的Si片上分别沉积约500 nm厚的10B靶,沉积过程中分别对4片Si片作不加温、加温100 ℃、加温200 ℃和加温300 ℃处理。不同基片温度下沉积的10B靶生长过程变化如图4所示。由图4可见:基片不加温时靶表面呈现颗粒沉积,不结晶;基片加温100 ℃时,靶表面呈现团聚状,并开始结晶;基片加温200 ℃时,靶表面呈现明显的枝状晶;基片加温300 ℃时,沉积的10B靶呈现明显的岛状晶和管状晶。
划痕法是一种广泛应用于表征膜-基界面结合强度的方法[9],本工作通过微划痕测试仪所测的声发射数据评定膜基结合力。在划擦过程中,当膜基出现结合失效时,声发射信号会突然增强,因此声发射信号突变峰所对应的法向载荷可作为临界载荷的判定值。图5示出10B靶声发射信号强度与法向载荷的关系。由图5可见,样品的声发射信号强度均发生突变,对应的法向载荷即为该样品的膜基结合力。

图4 不同基片温度下沉积的10B靶SEM图Fig.4 SEM picture of 10B target deposited at different substrate temperatures

a——常温;b——100 ℃;c——200 ℃;d——300 ℃图5 10B靶声发射信号强度与法向载荷的关系Fig.5 Relationship between 10B target acoustic signal strength and normal load
由图4、5可判断,随基片温度的升高,生长的10B靶逐步结晶,越来越致密,膜基结合力也越好,但基片温度是有边际效应的。首先,随基片温度升高到一定程度后,膜基结合力的增长率是递减的;其次,基片温度升高到一定程度后,生长的薄膜与基片材料会产生互相渗透效应。
4 不均匀性计算与测试
4.1 不均匀性计算
衬底转动蒸发沉积,衬底上任意一点生长的薄膜归一化质量厚度由下式[10]给出:
(1)
其中:h为源-衬距,cm;r为源-轴距,cm;s为衬底中心至衬底上任意一点的距离,cm;d(s)为衬底上任意一点的归一化质量厚度,μg/(cm2·mg)。分别选取不同的源-衬距和源-轴距,通过Matlab计算厚度分布,并计算φ100 mm的靶在不同h-r匹配值下对应的最大不均匀性,计算结果如图6所示。根据图6计算结果和物理实验对均匀性的要求,即可确定最佳的h和r匹配参数,从而为实际制靶中选取几何参数提供依据。
4.2 不均匀性测试
在满足物理实验对均匀性要求的前提下,为尽量提高同位素材料的利用率,源-衬距h应尽量选择较小值。确定h后,再根据上述计算结果匹配对应的源-轴距r。不均匀测试选取近几年实际制备同位素10B靶时常用的参数组合(h=15 cm、r=13.5 cm),在100 mm×100 mm的铝板上均匀分布36片铝膜,在铝膜上沉积约120 μg/cm2的10B靶(φ8 mm)。用千万分之一天平测量10B靶的质量,并计算出每片10B靶的质量厚度,最后统计36个位置10B靶的质量厚度分布,并以此来表征100 mm×100 mm范围内的10B靶不均匀性,测试结果列于表1。10B靶质量厚度的总平均值为112.0 μg/cm2,去除四角后的平均值为116.8 μg/cm2。

图6 不均匀性计算结果Fig.6 Calculation result of inhomogeneity
由表1可知:1) 在上述工艺条件下得到的10B靶平均质量厚度为112 μg/cm2,厚度分布中间厚、周围薄、四角位置的10B靶最薄;2) 对于在有效尺寸为100 mm×100 mm的基衬上制备10B靶,最大不均匀性为14.8%;3) 若考虑φ100 mm的范围(即舍弃四角的4片10B靶),则最大不均匀性为12.4%;4) 若选取φ80 mm区域,最大不均匀性小于10%。图7为同位素10B靶照片。
5 总结与讨论
1) 利用间歇式静电聚焦微调电子轰击法系统研究了制备同位素10B靶的工艺,确定了“压片-烧结-蒸发”三步法制备10B靶。

表1 质量厚度分布测试结果Table 1 Result of mass thickness distribution
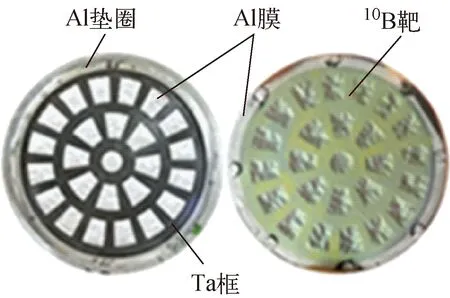
图7 同位素10B靶照片Fig.7 Photo of 10B target
2) 基片温度对10B靶的生长过程、结构和结合力等性能有重要影响,随基片温度的升高,生长的10B靶逐步结晶,越来越致密,膜基结合力也越好,温度升高到一定值后,靶基结合力的增长率呈递减趋势。制备10B靶的最佳基片温度约300 ℃。
3) 通过对工艺中的参数变量研究,显示最佳的蒸发速率为0~0.02 μg/(cm2·s),灯丝平面与10B柱的最佳距离为10.5~11 mm。对于尺寸为φ80 mm同位素10B靶的制备,不均匀性可控制在10%以内。

