瓦里安300XP离子注入机改造及功能开发
张明亮,韩国威,刘 庆,李 艳,杨富华,3,4,王晓东,3,4
(1.中国科学院 半导体研究所 半导体集成技术工程研究中心,北京 100083;2.中国科学院 大学微电子学院及材料与光电研究中心,北京 100049;3.北京量子信息科学研究院,北京 100193;4.北京市半导体微纳集成工程技术研究中心,北京 100083)
半导体器件被广泛应用于运算、存储、显示、通讯和供电等领域,是构建现代信息社会的重要基石.本质上,半导体器件丰富的功能均是通过可控可调的半导体电阻实现.掺杂是调控半导体材料电阻的主要工艺,把杂质原子可控地引入半导体材料晶体结构中,改变材料的能带结构,如多数载流子类型、浓度、迁移率等,实现半导体器件的预期功能.离子注入和扩散是最常用的两种掺杂工艺.由于离子注入能够准确地重复控制每一次掺入杂质的浓度、深度以及杂质分布,成为一种标准半导体掺杂工艺,已经在微电子、光电子、传感器、新材料等领域广泛使用[1].离子注入设备体积庞大,系统复杂,价格昂贵,是半导体制造中的核心装备之一.
中国科学院半导体研究所拥有瓦里安公司制造的Varian 300XP型中束流离子注入机,配有三氟化硼(BF3)和膦烷(PH3)气体源,可在20~130 keV束流加速度下工作,通过对各种半导体材料进行掺杂,用于制作光电探测器、光伏器件、微电子机械系统(MEMS)压力传感器及执行器、场效应管、二极管和热电器件等.该设备对所内外开放共享使用,为众多科研项目的顺利完成及预研产品的开发起到了关键支撑作用.
1 工作原理
Varian 300XP离子注入设备的支持系统包括水、电、气、真空及排风系统.水包括普通工艺冷却水及高纯水两个独立循环系统.主供电为美国标准208 V 60 Hz,经内部电源变换,有直流高压、交流高压和隔离供电等形式.使用气体包含压缩空气、高纯氮气和离子源气体.真空由三台机械干泵、两台氦冷泵和一台分子泵建立.排风主要集中在离子源、样品操作台及机械泵排气部分.
在高真空建立好之后,启动高纯水循环系统,开启隔离变压器,给离子源内部供电.我所Varian 300XP离子注入机采用Freeman离子源,在棒形钨灯丝上通过约180 A电流,在弧室壁与灯丝间加50 V电压,质量流量计(MFC)控制的源气体分子与高能电子碰撞,在弧室内产生等离子体.使用30 kV左右吸出高压将正离子吸出弧室,引入分析器,具有不同荷质比的离子在分析磁场中以不同的轨迹飞行,互相分离.调节分析器的磁场强度,能选择需要的杂质离子束通过分析器出口狭缝,在加速管中使用静电场加速到设定能量.通过四级杆聚焦镜调整束流形状后,用平面扫描器将杂质离子均匀分散成正方形,通过主法拉第杯及设定法拉第杯,观察示波器上的波形,对离子束的扫描范围及分布情况进行调节,利用处于光阑上的4个角法拉第杯监测束流大小.设定好注入剂量后,启动注入,束线挡板自动放下,杂质元素均匀注入到工艺室内的衬底上,同时,注入光阑4个角上的角法拉第杯开始记录注入离子剂量,当累计注入剂量达到设定值,剂量控制系统自动将束线挡板竖起,阻断离子束,完成设定注入工艺.
通常Varian 300XP离子注入机配有三氟化硼、膦烷、砷烷和氩气气体源,可以提供硼、氟、磷、二氟化硼和砷的注入,离子束能量在20~200 keV范围内可调.对于中等剂量注入(<1×1016cm-2),为保证注入的均匀性,一般通过调节注入的束流,使每一片完成时间大于60 s.对于使用光刻胶做掩蔽层定义注入区域的衬底,一般使用小于100 μA的束流,保证整个注入过程中光刻胶不变形或开裂.例如,以100 μA的束流,对10 cm衬底片注入1×1015cm-2的硼离子,约需9 min即可完成,对光片进行注入,可使用更大的束流.Varian公司的离子注入机部门被Applied Materials公司收购后,Varian 300XP的升级版为VIISta 900 3D型离子注入机.
我所的Varian 300XP离子注入机在一家半导体工厂已被使用多年,且部分改装过,仅有一个进样终端正常工作.经过安装调试后,基本可以使用,但是硼离子束流最大仅30 μA,单个进样终端,卡盘为10 cm.离子源内部的电气控制经常失灵,注入过程中,扫描系统也频繁出错,导致10 cm圆片片内方块电阻不均匀性超过10%,因此有必要对其进行功能改造升级.
2 改造及功能开发结果
2.1 离子源供电电源
引出束流小,注入效率低是这台设备存在的主要问题,我们先后从引出距离、引出电压、狭缝开口尺寸、源磁场、灯丝形状和灯丝纯度等各方面进行优化,未能有效增加引出束流大小.与此同时,供电电源中频繁出现元器件烧坏问题,灯丝电源与起弧电源经常不匹配,无法稳定起弧.离子源供电电源互联关系的原理框图如图1(a)所示.由图1(a)可见,灯丝电流源提供稳定可调的电流,使钨灯丝产生热电子发射.同时,起弧电源在灯丝与弧室之间加稳定可调的电压,获得稳定的源气体等离子体.原离子源供电系统中灯丝电源最大输出500 W,起弧电源最大输出450 W,如图1(b)所示.这两套电源由于年代久远,电子元件老化严重,影响了离子束流及相关性能,因此定制了300 A的电流源,电压5 V,电流、电压双控制,最大输出1 500 W.同时还定制了1 500 W起弧电源,电压150 V,电流10 A,采用电压、电流双控制模式,并集成到当前的系统中,实物如图1(c)所示.用φ 2×80高纯钨棒做灯丝,离子源真空在20 μTorr左右,灯丝电源在150 A左右,起弧电源75 V,得到稳定的弧流约2 A,阳极引出硼离子束流约10 mA.而改造前,最大的阳极引出硼离子束流约2 mA,且不稳定,经常灭弧.两台电源的电流、电压均能控制并调节,功能符合预期,运转正常.
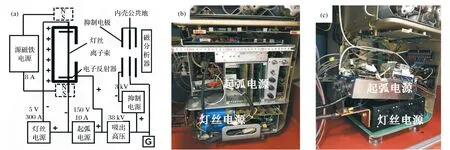
图1 离子源供电电源
2.2 光电隔离控制系统
离子源内部与外部操作台之间有吸出和加速高压,操作台上的控制必须通过隔离高压系统来实现.在原控制系统中,电位器产生的模拟量,通过电压频率转换,成为控制发光二极管的方波信号,如图2(a)所示.通过塑料光纤,光信号送入离子源内,在通过频率电压逆转换,将控制端的模拟电压还原回来,如图2(b)所示.由于芯片功能衰退或互联问题,光电隔离控制经常不稳定,尤其是对分析磁场的控制和对源气体流量的MFC的控制.用工业级的多通道光端机更换旧的光纤通讯系统,三组光端机的发射部分如图2(c)所示,两组光端机的接受部分如图2(d)所示,用于控制灯丝电源、起弧电源、4路气体流量MFC.另一个光端机接收器如图2(e)所示,用于控制分析器、源磁场及析出高压.改造后,原控制面板上的电位器全部停用,新的电位器统一接在一个5 V直流电源上,可调节输出0~5 V模拟信号.在未加高压情况下,外部电位器设定的电压值与内部光端机接收器输出的电压值保持一致,最大偏差小于0.1 V,完全满足使用需求.在120 kV(析出高压30 kV,直线加速高压90 kV)高压下,测试每一路光电隔离控制线路,均可以稳定调节,不受高压影响,也不影响高压的调节与设定,实现了预期的功能.

图2 光电隔离控制系统改造
2.3 进样终端升级
原设备中一个进样终端不可用,将这一路的法拉第检测系统含光阑及后端的进样卡盘全部去除,用从其他旧设备上拆下的15 cm部件替换安装.系统通电后,手动逐步检查操作,发现进出样片功能正常.一个10 cm进样终端升级为15 cm,将10 cm单晶硅圆片贴在15 cm单晶硅圆片上,并固定在进样室内,如图3所示.
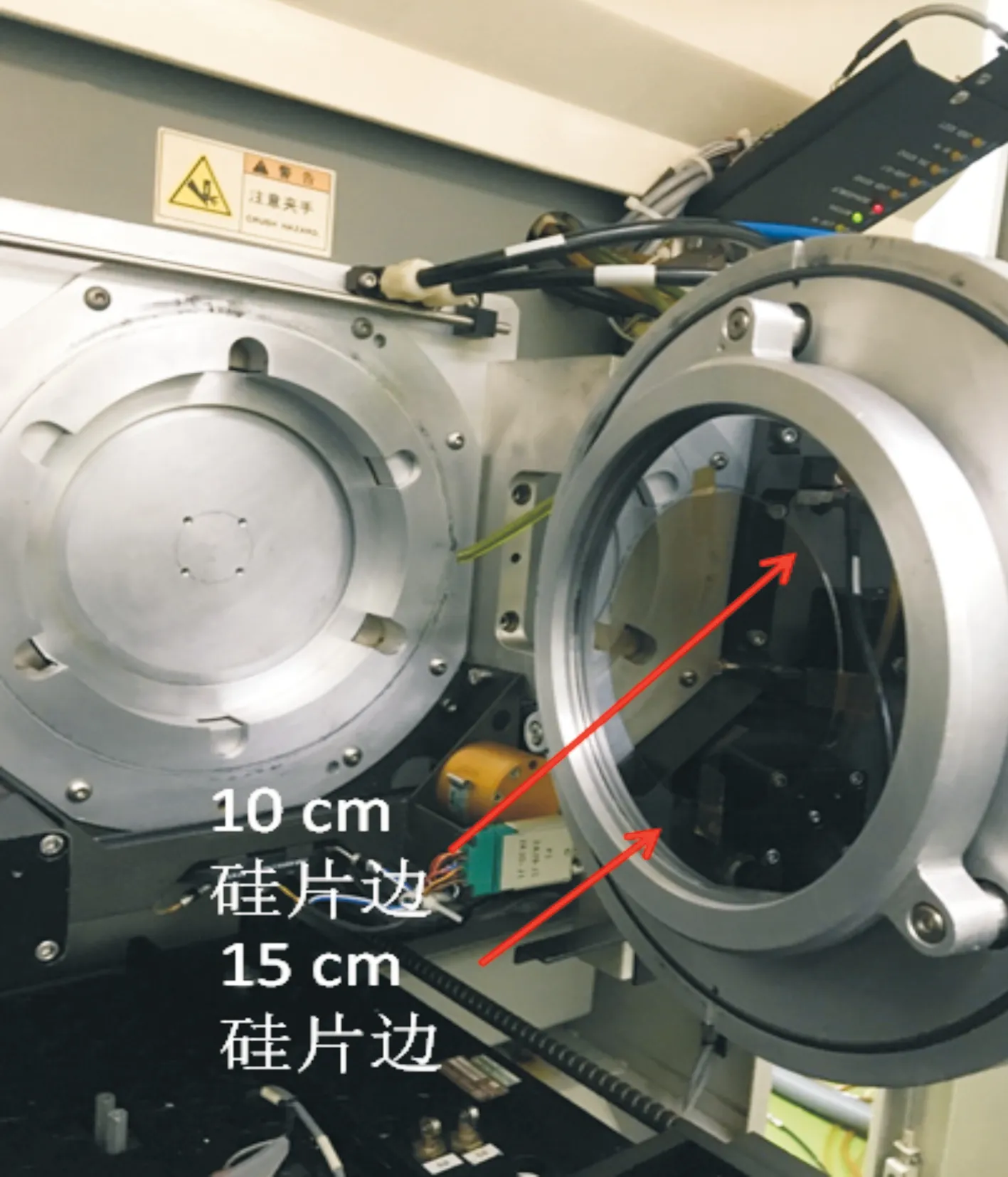
图3 进样卡盘升级
2.4 剂量监控系统改造
深入分析扫描控制板上各模块的功能,在原电路板上加装电位器、正负极性转换开关及电容滤波器,如图4(a)所示.测试发现,束流能够向两个进样终端偏转,15 cm的光阑、4个角法拉第杯能够正常接收到束流,说明扫描开的离子束满足15 cm晶圆片注入的面积.新开发的剂量监控系统如图4(b)所示,包括电流转电压模块、电压转频率模块、以单片机为核心的计数比较模块及电磁气动阀束流开关.利用CA741放大器将电流信号转换成电压信号,再用AD654将电压转换成方波频率,送入单片机进行累积计数.在单片机另一输入端设定需要注入剂量的数值,单片机不断比较累计计数与设定剂量数值,当两者完全相等时,输出一个5 V的高电位,控制继电器接通24 V电磁阀控制信号,压缩空气推动气缸,切换束线挡板,从开通到关闭位置状态.按下复位键,当累计计数与设定剂量数值不等时,单片机输出0 V低电位,束线挡板保持在开通位置状态.用数字源表的恒电流源模式产生的电流模拟离子束束流检测到剂量监控系统功能与预期一致,运转完全正常.通过调节放大器的放大系数和AD654的时间常数,离子束束流25 μA产生40 kHz方波,在10~400 kHz范围,电流与频率线性相关系数大于0.99,满足对设备实际产生离子束束流的数字化计量.经计算,2×107个方波计数相当于1×1015cm-2的剂量,在实际硅片上注入后,通过电阻反推注入离子数量,与设定剂量值基本一致,同时,还与工艺仿真结果吻合较好.

图4 (a)扫描控制模块,(b)剂量监控及束流开关控制模块
2.5 加速高压系统改造
原设备的直线加速高压部分采用二极管和大电容的倍压器架构,由于二极管和电容器的性能退化,经常发生击穿、打火等现象,导致系统无法正常使用.将旧的电源及倍压器拆除,换上定制的单极性输出高压电源,输出高压直接加载到加速管上,工作完全正常,加载的高压在0~100 kV可调节,原系统中的高压测量模块正常工作,能够准确读出实际加载的高压,该数值等于新高压电源加载的高压值与吸出高压之和,完全符合预期.
2.6 硼离子束流及注入均匀性
改造后的离子注入整体设备运行正常,在150 A灯丝电流、75 V起弧电压、三氟化硼气体保持离子源真空为20 μTorr、28 keV析出电压和束流能量加速到60 keV等条件下,主法拉第杯上测量到的束流达到160 μA,如图5所示.

图5 主法拉第杯实时监测束流照片
通常采用离子注入后形成电阻的不均匀性反映离子注入的均匀性.在设备全部正常运转情况下,使用硼离子注入n型单晶硅片,退火激活后,测量注入面方块电阻,统计计算结果如表1所列.在两个剂量水平上,各用5片15 cm圆片测量片内和片间均匀性,测试结果表明,片内及片间的电阻不均匀性都优于3.5%.使用离子注入工艺仿真软件ICECREAM和SRAM进行仿真,仿真结果与此台设备实际工艺结果较一致.

表1 硼离子注入形成电阻的不均匀性
3 应用实例
研究发现,浓硼掺杂的单晶硅层,在碱性湿法腐蚀中,腐蚀速度大大减小[2].随着腐蚀温度降低,在较低的硼掺杂浓度下,就会出现腐蚀自停止效应.EPW“S”是一种有机碱性溶液,包含乙二胺、邻苯二酚、水和吡嗪,能够在50 ℃以上使用,对氧气不敏感,不形成残留物,各向异性腐蚀,(100)面与(111)面腐蚀速率比约100∶1,能有效避免碱金属离子对半导体器件性能的影响.氢氧化钾溶液是最常用的一种单晶硅湿法腐蚀溶液,(100)面与(111)面腐蚀速率比约400∶1,可以选择性各向异性腐蚀.在有机碱性溶液中,相对较低的硼掺杂浓度即可实现腐蚀自停止层制作,在较低的腐蚀温度下,较低的硼掺杂浓度就可以制备出腐蚀自停止层单晶硅[3].
在完成设备升级改造后,一般1~2 h就能顺利完成浓硼离子注入工艺.利用大束流硼离子注入制备浓硼掺杂单晶硅结构层,1×1016cm-2以上的离子剂量已经能够应用到MEMS压力传感器、热电器件以及纳米谐振子器件中.
3.1 MEMS 压力传感器
P型重掺杂的硅压阻温度系数小,Goodrich公司报道了一款基于重掺杂硼的硅压阻MEMS压力传感器,经过温度补偿,测量精度达到0.05%,是目前报道的性能最好的压阻式MEMS压力传感器[4].由于在医疗、气象、航空航天等领域的广泛应用需求,微型化MEMS压力传感器的研究受到越来越多的关注[5].在n型单晶硅表面注入硼,形成浓硼掺杂层,利用该浓硼层制作硅纳米线压阻,互联成惠斯通电桥,构建出MEMS压力传感器芯片.经过浓硼掺杂过的单晶硅在四甲基氢氧化铵(TMAH)溶液中腐蚀后剩余的硅薄膜如图6(a)所示.该膜厚可以通过离子注入及后续退火工艺调节.表面整层的浓硼掺杂硅通过沟槽刻蚀隔离技术,在应力集中的感压膜上形成压阻条.图6(b)是悬空硅压阻局部放大的扫描电镜(SEM)照片,宽度120 nm,厚度1.1 μm.图6(c)是感压膜边沿切向压阻条的SEM照片.图6(d)为MEMS压力传感器芯片横截面的SEM照片,感压膜厚度40 μm.实验室测试发现,满量程1 MPa输出约50 mV,满量程精度优于1%.温度特性测试在恒温箱中进行,分别测量-25、25、120 ℃ 3个点的数据,灵敏度温度系数最大仅3%,电阻温度系数最大为2.5%.
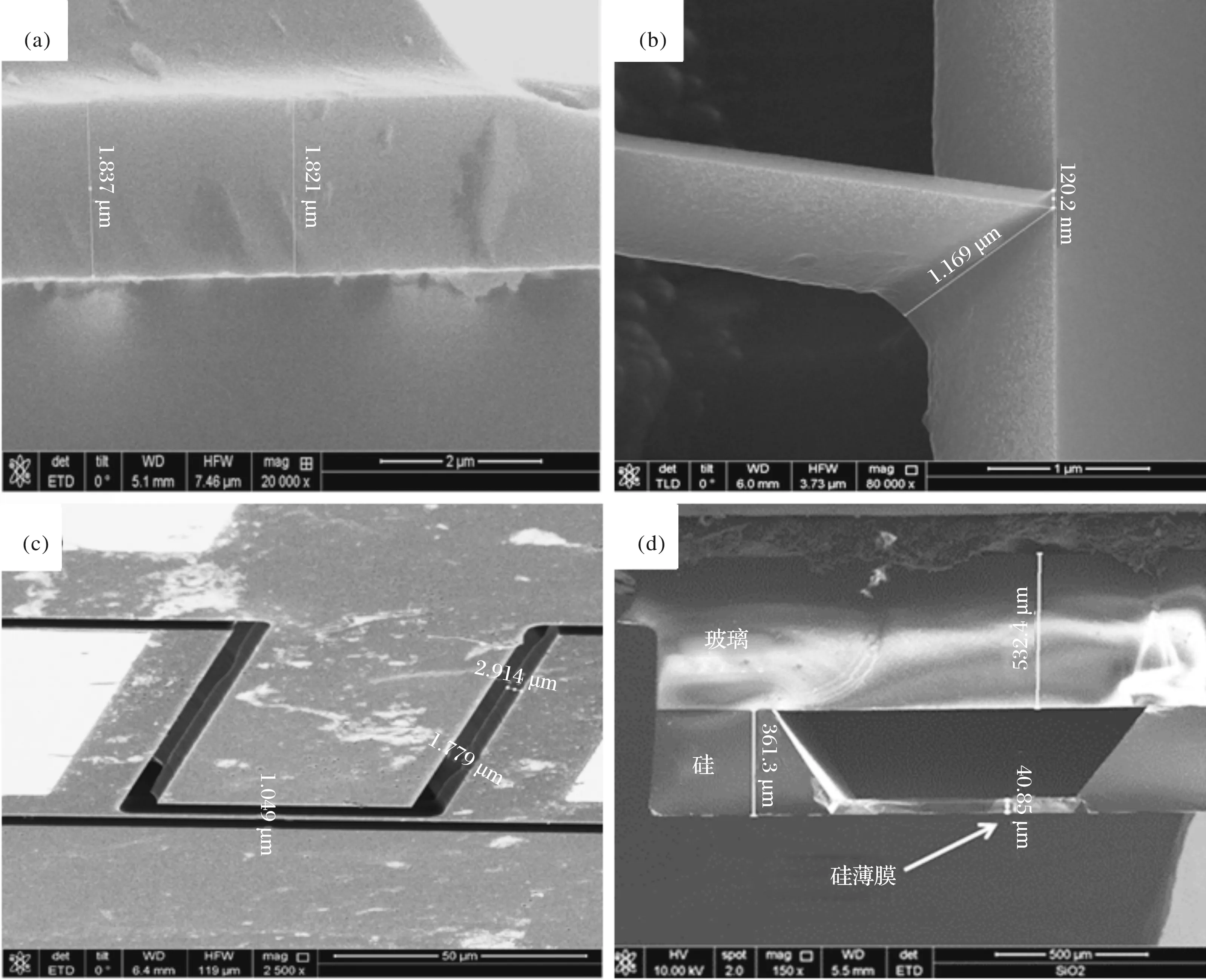
图6 基于浓硼掺杂硅压阻MEMS压力传感器
3.2 热电器件
热电器件基于塞贝克效应能够将热能转换成电能,基于珀尔帖效应能使用电能产生局部制冷.体硅材料的热电优值ZT仅仅0.01左右,浓硼掺杂的硅纳米线表现出优异的热电性能[6],最大热电优值ZT接近1[7].由于硅材料应用广泛,并且微纳加工工艺成熟,易于集成,已经吸引了广泛的研究兴趣[8].利用离子注入在n型单晶硅表面形成浓硼掺杂层,在TMAH溶液中自停止腐蚀,制作出硅纳米线热电器件[9].硅纳米线热电器件结钩如图7(a)所示,利用金属铂构建两个热岛,同时用作温度传感器.图7(b)是硅纳米线热电器件的中间悬空的硅纳米线的SEM照片.硅纳米线的长7.66 μm,宽408 nm,高685 nm,电导率约为1.3×10-3Ω•cm,对应的掺杂浓度为8.92×1 019 cm-3.该硅纳米线的热导率为 17.25 W/(m·K),与块体单晶硅的热导率相比[120 W/(m·K)],降低了约7倍.测量得到,该硅纳米线室温下塞贝克系数是 44.45 μV/K.
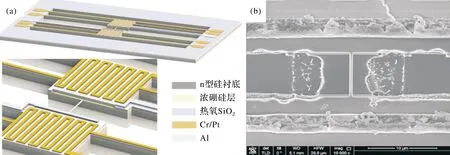
图7 硅纳米线热电器件
3.3 硅纳米带谐振子
高灵敏传感器在公共安全、环境监测、食品卫生和临床诊断等领域有着迫切应用需求,谐振频率变化的纳米线谐振子是高灵敏传感器的核心元件.微纳机电生化传感器利用机械组元与待测物相互作用,通过测量机械组元的质量、应力和表面声波等参数的变化,获得检测物的信息.基于谐振原理的生化传感器,表现出高灵敏度,能检测出单个细菌、单个病毒和单条DNA等.并且,经过表面修饰后,检测选择性得到提高,例如,利用自组装分子固定抗体,可检测肝癌标志物甲胎蛋白.修饰表面敏感层,可检测环境中爆炸物、有毒气体的分子等.用纳米材料构筑谐振型生化传感器,将进一步促进生化传感器向小型化、高灵敏、低成本和智能化方向发展.悬臂梁和双端固支梁是最常用的微纳谐振子,它们本征共振频率f0为:
(1)
式中,k、m*是梁的弹性系数和有效质量,t、L是梁的厚度及长度,E、ρ是梁材料的杨氏模量和密度,C是常数,悬臂梁的C为0.161 5,双端固支梁的C为1.027.若不考虑表面吸附对谐振子刚度系数的影响,谐振子频移(Δf)与吸附质量(Δm)成线性关系:
(2)
由式(2)可见,提高检测灵敏度(f0/2m*)的途径有:(1)提高本征共振频率(f0).(2)减小振动部分有效质量(m*).由式(1)可见,对于相同材料和尺寸,双端固支梁的共振频率是悬臂梁的6倍多.振动部分有效质量随梁尺寸的立方减小,纳米尺寸谐振子将大大提高对质量检测的灵敏度.例如,一微米尺度梁(长×宽×厚为200 × 20 × 0.2 μm3)与一纳米尺度梁(长×宽×厚为1 000 × 200 × 200 nm3),微米梁的质量是纳米梁的2×104倍,纳米梁的本征共振频率是微米梁的4×104倍.根据式(2),纳米梁对质量检测的灵敏度是微米梁的8×108倍.
利用离子注入形成浓硼掺杂层,通过电子束光刻和干湿法刻蚀,制作出硅纳米带谐振器.单栅极硅纳米带谐振子的SEM照片如图8(a)所示.由图8(b)可知,硅纳米带长5.2 μm,宽75 nm,厚800 nm.该谐振子通过栅极加交流激励信号,驱动硅纳米带振动,通过测量源漏两端的电阻变化率,得到谐振频率.另外,还可以通过源漏通电流、加热驱动硅纳米带振动、测量纳米带与栅极间的电容变化率读出谐振频率.类似的工艺,还可以制作出不同长度硅纳米带、双栅控制的谐振子,如图8(c)和(d)所示.利用这套工艺,可以制备出一系列不同尺寸的硅纳米带谐振子,可控调节的尺寸范围为:长 1~10 μm,宽50~1 000 nm,厚 200~2 000 nm,为高灵敏度传感器的构建奠定了基础.
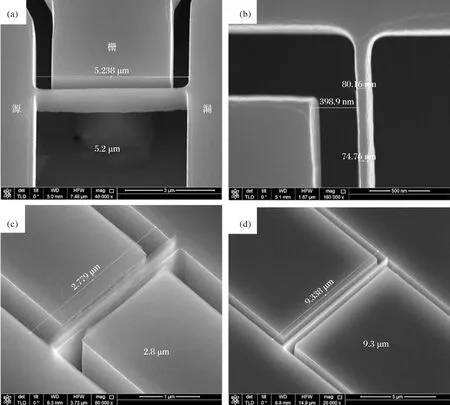
图8 硅纳米线谐振子
4 结论
针对中科院半导体所瓦里安300XP离子注入机的功能缺陷,将原离子源供电系统中灯丝电流源和起弧电压源的最大输出功率升级,并集成到当前的系统中.将原系统中塑料光纤隔离控制线路更换成工业级多通道光纤通讯光端机,对气体流量、离子源电源、分析器、源磁场、吸极高压进行稳定控制和调节.将原系统中采用倍压原理的高压加速系统升级成一体化单极性的高压输出电源.将一个10 cm进样终端改造成15 cm的样品卡盘,并开发一套独立控制剂量监测系统.改造后,硼最大束流超过150 μA,15 cm晶圆片内片间电阻不均匀性优于3.5%.利用大束流硼离子注入制备浓硼掺杂单晶硅结构层,成功应用到MEMS压力传感器、热电器件以及纳米谐振子器件中.
致谢:
感谢国家重点研发计划(项目号:2019YFB1503602,2018YFB1107502)、国家自然科学基金(项目号:51720105004)、中国科学院科研仪器设备研制项目(项目号:GJJSTD20200006)及中国科学院仪器设备功能开发技术创新项目对本研究工作的支持.

