等离子增强原子层沉积低温生长GaN薄膜∗
汤文辉 刘邦武 张柏诚 李敏 夏洋‡
1)(山东科技大学材料科学与工程学院,青岛 266000)
2)(中国科学院微电子研究所,微电子设备技术研究室,北京 100029)3)(中国科学院嘉兴微电子仪器与设备工程中心,嘉兴 314006)
等离子增强原子层沉积低温生长GaN薄膜∗
汤文辉1)2)3)刘邦武2)张柏诚3)李敏1)†夏洋2)3)‡
1)(山东科技大学材料科学与工程学院,青岛 266000)
2)(中国科学院微电子研究所,微电子设备技术研究室,北京 100029)3)(中国科学院嘉兴微电子仪器与设备工程中心,嘉兴 314006)
(2016年12月29日收到;2017年2月6日收到修改稿)
采用等离子增强原子层沉积技术在低温下于单晶硅衬底上成功生长了GaN多晶薄膜,利用椭圆偏振仪、低角度掠入射X射线衍射仪、X射线光电子能谱仪对薄膜样品的生长速率、晶体结构及薄膜成分进行了表征和分析.结果表明,等离子增强原子层沉积技术生长GaN的温度窗口为210—270◦C,薄膜在较高生长温度下呈多晶态,在较低温度下呈非晶态;薄膜中N元素与大部分Ga元素结合成N—Ga键生成GaN,有少量的Ga元素以Ga—O键存在,多晶GaN薄膜含有少量非晶态Ga2O3.
等离子增强原子层沉积,氮化镓,低温沉积
1 引 言
20世纪80年代以来,III族氮化物半导体体系材料(InN,AlN,GaN)及其合金InAlGaN在高饱和迁移率晶体管、发光二极管(LED)、紫外探测器等光电设备领域有着广泛的应用.该体系所构成的组分可调的InAlGaN材料是目前惟一能覆盖紫外至红外波段的半导体材料[1].
由于GaN有着较宽的直接带隙(3.4 eV),在LED、异质结场效应晶体管、蓝紫光激光器和紫外探测器等光电领域有着重要的应用[2],尤其是它较强的蓝光发射波段以及低能耗等特性,使实现白光LED成为可能,从而在提高发光功效的同时降低了能源消耗.另外,GaN凭借其突出的热稳定和抗辐射等优良特性,在高频高功率光电器件方面有着重要应用,与金刚石、ZnO、SiC等材料同被称誉为第三代半导体材料[3].
在实际生产中,GaN薄膜目前的沉积技术主要有金属有机物化学气相沉积(MOCVD)[4,5]、分子束外延[6]和氢化物气相外延[7].其中MOCVD是最为常用的GaN薄膜生长技术,其生长温度通常在1000◦C以上,过高的温度不仅与现有的互补金属氧化物半导体技术不兼容,也与目前广泛使用的温度敏感膜器件相冲突[8].MOCVD法为裂解氮源(NH3)需要很高的温度,但同时会导致GaN薄膜中N的平衡蒸汽压升高,这样便增加了薄膜中的氮空位浓度,高的氮空位浓度是导致薄膜较高的背景载流子浓度(1017cm−3)的原因.因此,降低GaN的生长温度有助于降低其背景载流子浓度.然而,如果单纯地降低MOCVD法生长GaN的温度会面临一些困难:一是低温下生长表面的反应物活性较低,不利于反应活性基团迁移扩散,二是低温会降低NH3的裂解程度,二者综合起来会降低薄膜的质量.因此,寻求有效的低温生长薄膜技术非常关键.
等离子增强原子层沉积(plasma-enhanced atomic layer deposition,PE-ALD)法是一个非常有潜力替代MOCVD实现低温生长GaN薄膜的技术.PE-ALD技术通过其独有的自限制反应机制实现了对薄膜高均匀性、高保形性以及原子尺度厚度等方面控制[9,10].相比于等离子体增强化学气相沉积,PE-ALD的独特性在于反应物是分别单独地通入腔室,反应物吸附于表面并发生反应,薄膜厚度可控制在埃米级.20世纪90年代,人们开始以ALD法生长GaN,Kim等[11]利用GaCl3和NH3分别作为Ga源和N源以热型ALD技术生长GaN,将生长温度降低至500◦C.Sumakeris等[12]采用加热钨丝辅助氮源(NH3)分解,在350◦C下实现了GaN薄膜的生长.近些年来,Ozgit研究小组[13−16]在以PE-ALD法制备GaN薄膜方面进行了大量的研究,以中空阴极等离子体活化氮源,在200◦C的低温下生长出了低杂质浓度、高质量的GaN薄膜.本文利用PE-ALD技术生长GaN薄膜,并利用射频等离子体发生器大幅增强N源活性,采用N2/H2混合气为氮源,从而进一步降低了GaN薄膜的生长温度(150—300◦C),分析了GaN薄膜的组织结构以及成分,并探讨了薄膜的生长机理.
2 实 验
2.1 GaN薄膜的生长
采用PE-ALD设备(PEALD-200A,嘉兴科民电子设备技术有限公司,中国)进行GaN薄膜的生长.沉积之前,将衬底Si(100)依次通过异丙醇、丙酮、乙醇以及去离子水进行超声清洗.为了去除Si衬底表面的氧化物,Si衬底需经约2 min的稀释氢氟酸溶液(HF,2 vol%)浸泡,浸泡后用去离子水冲洗并用N2吹干干燥.清洗后的Si衬底立即放入腔室加热盘上,先在120◦C下预热30 min以上,随后分段加热至生长所需温度,待衬底达到生长温度后保持30 min以上使其室内的温度分布稳定后进行沉积.采用三甲基镓(trimethylgallium,TMG)作为镓源,由于TMG在常温下具有较高的蒸汽压,室温下为227 Torr[12](1 Torr=1.33× 102Pa),故采用自制的冷却装置将镓源温度维持在−1◦C.以N2/H2混合等离子体作为氮源,N2,H2流量分别为20 sccm(1 sccm=1 mL/min).采用50 sccm的载流气Ar将TMG和N2/H2混合气代入反应腔室,反应腔室压力为0.15 Torr,射频等离子体发生器功率为250 W.采用的生长配方如下:0.01 s-TMG脉冲/3 s-reaction/50 s-吹扫/30 s-N2/H2混合等离子气/50 s-吹扫,其中3 s-reaction是为了增加镓源在腔室的滞留时间使其充分反应吸附于衬底表面.
采用PE-ALD法生长GaN薄膜基本原理如图1所示,以脉冲模式交替地向腔室内通入TMG与N2/H2混合等离子体,在脉冲间隙利用载流气Ar将多余的前驱体源与产物吹扫出腔室.在一个ALD过程中,TMG首先与衬底表面活性位点反应并吸附于生长表面,表面达到饱和后反应自动停止,留下产物以及新的表面活性位点也就是说,前躯体TMG完全占据生长表面所有活性位点后,即使增加它的脉冲输出时间,多余的TMG也不再与表面反应,之后反应产物和多余的TMG一同被吹扫出反应腔室.同理,N2/H2混合等离子体脉冲后,生长表面又会形成新的活性位点.以这样的周期性生长方式,使薄膜一层一层地逐层增厚.
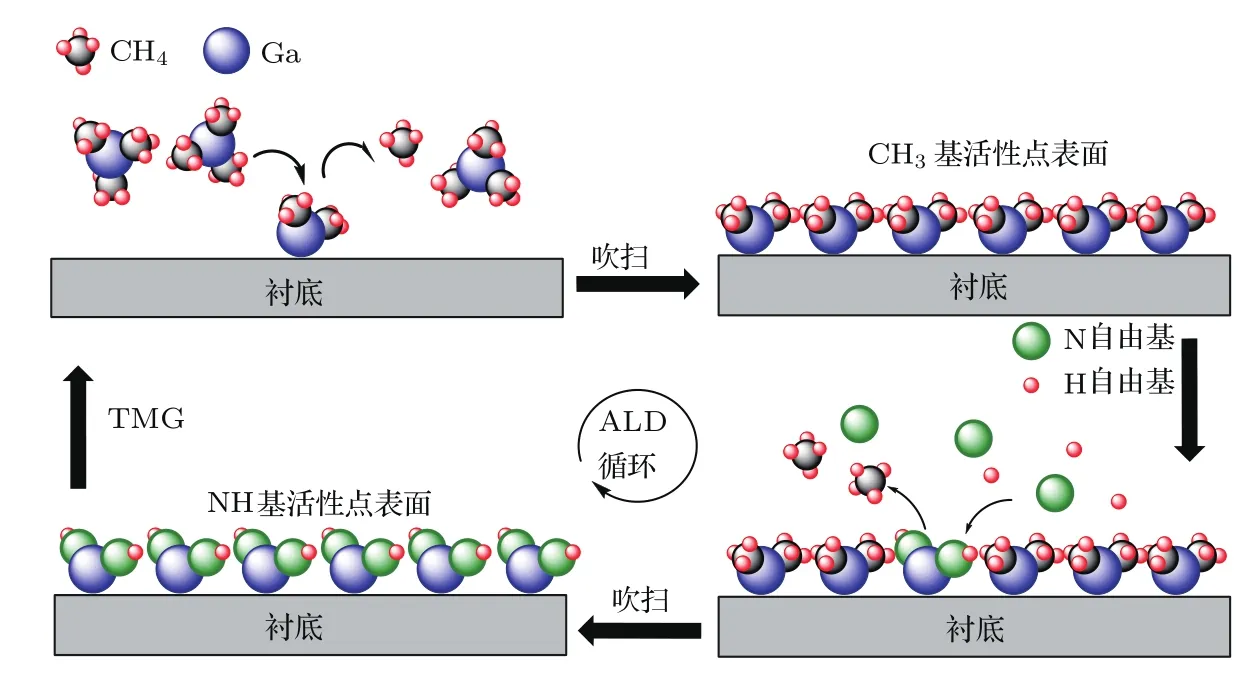
图1 (网刊彩色)PE-ALD GaN原理图Fig.1.(color online)The schematic diagram of the PE-ALD GaN.
2.2样品测试
采用型号为Woollam-RC2的椭圆偏振仪在200—1000 nm波长范围对薄膜样品进行测试,通过对数据模拟计算得出薄膜样品的光学常数以及厚度.采用Thermo Scienti fi c公司的ESCALab250型X射线光电子能谱仪(XPS)对薄膜样品进行元素成分以及相应的价态表征,激发源为单色化Al Kα X射线,通透能为30 eV.由于GaN经Ar+刻蚀溅射时会被还原,造成Ga元素价态发生改变,因此本文中所有样品的XPS测试数据都来源于未被刻蚀的薄膜表面.所有XPS数据根据结合能位于284.8 eV的烷基碳或污染碳的C 1s进行校正,采用软件XPSpeak4.1对HR-XPS数据进行处理,处理过程中并未对结合能和半高宽进行约束.采用日本Rigaku公司Smartlab薄膜版X射线衍射仪以低角度略入射方式(GIXRD)表征了表膜的晶体结构,2θ角在20◦—80◦,步进为0.02◦.
3 结果与分析
为了确保本实验中GaN是以ALD模式(自限制反应)进行生长,本实验在不同温度(150—300◦C)下进行了一系列GaN薄膜的生长实验,以确定GaN的生长温度窗口,生长周期均为300 cycle,其他条件如前所述保持不变.图2所示为GaN薄膜平均生长速率(growth rate per cycle,GPC)随生长温度变化情况,其中GPC(Å/cycle)为薄膜厚度与生长周期数的比值.可以看到GaN薄膜的生长速率在温区II(210—270◦C)范围内为0.70 Å/cycle且保持平稳,表明在此温度区间内GaN的生长是自限制的.在温区I中,薄膜生长速率随温度的上升有着明显的增加,150◦C时GPC为0.53 Å/cycle,当温度上升至210◦C时为0.70 Å/cycle.由于前驱体TMG吸附于表面活性位点以及N,H自由基与表面活性基团的反应是热激活过程[17],因此温度显然是影响薄膜生长的重要因素.在温区I温度较低(150◦C)时,加热盘提供的热能不足,无法促进前驱体TMG或N,H自由基完全吸附在反应表面上,导致低温下GaN薄膜生长速率较低.随着温度升高,加热盘可提供更多的能量,前驱体TMG和N,H自由基在生长表面的吸附效率升高,薄膜生长速率升高.当温度上升至温区II开始点210◦C,此时加热盘提供薄膜生长的能量恰好使前驱体TMG和N,H自由基在生长表面达到饱和吸附,薄膜生长速率不再增加,即使温度上升至270◦C,温区II内的生长速率仍基本保持不变.生长速率保持平稳体现出了PE-ALD独有的自限制反应本质.随着进一步升高温度,薄膜生长速率迅速升高,300◦C时高达0.91 Å/cycle,这是由于在较高温(>270◦C)时,TMG开始受热分解,生长表面结构开始不稳定,薄膜的生长方式由ALD逐层生长模式转变为CVD岛状沉积模式,导致GPC迅速升高[18].因此,以PE-ALD技术生长GaN薄膜的温度窗口为210—270◦C.
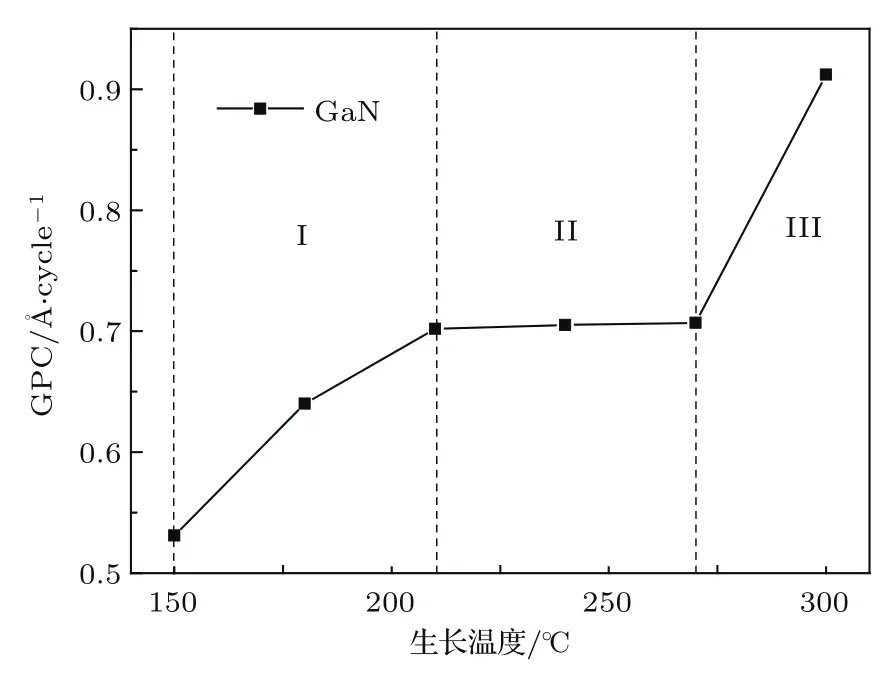
图2 生长温度对GaN薄膜生长速率(GPC)的影响Fig.2.Dependence of PE-ALD GaN growth rate(GPC)on temperature.
采用GIXRD对GaN薄膜进行结构表征,图3(a)和图3(b)分别为150◦C和250◦C下生长的GaN薄膜衍射谱图.可看出150◦C下生长的GaN薄膜无明显的衍射峰,表明其为非晶薄膜,而250◦C下生长的薄膜有明显的衍射峰,峰位在2θ=32.4◦,34.6◦,36.9◦, 分别对应着GaN(100),(002)和(101)面,表明250◦C下GaN薄膜呈多晶态,并以(002)取向为主.可看出,在低温150◦C情况下活性基团热运动时能量较低,加上生长表面吸附率低,阻碍了Ga,N原子迁移到能力最低的晶面进行有序排列生成GaN晶体;当温度升高到250◦C时,Ga,N原子热运动能量升高,能在短时间内迁移至能量最低点进行有序排列,从而构成GaN多晶薄膜.

图3 GaN薄膜的GIXRD图谱 (a)150◦C GaN;(b)250◦C GaNFig.3.The GIXRD patterns of the GaN thin fi lm:(a)150◦C GaN;(b)250◦C GaN.
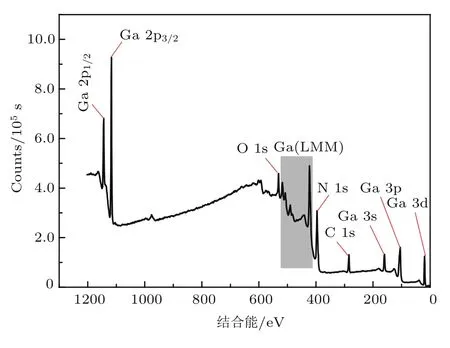
图4 250◦C下GaN薄膜的XPS宽扫图谱Fig.4.The XPS survey pattern of the GaN thin fi lm grown at 250◦C.
图4所示为250◦C下GaN薄膜的XPS宽扫图谱,可以看出,PE-ALD生长GaN薄膜的主要组成元素为Ga,N,C,O.其中结合能为18.8,284.8,398.4,531.8 eV处的峰分别对应Ga 3d,C 1s,N 1s和O 1s的特征峰;而结合能为103,158.9,1116.6,1143.4 eV处的峰分别对应Ga 3p,Ga 3s,Ga 2p3/2和Ga 2p1/2特征峰.
表1所列为150◦C和250◦C下GaN薄膜中各组成元素情况,可以看到两个薄膜均为富Ga薄膜.究其原因,生长过程中表面前驱体的甲基团断裂不完全,导致N自由基不完全地吸附于生长表面,形成富Ga少N薄膜;杂质C来源于甲基残留中的碳和环境污染,当温度从150◦C上升至250◦C时,有更多的能量促进甲基断裂和N自由基的吸附,造成杂质C含量降低和N含量升高;温度变化并未明显改变薄膜中的O含量,O元素与哪种元素键合需进一步分析.

表1 150◦C和250◦C下GaN薄膜组成元素对比Table 1.The comparison of the component between the GaN thin fi lms grown at 150◦C and 250◦C.
另外值得注意的是,N 1s特征峰可能会受到Ga元素的俄歇峰Ga(LMM)的影响,如图4中灰色区域所示,因此需对N 1s和Ga 3d特征峰进行分峰拟合处理.图5所示为250◦C下GaN薄膜的Ga 3d和N 1s的分峰拟合结果.图5(a)中,亚峰A的结合能为20.75 eV,对应为Ga—O键,O杂质的存在一方面来源于薄膜被空气氧化所致,另一方面来源于交感耦合等离子石英管本身[19].在等离子体功率不变的情况下,薄膜吸收杂质O含量也基本不变,因此生长温度的升高并未显著影响杂质O含量;另前述中说明温度的升高利于甲基的断裂,反而促进了O元素与Ga的结合,O含量微微上升.结合能位于20.17 eV的亚峰B对应为Ga—N键[20,21],薄膜中Ga—N键衍射峰强度远高于Ga—O键衍射峰,说明大部分的Ga元素与N形成了GaN,只有少量的Ga元素与O生成了Ga2O3.位于17.00 eV的亚峰C来源于N 2s的内层电子[22,23].图5(b)中,结合能位于397.68 eV的亚峰a对应为N—Ga键[24],结合能为395.92和392.96 eV的亚峰b和c都来自于Ga的俄歇峰Ga(LMM)[25],图谱中不存在N—O键衍射峰.综上所述,薄膜中所有的N元素与大部分Ga元素形成N—Ga键生成了GaN.结合GIXRD图谱可知薄膜中不含Ga2O3相,由此可判断少量的Ga2O3以非晶态形式存在于GaN多晶薄膜中.
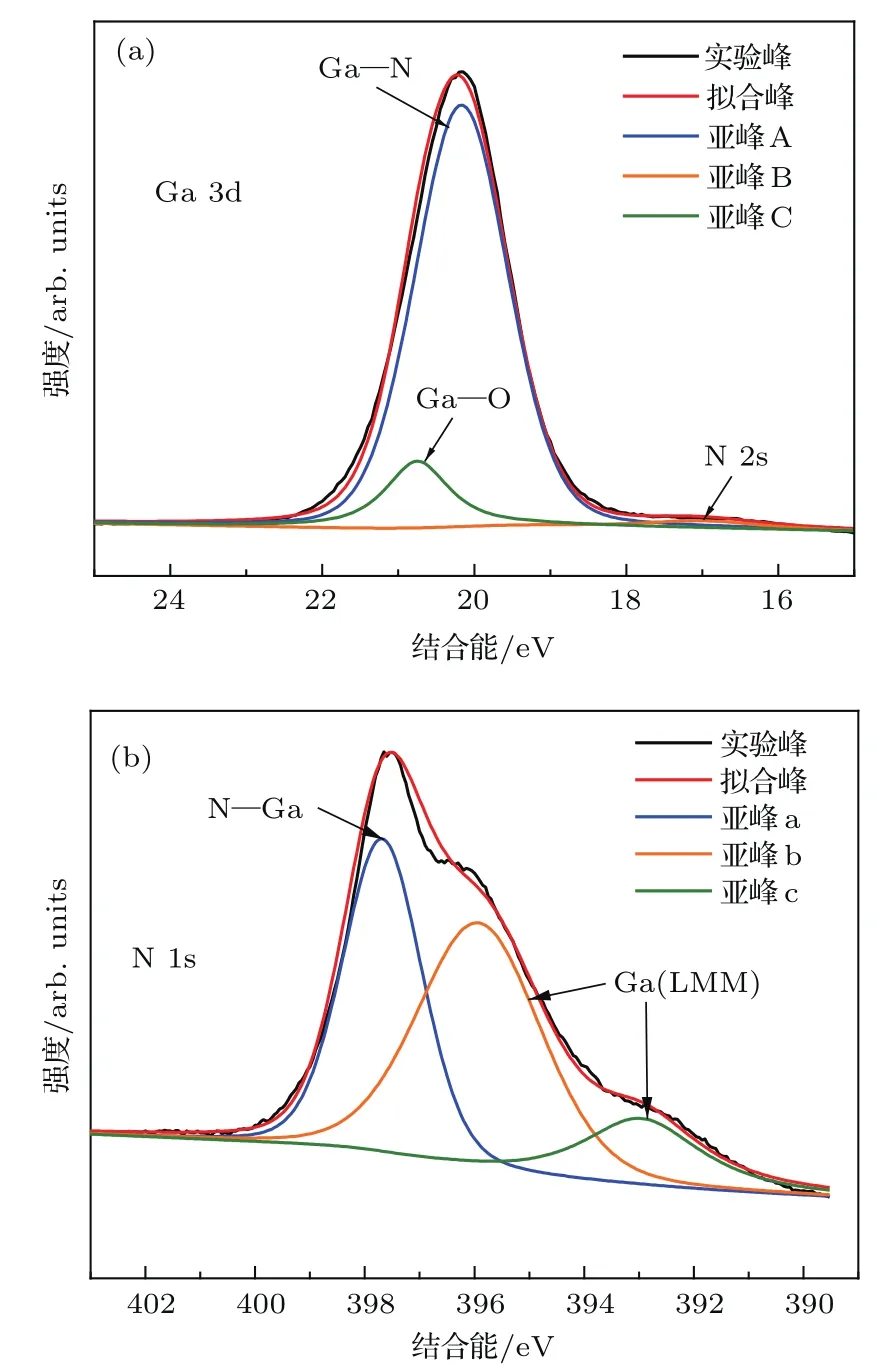
图5 (网刊彩色)250◦C下GaN薄膜中(a)Ga 3d和(b)N 1s的HR-XPS谱图Fig.5.(color online)HR-XPS patterns of the(a)Ga 3d and(b)N 1s of the GaN thin fi lm grown at 250◦C.
4 结 论
采用PE-ALD技术在低温下于单晶硅衬底上成功生长了GaN多晶薄膜,对薄膜的生长速率、晶体结构及薄膜成分进行了表征和分析.结果表明:采用PE-ALD技术生长GaN的温度窗口为210—270◦C,此窗口内GPC保持在0.70 Å/cycle不变;生长温度较低时薄膜呈非晶态,250◦C时,GaN薄膜呈多晶态,以(002)取向为主;薄膜中N元素全都以N—Ga键存在,大部分的Ga元素与N结合形成Ga—N键生成GaN,有少量的Ga元素与O杂质元素结合成Ga—O键生成Ga2O3,多晶GaN薄膜含有少量非晶态Ga2O3;薄膜中C杂质主要来源于甲基残留和环境污染,O杂质来源于空气氧化和等离子石英管.PE-ALD生长过程中,薄膜的生长取决于N2/H2混合等离子体的活化程度以及薄膜表面上活性位点与前驱体的化学反应.本实验射频等离子体发生器的功率为定值250 W,N2/H2混合等离子体的活化程度不变,因此后期工作可以通过增加表面反应的时间,即增加配方中reaction步骤和N2/H2混合等离子体脉冲的时间使薄膜C杂质含量降低.同时,要降低薄膜O杂质浓度,后期将采用中空阴极等离子体来活化N2/H2混合气,改进所得氮源的纯度,以期得到低O浓度的薄膜.
感谢中国科学院微电子工程中心贾毅博士后和万军博士后的大力帮助.
[1]Vurgaftman,Meyer J R,Ram-Mohan L R 2001J.Appl.Phys.89 5815
[2]Strite S,Morkoç H 1992J.Vac.Sci.Technol.B10 1237
[3]Pearton S J,Zolper J C,Shul R J,Ren F 1999J.Appl.Phys.86 1
[4]Nakamura S 1991Jpn.J.Appl.Phys.Part 230 1705
[5]Nakamura S,Senoh M,Mukai T 1993Appl.Phys.Lett.62 2390
[6]Calarco R,Marso M,Richter T,Aykanat A I,Meijers R,Hart A,Stoica T,Lüth H 2005Nano Lett.5 981
[7]Kim H M,Cho Y H,Lee H,Kim S II,Ryu S R,Kim D Y,Kang T W,Chung K S 2004Nano Lett.4 1059
[8]Hirvikorpia T,Nissia M V,Nikkolab J,Harlina A,Karppinen M 2011Surf.Coat.Technol.205 5088
[9]George S M 2010Chem.Rev.110 111
[10]Puurunen R L 2005J.Appl.Phys.97 121301
[11]Kim O,Kim D,Anderson T 2009J.Vac.Sci.Technol.A27 923
[12]Sumakeris J,Sitar Z,Ailey K S,More K L,Davis R F 1993Thin Solid Films225 244
[13]Ozgit A C,Goldenberg E,Okyay A K,Biyikli N 2014J.Mater.Chem.C2 2123
[14]Bolat S,Ozgit A C,Tekcan B,Biyikli N,Okyay A K 2014Appl.Phys.Lett.104 243505
[15]Ozgit A C,Donmez I,Biyikli N 2013ECS Trans.58 289
[16]Goldenberg E,Ozgit A C,Biyikli N,Okyay A K 2014J.Vac.Sci.Technol.A32 031508
[17]Motamedi P,Cadien K 2015RSC Adv.5 57865
[18]Feng J H,Tang L D,Liu B W,Xia Y,Wang B 2013Acta Phys.Sin.62 117302(in Chinese)[冯嘉恒,唐利丹,刘邦武,夏洋,王冰2013物理学报62 117302]
[19]Butcher K S A,A fi fuddin,Chen P P T,Tansley T L 2001Phys.Status Solidi C0 156
[20]Wolter S D,Luther B P,Waltemyer D L,Onneby C,Mohney S E 1997Appl.Phys.Lett.70 2156
[21]Kumar P,Kumar M,Govind,Mehta B R,Shivaprasad S M 2009Appl.Surf.Sci.256 517
[22]Matolín V,Fabík S,Glosík J,Bideux L,Ould M Y,Gruzza B 2004Vacuum76 471
[23]Lambrecht W R L,Segall B,Strite S,Martin G,Agarwal A,Morkoç H,Rockett A 1994Phys.Rev.B50 14155
[24]Majlinger Z,Bozanic A,Petravic M,Kim K J,Kim B,Yang Y W 2009Vacuum84 41
[25]Moldovan G,Harrison I,Roe M,Brown P D 2004Inst.Phys.Conf.Ser.179 115
PACS:81.15.Kk,81.20.–n,73.40.Kp,77.84.BwDOI:10.7498/aps.66.098101
Low temperature depositions of GaN thin fi lms by plasma-enhanced atomic layer deposition∗
Tang Wen-Hui1)2)3)Liu Bang-Wu2)Zhang Bo-Cheng3)Li Min1)†Xia Yang2)3)‡
1)(School of Materials Science and Engineering,Shandong University of Science and Technology,Qingdao 266000,China)2)(Institute of Microelectronics of Chinese Academy of Sciences,Beijing 100029,China)3)(Jiaxing Microelectronic Equipment Research Center,Chinese Academy of Sciences,Jiaxing 314006,China)
29 December 2016;revised manuscript
6 February 2017)
Metalorganic chemical vapour deposition and molecular beam epitaxy have already been demonstrated to be successful techniques for obtaining high-quality epitaxial GaN layers with low impurity concentrations and pretty good electrical properties.However,high growth temperature employed in both of these methods give rise to some intrinsic defects of the thin fi lms,such as high background-carrier concentrations.As a low-temperature thin fi lm deposition method,plasma-enhanced atomic layer deposition(PE-ALD)has more unique advantages compared to both methods for epitaxial growth of GaN.In this paper,the polycrystalline GaN thin fi lms were fabricated on Si(100)substrates at 150–300◦C by PE-ALD.Trimethylgallium and N2/H2plasma gas mixture were used as the Ga and N precursors.The growth rate of the thin fi lms was demonstrated by the spectroscopic ellipsometer.The crystal structrue and composition of the GaN thin fi lms were characterized by X-ray di ff ractometer and X-ray photoelectron spectrometer(XPS).It is showed that the growth window for PE-ALD grown GaN thin fi lms is 210–270◦C,where the growth rate remains constant at 0.70 Å/cycle.And it is known that it is the self-limiting nature of PE-ALD that is ascribed to the plateau of the growth rate.Films grown at relatively higher temperature are polycrystalline with a hexagonal wurtzite structure,while fi lms grown under relatively lower temperature are amorphous.The grazing incidence X-ray di ff raction(GIXRD)patterns of the polycrystalline thin fi lms reveal three main peaks located at 2θ =32.4◦,34.6◦and 36.9◦,which are corresponding to the(100),(002)and(101)re fl ections.It is showed that the Ga,N atoms would get higher energy for more e ff ective migration to positions with lowest energy to form ordered crystalline arrange at higher growth temperature.The XPS results show that all the N elements of the as-grown thin fi lms are in the form of N—Ga bond,indicating that all the N elements are formed into GaN thin fi lms;and there is a little amount of the Ga elements that exist in Ga—O bond.The fact that there is no Ga2O3-related peaks in the GIXRD pattern suggests that there is small amount of amorphous Ga2O3dispersed in the polycrystalline GaN thin fi lms.In the future work,reducing the concentration of the C and O impurities may be achieved by increasing the time of the reaction and plasma pules in the process formula and replacing the inductively coupled plasma with the hollow cathode plasma,respectively.
plasma-enhanced atomic layer deposition,GaN,low-temperature deposition
10.7498/aps.66.098101
∗浙江省科研院所扶持专项(批准号:2016F50009)资助的课题.
†通信作者.E-mail:kd_limin@126.com
‡通信作者.E-mail:xiayang@ime.ac.cn
*Project supported by the Support Special Project Foundation for Scienti fi c Research Institutes of Zhejiang Province,China(Grant No.2016F50009).
†Corresponding author.E-mail:kd_limin@126.com
‡Corresponding author.E-mail:xiayang@ime.ac.cn

