纳米银焊膏封装大功率COB LED模块的性能研究
杨呈祥, 李 欣*, 孔亚飞, 梅云辉, 陆国权,2
(1. 天津大学 材料科学与工程学院, 天津 300072;2. 弗吉尼亚理工大学 材料科学与工程学院, 弗吉尼亚 蒙哥马利 24060)
纳米银焊膏封装大功率COB LED模块的性能研究
杨呈祥1, 李 欣1*, 孔亚飞1, 梅云辉1, 陆国权1,2
(1. 天津大学 材料科学与工程学院, 天津 300072;2. 弗吉尼亚理工大学 材料科学与工程学院, 弗吉尼亚 蒙哥马利 24060)
为提高大功率LED的散热能力,采用具有更高熔点和更优良的导电导热性能的纳米银焊膏作为芯片粘结材料,以Al2O3基陶瓷基板封装COB LED模块。同时以Sn/Ag3.0/Cu0.5和导电银胶两种粘结材料作为对比,分别在27,50,80,100,120 ℃等环境温度中测试3种模块的光电性能来评估模块的热管理水平;在100 ℃环境下进行加速老化实验,评估3种LED模块的可靠性。测试结果表明,纳米银焊膏封装的大功率LED模块光电性能优异,且具有较强的长期可靠性。
大功率LED; COB封装; 纳米银焊膏; 光电性能; 可靠性
1 引 言
随着LED应用市场的逐渐成熟,人们对大功率LED的需求越来越多。光通量是体现LED竞争能力的关键参数[1]。人们采用多芯片集成阵列模块的方法[2]使LED的光输出能力逐年增强,同时LED的功率和正向电流也逐渐增大。这直接导致LED结温的升高,而结温升高会使LED的量子效率降低,寿命缩短,输出波长红移甚至器件失效[3-7]。因此,LED模块的散热能力对于LED可靠性的影响非常大。近年来,人们对环境保护和可持续发展的意识越来越强,因此如何在提高LED输出功率的同时尽可能减小封装体积以减少封装成本和能量浪费,成为一个重要课题。
作为一级封装,芯片粘结层是热量由芯片传输到基板的必经路径,因此粘结层材料是影响大功率LED散热能力及可靠性的主要因素[8]。常用的粘结材料有锡基焊料[9]和导电银胶[10]。但由于这两种粘结材料失效温度较低,所以工作温度受到限制,满足不了大功率LED应用于军工行业、航空航天和核环境等高温恶劣环境[10]的需要。纳米银焊膏由于能够实现低温烧结且烧结完成后为多孔单质银层,可以应用于高温环境且具有优良的热学、电学、力学性能和可靠性,因此在恶劣环境应用的高功率LED模块封装中具有一定的潜力。
COB(Chip-on-board)封装技术可通过基板直接散热,减少热阻,适合于大功率多芯片阵列的LED电子封装[11-12]。本文采用纳米银焊膏代替传统的粘结材料,用于高功率COB LED模块的芯片级粘结。为了研究恶劣环境中模块的工作性能,分别在不同温度条件下测试纳米银焊膏封装模块的光电特性,并将其与Sn/Ag3.0/Cu0.5和导电银胶封装模块进行对比,研究芯片级粘结材料对大功率LED模块性能的影响。
2 实 验
2.1 实验材料
本实验采用OSRAM的F4152A型GaN基大功率蓝光1 W芯片作为实验对象。如图1(a)所示,芯片为垂直式LED,N极向上,上下两电极均采用镀金处理。芯片尺寸为1 mm×1 mm×0.19 mm(图1(b))。采用Al2O3基DPC陶瓷基板作为大功率LED支架,表面覆银,如图2所示。基板尺寸为12 mm×12 mm×0.5 mm,基板上9个独立焊盘可完成9芯片集成。
新型高温用纳米银焊膏由美国NBE公司(NBE Technologies LLC, Blacksburg, VA)提供,含银量为80%,银颗粒平均粒径约为30 nm,热导率为238 W/(m·K)。为了研究不同粘结材料对LED模块性能的影响,另外采用针筒式LF-200型Sn/Ag3.0/Cu0.5合金焊料和Ablebond 84-1LMISR4型导电银胶封装LED模块并进行对比。

图1 (a) OSRAM 1 W蓝光芯片示意图;(b) 芯片尺寸示意图。
Fig.1 (a) Schematic of OSRAM 1 W LED blue chip. (b) Schematic of chip size.
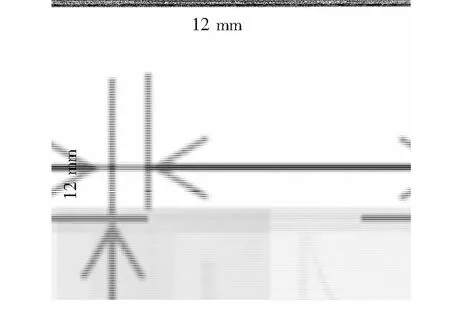
图2 Al2O3基陶瓷基板示意图
2.2 样品制备
本实验制备LED模块的过程如图3所示。基板经过清理后,采用点胶的形式将纳米银焊膏涂覆于基板上,而后完成贴片。将粘结好芯片的模块置于加热台上,在280 ℃下完成焊膏烧结,并通过金线键合实现芯片与基板间的电气连接。金线键合采用三串三并的电路形式,如图4所示。本实验中,用于对比的Sn/Ag3.0/Cu0.5合金焊料和导电银胶的工艺曲线如图5所示。

图3 9 W COB封装的LED模块制备流程

图4 LED模块三串三并电路
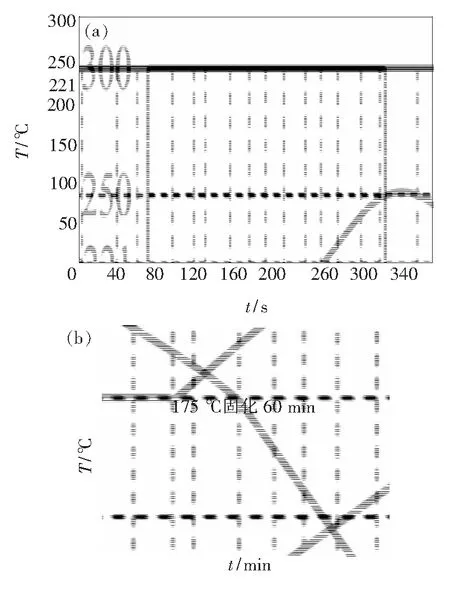
图5 粘结工艺曲线。(a) Sn/Ag3.0/Cu0.5;(b) 导电银胶。
Fig.5 Sintering process. (a) Sn/Ag3.0/Cu0.5.(b) Silver epoxy.
2.3 实验方法
针对制备完成的样品,分别进行光电性能和可靠性测试。图6所示为本实验采用的光电测试系统示意图。在实验中,将样品置于积分球中,给LED模块通直流电,电流从0~1 500 mA不断增加,每隔100 mA记录样品光电测试数值,获得LED模块光电特性随电流的变化关系,每组测试3个样品取平均值。为了研究不同环境温度对模块性能的影响,采用加热片分别为实验提供50,80,100,120 ℃的高温环境。

图6 光色电综合测试系统
Fig.6 Structure diagram of LED photoelectric parameter testing system
为了研究不同粘结材料对LED模块长期可靠性的影响,采用如图7所示的光衰测试系统进行100 ℃环境下的加速老化实验,记录3种模块长时间点亮的光性能变化。
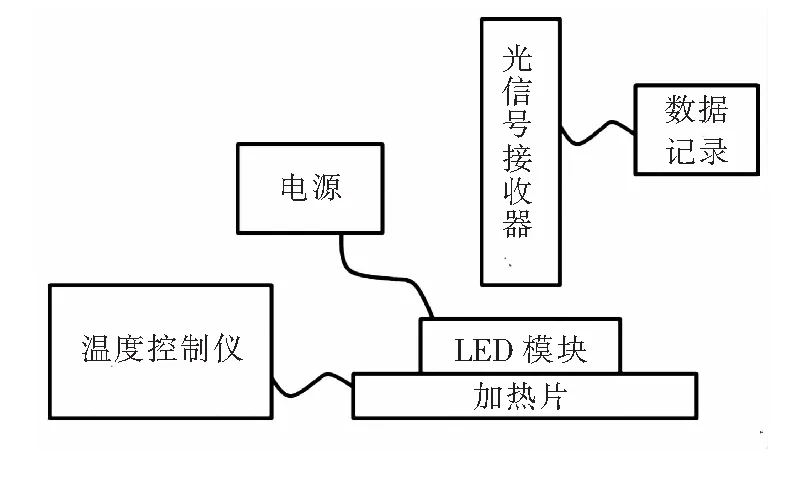
图7 光衰测试系统
3 结果与讨论
3.1 纳米银焊膏封装大功率COB LED模块的光电性能
图8为纳米银焊膏粘结的LED模块在27,50,80,100,120 ℃环境温度下的光功率随电流的变化关系。由图可以看出,在小电流区域,光功率与电流基本呈线性关系;随着电流的进一步增大,光功率增长速率逐渐减缓。这是LED芯片内部PN结处热量积累的结果。
此外,还可以看出,在较高的环境温度下,相同电流对应的光功率较低。当电流为1 500 mA时,50,80,100,120 ℃环境下的LED模块光功率分别比室温下点亮模块的光功率下降3.3%、17.6%、22.7%、25.7%。这是由于高温导致电子与空穴复合受阻[12]。

图8 不同温度下的光功率-电流关系曲线
Fig.8 Plot of optical powervs. current for LED modules at various ambient temperatures
图9给出了纳米银焊膏封装的LED模块在不同点亮电流下,发光波长与温度的变化关系。可以看出,当点亮电流一定时,模块的发光波长随温度的变化出现红移。将波长随温度的变化数据进行线性拟合,可以看出各电流下的波长温度系数几乎一致,经计算可以得到纳米银焊膏封装COB LED模块的波长温度系数为0.05 nm/℃。

图9 恒定电流下的主波长-温度拟合曲线
Fig.9 Fitting plot of dominant wavelengthvs. ambient temperature at a constant current
3.2 芯片粘接材料对大功率COB LED模块光电性能的影响
为了研究芯片级粘接材料纳米银焊膏、Sn/Ag3.0/Cu0.5焊料以及导电银胶对封装模块光电性能的影响,我们分别测试了各模块在不同工作环境中的发光效率,结果如图10所示。从图中可以看出,在各个环境温度下,纳米银焊膏封装的LED模块的光效率均明显高于Sn/Ag3.0/Cu0.5焊料和导电银胶。此外,对于所有的LED模块,其光效率均随电流水平的提高而降低。这种现象与势阱中的电子数量有关。当电子处在势阱中时,其势能最小,数量比较稳定。但随着电流的增加,注入势阱的电子数量逐渐增多,与此同时,越来越多的电子扩散逸出势阱,产生无辐射的电子与空穴复合,导致内部量子效率的降低,从而引起光效率的下降[13-14]。
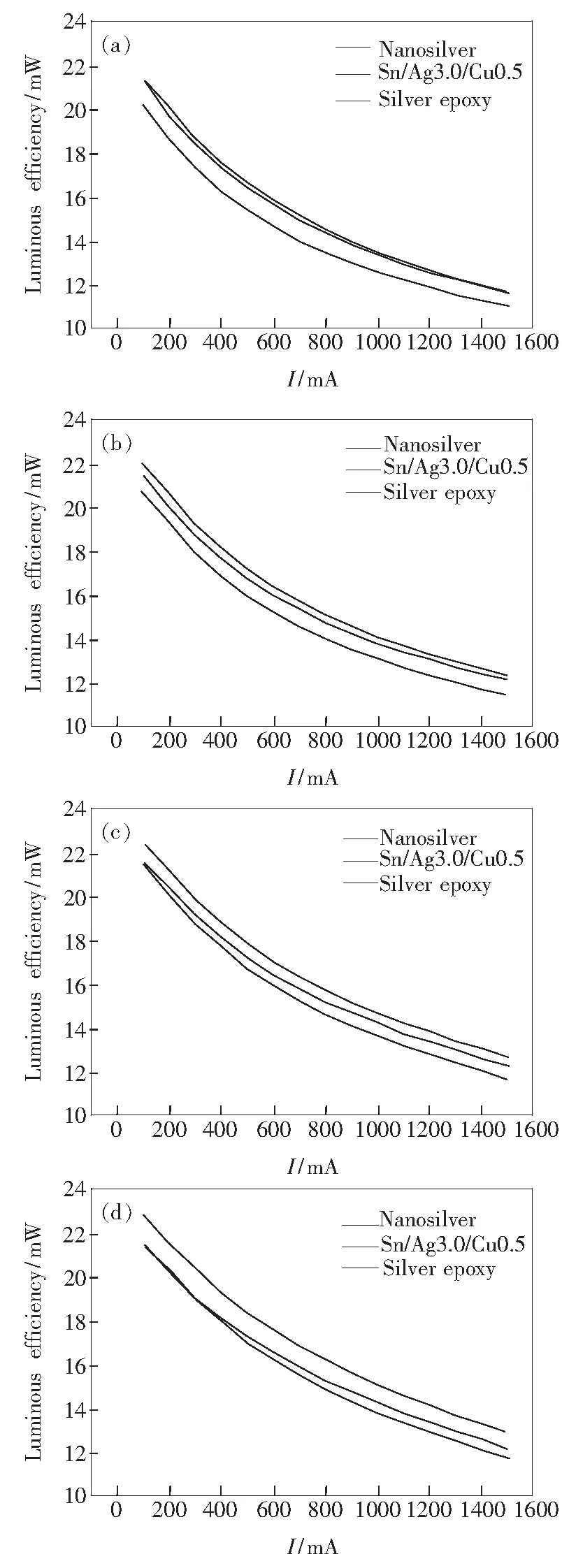
图10 不同环境温度下的LED器件的光效率-电流关系曲线。(a) 27 ℃; (b) 50 ℃; (c) 80 ℃; (d) 100 ℃。
Fig.10 Plots of calculated luminous efficiencyvs. current for LED modules at various ambient temperatures. (a) 27 ℃. (b) 50 ℃. (c) 80 ℃. (d) 100 ℃.
此外,从图10中4组环境温度下的模块光效率对比可以看出,环境温度越高,纳米银焊膏封装模块的光效率优势越明显。在此,我们分别计算了当电流注入水平为1 500 mA时,各温度下Sn/Ag3.0/Cu0.5焊料和导电银胶封装的LED模块的光效率较纳米银焊膏封装模块的降低率,计算结果见表1。在高温环境中纳米银焊膏的优势之所以愈加明显,是由于其具有更强的疏散内部热量的能力。在3种芯片粘接材料中,纳米银焊膏的热传导能力最强,因此相比于另外两组LED模块,由纳米银焊膏粘接的模块可以更有效地向外疏散内部热量,且在高温环境下差别更加显著。
表1 1 500 mA电流水平下的Sn/Ag3.0/Cu0.5焊料和导电银胶封装的LED模块光效率较纳米银焊膏封装模块的降低率
Tab.1 Lumen degradation for modules die attached by Sn/Ag3.0/Cu0.5 and silver epoxy relative to the ones die attached by nanosilver paste under 1 500 mA

材料/℃锡银铜焊料/%导电银胶/%271.85.5501.97.2803.38.01005.58.8
3.3 芯片粘接材料对大功率COB LED模块可靠性的影响
在1 000 mA电流水平下,我们对纳米银焊膏、Sn/Ag3.0/Cu0.5焊料和导电银胶封装的LED模块进行了100 ℃的加速老化实验,研究不同粘结材料对其长期可靠性的影响。图11中给出了3种材料粘结的LED模块的光衰曲线。从图中可以看出,3种材料封装的LED模块的光输出均在短暂升高后逐渐降低,且纳米银焊膏封装的LED模块下降较其他两种材料平缓。当实验进行至1 000 h时,纳米银焊膏、Sn/Ag3.0/Cu0.5焊料和导电银胶封装的LED模块的光通量分别下降至初始的91.5%、87.5%、87%,说明纳米银焊膏封装的大功率LED模块具有更优异的长期点亮可靠性。

图11 100 ℃下3种封装模块的光衰曲线
4 结 论
采用新型的纳米银焊膏作为芯片粘结材料封装高功率COB LED模块,其主波长变化(Δλ)与周围温度T呈线性关系,波长温度系数为0.05 nm/℃。与锡银铜焊料、导电银胶相比,纳米银焊膏封装的LED模块表现出最优的光效率值,其不同环境温度下光效率均高于前两者,并且这种差值随温度的增加更加显著;纳米银焊膏封装LED模块的光衰减率比前两者明显偏低,具有更优异的长期点亮可靠性。这些显著性差异主要是由于纳米银焊膏粘结层具有较高的导电导热率,其封装的高功率LED器件可以更有效地将PN结处产生的热量转移到外界环境,降低结温,进而增强器件性能及延长器件寿命。
[1] 宁磊,史永盛,史耀华,等. LED封装结构对出光率的影响 [J]. 液晶与显示, 2010, 25(6):822-825. NING L, SHI Y S, SHI Y H,etal.. Influence of package structure on LED light extraction [J].Chin.J.Liq.Cryst.Disp., 2010, 25(6):822-825. (in Chinese)
[2] 白一鸣,罗毅,韩彦军,等. 集成封装发光二极管光提取效率的计算及优化 [J]. 光学 精密工程, 2014, 22(5):1129-1137. BAI Y M, LUO Y, HAN Y J,etal.. Calculation and optimization of light extraction efficiency for integrated LED [J].Opt.PrecisionEng., 2014, 22(5):1129-1137. (in Chinese)
[3] NARENDRAN N, GU Y. Life of LED-based white light sources [J].J.Disp.Technol., 2005, 1(1):167-171.
[4] NARENDRAN N, GU Y, FREYSSINIERJ P,etal.. Solid-state lighting: failure analysis of white LEDs [J].J.Cryst.Growth, 2004, 268(3):449-456.
[5] ARIK M, BECKER C A, WEAVERS E,etal.. Evaluation of temperature distribution of LED module [J].Microelectron.Reliab., 2013, 53(4):554-559.
[6] NARENDRAN N, GU Y, HOSSEINZADEH R. The degradation of GaAlAs red light-emitting diodes under continuous and low-speed pulse operation [J].Microelectron.Reliab., 1998, 38(10):1627-1630.
[7] 王志斌,刘永成,李志全. 双进双出射流水冷大功率LED散热系统研究 [J]. 光子学报, 2014, 43(7):0723003-1-6. WANG Z B, LIU Y C, LI Z Q. Analysis on high power LED cooling system based on double inlet and outlet water jet [J].ActaPhoton.Sinica, 2014, 43(7):0723003-1-6. (in Chinese)
[8] LI X, CHEN X, LU G Q. Reliability of high-power light emitting diode attached with different thermal interface materials [J].J.Electron.Pack., 2010, 132(3):031011-1-6.
[9] MANIKAM V R, CHEONG K Y. Die attach materials for high temperature applications: a review [J].IEEETrans.Compon.Pack.Manufact.Technol., 2011, 1(4):457-478.
[10] RIMDUSIT S, ISHIDA H. Development of new class of electronic packaging materials based on ternary systems of benzoxazine, epoxy, and phenolic resins [J].Polymer, 2000, 41(22):7941-7949.
[11] 兰海,邓种华,刘著光,等. LED的COB封装热仿真设计 [J]. 发光学报, 2012, 33(5):535-539. LAN H, DENG Z H, LIU Z G,etal.. Thermal simulation for design of LED COB package [J].Chin.J.Lumin., 2012, 33(5):535-539. (in Chinese)
[12] 马建设,贺丽云,刘彤,等. 板上芯片集成封装的发光二极管结构设计 [J]. 光学 精密工程, 2013, 21(4):904-910. MA J S, HE L Y, LIU T,etal.. Design of optical structure for chip-on-board wafer level packaging LEDs [J].Opt.PrecisionEng., 2013, 21(4):904-910. (in Chinese)
[13] 王健,黄先,刘丽,等. 温度和电流对白光LED发光效率的影响 [J]. 发光学报, 2008, 29(2):358-362. WANG J, HUANG X, LIU L,etal.. Effect of temperature and current on LED luminous efficiency [J].Chin.J.Lumin., 2008, 29(2):358-362. (in Chinese)
[14] 郑峰,刘丽莹,刘小溪,等. 多主色LED照明光源的相关色温调控 [J]. 光学 精密工程, 2015, 23(4):927-933. ZHENG F, LIU L Y, LIU X X,etal.. Control of correlated color temperature for multi-primary color LED illumination [J].Opt.PrecisionEng., 2015, 23(4):927-933. (in Chinese)

杨呈祥( 1990-),男,山西太原人,硕士研究生,2012年于长春理工大学获得学士学位, 主要从事纳米银焊膏的低温烧结及性能测试方面的研究。
E-mail: aeiq560@163.com

李欣(1984-),女,天津人,博士,2012年于天津大学获得博士学位,主要从事高功率电子封装技术以及可靠性方面的研究。
E-mail: xinli@tju.edu.cn
High Power COB LED Modules Attached by Nanosilver Paste
YANG Cheng-xiang1, LI Xin1*, KONG Ya-fei1, MEI Yun-hui1, LU Guo-quan1,2
(1.SchoolofMaterialScienceandEngineering,TianjinUniversity,Tianjin300072,China;2.DepartmentofMaterialScienceandEngineering,VirginiaTech,Montgomery24060,America)*CorrespondingAuthor,E-mail:xinli@tju.edu.cn
In order to improve the thermal performance of the high-power LED, the novel nanosilver paste with higher melting temperature and thermal/electrical conductivity was used as die-attach material, and Al2O3-based ceramic substrates were used to form a high-power LED chip-on-board (COB) architecture. To compare the effect of die attach material, high power COB LED modules were packaged by nanosilver paste, traditional Sn/Ag3.0/Cu0.5 solder and silver epoxy, respectively. The photoelectricity properties of three kinds of LEDs under various ambient temperatures from 27 to 120 ℃ were measured to evaluate their thermal management. The accelerated degradation testing under 100 ℃ was measured to evaluate the reliability. The test results show that the nanosilver paste is a very promising die-attach material for high power multi-chip modules packaging.
high power LED; COB packaging; nanosilver paste; photoelectricity property; reliability
1000-7032(2016)01-0094-06
2015-09-10;
2015-11-12
天津市自然科学基金青年基金(13JCQNJC02400)资助项目
TN312.8
A
10.3788/fgxb20163701.0094

