用248 nm光刻机制作150 nm GaAs PHEMT器件性能及可靠性评估
郭 啸,章军云,林 罡
(南京电子器件研究所,南京210016)
用248 nm光刻机制作150 nm GaAs PHEMT器件性能及可靠性评估
郭啸,章军云,林罡
(南京电子器件研究所,南京210016)
介绍了基于光刻机的150 nm T型栅GaAs PHEMT工艺,其中重点介绍了使用的shrink关键工艺步骤。利用新工艺在某100 mm GaAs工艺线上进行流片,并通过直流测试、loadpull测试、微波小信号测试以及环境试验、极限电压测试、高温步进试验,获得新工艺下制作的GaAs PHEMT的各项性能指标及可靠性。最后制作得到的器件在性能和通过直接光刻得到的PHEMT在性能和可靠性上基本在一个水平上,但是想要通过shrink工艺得到线宽更细的栅长需要进一步努力。
砷化镓;赝配高电子迁移率晶体管;可靠性;T型栅
1 引言
近年来,毫米波有源器件的市场需求越来越大,发展越来越迅速,而GaAs PHEMT因其比较优越的性能、较低的成本和比较成熟的制造工艺成为8 mm波段有源器件的首选。传统的基于电子束直写技术制造的毫米波器件工艺由于其固有的低效率、低产能的缺点,已经满足不了量产的需要,而基于光刻机的工艺相对于电子束直写具有高效率、高成品率和高成熟度的优点,因此我们开发了基于248 nm光刻机的150 nm T型栅GaAs PHMET工艺。此工艺相较于更高精度光刻机制作的150 nm栅长器件,在器件性能和可靠性上处在同一水平,但是就光刻机设备成本而言,248 nm光刻机更加廉价,光刻机设备采购成本可降低70%~75%。
2 关键工艺设计
2.1Shrink工艺
Shrink工艺是指在通过曝光显影光刻出图形窗口之后,在圆片表面再涂一层shrink材料,这种材料可以溶于指定的溶剂。通过烘烤,材料和原先的光刻胶在交界面处发生铰链反应,使这部分材料的化学性质发生变化,不再溶于溶剂[1]。这样就可以用溶剂将未发生铰链反应的材料洗去,这样附着在窗口两侧的shrink材料就缩小了窗口的线宽。该工艺的意义在于可以突破光学光刻机物理分辨率限制的最小线宽,在工艺设备不变的情况下实现更小的特征尺寸,提升了工艺能力。

图1 shrink工艺示意图
Shrink工艺的核心是烘烤温度和时间的控制,温度高低和时间长短直接决定了shrink量的大小[2]。基本关系是烘烤温度越高,时间越长,shrink量越大,最终获得的线宽越小。
2.2侧墙工艺
另一个重要工艺是侧墙工艺(Sidewall Process)[3],侧墙工艺就是在栅挖槽之后先通过PECVD各向同性生长一层侧墙介质,然后各向异性把刚刚生长的介质刻蚀掉,在栅窗口两边留下2个spacer层,缩小了窗口的底部线宽。

图2 侧墙工艺示意图
从图2可以看到,用等离子干法刻蚀掉积淀的介质之后,窗口两侧会形成两个侧墙(Sidewall),这需要干法刻蚀有很好的各向异性。在调节等离子刻蚀设备时,应该选择一个非常低的工作气压来保证很好的刻蚀各向异性。
3 器件性能测试及可靠性评估
下面给出流片后得到的器件性能测试及可靠性评估,并将其和中国电科55所砷化镓部直接光刻制作的150 nm栅长器件(工艺代码PPH15H)相比较,目的是验证此工艺的可行性。
3.1直流特性(高温和常温)
直流特性的性能测试选用PCM中的100 μm栅宽的单指管芯,分别测试了高温(85℃)和常温(25℃)下的I-V曲线、Diode、转移特性、开态击穿和关态击穿特性。
测试结果见图3和表1。
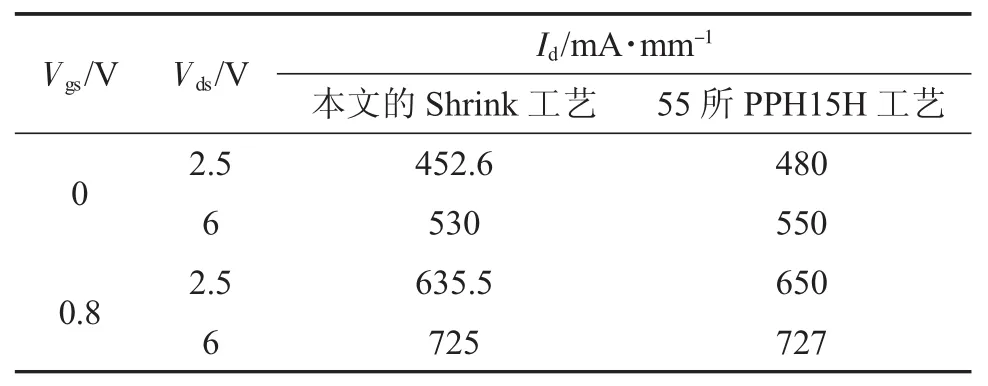
表1 两种工艺的直流测试参数比较
常温下,器件表现出一定的短沟道效应,这主要是由于器件的栅长缩短导致的。高温下,各漏压偏置电流都有一定的衰减。此外,Vds在0~4 V的范围内,没有表现出明显的Kink效应。
由图4可以看出,最大跨导Gmmax=523.4 mS/mm (@Vgs=-0.5 V,Vds=6 V),并且Vgs在-0.76 V和-0.16 V之间,跨导都可以保持在450 mS/mm以上,体现出跨导良好的线性。在高温下,跨导和漏电流都有一定程度的衰减。并且,Gmmax=460 mS/mm(@Vgs=-0.64V,Vds=6V),夹断电压-1.74 V(PPH15H下为-1.8 V)。

图4 转移特性、跨导曲线

图5 二极管特性曲线
由图5可以得到,常温下势垒高度为0.796 eV,在高温下,势垒高度为0.67 eV;55所PPH15H工艺下,常温势垒高度为0.7 eV,高温下为0.62 eV。

图6 栅漏关态击穿曲线
由图6可以看出,常温下,VBgd=-16.4 V,高温下,VBgd=-16.8 V。由图7得到,常温下,VBds=8 V,高温下,VBds=7.2 V。栅漏和源漏都是在高温下更容易击穿,这是因为温度越高,载流子的能量越大,形成的电流越大,相比之下,温度对VBds影响更大,对VBgd的影响很小。

图7 源漏关态击穿曲线
将上述参数和55所PPH15H工艺比较,如表2所示。

表2 击穿电压的比较
3.2小信号s参数(高温、低温、常温)

图8 电流增益
在Vds=6 V、Ids=75 mA/mm的条件下测量10 μm× 80 μm管芯的微波小信号的性能表现。由图8并结合外推法[4]得到电流截止频率约为ft=37.5 GHz,并且受温度的影响很小,说明器件的频率特性表现良好,并且可以承受一定的环境温度波动的影响。用同样的方法测量55所PPH15H工艺的结果,得到ft约为37GHz。
3.3LoadPull测试
在10 GHz的频率下,分别设Vds=4、5、6、7、8,Ids=75 mA/mm,做10 μm×80 μm管芯的loadpull测试。得到最大输出功率、最大附加效率随漏压偏置的变化关系图,见图9、图10。
在频率 35 GHz、Vds=6 V、Ids=75 mA/mm下作loadpull测试,得到在最佳输入Pin=1.5 dBm时,最大输出功率Pout=21.97 dBm,最大附加效率PAE=44.27%。
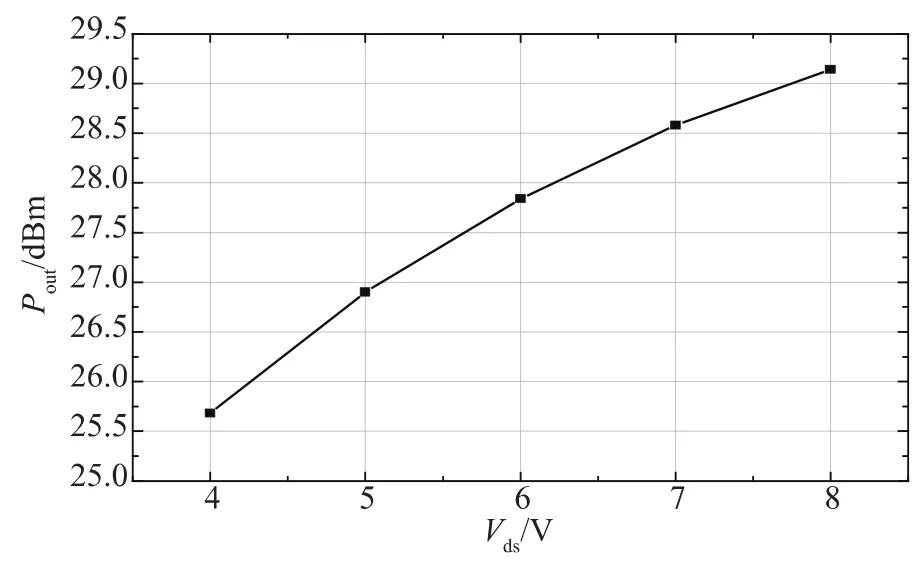
图9 最大输出功率随漏压偏置的变化关系图

图10 最大附加效率随漏压偏置的变化关系图
3.4管芯的极限电压试验
此试验过程中,用 10 μm×80 μm的管芯从Vds=6 V起不断增加漏压偏置,保持Ids=75 mA/mm不变,做Pin的扫描,直至管芯烧毁或出现其他失效模式。
统计结果显示,平均的烧毁偏置是10.33 V,功率匹配点和效率匹配点下烧毁的情况均有出现,表3为两种工艺的比较。
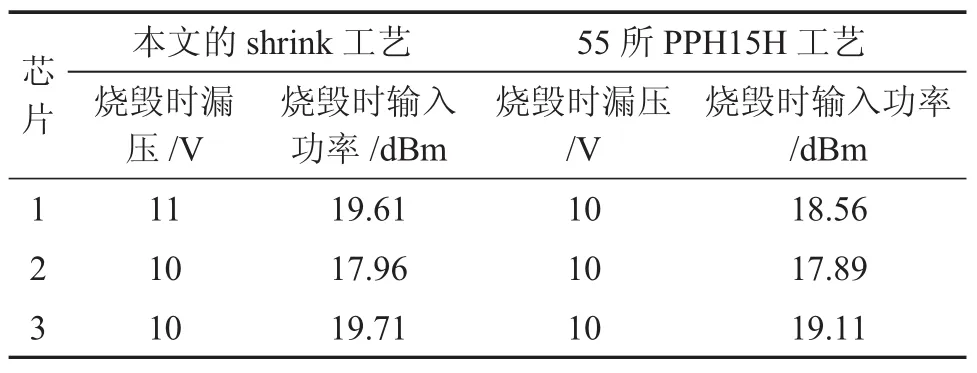
表3 极限电压测试比较
3.5环境试验[5]
选用10 μm×80 μm的管芯,分别做盐雾试验和温度循环试验。
盐雾试验:环境温度35℃,盐溶液浓度5%(重量百分比)的氯化钠溶液,盐溶液PH值6.5~7.2,试验时间10天,即240 h。
温度循环试验:环境温度25~380℃,转换时间〈15 min,极端温度停留时间30 s,循环100次。
由表4~7中数据可知,盐雾试验和温度循环前后的直流数据变化很小,完全在可接受的范围内,并且
温度循环前后直流数据的一致性更好。

表4 盐雾试验前的直流测试
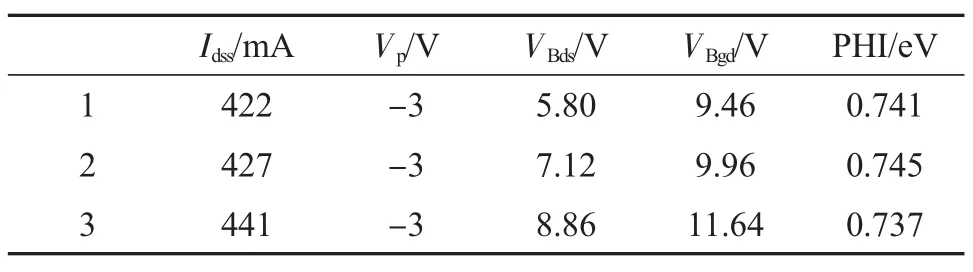
表5 盐雾试验后的直流测试

表6 温度循环前的直流测试
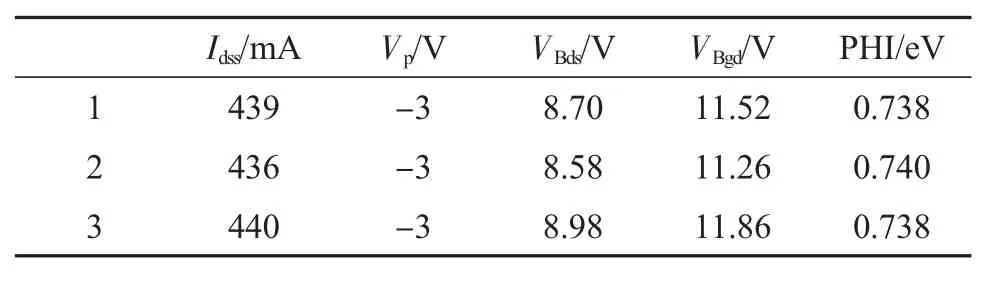
表7 温度循环后的直流测试
在显微镜下观察,盐雾试验后的芯片边缘(划片槽处)受到腐蚀明显,呈锯齿状,而温度循环后的芯片从外观上并无明显变化。
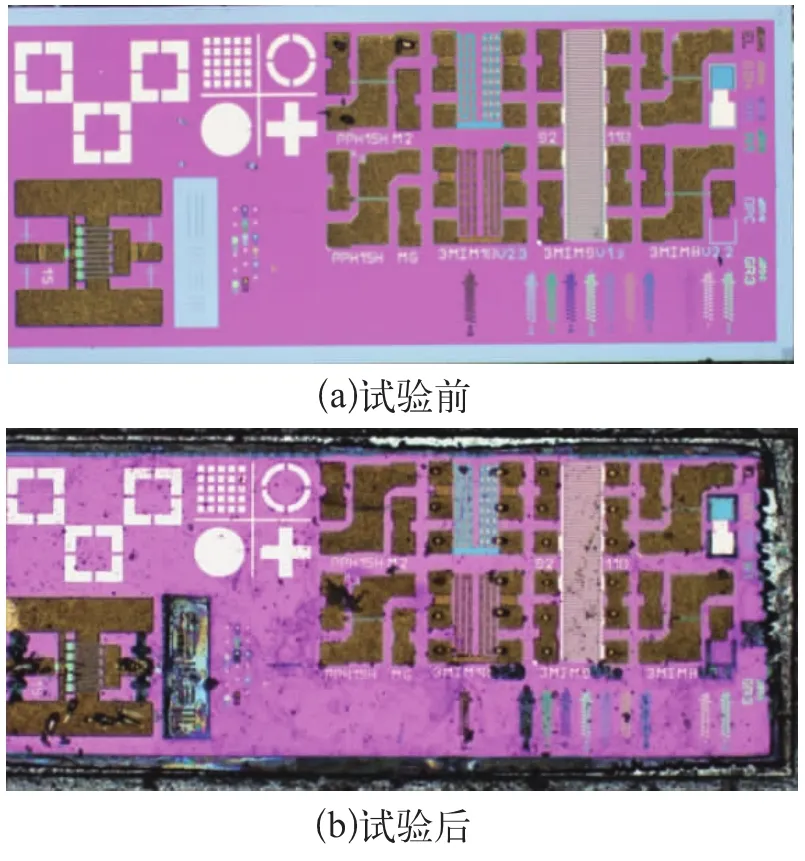
图11 盐雾试验前后芯片的外观对比
3.6高温步进试验
选用10 μm×80 μm的管芯,从Tc=100℃加电,并且使Vds=6 V,调整Vgs使得热耗Pdis=800 mW/mm,每个温度点持续≥4 h,然后调整Tc,Step=25℃;通过Tc不断步进,直至管芯烧毁或出现其他失效模式。结果在温度到达275℃时管芯烧毁,图12是栅电流的变化趋势图。

图12 栅电流的变化趋势图
4 结论
采用该工艺制作的150 nm栅长的GaAs PHEMT在各项性能指标上和55所PPH15H工艺在同一水平,且在高低温、盐雾环境下仍能表现出良好的性能,如果采用此工艺制作150 nm栅长的GaAs PHEMT,在设备成本上可以节省大量资金。本文的研究成果为基于248 nm光刻机的150 nm的T型栅GaAs PHMET工艺提供了前提,在此基础上进行进一步的研究,能更好地提升产品的性能和可靠性,且可以推广到更小的栅长和GaN等其他材料的器件制作中。
[1]孙加兴,叶田春.用三层胶工艺X射线光刻制作T型栅[J].半导体学报,2004,25(3):358-360.
[2]谢常青,陈大鹏.应用于PHEMT器件的深亚微米T形栅光刻技术[J].微纳电子技术,2007,39(7):39-42.
[3]MAMORU T,TOSHIYUKI T.Advanced RELACS technologyforArFresist[J].J ofPhotopolymerScience and Technology,2003,16(4):507-510.
[4]TOYOSHIMA T,ISHIBASHI T.0.1 μm level contact hole patternformationwithKrFlithographybyresolutionenhancement lithography assisted by chemical shrink(RELACS)[J]. IEDMTech Dig,1998(6-9):333-336.
[5]徐俊成.化学微缩技术应用于电子束微影制程与电子束阻剂线宽变异原因及微波消化效率之探讨[D].第二章.台湾清华大学博硕士论文,台湾国家图书馆典藏.
The Performance Test and Reliability Evaluation of 150 nm GaAs PHEMT Based on the 248 nm Stepper
GUO Xiao,ZHANG Junyun,LIN Gang
(Nanjing Electronic Devices Institute,Nanjing 210016,China)
The paper introduces the process of 150 nm T-shaped gate GaAs PHEMT and highlights key steps including shrink technology.The GaAs PHEMT is taped out in 100 mm GaAs process.The GaAs PHEMT goes through the DC measurement,loadpull measurement,microwave small signal measurement and environmental test,limit voltage measurement and high temperature step test and obtain the performance parameters and reliability.The performance and reliability of the device obtained by the developed process are similar with the ones obtained by direct lithography.The fabrication of thinner gate length through the shrink process is still a long way to go.
GaAs;PHEMT;reliability;T-shaped Gate

TN386;TN43
A
1681-1070(2016)08-0044-05
2016-4-28
郭啸(1990—),男,安徽滁州人,2013年毕业于东南大学电子科学与技术专业,获学士学位,南京电子器件研究所在读研究生,研究方向为微波毫米波功率器件。

