AlGaInP材料LED的电子束辐照效应的PL谱分析
于莉媛 刘 超 牛萍娟 吴英蕾
(1.天津工业大学电气工程与自动化学院 天津 300387 2.天津工业大学电子与信息工程学院 天津 300387 3.天津工业大学电工电能新技术天津市重点实验室 天津 300387)
1 引言
(AlxGa1-x)0.5In0.5P是一种宽禁带直接带隙材料,对其中的Al的摩尔组分x进行调节,能够使材料的能隙宽度和 GaAs衬底有更好的晶格匹配,进而发光复合几率大、发光效率较高。其带隙宽度在1.9eV~2.3eV之间变化,在红光(650nm)到蓝绿光(560nm)相当宽的波长范围内可以实现超高亮度的发光二极管(light-emitting diodes,LEDs)[1]。AlGaInP材料 LEDs主要应用于户外的多彩显示、汽车尾灯和作为聚合物光纤(POF)通信的光源等。AlGaInP材料LEDs 的结构比较复杂,包含有多量子阱层、限制层以及DBR层等。在材料生长过程中,对材料组分的控制成为难点,掺入 Al组分带来的氧污染也使材料的发光效率变低。同时,在载流子注入的过程中,由于电子迁移率高于空穴,没有被限制在有源层的电子将会在有源层外发生复合,降低了有源层内的电子-空穴复合几率,进而降低内量子效率。
在近年来的研究中,研究人员发现可以利用电子束辐照手段,对载流子注入的半导体器件,例如LEDs等进行深入研究,可以应用电子束辐照引起的器件性能的变化去揭示关于电子注入对残余杂质和结构性缺陷的效应影响;另外,LEDs作为半导体器件也会可能暴露于地球或空间的辐照环境中,因此,针对电子束辐照对器件性能及寿命影响的研究更为重要。其研究主要着重于器件性能的变化和由辐照带来的永久性损伤上,这些都与电子束辐照的注入条件有关。AlGaInP材料 LEDs的结构一般采用双异质结或者多量子阱结构,经辐照后将在LEDs的内部产生晶格空位、间隙原子和反位缺陷等内在缺陷,对材料和器件的电学性能和发光性能等都将产生很大的影响。
国内外已经有关于辐照LED的相关实验报道,主要集中在GaN材料LEDs上[2-7]。1999年Z-Q.Fang等人发现1MeV电子辐照在GaN材料LED中产生诱生深能级(Ec~0.18eV)。2002年,Gelhausen等人利用低能电子束辐照研究掺 Mg的GaN材料 LED的缺陷问题,提高了 LED的发光效率。2003年,Sharshar等人进行了AlGaAs材料LEDs的电子束辐照和γ射线辐照效应的研究,发现了LEDs的发光强度与辐照剂量之间的关系。其中,关于 AlGaInP LEDs 的辐照效应的研究较少。本课题组在本领域的研究上做了一定的工作,主要集中在 LEDs的辐照损伤、应用辐照改善 LED的发光性能以及LED的辐照诱生缺陷等方面。
本文主要应用1.5MeV电子加速器、3MeV电子加速器、7.5MeV电子加速器及7.5MeV电子加速器X射线转靶等几种电子束辐照对AlGaInP LEDs外延片进行实验,并应用 PL谱对比分析不同能量剂量的电子束辐照对AlGaInP LEDs发光性能的影响,并通过与理论值的拟合,总结其辐照效应。本实验结果将被用于指导AlGaInP基LED的辐照改性实验。
2 实验
实验中选用的AlGaInP LEDs外延片的材料结构如图1(a)所示,其主波长为630nm左右,对应的强发光峰位置的能量为E=1.96eV。在外延结构上,窗口层为p型GaP材料,有源区采用量子阱结构,两侧为n型限制层和p型限制层,底部设计有分布式布拉格反射层(DBR)结构。其典型的常温下PL谱发光特性图如图1(b)所示,其中存在着由厚度干涉条纹引起的卫星峰,并且主峰半峰宽度较小,表明有源区的各个量子阱的均匀性较好。
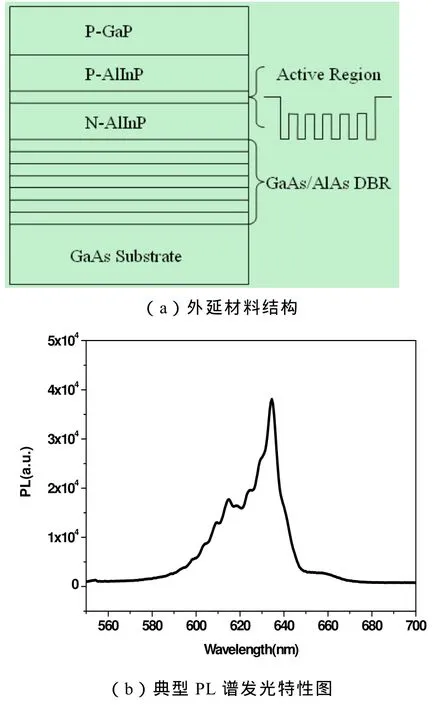
图1 AlGaInP材料LEDs外延片材料结构Fig.1 Structure of AlGaInP LEDs epitaxial wafer
本实验是利用电子加速器及X射线转靶装置对LEDs进行辐照,实验中应用到1.5MeV电子加速器、3MeV电子加速器、7.5MeV电子加速器和7.5MeV电子加速器X射线转靶辐照装置。并在每一个辐照能量下,进行剂量分别为5kGy,10 kGy和15 kGy的辐照实验。实验是在标准大气压、常温和普通空气氛围中进行的,符合一般 LEDs的工作环境。实验中准备了若干片AlGaInP材料LEDs外延片样品,并将样品分割成大小相等的若干正方形芯片,保证在不同辐照条件下的样品的可比较性。
对样品采用光致发光(PL)光谱测量系统对其的发光强度进行测试,主要对有关材料的结构、成分、能级跃迁等信息进行分析。本实验中使用实验室搭建的PL谱测试系统,系统中使用功率为100mW、波长为532nm的绿光激光器作为AlGaInP材料 LEDs外延片的激发光源。在实验中对正方形LED外延片样品进行了五个位置点的测量,五点位置分别位于四个角区域点和中心区域,并提取五个测量点的平均 PL光谱强度值,并对实验结果进行对比分析,获得了较为适合进行AlGaInP基LED的辐照改性实验的辐照的能量及剂量。
3 实验结果及分析
3.1 辐照实验结果
应用以上几种能量的电子辐照LED,并对其进行测试得到不同剂量下的PL谱图,实验中共准备了6组外延片作为样本,从测试结果的趋势上看,不同辐照实验下,几组外延片样本的变化趋势大致相同,故选取较为典型的一组外延片,即3#外延片,进行比较和分析。如图 3所示,(a)-(c)分别为1.5MeV、3MeV和7.5MeV电子辐照的情况,图中‘1’、‘2’和‘3’分别代表辐照剂量为5kGy,10kGy和 15 kGy的情况。其中横坐标为扫描波长,从550nm到 700nm,纵坐标为相对发光强度,由于7.5Mev加速器的X射线转靶辐照实验时只有一个剂量,因此未进行比较。
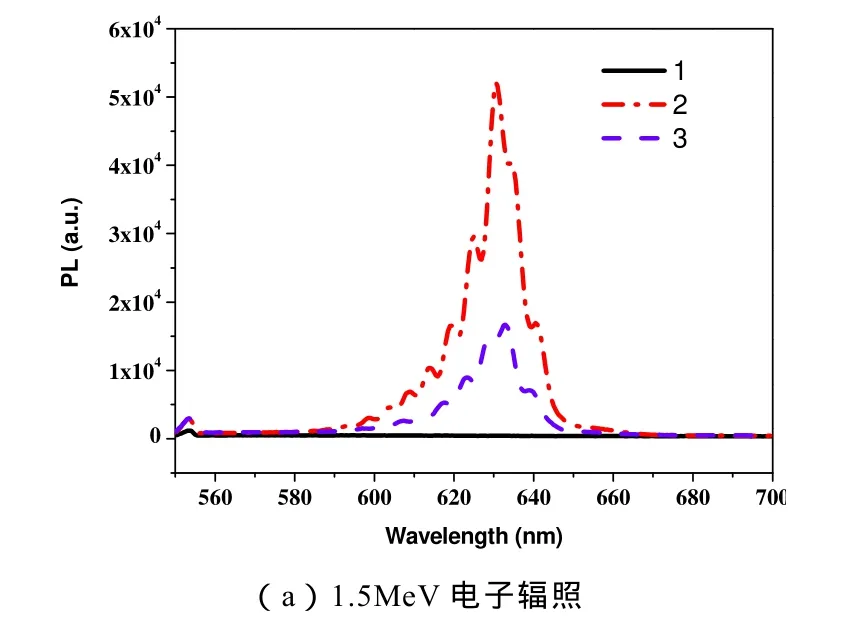

图3 不同剂量电子辐照后的外延片PL谱Fig.3 PL spectrum of electron-beam irradiation on LED samples with different dose
由以上实验结果中看出,图 3(a)为1.5MeV电子辐照的情况,与图1-(b)的未辐照外延片的典型PL谱的主波长的峰值相对比,其主波长没有变化,在剂量为10kGy时发光强度峰值有所增加。在辐照作用下,LED的PL谱形变化较小,仅在波长为555nm左右的位置上存在一个小的突起,对应的能量为E=2.23eV。样品经过能量为3MeV的辐照后,如图3(b)所示,5kGy剂量的发光强度最大,15kGy剂量的最小,而10kGy剂量的居中。并与未辐照外延片相对比,其发光强度有所增加。由图3(c)中看出,经过能量为7.5MeV的辐照后,10kGy剂量的发光强度最大,15kGy剂量的最小,而 5kGy剂量的居中。该组结果中与未辐照外延片的发光强度相比有所降低,在555nm处的较小的突起变化明显,其随剂量的变化趋势为先降低后增加。
3.2 发光强度变化分析
对比不同辐照能量和剂量情况下,将辐照后样品的主波长的发光强度峰值的平均值与未辐照的样品的主波长的发光强度峰值的平均值相比,选择未辐照发光强度归一化均值 4×104,得到的主峰强度变化的比值作为对比和分析的数据。LEDs发光强度的主峰强度变化比值的变化规律如表1所示。

表1 主峰强度变化比值Tab.1 The change of main intensity peak ratio
从上表中可以对比出不同辐照源对 LED外延片发光强度的影响。其中 7.5MeV电子束辐照后发光强度很低,其他的辐照源对应的外延片的发光强度相差不大。这是由于7.5MeV电子束的能量过大,部分对外延片内部结构造成损伤,导致外延片样品局部或完全失效。其中发光强度提高最多的为1.5MeV电子束辐照。
在 AlGaInP体系材料的生长过程中将会引入Mg-H复合体,与GaN体系材料的电子辐照效应相似,Mg-H复合体经辐照后分解,使得Mg原子活性得到恢复,进而使P型GaP层和P型AlGaInP层载流子浓度得到提高。随着辐照剂量的增加,辐照诱生缺陷增多,加强了对载流子的俘获,使非辐射复合增加,发光性能有所降低[8]。
从少子寿命角度来分析,少子寿命τ与辐照剂量的关系如下式:

其中,τ0为辐照前少子寿命,k为辐照损伤系数,φn为辐照剂量。在较低剂量下,随辐照剂量的上升,少子寿命降低,扩散长度减小,将会在 pn结的附近产生一个窄的本征区,由于电子束辐照引起的窄的本征区的产生引起正向电流的显著提高,同时引起发光强度的提高。随着剂量的进一步增加,缺陷俘获的电子浓度为nt(t),如下式所示:

Nt0为缺陷的本征浓度,T为系统温度,αrate为升温速率常数,由上式看出,随着少子寿命降低,缺陷俘获的少子浓度也有所降低,复合几率下降,引起发光强度的降低。与实验结果大致相符。由图3中可以观察到主波长也随剂量的增加有一定的红移,这是由于随着剂量的增加,由P型掺杂引起的导带边的升高,而使主波长产生红移。
3.3 电子辐照X射线转靶实验
进一步使用低剂量的由7.5MeV加速器X射线转靶产生的电子辐照外延片样品,X射线转靶技术是将X射线打重金属靶转换成有很强的方向性、向前集中的更大的穿透深度和利用效率特别高的高能高功率电子束。经实验测得的PL光谱的发光强度高于应用 7.5MeV加速器辐照的外延片的发光强度,表明 X射线转靶技术可显著改善 LED外延片样品的发光性能。
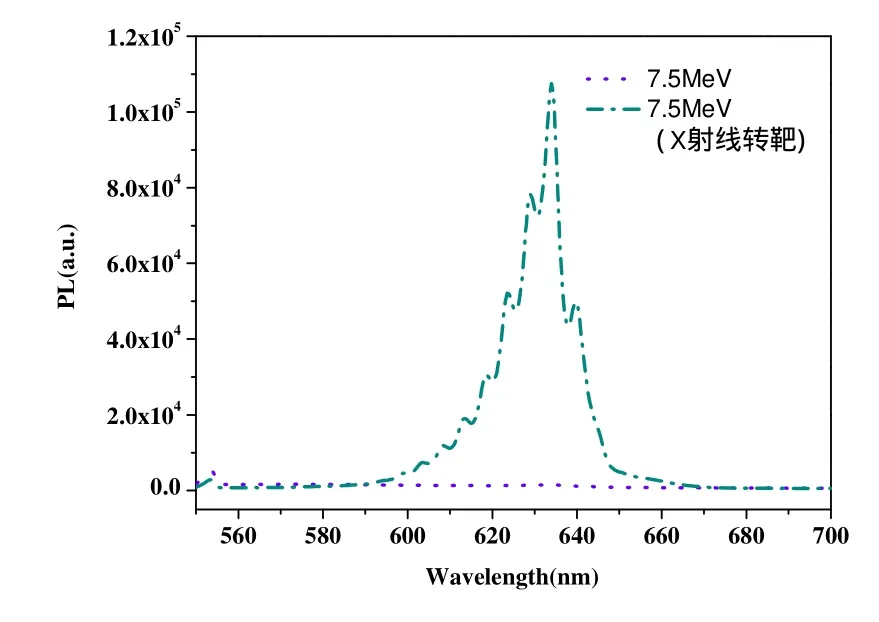
图4 7.5MeV电子加速器与7.5MeV电子加速器X射线转靶辐照的外延片PL谱Fig.4 PL spectrum of 7.5MeV electron-beam irradiation and with rotating anode X ray on LED samples
4 结论
本文主要研究 1.5MeV电子加速器、3MeV电子加速器、7.5MeV电子加速器和7.5MeV电子加速器X射线转靶几种辐照对AlGaInP基LED器件发光性能的影响,并通过实验结果对比分析不同辐照对AlGaInP基LED外延片的辐照效应,在实验中我们发现,在发光强度的变化上,在 1.5MeV能量电子辐照的10kGy剂量以下、3MeV能量电子辐照的5kGy剂量以下时,辐照使发光强度增强,随剂量的增加,发光强度逐渐降低;在 7.5MeV能量电子辐照下,样品发生失效,发光强度下降较多;在7.5MeV电子加速器X射线转靶辐照下,可显著改善LED外延片样品的发光性能。初步分析是由于材料生长中引入的Mg-H复合体经辐照后分解,使得Mg原子活性得到恢复,进而使P型GaP层和P型AlGaInP层载流子浓度得到提高,并随着辐照剂量的增加,辐照诱生缺陷增多,使发光性能有所降低。本结果将被用于指导AlGaInP材料LED的辐照改性实验。
[1] Orlova,K.N.,A.V.Gradoboev,I.A.Asanov.Gamma Degradation of Light-Emitting Diodes Based on Heterostructures AlGaInP[J].In Strategic Technology(IFOST),2012 7th International Forum on,1-4.
[2] Ohyama,H.,K.Takakura,M.Hanada,T.Nagano et al.Degradation of GaN LEDs by Electron Irradiation[J].Materials Science and Engineering,2010,173(30):57-60.
[3] Vergeles,P S,and E B Yakimov.EBIC Investigation of InGaN/GaN Multiple Quantum Well Structures Irradiated with Low Energy Electrons[J].Journal of Physics:Conference Series,2011,281(1):012013.
[4] Shmidt,N.M.,P.S.Vergeles,E.E.Yakimov,E.B.Yakimov.Effect of Low-Energy Electron Irradiation on the Cathodoluminescence of Multiple Quantum Well(MQW)InGaN/GaN Structures[J].Solid State Communications,2011,151(3):208-211.
[5] Fu,X.,T.Ma,C.Zhang,L.Zhang,Z.Zhang,X.Wang,H.Ma,H.Tu.Effects of High-Energy Electron Irradiation on Blue Luminescence of Unintentionally Doped GaN Heterostructure[J].Nuclear Instruments and Methods in Physics Research Section B:Beam Interactions with Materials and Atoms 286,2012:138-40.
[6] Lorenz,K.,E.Nogales,S.M.C.Miranda,N.Franco,B.Méndez,E.Alves,G.Tourbot,B.Daudin.Enhanced Red Emission from Praseodymium-Doped GaN Nanowires by Defect Engineering[J].Acta Materialia,2013,61(9):3278-3284.
[7] L.M.Zhang,C.H.Zhang,L.Q.Zhang,X.J.Jia,T.D.Ma,Y.Song,Y.T.Yang,B.S.Li,Y.F.Jin.Structural and Optical Study of Irradiation Effect in GaN Epilayers Induced by 308MeV Xe Ions[J].Nuclear Instruments and Methods in Physics Research Section B:Beam Interactions with Materials and Atoms,2011,269(15):1782-85.
[8] Nakamura,T.,K.Kamioka,K.Kuriyama,K.Kushida,Q.Xu,M.Hasegawa.Compensation Mechanism of DX-like Center in Neutron Transmutation Doped GaN[J].Solid State Communications,2015,205:1–3.
[9] Liang L M,Xie X J,Hao Q Y,Tian Y,Liu C C.Effects of annealing an the luminescence properties from defects formed in electron- irradiated GaN[J].Radiation Measurements,2012,47:965-969.
[10] F.Berthet,Y.Guhel,H.Gualous,B.Boudart,J.L.Trolet,M.Piccione,C.Gaquière.Annihilation of Electrical Trap Effects by Irradiating AlGaN GaN HEMTs with Low Thermal Neutrons Radiation fluence[J].Microelectronics Reliability,2012,52:2159-2163.

