NAND型Flash存储器总剂量效应实验研究
盛江坤,邱孟通,姚志斌,何宝平,黄绍艳,刘敏波,肖志刚,王祖军
(西北核技术研究所 强脉冲辐射环境模拟与效应国家重点实验室,陕西 西安 710024)
NAND型Flash存储器是一种非易失性存储器,具有编程和擦除速度快、生产工艺简单、生产成本低、存储密度大、功耗小及重量轻等优点,在电子设备中常用作数据存储。近几年,美国航天局和欧空局在其卫星产品中加强了NAND型Flash存储器的应用,涉及气象卫星、地球资源探测卫星及空间探测器等诸多领域。国内也已开展了基于NAND型Flash存储器的星载固态存储技术的研究与应用[1]。空间应用表明,NAND型Flash存储器抗总剂量能力较差[2-3],使NAND型Flash存储器的总剂量效应研究成为空间电子元器件辐射效应研究的一个重要方面。
从20世纪末开始,国外针对NAND型Flash存储器进行了大量抗总剂量性能的测试考核与效应研究[4-6]。国内对Flash存储器的辐射效应研究主要集中在一种容量小、常用作指令存储的NOR型Flash存储器上[7-8]。本文从辐照偏置和工艺尺寸两方面开展NAND型Flash存储器的总剂量效应实验研究。
1 NAND型Flash存储器
NAND型Flash存储器的结构如图1所示[9]。其主要由存储阵列、电荷泵电路、译码电路、缓存电路及控制逻辑电路等组成。
NAND结构通过多位直接串联形成一串联结构,串联结构的两端各有一选通晶体管,以保证串联结构同位线(BL)和地线(SL)相连,字线(WL)与存储单元的控制栅相连。共享同一字线的存储单元构成逻辑页,同一组字线上的所有存储单元构成逻辑块。页是编程操作的基本单位,块是擦除操作的基本单位。
电荷泵电路用于产生各类操作需要的高电压;译码电路将电荷泵产生的电压施加到相应的存储单元上;缓存电路用于缓存读出或写入的数据;控制逻辑电路负责与用户通信,并控制存储器执行各类操作。
存储单元的编程和擦除操作通过FN隧穿效应实现(图2)。执行编程操作时,在控制栅上加高压,使电子从衬底进入浮栅,提高存储单元的阈值电压,此时存储数据为0;执行擦除操作时,在衬底上加高压,使浮栅上的电子回到衬底,降低存储单元的阈值电压,此时存储数据为1。
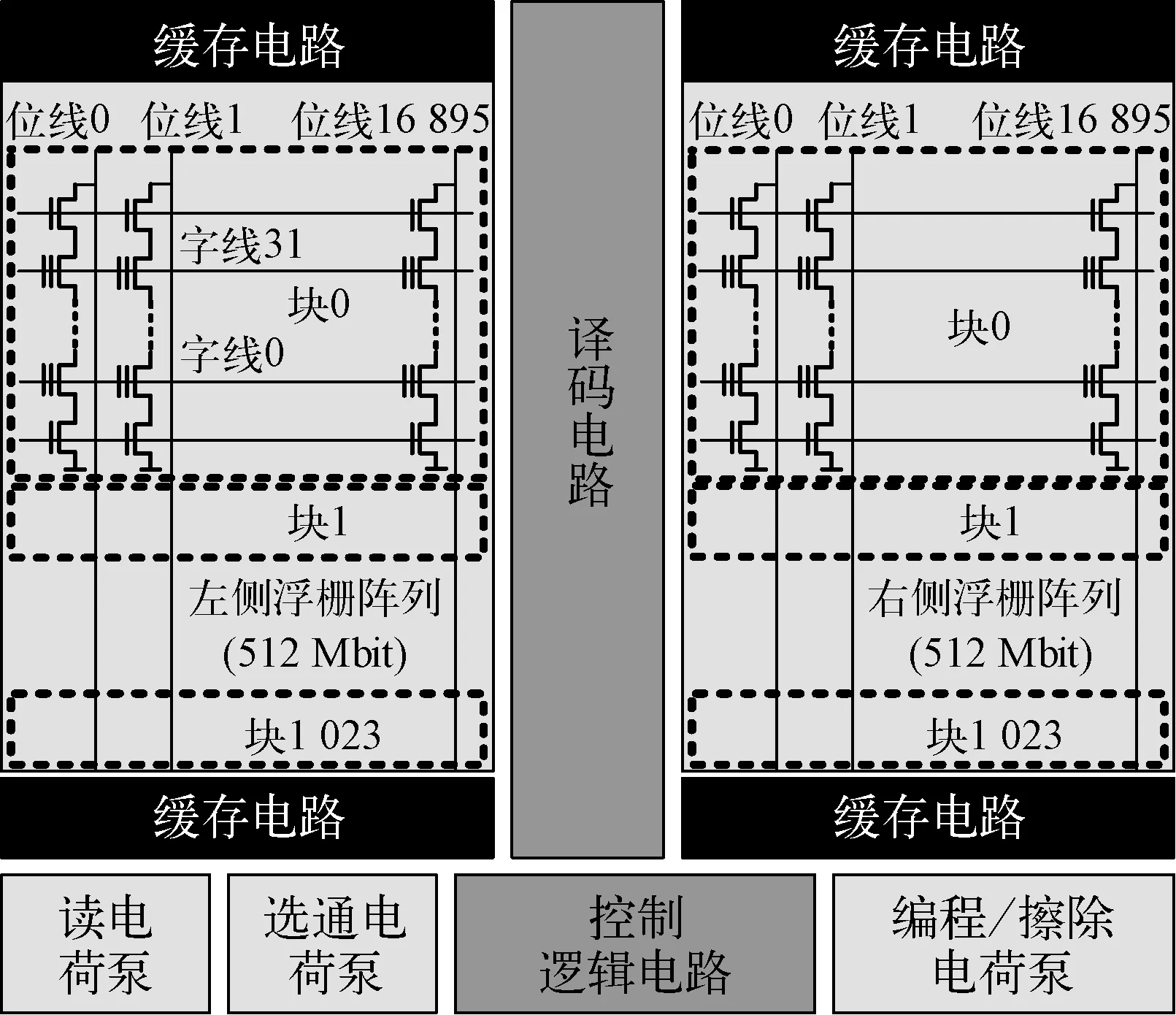
图1 NAND型Flash存储器结构
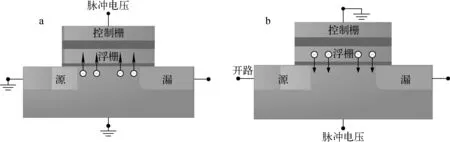
图2 存储单元的编程(a)与擦除(b)
进行读出操作时,使串联结构上的选通晶体管和其他存储单元处于导通状态,在需要读出的存储单元上施加判读电压,判读电压的值介于编程状态和擦除状态的阈值电压之间,通过判断整个串联结构的导通状态来判断存储单元上存储的数据。
2 实验
实验在西北核技术研究所60Co γ射线源上进行,辐照剂量率为0.5 Gy(Si)/s。实验选取镁光公司4种不同型号的NAND型Flash存储器。被测器件信息列于表1。

表1 被测器件信息
实验所用的测试系统为自主研制的NAND型Flash存储器总剂量效应测试系统。测试系统可对被测器件的数据位翻转、擦写时间、擦写功能、指令响应及静态电流进行测试。
NAND型Flash存储器的测试方法分为刷新测试和非刷新测试。非刷新测试模式下,测试系统对被测器件执行读出操作,并进行数据位翻转测试。刷新测试模式下,测试系统对被测器件顺序执行擦除、编程和读出操作,通过测量R/B信号低电平保持时间得到擦写时间,通过读出被测器件状态寄存器的值及读出操作来判断擦写功能是否失效。两种测试模式下通过监测被测器件R/B信号电平是否正常转换来判断指令响应是否正常。静态加电条件下通过高端法测量静态电流。
针对MT29F2G08AAD,实验选用静态加电、不加电及动态3种辐照偏置,来研究辐照偏置对器件总剂量效应的影响。静态加电和不加电辐照偏置下,辐照一定总剂量后,对器件执行刷新测试或非刷新测试,然后循环上述过程。动态辐照偏置下,对器件循环执行刷新测试或非刷新测试。执行刷新测试或非刷新测试时,向器件写入的数据为55H。针对表1所列的4种器件,通过开展静态加电辐照偏置下的总剂量效应实验,来研究不同工艺尺寸器件的总剂量效应的异同性。
3 实验结果与分析
3.1 辐照偏置对总剂量效应的影响
实验中仅发现0到1的翻转,即浮栅上的电子消失。图3为MT29F2G08AAD在不同辐照偏置下数据位翻转率随总剂量的变化。
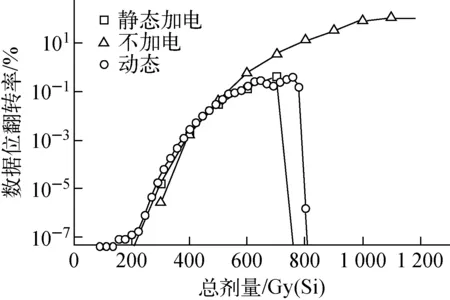
图3 MT29F2G08AAD在不同辐照偏置下数据位翻转率随总剂量的变化
总剂量在200~700 Gy(Si)之间时,3种辐照偏置下的数据位翻转率均迅速升高,且翻转率相当。根据NAND型Flash存储器的工作原理,静态加电和不加电辐照偏置下,存储阵列的偏置均为栅极浮空;动态辐照偏置下,虽因循环读出而在相应存储单元的栅极上施加正电压,但正电压维持的时间很短,在整个辐照时间中占的比例很小,因此动态条件下存储阵列的辐照偏置与另外两种偏置相似,从而使总剂量相同时器件在3种偏置状态下的数据位翻转率相当。
当总剂量达800 Gy(Si)左右时,静态加电和动态辐照偏置下数据位翻转率变为0,这种现象是由读出功能失效造成的。随辐照剂量的积累,电荷泵电路的输出电压降低,译码电路的漏电流增大[9]。这些因素使施加在存储单元控制栅上的电压降低,造成整个串联结构无法正常导通,进而导致翻转为1的存储单元又被重新读为0,因此测试时表现为数据位翻转率降低。动态辐照偏置下,电荷泵启动的时间仅占读出时间的5%左右,所以静态加电和动态两种辐照偏置下器件的读出功能失效阈值相差不大。
不加电辐照偏置下的数据位翻转率在总剂量大于800 Gy(Si)时继续升高,在总剂量达到1 000 Gy(Si)时变为100%,即回读数据全部为FFH,这并非是由存储单元全部翻转造成的,而是由读出功能失效引起的。

图4 MT29F2G08AAD在600 Gy(Si)和700 Gy(Si)时的翻转位图
图4为静态加电辐照的MT29F2G08AAD在600 Gy(Si)和700 Gy(Si)时的翻转位图,其他总剂量点及不同偏置的翻转位图与图4相似。从图4可看出,器件的数据位翻转呈一定的随机特性,在块的起始页和结束页翻转数较多,这一阶段的数据位翻转是由存储单元阈值电压漂移造成的。在电离辐射作用下,浮栅周围的氧化层中产生电子空穴对,未发生复合的电子在电场的作用下被迅速扫出氧化层,空穴在电场的作用下向浮栅移动,一部分进入到浮栅中与电子复合,另一部分陷在氧化层中,形成氧化层正电荷,同时,浮栅上的电子在辐照后获得足够的能量而跃过氧化层势垒。这些因素都会造成浮栅上的电荷损失,使存储单元的阈值电压发生负向漂移[10]。辐照剂量较小时,阈值电压虽漂移,但尚未小于判读电压,因此未出现数据位翻转;当辐照剂量累积到一定程度时,阈值电压小于判读电压,就会检测到0到1的翻转。由于生产工艺及脉冲电压扰动等因素,存储单元的阈值电压呈一定的随机分布特性,因此数据位的翻转亦呈一定的随机分布特性。
图5为MT29F2G08AAD归一化总擦除时间和编程时间随总剂量的变化。从图5可看出,静态加电和动态辐照偏置下,擦除时间和编程时间的变化趋势相同,均在辐照剂量累积一定程度后因外围电路性能退化而变长。但操作时间的变长并不是连续的,图6为MT29F2G08AAD在不同总剂量下的擦除时间分布。从图6可看出,擦除时间的变化是阶跃性的,按约375 μs的倍数增长。编程时间的变长同样是阶跃性的,但编程时间变长的页数较少,因此编程时间的增长率较低。
擦除时间和编程时间呈阶跃性变长主要由NAND型Flash存储器的工作机制[11]造成。擦除和编程的操作流程均为闭环结构,一次擦除或编程操作结束后将对操作结果进行验证,若操作成功则退出操作,若不成功则再进行一次操作。
如果循环一定次数后擦除或编程操作仍不成功,则退出操作流程,并提示操作失败。因此当操作时间增大到一定值后,器件的擦除功能和编程功能将失效。实验发现,600 Gy(Si)时,进行静态加电辐照的4个器件均擦除成功;700 Gy(Si)时,3个器件的全部块地址擦除失败,1个器件的两个块地址擦除失败;800 Gy(Si)时,4个器件全部块地址擦除失败。这表明静态加电辐照偏置下器件的擦除功能失效阈值在600~800 Gy(Si)之间。进行动态辐照的3个器件分别在621、657及661 Gy(Si)时全部块地址擦除失败。实验中并未发现编程功能失效,仅监测到编程时间的变长。从擦除时间和编程时间的变化及擦除功能失效阈值看,静态加电辐照偏置和动态辐照偏置的实验结果相似,产生这种现象的原因是动态辐照偏置下电荷泵启动的时间在整个辐照时间中占的比例较小,仅占约20%。

图5 擦除时间及编程时间随总剂量的变化

图6 不同总剂量下擦除时间的分布
不加电辐照偏置下,编程时间在功能失效前略有上升,而擦除时间无明显变化,总剂量达1 000 Gy(Si)后,操作时间突然降低至接近0,且所有编程操作和擦除操作均失败,回读的数据全部为FFH,与非刷新测试的结果相似,说明不加电辐照偏置下的数据位翻转率变为100%是由读出功能失效造成的。不加电辐照下失效现象不同于另外两种偏置的失效现象,表明不同辐照偏置下引起功能失效的敏感电路不同。
实验中被测器件的指令响应正常。静态偏置下进行非刷新测试时未发现数据位翻转现象,表明辐照并未对存储单元造成致命的损伤,重新执行擦除和编程操作后,可补充浮栅上损失的电荷,这一现象为NAND型Flash存储器的航天应用提供了启示,即在保存的数据发生翻转前,对卫星上的Flash存储器进行重新写入,可提高数据的保存时间,直至器件的功能失效。不加电辐照偏置下器件的功能失效阈值高于静态加电和动态辐照偏置的情况,表明器件在冷备份状态下会有更长的寿命。
3.2 不同工艺尺寸器件的总剂量效应
图7分别为4种器件数据位翻转率、擦除时间及静态电流随总剂量的变化,其功能失效阈值列于表2。
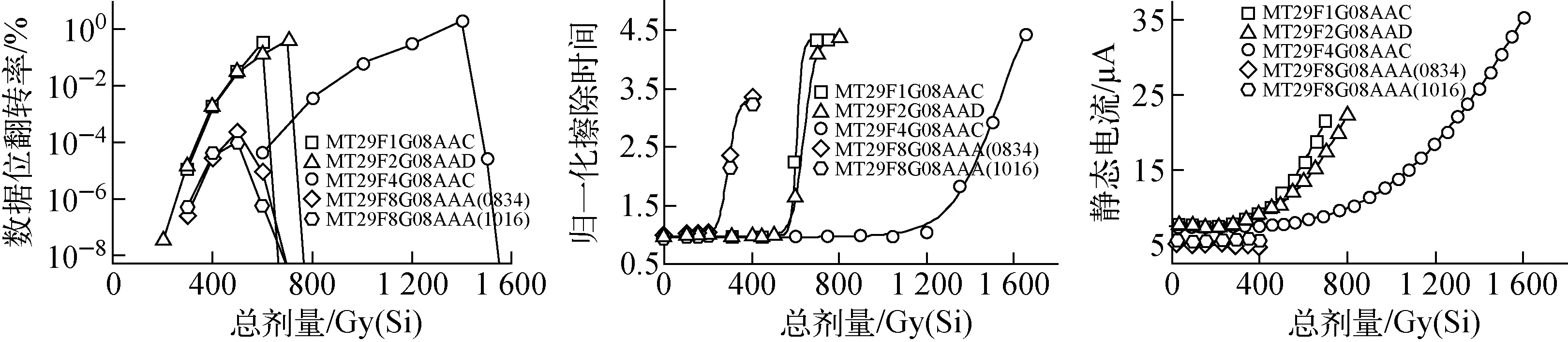
图7 4种器件的翻转率、擦除时间及静态电流随总剂量的变化

表2 4种器件功能失效阈值
4种器件的数据位翻转率变化趋势相似,均表现为先升高、后由于读出功能失效而变为0。翻转数迅速增加是由存储单元阈值电压漂移造成的,存储单元阈值电压的漂移不仅与氧化层厚度有关,还与氧化层介电常数及辐照前浮栅电荷量等参数有关[10]。另外,对于当前工艺下的NAND型Flash存储器,考虑到数据的可靠性原因,氧化层的厚度已不能随工艺尺寸等比例缩小[3],因此,翻转数并不随器件的工艺尺寸单调变化。
4种器件的擦除时间先变长,增长到一定值后产生功能失效。对于1G、2G和4G器件,其擦除功能的失效阈值随工艺尺寸的减小而增大,这与常见的器件抗总剂量性能随工艺尺寸的变化规律相符合。但8G器件却并不符合此规律,擦除功能在400 Gy(Si)处即发生失效,其原因可从影响电荷泵输出电压的因素进行分析。
电荷泵的输出电压为:
(1)
其中:VDD为电荷泵供电;Vφ为时钟信号高电平;Vth为MOS管阈值电压;C为时钟耦合电容;CS为电荷泵每一级的寄生电容;Iout为电荷泵输出电流;f为时钟频率;N为电荷泵级数。
由式(1)可看出,大的负载电流会降低电荷泵的输出电压,进而对擦除功能造成影响。8G器件的块容量是其他3种器件的两倍,在执行擦除操作时需更大的电流,因此更易产生擦除失败。辐照前,8G器件小部分块擦除时间与其他3种器件相同,均为400 μs左右,但大部分块擦除时间大于800 μs,是其他器件的两倍,这也反映出大的负载电流对擦除功能的影响。
1G、2G和4G器件功能失效时静态电流均有较大的增长,且器件的静态电流开始增大时,相同总剂量下工艺尺寸越小的器件静态电流变化越小,而8G器件在功能失效时静态电流却无明显变化,这也从侧面说明了8G器件功能失效的原因与其他器件不同。
4 小结
本文对镁光公司的4种NAND型Flash存储器进行了不同辐照偏置下的总剂量效应实验及不同工艺尺寸器件的静态加电辐照实验。实验结果表明,器件在静态加电和动态辐照偏置下的总剂量效应相似,而与不加电辐照偏置下的总剂量效应不同,表明不同辐照偏置下引起功能失效的敏感电路不同。不同工艺尺寸器件的各敏感参数变化趋势相似,受各种因素的综合影响,其并不随工艺尺寸单调变化。
参考文献:
[1] 陈斌,沈卫华,朱岩,等. 嫦娥二号卫星大容量存储器设计[J]. 航天器工程,2011,20(5):99-104.
CHEN Bin, SHEN Weihua, ZHU Yan, et al. Design of solid state recorder for Chang’e-2 orbiter[J]. Spacecraft Engineering, 2011, 20(5): 99-104(in Chinese).
[2] CELLERE G, PACCAGNELLA A. A review of ionizing radiation effects in floating gate memories[J]. IEEE Transactions on Device and Materials Reliability, 2004, 4(3): 359-370.
[3] GERARDIN S, PACCAGNELLA A. Present and future non-volatile memories for space[J]. IEEE Transactions on Nuclear Science, 2010, 57(6): 3 016-3 039.
[4] NGUYEN D N, LEE C I, JOHNSTON A H. Total ionizing dose effects on flash memories[C]∥IEEE Radiation Effects Data Workshop. USA: IEEE, 1998: 100-103.
[5] OLDHAM T R, FRIENDLICH M R, SANDERS A B, et al. TID and SEE response of advanced samsung and micron 4G NAND Flash memories for the NASA MMS mission[C]∥IEEE Radiation Effects Data Workshop. USA: IEEE, 2007: 221-225.
[6] BAGATIN M, GERARDIN S, CELLERE G. Error instability in floating gate flash memories exposed to TID[J]. IEEE Transactions on Nuclear Science, 2009, 56(6): 3 267-3 273.
[7] 贺朝会,耿斌,陈晓华,等. 浮栅ROM器件γ辐射效应实验研究[J]. 核电子学与探测技术,2002,22(4):344-347.
HE Chaohui, GENG Bin, CHEN Xiaohua, et al. Experimental study on γ irradiation effects of floating gate ROMs[J]. Nuclear Electronics & Detection Technology, 2002, 22(4): 344-347(in Chinese).
[8] 贺朝会,耿斌,杨海亮,等. 浮栅ROM器件辐射效应机理分析[J]. 物理学报,2003,52(9):2 235-2 238.
HE Chaohui, GENG Bin, YANG Hailiang, et al. Mechanism of radiation effects in floating gate ROMs[J]. Acta Physica Sinica, 2003, 52(9): 2 235-2 238(in Chinese).
[9] BAGATIN M, CELLERE G, GERARDIN S. TID sensitivity of NAND Flash memory building blocks[J]. IEEE Transactions on Nuclear Science, 2009, 56(4): 1 909-1 913.
[10] SNYDER E S, McWHORTER P G , BELLIN T A. Radiation response of floating gate EEPROM memory cells[J]. IEEE Transactions on Nuclear Science, 1989, 36(6): 2 131-2 139.
[11] MICHELONI R, CRIPPA L, MARELLI A. Inside NAND Flash memories[M]. Germany: Springer, 2010: 329-337.

