氧化锌锡薄膜晶体管的制备与性能研究
初学峰, 胡小军, 张祺, 黄林茂, 谢意含
(1.吉林建筑大学 寒地建筑综合节能教育部重点实验室, 吉林 长春130118;2.吉林建筑大学 电气与计算机学院, 吉林 长春130118)
1 引言
近年来,随着科学技术的发展,薄膜晶体管(TFT)作为显示器中的关键元件,受到研究人员的广泛关注[1-7]。在显示领域中,非晶硅目前是商用显示技术领域中主要使用的材料,但是其迁移率低于1 cm2/(V·s),不能满足现有的AMOLED、QLED等新型显示技术的需求[8]。因此,研究人员聚焦于金属氧化物薄膜晶体管。
现有金属氧化物薄膜晶体管具有制造成本低、迁移率高、开关比高、稳定性好等优势,而含铟(In)的金属氧化物薄膜晶体管是其中的佼佼者,如:IGZO[9]、ITZO[10]、IZO[11]、IAZO[12]等,所以最受关注。归因于In3+(4d105s0)的特殊电子结构[13],铟离子的5s0轨道相互重叠,形成电子通道,所以其电子迁移率较高。然而铟元素是一种具有毒性且稀少的元素,寻找一种新的材料来代替铟基氧化物是非常重要的。Sn4+与In3+具有相同的电子结构和物理化学性质,所以锡基氧化物被认为是铟基氧化物的潜在替代材料之一。目前为止,常用的生长金属氧化物薄膜的沉积方法包括电化学沉积[14]、化学气相沉积[15]、脉冲激光沉积[16]、溶胶凝胶[17]、磁控溅射[18-20]等。其中磁控溅射技术由于生长温度低、厚度均匀性高、溅射薄膜致密等优点是沉积氧化锌锡(ZTO)薄膜中应用最广泛的技术之一。
溅射功率对薄膜质量有显著的影响。本文通过磁控溅射技术,制备了不同溅射功率的ZTO薄膜及其薄膜晶体管,研究溅射功率对TFTs迁移率、阈值电压、亚阈值摆幅、电流开关比的影响。实验结果表明,使用90 W溅射功率制备器件时,其电学、光学性能达到最佳。
2 实验
本文所有样品都基于锌锡氧化物陶瓷靶材和SiO2/p-Si衬底。锌锡氧化物陶瓷靶材中锌锡原子比为7∶3,SiO2的厚度为285 nm。制备过程如下:首先使用丙酮、无水乙醇、去离子水清洗SiO2/p-Si衬底10 min,再使用氮气吹去衬底表面残留的水分。其次对衬底进行光刻,使有源层图案化。随后采用磁控溅射法在SiO2/p-Si衬底上室温制备ZTO薄膜,溅射功率为70 W、80 W、90 W、100 W(功率密度为2.8 W/cm2、3.2 W/cm2、3.6 W/cm2、4.0 W/cm2),氩氧比为90∶10,溅射时间为7.5 min,厚度为50 nm。去除光刻胶后,在空气氛围下600 ℃退火1 h。最后通过电子束蒸发方法,在ZTO薄膜上制备50 nm厚的源漏Al电极,其中Al电极图案化通过紫外光刻实现,沟道宽度为300 μm、沟道间距为10 μm。TFT的结构如图1所示。

图1 ZTO TFT结构示意图Fig.1 Schematic diagram of ZTO TFT structure
本实验采用磁控溅射设备生长ZTO TFT的有源层。使用光刻机(ABM/6/350/NUV/DCCD/M, USA)进行光刻,将沟道层图案化。采用快速退火炉(RTP-100,Germany)对ZTO TFTs进行退火处理。采用半导体参数分析仪(Keysight B1500A, USA)在室温、空气氛围下测量TFT的电学性能。使用原子力显微镜(AFM,MFP-3D Origin+,USA)表征ZTO薄膜的表面结构和形貌,通过X射线衍射仪(XRD,D8DISCOVER,Germany)得到ZTO薄膜的成分、晶体的结构,使用紫外可见分光光度计(UV-Vis, 2600 UV,Japan)测量ZTO薄膜在紫外和自然光下的透光率,采用X射线光电子能谱仪(XPS, ESCALAB 250 Xi,USA)检测薄膜中元素的组成、元素的化学态信息。
3 实验结果与讨论
3.1 薄膜透射光谱分析
图2描述了在不同溅射功率下制备的ZTO薄膜的透光率,所有样品在可见光范围内均表现出良好的透光率,展现了其在透明显示领域的应用前景。

图2 不同溅射功率的ZTO薄膜在200~800 nm范围内的透光率图Fig.2 Transmittance of ZTO thin films with different sputtering powers in the range of 200~800 nm
3.2 薄膜结构与形貌分析
图3是不同溅射功率下沉积的ZTO薄膜在600 ℃空气氛围下退火后测量的XRD谱图。在20°~80°衍射角中未发现明显尖锐的衍射峰,说明ZTO薄膜均为非晶结构。结合薄膜的AFM数据,所有ZTO薄膜光滑均匀,相对应的ZTO TFTs具有良好的电学一致性。
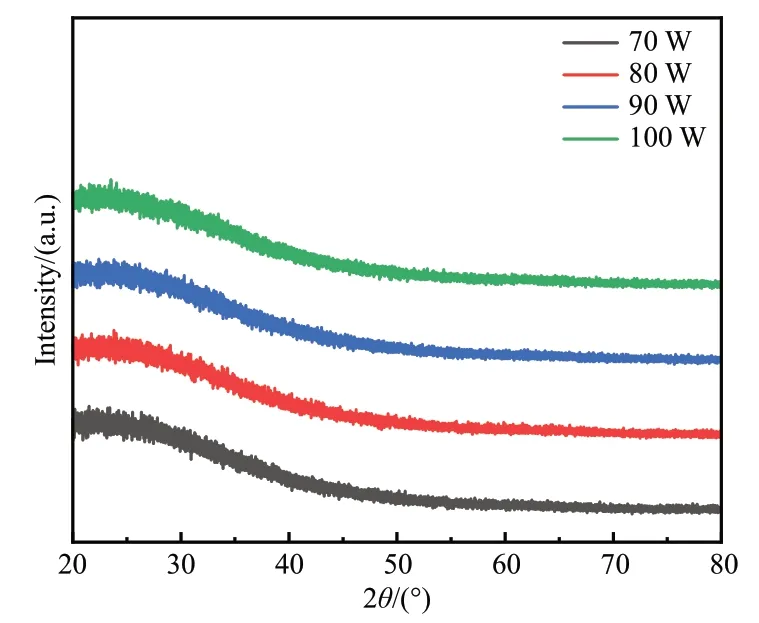
图3 不同溅射功率下ZTO薄膜的XRD图谱Fig.3 XRD pattern of ZTO film under different sputtering powers
有源层表面粗糙度对薄膜晶体管有着重要影响。为了表征薄膜粗糙度,对ZTO薄膜进行AFM测量。图4是不同溅射功率沉积的ZTO薄膜的AFM 3D形貌图。计算得到的ZTO薄膜的均方根面粗糙度(RMS)结果见图4。结果显示,随着溅射功率的提高,RMS值一直减小。这可能是由于高的溅射功率致使ZTO薄膜生长的速度增加,到达衬底形成晶核的原子和原子团的数量逐渐增加。与晶核生长相比,成核过程占主导地位,使薄膜的密度增加,导致较小的RMS值[21]。

图4 不同溅射功率的ZTO薄膜的AFM图像。(a) 70 W; (b) 80 W; (c) 90 W;(d)100 W。Fig.4 AFM images of ZTO films with different sputtering powers. (a) 70 W; (b) 80 W; (c) 90 W; (d) 100 W.
3.3 薄膜X射线光电子能谱分析
为了研究溅射功率对ZTO薄膜中元素比例和化学价态的影响,通过X射线光电子能谱的分析表征,分别测试了ZTO薄膜的Sn3d、Zn2p、O1s谱图,见图5。根据X射线光电子能谱的半定量计算,得到不同溅射功率下ZTO薄膜中各元素的比例,如表1所示。当溅射功率增加时,Zn元素含量先减少后增大,Sn元素含量逐渐增大,O元素含量先增大后减少。在氧化物半导体中,一般导带最小值由金属离子高度分散的球形s轨道构成,价带最大值由氧的外层轨道构成。随着Sn含量的增加,Sn4+含量增加,其球型s轨道的重叠增加,样品的载流子浓度增大。

表1 ZTO薄膜中Sn、Zn和O元素的原子含量(摩尔分数)Tab.1 Atomic content (mole fraction) of Sn, Zn and O elements in ZTO film

图5 ZTO薄膜的XPS光谱。(a) Sn3d; (b) Zn2p; (c)O1s。Fig.5 XPS spectra of ZTO thin film. (a) Sn3d; (b) Zn2p;(c) O1s.
在Sn3d谱图(图5(a))中, Sn3d3/2和Sn3d5/2峰的结合能分别为494.10 eV和485.70 eV。随着溅射功率的增加,Sn3d双峰向着更高的结合能位移。说明随着溅射功率的增大,薄膜中Sn4+占Sn元素的比例增大。此外,在Zn2p、O1s光谱中也观察到了类似的位移,如图5(b)、5(c)所示[22]。结果表明,Zn2+离子被电负性更大的Sn4+离子取代(Sn:1.8vs.Zn:1.6),导致外层电子密度变化和Sn3d峰的位移[23]。
图6显示了不同溅射功率下ZTO薄膜的O1s峰的XPS拟合结果。通过高斯洛伦兹拟合法将氧卷积成3个不同的峰,分别位于530.15 eV(OⅠ)、531.20 eV(OⅡ)和532.50 eV(OⅢ)。在530.15eV处有低结合能峰,其归因于O2-离子与Zn或Sn离子连接的晶格氧(OⅠ)。531.20 eV的峰对应于氧空位(OⅡ),532.50 eV的峰则对应于ZTO薄膜表面松散结合的氧(OⅢ),如羟基、—CO3、表面吸收的水或氧等[24]。随着溅射功率的增加,OⅠ峰占总氧峰(OⅠ+OⅡ+OⅢ)的原子比例从74.80%下降到了70.35%,OⅡ峰面积占总氧峰的原子比从19.18%上升到24.35%。结果表明,在较高的溅射功率下ZTO薄膜存在较多的氧空位。根据=VO+2e-+1/2O2(g)公式,ZTO薄膜中的氧空位作为双电离供体,最多向导带贡献两个电子[24]。因此,更多的氧空位会导致更高的载流子浓度。在后续的电学性能测试中,90 W溅射功率下ZTO薄膜晶体管拥有更大的开启电流(ION)和更高的饱和迁移率,与结果一致。

图6 不同溅射功率下ZTO薄膜的O1s光谱。(a) 70 W; (b) 80 W; (c) 90 W; (d) 100 W。Fig.6 O1s spectra of ZTO films with different sputtering powers. (a) 70 W; (b) 80 W; (c) 90 W; (d) 100 W.
3.4 TFT器件电学性能分析
使用半导体参数仪对ZTO薄膜晶体管进行了电学性能的测试,如图7所示。在图7(b)中,漏极电流IDS随着VGS的增大而增大,表现出了良好的饱和趋势,说明TFT是以N型半导体工作。在VDS较小时,未出现“电流拥挤”现象,表明源漏电极与沟道层形成的欧姆接触良好。

图7 不同溅射功率下ZTO薄膜晶体管的(a) 转移特性曲线、IDS1/2-VGS和(b) 90 W下 输出特性曲线。Fig.7 (a) Transfer characteristic curves, IDS1/2-VGS of ZTO thin film transistor under different sputtering power,( b) Output curves at 90 W.
器件的迁移率可以根据公式(1)算出:
其中:W和L分别为通道宽度和长度;μFE为场效应迁移率;Ci为SiO2栅绝缘层单位面积电容;VGS是栅极施加电压。采用90 W溅射功率的ZTO TFT具有最佳性能,饱和迁移率为15.61 cm2/(V·s)。
如图7(a),在转移曲线一阶偏导最大处取一切点做切线与横坐标的截距即为VTH。随着溅射功率的变化,ZTO TFTs的阈值电压和亚阈值摆幅会发生变化,亚阈值摆幅、电流开关比通过公式(2)~(3)获得:
SS的单位是V/decade。
使用公式计算可以得到TFTs的饱和迁移率、亚阈值摆幅、阈值电压和电流开关比,数据列于表2。当溅射功率增大到90 W时,ZTO TFT的饱和迁移率从7.74 cm2/(V·s)增加到15.62 cm2/(V·s),亚阈值摆幅为0.30 V/decade,电流开关比为8.92×109。恰当地增加溅射功率,可以使ZTO薄膜晶粒尺寸增加,减少晶界对载流子的散射作用,增加在ZTO TFT的迁移率[25]。但是随着溅射功率进一步增大,ZTO TFT的饱和迁移率、电流开关比逐渐减小。因为溅射功率的增大,ZTO薄膜的厚度增加,缺陷变多,载流子在运动时发生散射现象,导致TFT饱和迁移率下降,器件的电学性能降低。

表2 不同溅射功率下的电学参数Tab.2 Electrical parameters under different sputtering power
图8显示了不同溅射功率下制备的ZTO TFTs在正偏置应力(PBS)和负偏置应力(NBS)条件下的稳定性。在相同的PBS条件(VGS=10 V)下,70 W、80 W、90 W、和100 W溅射功率下制备的ZTO TFT的阈值电压位移(ΔVTH)分别为+2.78 V、+1.47 V、+0.69 V和+1.36 V。在NBS(VGS=-10V)稳定性方面,其阈值电压位移为-1.56 V、-1.26 V、-0.48 V和-0.61 V。总的来说,在90 W溅射功率下制备的ZTO TFT的稳定性最好。这可能是由于绝缘介质层内的载流子陷阱或有源层/介质层界面以及附近深间隙态的缺陷造成的。因此,可以认为VTH位移是与被捕获在界面或绝缘介质内的电荷的数量有关[26]。

图8 采用不同溅射功率制备的ZTO薄膜晶体管的偏置应力测试结果。(a)正偏置应力;(b)负偏置应力。Fig.8 The bias stress test results of ZTO thin-film transistors prepared under different sputtering powers. (a) Positive bias stress; (b) Negative bias stress.
4 结论
在285 nm SiO2/p-Si衬底上制备了氧化锌锡(ZTO)薄膜晶体管,系统地研究了溅射功率对ZTO薄膜形貌、元素组成、光学和电学性能的影响。所有的ZTO薄膜都是非晶态,薄膜表面光滑、平整。随着溅射功率增大,ZTO薄膜表面粗糙度降低,在溅射功率为100 W时粗糙度最低为0.58 nm。在200~800 nm波长范围内透光率>90%。当溅射功率从70 W升到100 W时,器件的电学性能先升高后降低,90 W溅射功率的样品最好,具有15.61 cm2/(V·s)的饱和迁移率(μSAT)、0.57 V/decade的亚阈值摆幅(SS),阈值电压为-5.06 V,电流开关比(ION/IOFF)超过109。

