一种低反向恢复电流的无电压回跳RC-IGBT 设计∗
曾 伟,武 华,冯秀平,陈翰民,姚 佳,杨煌虹
(赣南师范大学物理与电子信息学院,江西 赣州 341000)
绝缘栅双极型晶体管(Insulated Gate Bipolar Transistor,IGBT)具有高输入阻抗和低导通压降的特性,目前已成为高压、高功率开关器件领域的主流器件[1-3]。在大多数的应用场合,由于传统IGBT 器件自身没有反向导通能力,需要与续流二极管(Freewheeling Diode,FWD)反并联使用,以获得逆向导通性能,但这不仅显著增加制造与封装成本,而且对FWD 的要求也很高,相关研究机构先后提出并实现了将IGBT 与FWD 集成在同一块硅片上的新型IGBT 器件结构[4-6]。于是诞生了在IGBT 集电区引入N+短路区的RC-IGBT,但在RC-IGBT 集电区引入短路的N+集电区后,阳极短路结构使器件在初始导通时,会出现电压回跳现象[7]。为解决该问题,许多学者提出了各种解决方案,通常有以下两种方法:一种是增大器件集电区短路电阻,降低器件漂移区电阻,例如具有三明治集电极结构的半超结RC-IGBT(SSS-RC-IGBT)[8],新型自控双沟栅极RCIGBT(DTG-RC-IGBT)[9],具有多P+/N 集电极的IGBT(SA-IGBT)[10]等;第二种是引入新结构,改变逆向导通模式或保证器件导通时的空穴注入方法,例如具有多提取通道的RC-IGBT(MEC-RC-IGBT)[11],具有N-Si/N-Ge 异质结的RC-IGBT(NNHRC-IGBT)[12],氧化槽隔离型RC-IGBT(TO-RC-IGBT)[13],使器件快速地度过工作模式转换。但无论是通过改变器件电阻解决回跳现象的器件,还是通过改变逆向导通模式的器件,器件结构都比较复杂,对工艺要求较高,并且对器件某些特性,会有一定不利影响,比如反向恢复特性,阻断特性等。
本文提出了一种无回跳的RC-IGBT 器件结构,器件仅在集电极侧场截止层下方加入一个N 型层作为高阻层,同时把N+集电区部分替换为P 型薄层,通过加入的N 型层增加集电极电阻,同时用P型薄层替换了部分N+集电区,保证在初始导通时集电区的空穴能够在第一时间注入,改变了传统器件在导通初始阶段是电子电流为主,随后空穴电流增大的情况,从而消除了RC-IGBT 的电压回跳现象,同时具有低反向恢复电流。
1 器件结构与机理
传统RC-IGBT 为了得到反向导通性能,在集电区引入N+集电区,造成RC-IGBT 器件在导通时存在电压回跳现象,即RC-IGBT 器件在导通时,一开始工作在双极模式,在器件导通时需要从双极模式转换为单极模式,这时集电极电阻会急剧降低,从而导致出现电压骤回现象,这种现象在低温下会更加明显,严重时甚至会导致器件完全不能进入IGBT工作模式,使正向压降变得特别大。
基于优化RC-IGBT 的电压回跳现象,设计并仿真了所提出的器件,传统的FS RC-IGBT 和本设计的P 型薄层替换部分N+阳极的无回跳RC-IGBT 剖面图如图1 所示,两种器件正面均采用平面栅极结构,传统FS RC-IGBT 背面集电区上方采用N 缓冲层作为场截止层(Field Stop,FS)。所设计的P 型薄层替换部分N+集电区的无回跳RC-IGBT,正面结构与传统FS RC-IGBT 结构一样,但是器件背面集电区与场截止层之间加入了一层N 型高阻层(N-buffer),同时将N+集电区的一部分用P 型薄层(P-layer)替换。本设计器件厚度为120 μm,器件集电极侧的N+集电区与P+集电区的长度比为1 ∶4,器件漂移区厚度为100 μm,掺杂浓度为8×1013cm-3,加入的N-buffer层厚度为5 μm,掺杂浓度为8×1013cm-3,用于替换的P 型薄层厚度为1.5 μm,掺杂浓度为6×1014cm-3。集电区厚度为5 μm,替换后剩余的N+集电区厚度为3.5 μm,掺杂浓度为1×1019cm-3。
因为器件回跳电压会受到器件集电极电阻的影响,在集电区与场截止层之间加入一层N 型高阻层,用于提高器件集电极电阻,缓解器件的电压回跳。同时电压回跳现象的产生也是由于N+集电区加入后,器件的背面空穴注入受到了影响,因此本设计中用P型薄层替换一部分N+集电区,保证一开始模式转换时的背面空穴注入,同时由于薄层的厚度较N+集电区薄,其掺杂浓度比集电区低得多,能保证器件的反向导通性能,不会使器件失去反向导通能力。
2 设计结果与分析
图2 所示是传统FS RC-IGBT 与设计的无回跳RC-IGBT 的正、反向导通特性的仿真结果,传统的FS RC-IGBT 在正向导通过程中,会出现集电极电流增大,集电极-发射极电压减小的电压回跳现象,其回跳电压为5.59 V。从图2 看出,本设计的无回跳RC-IGBT 中,在P-layer 层厚度为1.5 μm,掺杂浓度为6×1014cm-3时,设计的器件消除了正向导通时的电压回跳现象。原因是在集电区与场截止层中间加入了N-buffer 层,用于增加集电极电阻,同时把N+集电区的一部分用轻掺杂P-layer 层代替,使得P+集电区在初始导通时就可以向漂移区注入空穴,有效抑制了器件的电压回跳现象。同时从图2 可以看出器件在P-layer 层厚度为1.5 μm,掺杂浓度为6×1014cm-3时的反向导通性能依旧稳定。
图3 所示是P-layer 层厚度为1.5 μm 时,P-layer层掺杂浓度对无回跳RC-IGBT 的正向导通特性的影响,器件回跳现象随着P-layer 层掺杂浓度的增加而减弱,当掺杂浓度达到6×1014cm-3时,设计的无回跳RC-IGBT 的回跳现象已经完全消除。器件在初始导通阶段由发射极漂移到集电极侧的电子电流由于P-layer 层的加入,在流入N 型集电区前在P-layer 层处产生压降,可以使P 型集电区的空穴在初始阶段就参与导通,避免了由于初期仅有电子电流,而后空穴电流才出现,使得漂移区电阻骤减引起电压回跳现象。
图4 所示为器件P-layer 层掺杂浓度及厚度对无回跳RC-IGBT 的反向导通特性的影响。由于N+集电区的一部分用轻掺杂的P-layer 层代替,P-layer层的加入会使器件的反向导通性能有所减弱,要对P-layer 层的厚度以及掺杂浓度进行设计,当P-layer层的厚度以及浓度足够大时可以完全消除电压回跳现象,但器件反向导通性能会有很大削弱,甚至不能反向导通,所以结合高阻N-buffer 层使集电极电阻增加的效果,在厚度为1.5 μm、掺杂浓度为6×1014cm-3时,完全消除了电压回跳现象。

图4 P-layer 层掺杂浓度及厚度对设计的无回跳RC-IGBT 反向导通特性的影响
图5 所示为场截止层浓度为5×1017cm-3时,传统FS RC-IGBT 与本设计无回跳RC-IGBT 的阻断特性,结果表明所设计的无回跳RC-IGBT 阻断特性与传统器件几乎一样,其击穿电压为725 V,由于器件并没有改变场截止层的结构与掺杂,所以器件的场截止层依旧能截断纵向电场,保证器件阻断特性的稳定。

图5 传统FS RC-IGBT 与所设计的无回跳RC-IGBT 的阻断特性
图6 所示为反向导通电流密度为50 A•cm-3时,传统FS RC-IGBT 与设计的无回跳RC-IGBT 的反向恢复特性曲线。两种器件的反向恢复时间均为2 326 ns,但本设计的器件由于P-layer 层的加入,使基区平衡空穴密度有所提升,会减小产生的反向电流,所以反向恢复的峰值电流密度为30 A/cm3,比传统FS RC-IGBT 反向恢复的峰值电流密度45 A/cm3小很多,所设计的无回跳RC-IGBT 在反向恢复过程中损耗会更低。
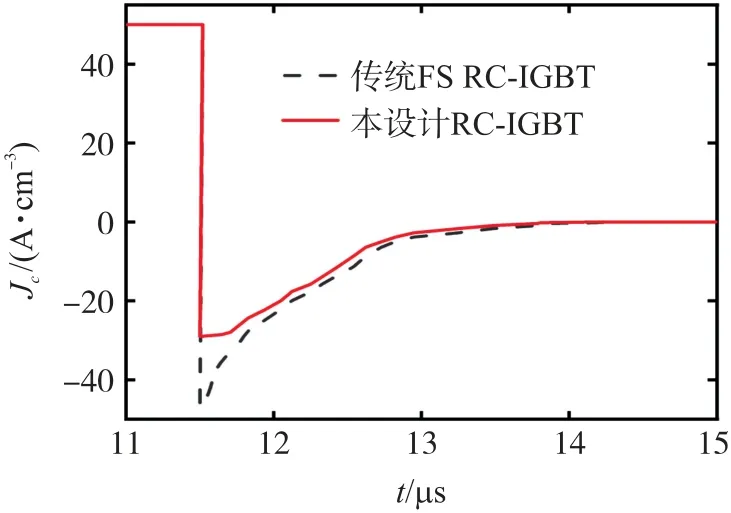
图6 传统FS RC-IGBT 与所设计的无回跳RC-IGBT 的反向恢复特性
图7 所示为传统FS RC-IGBT 与设计的无回跳RC-IGBT 关断特性曲线,本设计的无回跳RC-IGBT关断时间(从90%Jce下降到10%Jce的时间)为934 ns,比传统FS RC-IGBT 关断时间1 037 ns 减小了103 ns。因为加入的P-layer 层在器件关断时,与N-buffer 层、N+集电区组成的三极管结构会导通,使器件漂移区中的载流子被抽取得更快,在一定程度上使器件的关断能力有所提高,同时由图7 可知,所设计的器件对关断损耗的优化较小,器件的关断损耗与传统FS RC-IGBT 器件差别不大。
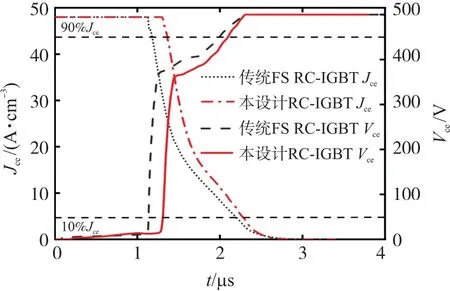
图7 传统FS RC-IGBT 与所设计的无回跳RC-IGBT 的关断特性
表1 为传统FS RC-IGBT 与所设计的无回跳RC-IGBT 一些主要性能参数对比,可以看出所设计的无回跳RC-IGBT 消除了回跳现象,同时在反向恢复电流峰值和关断时间上比传统的器件有更优秀的特性。
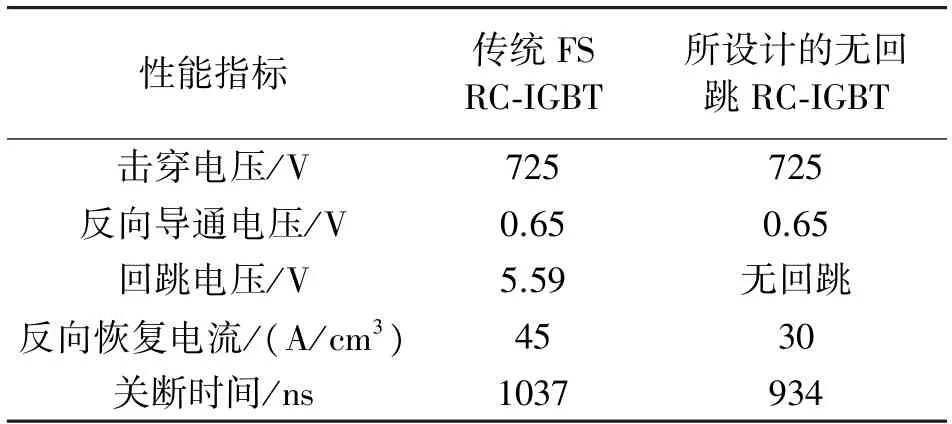
表1 传统FS RC-IGBT 与所设计的无回跳RC-IGBT性能参数对比
3 结论
基于Sentaurus TCAD 提出了一种无回跳的RCIGBT 器件结构并进行了仿真验证,该RC-IGBT 在器件宽度为24 μm,N-layer 区厚度为1.5 μm,浓度为6×1014cm-3时,器件的回跳现象已经消除,加入的N-buffer 层增加了集电极电阻,同时P 型薄层保证在初始导通时集电区的空穴能够在第一时间注入,改变了传统器件在导通初始阶段是电子电流为主,随后空穴电流增大的情况。在不影响器件反向导通性能的同时,消除了电压回跳现象,并且使器件的反向恢复电流峰值降低了15 A/cm3,同时器件的关断特性也有所改善,关断时间减小了103 ns,相较于传统FS RC-IGBT,反向恢复峰值电流降低了33.3%,关断时间减小了9.93%。

