新型铁电薄膜在MFIS器件中的应用
王树雨,芦春光,袁秋婷,仇加俊,付跃举,蔡淑珍,傅广生
(河北大学 物理科学与技术学院,河北 保定 071002)
非挥发性铁电存储器具有高存储密度、较低功耗、随机读写和优良的工艺兼容性等诸多优点,特别是在断电后还能保留之前的数据,使其在存储系统中扮演着越来越重要的角色[1].金属-铁电-半导体场效应晶体管(metal/ferroelectric/semiconductor)器件在半导体器件中被公认为第3代最理想的存储器件[2].在该结构中,采用铁电薄膜取代传统MOS场效应晶体管中的栅极氧化层[3],构成了新型的MFS结构.该结构利用铁电薄膜的不同极化方向来定义 “0”和“1”2个逻辑状态,实现二进制数据的存储.在MFS结构中,由于铁电层和半导体层直接接触,导致其界面特性较差,如界面的陷阱密度较高、漏电流较大以及铁电薄膜与半导体基底之间易产生相互扩散等问题,这些问题会对器件的性能产生影响,从而限制了MFS结构的应用与发展.为了解决上述存在的问题,在MFS结构的铁电层与半导体层之间再增加一个绝缘层,从而改善界面出现的一系列问题,也就是金属-铁电-绝缘层-半导体(metal-ferroelectric-insulator-semiconductor,MFIS)结构[4].在关于MFIS结构的研究中,MFIS结构的绝缘层选用最多的是单一的金属氧化物[5-6],但根据目前研究,高介电材料比较适合充当MFIS结构的绝缘层[7-8],因为高介电材料不仅可以在具备一定的厚度的情况下给铁电层施加适当的电压,还可以避免因电子隧穿对漏电流产生的影响[7].
1 新型铁电材料的应用
在MFIS器件绝缘层的选取上,选择了具有高介电特点的新型铁电薄膜的Na0.5Y0.5TiO3(NYTO)薄膜,作为A位掺杂的钙钛矿型氧化物.将NYTO薄膜作为MFIS器件的绝缘层,是否会让MFIS器件拥有更好的性能成为一个值得探究的课题.本文选用具有较大剩余极化强度、较低工作电压的Pb(Zr,Ti)O3(PZT)铁电薄膜材料[9]作为MFIS结构的铁电层材料,PZT薄膜采用溶胶-凝胶法制备.本文在实验过程中:制备Pt/PZT/Pt电容器利用铁电测试仪去测试其铁电性能;制备Pt/NYTO/Pt电容器以测量其介电特性;制备Pt/PZT/NYTO/Si电容器,通过XRD、SEM和LCR表等一系列表征和测试手段,重点研究以NYTO薄膜为绝缘层制备出的MFIS电容器是否具有较好的性能.
2 实验步骤
MFIS电容器的绝缘层NYTO薄膜是通过磁控溅射法制备的,NYTO的靶材是根据高温固相反应法,将药品Na2CO3、 Y2O3和TiO2以化学计量比为1∶1∶4进行烧制而成的.MFIS电容的铁电层Pb(Zr,Ti)O3(PZT)薄膜是采用溶胶-凝胶法制备的,整个工艺流程分为以下几个部分.
2.1 基片准备
选取P型Si(001)作为半导体衬底,将Si片切成5 mm×5 mm的基片,分别用丙酮和无水乙醇在超声波清洗器中清洗10 min,清洗完成后放入体积分数10 % HF酸缓冲液中浸泡10 min左右以去除附着在Si片表面的SiO2氧化层,然后使用去离子水将Si片清洗干净.
2.2 绝缘层NYTO的制备
将清洗后的Si片粘在基片托上放入磁控溅射系统的腔体内,关闭腔体抽真空,真空度达4×10-4Pa时,充入氩气和氧气,流量比分别为75∶25,控制腔体内压强为2.5 Pa,溅射温度为630 ℃,溅射功率在90 W,预溅射后控制正式溅射时间为40 min,溅射结束在腔体内充入8.5×104Pa的氧气,使薄膜在氧气环境中降温.
2.3 铁电层PZT的制备
制备PZT薄膜时用到的PZT前驱体溶液是Pb(Zr0.2Ti0.8)O3溶液,该溶液中Pb元素过量15 %.制备过程中使用匀胶机在提前准备好的基片上将Pb(Zr0.2Ti0.8)O3前驱体溶液涂抹均匀,操作过程如下:先将匀胶机的转速控制在500 r/min保持6 s,然后再将转速提高至4 000 r/min保持40 s.甩胶结束以后将基片置入温控炉中在350 ℃烘烤5 min,此时的PZT薄膜是无定形态,薄膜的厚度为40 nm左右,可根据需要对薄膜的厚度进行调整,在此需要将上述过程重复3次,就可得到所需的PZT薄膜.在此之后,将得到的薄膜再放入退火炉中在氧气氛围下退火,退火温度为550 ℃,时间为60 min,最终就制备出性能良好的PZT铁电薄膜.
2.4 顶电极的制备
先将掩膜板用丙酮和无水乙醇清洗10 min,之后将样品固定在掩膜板上,然后将Pt靶和掩膜板放入磁控溅射腔体中,抽真空使真空度达到1×10-4Pa,充入氩气和氮气,V(Ar)∶V(N2)=15∶1,使腔体内压强稳定在0.2 Pa,溅射功率为100 W,溅射时间2 min,可在薄膜表面生长了70 nm厚的金属Pt作为顶电极.
为了测量PZT的铁电性质,在Pt基片上制备Pt/PZT/Pt电容器.为了测量绝缘层材料NYTO薄膜的介电特性,制备Pt/NYTO/Pt电容器测量其介电特性.
3 结果分析与讨论
3.1 Pt/PZT/Pt电容器的铁电性能分析
如图1a所示,在1 kHz测试频率下,使用15 V测试电压测量得到的PZT铁电薄膜的电滞回线,从图1a中可以看出:15 V测试电压下所制备的PZT铁电薄膜剩余极化强度(Pr)和矫顽电压(Uc)分别是:42.53 μC/cm2和3.24 V.这表明上述所制备的PZT薄膜具有优异的铁电性.
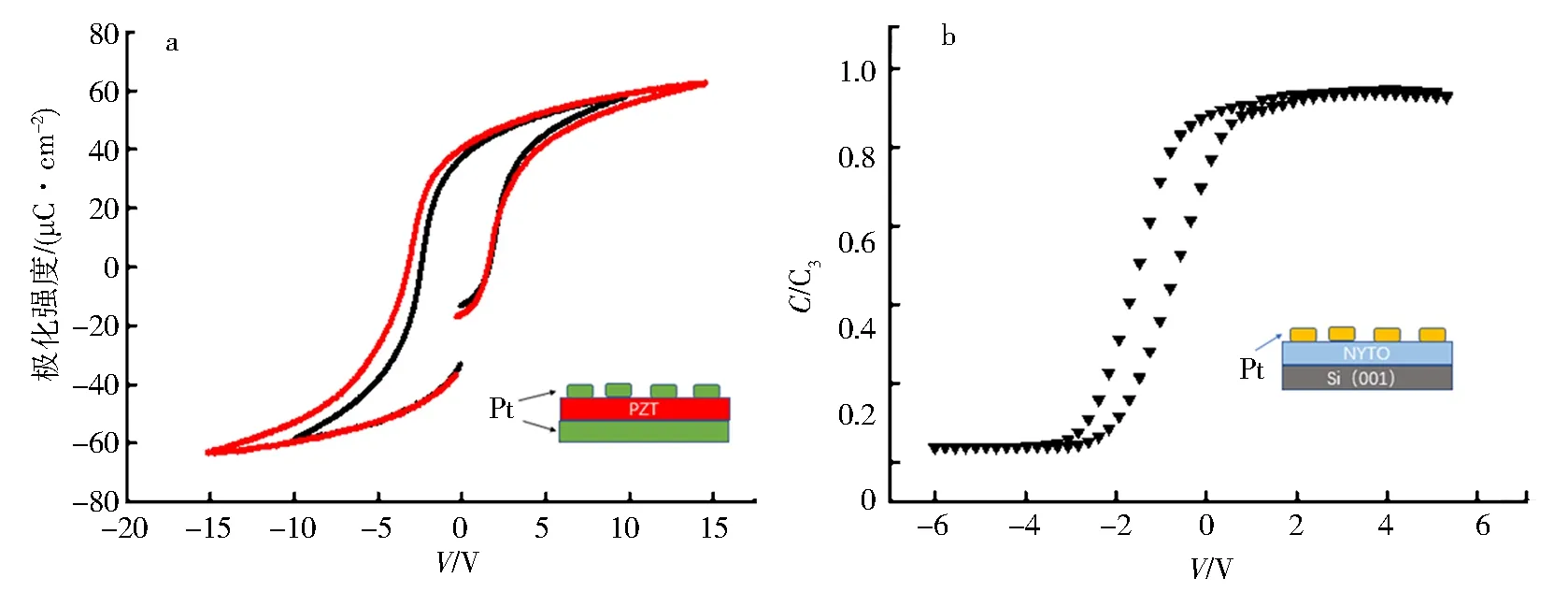
图1 Pt/PZT/Pt电容器的电滞回线(a)及Pt/NYTO/Si电容器的C-V曲线(b)Fig.1 Hysteresis loop of Pt/PZT/Pt capacitor (a) and C-V curves of Pt/NYTO/Si capacitors (b)
3.2 Pt/NYTO/Si电容器的介电性能分析
使用Agilent E4980 LCR表对制备的Pt/NYTO/Si电容器进行介电性能测试,测试结果如图1b所示.通过计算得出所制备的NYTO薄膜的介电常数为30,表明NYTO薄膜具有良好的介电特性.
3.3 XRD图和SEM图分析
使用X线衍射仪,对制备的MFIS电容器样品进行XRD测试分析.控制X线衍射仪的扫描角度为10°~55°.测试结果如图2a所示.从图2a可以看出,在扫描范围内,除了Pt (111)的峰和绝缘层NYTO的衍射峰以外,XRD图谱中有5个PZT衍射峰:(001)、(110)、(111)、(210)和(211),说明制备的PZT薄膜结晶良好,且结构为钙钛矿结构.

图2 Pt/PZT/NYTO/Si电容器的XRD衍射图(a)及Pt/PZT/NYTO/Si电容器的SEM截面(b)Fig.2 XRD patterns of Pt/PZT/NYTO/Si capacitors (a) and SEM section of Pt/PZT/NYTO/Si capacitor (b)
使用扫描电子显微镜SEM对制备的MFIS器件的截面进行扫描,扫描结果如图2b所示.从图2b中可以看出,PZT薄膜比较均匀,成膜质量较好,且与NYTO薄膜界限分明,2种薄膜材料之间并没有扩散或者反应活动的发生.
3.4 C-V特性分析
电容-电压(C-V)性能测试是评估电容器性能的重要手段.由于铁电层材料存在电滞特性,MFIS电容器的C-V曲线的形状是呈顺时针方向的回字形状[10],其C-V特性曲线中存在3个区域:积累区、耗尽区以及反型区.在C-V测试过程中,当电压从不同方向上扫描时,由于铁电层的存在,会使测试的平带电压发生平移,这就使C-V曲线也发生平移[11].平带电压的平移量称为记忆窗口(memory window)[12].而记忆窗口是MFIS电容器至关重要的性能指标,记忆窗口的宽窄程度则直接关系到MFIS电容器性能的好坏[13].图3a是绝缘层厚度为40 nm时Pt/PZT/NYTO/Si电容器在不同应用电压下的C-V特性曲线,从图中可以发现,MFIS电容器的C-V曲线的记忆窗口随应用电压的增大而增大,其中当Pt/PZT/NYTO/Si电容器的应用电压为32 V时,样品的记忆窗口为13 V.这可以说明很好地实现了Si基NYTO薄膜与PZT薄膜的集成.
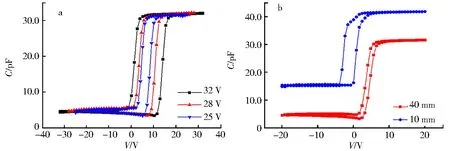
图3 不同应用电压下Pt/PZT/NYTO/Si电容器的C-V曲线(a)及绝缘层不同厚度下Pt/PZT/NYTO/Si电容器的C-V特性曲线(b)Fig.3 C-V curves of Pt/PZT/NYTO/Si capacitors at different application voltages (a) andC-V characteristic curves of Pt/PZT/NYTO/Si capacitors with different thickness of insulation layer (b)
关于记忆窗口的解释可通过铁电层的有效电场[14]Ef的概念说明,公式如下:
(1)
其中,UG为应用电压,df为铁电层的膜厚,di为绝缘层的膜厚,εf为铁电层的相对介电常数,εi为绝缘层的相对介电常数.从式(1)中可以推断出,有效电场Ef的值会随着应用电压的增大而增大,铁电层越来越达到饱和的状态,导致C-V特性曲线的记忆窗口变大.而有效电场Ef的值会随di的增加而减小,使铁电层的有效电场越来越小,铁电层越来越远离饱和的状态,导致C-V特性曲线的记忆窗口变小,这一点通过图3b可以得到证明,从图3b可以看出,当绝缘层NYTO的厚度从10 nm逐渐增加为40 nm,电容器的C-V特性曲线均变窄,其记忆窗口的数值变小,从4.55 V减小至2.86 V.这表明选择合适的绝缘层厚度是制备MFIS器件的关键.
3.5 I-V特性分析
电压-电流(I-V)测试是评测电容器电学性能优劣的重要指标,通过对电容器进行I-V测试及拟合,可以推断出其漏电特性[15]和导电机制.可以根据得到的导电机制来判断电容器的电流类型,去改善器件的性能.接下来使用Keithley2612 多功能表对Pt/PZT/NYTO/Si电容器的漏电特性进行测试.图4为对应测量的J-V特征曲线及拟合曲线,从图4a中可以看出,制备的电容器的漏电流较小,在测试电压为8 V时漏电流密度为1.08×10-6A/cm2.图4b为电容器漏电流的正半支的拟合图,通过对漏电流的拟合发现,推断其电流传导机制符合陷阱控制的空间电荷限制电流导电机制.

图4 Pt/PZT/NYTO/Si电容器的J-V曲线(a)及拟合曲线(b)Fig.4 J-V diagram of Pt/PZT/NYTO/Si capacitors (a) and fitted curve (b)
4 总结
通过将具备高介电特性的新型铁电薄膜NYTO薄膜作为MFIS器件的绝缘层,制备出Pt/PZT/NYTO/Si电容器,通过对其进行XRD测试和SEM扫描,得出制备的MFIS器件结构完整,且各层之间界限分明无扩散情况的发生;通过对其进行C-V测试,得出Pt/PZT/NYTO/Si电容器的绝缘层厚度为40 nm时,其记忆窗口的数值比较理想,当应用电压为32 V时记忆窗口为13 V,实现了Si基NYTO薄膜与PZT薄膜的集成;通过对其进行I-V测试,得出制备的MFIS器件具有较低的漏电流密度,为1.08×10-6A/cm2,且其电流传导机制符合陷阱控制的空间电荷限制电流导电机制.Pt/PZT/NYTO/Si电容器的成功制备,对非挥发非破坏性铁电存储器MFIS器件的研究具有非常重要的意义,使其有望成为一种重要的存储器件;此外NYTO薄膜的成功应用,也为新型无铅铁电材料的研究与应用提供了重要的参考意义.

