氮化镓基高电子迁移率晶体管单粒子和总剂量效应的实验研究*
陈睿 梁亚楠 韩建伟2) 王璇2) 杨涵2)陈钱2) 袁润杰2) 马英起2) 上官士鹏
1) (中国科学院国家空间科学中心, 北京 100190)
2) (中国科学院大学, 北京 100049)
利用重离子加速器和60Co γ射线实验装置, 开展了p型栅和共栅共源级联结构增强型氮化镓基高电子迁移率晶体管的单粒子效应和总剂量效应实验研究, 给出了氮化镓器件单粒子效应安全工作区域、总剂量效应敏感参数以及辐射响应规律.实验发现, p型栅结构氮化镓器件具有较好的抗单粒子和总剂量辐射能力, 其单粒子烧毁阈值大于37 MeV·cm2/mg, 抗总剂量效应水平高于1 Mrad (Si), 而共栅共源级联结构氮化镓器件则对单粒子和总剂量辐照均很敏感, 在线性能量传输值为22 MeV·cm2/mg的重离子和累积总剂量为200 krad (Si)辐照时, 器件的性能和功能出现异常.利用金相显微镜成像技术和聚焦离子束扫描技术分析氮化镓器件内部电路结构, 揭示了共栅共源级联结构氮化镓器件发生单粒子烧毁现象和对总剂量效应敏感的原因.结果表明,单粒子效应诱发内部耗尽型氮化镓器件的栅肖特基势垒发生电子隧穿可能是共栅共源级联结构氮化镓器件发生源漏大电流的内在机制.同时发现, 金属氧化物半导体场效应晶体管是导致共栅共源级联结构氮化镓器件对总剂量效应敏感的可能原因.
1 引 言
随着空间卫星、深空探测等航天技术的不断发展, 对于耐高温、大功率、小型化、适应极端辐射环境的电源系统需求日益明显[1-4].氮化镓(GaN)基功率器件作为宽禁带半导体技术的核心代表之一,相较于传统的硅器件具有击穿电压高、导通电阻小以及耐高温等优点, 可满足新一代航天器电源系统的应用需求.由于采用异质结层替代栅氧层工艺,GaN等宽禁带器件天然具有较好的抗总剂量效应(total ionizing dose effect, TID)能力, 但其对空间高能粒子导致的单粒子效应(single event effect, SEE)较为敏感[5-7].目前国内外针对GaN器件的总剂量效应研究相对较多, 主要涉及抗辐射GaN材料和工艺加固设计、p型栅结构增强型GaN器件的实验评估和影响因素研究.相关实验研究发现, 增强型GaN器件的抗总剂量水平可达到1 Mrad(Si), 并初步揭示了其总剂量辐射损伤机理[7-13].但目前有关共源共栅级联结构(Cascode)GaN高电子迁移率晶体管(high electron mobility transistor, HEMT)器件的总剂量效应研究报道较少, 尤其是对比研究不同电路结构GaN HEMT器件的总剂量效应的特征与规律尚存在明显不足.相对于总剂量效应, GaN器件单粒子效应研究相对薄弱, 主要集中在GaN器件单粒子失效模式和表现特征的实验研究, 以及相关辐射损伤机理研究存在不足, 严重制约了GaN器件在航天器电源系统的广泛应用.
本文针对GaN Systems公司p型栅结构和Transphorm公司共源共栅级联结构的增强型GaN HEMT器件, 利用重离子加速器和60Coγ射线分别进行了单粒子烧毁(single event burnout,SEB)效应和总剂量效应实验研究, 获得了GaN HEMT的辐射响应特征、敏感参数和区域, 并揭示了Cascode型GaN HEMT对SEB和总剂量辐射敏感的物理机理.
2 实验条件和样品
利用中国原子能科学院H-13串列加速器, 开展了GaN HEMT的SEB效应研究.辐照离子分别为能量169 MeV的48Ti离子和210 MeV的74Ge离子, 线性能量传输值(linear energy transfer, LET)分别为21.8和37 MeV·cm2/mg, 束流强度和注量分别为2 × 104cm—2/s和5 × 106cm—2.利用北京大学60Coγ射线总剂量实验模拟源, 开展了GaN HEMT的总剂量效应研究, 辐照剂量率为100 rad(Si)/s, 累积辐照总剂量分别为200 krad(Si),500 krad(Si) 和1 Mrad(Si), 辐照实验参数采用在线测试.总剂量辐照后采用室温168 h退火测试,单粒子和总剂量实验现场图如图1所示.

图1 实验现场 (a)单粒子效应实验现场; (b)总剂量效应实验现场Fig.1.Experiment setup: (a) SEE experiment; (b) TID experiment.
单粒子效应和总剂量效应实验样品分别选用同一批次GaN Systems公司650 V GS0650111L型和Transphorm公司900 V TP90H180PS型的GaN HEMT各5片, 正面开封图如图2所示, 实验样品信息如表1所列.单粒子效应实验器件均经过正面开盖处理且功能测试正常.GaN HEMT单粒子效应和总剂量效应的辐照实验电路参照MILSTD-750D标准, 如图3所示, 在器件漏源端和栅源端分别通过串联电阻和并联电容接入Keithley2470和2450型圆表, 用来提供器件的偏置电压和监测器件漏源端电流、阈值电压等电学参数变化.GaN HEMT单粒子效应实验偏置条件采用关态偏置: 漏源电压Vds为0—650 V(900 V), 栅源电压Vgs为—5, —3, —1和0 V.总剂量效应实验偏置条件采用关态和开态两种偏置, 其中关态偏置:Vds与Vgs均为0 V, 开态偏置:Vgs为2.6 V,Vds为1 V.

图2 GaN器件开封装图 (a) GS0650111L; (b) TP90H-180PSFig.2.The decapping photograph of GaN device: (a) GS0-650111L; (b) TP90H180PS.

表1 实验样品的参数Table 1.Parameters of the tested sample.

图3 单粒子和总剂量效应实验电路原理图Fig.3.Schematic diagram of SEE and TID test circuit.
3 实验结果
3.1 单粒子效应实验结果
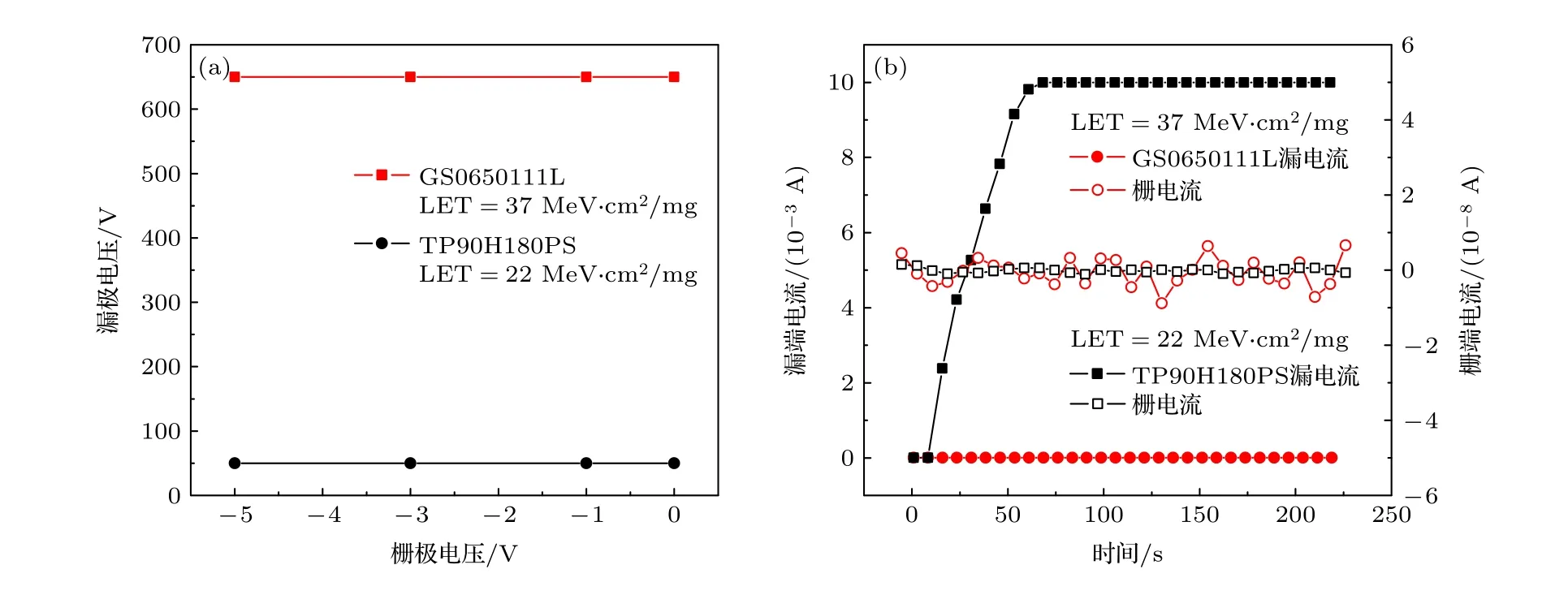
图4 (a) GS0650111L和TP90H180PS器件安全工作区域; (b)漏、栅端电流随时间的变化Fig.4.(a) Safe operating area of GS0650111L and TP90H180PS; (b) the variations of drain current and gate current with time.
图4 (a)给出了GS0650111L和TP90H180PS器件分别在能量为210 MeV的Ge (LET值为37 MeV·cm2/mg)和能量为169 MeV的Ti (LET值为22 MeV·cm2/mg)离子辐照下, 器件漏源电压Vds随栅源电压Vgs的变化关系, 即器件SEB效应的安全工作区域.当入射粒子LET值分别为37和22 MeV·cm2/mg时, 随着器件的栅极电压Vgs从—5 V增加到0 V, GS0650111L和TP90H-180PS器件的漏极电压Vds分别保持650和50 V不变.GS0650111L和TP90H180PS器件漏端电流Id和栅端电流Ig随辐照时间的变化如图4(b)所示, 在粒子LET值为37 MeV·cm2/mg辐照下,GS0650111L器件漏极电压为650 V时, 器件漏端电流Id和栅端电流Ig未出现明显变化, 而当粒子LET值降为22 MeV·cm2/mg, 器件漏极电压为100 V时, TP90H180PS器件漏端电流Id随时间不断增大, 直到限流值10 mA, 栅端电流基本保持不变, 表现出明显的漏端大电流现象.
图5为TP90H180PS器件发生SEB效应的实物图, 从图5(a)可以发现Cascode结构中的耗尽型GaN HEMT出现了SEB现象, 且主要发生在插指结构的金属布线层上, 而硅(Si)金属氧化物场效应晶体管(metal oxide semiconductor field effect transistor, MOSFET)未出现SEB现象.图5(b)所示为利用金相显微镜拍照分析提取的器件SEB区域细节, 可以看到器件金属布线层中的栅区域和漏区域之间出了明显的烧毁现象.

图5 TP90H180PS器件发生SEB的实物图 (a) SEB敏感区域; (b) SEB区域局部示意图Fig.5.The SEB photograph of TP90H180PS: (a) SEB sensitive areas; (b) partial enlargement of SEB sensitive areas.
3.2 总剂量效应实验结果
图6 所示为TP90H180PS和GS0650111L器件工作在开态和关态偏置时, 器件漏电流随辐照累积剂量的变化.当器件工作在开态偏置条件时,从图6(a)可以看到, 随着辐照累积剂量增大到200 krad(Si)时, GS0650111L器件的漏电流从正常工作电流约2.1 nA增大到约150 μA, 当辐照剂量累积到1 M rad(Si)时, 器件漏电流减小约为75 μA.之后, 随着退火时间增加, 器件漏电流不断减小, 当经过约50 h的室温退火后, 器件的漏电流基本上恢复至正常工作电流值, 而TP90H180PS器件在辐照剂量累积到1 Mrad(Si)时, 器件的漏电流基本未发生变化.当器件工作在关态偏置条件下, 漏电流约为20 nA.从图6(b)可以看到, 当辐照累积剂量增加到1 Mrad (Si)时, GS0650111L器件漏电流基本保持不变, 随后经过168 h的退火后, 器件的漏电增大到约15 μA, 此时器件的功能正常.TP90H180PS器件随着辐照累积剂量增加,漏电流在不断增加, 累积剂量为1 Mrad (Si)时,漏电流增大到约10 μA, 但经过168 h小时的室温退火后, 漏电流恢复至正常工作电流值附近.
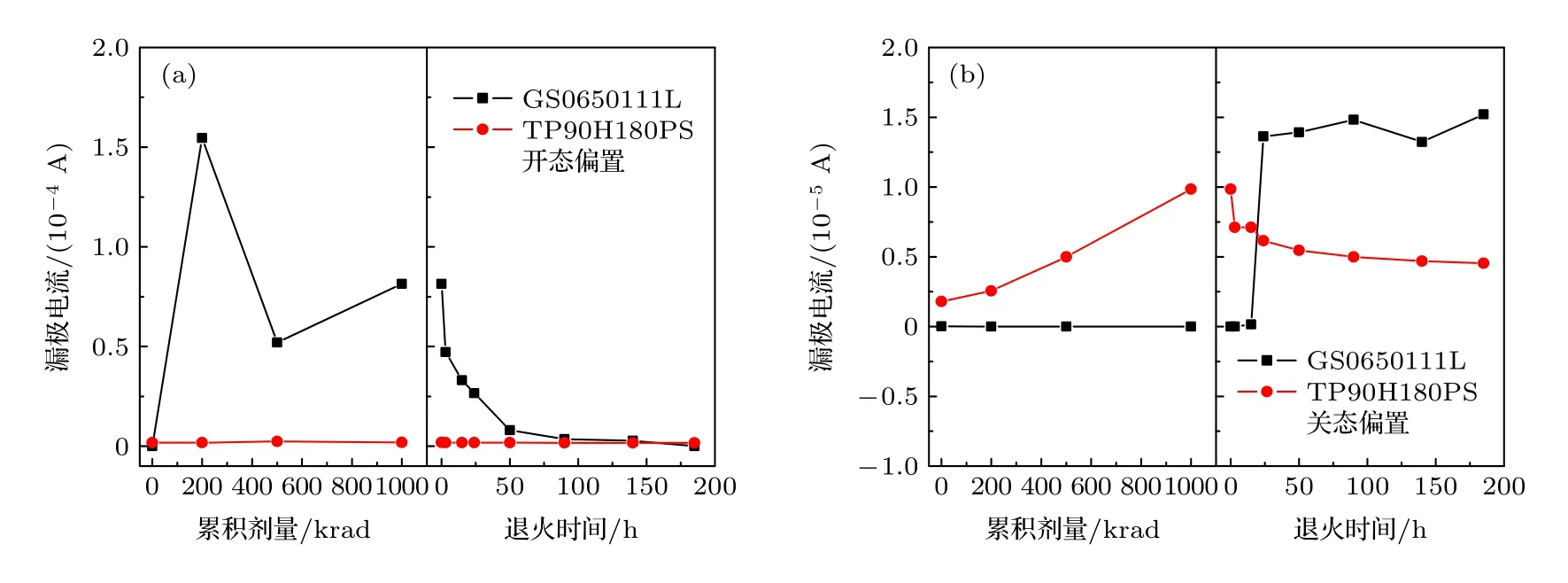
图6 器件漏极电流随辐照累积剂量及退火时间(168 h)的变化 (a)开态偏置; (b)关态偏置Fig.6.The variations of drain current with cumulative dose and annealing time: (a) On-state bias; (b) off-state bias.
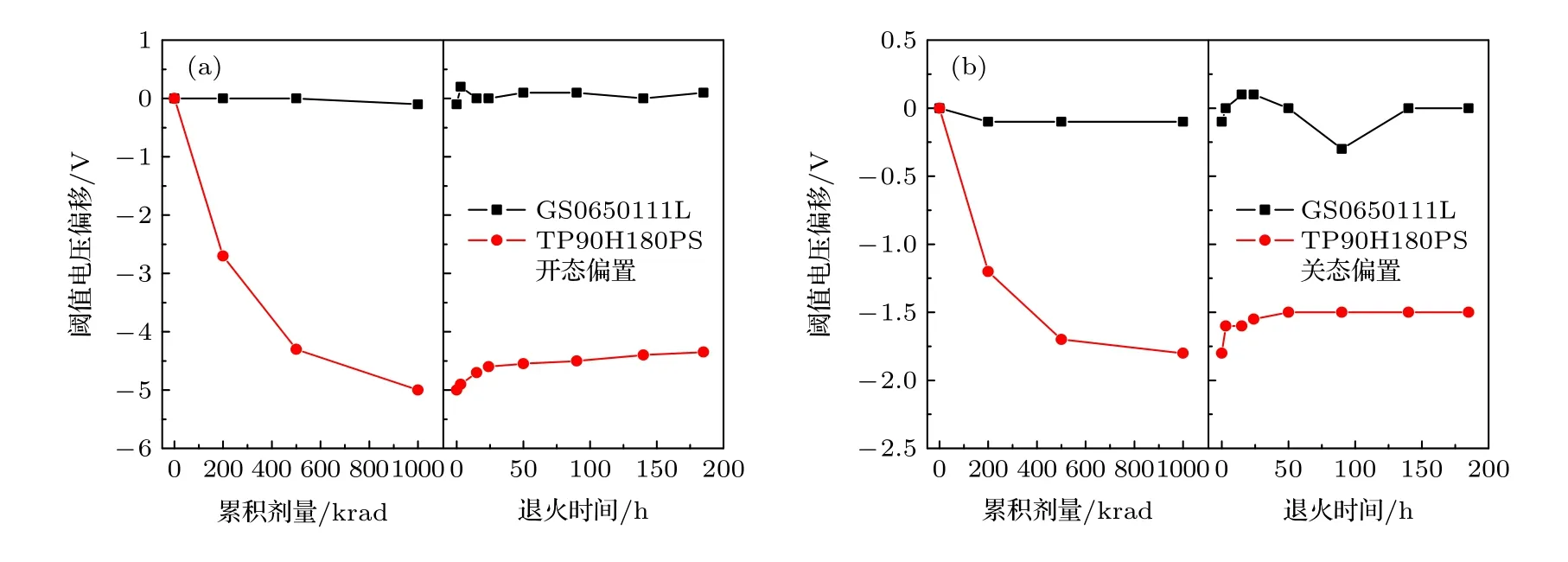
图7 器件阈值电压随辐照累积剂量及退火时间(168 h)的变化关系 (a)开态偏置; (b)关态偏置Fig.7.The variations of threshold voltage with cumulative dose and annealing time: (a) On-state bias; (b) off-state bias.
在开态和关态辐照偏置时, TP90H180PS和GS0650111L器件阈值电压随辐照累积剂量的变化如图7所示.从图7(a)可以看到, 当辐照时器件工作在开态偏置条件时, 随着辐照累积剂量增大到1 Mrad (Si)时, TP90H180PS器件的阈值电压负向偏移约为5 V, GS0650111L器件阈值电压基本保持不变.当经过168 h室温退火后, TP90H180PS器件的阈值电压仍处于负向偏移状态, 器件的功能出现异常.当器件工作在关态偏置条件下, 由图7(b)可见, 辐照累积剂量增加到1 Mrad(Si)时,TP90H180PS器件的阈值电压负向偏移量约为1.7 V, 且经168 h的退火仍未恢复, 此时器件的功能异常, GS0650111L器件随着辐照累积剂量增加,其阈值电压基本保持不变.
4 讨 论
4.1 单粒子效应
从图4中在不同LET值辐照下, TP90H180PS和GS0650111L器件漏端和栅端电流随时间的变化可以发现, 相对于p型栅结构, Cascode结构的GaN器件对单粒子效应更加敏感.在LET值为22 MeV·cm2/mg的粒子辐照下, TP90H180PS器件工作电压从900 V衰减到50 V, 下降近95%,此时器件的漏极电流出现明显的增大, 而栅极电流基本保持不变.
重离子辐照后, TP90H180PS器件在关态模式下, 器件的栅、漏电流随漏端电压的变化如图8所示.可以看到, 器件的栅极电流仍保持在纳安量级, 即器件的栅源端处于截止状态, 而随着漏极电压增加, 器件的漏极电流在不断增大, 即表明器件漏源区域之间存在导电通道.进一步对图9(a)所示的Cascode GaN器件内部电路结构分析可得,TP90H180PS型GaN器件电路由低压增强型Si MOSFET和高压耗尽型GaN HEMT共源极、共栅极级联组成.当器件处于反偏截止状态时, 低压增强型Si MOSFET截止, 高压耗尽型GaN HEMT的漏极、栅极以及Si MOSFET的源极可形成TP90H180PS器件的源漏漏电路径, 导致器件源漏端出现大电流现象, 这可能是图5中TP90H-180PS器件SEB区域主要在高压耗尽型GaN HEMT的主要原因.此外, 分析图9所示的耗尽型GaN HEMT的剖面结构[14]可以发现, GaN器件的源端、栅端和漏端通过AlGaN势垒层和GaN沟道层隔离(二者之间形成了二维电子气).由于GaN器件栅源端接地, 内部Si MOSFET处于截止状态, 在耗尽型GaN HEMT和Si MOSFET G_Si及D_Si构成的电流路径上电流极小, 即GaN器件栅极电流很小.当重离子入射耗尽型GaN HEMT时, 在粒子入射的径迹上势必产生大量的电子空穴对, 由于耗尽型GaN HEMT的漏栅极之间存在高压偏置, 导致辐射诱发的载流子向器件AlGaN层不断注入, 随着辐射诱发的电子浓度在AlGaN势垒层中不断积累, 栅电极与半导体形成的肖特基势垒宽度不断减小, 促使辐射诱发的电子隧穿栅势垒[15-17], 形成耗尽型GaN HEMT的漏端、栅端和Si MOSFET源端的大电流路径, 与图5(b)中耗尽型GaN器件栅漏端之间出现SEB的现象一致.

图8 重离子辐照后关态模式下Cascode器件的栅漏电流随漏极电压的变化Fig.8.The variations of gate/drain current with drain voltage for Cascode device in off-state mode after heavy ion irradiation.
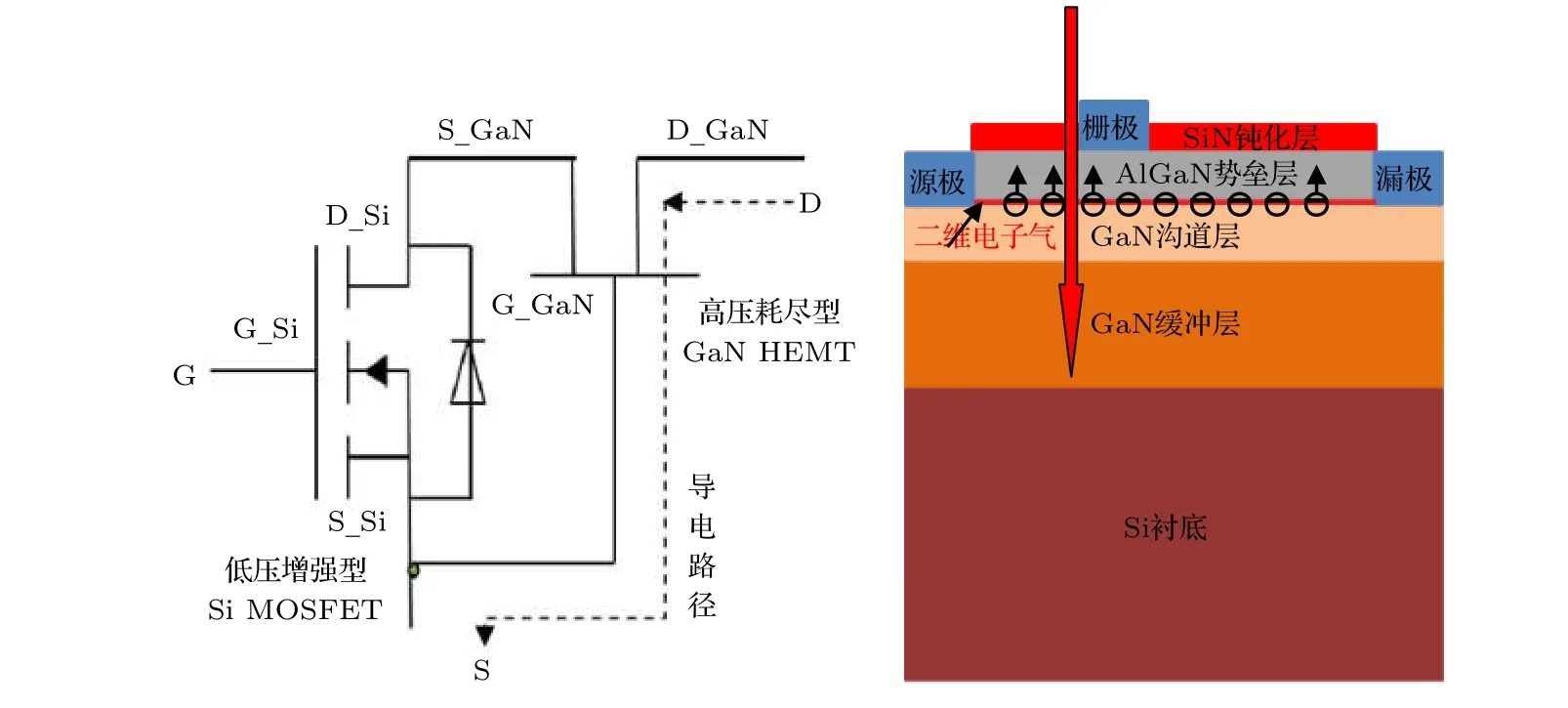
图9 (a) Cascode型GaN HEMT电路结构原理图; (b)耗尽型GaN HEMT的剖面示意图Fig.9.(a) The circuit schematic diagram of Cascode type GaN HEMT device; (b) the cross-section diagram of the depletion type GaN HEMT.

图10 p型栅GaN HEMT的剖面示意图Fig.10.The cross-section diagram of the p-type gate GaN HEMT.
p型栅结构GaN HEMT的剖面结构如图10所示.二维电子气存在于AlGaN势垒层和GaN沟道层之间, 通过施加栅极电压控制p型GaN和n型AlGaN形成PN结的导通与截止, 实现GaN HEMT的开关特性.当重离子入射GaN HEMT时, 辐射诱发的电子相对较难连续穿过AlGaN势垒层和p型GaN, 形成类似耗尽型GaN HEMT的栅漏端大电流通道.相关的研究报道发现, 单粒子入射p型栅GaN HEMT可能会导致器件AlGaN势垒层局部出现缺陷, 造成器件源漏端漏电增大.当漏电流增大到一定的程度时, 会导致器件的介质层被击穿, 进而出现大电流现象.但通过聚焦离子束扫描技术(focused ion beam, FIB)发现, GS065-0111L器件的介质层厚度远大于1 μm, 较难被单粒子辐射感生载流子形成的电场击穿, 这可能是p型栅结构GaN HEMT单粒子烧毁LET阈值相对较高的原因.
4.2 总剂量效应
分析图6和图7可发现, 与国内外相关GaN HEMT的总剂量实验研究报道相一致, p型栅结构的GS0650111 L型GaN器件具有较强抗总剂量效应能力, 在辐照总剂量累积到1 Mrad(Si)时,在开态和关态偏置条件下, 器件的漏电流和阈值电压基本保持不变.室温退火时, 器件的漏电流略有增加, 但器件的输出和转移功能正常.由图9(b)和图10(a)中所示的GaN HEMT剖面图可发现,GaN HEMT主要通过AlGaN势垒层和GaN沟道层之间极化的二维电子气漂移扩散产生电流, 不存在栅氧化层工艺, 总剂量效应主要通过在p型GaN和SiN钝化层界面或AlGaN势垒层和GaN沟道层界面处产生额外的感生界面陷阱电荷, 进而影响器件的性能参数与功能[18].由于GaN HEMT界面层厚度较薄且界面陷阱电荷迁移率较低, 极大地抑制了总剂量辐射诱发界面陷阱电荷的数量和作用范围, 这可能是p型栅结构GaN HEMT对总剂量辐射不敏感的主要原因.此外, 由于总剂量效应累积剂量较高, 总剂量辐射感生的界面陷阱在室温退火时可能会继续增长, 进而造成器件漏极电流增加[19].
与p型栅GaN HEMT的总剂量辐射响应特征相反, Cascode结构的TP90H180PS型GaN HEMT在开态和关态偏置条件下, 均表现出对总剂量效应较为敏感.在开态偏置条件下, 当辐照总剂量累积到200 krad(Si)时, 器件的漏电流和阈值电压出现明显增加; 在关态偏置条件下, 器件的漏电流在累积剂量为500 krad(Si)时显著增加, 器件功能出现异常.分析TP90H180PS型GaN HEMT的内部电路结构可知, 器件漏电流、阈值电压、开关频率等性能参数均受低压NMOSFET的影响.众所周知, 商用Si NMOSFET对总剂量效应非常敏感, 通常会造成器件的漏电流增加和阈值电压负向偏移[20].这可能是总剂量效应导致TP90H180-PS型GaN器件漏电流增加和阈值电压负向偏移的主要原因.
5 结 论
本文利用重离子加速器和60Coγ射线实验装置, 分别开展了p型栅和Cascode结构增强型GaN HEMT的单粒子效应和总剂量效应实验研究.研究获得了不同结构GaN HEMT的单粒子效应响应特征及安全工作区域, 获得了不同工作模式下, 不同结构GaN HEMT的总剂量效应表现特征与规律.值得注意的是, 研究发现p型栅结构GaN HEMT具有较强的抗单粒子和总剂量能力, 但是Cascode结构的GaN HEMT对单粒子效应和总剂量效应均很敏感.实验研究揭示了单粒子辐射诱发耗尽型GaN HEMT栅极肖特基势垒发生电子隧穿可能是导致Cascode结构GaN HEMT出现SEB的内在机制, 以及Si NMOSFET是导致Cascode结构GaN HEMT对总剂量效应敏感的可能原因.

