旋涂法制备氧化锆介质层及其在薄膜晶体管中的应用
钟云肖, 周尚雄, 姚日晖, 蔡 炜, 朱镇南,魏靖林, 徐海涛, 宁洪龙*, 彭俊彪
(1. 高分子光电材料与器件研究所, 发光材料与器件国家重点实验室, 华南理工大学 材料科学与工程学院, 广东 广州 510640; 2. 华南农业大学 电子工程学院, 广东 广州 510642)
1 引 言
薄膜晶体管(Thin film transistor,TFT)是一种三端场效应器件,可以组成显示的驱动电路从而实现平板显示产业大尺寸、超高清和全彩高刷新显示。TFT中绝缘层能起到存储电容和防止信号串扰等作用,其不仅影响TFT器件的转移性能,同时影响稳定性和寿命等。早期TFT器件主要采用SiO2作为绝缘层材料,但随着集成电路中晶体管特征尺寸的逐渐减小,隧道效应产生的较大漏电流使得SiO2栅介质丧失了良好的绝缘效果[1]。为了进一步降低器件尺寸,同时提高电学性能、降低漏电流和能耗,人们迫切需要找到一种更加合适的高介电材料(即High-k材料),以取代SiO2作为晶体管的栅介质。
相比于其他介电绝缘材料(SiO2,HfO2,Y2O3, Al2O3[2-5]等),ZrO2有高的相对介电常数(~27)、较宽的禁带(7.8eV),且具有硬度高、韧性好、抗腐蚀、高温化学稳定性好[6]等特性,是一种常用的介质层材料。较高的介电常数使得ZrO2薄膜在相同厚度下,可以有效地提高电容密度,这将有效地减少穿过栅介质层的直接隧穿电流,并且可以提高栅介质的可靠性[7-8]。同时ZrO2薄膜优异的绝缘性可以降低关态电流。因此,制得的IGZO-TFT具有稳定性好、阈值电压低、亚阈值摆幅小和迁移率高等特点。基于以上考虑,以及ZrO2薄膜具有简单的制备方法,本实验选择ZrO2为绝缘层,制备IGZO-TFT。
传统工艺中金属氧化物薄膜的制备依赖于真空制备技术,如气相沉积、磁控溅射等,从而造成制备成本高、加工速度慢且需要复杂的光刻过程。相比而言,利用旋涂法制备的薄膜具有膜厚度精确可控、性价比高、节能、污染低等优点,因此旋涂法制备金属氧化物薄膜吸引了越来越多的关注[9-14]。2013年,Li等[1]在玻璃衬底上制备了以ZrO2为绝缘层的TFT器件,器件开关比为104,饱和迁移率为0.8cm2/(V·s);2016年,Cho等[15]利用旋涂法制备了ZrO2绝缘层,测得当电压为-10V时,漏电流密度为5.18×10-6A/cm2,最终制备的IGZO-TFT迁移率为0.604cm2/(V·s)。
目前关于旋涂氧化锆薄膜及其在TFT器件中应用的研究较少,同时缺乏旋涂参数影响的探究。本文采用溶液法制备氧化锆薄膜,通过XRD、XPS等方式测试氧化锆薄膜的电学性能与薄膜结构,探讨了旋涂转速以及退火温度对薄膜性能的影响。经过优化后制备的氧化锆薄膜粗糙度为0.7nm,当电场强度为1MV/cm时,漏电流为3.13×10-5A/cm2。利用旋涂的氧化锆薄膜在玻璃基板上制备了铟镓锌氧化物-薄膜晶体管(IGZO-TFT),其迁移率为6.5cm2/(V·s),开关比达到2×104。
2 实验过程
以ZrOCl·8H2O为溶质、乙二醇单甲醚(2-MOE)为溶剂配制溶液,室温下搅拌2h后老化24h。氧化锆溶胶过滤后滴在ITO玻璃上,用KW-4A型匀胶机将溶胶均匀甩开,选取不同的旋涂转速作为实验变量,旋涂后进行预退火,重复进行多次旋涂。多次旋涂完毕后经过高温后退火以得到均匀、致密的绝缘层薄膜,选取不同后退火温度为实验变量。最后在氧化锆介质层上通过溅射的方式层积IGZO有源层和Al源漏电极以制备完整TFT器件。
采用PANalytical锐影X射线反射(XRR)系统测试薄膜的物相、厚度、密度和粗糙度等;Multimode8原子力显微镜(AFM)用于观察薄膜的表面形貌; ESCALAB250Xi X射线光电子能谱(XPS)用于进行薄膜成分分析;Agilent E4980A和Agilent B1500A分别用于测试 MIM器件 (ITO/氧化锆绝缘层/Al)的电容-电压特性、电流-电压特性,测试中ITO与Al分别作为电极与探针接触;Agilent4155C测试TFT器件的输出特性和转移特性。
3 结果与分析
3.1 退火温度对薄膜性能的影响
在溶液法制备薄膜的过程中,高温后退火可以移除湿膜中的杂质副产物等,以形成稳定均一的薄膜。退火后的氧化锆薄膜除ZrO2外,还含有氧化锆水合物,对氧化锆薄膜的后期高温处理一方面使氧化锆水合物脱水形成氧化锆,另一方面促使氧化锆结晶。为了探究不同的退火温度对薄膜性能的影响,将旋涂后的薄膜分别置于300,400,500℃下退火1.5h,并利用MIM结构 (ITO/ZrO2/Al)测试薄膜的电学特性。表1是不同退火温度的薄膜的电学数据,可以看出,300℃后退火的薄膜具有更好的介电特性,其中漏电流密度为1×10-4A/cm2,击穿电压为15V。

表1 不同退火温度的薄膜的漏电流数据
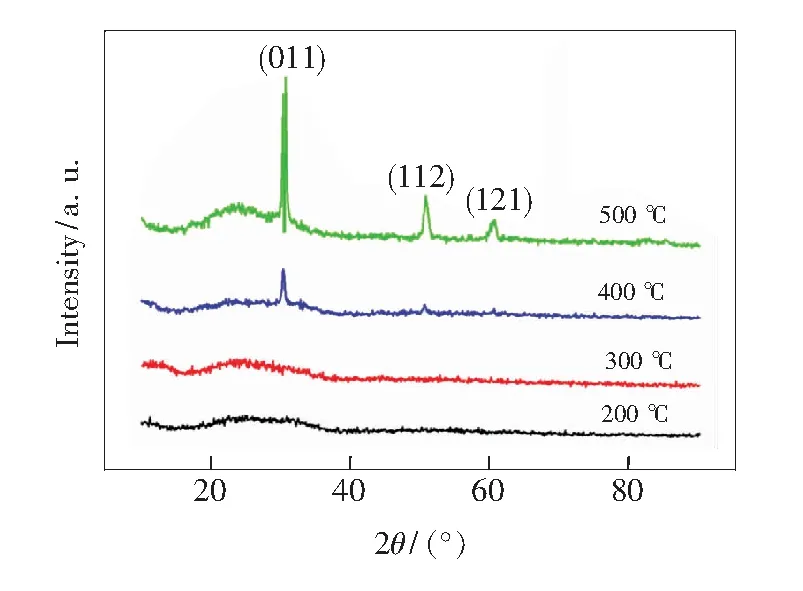
图1 不同退火温度ZrO2薄膜的XRD图谱
Fig.1 XRD spectra of ZrO2films annealed at different temperatures
图1是不同退火温度的薄膜的XRD图谱。300 ℃退火的薄膜呈现非晶态,当退火温度超过400 ℃时,氧化锆薄膜出现结晶态。可以看出结晶态的绝缘层具有更高的漏电流,一方面是因为富含缺陷的晶界为电子和杂质流动提供了快速的通道,另一方面是结晶态下薄膜表面粗糙度增加使得接触特性变差[16]。将退火温度控制在薄膜结晶温度以下进行实验,退火温度从200 ℃升高至300 ℃,其漏电流密度由8×10-4A/cm2下降到1×10-4A/cm2。可以发现对于非晶态绝缘层薄膜,退火温度升高,薄膜的杂质缺陷减少,漏电流密度减小。
3.2 转速对薄膜性能的影响
在溶液法制备薄膜的过程中,旋涂转速、前驱体粘度等是薄膜厚度及粗糙度的决定性因素,这些因素又进而影响了绝缘层薄膜的漏电流密度。为了探究不同的旋涂转速对薄膜性能的影响,实验中采用控制变量法,在不同转速条件下进行旋涂制膜,旋涂后的薄膜在300 ℃下退火1.5 h。利用X射线反射(XRR)系统测试薄膜厚度、密度和粗糙度,利用MIM结构 (ITO/ZrO2/Al)测试薄膜的电流-电压特性。
前驱体溶液不同旋涂转速下制备的ZrO2薄膜的性能参数如表2所示,从表中数据可以看出随转速的增加,ZrO2薄膜的膜厚、粗糙度降低。转速在4 000 r/min以下时,其改变对膜厚、粗糙度以及漏电流密度有明显影响;转速从4 000 r/min增加到5 000 r/min时,厚度、粗糙度以及漏电流密度分别从77.99 nm、0.457 nm和1.34×10-3A/cm2变为68.84 nm、0.421 nm和3.13×10-5A/cm2;当转速超过5 000 r/min时,其变化对膜厚、粗糙度以及漏电流密度影响不大。根据Meyerhofer[17]提出的旋涂溶剂挥发模型,挥发速率、转速和初始粘度等因素与膜厚度的变化成一定比例关系,如公式(1)、(2)所示:
(1)
e∝ω1/2,
(2)
其中e为溶剂挥发速率,ω为角速度,v0为初始粘度,随着旋涂转速的增大,相应制备薄膜的厚度越薄。同时,当转速较大时,膜厚随转速的变化率较低。粗糙度减少可以使绝缘层薄膜与电极、有源层结合更加紧密,抑制界面电子陷阱,有利于减少载流子散射中心和提高有源层的场效应迁移率[18-20],同时也可以降低TFT的阈值电压,提高器件开关比[21-22]。粗糙度降低到一定程度后,其变化对器件性能的影响减弱,因此在后续的实验中转速选取为5 000 r/min。

表2 不同旋涂转速下薄膜的性能参数
3.3 旋涂氧化锆薄膜在TFT中的应用
分析各参数对旋涂氧化锆薄膜的影响后,选取较优的实验参数,转速为5 000 r/min,退火温度为300 ℃制备氧化锆薄膜。图2为旋涂氧化锆薄膜的AFM扫描图,可以看出制备的薄膜结构致密、均匀,没有孔洞、微裂纹等缺陷,其中测得RMS为0.7 nm。当电场强度为1 MV/cm时,利用MIM结构(ITO/氧化锆绝缘层/Al)测得薄膜的漏电流仅为3.13×10-5A/cm2。
利用旋涂氧化锆薄膜制备底栅顶结构的TFT 器件,其中栅极为ITO,厚度约为150 nm,栅极上旋涂氧化锆薄膜,接着溅射10 nm IGZO有源层以及100 nm Al源漏电极。图3是TFT器件的结构图以及TEM 截面图。用TEM进行样品分析,测得ITO侧面蚀刻角约为18°02′,ITO斜坡ZrO2薄膜厚度为123 nm, ITO顶部ZrO2薄膜厚度为116 nm,厚度差仅为7 nm,台阶对旋涂薄膜厚度影响不大,工艺具有较强的台阶覆盖能力,适用于堆栈式电子器件的制备。测量器件单层薄膜厚度,可知ITO厚度为139 nm,ZrO2厚度为116 nm,IGZO厚度为7 nm,Al厚度为95 nm,与实验拟定薄膜厚度相差较小,膜厚在一定误差范围内可控。观察TEM局部放大图,可以看出氧化锆层的界面明显,与上下两层的结合紧密,内部不存在孔洞等缺陷,且上界面光滑程度高,为高质量IGZO半导体薄膜的获得提供了保障。图4是TFT器件的输出特性和转移特性,器件迁移率为6.5 cm2/(V·s),开关比为2×104。

图2 氧化锆薄膜的AFM图

图3 (a) TFT器件的结构图;(b) TFT器件的TEM 截面图。
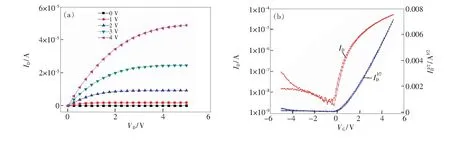
图4 (a)IGZO TFT器件的输出特性;(b) IGZO TFT器件的转移特性。
4 结 论
在不同的条件下旋涂制备氧化锆薄膜,通过分析氧化锆薄膜的表面形貌、成分、物相及电学特性,可以得出:(1)高温后退火可以使氧化锆水合物脱水形成氧化锆同时促使氧化锆结晶,当退火温度高于300 ℃时,薄膜出现结晶态使得薄膜漏电流增加。(2)退火温度在绝缘层薄膜结晶温度以下时,退火温度越高,薄膜的杂质缺陷越少,漏电流密度越小。(3)转速较低时,转速的改变对膜厚和粗糙度影响较大, 4 000 r/min与5 000 r/min制备的薄膜膜厚相差9 nm,粗糙度分别为0.457 nm和0.421 nm。当转速超过5 000 r/min时,其变化对膜厚及粗糙度影响不大。
通过优化实验条件发现,当转速为5 000 r/min、退火温度为300 ℃时,可获得低粗糙度、低漏电和高相对介电常数的ZrO2介电层,薄膜的漏电流为3.13×10-5A/cm2。在玻璃基板上制备IGZO-TFT器件,其迁移率为6.5 cm2/(V·s),开关比为2×104。
[1] LI X F, XIN E L, ZHANG J H. Low-temperature solution-processed zirconium oxide gate insulators for thin-film transistors [J].IEEETrans.ElectronDev., 2013, 60:3413-3416.
[2] LIN W K, LIU K C, CHANG S T,etal.. Room temperature fabricated transparent amorphous indium zinc oxide based thin film transistor using high-kappa HfO2as gate insulator [J].ThinSolidFilms, 2012, 520:3079-3083.
[3] BOBADE S M, SHIN J H, CHO Y J,etal.. Room temperature fabrication oxide TFT with Y2O3as a gate oxide and Mo contact [J].Appl.Surf.Sci., 2009, 255:7831-7833.
[4] 朱乐永, 高娅娜, 张建华, 等. 溶胶凝胶法制备以HfO2为绝缘层和ZITO为有源层的高迁移率薄膜晶体管 [J]. 物理学报, 2015, 64(16):441-447.
ZHU L Y, GAO Y N, ZHANG J H,etal.. High mobility thin film transistors with solution-processed hafnium-oxide and zinc-indium-tin-oxide semiconductor [J].Chin.Phys.Sinica, 2015, 64(16):441-447. (in Chinese)
[5] CHEN R S, ZHOU W, ZHANG M,etal.. High performance self-aligned top-gate ZnO thin film transistors using sputtered Al2O3gate dielectric [J].ThinSolidFilms, 2012, 520:6681-6683.
[6] JEON T S, WHITE J M, KWONG D L. Thermal stability of ultrathin ZrO2films prepared by chemical vapor deposition on Si(100) [J].Appl.Phys.Lett., 2001, 78:368-370.
[7] KIM Y H, HEO J S, KIM T H,etal. Flexible metal-oxide devices made by room-temperature photochemical activation of sol-gel films [J].Nature, 2012, 489:128-191.
[8] LIU G X, LIU A, ZHU X X,etal.. Low-temperature, nontoxic water-induced metal-oxide thin films and their application in thin-film transistors [J].Adv.Funct.Mater., 2015, 25:2564-2572.
[9] SON B G, JE S Y, KIM H J,etal.. High-performance In-Zn-O thin-film transistors with a soluble processed ZrO2gate insulator [J].Phys.Stat.Sol.-Rap.Res.Lett., 2013, 7:485-488.
[10] PARK Y M, DANIEL J, HEENEY M,etal.. Room-temperature fabrication of ultrathin oxide gate dielectrics for low-voltage operation of organic field-effect transistors [J].Adv.Mater., 2011, 23:971-974.
[11] SONG K, YANG W, JUNG Y,etal.. solution-processed yttrium oxide gate insulator for high-performance all-solution-processed fully transparent thin film transistors [J].J.Mater.Chem., 2012, 22:21265-21271.
[12] TSAY C Y, CHENG C H, WANG Y W. Properties of transparent yttrium oxide dielectric films prepared by sol-gel process [J].Ceram.Int., 2012, 38:1677-1682.
[13] AVIS C, JANG J. High-performance solution processed oxide TFT with aluminum oxide gate dielectric fabricated by a sol-gel method [J].J.Mater.Chem., 2011, 21:10649-10652.
[14] 钟云肖, 谢宇, 周尚雄, 等. 溶液法氧化物薄膜晶体管的印刷制备 [J]. 液晶与显示, 2017, 32(6):443-454. ZHONG Y X, XIE Y, ZHOU S X,etal.. Oxide semiconductor thin film transistor device print fabrication based on solution method [J].Chin.J.Liq.Cryst.Disp., 2017, 32(6):443-454. (in Chinese)
[15] CHO J, CHOI P, LEE N,etal.. Dielectric properties of solution-processed ZrO2for thin-film transistors [J].J.Nanosci.Nanotechnol., 2016, 16:10380-10384.
[16] BARQUINHA P, PEREIRA L, GONCALVES G,etal.. Performance and stability of low temperature transparent thin-film transistors using amorphous multicomponent dielectrics [J].J.Electrochem.Soc., 2009, 156:H824-H831.
[17] MEYERHOFER, D. Characteristics of resist films produced by spinning [J].J.Appl.Phys., 1978, 49:3993-3997.
[18] LEE J M, CHOI B H, JI M J,etal.. The improved performance of a transparent ZnO thin-film transistor with AlN/Al2O3double gate dielectrics [J].Semicond.Sci.Technol., 2009, 24(5):055008.
[19] OH B Y, JEONG M C, HAM M H,etal.. Effects of the channel thickness on the structural and electrical characteristics of room-temperature fabricated ZnO thin-film transistors [J].Semicond.Sci.Technol., 2007, 22(6):608-612.
[20] KIM C S, JO S J, LEE S W,etal.. Low-voltage organic transistors: the effect of a spin-coated smoothing layer on device performance [J].Semicond.Sci.Technol., 2006, 21(8):1022-1025.
[21] NGUYEN C P T, RAJA J, KIM S B,etal.. Enhanced electrical properties of oxide semiconductor thin-film transistors with high conductivity thin layer insertion for the channel region [J].Appl.Surf.Sci., 2017, 396:1472-1477.
[22] 董俊辰, 郁文, 李慧津, 等. 高性能钆铝锌氧薄膜晶体管的制备 [J]. 液晶与显示, 2017, 32(5):339-343.
DONG J C, YU W, LI H J,etal.. Fabrication of high performance gadolinium-aluminum-zinc-oxide thin film transistors [J].Chin.J.Liq.Cryst.Disp., 2017, 32(5):339-343. (in Chinese)

