掺钨VO2薄膜的电致相变特性∗
张娇 李毅2) 刘志敏 李政鹏 黄雅琴裴江恒 方宝英 王晓华3) 肖寒4)
1)(上海理工大学光电信息与计算机工程学院,上海 200093)
2)(上海市现代光学系统重点实验室,上海 200093)
3)(上海电力学院电子与信息工程学院,上海 200090)
4)(上海健康医学院影像学院,上海 201318)
掺钨VO2薄膜的电致相变特性∗
张娇1)李毅1)2)†刘志敏1)李政鹏1)黄雅琴1)裴江恒1)方宝英1)王晓华1)3)肖寒1)4)
1)(上海理工大学光电信息与计算机工程学院,上海 200093)
2)(上海市现代光学系统重点实验室,上海 200093)
3)(上海电力学院电子与信息工程学院,上海 200090)
4)(上海健康医学院影像学院,上海 201318)
掺钨VO2薄膜,电致相变,阈值电压,光透过率
1 引 言
二氧化钒(VO2)是一种具有特殊相变性能的材料,当温度升高到68°C时,VO2能在短时间内完成半导体-金属相的转变,晶体由单斜金红石结构转变为四方金红石结构,且相变过程是可逆的[1].在相变前后,VO2的电导率、磁化率、光透过率等特性表现出较大的差异.目前研究表明,掺入W,Mo,Nb,Ti等高价态元素能有效降低VO2的相变温度,其中掺钨的效果最为明显.实验证明,每掺杂1%(原子数分数)的钨,VO2的相变温度约下降22°C,掺钨可使VO2薄膜的相变温度更接近室温[2−7].值得关注的是,掺钨也在很大程度上对薄膜的电学性能产生影响.Paone等[8]使用热蒸镀和反应磁控溅射法制备掺钨VO2薄膜,均检测到相变前后薄膜电阻接近两个数量级的变化.Takami等[9]实验发现,掺钨导致载流子浓度的增加,改变了库仑斥力能,使薄膜的金属态更加稳定.此外,刘冬青等[10]研究发现,随着掺钨量的增加,掺钨VO2薄膜的发射率降低.热激励只是诱发掺钨VO2薄膜相变的方式之一,光激励相变也逐渐吸引了研究者的目光[11].Okuyama等[12]通过分析X射线对薄膜衍射强度的影响,提出光致辐照诱导掺钨VO2薄膜相变的机理.Xiao等[13]利用太赫兹时域光谱技术研究了掺钨对VO2薄膜光致相变的影响.掺钨VO2薄膜具有良好的相变性能,然而热激励对温控的精确度要求高,难以实现微型化和集成化;光激励对光源也有特殊要求,限制了光激励在高速光电器件中的应用.
近年来,人们开始探索VO2的电激励相变特性[14−16].Zhou等[17]制备了金属/VO2/金属结构的纳秒级高速光开关器件.Markov等[18]基于近场等离子耦合,研究了混合型Si-VO2-Au结构的光调制器.由于VO2自身的电导率较低,应用于光电器件时往往需要导电性能良好的基底作为辅助,而常用的金属或硅基底会造成薄膜质量下降以及相变迟滞严重等问题,极大地影响了器件的性能.Soltani等[19,20]在蓝宝石基底上制备了平面结构的电压驱动掺钨VO2微光开关,对1.55µm光信号进行测试,消光比高达28 dB.在此基础上又研发出微光开关阵列,兼备可控性高和易于集成的特点,但仍面临相变阈值电压过高的问题.
为了深入探究掺钨VO2薄膜在电压诱导相变前后的光电性能,本文采用直流磁控溅射与后退火工艺相结合的方法制备掺钨VO2薄膜,并选用掺氟SnO2(FTO)导电玻璃为基底.FTO不仅具有良好的导电性能,减小了表面接触电阻对掺钨VO2薄膜电学性能的影响,还具备优异的耐热性能,经高温退火工艺处理后仍保持稳定.此外,FTO在可见光波段的透过率高于80%[21,22].这些特性使FTO能够在掺钨VO2薄膜与玻璃之间充当有效的缓冲层.在此基础上,本文研究了掺钨VO2薄膜在电激励作用下的相变特性,并与未掺杂VO2薄膜进行对比,测试了相变前后薄膜光学性能的变化,进一步分析了温度对薄膜相变阈值电压的影响.
2 实 验
实验采用JC500-3/D型磁控溅射设备(配有FTM-V型膜厚检测仪),选用按质量分数1.4%均匀掺钨的钨钒合金靶,通入纯度为99.999%的氩气制备掺钨VO2薄膜,在SX2-4-10型箱式退火炉中完成后退火工艺.实验分别选用玻璃和导电膜厚约为300 nm的FTO透明导电玻璃为基底,在SK3300H型超声波清洗机中经过丙酮、乙醇、去离子水清洗后,用高纯氮气吹干.磁控溅射前预先抽真空,使反应腔内的真空度达到3.0×10−3Pa.气体流量计控制通入的氩气流量为80 mL/min(标准状态),溅射时反应腔内真空度稳定在3.0×10−1Pa,设置工作电压400 V,工作电流2 A.掺钨金属钒薄膜制备完成后,将其放入箱式退火炉,在400°C的空气气氛中进行热氧化退火,通过比较不同退火时间的薄膜样品性能,最终优选出最佳退火时间为2.5 h.此外,选用纯度为99.99%的金属钒靶,采用上述工艺条件,分别在玻璃和FTO透明导电玻璃基底上制备膜厚约为300 nm的VO2薄膜.
利用PHI-5000C ESCA型X射线光电子能谱仪对薄膜进行表面元素成分分析,运用Mini flex 600型X射线衍射仪进行物相结构检测,使用ZEISS MERLIN Compact型场发射扫描电子显微镜(SEM)进行表面和横截面形貌观测,采用XE-100型原子力显微镜(AFM)进行表面粗糙度测量,用RTS-8型四探针测试仪和KER3100-08S型精密恒温台进行薄膜电阻的变温测试.此外,为了研究掺钨VO2薄膜的电致相变特性,我们分别在FTO和掺钨VO2膜层上制备Au电极连接点,采用Keithley 4200-SCS型半导体参数仪在不同温度下对样品的电流-电压(I-V)特性进行分析.最后用Lambda 1050型UV/VIS/NIR分光光度计测试样品的光学透过率.
3 结果与讨论
图1为掺钨VO2薄膜在0—1100 eV范围内的X射线光电子能谱(XPS).通过比照结合能数据库,标定测试样品的表面只存在氧、钒、碳和钨四种元素.图1(b)和(c)中红色线为基线,蓝色线和绿色线为分峰处理的结果.从图1(a)可知,结合能为533.2 eV的峰为O-1s,位于512.0—526.0 eV的峰对应V-2p的峰值.而位于结合能286.3 eV处的C-1s峰,是由表面吸附的杂质引起的.由于掺钨的比例较小,结合能35.8 eV对应的W-4f峰较弱.对V-2p采用高斯拟合的方法进行分峰处理,结果如图1(b)所示,在薄膜表面结合能516.2和517.3 eV处对应的V离子主要存在于VO2中;结合能524.5 eV处的V-2p1/2峰,钒氧化物以V2O5的形式存在,少量的V2O5是薄膜在高温退火过程中表面过度氧化引起的.图1(c)为掺钨VO2薄膜中W-4f的分峰拟合,结合能35.6和37.8 eV分别对应同一价态的W-4f7/2和W-4f5/2,均表现为+6价.
图2为VO2/FTO薄膜和掺钨VO2/FTO薄膜的X射线衍射(XRD)图谱. 对于透明导电玻璃基底上的FTO薄膜,SnO2的衍射峰出现在27.257°,34.403°,38.441°,52.084°,55.260°,62.018°,66.081°和81.203°. 与ICSD卡片比照,8个晶面的峰位角基本符合(PDF No.77-0447),可知F对SnO2的掺杂并没有改变其晶相和四方金红石结构.对比图2(a)和图2(b),两者与FTO对应的衍射峰位基本一致,VO2薄膜和掺钨VO2薄膜生长时,均在单一角度出现较强的衍射峰,具有择优取向晶面(110)的特点(PDF No.31-1438).从图2(c)可以看出,略有不同的是VO2在25.287°处出现(110)晶面的峰位角,而掺钨VO2表征(110)晶面的峰位角为25.182°.通过布拉格定律对两种薄膜在(110)晶面的峰位角计算可得,VO2和掺钨VO2的晶面间距分别为0.3519和0.3534 nm.此外,通过XRD没有检测到属于WO3的衍射峰,说明钨掺杂进入VO2的晶格.由此可以推测,高价态W6+在VO2中以替位掺杂的形式存在,改变了VO2的晶体结构,破坏V4+—V4+键的结合,而V原子半径小于W原子半径,故表现出晶面间距的不同.
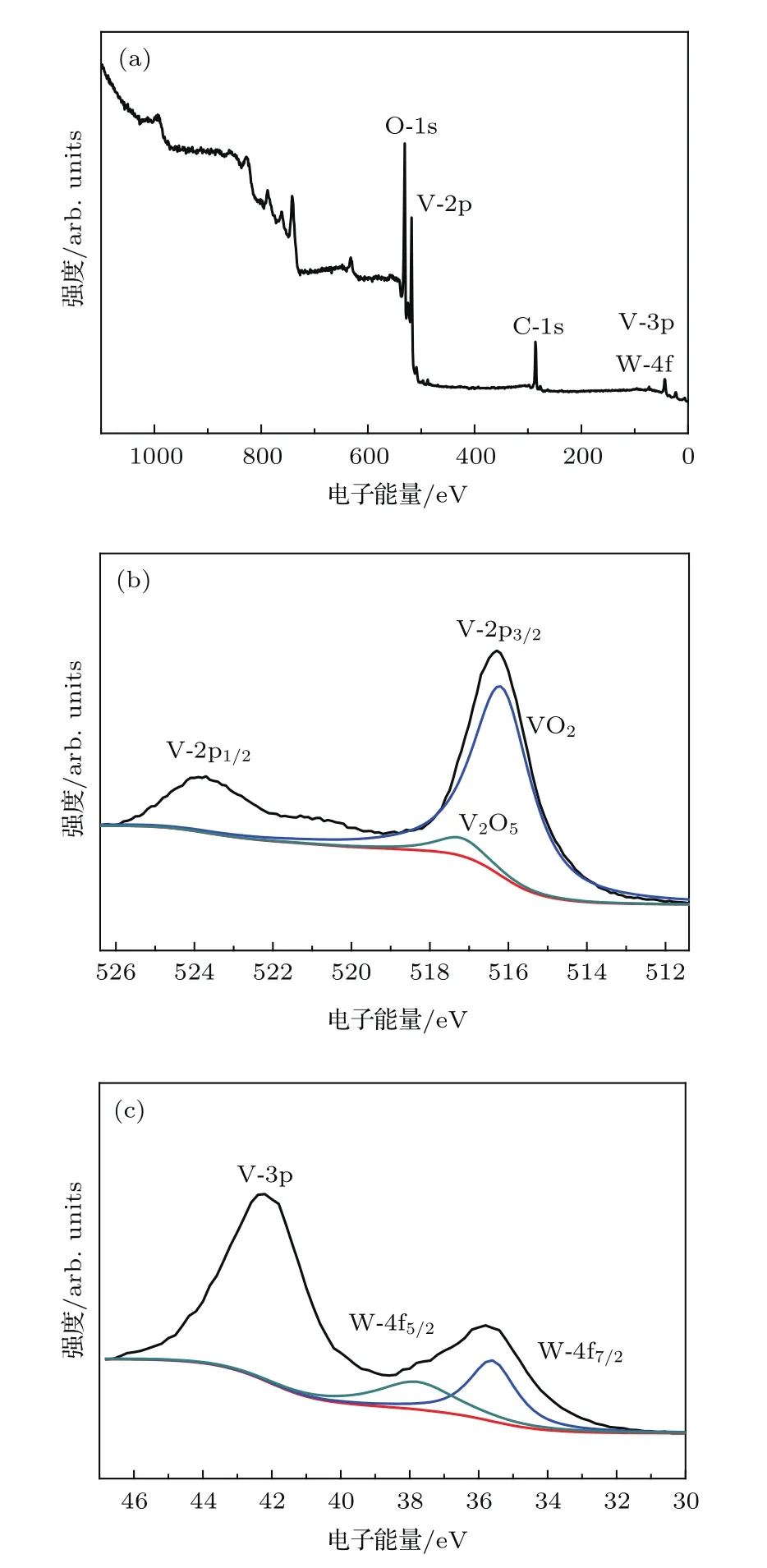
图1 (网刊彩色)掺钨VO2薄膜的XPS图谱 (a)掺钨VO2薄膜宽程扫描谱;(b)掺钨VO2薄膜中V-2p的分峰拟合;(c)掺钨VO2薄膜中W-4f的分峰拟合Fig.1. (color online)XPS pro files of W-doped VO2 film:(a)Full spectrum scanning on the W-doped VO2 film;(b)peak fitting for V-2p on the W-doped VO2 film;(c)peak fitting for W-4f on the W-doped VO2 film.
掺钨VO2/FTO薄膜表面和截面形貌的SEM图像如图3所示.由图3(a)可知,薄膜表面结晶致密,分布均匀,晶粒呈现不规则片状且孔洞和空隙较少,表明薄膜质量较高.从截面形貌图可以看出,所制备的掺钨VO2/FTO薄膜结构明晰,上层掺钨VO2薄膜厚度约为310 nm,FTO缓冲层厚度约为300 nm.由于FTO具有耐高温的特点,对复合薄膜进行后退火工艺处理后并没有破环FTO的结构及性能,两层薄膜间未出现相互渗透和融合的现象.
图4所示为以玻璃和FTO透明导电玻璃为基底制备的掺钨VO2薄膜的AFM图像.图4(a)和图4(b)中样品的表面均方根粗糙度分别为7.887和10.504 nm,表现出明显的差异.对比可知,FTO有效地缓解了薄膜与玻璃基底之间的应力,生长在FTO薄膜表面的掺钨VO2薄膜,膜层较为平整,晶粒间空隙较小.同时,FTO与VO2晶体都具有四方金红石结构,相似的晶格常数和较高的匹配程度易于上层薄膜的成核和生长.
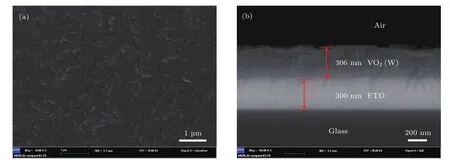
图3 掺钨VO2/FTO薄膜的SEM图像 (a)表面SEM图像;(b)横截面SEM图像Fig.3.SEM images of W-doped VO2 film on FTO:(a)Surface SEM image;(b)cross-sectional SEM image.
进一步对比在FTO透明导电玻璃基底上制备的VO2薄膜和掺钨VO2薄膜的特性.VO2/FTO薄膜和掺钨VO2/FTO薄膜的电阻-温度变化曲线如图5(a)所示.可以看出,随着温度升高,薄膜的电阻逐渐降低,前期变化缓慢,当达到相变温度点时电阻发生突变,相变前后电阻变化量均接近三个数量级.降温过程中薄膜的电阻变化与升温时相反,在相变温度附近电阻急剧增大,表现出相变的可逆性.图5(b)和图5(c)是对电阻-温度的变化率进行高斯拟合的结果,由图可知,VO2/FTO薄膜的相变温度约为49°C,而掺钨VO2薄膜的相变温度仅为32°C,相比于VO2薄膜,相变温度显著降低.一方面,由于FTO透明导电玻璃的导热性比普通玻璃基底更好,可加快传递VO2相变所需要的热能.另一方面,FTO与VO2的晶体结构极为相似,有效避免了VO2薄膜生长过程中晶格失配和缺陷较多的问题,减小了VO2薄膜与基底接触面的界面能,同时降低了薄膜的内应力,这些因素导致相变温度的降低.此外,掺钨改变了VO2/FTO薄膜的晶界和孔隙分布,薄膜的热滞回线宽度由10°C收窄至5°C,热滞回线宽度较小有利于薄膜的相变性能保持稳定.
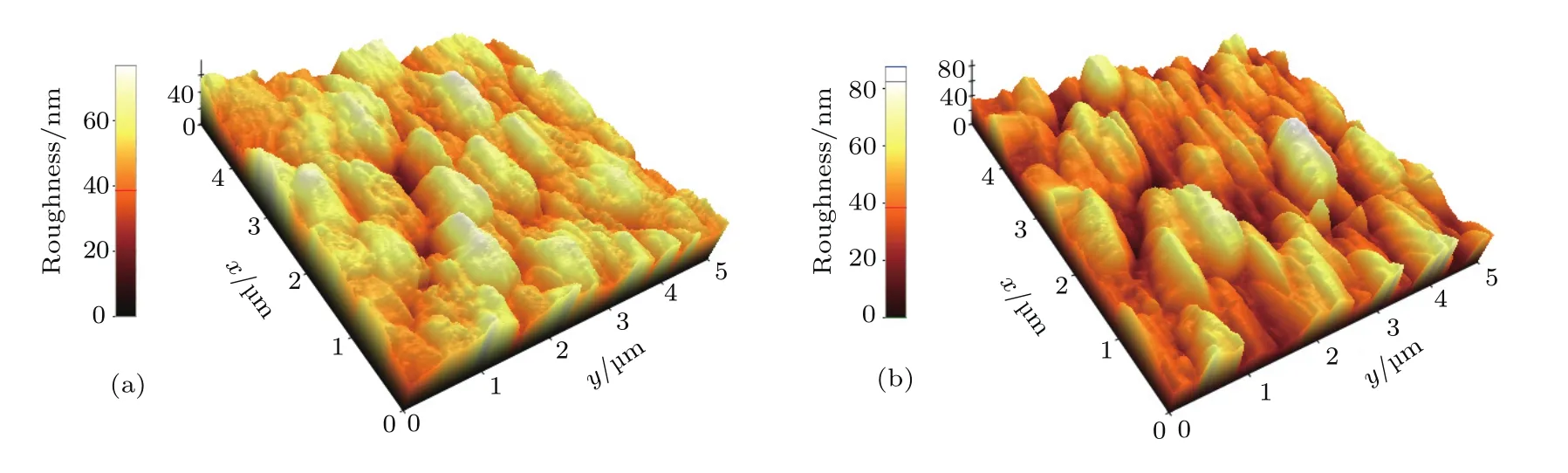
图4 (网刊彩色)AFM图像 (a)掺钨VO2/FTO薄膜;(b)掺钨VO2/玻璃薄膜Fig.4.(color online)AFM images:(a)W-doped VO2 film on FTO;(b)W-doped VO2 film on glass.
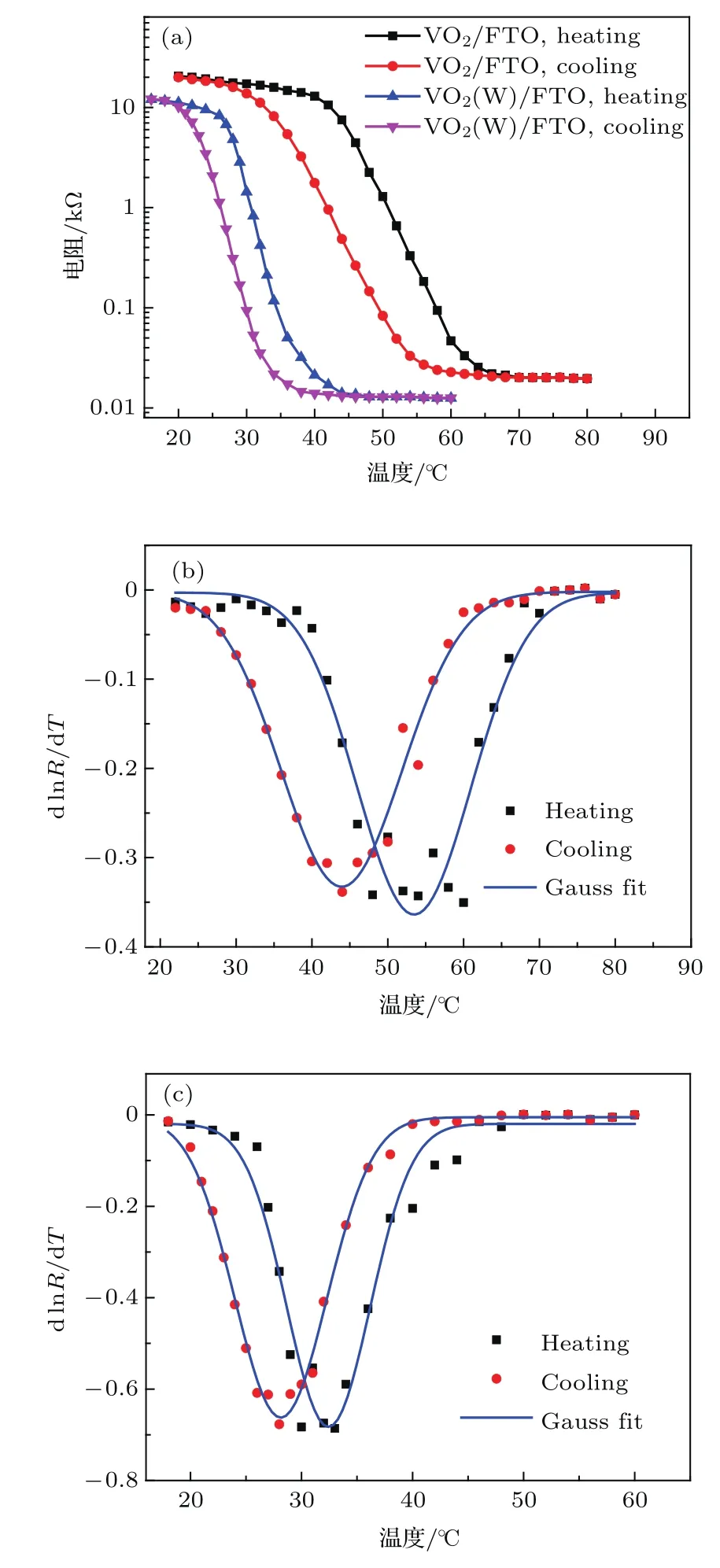
图5 (网刊彩色)掺钨VO2/FTO薄膜和VO2/FTO薄膜的电阻-温度变化曲线 (a)电阻-温度变化曲线;(b)高斯拟合VO2/FTO电阻变化率-温度曲线;(c)高斯拟合掺钨VO2/FTO电阻变化率-温度曲线Fig.5.(color online)Resistance-temperature curves of W-doped VO2 film on FTO and VO2 film on FTO:(a)Resistance-temperature curves;(b)Gauss fitting curves of VO2 film on FTO;(c)Gauss fitting curves of W-doped VO2 film on FTO.
实验发现,相变前后掺钨VO2/FTO薄膜的电阻始终小于未掺杂的薄膜.室温下,Rajeswaran等[23]曾用霍尔效应测试掺钨VO2薄膜,发现载流子浓度随着掺钨量的增加而升高,这表明掺钨不仅使VO2的晶体结构发生了变化,也对载流子浓度有直接影响.W6+携带两个多余的价电子,替位掺杂产生的新氧化物对电子束缚能力较弱,只需要外界提供较低的能量就足以跃迁进入导带,使费米能级偏离禁带中央,从而增加了导带中载流子的浓度[24].因此,掺钨VO2薄膜具有更加优越的导电性能和更接近于室温的相变温度.
为了测试薄膜的电致相变特性,我们制备了图6所示测试结构.基底为10 mm×7 mm的矩形FTO透明导电玻璃,FTO膜层担任缓冲层和底电极的角色,与顶层掺钨VO2薄膜的接触面积为7 mm×7 mm,分别在FTO和掺钨VO2膜层上制备长和宽均为1 mm的Au电极连接点,测试时施加垂直于膜层的电压.在室温25°C下,对膜厚相同的掺钨VO2/FTO薄膜和VO2/FTO薄膜分别施加0—8 V电压,使用4200-SCS型半导体参数仪测试I-V特性曲线.如图6所示,随着施加电压逐渐增大,达到某个阈值时,平缓增长的电流在极短时间内发生突变,电流变化约为两个数量级,两种薄膜都有类似的变化趋势,但电流突变的幅度略有不同.实验发现,薄膜相变前后存在电流迟滞现象,这与电致相变的显著特征一致,其中,VO2/FTO薄膜的电流迟滞现象更为明显.掺钨VO2/FTO薄膜和VO2/FTO薄膜发生相变的阈值电压分别为4.2和6.0 V.通过对比可知,掺杂的薄膜具有电阻率低和相变阈值电压低的特点,展现出优于VO2薄膜的电致相变特性.这种现象是由掺钨引起的,掺杂使VO2晶粒中载流子浓度增加,在施加较低电压的情况下,载流子浓度迅速达到临界值,从而诱导VO2/FTO薄膜发生相变.
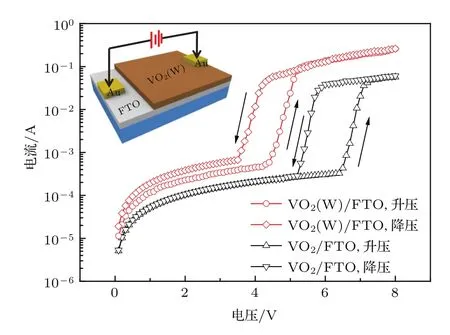
图6 室温下掺钨VO2/FTO薄膜和VO2/FTO薄膜的I-V特性曲线Fig.6.I-V characteristics of W-doped VO2 film on FTO and VO2 film on FTO at room temperature.
此外,分别在25,30,35,40,45°C条件下,对掺钨VO2/FTO薄膜施加0—8 V电压,进行I-V特性曲线测试,结果如图7所示.从图中可以看出,25°C时电流突变的阈值电压为4.2 V,而30与35°C对应的阈值电压分别为3.6和3.1 V,说明温度越高,相变阈值电压越低.进一步分析可知,当温度低于相变温度或在其附近时,随着温度的升高,电流突变幅度呈现下降趋势.当外界温度远高于热致相变温度时,薄膜已经发生半导体-金属态的转变,呈金属态,具有良好的导电性能,电流表现出平稳上升的趋势,几乎观察不到突变现象.施加相同电压时,室温条件下测得的电流始终小于升温时的电流,且随着温度升高,电流变化趋于平缓.
对掺钨VO2/FTO薄膜施加电激励或热激励均有促成相变的作用.根本原因在于外加激励使能带的载流子填充发生变化,当载流子浓度高于临界值时,VO2处于金属相,而低于临界值时处于半导体相,从而导致钨掺杂VO2/FTO薄膜在相变前后光电性能出现显著的差异.低温时,随着施加电压的增加,电场强度逐渐增大,晶粒中的载流子浓度升高,当部分晶粒的载流子浓度达到临界值时,电阻率急速下降,可观测到明显的电流突变现象,且电流突变幅度较大.而高温时,大部分晶粒受到电压和温度的双重影响,已经发生相变,薄膜处于稳定的金属态,电流整体表现出增大趋势,但突变幅度减小.
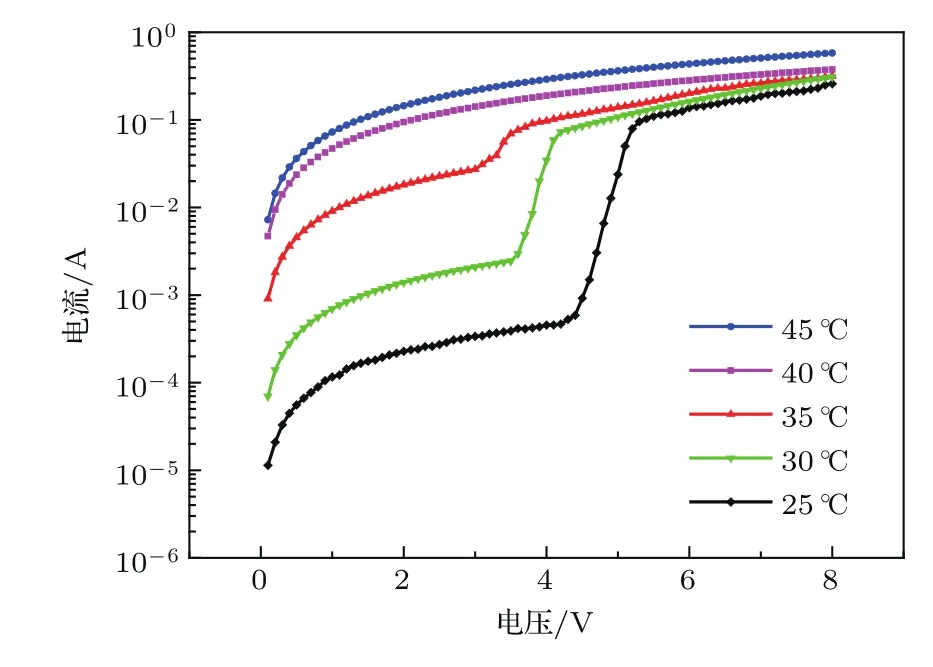
图7 (网刊彩色)不同温度下掺钨VO2/FTO薄膜的I-V特性曲线Fig.7.(color online)I-V characteristics of W-doped VO2 film on FTO at different temperatures.
图8为对掺钨VO2薄膜施加0和8 V电压时,分别在20,30,40,50°C条件下测得400—2200 nm范围内的透射光谱.由图8(a)可知,掺钨VO2薄膜的最大透过率为47%.当无电压激励而仅施加热激励时,在20与30°C条件下,薄膜的透过率最多下降2.7%,在30—40°C范围内,薄膜在近红外波段的透过率却有明显下降,进一步测试确定热致相变温度与电阻突变测得的结果相符.当施加8 V电压时,不同温度下的透过率均有较为明显的降低,其中20和30°C时1100—1500 nm波段内透过率下降最大可达23%和22%.由于此时未达到薄膜的相变温度,分析可知薄膜透过率的大幅度降低主要是电致相变的结果,外加电压使载流子的浓度升高,迁移速度变快,而掺钨也有助于提高薄膜对红外光产生的屏蔽作用[25].此外,实验测得掺钨VO2薄膜在20和30°C的相变阈值电压分别为5.1和3.6 V,说明温度越低,诱导薄膜相变的阈值电压越高.当外加电压高于阈值电压时,大部分晶粒已经发生相变,薄膜呈现稳定的金属态,升高温度对薄膜的透过率影响不大.施加相同电压的条件下,40—50°C时测得的透过率是相变后的结果,透过率变化不明显,仅有微弱的下降.综合温度和电压两种因素,施加8 V电压,50°C时近红外波段的透过率变化幅度最大可达27%,进一步表明电激励和热激励均会诱发掺钨VO2薄膜相变.
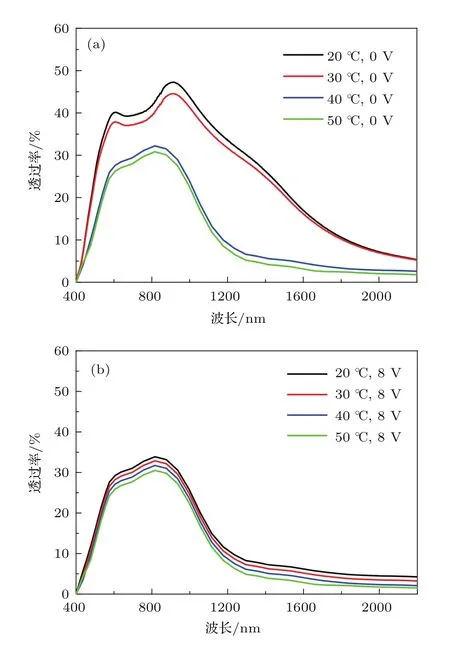
图8 (网刊彩色)掺钨VO2薄膜的透过率-波长变化曲线Fig.8.(color online)Optical transmittance spectra of W-doped VO2 film.
4 结 论
本文采用直流磁控溅射法和后退火工艺,在FTO透明导电玻璃基底上成功制备了高质量且性能良好的掺钨VO2薄膜.相变前后薄膜的电阻有接近三个数量级的突变,薄膜的相变温度约为32°C.与未掺杂的VO2薄膜相比,掺钨薄膜的的相变温度更接近于室温,电阻率更低.我们重点研究了掺钨VO2薄膜的I-V特性曲线,对薄膜施加0—8 V电压,发现当电压达到4.2 V时,电流约有两个数量级的显著突变,出现电压诱导相变现象.在此基础上,分别在25,30,35,40,45°C条件下测试了薄膜的电流变化,结果表明升温对电致相变有影响,温度越高,相变需要的阈值电压越低,高温时薄膜处于稳定的金属态,电压诱导相变的特征不明显.此外,研究发现电致相变前后薄膜的光学透过率有突变现象.对薄膜施加8 V电压,20和30°C时在1100—1500 nm波段内透过率下降最大可达23%和22%,而50°C时透过率下降27%.综上所述,掺钨VO2薄膜具备良好的电致相变性能,且具有制备成本低、工艺简单等优势,在光电集成器件领域有重要的应用价值.
[1]Morin F J 1959Phys.Rev.Lett.3 34
[2]Tong G X,Li Y,Wang F,Huang Y Z,Fang B Y,Wang X H,Zhu H Q,Liang Q,Yan M,Qin Y,Ding J,Chen S J,Chen J K,Zheng H Z,Yuan W R 2013Acta Phys.Sin.62 208102(in Chinese)[佟国香,李毅,王锋,黄毅泽,方宝英,王晓华,朱慧群,梁倩,严梦,覃源,丁杰,陈少娟,陈建坤,郑鸿柱,袁文瑞2013物理学报62 208102]
[3]Tazawa M,Jin P,Tanemura S 1998Appl.Opt.37 1858
[4]Manning T D,Parkin I P,Pemble M E,Sheel D,Vernardou D 2004Chem.Mater.16 744
[5]Lawton S A,Theby E A 1995J.Am.Ceram.Soc.78 238
[6]Mao Z P,Wang W,Liu Y,Zhang L P,Xu H,Zhong Y 2014Thin Solid Films558 208
[7]Wang X J,Liu Y Y,Li D H,Feng B H,He Z W,Qi Z 2013Chin.Phys.B22 066803
[8]Paone A,Sanjines R,Jeanneret P,Whitlow H J,Guibert E,Guibert G,Bussy F,Scartezzini J,Schüeler A 2015J.Alloys.Compd.621 206
[9]Takami H,Kanki T,Ueda S,Kobayashi K,Tanaka H 2012Phys.Rev.B85 205111
[10]Liu D,Cheng H,Xing X,Zhang C,Zheng W 2016Infrared Phys.Technol.77 339
[11]Chen Z,Wen Q Y,Dong K,Sun D D,Qiu D H,Zhang H W 2013Chin.Phys.Lett.30 017102
[12]Okuyama D,Shibuya K,Kumai R,Suzuki T,Yamasaki Y,Nakao H,Murakami Y,Kawasaki M,Taguchi Y,Tokura Y,Arima T 2015Phys.Rev.B91 064101
[13]Xiao Y,Zhai Z H,Shi Q W,Zhu L G,Li J,Huang W X 2015Appl.Phys.Lett.107 031906
[14]Hao R L,Li Y,Liu F,Sun Y,Tang J Y,Chen P Z,Jiang W,Wu Z Y,Xu T T,Fang B Y,Wang X H,Xiao H 2015Acta Phys.Sin.64 198101(in Chinese)[郝如龙,李毅,刘飞,孙瑶,唐佳茵,陈培祖,蒋蔚,伍征义,徐婷婷,方宝英,王晓华,肖寒2015物理学报64 198101]
[15]Xiong Y,Wen Q Y,Tian W,Chen Z,Yang Q H,Jing Y L 2015Acta Phys.Sin.64 017102(in Chinese)[熊瑛,文岐业,田伟,陈智,杨青慧,荆玉兰2015物理学报64 017102]
[16]Qiu D H,Wen Q Y,Yang Q H,Chen Z,Jing Y L,Zhang H W 2013Acta Phys.Sin.62 217201(in Chinese)[邱东鸿,文岐业,杨青慧,陈智,荆玉兰,张怀武 2013物理学报62 217201]
[17]Zhou Y,Chen X N,Ko C H,Yang Z,Mouli C,Ramanathan S 2013IEEE Electr.Dev.Lett.34 220
[18]Markov P,Appavoo K,Haglund R F,Weiss S M 2015Opt.Express23 6878
[19]Soltani M,Chaker M,Haddad E,Kruzelecky R,Margot J,Laou P,Paradis S 2008J.Vac.Sci.Technol.A26 763
[20]Soltani M,Chaker M,Haddad E,Kruzelecky R,Margot J 2007J.Vac.Sci.Technol.A25 971
[21]Bhattacharyya S R,Majumder S 2012Adv.Sci.Lett.5 268
[22]Acosta D R,Estrada W,Castanedo R,Maldonado A,Valenzuela M A 2000Thin Solid Films375 147
[23]Rajeswaran B,Umarji A M 2016AIP.Adv.6 035215
[24]Yan J Z,Zhang Y,Liu Y S,Zhang Y B,Huang W X,Tu M J 2008Rare Metal Mater.Eng.37 1648(in Chinese)[颜家振,张月,刘阳思,张玉波,黄婉霞,涂铭旌 2008稀有金属材料与工程37 1648]
[25]Continenza A,Massidda S,Posternak M 1999Phys.Rev.B60 15699
Characteristics of electrically-induced phase transition in tungsten-doped vanadium dioxide film∗
Zhang Jiao1)Li Yi1)2)†Liu Zhi-Min1)Li Zheng-Peng1)Huang Ya-Qin1)Pei Jiang-Heng1)Fang Bao-Ying1)Wang Xiao-Hua1)3)Xiao Han1)4)
1)(School of Optical-Electrical and Computer Engineering,University of Shanghai for Science and Technology,Shanghai 200093,China)
2)(Shanghai Key Laboratory of Modern Optical System,Shanghai 200093,China)
3)(School of Electronic and Information Engineering,Shanghai University of Electric Power,Shanghai 200090,China)
4)(College of Medical Imaging,Shanghai University of Medicine and Health Sciences,Shanghai 201318,China)
29 March 2017;revised manuscript
14 August 2017)
The phase transition characteristics of tungsten-doped vanadium dioxide film driven by an applied voltage are studied in the paper.A high-quality film is successfully deposited on an FTO(F:SnO2)transparent conductive glass substrate by direct current magnetron sputtering and post-anneal processing.First of all,an FTO substrate is placed in the chamber of magnetron sputtering system after being cleaned and dried.Then W-doped vanadium film is fabricated on the substrate with V-W alloy target with 1.4%W by mass fraction.In the process of magnetron sputtering,the operating pressure is kept at 3.0×10−1Pa,and the operating voltage and current are 400 V and 2 A,respectively.Finally,W-doped VO2film with a thickness of about 310 nm is prepared by being annealed at 400°C in air atmosphere for 2.5 h.In order to explore the crystal structure,element constituents,surface morphology,roughness and photoelectric properties of W-doped vanadium dioxide film,it is respectively characterized by X-ray photoelectron spectroscopy(XPS),X-ray diffraction(XRD),scanning electron microscope(SEM),atomic force microscope(AFM)and semiconductor parameter analyzer.The XPS analysis con firms that there are no other elements except vanadium,oxygen,carbon and tungsten on the surface of W-doped VO2film.The XRD patterns illustrate that tungsten-doping exerts an in fluence on the crystal lattice of VO2,but the film still prefers the orientation(110).The SEM and AFM images display that the film with low roughness has a compact structure and irregular crystal particles.Tungsten-doping is found to be able to improve the surface morphology of VO2thin film significantly.In addition,a remarkable change in electrical resistivity and a narrow thermal hysteresis loop are also obtained in the metal-semiconductor phase transition.Further,the in fluences of tungsten-doping on the phase transition properties of the film are analyzed.The experiment demonstrates that the threshold voltage at which the phase transition of W-doped VO2film occurs is 4.2 V at room temperature when the film is driven by an applied voltage ranging from 0 V to 8 V.It can be observed clearly that the current changes abruptly by two orders of magnitude.As the ambient temperature rises,the threshold voltage of phase transition drops and the current varies slightly.The optical transmittance curves show the distinct differences under applied voltage at different temperatures.It is found that the infrared transmittance difference reaches up to a maximal value of 27%at 50°C during phase transition,while it increases by only 23%at 20°C in a wavelength range of 1100—1500 nm.All these outstanding features indicate that W-doped VO2film has excellent properties of electrically-induced phase transition.Compared with undoped-VO2film,the W-doped VO2film is predicated to have a wide range of applications in the high-speed optoelectronic devices due to its advantages of lower phase transition temperature,resistivity and threshold voltage.
tungsten-doped VO2film,electrically-induced phase transition,threshold voltage,optical transmittance
PACS:81.05.–t,72.80.Ga,71.30.+h,68.55.–aDOI:10.7498/aps.66.238101
*Project supported by the National High Technology Research and Development Program of China(Grant No.2006AA03Z348),the Foundation for Key Program of Ministry of Education,China(Grant No.207033),the Science and Technology Research Project of Shanghai Science and Technology Commission,China(Grant No.06DZ11415),the Key Science and Technology Research Project of Shanghai Education Committee,China(Grant No.10ZZ94),and the Shanghai Talent Leading Plan,China(Grant No.2011-026).
†Corresponding author.E-mail:liyi@usst.edu.cn
(2017年3月29日收到;2017年8月14日收到修改稿)
采用直流磁控溅射与后退火工艺相结合的方法,在掺氟SnO2(FTO)导电玻璃基底上制备了高质量的掺钨VO2薄膜,对薄膜的结构、表面形貌和光电特性进行测试,分析了钨掺杂对其相变性能的影响.结果表明,室温下掺钨VO2薄膜的阈值电压为4.2 V,观察到阈值电压下约有两个数量级的电流突变.随着温度升高,相变的阈值电压降低,且电流突变幅度减小.当施加8 V电压时,分别在不同温度下测试了掺钨VO2薄膜的透过率.温度为20和50°C时,掺钨VO2薄膜相变前后的红外透过率差量分别为23%和27%.与未掺杂的VO2薄膜相比,掺钨VO2薄膜具有相变温度低、阈值电压低和电阻率小的特点,在高速光电器件中有广阔的应用前景.
10.7498/aps.66.238101
∗国家高技术研究发展计划(批准号:2006AA03Z348)、教育部科学技术研究重点项目(批准号:207033)、上海市科学技术委员会科技攻关计划(批准号:06DZ11415)、上海市教育委员会科技创新重点项目(批准号:10ZZ94)和上海领军人才培养计划(批准号:2011-026)资助的课题.
†通信作者.E-mail:liyi@usst.edu.cn

