基于MEMS工艺的SOI高温压力传感器设计*
李丹丹,梁 庭,李赛男,姚 宗,熊继军*
(1.中北大学电子测试技术重点实验室,太原030051;2.中北大学仪器科学与动态测试教育部重点实验室,太原030051)
基于MEMS工艺的SOI高温压力传感器设计*
李丹丹1,2,梁庭1,2,李赛男1,2,姚宗1,2,熊继军1,2*
(1.中北大学电子测试技术重点实验室,太原030051;
2.中北大学仪器科学与动态测试教育部重点实验室,太原030051)
利用MEMS(微机电系统)工艺中的扩散,刻蚀,氧化,金属溅射等工艺制备出SOI高温压力敏感芯片,并通过静电键合工艺在SOI芯片背面和玻璃间形成真空参考腔,最后通过引线键合工艺完成敏感芯片与外部设备的电气连接。对封装的敏感芯片进行高温下的加压测试,高温压力测试结果表明,在21℃(常温)至300℃的温度范围内,传感器敏感芯片可在压力量程内正常工作,传感器敏感芯片的线性度从0.9 985下降为0.9 865,控制在较小的范围内。高温压力下的性能测试结果表明,该压力传感器可用于300℃恶劣环境下的压力测量,其高温下的稳定性能为压阻式高温压力芯片的研制提供了参考。
高温压力传感器;压阻;敏感薄膜;SOI(绝缘体上硅);MEMS(微机电系统)
EEACC:7110;7230doi:10.3969/j.issn.1004-1699.2015.09.009
高温MEMS敏感器件由于可靠性高,在军事上广泛被采用[1]。硅压力传感器作为微型传感器中一种,利用半导体材料的压阻效应和良好的弹性,通过集成电路工艺和微机械加工工艺等MEMS加工工艺研制,在近几年得到了快速广泛的发展[2-4]。绝缘体上硅(Silicon on Insulator,SOI)高温压力传感器是一种新型的半导体高温压力传感器,它比扩散硅压力传感器具有更高的工作温度,比多晶硅高温压力传感器具有更高的灵敏度,具有耐高温、抗辐射和稳定性好等优点[5],能够解决石油、汽车、航空和航天等领域对高温压力传感器的迫切需求,在高温领域有很大的潜力[6]。但是,SOI高温压力传感器在高温下工作性能不是很稳定,自发热问题严重,这是SOI压阻式高温压力传感器的研究重点[7],同时由于SiO2和Si的热膨胀系数相差较大,温度变化时,内部产生热应力会引起传感器的零点温度漂移[8]。
本文在SOI商用晶圆基础上,针对一种经MEMS工艺优化设计制备的耐高温SOI压力敏感芯片,在不同温度下对其进行不同载荷的性能测试,分析并比较了传感器在高温高压载荷下输出电压信号的影响。
1 SOI压阻式压力传感器工作原理
该SOI高温压力传感器是基于单晶硅材料的压阻效应而制成的一种传感器,对于SOI晶圆而言,当选用(100)面作为制作传感器的基准面,在其在受到外力作用时,其电阻的相对变化可简化为[9]:

式中:σl、σt分别表示电阻内部所受到的纵向应力和横向应力(N/m2);68.8、-69.3分别为硅的纵向压阻系数和横向压阻系数(m2/N)。
采用如图1所示的惠斯通电桥测量,输入电压Vin不变,输出电压Vout可表示为:

零点输出情况下,Vout为零,即:
R1R3-R2R4=R1(1+∂1T)R3(1+∂3T)-
R2(1+∂2T)R4(1+∂4T)=0(3)
式中:∂1代表桥臂电阻的电阻率温度系数,此条件下可通过合适的掺杂浓度值使得引起零点温度漂移的惠斯通电桥桥臂上各电阻阻值和温度系数差异性忽略不计。
当敏感薄膜收到外力作用产生形变时引起表面电阻阻值发生改变,此时的电桥输出为:

式中:Rp1为敏感薄膜形变引起的桥臂电阻增量,由于半导体压阻效应的各向异性,可通过特殊工艺使得 R1=R2=R3=R4=RP,ΔRP1=ΔRP2=ΔRP3=ΔRP4=ΔRP此时的输出电压可表示为:

通过对压力传感器加载一定的压力信号,当该压力使得传感器敏感薄膜产生形变时,惠斯通电桥的输出电压会发生改变。因此,通过拾取输出电压信号随加载压力变化的特点,就可以间接测出外界压力信号值。

图1 惠斯通电桥
2 SOI压阻式压力传感器设计
为了保证传感器高温下的性能稳定性,我们通过设计合理的传感器参数和结构,保证传感器在正常温度内能够准确工作,以实现对传感器的优化。
2.1压敏电阻和敏感薄膜厚度设计
从微加工角度来看,扩散杂质表面浓度的大小影响着电阻条的温度系数和应变计温度系数,当应变为ε时,P型硅电阻的掺杂浓度影响电阻的温度系数(TCR)和电阻的应变计温度系数(TCG)温度变化值之间的关系式为[10]:

式中:G为剪切模量,α为TCR,β为TCG。
若满足α+β=0,由电阻及应变计因子引起的温度漂移将得到补偿,通过实验得到的掺杂浓度值为3×1018cm-3和2×1020cm-3,选择3×1018cm-3的浓度对电阻条进行扩散,同时欧姆接触区域选择2×1020cm-3的浓度进行扩散。为尽量降低自加热产生的热量,并使电阻的产热和散热达到平衡,单位面积功耗Ps≤5×10-3mW/μm2[11],又单位面积功耗的表达式为:

式中:Vin为输入电压,为5 V,Rs代表方块电阻,L和W分别表示电阻条的长和宽。该商用SOI晶圆顶层硅厚度为2 um,经过计算可得掺杂后的方块电阻Rs= 107.5 Ω,代入式7,可得L≥108 μm。
又单个电阻值的表达式为:

式中:ρ代表电阻率,当掺杂浓度控制在3×1018cm-3时,ρ=0.021 5 Ω·cm,d表示顶层硅厚度,d=2 μm,代入式(8),可得W≥8 μm。
对于方形硅薄膜来说,如要满足薄膜变形的小挠度理论模型,则薄膜表面最大应力差值应满足[12]:

可以得到:

式中:P表示量程2 MPa,a表示敏感膜边长1 000 um,h表示敏感膜厚度,表示泊松比0.278,σm表示硅的破坏应力,为6×109N/m2,代入式10,可得h≥15.7 μm。
考虑到加工水平和工艺尺寸限制,在设计中选择使用L=150 μm,W=10 μm,联合深硅刻蚀工艺和敏感薄膜过载保护,使得敏感膜厚度h=50 μm。如图2所示。
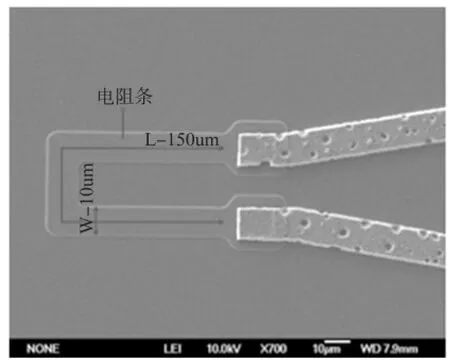
图2 电阻条电子显微镜扫描图
2.2金属引线设计
从集成电路制造早期开始就选择铝作为金属互连的材料,以薄膜的形式在硅片中连接不同器件,铝作为互连线有较低电阻率,廉价,工艺兼容等优点,随着芯片集成度越来越高,互连线的特征图形尺寸越来越细,铝已经不能满足现代高性能、高集成度的VLSI对互连线材料的要求,其根本原因是铝具有的电迁徙问题以及电阻率的限制,同时铝熔点仅为600℃,导致在淀积完铝膜后不能再对硅片进行高温处理,使得工艺灵活性有所降低。为了保证金属引线在高温环境下的性能,同时为了避免金属与半导体在接触中形成金属与半导体的化合物,采用物理气相沉积(PVD)的Ti/Pt/Au三层金属的结构,粘附层金属钛可以很好的阻挡金属在硅材料的扩散,同时在半导体和金属之间有很好的附着能力。金属互连线,如图3所示。过渡层金属铂(Pt)可以防止金(Au)与钛(Ti)之间形成高阻化合物。金(Au)作为导电层,在高温下有有较好的高温稳定性,可以有效解决在高温恶劣环境下,焊盘和引线力学和电学性能不稳定的情况。

图3 金属互连线示意图
3 SOI压阻式压力传感器制备
在SIMOX技术商用SOI晶圆的基础上,通过如图4所示的加工工艺流程,制备得到耐高温SOI压力敏感芯片。

图4 工艺流程图
先对SOI晶圆掺杂,然后用ICP刻蚀机刻蚀出电阻条(图4(a)),再做氧化层保护电阻,腐蚀出电极孔并对欧姆接触区进行重掺杂(图4(b)),其次通过金属溅射的方法布好金属互连线并对SOI晶圆背面深硅刻蚀(图4(c),4(d)),然后跟Pyrex玻璃阳极键合形成密闭参考压力腔(图4(e)),最后经过跟外部引线键合后形成最终的耐高温压力传感器芯片,如图5所示。

图5 芯片正面和背面示意图

图6 常温下的加压测试
4 测试分析及讨论
首先对传感器进行常温下的加压测试,测试平台如图6(a)所示,传感器置于压力罐内,通过外部引线连接到5 V恒压源和高精度万用表(Agilent 34410A),压 力 罐 通 过 压 力 控 制 器(Druck PACE5000)对其进行加压控制。为避免压力控制器加压过程中可能带来的测量误差,我们设定加压步进为50 kPa,在压力从0~600 kPa的加压过程中,传感器的输出电压随外部气压变化如图所示,由于是初次测试,传感器的敏感膜刚开始产生形变,所以在第一次气压上升过程中,测试数据偏离,气压继续增大时,数据恢复正常。从图6(b)可以看出,随着外部气压的上升,传感器的输出电压也跟着上升,在0~600 kPa的测试压力范围内,传感器的输出电压-外部气压曲线呈现出良好的线性特征,常温常压下的零位输出为47.16 mV,对测量得到的输出电压-外部气压数据进行线性拟合,线性拟合度为0.998 5,气压上升时的灵敏度为1.364×10-4mV/Pa,气压下降时的灵敏度为1.345×10-4mV/Pa,迟滞性小于0.4%。
然后对传感器进行高温下的加压测试,其高温(300℃)压力测试装置如图7(a)所示,通过JT-300高温真空压力炉提供一个高温高压的测试环境,SOI压力传感器置于高温压力炉中,传感器检测电路通过高温压力炉顶部的接插件和外部恒压源与高精度万用表(Agilent 34410A)相接,通过读取输出电压值随施加气压的变化,研究高温高压下传感器的性能参数。鉴于仪器限制,300℃的高温环境下,在0~500 kPa的测试压力范围内,传感器的输出电压-外部气压曲线如图7(b)所示,此时的输出电压为72.62 mv,对测量得到的输出电压-外部气压数据进行线性拟合,线性拟合度为0.986 5,气压上升时的灵敏度为,气压下降时的灵敏度为,迟滞性小于0.54%。
对比常温环境可以发现,300℃的高温环境下,传感器的零位输出电压和灵敏度均产生了一定的漂移,同时由于制作工艺的误差,常温下传感器的零位输出电压不为零。对不同温度-传感器零位输出和不同温度-传感器灵敏度输出数据进行线性拟合,拟合曲线如图8(a)、8(b)所示,可知不同温度下传感器的零位和灵敏度均产生漂移,所以后期应用时,需外接电阻对传感器的零位、零位温漂以及灵敏度温漂进行补偿。

图7 高温下的加压测试

图8 不同温度下的传感器零位输出和灵敏度输出拟合曲线
5 结论
本文设计并制备了一种基于SOI的高温压力传感器,通过对制备的传感器进行常温高压和高温高压的测试,得到并讨论了该传感器的高压性能参数,探讨了不同温度下的加压环境中传感器的非线性误差,迟滞性和灵敏度。随着温度的升高,传感器的产生一定的温度漂移,在21℃(常温)至300℃的温度范围内,传感器敏感芯片可在压力量程内正常工作,其输出电压-外部气压曲线呈现出良好的线性特征,具有良好的输出特性,这为合理设计、应用SOI微结构压力传感器提供了一种参考依据。
[1] 耿振亚,宋国庆,张冬梅.基于MEMS实现SOI压力传感器的工艺研究[J].传感器世界,2010,16(1):28-31.
[2] 姜润翔,张晓兵,龚沈光.泥沙掩埋对压阻式压力传感器的影响及其对策研究[J].传感技术学报,2013,26(8):1178-1182.
[3] Giulio Fragiacomo,Kasper Reck,Lasse Lorenzen.Novel Designs for Application Specific MEMS Pressure Sensors[J].Sensors,2010,10(11):9541-9563.
[4] 史晓晶,陈德勇,王军波.一种新型微机械谐振式压力传感器研究[J].传感技术学报,2009,22(6):790-793.
[5] 海潮和,韩郑生,周小茵.提高SOI器件和电路性能的研究[J].半导体学报,2006(S1):322-327.
[6] 张晓莉,陈水金.耐高温压力传感器研究现状与发展[J].传感器与微系统,2011,30(2):1-4.
[7] Guo S W,Harald E,Kimiko C.High Temperature Smart-Cut SOI Pressure Sensor[J].Sensors and Actuators A:Physical,2009,154 (2):255-260.
[8] 许高斌,李凌宇,陈兴,等.SOI基纳米硅薄膜超微压压力传感器研究[J].电子测量与仪器学报,2013,27(12):1107-1113.
[9] 王伟.SOI高温压力传感器设计及制备技术研究[D].中北大学,2013:8-9.
[10]Guo S W,Tian X D,Wang W.Temperature Characteristics of Microcrystalline and Polyerystalline Silicon Pressure Sensor[J].Sensors and Actuators A:Physical,1990,21(1):133-136.
[11]孙以材,刘玉岭,孟庆浩.压力传感器的设计制造与应用[M].北京:冶金工业出版社,2000,4:126-127.
[12]San Haisheng,Zhang Hong,Zhang Qiang,et al.Silicon-Glass-Based Single Piezoresistive Pressure Sensors for Harsh Environment Applications[J].Journal of Micromechanics and Microengineering,2013,23(7):75020-75027.

李丹丹(1991-),女,湖南岳阳人,中北大学仪器与电子学院硕士研究生,精密仪器及机械专业,导师熊继军老师,副导梁庭老师,主要研究方向为SOI高温硅压阻式压力传感器的设计和制备,对硅压阻式压力传感器的工作原理和制备过程有一定的了解,熟悉MEMS加工工艺流程和工艺设计等;

梁庭(1979-),男,山西长治人,博士,副教授,主要从事MEMS高温压力传感器、微光学集成气体传感器、宽禁带半导体传感器以及MEMS微加工工艺等的研究;

熊继军(1971-),男,湖北浠水人,博士,教授,主要从事纳机电器件基础研究、微系统集成和动态测试技术等方面的研究,xiongjijun@nuc.edu.cn。
Design of SOI High Temperature Pressure Sensor
Based on MEMS Process*
LI Dandan1,2,LIANG Ting1,2,LI Sainan1,2,YAO Zong1,2,XIONG Jijun1,2*
(1.Science and Technology on Electronic Test and Measurement Laboratory,North University of China,Taiyuan 030051,China;2.Key Laboratory of Instrumentation Science and Dynamic Measurement,Ministry of Education,North University of China,Taiyuan 030051,China)
By using the process of diffusion,etching,oxidation,sputtering in MEMS(micro electro mechanical system)process,the SOI high temperature pressure sensor chip is prepared,and the vacuum chamber is formed between the back of sensor chip with the glass through the electrostatic bonding process,finally the sensor chip and the peripheral equipment is connected through the wire bonding process.Test the packaged sensor chip under high temperature with high pressure,the test results shows that in the temperature range 21℃(at room temperature)to 300℃,the sensor chip can work normally in the pressure scale,the linearity of the sensor chip is decreased from 0.9 985 to 0.9 865,controlled in a small range.The performance test results under high temperature pressure shows that the pressure sensor can be used for pressure measurement in 300℃harsh environment,the stable performance under high temperature has provided reference for the development of piezoresistive pressure chip.
high temperature pressure sensor;piezoresistance;sensitive membrane;SOI(Silicon on Insulator);MEMS(Micro Electro Mechanical System)
TN305.1
A
1004-1699(2015)09-1315-06
项目来源:国家杰出青年科学基金项目(51425505)
2015-04-08修改日期:2015-07-01

