InAs/GaInSb超晶格薄膜结构与电学性能
陈道明,国凤云,张新建,白贵元,赵连城
(1.中国工程物理研究院材料研究所,四川江油 621907; 2.哈尔滨工业大学材料科学与工程学院,黑龙江哈尔滨 150001)
InAs/GaInSb超晶格薄膜结构与电学性能
陈道明1,2*,国凤云2,张新建1,白贵元1,赵连城2
(1.中国工程物理研究院材料研究所,四川江油 621907; 2.哈尔滨工业大学材料科学与工程学院,黑龙江哈尔滨 150001)
采用分子束外延(MBE)方法,调节生长温度、Ⅴ/Ⅲ束流比等参数在(001)GaAs衬底上生长了InAs/ GaInSb超晶格薄膜。结果表明:InAs/GaInSb超晶格薄膜的最佳生长温度在385~395℃,Ⅴ/Ⅲ束流比为5.7∶1~8.7∶1。高能电子衍射仪(RHEED)原位观测到清晰的GaAs层(4×2)、GaSb层(1×3)和InAs层(1×2)再构衍射条纹。获得的超晶格薄膜结构质量较好。随着温度的升高,材料的载流子浓度和迁移率均上升。
InAs/GaInSb;超晶格薄膜;分子束外延
1 引 言
随着红外探测和成像技术在武器装备系统中的迅猛发展,光学制导将成为精确制导武器技术的主导。红外探测技术还被广泛应用于遥控、跟踪、预警、夜视、观测、瞄准以及医疗与自动控制等军事和国民经济诸多领域。美国Los Alamos国家实验室的Smith等[1]和美国海军实验室的Youngdale等[2]指出了InAs/Ga1-xInxSb超晶格材料用于红外探测的应用潜力,以其为代表的Ⅲ-Ⅴ族Ⅱ类超晶格材料受到发达国家军方的重视,被视为有望替代TeCdHg(MCT)的首选材料[3]。由于量子点材料的阈值电流密度较低,所以在制作半导体器件上极具吸引力[4-5]。InAs/GaInSb超晶格材料具有隧道暗电流低、俄歇复合率低、探测波长可调和面阻高等突出的优点[6-8],通过调节InAs层厚度、GaInSb层厚度和In含量等可改变InAs/ GaInSb的能带结构,所制作的红外探测器可实现在2~40 μm之间的任意波段工作[9-10]。随着红外焦平面阵列探测器在航空航天中的应用[11], InAs/GaInSb红外探测器将具有更广阔的应用前景。
分子束外延方法是一种在清洁的超高真空条件下利用各组分元素制备单晶薄膜的生长技术。像不同类型红外探测器件在性能优化及物理机制[12]等方面存在制约一样,制约InAs/GaInSb超晶格材料在红外探测领域应用的主要因素有:合适的应变补偿方法和界面控制;超晶格材料结构设计及质量控制;相关工艺参数的选取及优化等。关于InAs/GaInSb超晶格薄膜的层厚、In含量、应变及位错等基础计算尚少见报道,对材料结构质量和电学性能等也缺乏分析。本文计算了超晶格薄膜的基础物性参数,并分析了影响其结构和电学性能的因素。
2 实 验
2.1 材料设计
InAs/GaInSb超晶格材料属于第Ⅱ类破隙型超晶格,其中InAs层的导带低于GaInSb层的价带,使电子集中在InAs层中,而空穴集中在GaInSb层中[13],如图1所示。研究者多以GaSb作为薄膜生长的基板,其与InAs/Ga1-xInxSb超晶格的晶格失配度较小,可降低外延层中的缺陷,使超晶格薄膜结构质量提高;但缺点是GaSb具有较高的本征掺杂浓度,导致器件隧穿电流较大,同时对GaSb衬底材料的改性较难,生产成本较高。GaAs衬底的成本较低,与GaSb、InAs相比,晶格失配约为7%。本文在成熟的GaAs衬底上再外延生长一层GaSb缓冲层,以期获得较好的质量,作为最终器件生长的基板。
影响InAs/Ga1-xInxSb超晶格薄膜结构质量的主要因素有生长温度、InAs/Ga1-xInxSb各层厚度和Ⅴ/Ⅲ族束流比等。在适当的基底温度下,薄膜会从非晶态经过多晶结构向单晶结构发展。生长温度对薄膜中的缺陷等也有较大影响。温度过低不利于表面原子的扩散迁移过程,影响生长速率;温度过高则不利于薄膜成分的控制。生长温度会影响表面上的一切过程,如吸附粒子的数目、表面扩散、凝结以及岛的形貌等。
Ⅴ/Ⅲ束流比是决定材料组分和生长速率的关键因素:当Ⅴ/Ⅲ束流比较大时,Ⅴ族原子能够较快且完全覆盖薄膜的生长表面,生长速率只与Ⅲ族原子的粘附系数等因素有关,因而生长速率会呈现出饱和现象;当Ⅴ/Ⅲ束流比较小时,Ⅴ族原子在生长表面的覆盖程度小,薄膜的生长速率与表面Ⅴ族原子的数量息息相关。经过前期理论计算和实验验证,设计使用的Ⅴ/Ⅲ族束流比为5∶1~11∶1。周期及各层厚度等因素对超晶格材料中的应变分布及晶格常数会产生影响,厚度太大无法形成超晶格结构,厚度太小则控制生长过程较难,同时可能造成原子面的铺排不完整,缺陷增多等。
2.2 薄膜生长
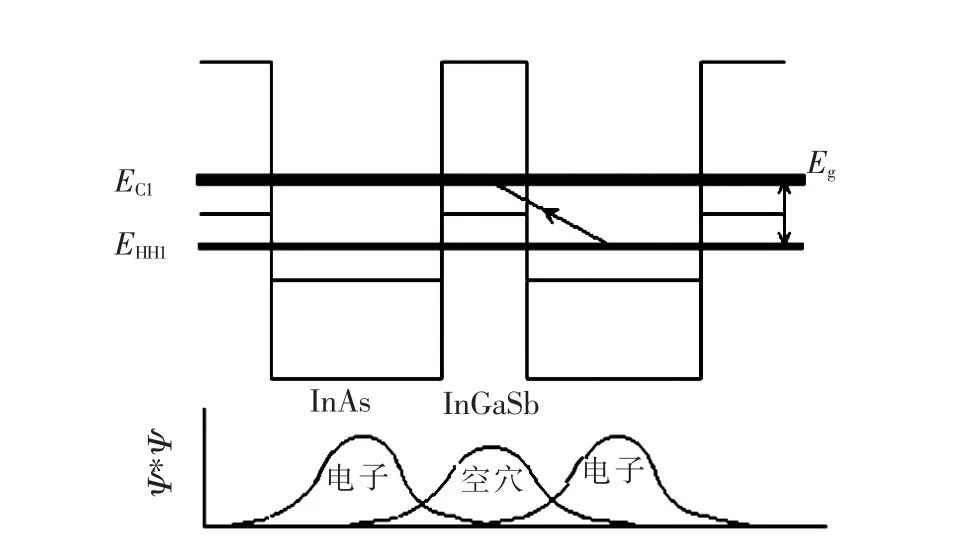
图1 InAs/GaInSb超晶格能带结构[13]Fig.1 Band structure of InAs/GaInSb superlattice[13]

表1 样品生长工艺参数Table 1 Experimental parameters of samples
采用法国Riber公司的Compact21T分子束外延系统生长InAs/Ga1-xInxSb薄膜,生长室的真空度控制在1×10-8~1×10-11Pa。MBE生长过程在反射式高能电子衍射仪、红外测温仪和离子规等监测下进行,可实时监测样品的表面形貌、衬底的表面温度、室内气压和校正源炉束流等。
铟源和镓源均是高纯固态金属,砷源和锑源分别由带阀的裂解炉提供,阀门由气动开关控制,响应时间为0.1 s。实验采用(001)晶向的GaAs为衬底,先外延生长一定厚度的GaAs层,然后再生长GaSb缓冲层,最后交替生长InAs/GaInSb。基于前期的理论设计和异质结薄膜生长实验,本文选取的具体生长工艺参数见表1。在整个生长过程中实时监控Ⅲ族元素(镓和铟)的炉温和束流关系、Ⅴ族元素(锑和砷)的阀门开放率与束流关系,结果表明束源温度或阀门开放率与束流强度呈线性关系。
2.3 样品表征
双晶(DCXRD)摇摆曲线的测量采用的是日本理学(Rigaku)的SLX21AL型X射线衍射仪,辐射源为Cu Kα1射线(λ=0.154 06 nm),Ge(004)作为单色器第一晶体,测量过程采用ω/2θ联动方式(n,-m)排列扫描。超晶格薄膜的载流子迁移率和载流子浓度等电学性能采用半导体综合测试系统测试。
3 结果与讨论
3.1 超晶格薄膜生长的RHEED原位监测
GaAs生长完成后的RHEED衍射呈现出清晰的(4×2)再构图样,如图2(a)所示,表明GaAs层表面较好,可开始进行GaSb缓冲层生长。此时GaAs层的RHEED衍射图样迅速变暗,随着GaSb层的生长,RHEED图样逐渐变为点状,最终显示出清晰的(1×3)再构衍射条纹,如图2(b)所示。随后进行超晶格膜层生长,最后观察到InAs层呈现(1×2)再构条纹,如图2(c)所示。
3.2 超晶格薄膜结构质量
对薄膜进行双晶X射线衍射分析,选取(004)晶面的对称衍射,结果见图3。从图3可以看出:样品SL-1#没有出现卫星峰,所以为异质结薄膜结构,并未形成超晶格结构,原因是生长各层膜厚较大,各层之间近似完全驰豫,可以看成体单晶结构。据文献[14]报道,当超晶格薄膜的周期厚度超过15 nm时,薄膜的性质将由半导体转变为半金属,此时超晶格结构转变为异质结结构。其余样品均出现明显的卫星峰,且级数较多,半峰宽较窄,表明超晶格薄膜生长状况较好。从样品SL-2#与SL-3#的DCXRD图像可以看出,生长温度为385℃的样品的卫星峰级数要多于生长温度为395℃的样品。通过SL-4#、SL-5#和SL-6#样品的图像可以得出,随着Ⅴ/Ⅲ束流比的加大,卫星峰级数有降低的趋势。
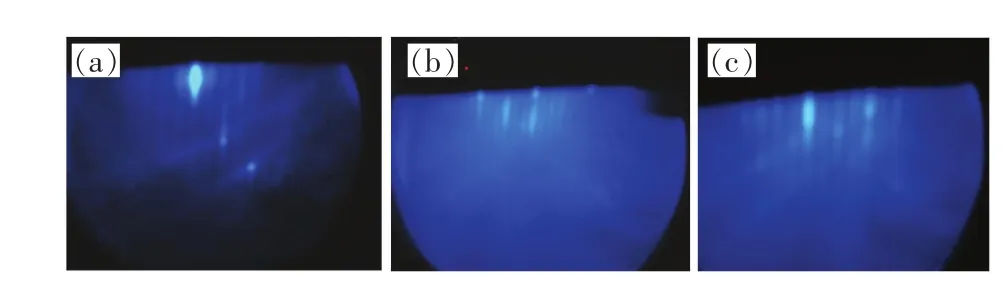
图2 超晶格薄膜生长的RHEED衍射花样。(a)(4×2)再构图样;(b)(1×3)再构图样;(c)(1×2)再构图样。Fig.2 RHEED diffraction pattern of superlattice samples growth.(a)4×2.(b)1×3.(c)1×2.
InAs/GaInSb超晶格薄膜和GaSb缓冲层之间可近似认为是完全共格的,属于小失配情况,对Bragg方程进行微分可得:

式中:Δθ为峰位间距,Δd/d=ε为晶格应变,cotθB为缓冲层Bragg角的余切值,ε为生长方向的应变ε⊥。超晶格的衍射遵守Bragg方程:

式中:D为周期厚度,L为卫星峰的级数,θl为第l级的Bragg角。周期厚度D可通过多量子阱卫星衍射峰间距Δθp计算:

式中:λ为入射X射线的波长,θB为衬底衍射晶面的Bragg角,φ为(001)面与衍射面的夹角,α为晶体表面与(001)面的夹角。
GaInSb的晶格常量随In组分的变化而变化,且其晶格常量在GaSb和InSb晶格常量间变化。通过式(4)对不同的晶格常量进行线性插值即可确定不同的晶格常量所对应的In组分:


式中:xi为一个周期内各层的组分,ti为一个周期内各层厚度,M为周期数。
对于超晶格薄膜材料,标定峰位时将最靠近衬底衍射峰的卫星峰定为零级峰,其峰位为Δθ0,与衬底峰角间距为Δθ'0,有:

根据运动学理论,零级卫星峰的半高宽(FWHM) Δω0为:

图3 超晶格样品SL-1#(a)、SL-2#(b)、SL-3#(c)、SL-4#(d)、SL-5#(e)、SL-6#(f)的DCXRD图谱。Fig.3 DCXRD figures of superlattice sample SL-1#(a),SL-2#(b),SL-3#(c),SL-4#(d),SL-5#(e),and SL-6#(f),respectively.

式中:ΔθM为任意两个相邻卫星峰间距。
位错密度是超晶格薄膜质量评估指标中的一项重要参数,X射线衍射双晶摇摆曲线的半峰宽反映了超晶格薄膜的位错密度ρ,它们的关系可以表示为:

式中:b为位错的柏格斯矢量。
综上所述,通过理论计算和计算机模拟列出超晶格样品的一些测试参数如表2所示。由于样品SL-1#为异质结薄膜,并未形成超晶格结构,因此无法用上述理论对其进行计算和分析。
从计算结果可以得出,Ⅴ/Ⅲ束流比加大和周期厚度减小会使半峰宽加宽,样品缺陷密度增加,应变和失配位错增大。控制周期厚度还和生长层原子表面逃逸现象有关,生长过程中由于生长温度的波动、束流比的改变等致使部分区域没有按逐层生长平铺的模式而出现空缺,造成一定程度的晶面弯曲,进一步使衍射峰宽化。各层厚度的减小增加了原子逐层生长的难度,位错、点缺陷和周期重复性差等因素都会使卫星峰加宽和峰强下降。分析认为,所获得的InAs/Ga1-xInxSb超晶格薄膜晶体质量和结构完整性均较好,GaSb缓冲层与GaAs衬底之间近似完全驰豫,界面共格度较小,而超晶格薄膜与GaSb缓冲层之间的共格度较高,应变层应力驰豫很少。
3.3 超晶格薄膜电学性能
霍尔测试结果表明,外延生长的超晶格薄膜为n型电子占优的半导体材料,载流子迁移率数据如表3所示。载流子的迁移率与等电子杂质效应和缺陷散射等因素有关。由于超晶格薄膜中掺入了铟元素,铟向GaSb层中扩散,镓的电负性为1.81,铟替代了部分格点上的镓,而铟的电负性为1.78,产生等电子杂质效应使铟成为正电中心。同时,锑向InAs层中扩散,砷的电负性为2.18,锑替代了部分格点上的砷,锑的电负性为2.05,锑同样也成为正电中心。生长过程中出现的扩散效应促生大量正电中心,这些正电中心能捕获薄膜中的自由载流子(电子)。同时,生长过程中还存在这种缺陷中心对载流子的散射作用,这种散射作用越大,迁移率就越低。超晶格薄膜的电学性能受到多种因素的共同作用,生长过程中的结构质量控制至关重要。
TeCdHg是中远红外探测中最重要的半导体材料之一,可在室温下工作[15]。从表3中可以看出,300 K下,InAs/Ga1-xInxSb超晶格薄膜迁移率保持在一个较高的水平,有望实现在非制冷情况下工作。温度在一定范围内升高,增加了电子的能量,使得电子逃离正电中心束缚的概率增加,也会使迁移率升高。

表3 超晶格样品的霍尔测试参数Table 3 Hall test parameters of superlattice samples
4 结 论
实验得出了超晶格薄膜的优化生长条件:以GaAs上生长的GaSb层为材料生长的基板,生长温度在385~395℃,Ⅴ/Ⅲ束流比为5.7∶1~8.7∶1,层厚比建议为1~2.5。分析了MBE生长过程和原位监测,在生长过程中束源温度(阀门开放率)与束流强度始终保持线性关系,RHEED原位观测到各膜层清晰的再构衍射条纹。计算了位错密度、垂直应变、晶格常数、x值和半峰宽等重要数据,得到超晶格膜和异质结膜的不同成膜厚度。结果表明,在该工艺参数下获得的超晶格薄膜卫星峰级数较多,半峰宽较窄,晶体质量和结构完整性很好。霍尔测试表明薄膜为电子占优的半导体材料,超晶格薄膜的载流子浓度和载流子迁移率主要是受电子杂质效应和缺陷中心散射作用的影响。随着温度的升高,材料的载流子浓度和迁移率均上升。文中制备的样品在300 K下的迁移率保持在一个较高的水平,电学性能较好,有望实现器件在非制冷情况下工作。
[1]Smith D L,Maihiot C.Proposal for strained typeⅡsuperlattice infrared detectors[J].J.Appl.Phys.,1987,62:2545-2548.
[2]Youngdale E R,Meyer J R,Hoffman C A,et al.Auger lifetime enhancement in In-GaInSb superlattices[J].Appl. Phys.Lett.,1994,64(21):3160-3162.
[3]Bandara S V,Gunapala S D,Liuetal J K.10-16 μm broadband quantum well infrared photodetector[J].Appl.Phys. Lett.,1998,72(17):2427-2429.
[4]Li S W,Miao G Q,Jiang H,et al.Vertically stacked,self-assembled MBE-grown InAs quantum dots and application of field effect transistor[J].Chin.J.Lumin.(发光学报),2002,23(6):554-558(in Chinese).
[5]Xu H X,Wang H L,Yan J Y,et al.Gain and linewidth enhancement factor of InAs/GaAs quantum-dot laser diodes[J]. Chin.J.Lumin.(发光学报),2015,36(5):567-571(in Chinese).
[6]Young M H,Chow D H,Hunter A T.Recent advances in Gal-xInxSb/InAs superlattice IR detector materials[J].Appl. Surf.Sci.,1998,123-124:395-399.
[7]Qiu Y X,Li M C,Zhao L C.The interface structure of InAs/GaInSb strained-layer superlattice[J].J.Funct.Mater. (功能材料),2005,36(9):1316-1319(in Chinese).
[8]Piotrowski J,Rogalski A.Uncooled long wave length infrared photon detectors[J].Infrared Phys.Technol.,2004,46: 115-131.
[9]Zakharova A A,Semenikhin I A,Chao K A.Optical anisotropy of InAs/GaSb broken-gap quantum wells[J].J.Experiment.Theoret.Phys.,2012,114(5):731-737.
[10]Wang D,Donetsky D,Jung S,et al.Carrier lifetime measurements in long-wave infrared InAs/GaSb superlattices under low excitation conditions[J].J.Electron.Mater.,2012,41(11):3027-3030.
[11]Wang D J,Kuang H P,Zhou G,et al.Design and implementation of data acquisition system for IRFPA detector[J]. Chin.J.Liq.Cryst.Disp.(液晶与显示),2009,24(3):429-432(in Chinese).
[12]Chen J.,Wang Q S.Recent progress of infrared upconversion device based on the integration of OLED[J].Chin.Opt. (中国光学),2015,8(1):17-27(in Chinese).
[13]Zhao L C.The interface structure and photoelectric properties in infrared photoelectric thin films materials[J].China Surf.Eng.(中国表面工程),2009,22(3):1-6(in Chinese).
[14]Mohseni H.InAs/GaSb Superlattices for Infrared Detectors TypeⅡ[D].Northwestern University Dissertation,2001:48.
[15]Zhang J M,Feng G B,Yang P L,et al.Thermal issues of photoconductive HgCdTe detector in mid-infrared laser parameter measurement[J].Opt.Precision Eng.(光学精密工程),2015,23(1):22-30(in Chinese).

陈道明(1988-),男,四川泸州人,工程师,2012年于哈尔滨工业大学获得硕士学位,主要从事材料表面工程和薄膜技术等方面的研究。
E-mail:chendaominght@126.com
Structure and Electrical Properties of InAs/GaInSb Superlattice Film
CHEN Dao-ming1,2*,GUO Feng-yun2,ZHANG Xin-jian1,BAI Gui-yuan1,ZHAO Lian-cheng2
(1.Institute of Materials,China Academy of Engineering Physics,Jiangyou 621907,China; 2.School of Materials Science and Engineering,Harbin Institute of Technology,Harbin 150001,China) *Corresponding Author,E-mail:chendaominght@126.com
InAs/GaInSb superlattice material was grown on(001)GaAs substrates by molecular beam epitaxy(MBE),adjusting the growth temperature andⅤ/Ⅲbeam ratio.The results show that the growth temperature is in the range of 385℃and 395℃,theⅤ/Ⅲbeam ratio is from 5.7∶1 to 8.7∶1.RHEED situ observations to the GaAs layer(4×2),GaSb layer(1×3)and InAs layer (1×2)show clarity reconstructed diffraction fringes,the quality of superlattice structure is better,and with increasing temperature,the carrier concentration and mobility of the material are increased.
InAs/GaInSb;superlattice film;molecular beam epitaxy
O484.4
:ADOI:10.3788/fgxb20153611.1252
1000-7032(2015)11-1252-06
2015-07-13;
:2015-09-18

