锑化铟离子注入退火技术研究
李海燕,杜红艳,赵建忠
(华北光电技术研究所,北京100015)
1 引言
InSb是一种Ⅲ-Ⅴ族窄禁带化合物半导体,是目前研制3~5 μm波段红外焦平面阵列的重要半导体材料。在InSb红外焦平面阵列的研制中,常用扩散和离子注入两种方法掺杂成结,近年来,离子注入方法因其对掺入杂质精确的控制能力逐渐取代扩散法[1]。由于离子注入工艺过程中会对衬底材料晶格结构造成损伤,同时掺入杂质并未处于激活状态,因此需要采用退火工艺消除晶格损伤,激活注入杂质。常用退火方法有两种,一种是常规退火,一种是快速热退火,相较于常规退火,快速热退火升温快,退火时间短,具有杂质激活率高、再分布小、损伤缺陷消除好等优点[2]。本文针对Be离子注入掺杂的InSb材料进行快速热退火技术研究,分析不同退火条件下的注入InSb损伤恢复情况以及注入Be的激活状况,以确定最佳退火条件。
2 机理分析
一定能量的入射离子进入晶体后,与晶体中的原子相互作用,使晶体中的原子经碰撞后获得足够的能量摆脱晶格束缚,离开它的平衡位置进入间隙,形成缺陷对,此外,被移位的原子也可能把它的能量依次转移到其他原子上,发生级联移位,形成更多的缺陷,当注入离子数量增加时,这种缺陷可能重迭、扩大成复杂的损伤,考虑到实际晶体中杂质与缺陷的相互影响以及缺陷的复合扩散等因素,可以想象,离子注入给晶体造成的辐射损伤,可以是简单的点状缺陷,也可以形成更为复杂的损伤复合体,甚至是完全无序的非晶层,这些辐射损伤将直接影响半导体器件的电性能,使迁移率和寿命等半导体参数受到影响[3],因此通常采用热处理的方式——退火,以消除辐射损伤造成的缺陷,使损伤的晶格得到一定程度的恢复,同时使杂质原子处于替位式的激活状态[4]。在退火环境下,材料中注入杂质Be替代与其原子大小及电子壳层相近的In成为替位式杂质,同时在高温下通过原子振动和移位消除辐射损伤造成的缺陷,使损伤的晶格得到一定程度上的恢复。
常用的两种退火方式为常规热退火和快速热退火,常规热退火即在真空或者充有保护气体的石英管内进行,退火设备简单,退火过程时间长,容易造成杂质的再扩散、图形畸变并可能引入新的杂质,较于快速热退火杂质激活率不够高,缺陷消除不完全,因此本研究中采用快速热退火的退火处理方式,快速热退火过程升温快,杂质来不及扩散,特别适用于高密度窄间距的平面结工艺[5]。在退火过程中,退火时间不足或是退火温度过低,都会使缺陷不能完全消除,残留较小位错及空洞,且杂质激活率不高;一定退火温度的情况下退火时间过长则容易引发热缺陷;一定退火时间条件下退火温度过高会引起InSb 分解[6]。
3 实验
实验采用<111>晶向的N型InSb单晶,材料熔点为525℃,直径2 in,在77 K条件下,载流子浓度为1014~1015cm-3,电子迁移率 μn>105cm2V-ls-1,经切、磨、抛,超声清洗,表面腐蚀后,生长一定厚度的SiO2作为注入保护层,一方面用于防止注入过程中的表面污染,另一方面减弱注入沟道效应。在室温下注入Be+,注入能量为100 keV,注入剂量为1014cm-2,注入时样片偏转7°,以减弱沟道效应。
快速热退火在半导体快速热处理设备中进行,退火前在InSb表面生长一定厚度的SiO2做为退火保护层,同时退火环境为氮气氛围。将实验范围设置如下:退火温度范围为300~450℃,退火时间为5 ~120 s。
4 实验结果及分析
注入形成的损伤如位错环、空洞等大部分分布在衬底表面及注入杂质峰值浓度深度附近这两部分区域,注入杂质大部分处于间隙位置而没有发挥提供载流子的作用[5-7]。对上述材料进行快速热退火,退火实验条件设置如表1所示。
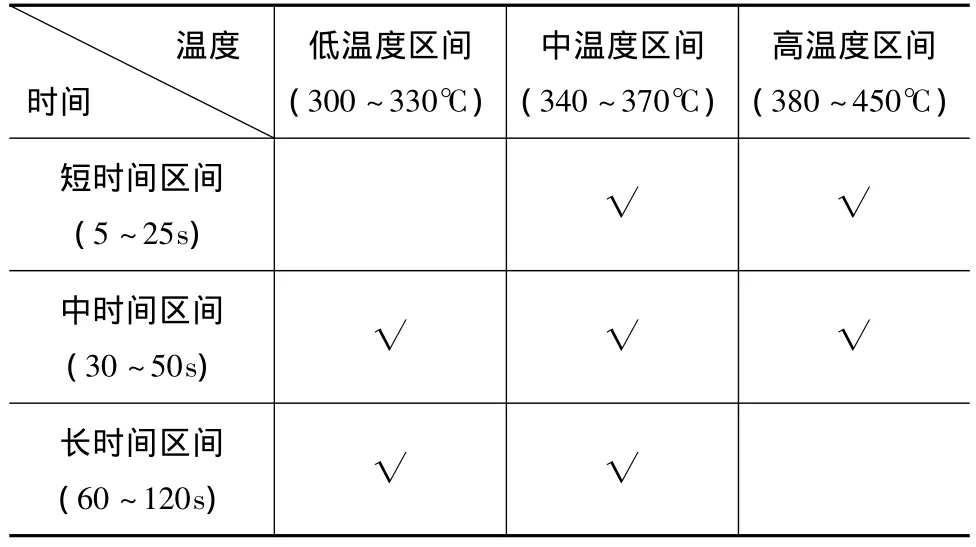
表1 退火条件设置
暂不考虑表面钝化及测试过程中其他不可控因素的影响,根据中测得到的PN结性能曲线,将测试结果大致分为以下几类:
(1)低温度区间,中时间区间的退火条件下,得到的PN结测试曲线如图1所示。

图1 低温中时间退火条件下的PN结I-V特性曲线
在退火温度低的情况下,中等退火时间范围的退火环境提供的能量不足以使衬底材料获得足够的能量通过衬底材料中的原子移动消除注入损伤,同时离子注入杂质也没能获得足够的能量从间隙位置转换到替位位置发挥受主作用,此时的PN结性能很差。
(2)低温度区间,长时间区间的退火条件下,部分测试结果得到的PN结测试曲线如图2所示,大部分I-V曲线中反向电流随反向电压增大而明显增加,退火效果重复性差。

图2 低温长时间退火条件下的PN结I-V特性曲线
可见,虽然退火温度较低,但是退火时间达到一定程度时,仍就可以激活数量可观的注入杂质,并且能修复大部分损伤,在一定的外加电压的作用范围内下表现出不错的PN结性能。部分晶格损伤,在此退火环境无法消除,导致外加反向电压增大时,器件中的漏电流成分增加,PN结性能降低。
(3)在中温度区间,短时间区间的退火条件下,得到的PN结的I-V测试曲线呈现出短路的性状。可以认为这种条件下由于退火时间过短,没有形成PN结,材料整体特性以N区为主,并且注入损伤也没有得到很好地修复,衬底中的损伤仍然以点缺陷以及位错等形式存在,在外加电压的作用下很容易击穿,呈现出短路的性能特点。
(4)在中温度区间,中时间区间的退火条件下,得到的PN结的I-V测试曲线如图3所示。

图3 中温中时间退火条件下的PN结I-V特性曲线
在此退火条件下,大部分的PN结测试结果如图所示,表现出了相对较好的PN结性能曲线,表明在此退火条件下,注入杂质得到最大限度的激活,退火损伤也得到最大限度的修复,但结中仍然存在部分缺陷使得反向电压增大时,结的性能会缓慢变差。
(5)在中温度区间,长时间区间的退火条件下,得到的PN结的I-V测试曲线如图4所示。
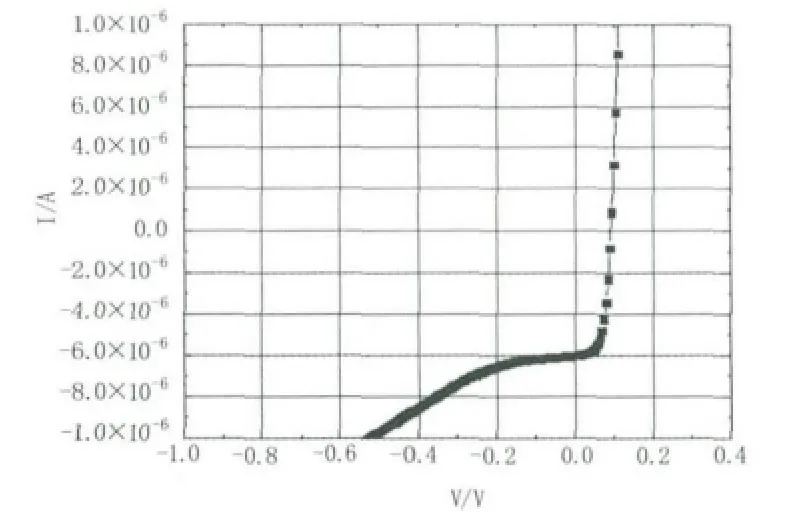
图4 中温长时间退火条件下的PN结I-V特性曲线
表明在此退火条件下,由于退火时间过长,在衬底材料中诱发二次缺陷,此外,在此退火温度下仍然会残留一些注入损伤,材料内部存在晶格结构不稳定的因素,因此当反向电压增大到一定程度时,容易发生击穿现象。
(6)在高温度区间,低时间区间的退火条件下,得到的PN结的I-V测试曲线如图5所示。
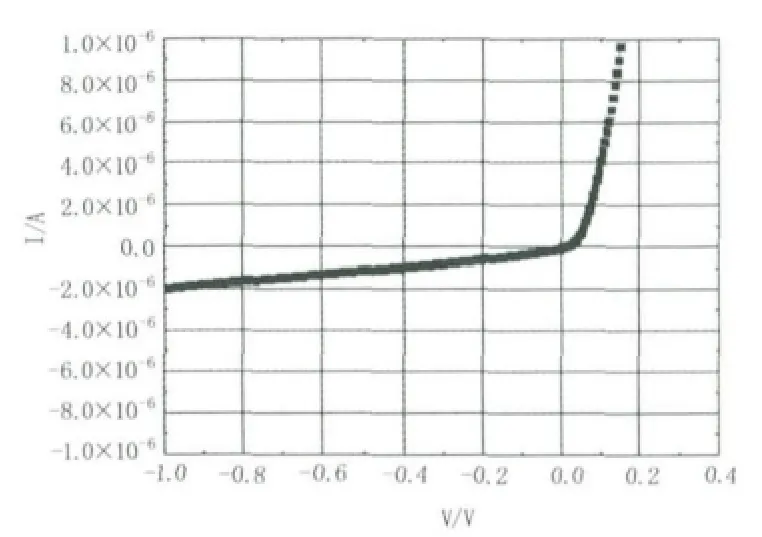
图5 高温短时间退火条件下的PN结I-V特性曲线
在此退火条件下,衬底材料中已经形成了PN结,但是由于退火时间过短,杂质激活率较低,衬底中仍然存在大量的缺陷,所以在光照情况下光生载流子无法到达PN结区域形成光生电流。
(7)在高温度区间,中时间区间的退火条件下,得到的PN结的I-V测试曲线如图6所示。

图6 高温中时间退火条件下的PN结I-V特性曲线
退火温度过高,导致退火过程中在衬底材料中形成新的热缺陷,同时,温度过高造成InSb近表面热分解,成分失配,在反向电压增大时电流明显增大,器件性能变差。
5 结论
在一定的退火过程中,退火时间不足或是退火温度过低,都会使缺陷消除不完全,且杂质激活率不高;一定退火温度的情况下退火时间过长则容易引发热缺陷;一定退火时间条件下退火温度过高会引起InSb分解并带来新的热缺陷[6]。对注入能量为100 keV,注入剂量为1014cm-2的 Be+注入 InSb晶片进行了快速退火实验,退火温度范围为300~400℃,退火时间为5~120 s。研究发现经过一定实验条件下快速热退火能得到高质量的PN结。
[1] Du Hongyan.PN junction in InSb by Be ion implantation[J].Laser& Infrared,2012,42(2):161 -164.(in Chinese)杜红艳.InSb中Be离子注入成结研究[J].激光与红外,2012,42(2):161 -164.
[2] Zhaug Tingqing,Liu Jialu.Study of be - implanted lnSb under RTA[J].Journal of Semiconductors,1994,15(1):35 -38.(in Chinese)张廷庆,刘家璐.铍注入锑化铟快速热退火[J].半导体学报,1994,15(1):35 -38.
[3] Zhang Tingqing,Liu Jialu.Effect of rapid thermal annealing on declation of stolichiometry in surface layer of InSb[J].Microfabrication technology,1991,2:62 - 65.(in Chinese)张廷庆,刘家璐.快速热退火对锑化铟表面化学配比的影响[J].微细加工技术,1991,2:62 -65.
[4] Zhang Guodong,Sun Weiping,Ni Yongping.Planar InSb photodiodes array chips fabricated by Mg ions implantation[J].Infrared and Laser Engineering,2005,34(1):19 -22.(in Chinese)张国栋,孙维国,倪永平.Mg离子注入成结制备InSb光电二极管阵列研究[J].红外与激光工程,2005,34(1):19-22.
[5] Gong Xiaoxia,Su Yuhui,Lei Shengqiong.Design of ion Implantation of InSb p-on-n Photovoltaic Device[J].Infrared Technology,2009,31(4):232 - 235.(in Chinese)龚晓霞,苏玉辉,雷胜琼.锑化铟p-on-n光伏器件的离子注入设计[J].红外技术,2009,31(4):232 -235.
[6] S J Pearton,A R Von Neida,J M Brown,et al.Ion implantation damage and annealing in InAs,GaSb,and GaP[J].Journal of Applied Physics,1988,64(2):629 -636.
[7] R Callec,A Poudoulec.Characteristics of implantation induced damage in GaSb[J].Journal of Applied Physics,1993,73(10):4831 -4835.

