H P-6 0 2型化学腐蚀抛光机研制技术及应用
陈仲武,宋文超
(中国电子科技集团公司第四十五研究所,北京 101601)
H P-6 0 2型化学腐蚀抛光机研制技术及应用
陈仲武,宋文超
(中国电子科技集团公司第四十五研究所,北京 101601)
介绍了抛光片化学腐蚀抛光原理和HP-602型化学腐蚀抛光机设备用途、结构组成、性能特点,以及解决的关键技术和应用,能自动完成晶片抛光后的碱腐蚀和清洗工艺,是材料行业晶片制备中的关键设备。
化学腐蚀抛光;循环溢流槽;自动传输机构;PEEK提篮
随着大规模集成电路和微电子技术向高密度、高集成度和高可靠性方向发展,对半导体材料的要求也越来越高,晶片表面质量和厚度一致性等参数指标,对后序的器件工艺及集成电路工艺有着至关重要的影响,直接影响器件成品率、性能和可靠性。化学腐蚀抛光是晶片制备中最重要的步骤,本文主要介绍化学腐蚀抛光工艺原理、设备研制和典型工艺参数。
1 工艺原理
晶片研磨之后,晶片表面还有一定量的均衡损伤,要将这些损伤去除,但尽可能低的引起附加的损伤,比较常用的就是采用化学腐蚀方法:碱腐蚀和酸腐蚀。两种方法都被应用于溶解晶片表面的损伤部分,而且都有各自的优缺点。但从腐蚀速率、表面质量、控制难易、环境影响等方面比较,一般都采用碱腐蚀为主,腐蚀清洗完成后晶片表面无碱印、无花篮印、无花纹、无色差,合格率达到99%以上。
碱腐蚀使用碱性氢氧化物如氢氧化钾(KOH),KOH与硅片的基本反应式为:Si+2H2O+2KOH→2H2+Si(OH)2(O)2+2K+。用这种方法,晶片浸在45%的KOH和55%纯水的溶液中,溶液加热至约100℃,温度精度控制在±2℃以内,腐蚀完成后,需要将晶片尽快浸入纯水以阻断KOH与晶片表面之间的继续反应。由于采用多片(50~100片)同时腐蚀,为了提高腐蚀速率、腐蚀表面质量和片间均匀性,装片盒提篮可以在腐蚀槽上下抛动,化学液溢流循环并过滤,从腐蚀槽到快排冲洗槽时间不超过3 s,对纯净水冲洗压力流量都有较高要求,工艺过程除了上下料外,腐蚀、传输和冲洗过程全自动完成,对设备功能和可靠性要求较高,除了机架、槽体、管路、控制等设计外,工艺程序可以编程、参数可以界面设定,并有检测、保护和安全措施。
2 设备组成和工作原理
HP-602型化学腐蚀抛光机(以下简称设备)主要用于晶片研磨之后的腐蚀、清洗工艺,主要实现KOH腐蚀和快排冲洗槽(QDR)喷淋冲洗等工艺功能;设备组成包括机架、PTFE腐蚀溢流槽、QDR快排冲洗槽、PEEK提篮、传输机构、管路部分、排风排液部分和电气控制部分(见图1、图2);槽体设计兼容晶片 50 mm(2 英寸)、75 mm(3 英寸)、100 mm(4英寸)、125 mm(5英寸)和 150 mm(6英寸),每批次处理4盒100片。
设备工作原理:开机后,人工手动从设备前方QDR槽处上料,在提篮里可以同时放置4片盒,由传输机构翻转到PTFE腐蚀槽,完成腐蚀工艺后传输机构自动翻转到QDR快排冲洗槽清洗,传输时间不超过3 s,清洗结束后提示人工手动取出片盒,然后进行下一批次腐蚀清洗。

图1 设备外形图
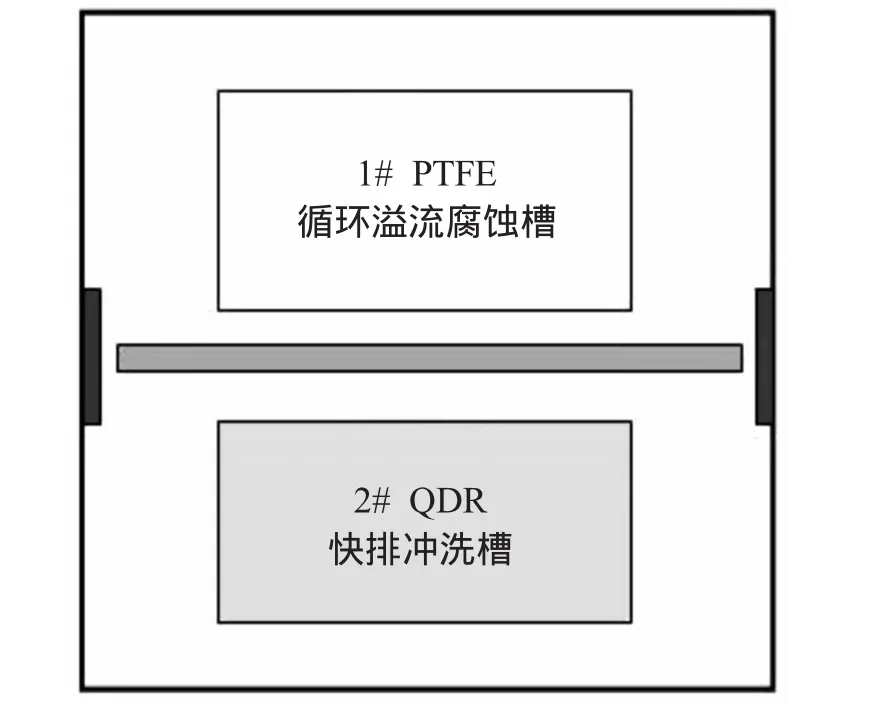
图2 设备台面布局图
2.1 槽体功能
PTFE循环溢流腐蚀槽由PTFE工艺槽、储液槽、管路在线加热、循环泵及管件管路系统组成,其结构原理见图3,具有腐蚀、溢流循环、在线加热、过滤和排放冲洗功能,工艺过程和工艺时间可以编程。槽体由PTFE材料一体注塑成形,为四面V型循环溢流结构;液体加热采用管路PFA在线加热器(12 kW),加热温度范围:室温~100℃,精度±2℃,温度检测采用铂电阻(全氟保护套)温度探头浸没在槽体(中间位置)溶液中的方式检测,再利用温控仪进行控制;溶液循环采用高温全氟风囊泵实现溶液循环,流量最大40 L/min;管路装有全氟过滤器,过滤精度10 μm;槽内安装有N2液位检测系统,当液面过低时发出声光报警;溶液的供应采用人工手动配液至储液槽,通过循环泵将溶液打入工艺槽中,满足工作液位后进行自循环工艺运行;溶液排放时利用工作循环泵将内外槽及管路中溶液排放至贮液槽。溶液在贮液槽自然冷却后,人工操作按钮控制气控阀排放专用管道,排放温度小于50℃,由程序互锁保护,在排放口处安装有手动阀门进行二次保护;定期对槽体和循环管路进行DI水清洗,可以通过界面选择操作,清洗自动完成,避免槽体管路KOH结晶。
QDR快排冲洗槽主要由喷淋槽、溢流槽、匀流板、快排气缸、喷管喷嘴、氮气鼓泡、管路和管件等组成,其结构原理见图4,具有喷淋、溢流、快排和氮气鼓泡等功能,各功能的运行时间及次数可编程控制。槽体由NPP板材焊接加工而成,底部DI水注入,上部DI水喷淋,注入时间小于60 s,排放时间小于6 s;为了增加清洗效果,喷嘴采用实心圆锥,喷出的DI水不可雾化,底部增加氮气鼓泡;注入喷淋DI水通过储水槽采用磁力泵供给,满足冲洗压力和流量。
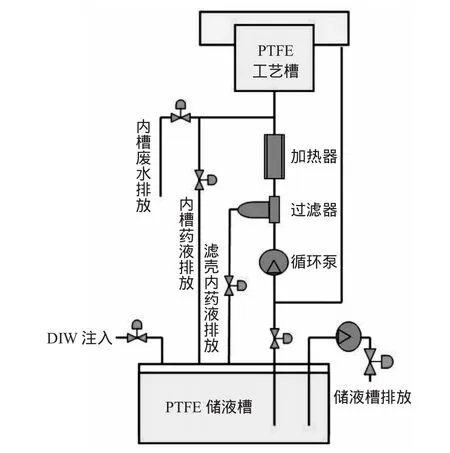
图3 PTFE腐蚀溢流槽结构原理图
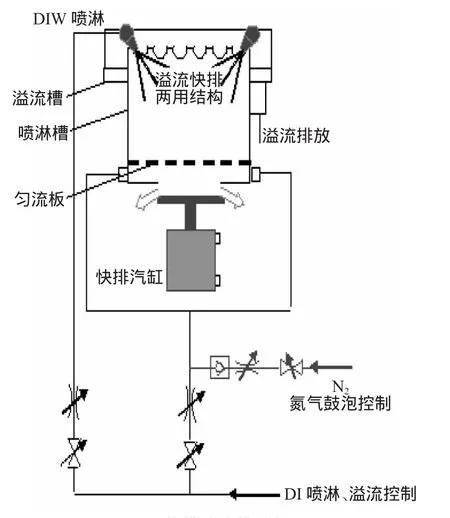
图4 QDR快排冲洗槽结构原理图
2.2 自动传输机构
自动传输机构由电机驱动部分、旋转摆臂部分和提篮组成(见图5),主要功能是把放有片盒(装有待腐蚀晶片)的提篮,自动传输到腐蚀槽内,完成腐蚀工艺后,再自动传输到QDR快排冲洗槽内,进行清洗工艺。主要难点是:(1)每批次处理4片盒100片,负载较大;(2)提篮从PTFE腐蚀槽摆动到QDR快排冲洗槽,时间不超过3 s;(3)驱动位置精度、可靠性和安全性。电机驱动部分安装在设备顶部,与腐蚀湿区隔离,由伺服电机驱动,同步带传动,电机转速可调,增减速编程,可以正反转,摆动位置通过脉冲和信号凸轮控制,增加位置保护和自锁功能,实现位置精确传输,避免撞车或者位置过冲,为了增加腐蚀效果和腐蚀均匀性,提篮在腐蚀槽内上下抛动,抛动频率30~60次/min,抛动行程60~100 mm,在范围内可以通过界面设定。旋转摆臂安装在机架两侧,由同步带驱动,实现正反转摆动和腐蚀槽内上下抛动,速度位置可调,对提篮挂钩采用同步带反向定位,保证提篮位置垂直向下,避免在传输过程中片盒移位或者晶片掉出,同时对旋转摆臂结构设计和材料选用进行防腐保护处理。

图5 设备自动传输和摆臂结构图

图6 设备提篮结构图
2.3 PEEK提篮
提篮采用具有较好机械强度、耐高温、耐腐蚀的PEEK材料加工制造,结构设计如图6所示,四周敞开,上部直杆为提篮受力支撑部分,两端与摆臂挂钩连接,易于取放和定位;提篮底板为片盒定位,除了片盒四角定位外,片子位置部分为中空结构,连接部分也开孔,既减轻质量,又易于溶液循环、提篮抛动和DI水冲洗;两端端板连接提篮底板和上部直杆,设计为中空结构,片盒上部有压杆,防止晶片在腐蚀和抛动时移出片盒。另外,由于PEEK材料是一种经受极强化学腐蚀的材料,具有良好的耐热、物理电阻和环境电阻性能,易于加工也是重要的特性之一,所以在KOH溶液浓度50%,温度在90℃~130℃的溶液和常温DI水中交替使用,仍可保持优良的机械性能和材料稳定性,并通过用户长时间使用验证,也是实现晶片腐蚀清洗后晶片表面无碱印、无花篮印、无花纹、无色差的重要条件之一。
3 设备主要特点
(1)设备结合国外最新技术和工艺,应用成熟单元技术,正面操作区采用左右对开门结构,观察窗为透明PVC材料,侧面开有PVC活动门(在KOH腐蚀槽位置),以便用户观察腐蚀情况;排风装置由引风窗及排风口等组成,引风窗位于槽体后方,排风口(2个)位于设备后上部,排风口有手动调节装置;设备前、后下方及设备左右两侧均设有维护门。
(2)设备控制部分与湿区隔离,通过PLC实现控制功能,操作面板位于设备前上部,控制按钮及主要显示仪表设置其上,用户可根据需要,通过触摸屏对整机工艺实现参数设置和控制。制程区设有照明装置,照明装置和湿区隔离,设备具有风压检测功能,以及氮气和压缩空气压力报警功能。
(3)PTFE循环溢流槽采用一体注塑成形,避免加热变形;具有储液槽和冲洗功能,避免槽体管路结晶,通过循环在线加热,实现温度精度;QDR快排冲洗槽通过磁力泵控制流量和压力,实现晶片化抛后的表面质量。
(4)自动传输机构通过伺服电机驱动,同步带传送,信号凸轮和脉冲控制位置,实现正反转和增减速编程,抛动行程和频率可以设定,位置精度高,传输快速平稳,运行安全可靠。提篮材料选用PEEK,具有耐高温、耐腐蚀和易加工特点,结构设计合理,满足工艺使用和成品率要求。
(5)管路、接头、电磁阀、溶液阀、泵和过滤器等采用品牌产品,符合1000级净化等级要求,管路设计合理,连接可靠,化学液温度、流量、压力控制和循环系统精度高,具有设定、显示和故障报警等功能。
4 小 结
该设备研制成功投入用户使用以来,通过连续运行和大量产品证明,晶片腐蚀清洗完成后表面无碱印、无花篮印、无花纹、无色差,合格率达到99%以上,工艺参数稳定,批量处理能力强,完全可以替代进口设备。同时可以应用到继硅之后的砷化镓等新一代半导体功能材料,其抛光片质量将显著提高器件的成品率、性能和可靠性,以满足制造高性能微波变频器件及光电器件,广泛应用于雷达通讯、精确制导、新一代卫星通信等系统,以缩短与国外先进技术的差距,为国内材料行业工艺发展和装备制造奠定基础。
:
[1]刘传军,赵权,刘春香,等.晶片清洗原理与方法综述[J].半导体情报,2000,(02):30-36.
[2]杨洪星,吕菲,赵权,等.砷化镓抛光片总厚度变化之研究[J].半导体情报,2001,(05):55-57.
The Manufacturing Technique and Application of HP-602 Chemical Corrosion Polishing Equipment
CHEN Zhongwu,SONG Wenchao
(The 45thResearch Institute of CETC,Beijing 101601,China)
Abstract:The wafer chemical corrosion polishing process is introduced.The applications,structure,characteristics,and the key techniques of HP-602 chemical corrosion polishing equipment are also introduced.The alkali corrosion and cleaning process of the polished wafer can be automatically processed in the equipment.The HP-602 chemical corrosion polishing equipment is the key equipment of material manufacturing.
Keywords:Chemical corrosion polishing;Cycling and overflowing tank;Automatically transmission mechanism;PEEK basket
TN305
B
1004-4507(2013)12-0031-05
2013-10-15
陈仲武(1966-),男,甘肃合水,高级工程师,主要从事半导体专用设备研究与开发,近些年主要进行湿法腐蚀清洗设备研发、制造和技术服务,特别是对国外同类设备技术和用户工艺技术有较深入研究。

