氮气含量对硅基AlN薄膜结构及性能的影响
刘永智,李海翼
(甘肃民族师范学院物理与水电工程系,甘肃合作747000)
1 引 言
高性能的AlN在现代半导体产业中成为一种新型的多功能材料,其纤锌矿的AlN具有宽的直接带隙,其禁带宽度为5.9~6.2eV[1],由于它的优越的物理和化学性能,如高击穿场强(10kV/m)、高热导率[3.2W/(cm·K)]、高电阻率、高化学和热稳定性以及良好的光学及力学性能[2]等,能应用于表声波(SAW)和体声波(BAW)器件、金属绝缘体半导体器件、MIS埋层、大规模的绝缘集成电路(ULSI)[3]等领域而吸引了众多半导体工作者.在很多器件的应用中,AlN薄膜的结构和粗糙度对其影响很大,要求其结构必须具有多晶择优取向,组成均匀,表面粗糙度小[4-5],但是目前在沉积AlN薄膜过程中工艺参量对薄膜结构和粗糙度方面的实验研究的报道并不多[6-7].因此研究AlN薄膜的结构和表面粗糙度就比较有意义了.
制备AlN薄膜的方法有化学气相沉积法(CVD)[8]、超高真空电子束蒸发法[9]、等离子体浸没离子注入技术[10]等,反应磁控溅射方法由于低成本且要求相对较低的生长温度而备受关注,已广泛用于大面积沉积各种半导体材料,如SiC和AlN.本文采用直流磁控反应溅射沉积AlN薄膜,以探索氮气含量在整个制备薄膜过程中的重要作用.
2 实 验
采用CKJ-500D多靶磁控溅射镀膜设备,直接在p-Si(111)基底沉积3组AlN薄膜,用直径为100mm,纯度为99.999%的金属Al为靶材,以纯度99.999%的氩气为工作气体,99.999%的氮气为反应气体.真空腔的本底真空度5.0×10-4Pa,沉积过程中溅射气压为0.6Pa,溅射电流为0.40A,基底温度为360℃,溅射时间为180min保持不变,保持氮气和氩气总量不变,改变氮气占总量的百分比.经过多次探索实验,氮气含量过低,薄膜中只有铝生成,而当氮气含量过高(>87.5%)时,沉积过程中靶面严重中毒,实验无法进行,所以本实验的氮气含量范围为25%~87.5%较为合适.
采用英国Bede-D1型X射线衍射仪(XRD)来测试薄膜结构.采用AJ-Ⅲ型原子力显微镜(AFM)对薄膜的表面形貌、表面粗糙度进行分析.采用NICOLET380傅里叶变换红外光谱仪(FTIR)测量薄膜红外吸收光谱.
3 实验结果及分析
3.1 氮气含量对AlN薄膜结构的影响
图1给出在氮气含量分别为25%,37.5%,50%,62.5%,75%,87.5%时制备的AlN薄膜的XRD图.从图1可以看出,薄膜呈现多晶态.可以看出,在25%的氮气含量下,只有金属铝的(311)的衍射峰被观察到,衍射角为2θ=78.2°.37.5%时,渐出现六方相的AlN(002)衍射峰,氮气含量增加到50%时,出现六方AlN(100)、AlN(002)的混合相,随着氮气含量的增加,AlN(100)的衍射峰强度逐渐增大,且出现AlN(110)衍射峰,75%时峰强达到最强,说明此时薄膜的结晶度最好,但当氮气含量过大时(87.5%),薄膜中出现亚稳态的立方向的AlN(200)衍射峰,且六方相的其他衍射峰逐渐消失.这是由于增加氮气含量,样品可以和Al充分发生反应,使得AlN晶粒得以生长.对于给定的气压,增加氮气流量将导致中性粒子流的增加,从而增加了对薄膜的碰撞导致薄膜有了一定的取向.当氮气含量过大时,反应气体充当工作气体,氮气粒子轰击靶材,极易与靶材发生反应,在靶材表面生成不导电的AlN,到达基底表面的AlN粒子较少,从而在表面形成多晶态薄膜.

图1 不同氮气含量下沉积AlN薄膜的XRD图
3.2 氮气含量对AlN薄膜的表面形貌的影响
如图2为6个样品在不同氮气含量下沉积的AlN薄膜原子力显微镜(AFM)三维视图,扫描范围为2 500nm.
由AFM的离线软件可分别得到扫描区域内最大高度h、表面均方粗糙度RMS、平均粒径d,相应数据见表1.
AlN薄膜应用于SAW器件中,由于SAW仅在表面传播,全部的能量几乎只在从表面向内部1个波长之内,当表面粗糙度超过1个波长时,SAW显然无法通过,一般要求薄膜表面粗糙度小于30nm[11].薄膜的表面粗糙度和颗粒大小都随氮气含量的增加先增大后减小,6个样品的粗糙度均小于30nm.在25%的氮气含量下,氮气浓度较低,不足以跟铝原子反应在基底表面生成AlN,其薄膜表面可能只有金属铝原子,所以其平均颗粒尺寸较小,37.5%的氮气浓度下,薄膜表面颗粒相对变大,颗粒之间存在一些直径较大的孔隙.再增大氮气浓度,到75%的氮气含量下,薄膜表面颗粒明显细化,直径减小,高度降低,颗粒之间孔隙变小.随着氮气含量由25%增加到62.5%,薄膜中逐渐生成了AlN,薄膜的厚度增加,表面均方粗糙度由2.6nm增加到3.8nm,之后氮气浓度达到75%时,其表面均方粗糙度减小到3.0nm.


图2 不同氮气含量下沉积AlN薄膜的AFM图

表1 不同氮气含量下沉积的AlN薄膜表面粗糙度和颗粒平均粒径
3.3 AlN薄膜的FTIR分析
图3给出了不同氮气含量下Si基底AlN薄膜在(500~3 500cm-1)红外波段的FTIR图(图中已扣除了Si基底的本底).可以看出,随着氮气含量的增加,在670~700cm-1处出现Al—N的吸收峰,且吸收峰的强度随氮气含量的增加先逐渐增大,之后又逐渐减小.氮气含量为75%时,吸收峰最强,表明此时Al—N键的键密度最强,此结果与XRD图谱的结果相吻合.FTIR可以反映薄膜的晶格振动状态,入射光与光学横模的耦合导致了光在670~700cm-1处被强烈吸收,不能透过薄膜,由此也表明了此时的薄膜确为AlN薄膜.
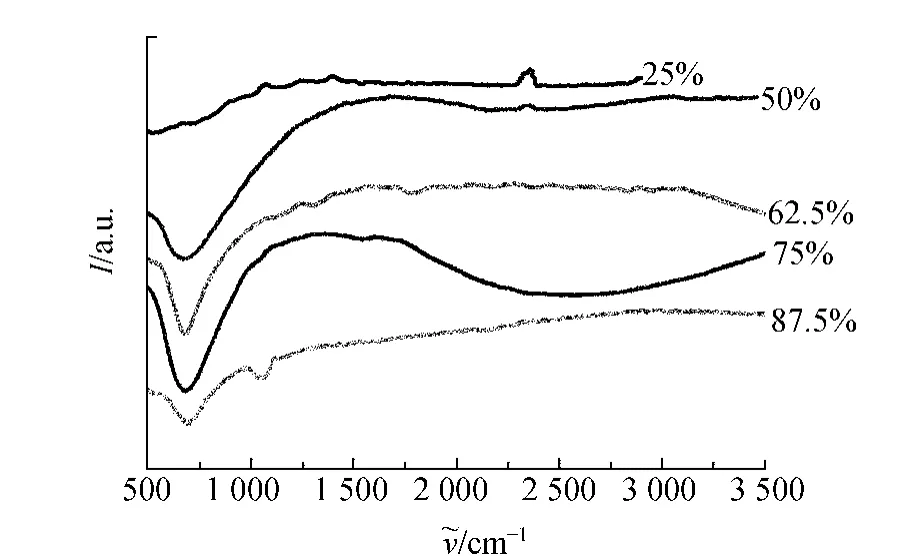
图3 不同氮气含量下Si基底沉积AlN薄膜的FTIR图
4 结 论
利用直流磁控溅射技术成功地制备了AlN薄膜.分析了氮气含量对硅基制备的AlN薄膜结构的影响.氮气含量比较低时,薄膜呈非晶态,随着氮气含量的增加,AlN薄膜中出现了六方相的(100)AlN、(110)AlN和弱的亚稳态的(002)AlN衍射峰;制备的6组薄膜都符合SAW器件的要求,薄膜表面粗糙度小于30nm;在氮气含量为75%时,薄膜的FTIR图谱中出现了强烈的吸收峰,表明薄膜中已经生成了AlN.据本组实验来看,氮气含量为75%时沉积的AlN薄膜质量比较好.
[1] Ishihara M,Li S J,Yumoto H,et al.Control of preferential orientation of AlN films prepared by the reactive sputtering method[J].Thin Solid Films,1998,316(1/2):152-157.
[2] Qiao Bao-wei,Liu Zheng-tang,Li Yang-ping.Effect of technical parameters on deposition rate of AlN films prepared by magnetron reactive sputtering[J].Journal of Northwestern Polytechnical University,2004,22(2):260-263.
[3] Kar J P,Bose G,Tuli S.A study on the interface and bulk charge density of AlN films with sputtering pressure[J].Vacuum,2006,81(4):494-498.
[4] Liu F D,Kao K C.Piezoelectric,dielectric,and interfacial properties of aluminum nitride films[J].Vac.Sci.Technol.A,1998,16(4):2360-2366.
[5] Xu X H,Wu H S,Zhang C J,et al.Morphological properties of AlN piezoelectric thin films deposited by DC reactive magnetron sputtering[J].Thin Solid Films,2001,388(1/2):62-67.
[6] Shukla G,Khare A.Dependence of N2pressure on the crystal structure and surface quality of AlN thin films deposited via pulsed laser deposition technique at room temperature[J].Applied Surface Science,2008,255(5):2057-2062.
[7] Pigeat P,Miska P,Bougdira J,et al.Surface roughness of AlN films deposited on negatively biased silicon and diamond substrates[J].Diamond and Related Materials,2009,18(11):1393-1400.
[8] Dollet A,Casaux Y,Chaix G,et al.Chemical vapour deposition of polycrystalline AlN films from AlCl3-NH3mixtures:Analysis and modelling of transport phenomena[J].Thin Solid Films,2002,406(1/2):1-16.
[9] Ming Z,Peng C,Fu K Y,et al.AlN thin films fabricated by ultra-high vacuum electron-beam evaporation with ammonia for silicon-on-insulator application[J].Applied Surface Science,2005,239(3/4):327-334.
[10] Valcheva E,Dimitrov S,Manova D.AlN nanoclusters formation by plasma ion immersion implantation[J].Surface &Coatings Technology,2008,202(11):2319-2322.
[11] Xu X H,Wu H S,Zhang C J,et al.Morphological properties of AlN piezoelectric thin films deposited by DC reactive magnetron sputtering[J].Thin Solid Films,2001,388(1/2):62-67.

