EUV 掩膜版的等离子刻蚀法
随着集成电路制造技术的进步,尽管CD 已经接近物理和理论极限,其继续减小的趋势依旧延续着。无论如何,目前的光刻技术将在未来的几年之内达到极限,下一代使用更短波长的光刻技术即将进入人们的视线。
这些更短波长技术中EUV的呼声最高。它采用的是仅13.5 nm的波长,相较其它光学光刻来说具有很大的优势。EUV 光刻采用的掩膜版比普通的光学掩膜版缩小了近4 倍,但其规格要求却比现在的193 nm 节点更加严格。EUV 掩膜版主要的制造要求包括几乎为零的刻蚀CD bias 以及完美的CD 均匀性。目前,CD的非均匀性主要来自光刻胶腐蚀的不均匀。局部刻蚀CD bias 控制是实现CD bias和均匀性的主要挑战。
业界采用的比较实用的方法是使吸收层尽可能的薄,这样一来,光刻胶也会变薄,深宽比也会相应的减小,CD bias和刻蚀均匀性也会得以改善。同样的,薄的光刻胶层在图形转移过程中也会有更好的CD 表现。
最近的研究中提出了一种基于热力学计算的self-mask 概念。该方法采用的吸收层中含有抗反射成分以及吸收体。两个亚层的化学组分不同,因此刻蚀速率也不尽相同。吸收体相对于抗反射层的选择比补偿了抗反射亚层,起到了硬掩膜的作用。尽管在叠层中依然有光刻胶,但是抗反射层起到了主要的掩膜作用,并决定了CD的值,因为光刻胶受制于腐蚀作用。
EUV 掩膜中的吸收体大致有几种。总的来说,抗反射亚层与吸收体的化学成分基本相同,除了氧含量之外。最早人们倾向于实用含铬的吸收体用于EUV 掩膜,但是现在Ta 材料的使用更多。TaBO/TaBN、TaON/TaN和TaSiON/TaSi 等都是掩膜吸收体的候选者。
为了优化工艺,经常需要运用到刻蚀清洗的方法,但这种方法会产生挥发性的刻蚀产物。因此采用了Gibbs 能最小化方法来计算组分平衡以决定产物的挥发性。计算了TaBO/TaBN 吸收体刻蚀的组分平衡。为了得到self-mask 结果,进行了2 步及多步刻蚀研究。第一步是TaBO(抗反射层)的刻蚀,第二步是TaBN(吸收体)的刻蚀。碳是从气相反应物中分解的唯一非挥发性产物。如果分解反应发生在刻蚀表面,碳将沉积下来并速度放慢,甚至在轰击较弱的条件下使刻蚀停止。
当TaBN 被刻蚀时,TaBO 部分也被暴露在氯气里。因此,需要研究氯气对TaBO 刻蚀的热力学。结果表明,在周边温度条件下,产生了非挥发的B2O3,它导致了刻蚀工艺和刻蚀停止的减速。
TaBO 反射亚层被刻穿后,CF4 将持续刻蚀下面的TaBN。由于TaBN 比反射层厚,所以光刻胶也将被继续腐蚀,反射层的水平尺寸也将继续改变,产生严重的CD bias。为了去除这些不良影响,只在TaBO被刻穿后使用氯气。第二步中TaBN的刻蚀速率很高,这是因为较高的挥发性,但是TaBO的边缘由于产物的非挥发性所以刻蚀速率较低。反射层和吸收体产物挥发性的不同产生了TaBN 对TaBO的选择比。因此,反射层在TaBN 刻蚀中起到了硬掩膜的作用,将CD bias 减少到了0.5~2 nm的范围,甚至可以实现无CD bias 并增强了CD 均匀性的控制。
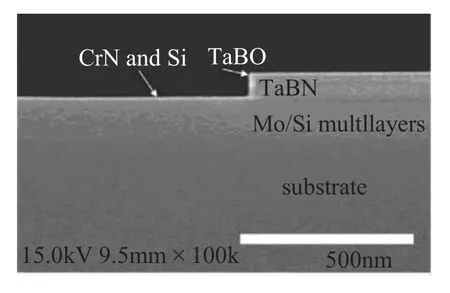
图1 TaBO/TaBN 吸收层EUV 掩膜版截面图
在确定最佳刻蚀条件时,self-mask 方法使得采用刻蚀选择比优化比刻蚀CD 优化更实际。选择比的优化既不需要高质量的光刻胶,也不需要延长CD-SEM时间,由此节约了工艺研发时间。另外,由于选择比优化不需要整片测量,一块掩膜版可以被反复使用多次(图1)。Self-mask 方法另一大优势是在吸收体被刻穿之前进行干法去胶。去胶后再将吸收体完全去除。该工艺过程防止了有害的钌氧化物的产生,并防止了使用钌覆盖层时造成的EUV 反射率的降低。
基于热力学计算的两步self-mask 刻蚀技术对于决定平衡条件和产物挥发性非常有效。该方法克服了目前软掩膜所带来的劣势,能够得到几乎0的CD bias 及较好的图形转移结果。

