硅掺杂对AlN材料的影响研究

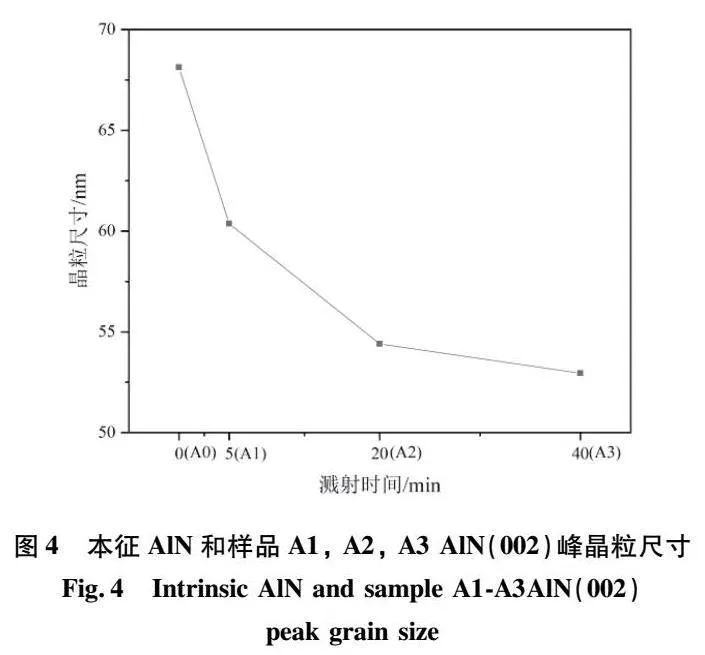
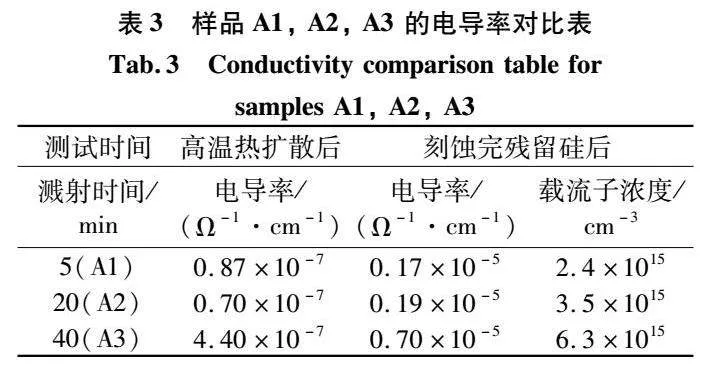




文章编号1000-5269(2024)06-0014-05
DOI:10.15958/j.cnki.gdxbzrb.2024.06.03
摘要:近年来,对AlN材料的研究热度居高不下,对AlN材料的制备日益成熟,但是对掺杂的研究大多数是理论方面,而有效地掺杂是制备器件的前提之一。本文采用高温热扩散的方式对超宽禁带材料AlN进行N型掺杂实验研究。首先使用磁控溅射仪在AlN薄膜上溅射一层Si,然后进行高温热扩散,热扩散后测试霍尔发现其电导率没有明显规律,分析原因可能是薄膜表面沉积的Si没有完全进入AlN中,表面残余的Si影响了测试结果,进一步使用ICP刻蚀设备刻蚀掉表面残留的Si。SEM测试热扩散前后的薄膜截面厚度,发现热扩散后的厚度小于热扩散前。EDS线扫模式测试其截面发现Si含量从薄膜顶部到底部呈递减趋势,符合扩散规律。XRD测试后发现掺杂后除了衬底峰其余的峰都向大角度偏移,且霍尔测试发现高温热扩散后的样品电导率从10-8 Ω-1·cm-1到10-5 Ω-1·cm-1,这些都说明了AlN材料形成有效的N型掺杂。
关键词:AlN;N型掺杂;ICP刻蚀;磁控溅射;高温热扩散;电导率
中图分类号:O474
文献标志码:A
氮化铝(aluminum nitride, AlN)为Ⅲ-Ⅴ族宽禁带半导体中带隙最大的材料。1960年,TAYLAR等[1]第一次在1 800~2 000 ℃的氮气气氛中蒸发铝,制备出直径0.5 mm、长度30 mm的AlN单晶薄片。随后许多研究人员使用物理气相传输(physical vapor transport, PVT)[2]、氢化物气相外延[3-4]、化学气相外延等[5]方法制备AlN单晶薄膜。目前,AlN基的光电器件、高温高功率器件的研究也逐渐展开,但AlN一般都是作为衬底或者外延层在器件中应用,或者是在压电器件中应用较多,而制备上述器件的前提就是实现有效的P型和N型掺杂,本文将用理论与试验相结合的方式来对AlN的N型掺杂进行研究。
对于制备N型AlN有许多杂质源,2002年,TANIYASU等[6]采用气相外延法成功制备出导电性好的Si掺杂AlN薄膜。2012年,吴荣等[7]发明了一种Si掺杂AlN半导体薄膜的制备方法,使用Si靶和Al靶在氮气氛围下双靶磁控溅射,得到掺杂分布均匀、沉积速率高的N型AlN薄膜。2012年,王新建等[8]使用热扩散方式对AlN进行Si热扩散掺杂,将SiNx作为扩散源,经过热扩散掺杂电导从19×10-3 S·m-1增加到2.1×10-3 S·m-1。2014年,WANG等[9]使用第一性原理的赝势法,研究了一种有效的XN(SiAl—XN,X=F、Cl、Br和I)共掺杂氮化铝的N型掺杂策略。结果表明,SiAl—XN配合物的供体电离能远低于相应的分离SiAl杂质。2016年,CONTRERAS等[10]通过分子束外延生长Si掺杂AlN,获得导电性良好的N型导电材料,在室温下测得自由载流子浓度约为1×1015 cm3。2021年,周露[11]利用MS软件进行O、Ce、Si替位AlN中的Al形成N型掺杂的第一性原理仿真。2021年,程建军[12]使用氧来掺杂AlN来形成N型掺杂实验研究。综上所述,发现掺杂原子与AlN中被替换原子的尺寸相差越大,对晶格的扰动越大,越不利于掺杂浓度的提高。因此,Si是最适合形成N型AlN的杂质源。
虽然目前对于AlN的N型掺杂试验研究已经有很多种方法,但采用高温热扩散的方式来进行研究的报道很少,本试验采取高温热扩散的方式进行试验研究,并且在已有试验的基础上,本试验将杂质源改为高纯硅,这样便于在掺杂后去除残留层。
1试验
1.1试验方法
本文使用Si杂质源对蓝宝石衬底上的AlN薄膜进行了掺杂研究,使用磁控溅射仪在薄膜上溅射了不同时间的Si原子。使用硅靶作为Si原子的来源。磁控溅射仪的基本参数设置为:本底真空为90×10-4 Pa,靶基距为6.0 cm,溅射功率为200 W,工作压强为5.0 Pa,衬底温度为125 ℃,通入30 sccm的氩气。分别溅射5、20、40 min,并依次标记为A1、A2、A3。磁控溅射完毕的样品采用水平管式高温扩散炉对样品进行高温扩散,在1 150 ℃的温度下,通入120 min的N2。高温扩散后使用ICP刻蚀机对高温扩散后残留Si进行物理轰击。在300 Pa的气体压强下通入0.73 sccm的SF6气体,设置激励功率为100 W,偏置功率为50 W。刻蚀时间是依据郑志霞等[13]研究反应离子刻蚀硅速率与激励功率和偏置功率之间的关系和测得溅射硅的厚度计算刻蚀硅时间,溅射硅时间5、20、40 min分别对应刻蚀时间为10、24、44 s。对AlN的刻蚀研究都是采用氯基气体以及采用物理和化学刻蚀相结合的方式[14-15]。
1.2性能测试
采用日本Rigaku SmartLab XG型X射线衍射仪(X-ray diffraction, XRD)来分析薄膜的结晶性质。采用VDP6800型霍尔测试仪测量出半导体材料的载流子迁移率、电阻率等电学信息。采用本原CSPM 5500型原子力显微镜测量样品表明形貌。采用日立公司Hitachi SU8100型SEM对晶体进行定性分析。采用日立公司U-4100型积分球式分光光度计测量薄膜的吸收光谱。
2结果与讨论
2.1物相分析
将高温热扩散后的AlN薄膜样品切割成0.2 cm×1 cm的小块样品测试其截面。
如图1所示,(a)、(b)、(c)分别是样品A3热扩散前、热扩散后和刻蚀完的薄膜截面的SEM测试图,能够看出溅射完成后在AlN薄膜上生长了一层硅,热扩散后硅的薄膜厚度明显减小,说明热扩散后硅进入到了AlN薄膜里面。测试霍尔后发现其电导率没有明显规律,分析原因可能是薄膜表面沉积的Si没有完全进入AlN中,表面残余的Si影响了测试结果,使用刻蚀机将残留硅刻蚀掉。刻蚀完残留硅后测试各样品截面能够明显看出残留硅几乎都被刻蚀掉且后续的霍尔测试也说明了Si被刻蚀完了。
从表1中能看出不同溅射时间,硅薄膜厚度的减少量不同,经过相同的时间,薄膜越厚,热扩散进入到AlN里面的硅就越多。
为了探究硅进入AlN薄膜后的分布,对刻蚀后A1、A2、A3样品的截面和表面进行EDS点扫测试,其截面和表面扫描位置图如图2所示。
表2给出扫描各区域的硅元素的质量百分比和原子百分比。从表2中可以看出,在样品A3的上、中、下三个区域都检测出Si元素,且薄膜上方Si原子占比最多,原子百分比13.004%,薄膜中间也有不少Si原子,原子百分比6.168%,在薄膜下方就剩下很少的Si原子,只有1.004%,说明Si作为目标掺杂元素经过热扩散成功进入到AlN薄膜里面。
综上所述,经过热扩散后,硅有效地进入了AlN薄膜里面,并且硅在AlN薄膜里面均匀分布。溅射硅时间越长,堆积在AlN薄膜表面的硅就越厚,越多的硅进入到AlN薄膜里面。
图3是高温热扩散前后样品的XRD图谱,其中,黑色曲线是未经过任何试验处理的原始样品AlN测出的XRD曲线,从图3(a)中能够看出有三个衍射主峰,分别位于32.399°、36.021°、76.441°,在36.021°处存在AlN(002)峰, AlN(004)的峰强相对较弱,所以该AlN薄膜是(002)择优取向,这与陈红举的生长AlN薄膜测试结果相符[16]。由于选用的测试模式X射线能够穿透薄膜所以会测出衬底峰Al2O3的峰。掺杂后除了衬底峰其余的峰都向大角度偏移说明AlN晶格发生收缩,样品A3偏移最大,因为掺杂浓度最高,这和一些研究者分析是一致的[17-19]。
图3(b)是刻蚀完残留硅后测试的XRD曲线,从图中能够明显看出来,样品A2、A3在刻蚀完残留硅后衬底峰变得十分明显,比起本征AlN测得衬底峰还要强烈,说明刻蚀过程损伤了AlN薄膜,这和田仁来等使用反应离子刻蚀方法刻蚀了薄膜后衬底峰变得明显的结果一致[20]。刻蚀使用的气体是SF6,查阅文献SF6对AlN的刻蚀速率很慢但对硅的刻蚀很有效[21],所以刻蚀的时间在经过计算后都是在此基础上延长了刻蚀时间,才会对薄膜造成了不同程度的影响。
根据谢乐公式[22]计算(002)峰的晶粒尺寸,并绘制出如图4所示的AlN(002)取向的晶粒尺寸变化图,明显地看到晶粒尺寸变小,说明结晶质量变差,掺杂硅对于薄膜的取向以及结晶质量都有影响。从图4中可以看出样品A1的结晶质量最好,结合上面的分析考虑是因为刻蚀对A2和A3样品有比较大的影响。
2.2电性能的测试结果分析
表3是样品高温热扩散后的电导率和刻蚀完成后的电导率以及载流子浓度。本征蓝宝石衬底AlN测试的电导率为0.8×10-8 "Ω-1·cm-1,载流子浓度0.9×1014 cm-3,这和中南大学汪炼成测试的结果一致[23]。
由表3可知,样品在高温热扩散后电导率增大了一个数量级,但是由于表面有残留硅,所以电导率的测试会因为残留硅受到影响,所以需要将表面残留硅去除后测试电导率以及载流子浓度。刻蚀完测得的电导率比热扩散完的电导率增大了两个数量级,说明刻蚀将大量的残留硅都刻蚀掉。刻蚀后相比于原始AlN薄膜电导率增加了三个数量级。同时,随着硅溅射时间增长,刻蚀掉残余硅后测得的电导率和载流子浓度越大。这是因为溅射硅时间越长,经过高温热扩散后,相应掺杂浓度最高的样品,其有效替位掺杂越多,其电导率和载流子浓度测试结果也是最大的。
3结论
1)SEM测试结果表明高温热扩散后溅射Si的厚度变薄,且Si厚度越厚的样品高温热扩散后减少的Si的厚度就越多,说明溅射Si时间越长进入到薄膜里的硅就越多。
2)使用EDS测试其原子百分比和XRD测试,结果表明Si原子已经进入到薄膜中。
3)由于残留Si会对薄膜的进一步表征分析产生影响,所以采用ICP刻蚀技术将薄膜表面的硅通过刻蚀去除掉,但通过XRD的测试结果发现刻蚀的方法容易将薄膜损伤。
4)刻蚀完的样品测试其电导率能够明显的看出其电导率增大了三个数量级,并且溅射硅时间越长的样品其电导率就越高,说明其掺杂浓度就越大。
综上试验结果表明,Si掺杂能形成稳定的N型AlN薄膜,这为制作AlN器件提供了借鉴。
参考文献:
[1]
TAYLOR K M, LENIE C. Some properties of aluminum nitride[J]. Journal of the Electrochemical Society, 1960, 107(4):308-314.
[2] GLEN A. Growth of high purity AlN crystals[J]. Journal of Crystal Growth, 1976, 34(2):263-279.
[3] AMANO H, SAWAKI N, AKASAKI I, et al. Metalorganic vapor phase epitaxial growth of a high quality GaN film using an AlN buffer layer[J]. Applied Physics Letters, 1986, 48(5):353-355.
[4] KUMAGAI Y, KUBOTA Y, NAGASHIMA T, et al. Preparation of a freestanding AlN substrate from a thick AlN layer grown by hydride vapor phase epitaxy on a bulk AlN substrate prepared by physical vapor transport[J]. Applied Physics Express, 2012, 5(5):5504.
[5] KAWAKAMI H, SAKURAI K, TSUBOUCHI K, et al. Epitaxial growth of AlN film with an initial-nitriding Layer on α-Al2O3 substrate[J]. Japanese Journal of Applied Physics, 1988, 27(2):161-163.
[6] TANIYASU Y, KASU M, KOBAYASHI N. Intentional control of n-type conduction for Si-doped AlN and Al X Ga1-XN (0.42 xlt;1)[J]. Applied physics letters, 2002, 81(7): 1255-1257.
[7] 吴荣, 任银拴, 简基康, 等. 一种Si掺杂AlN稀磁半导体薄膜的制备方法: CN201110297648.6[P].2012-03-15.
[8] 王新建, 宋航, 黎大兵, 等. 氮化铝薄膜的硅热扩散掺杂研究[J]. 发光学报, 2012, 33(7): 768-773.
[9] WANG Z, LI J , FU Y. Effective n-type doping strategy through codoping Si-Al-F-N in aluminum nitride[J]. Appl. Phys. Express, 2014, 7 (11): 111004.1-111004.3.
[10]CONTRERAS S, KONCZEWICZ L, MESSAOUD J B, et al. High temperature electrical transport study of Si-doped AlN[J]. Superlattices and Microstructures, 2016, 100(98): 253-258.
[11]周露. 掺杂氮化铝的第一性原理研究[D]. 重庆: 重庆理工大学, 2021.
[12]程建军. 氧掺杂AlN薄膜结构与性能研究[D]. 大连: 大连理工大学, 2021.
[13]郑志霞, 冯勇建, 张春权. ICP刻蚀技术研究[J]. 厦门大学学报(自然科学版), 2004, 43(8):365-368.
[14]赵龙, 王强, 薛晨阳. 基于单晶AlN薄膜的干法刻蚀和湿法腐蚀[J]. 微纳电子技术, 2020, 57(7):550-555.
[15]侯卓立, 周燕萍, 査强, 等. 薄膜体声波滤波器AlN压电薄膜的ICP刻蚀研究[J]. 真空科学与技术学报, 2020, 40(3):220-225.
[16]陈红举. 脉冲激光沉积制备不同择优取向的AlN薄膜的研究[D]. 河南:河南大学, 2010: 47-48.
[17]LI J, NAM K B, NAKARMI M L, et al. Band structure and fundamental optical transitions in wurtzite AlN[J]. Appl. Phys. Lett.,2003,83 (25): 5163-5165.
[18]GIM P, LADENBURGER A, SCHIRRA M, et all. Cathodoluminescence, photoluminescence, and reflectance of an aluminum nitride layer grown on silicon carbide substrate[J]. Appl. Phys, 2007,101 (2): 023511.1-023511.5.
[19]HONKALA K, HELLMAN A, REMEDIAKIS I N, et al. Ammonia synthesis from first-principles calculations[J]. Science, 2005, 307: 555-558.
[20]田仁来, 黄楠, 陈俊英,等. Ti-O薄膜的溅射刻蚀微形貌表面对内皮细胞生长的影响[J]. 功能材料, 2004(增刊1):345-347.
[21]CHEN D, XU D, WANG J,et al. Dry etching of AlN films using the plasma generated by fluoride[J].Vacuum, 2008, 83(2):282-285.
[22]戴超华,成震今,周君儒.全谱拟合法与谢乐公式计算铂纳米晶粒尺寸探讨[J].冶金分析,2022,42(12):72-76.
[23]汪炼成, 李滔, 林蕴. 一种AlGaN基背入式MSM紫外焦平面阵列成像系统的制备方法:CN201811603494.7[P].2019-04-19.
(责任编辑:于慧梅)
Abstract:
In recent years, the research fever of AlN materials remains high, and the preparation of AlN materials is becoming more and more mature, but most of the research on doping is theoretical, and effective doping is one of the prerequisites for the preparation of devices. Therefore, in this paper, high-temperature thermal diffusion was used to experimentally investigate the N-type doping of AlN, an ultra-broadband material. Firstly, a layer of Si was sputtered on the AlN film using a magnetron sputtering apparatus, and then high-temperature thermal diffusion was carried out. After thermal diffusion, the test of Hall found that there was no obvious pattern of conductivity, and the reason may be that the Si deposited on the surface of the film do not completely enter into the AlN, and as a result the residual Si on the surface influenced the results of the test. Therefore, the residual Si on the surface was further etched away using the ICP etching equipment. SEM test results of the cross-section thickness of the films before and after thermal diffusion reveal that the thickness after thermal diffusion is less than that before thermal diffusion. The EDS line-scan mode testing of its cross-section reveals a decreasing trend of Si content from the top to the bottom of the film, which is consistent with the diffusion law. XRD tests reveal that after doping all the peaks except the substrate peaks is shifted to a large angle. And Hall's test reveal that the conductivity of the samples after high temperature thermal diffusion range from 10-8 Ω-1·cm-1 to 10-5 Ω-1·cm-1, all of which indicate the formation of effective N-type doping of the AlN material.
Key words:
AlN; N-type doping; ICP etching; magnetron sputtering; high-temperature thermal diffusion; electrical conductivity
收稿日期:2024-01-25
基金项目:半导体功率器件可靠性教育部工程研究中心开放基金资助项目 (ERCME-KFJJ2019-01)
作者简介:郭丰杰(1998—),男,在读硕士,研究方向:电子科学与技术,E-mail:guofengjie000000@163.com.
*通讯作者:杨发顺,E-mail:fashun@gzu.edu.cn.

