宽禁带半导体Ga2O3基日盲紫外探测器的研究进展
沈乐昀,张 涛,刘云泽,吴慧珊,王凤志,2,潘新花,2*,叶志镇,2
(1 浙江大学 材料科学与工程学院 硅及先进半导体材料全国重点实验室,杭州 310058;2 浙江大学 温州研究院 温州市光电及纳米新材料重点实验室,浙江 温州 325006)
硅、锗作为第一代半导体材料的代表,自20世纪50年代开始,在微电子领域发挥了巨大的作用。但随着器件集成的要求不断提高,第一代半导体材料的缺陷逐渐显现,无法满足设备的需要。20世纪末,第二代半导体材料进入人们的视野,凭借更高的电子迁移率、更大的禁带宽度、更丰富的应用场景等优势引起科研工作者的关注,以砷化镓(GaAs)、磷化铟(InP)为代表材料,开拓了光纤及移动通信新产业。近年来,第三代半导体材料迅速发展,以碳化硅(SiC)、氮化镓(GaN)、硒化锌(ZnSe)、氧化锌(ZnO)、氧化镓(Ga2O3)等宽禁带半导体为代表。这些材料具备高击穿场强、高热导率及抗辐射能力等优异特性,更加适用于高温高频、大功率器件的制备,在半导体照明、移动通信、轨道交通、新能源汽车等领域具有广阔的应用前景。其中,Ga2O3是一种超宽禁带半导体材料,禁带宽度Eg=4.9 eV,具备良好的稳定性和较高的透光率。优异的物理化学性能使Ga2O3在电子电力器件及日盲紫外探测领域具有广泛的应用前景。本文重点介绍了β-Ga2O3材料的基本性质及其在日盲紫外探测领域的研究进展,就不同的器件结构展开详细论述。
1 Ga2O3材料的基本性质
1.1 晶体结构

由于β-Ga2O3在五种晶相中最为稳定,目前大多数紫外探测器件及其他电子电力器件都基于β-Ga2O3展开研究,本文将着重介绍β-Ga2O3在日盲紫外探测领域的应用。
1.2 物理性质
表1列出了β-Ga2O3和其他常用半导体材料的基本物理性质[1,26],其中β-Ga2O3的介电常数ε为10,迁移率μ为300 cm2·V-1·s-1,击穿电场强度Ebr为8 MV·cm-1,远大于SiC和GaN材料,可应用于高电场、高电压、高温环境。值得一提的是,β-Ga2O3的禁带宽度较宽,达到约4.85 eV,对应深紫外波段,在日盲紫外探测器件的应用中有巨大潜能。对于宽禁带半导体材料β-Ga2O3,理想的无缺陷态材料应呈现绝缘态,但在β-Ga2O3的生长过程中会无意间引入O空位、Ga空位或Ga间隙原子等缺陷,其中O空位会形成浅施主能级,导致非故意掺杂的β-Ga2O3呈现出n型,这与ZnO类似[27]。研究发现,O空位是影响β-Ga2O3材料导电性的关键因素,此外掺杂Si等元素可以作为施主杂质来调节β-Ga2O3的导电性能[28-30]。优异的光电特性使β-Ga2O3在日盲紫外探测、深紫外透明导电电极、高功率器件等领域都有良好的应用前景。但是,从表1中可知β-Ga2O3的热传导K为0.1~0.3 W·cm-1·K-1,远小于其他半导体材料,这也限制了β-Ga2O3功率器件的高温传导能力,需要进行额外的措施提升器件传热能力[31-33]。

表1 β-Ga2O3与其他常用半导体材料的物理性质[1,26]Table 1 Properties of β-Ga2O3 relative to other more commonly used semiconductors[1,26]
1.3 生长方法
高质量的材料是制备高性能器件的基础,结晶性好、平整且均一的薄膜通常表现出较好的电学性质,有利于制备高性能器件。近年来,多种方法用于β-Ga2O3材料的制备,并尝试将制得的材料应用于光电器件及电子电力器件中。
单晶β-Ga2O3由于其优异的物理性能受到人们的广泛关注,基于单晶β-Ga2O3的器件研究也不断涌现。相较于SiC和GaN,β-Ga2O3可以采用高温熔体技术生长大尺寸高质量单晶,其具有成本较低、速度较快、可实时观察等优势[34],常见的制备方法包括提拉法、导模法、火焰法、光学浮区法等[35-41]。提拉法为一种常见的制备单晶的方法[38,41],导模法已经较为成熟地应用于Al2O3单晶的生长中,也可应用于Ga2O3单晶的制备[35,40]。火焰法在生长中易于释放晶体,对熔炉的黏附性较小,已有报道详细研究用该方法制备β-Ga2O3单晶[37,39]。中国科学院上海光机所于2006年采用光学浮区法制备Sn掺杂的β-Ga2O3单晶[36]。
单晶材料尽管质量优异,但在制备工艺上存在反应温度高、能耗高、工艺复杂等不足。相比而言,薄膜材料的制备更为灵活简便且工艺的可重复性较高,可呈现单晶、多晶、非晶等形态。因此,制备高质量的Ga2O3薄膜成为了研究热点。近年来,薄膜的制备工艺不断发展,常用的Ga2O3薄膜的制备工艺有分子束外延(MBE)、金属有机化学气相沉积(MOCVD)、脉冲激光沉积(PLD)、雾化气相沉积(mist-CVD)、卤化物气相外延(HVPE)等。MBE技术自20世纪80年代制备了原子级沉积超晶格薄膜,其被用于制备GaAs,GaN等外延薄膜,为制备高性能半导体器件奠定基础。2007年,Oshima等采用等离子辅助MBE在(100)晶面的蓝宝石衬底上生长出高质量的β-Ga2O3薄膜[42]。Sasaki等使用臭氧MBE技术制备Sn掺杂β-Ga2O3薄膜,改变掺杂浓度实现对薄膜载流子浓度的调控[43]。随后,MBE制备β-Ga2O3薄膜的工艺和掺杂工艺被不断优化改进[44-45]。MOCVD技术与MBE相比不需要高真空条件,更适用于商业化生产。2004年,Kim等采用MOCVD技术在硅片上生长Ga2O3薄膜,实现异质外延[46]。2014年,Du等采用该方法在(100)β-Ga2O3衬底上同质外延β-Ga2O3单晶薄膜[47]。HVPE技术是一种价格低廉、沉积速度快的薄膜制备方法,但获得的薄膜表面较为粗糙,需要进行化学机械抛光处理。该方法不仅可以用于制备β-Ga2O3薄膜,还被用于α-Ga2O3的制备[48-49]。mist-CVD也是一种价格低廉的薄膜制备工艺,常用于制备不同晶相Ga2O3薄膜,如α-Ga2O3薄膜[50-53]。PLD技术由于其沉积温度较低,在掺杂和异质结构中有广泛的应用。2009年,Penner等采用PLD在500 ℃下制备Sn掺杂Ga2O3薄膜[54]。2014年,Muller等研究氧分压对PLD沉积Si掺杂Ga2O3薄膜的影响[55]。近年来,本课题组采用PLD技术在蓝宝石衬底上制备出高质量的Ga2O3多晶薄膜[56-57]。
此外,Ga2O3的各种纳米结构,包括纳米线、纳米带、纳米片等,也在器件领域受到关注。常用的制备方法包括碳热还原反应、激光烧蚀法、化学气相沉积等[58-61]。基于纳米结构本身比表面积大的优势,器件的灵敏度和响应时间显著提升了,但在结构的再现性、高质量接触、器件可靠性等方面还需要进一步的探索[1]。
1.4 研究现状与应用
关于Ga2O3的研究最早可以追溯到1952年[2],近些年开始受到人们的广泛关注,围绕Ga2O3的研究、应用不断涌现,主要包括Ga2O3的缺陷、掺杂、异质结等基础研究以及器件应用方面的研究[1]。
其中β-Ga2O3因其优异的物理性能,成为近年来关注的热点。基于β-Ga2O3的器件被应用在不同领域,包括日盲紫外探测器、透明导电电极、气敏传感器、场效应晶体管、发光二极管等[62]。拥有超宽带隙(4.9 eV)的β-Ga2O3非常适用于制备日盲紫外探测器件。由于日盲紫外光(200~280 nm)会被臭氧层强烈吸收,因此工作在该波段的日盲紫外探测器件抗干扰能力强,在臭氧空洞检测、空间通信、生化检测、导弹巡航等领域具有重要应用。此外,β-Ga2O3具有高达8 MV/cm的击穿电场强度,约为商业化半导体材料Si的20倍,且巴利加优值(Baliga’s figure of merit)达到3214(约为SiC的10倍,GaN的4倍),是低功耗器件的重要指标。基于上述可以得出β-Ga2O3在制备高温高频的大功率器件方面有广阔的应用前景。
2 Ga2O3基日盲紫外探测器
近年来,紫外探测器受到人们的广泛关注,在民用、军事等领域都有涉及。把10~400 nm波段的光归为紫外光,包括近紫外光(NUV)、中紫外光(MUV)、远紫外光(FUV)和极紫外光(EUV)。根据光谱的所在区域,还可划分为长波(UVA),中波(UVB),短波(UVC)和真空紫外波段(VUV)[63]。当太阳发出天然的紫外光源辐射时,UVC辐射会被大气中的双原子氧(100~200 nm)和臭氧(200~280 nm)吸收,VUV辐射会被空气强烈吸收。把波长介于200~280 nm的紫外光称为日盲紫外,采用日盲紫外制备的信号探测器不会受到太阳光背景的干扰,因此探测灵敏度和通信准确率极高,在军事和航空航天领域具有极大的应用前景,成为各国军事竞赛的重点方向。
评价日盲探测器性能的关键指标主要有:
(1)响应度
响应度(R)是光电流大小与入射光功率密度的比值,反映了器件将入射光转化为光电流的能力,单位为A/W。
(1)
式中:Iph是光电流;P是入射光功率密度;S是有效光照面积。响应度越高,说明在一定光功率照射下光生电子空穴对越多,器件性能越好。
(2)量子效率
量子效率(EQE)是光生电子-空穴对与入射光子数的比值,是衡量探测器光子利用率的重要指标。
(2)
式中:q是电子电荷量;hv是入射光子能量,其中,h是普朗克常数,v是光的频率。一般情况下,对于理想探测器量子效率等于100%,即一个入射光子产生一个光生电子对;但实际探测器量子效率小于100%;如果存在某种雪崩倍增机制或者光电导增益机制,量子效率可能会出现大于100%的情况。量子效率越高,器件性能越好。
(3)光暗比
光暗比是探测器件光照下光电流与暗电流的比值Iph/Id,也称为信噪比。光暗比越大,器件的灵敏性越好。其中,Id是暗电流。
(4)探测率
探测率(D*)是在噪声等效功率的基础上提出来的,目的在于更加精确地表示器件性能。器件性能与器件的有效光照面积和器件半导体层带宽有关。
(3)
式中:A是光照有效面积;B是材料的电子带宽;NEP是噪声等效功率,即信噪比为1时的光功率大小。
(5)响应时间
响应时间是表征光电探测器性能必不可少的参数之一,其中有τR和τD两个参数。τR为从没有光信号输入,到光信号输入,暗电流上升到光电流最高稳定数值时所用时间;τD为从有光照到去除光信号后,器件的电流从光电流下降到暗电流所需要的时间。通常情况,τR和τD都可使用光电流最高值的90%~10%所需时间。
(6)探测波长
探测波长反映的是探测器对不同波长紫外光的灵敏度差异,通常探测波长由半导体材料的禁带宽度决定。对于紫外探测器,探测的波长为400 nm以下的紫外光波段,半导体材料的禁带宽度大于等于3.1 eV,这类紫外探测器不受可见光的干扰;而对于日盲探测器,探测的波长为280 nm的深紫外波段,材料的禁带宽度大于等于4.4 eV,这类紫外探测器不受太阳光辐射干扰。
制备日盲紫外探测器需要的核心材料为宽禁带半导体材料,它们通常具有较高的击穿场强,适用于高温和高功率环境[64-65]。目前,AlxGa1-xN和MgxZn1-xO材料是最为常见的两种制备日盲紫外探测器的原材料,其器件表现出优异的光敏性和响应速度[66]。但是,AlxGa1-xN材料的外延生长需要超过1350 ℃的高温;而MgxZn1-xO材料易发生相偏析,从而引入缺陷和位错,降低检测性能。此外,金刚石作为一种超宽带隙材料,是研发日盲紫外探测器的理想材料,但受限于该半导体的带隙调节困难,光谱响应范围单一[67-69]。相比而言,β-Ga2O3具有超宽带隙(4.9 eV),可生长大尺寸的Ga2O3单晶和高质量外延薄膜,可通过掺杂等方式调控带隙[1],且易于与其他材料形成连续固溶体从而覆盖日盲波段[70]。
2.1 肖特基型
肖特基结构的光电探测器,主要基于金属和半导体材料在界面处的肖特基势垒,在光照下耗尽区会产生电子-空穴对,光电流增大,器件响应速度快;在黑暗环境下暗电流较低,器件响应度小。但是,肖特基结构的反向势垒较薄,因此反向偏压较低,适用于低压场合。
Oshima等[71]制备了β-Ga2O3基垂直结构肖特基型日盲紫外探测器,采用的是热退火和真空蒸发技术,Ga2O3衬底与Au/Ni形成了肖特基接触。器件在±3 V偏压下的整流比为106,PDCR为103(-3 V)。在200~260 nm光照下的响应度为2.6~8.7 A/W(10 V)。其性能得益于在界面处发生的载流子倍增效应,该区域受到约1.0 MV/cm的高内部电场。Suzuki等[72]通过β-Ga2O3和Au形成肖特基接触制备光电二极管,通过400 ℃的退火工艺提升光响应度。退火后的器件响应度达到103A/W,光暗比超过106,光响应性能大大提升。2011年,Suzuki等[73]再次报道了基于β-Ga2O3/Au肖特基型光电二极管。通过加入β-Ga2O3高阻层,器件性能显著提升,光响应度达到4.3 A/W。另外,Alema等[74]采用金属有机化学气相沉积法制备Pt/n-Ga2O3/n+Ga2O3肖特基型日盲紫外探测器。该器件窗口对小于260 nm的紫外辐射有90%的透过率,在±2 V偏压下,开启电压为1 V,整流比为108。
此外,肖特基结构也可用于自供电特性器件的制备。Chen等[75]制备基于Au/β-Ga2O3纳米阵列肖特基结构的自供电日盲紫外探测器。器件在258 nm光照下的响应度为0.6 mA/W(-6 V),暗电流为10 pA(-30 V),衰减响应时间为64 μs。大连理工大学Yang等[76]通过真空热蒸发技术在β-Ga2O3两面分别蒸镀Cu和Ti/Au电极,构成β-Ga2O3/Cu肖特基型日盲紫外探测器。器件在0 V偏压下具有明显的光响应,表现出自供电特性。
2.2 金属-半导体-金属结构(MSM)
MSM结构是基于肖特基结的一种简易结构,由金属和半导体接触形成的两个背靠背肖特基势垒构成。MSM型探测器结构简单,易于集成且与晶体管工艺兼容,也是最为常见的器件结构。但这类器件与肖特基型器件均基于单一半导体材料,器件的可调控性较差。
薄膜材料制备工艺灵活,可重复性高,易于制成高性能器件,可呈现单晶、多晶、非晶等形态。因此,制备高质量的Ga2O3薄膜材料受到了广泛关注,薄膜材料也被用于制备高性能Ga2O3器件。其中,分子束外延(MBE)技术是一种常用的制备半导体薄膜的方法。Oshima等[70]采用等离子体增强分子束外延(PMBE)技术在蓝宝石衬底上生长β-Ga2O3薄膜,虽然薄膜中还含有α-Ga2O3,但器件仍表现出良好的性能,在10 V偏压下暗电流仅1.2 nA,光响应达到0.037 A/W(254 nm)。Pratiyush等[77]采用相同方法制备β-Ga2O3,获得的MSM器件光暗比超过103。Guo等[78]采用激光分子束外延(LMBE)技术制成MSM结构的β-Ga2O3日盲紫外探测器。该器件对254 nm光照响应灵敏,对365 nm的光响应微弱。
此外,化学气相沉积(CVD)也被广泛应用在薄膜制备中。Weng等[79]采用热氧化GaN的方法获得β-Ga2O3薄膜,沉积Ti/Au/Ti/Au电极后制成MSM器件。器件的暗电流为1.39×10-10A,在260 nm光照下的电流上升为2.03×10-5A。最近,Jiang等[80]通过热氧化GaN制备N掺杂p型β-Ga2O3,由此制备的MSM器件具有高响应度(9.5×103A/W)、高量子效率(4.7×106%)和高探测度(1.5×1015Jones)。Jaiswal等[81]通过在GaN衬底上原位生长Ga2O3薄膜制备MSM日盲紫外探测器。该器件对230 nm光照响应灵敏,在35 V偏压下的响应度为0.8 A/W。另外,Hu等[82]采用MOCVD方法在蓝宝石衬底上制备Ga2O3基日盲紫外探测器,构成Au/Ga2O3/Au MSM结构。该器件在255 nm光照、20 V偏压下的响应度为17 A/W,量子效率达到8228%,截止波长约为260 nm。Zhang等[83]用N2O代替O2利用MOCVD技术生长β-Ga2O3薄膜,其器件的光电性能得到提升。在10 V偏压下,该器件的光响应度为26.1 A/W,光暗比为104,响应时间为0.48 s和0.18 s。
常见的薄膜制备方法还包括溶胶凝胶法、溅射法等。Kokubun等[84]报道了采用溶胶凝胶法制备β-Ga2O3薄膜的方法,并制备MSM结构光电探测器,该器件仅对小于270 nm的光照有明显响应。Shen等[85]采用该方法制备了β-Ga2O3基日盲紫外探测器,退火温度高于700 ℃时可获得晶相单一的β-Ga2O3,器件的最佳光暗比达到18.34,响应时间为0.10 s。Yuan等[86]共溅射铝镓氧化物(AGO)材料获得MSM结构的日盲紫外探测器,Al的加入有效增大了Ga2O3的带隙。该器件的峰值响应度为1.38 A/W(230 nm),是不添加Al元素器件的53.61倍。基于AGO的器件在光电流、暗电流和灵敏度方面都有显著提升。
在Ga2O3薄膜材料生长过程中,温度是至关重要的影响因素。为提升器件性能,可通过控制生长温度[87]、调节退火温度[88-89]等方式提高薄膜质量。Yu等[87]采用PLD技术在蓝宝石衬底上生长Ga2O3薄膜,探究生长温度对Ga2O3器件的性能影响。研究发现,800 ℃生长时,器件性能最佳,暗电流为1.2×10-11A,光暗比为105,响应度为0.903 A/W(250 nm)。薄膜的退火处理会影响晶体质量,从而使器件性能产生差异[89],退火温度一般控制在700~800 ℃为宜[88]。退火处理可以有效降低薄膜中的氧空位[90],其中氧气氛围的退火处理作用相对较好[91]。此外,对衬底进行前期退火处理也会影响薄膜的质量[92]。掺杂是优化器件性能的一种常用且有效的方法,可调节载流子浓度或材料带隙以优化器件性能。Ahn等[93-94]在MOVCD制备Ga2O3薄膜的过程中增加Si离子,引入Si掺杂。该方法有效提升器件的光暗比和光响应度。Li等[95]在Ga2O3薄膜中掺杂Zn元素,同时采用石墨烯作为电极构成MSM型日盲紫外探测器。该器件的探测度为4.9×1011cm·Hz1/2·W-1,光暗比大于105,暗电流为10-11A,且对光源有良好的选择性。此外,生长缓冲层也有利于制备高质量的薄膜。Liu等[96]采用同质外延加缓冲层的方法有效提高MSM结构器件性能,器件的暗电流低至0.04 nA,光暗比达到104,光响应度达到259 A/W,量子效率达到7.9×104%。Arora等[97]在硅衬底上生长β-Ga2O3薄膜制成MSM结构器件,对比有无高温籽晶层对器件性能的影响。研究表明,籽晶层有助于Ga2O3由非晶向多晶转变,且器件性能显著提升。器件的最佳光暗比大于103,暗电流为1.43 pA,响应度为96.13 A/W。
单晶薄膜制备的器件因内部缺陷少,因而性能优异,受到人们的青睐。通过从块体β-Ga2O3单晶上机械剥离薄层的方法可以快速便捷地获得所需层状材料。Oh等[98]采用该方法结合Ni/Au电极制备MSM型日盲紫外探测器。该器件的光暗比超过103,响应度达到1.68 A/W。2018年,Oh等[99]采用石墨烯电极替换Ni/Au电极制备Ga2O3基MSM器件,器件的光电性能得到提升,光暗比达到104,响应度达到29.8 A/W,探测度约为1×1012cm·Hz1/2·W-1。山东大学Mu等[100]同样采用机械剥离的方法获得β-Ga2O3单晶片,通过蒸镀Ni/Au电极制备MSM型紫外探测器。该器件在10 V偏压下的衰减时间为0.14 s,响应度为3 mA/W。
与薄膜材料相比,基于纳米结构的Ga2O3器件通常表现出更加优异的性能,包括纳米线[101-103]、纳米片[104]、纳米带[105-107]等等。中科院物理研究所Feng等[102]在980 ℃下通过蒸发法制备β-Ga2O3纳米线,采用电子束沉积Au电极构成MSM结构。该器件在254 nm光照下的暗电流在pA量级,响应时间为0.22 s和0.09 s。2010年,Li等[101]采用CVD法制备β-Ga2O3纳米线,构成桥式结构日盲紫外探测器。器件的光暗比达到3×104,衰减时间小于20 ms(254 nm),如图1所示。Li等[105]采用热蒸发的方法制备基于Ga2O3纳米带的MSM结构紫外探测器,器件对250 nm的光照响应度高,响应时间短,光暗比大于104。Tian等[106]采用相同的方法制备In掺杂Ga2O3纳米带。制得器件的灵敏度高达9.99×104%,响应度为5.47×102A/W,量子效率为2.72×105%,响应时间为1 s和0.6 s。此外,Zou等[107]以GaN为原材料制备Ga2O3纳米带用于MSM器件,器件暗电流极低(10-14A),光响应度高(851 A/W),并且能够在433 K高温下稳定工作。

图1 基于β-Ga2O3纳米结构的金属-半导体-金属型日盲紫外探测器[101](a)桥式结构β-Ga2O3纳米线的结构示意图;(b)时间响应曲线;(c)光电流衰减过程;(d)I-V特性曲线Fig.1 Solar-blind deep UV MSM photodetectors based on β-Ga2O3 nanostructures[101](a)schematic diagram of the bridged nanowire structure of thick β-Ga2O3 nanowire;(b)time-dependent photoresponse;(c)photocurrent decay process;(d)I-V characteristics curves
2.3 异质结型

Nakagomi等报道基于β-Ga2O3和p型(0001)6H-SiC异质结的深紫外探测器[109]。采用氧等离子体中镓蒸发法在p型6H-SiC衬底上生长β-Ga2O3薄膜。器件具有良好的整流特性,电流在反向偏压下随深紫外光强的增加而线性增加,且对波长在260 nm的紫外光响应最灵敏,响应时间达到毫秒量级。最近,Nakagomi等对β-Ga2O3/6H-SiC异质结型深紫外探测器的性能进行了提升,器件的灵敏度和响应速度均有所改善[110]。2015年,Nakagomi等再次报道了由β-Ga2O3和GaN异质结制成的深紫外光电探测器,β-Ga2O3同样采用氧等离子体中镓蒸发法进行制备[108]。该器件具有良好的整流特性,在225 nm波段下响应度达到0.18 A/W,响应时间在亚毫秒量级。相较于β-Ga2O3/6H-SiC异质结型紫外探测器,器件性能明显提升。
Zhao等[111]采用CVD法一步制备ZnO-Ga2O3核壳结构纳米线光电探测器,ZnO与Ga2O3均为单晶材料,且Ga2O3壳层仅为6~8个原子层。在-6 V电压下,器件的响应度高达1.3×103A/W,探测度为9.91×1014cm·Hz1/2·W-1,响应时间为20 μs和42 μs,表现出优异的性能。2017年,Zhao等[112]再次报道了ZnO/Ga2O3核壳结构日盲紫外探测器。该器件具有自供电特性,响应度高,响应时间快,在251 nm光照、0 V偏压下,器件的响应度为9.7 mA/W。
Kong等[114]将多层石墨烯转移到β-Ga2O3衬底上构成异质结,制备日盲紫外光电探测器。器件在254 nm光照下灵敏度好,稳定性高,响应度为39.3 A/W,探测度为5.92×1013cm·Hz1/2·W-1,超越了部分基于单一Ga2O3纳米结构的紫外探测器。2018年,中科院苏州纳米所制备石墨烯/Ga2O3纳米阵列垂直结构日盲紫外探测器,器件对于254 nm光照的响应度在-5 V偏压下为0.185 A/W[115]。同年,中山大学Lin等[116]制备的垂直结构石墨烯/Ga2O3异质结紫外探测器具有低暗电流和高灵敏度,响应度在-6 V偏压下为12.8 A/W。
此外,Ga2O3还能与许多材料构成异质结制备探测器件。Mahmoud等通过阳离子交换机制在SnO2薄膜上生长β-Ga2O3,成功制备性能优异的日盲紫外探测器[118]。在雪崩倍增机制下,该器件在254 nm光照下表现出高性能:灵敏度达1.7×105,响应度达到2.3×103A/W,响应时间为42 μs。北京理工大学Guo等[120]在Nb:SrTiO3(NSTO)衬底上生长β-Ga2O3薄膜,制备异质结型日盲紫外探测器。在内置电场驱动下,β-Ga2O3与NSTO界面处光生载流子分离,参与电流传输。浙江理工大学Guo等[121]制备GaN/Sn: Ga2O3pn结自供电紫外探测器,在0 V偏压下的响应度为3.05 A/W(254 nm),光暗比为104。郑州大学Chen等[117]采用化学气相沉积法制备了基于金刚石/β-Ga2O3的自供电日盲紫外探测器,器件在0 V下对244 nm光照的响应度为0.2 mA/W,紫外/可见响应度抑制比为1.4×102。Zhou等[122]基于MoS2/β-Ga2O3异质结制备自供电紫外探测器。器件在0 V偏压下的响应度为2.05 mA/W,最佳探测度为1.21×1011cm·Hz1/2·W-1。
2.4 薄膜晶体管型(TFT)
相较于众多探测器结构,TFT结构在栅压控制下暗电流极低,具有超高光暗电流比,因此获得了人们的广泛关注。TFT基于场效应原理,利用电场来控制导电沟道形状来实现沟道的开闭状态,如今已被广泛应用在模拟电路和数字电路中,成为数字集成电路中的重要元器件。
商业化的TFT主要包括氢化非晶硅(a-Si:H)TFT、低温多晶硅(LTPS)TFT和金属氧化物TFT。a-Si:H TFT目前应用最为广泛,技术成熟、成品率高且成本最低,但迁移率不是很理想。近年来发展迅速的LTPS TFT,虽迁移率高、稳定性好,但还存在制备工艺复杂、制备成本较高等问题[123]。金属氧化物TFT作为新的发展方向,弥补了a-Si:H TFT和LTPS TFT的不足,具备高迁移率、高稳定性、低成本和制备方法简易等优点,成为TFT领域的研究热点。采用Ga2O3材料作为TFT的源材料可利用结构优势实现深紫外波段的探测,从而获得更大的光增益,实现微弱信号的探测[124]。但是,TFT型器件对Ga2O3材料的质量要求较高,大多基于单晶Ga2O3实现微弱信号的探测,同时需要外加垂直电压,相较于其他结构能耗提升。
Oh等[125]制备Ga2O3基背栅场效应晶体管型紫外探测器,将机械剥离的二维β-Ga2O3薄层平铺于Si衬底上。该日盲紫外探测器在0 V的栅压下对254 nm光照有超高响应度(9.17×104A/W)。山东大学Liu等[126]在块体单晶上剥离层状Cr掺杂β-Ga2O3薄层,以p型Si作为衬底材料,制备场效应晶体管结构的光电探测器。在暗环境下,器件表现出良好的转移特性。当用254 nm的紫外光测试探测器性能时,光暗电流比达到了106,且暗电流可以控制在5 pA,表现出优异的探测性能。Kim等[127]将剥离的β-Ga2O3层状材料与石墨烯电极相结合制备光电晶体管,器件的光暗比在栅压控制下可达到106,表现出优异的探测性能。Qin等[128]制备增强型β-Ga2O3金属-氧化物-半导体(MOS)场效应晶体管。将MBE技术外延生长的Si掺杂Ga2O3层作为沟道材料,器件的开启电压约为7 V,暗电流可低至0.7 pA。在254 nm光照下,光暗电流比达到1.1×106,响应度高达3×103A/W。本课题组近年来对β-Ga2O3基TFT也进行了探索,采用PLD技术成功制备获得晶体管型紫外探测器。器件在栅压控制下,暗电流较低,且探测度达到4.41×1013Jones,为β-Ga2O3基TFT的发展奠定了基础。
此外,近年来还出现了基于非晶相Ga2O3TFT型光电探测器的研究工作。Qin等[129]采用磁控溅射法制备非晶Ga2O3基TFT,器件对254 nm紫外光有较高的响应,响应度为4.1×103A/W,量子效率为2×106%,探测度为2.5×1013cm·Hz1/2·W-1。Han等[130]采用磁控溅射工艺在Si衬底上生长非晶Ga2O3薄膜,制备薄膜晶体管结构紫外探测器,通过化学刻蚀的方法对有源层进行图案化。该方法有效地抑制了常见的栅极漏电流现象。Xiao等[131]采用旋涂工艺制备非晶Ga2O3TFT型紫外探测器,器件在260 nm光照下的响应度为2.17 A/W,光暗比为1.88×104。上述工作使Ga2O3材料制备的TFT器件在光电探测领域显示出广阔的应用前景。
表2[70-89,91-112,114-118,120-122,125-131]总结了基于不同结构的Ga2O3基紫外探测器的性能指标。从表中可见,肖特基型和MSM型的器件通常能获得较好的光暗比和暗电流,光暗比最高可达107[82],暗电流最低可控制在10-14A[107]。异质结型的Ga2O3基器件不仅与传统的半导体材料结合(如SiC,GaN等),还与新兴材料(石墨烯、NSTO等)相结合;此外,异质结型器件通常能够表现出自供电特性,在0 V偏压下实现良好的光电性能,该类器件是未来的发展方向。近年来,TFT结构被应用于Ga2O3基紫外探测器的制备中,由于栅压的控制,通常能够获得超高光响应度(105A/W)[125-126]、超大光暗比(108)[127]和优异的探测度[128],具有很大的发展潜力。
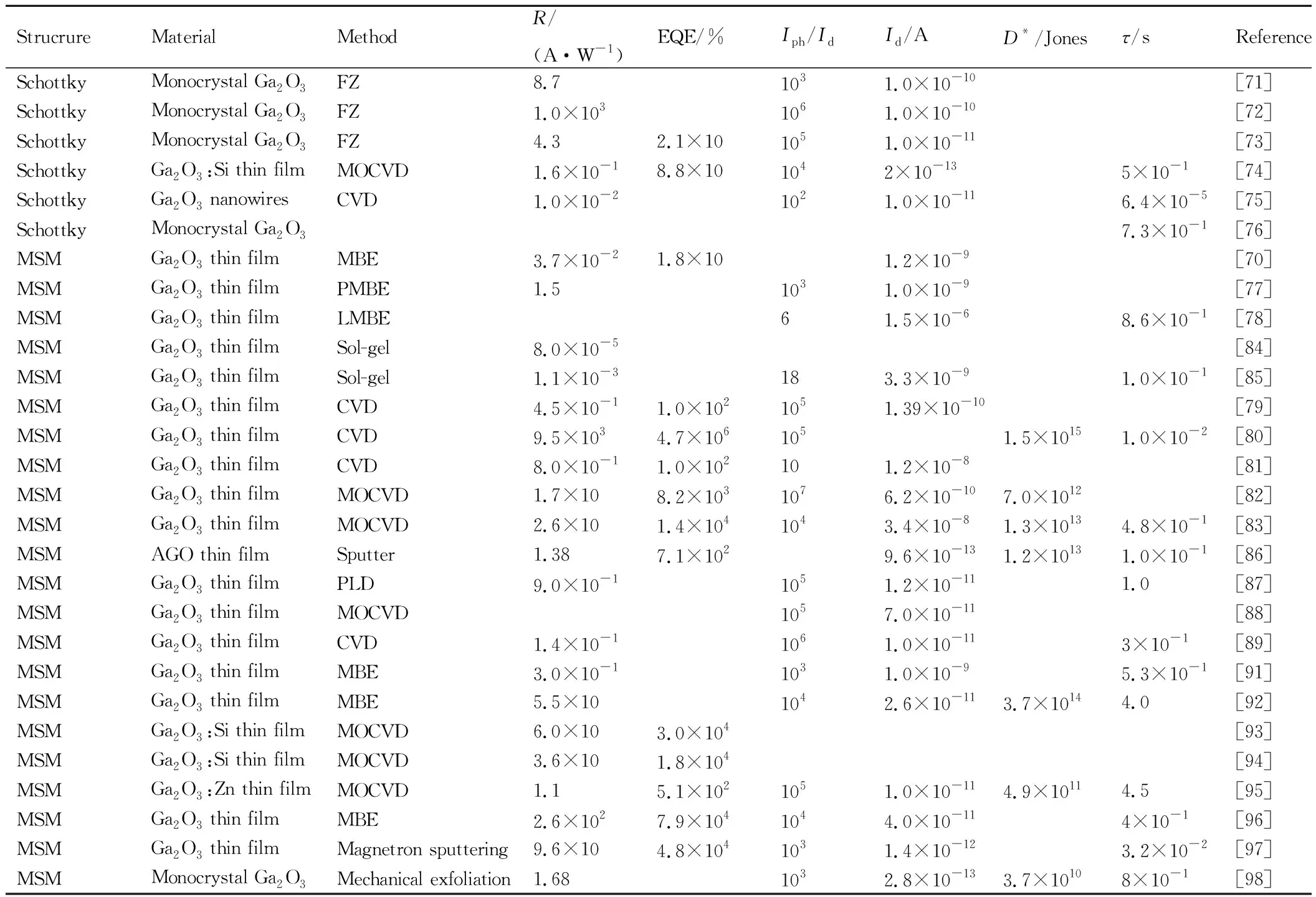
表2 Ga2O3基日盲紫外探测器的各项性能指标汇总Table 2 Summary of performance parameters of Ga2O3 based solar-blind UV detectors
3 结束语
宽禁带半导体Ga2O3是一种极具特色的材料,非常适合应用于日盲紫外探测领域,且在击穿场强、单晶生长等方面具备优势。目前,已经在物性研究、生长动力学、缺陷分析以及器件制备等方面开展了广泛的研究。本文介绍了Ga2O3的晶体结构和物性特征,并综述了不同结构的Ga2O3器件在日盲紫外探测领域的应用。
虽然,许多高性能的Ga2O3基紫外探测器已经陆续被报道,但目前仍有许多问题有待解决。大多数Ga2O3器件都是基于薄膜或纳米材料制备,由上文的叙述可知,基于纳米结构的器件通常会表现出更加优异的性能,但是单根纳米材料的光响应面积很小,在实际应用中并不适用,且制作工艺相对复杂,不利于商业化应用。薄膜材料经历长期的研究,制备工艺相对成熟,是最有可能实现商业化的材料形态。尤其是MSM结构的Ga2O3器件已经具备了商业化应用的性能。但是,薄膜中的位错、缺陷以及掺杂、晶相转变等方面仍需要进一步的研究,以获得高质量可调控的薄膜材料。单晶块体因优异的晶体质量吸引了不少研究学者的关注,其相关研究为同质外延高质量薄膜提供了基础,但单晶的价格昂贵且工艺复杂,还需不断改进。
此外,掺杂是调节材料能带和载流子浓度的有效方法,Ga2O3的n型掺杂已经开展了广泛研究,通常采用Si,Sn,Ge等元素实现能带调控。然而,Ga2O3的p型掺杂却存在很多难点。Ga2O3材料内部的空穴有效质量较大,因此无法自由运输,且O空位和Ga间隙将补偿空穴。主要的p型掺杂元素,如Zn,Mg,N等进入Ga2O3中将成为深能级受主,无法有效提供空穴,增加了空穴导电的难度。缺少有效的p型材料大大限制了Ga2O3基器件的发展,解决该问题是实现Ga2O3电子器件产业化的关键。目前的解决方案是将n型Ga2O3与其他带隙差异较大的材料构成异质结,如GaN,ZnO,SiC,石墨烯,金刚石等。

