一种能够改善鲁棒性的新型4H-SiC ESD 防护器件*
常帅军 马海伦 李浩 欧树基 郭建飞 钟鸣浩 刘莉†
1) (西安电子科技大学微电子学院,宽禁带半导体国家重点实验室,西安 710071)
2) (西安电子科技大学广州研究院,广州 510555)
1 引言
随着CMOS IC 中短栅长、薄栅氧化层等先进工艺的发展,在提高集成电路性能和集成度的同时,内部电路在静电放电时更易遭受破坏,因此改善ESD 防护器件的鲁棒性已经成为了研究的热点问题之一[1].宽禁带材料4H-SiC 因其高温、大功率和高压条件下优异的材料性能,能够克服硅材料的限制,更适用于航空航天、汽车等高压大功率器件领域.在ESD 器件应用方面,尽管4H-SiC 相比Si有着很多的优势,但目前对基于SiC 材料的ESD防护器件的研究还很少[1].由于4H-SiC 材料的临界电场(Ec=2.4 MV/cm)大约为Si 材料(Ec=0.25 MV/cm)的十倍,且载流子迁移率低,空穴迁移率不足Si 材料空穴迁移率的四分之一[2],这使得传统4H-SiC GGNMOS 器件的触发电压非常大,造成回滞效应相比硅基器件剧烈.近年,由韩国学者Do 等[3]提出了基于4H-SiC 材料的新型HHFGNMOS 结构,该结构采用常见于SCR 结构的分段结构以及栅极耦合技术[4,5].在同一工艺流片后,TLP 测试结果显示HHFGNMOS 结构的触发电压VT1由GGNMOS的250 V 减小至205 V,维持电压VH由74 V 提高至122 V,显著改善了4HSiC 材料本身所带来的剧烈回滞现象.但因电流集边效应HHFGNMOS 与GGNMOS的ESD电流主要通过靠近栅极的漏区内侧泄放,造成电流分布过于密集.
据此,本文在4H-SiC HHFGNMOS 基础上对MOS 管的漏区的底部进行改造,将其改为梳型(comb-like)结构,并利用TCAD 软件仿真,结果显示采用梳型结构后明显的改善了漏区内侧的电流分布问题,并且在合理的参数设置下,comb-like 4H-SiC HHFGNMOS 较4H-SiC HHFGNMOS的二次失效电流IT2提升5 A,维持电压VH增大8 V,从而在面积不变,工艺相兼容的条件下明显的改善了结构性能.
2 一种新型Comb-like 4H-SiC HHFGNMOS ESD 防护器件
众所周知,GGNMOS 是一种应用十分广泛的ESD 结构,与CMOS 工艺兼容,其结构如图1(a)所示,无论是基于SiC 材料还是Si 材料,在正常情况下,由于MN1的反向结高势垒的作用,器件不工作.当ESD 正脉冲作用于阳极时,Drain/P_Body PN 结反向击穿,形成的空穴电流注入P_Body,当Rp 压降超过0.7 V 时,寄生三极管QN1导通,泄放ESD 电流,以此达到保护芯片的目的.然而传统GGNMOS 结构并未改善基底材料为4H-SiC时所带来的剧烈回滞现象,因此无法满足ESD 器件日趋缩小的设计窗口.

图1 本文中所涉及到的4H-SiC ESD 防护器件结构 (a) 4H-SiC GGNMOS (grounded-gate NMOS)结构;(b) 4H-SiC HHFGNMOS(high holding voltage floating gate NMOSFET)结构;(c) comb-like 4H-SiC HHFGNMOS 结构;(d) comb-like 4H-SiC HHFGNMOS俯视图Fig.1.4H-SiC ESD protection device structure involved in this paper: (a) 4H-SiC GGNMOS (grounded gate NMOS) structure;(b) 4H-SiC HHFGNMOS (high holding voltage floating gate nMOSFET) structure;(c) comb-like 4H-SiC HHFGNMOS structure;(d) comb-like 4H-SiC HHFGNMOS top view.
图1(b)是韩国学者Do 等于2020 年提出的4H-SiC HHFGNMOS 结构,该结构由两个NMOSFET 组成,分别标记为为MN1和MN2.MN1漏极连接到阳极,MN1的栅极与MN2的漏极相连,MN1的源极及P_Body 电极与MN2的栅极、源极、P_Body 电极共同接至阴极.在正常工作情况下,HHFGNMOS 由于MN1的反向结高势垒的作用,该器件不工作.当ESD 正脉冲作用于阳极时,MN1的Drain/P_Body PN 结发生雪崩击穿,产生的空穴电流驱动MN1寄生三极管QN1导通以泄放ESD 电流.MN1的栅极连接到MN2的反向结,且MN1的栅极与漏区存在寄生电容,由于栅极耦合效应在ESD 正脉冲到达阳极时,MN1栅极形成一定的栅压,增强了Drain/P_Body PN 结的反向场强,使得更早发生雪崩击穿,降低了VT1,另一方面,MN1P+面积的减少减小了流经P_Body 区域的空穴电流,有助于QN1的正向偏置,进一步减小了VT1[6,7].MN1的源区采取分段结构,将N+/P+相互嵌套,减小源区N+有源区面积,器件导通时减小了寄生三极管的发射极注入效率,由文献[1]所知,寄生npn 电流增益:

其中γ和αT分别为寄生 npn 管的发射极注入效率和基区输运系数;
当γ减小,电流增益β减小,而β减小就会影响到寄生npn 管QN1集电极电流Ic的减小:

其中IS为理想饱和电流;Qb为基区电荷系数;VT为热电压.
当Ic减小时,维持电压增大.根据分析结果HHFGNMOS 结构性能出色,但仍存在因电流集边效应使得ESD 电流主要从漏区内侧泄放到阴极的问题,导致电流分布比较密集,ESD 脉冲引起的自加热效应更集中,更容易造成器件热失效.
comb-like 4H-SiC HHFGNMOS 结构与4HSiC HHFGNMOS 主要工作机理相同,但在HHFGNMOS的基础上将漏区改为comb-like 结构,该结构在保持HHFGNMOS 结构优点的同时,提升了漏区凹处电势,对原有寄生NPN 晶体管QN1的电流集边效应进行改进,利用了电流集边效应[8],降低漏区内侧的电流密度,使得电流分布变得均匀,同时维持电压小幅度增大,减小因SiC 材料特性所带来的的剧烈回滞现象,提高器件的鲁棒性.
3 TCAD 仿真结果分析与讨论
3.1 TLP(传输线)脉冲瞬态仿真测试结果
TLP 脉冲是具有一定上升沿和脉冲宽度的电流脉冲,广泛应用于对ESD 器件的性能测试[9],不同的脉冲宽度可以模拟不同的静电事件,本文通过10 ns 上升沿、100 ns 脉冲宽度的TLP 脉冲模拟HBM 静电事件对三种器件结构进行瞬态仿真测试.在仿真中,comb-like 4H-SiC HHFGNMOS与4H-SiC HHFGNMOS 尺寸保持相同,源极分段部分为13 段,每段宽度相同.所有器件栅长均为2 µm,掺杂区宽度均为200 µm.4H-SiC GGNMO S 长为45 µm,comb-like 4H-SiC HHFGNMOS 与4H-SiC HHFGNMOS 长为72 µm.此外,comblike 4H-SiC HHFGNMOS 结构中W=1 µm,S=1 µm,D=0.1 µm.表1 给出了仿真过程中所使用的器件结构参数.

表1 comb-like 4H-SiC HHFGNMOS 结构参数Table 1.structural parameters of comb-like 4H-SiC HHFGNMOS.
仿真过程中所采用的物理模型包括analytic,fldmob 迁移率模型,Selberherr 电离模型,bgn 禁带变窄模型,auger,srh 复合模型等.图2为以上三种基于4H-SiC 材料器件的TLPI-V特性曲线,插图为TLP 脉冲电路原理图.其中GGNMOS的触发电压、维持电压、二次失效电流分别为250 V,78 V,17 A 与文献[3]基本吻合,HHFGNMOS的触发电压、维持电压、二次失效电流分别为202 V,118 V,17 A 与文献[3]中205 V,122 V,17 A 基本吻合,GGNMOS,HHFGNMOS 泄漏电流为1×10—8A 与文献基本吻合,说明仿真采用的物理和结构模型是合理的.
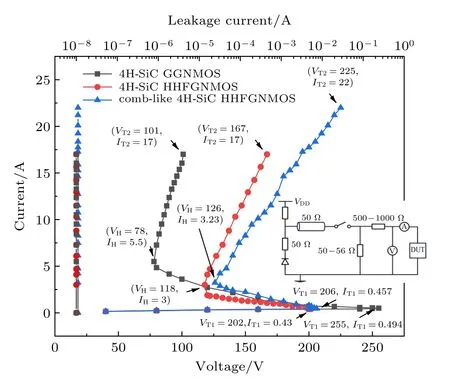
图2 基于4H-SiC的GGNMOS,HHFGNMOS,Comb-Like HHFGNMOS 三种结构的TLP I-V 仿真特性曲线Fig.2.TLP I-V simulation characteristic curves of GGNMOS,HHFGNMOS and comb-like HHFGNMOS based on 4H-SiC.
据前分析,4H-SiC HHFGNMOS 结构相比于4H-SiC GGNMOS,大大减小了回滞现象,但仍存在电流分布过于密集导致自加热效应比较严重的问题.图3 给出了comb-like 4H-SiC HHFGNMOS与4H-SiC HHFGNMOS 器件在同一TLP 脉冲瞬态仿真时的电流密度分布图,图中均选取阳极电流为85 mA/um 时刻的电流密度分布,以确保器件处于已触发状态下,由此可见comb-like 结构利用电流集边效应有效地降低了漏区内侧的电流密度,提高了电流分布的均匀性.图3 仿真的同时对comblike 4H-SiC HHFGNMOS 与4H-SiC HHFGNMOS晶格温度在TLP 脉冲测试期间的变化进行了提取,如图4 所示,从图4 可以明显地看出,相比于4H-SiC HHFGNMOS 结构,comb-like 4H-SiC HHFGNMOS 结构的晶格温度得到有效降低,在4HSiC HHFGNMOS 达到二次击穿点时,晶格温度由熔点2073 K 降至1872 K.结合图3 可以看到,由于comb-like 结构改善了电流分布,减轻了电流聚集导致的自加热效应,使二次失效电流由17 A 提升到22 A;同时一定程度上提升了维持电压,使得VH由118 V 提高到126 V,整体上较大程度改善了器件的性能.
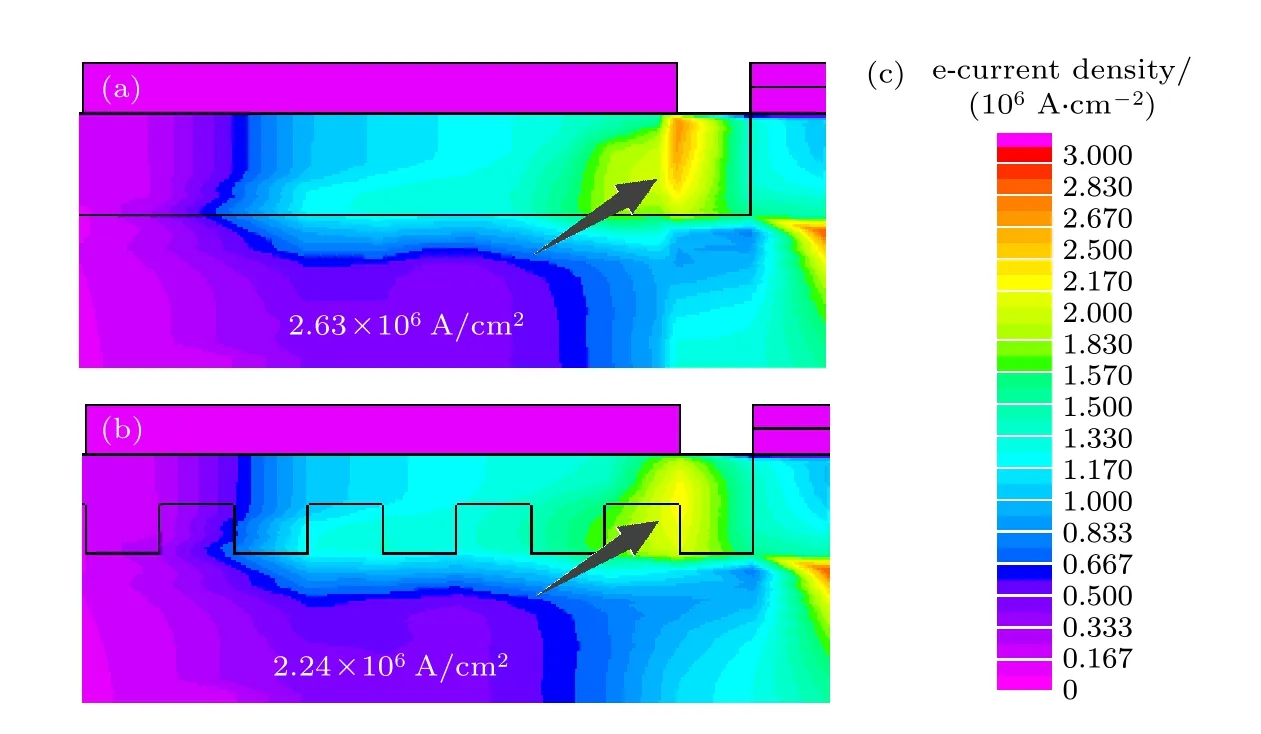
图3 4H-SiC HHFGNMOS 和comb-like 4H-SiC HHFGNMOS 漏区电流密度分布 (a) 4H-SiC HHFGNMOS 漏区电流密度分布;(b) comb-like 4H-SiC HHFGNMOS 漏区电流密度分布(W=1 µm,S=1 µm,D=0.1 µm);(c) 电流密度梯度图Fig.3.Drain current density distribution of 4H-SiC HHFGNMOS and comb-like 4H-SiC HHFGNMOS: (a) Drain current density distribution of 4H-SiC HHFGNMOS;(b) drain current density distribution of comb-like 4H-SiC HHFGNMOS (W=1 µm,S=1 µm,D=0.1 µm).

图4 Comb-Like 4H-SiC HHFGNMOS 与 4H-SiC HHFGNMOS相同应力下晶格温度曲线Fig.4.Lattice temperature curve of Comb-like 4H-SiC HHFGNMOS and 4H-SiC HHFGNMOS under the same stress.
3.2 Comb-like 结构的设计变量对电流分布的影响研究
如图1(c)所示,W(width),S(spacing),D(depth)是Comb-like 结构性能的影响参数,当W=1 µm,S=1 µm,D=0.1 µm 时,如图2 和图3所示Comb-like 结构较为显著的改善了HHFGNMOS 结构鲁棒性,现依次改变W,S,D值探究各参数的影响.
图5 给出了Comb-like 4H-SiC HHFGNMOS在W=1 µm,S=1 µm,D=0.1 µm的基础上依次改变W,S,D时的漏区电流密度分布,图中均选取阳极电流为85 mA/µm 时刻的电流密度分布,与图3 提取电流密度分布时的电学特性条件保持一致.图5(a)和图5(b)分别是D=0.05 µm,0.15 µm 及W和S不变时的电流密度分布,由图5(a)可知D=0.05 µm 时减轻了漏区内侧的电流集边现象,但改善程度较小,这是因为D较小时comblike 结构的凹处电势提升不明显,不能更有效地利用电流集边效应;由图5(b)可知,此时也显著减轻了电流集边效应,但此时漏区面积的减少导致漏区电阻相对图3(b)时增大更加明显,更易发生热损伤,不能更好的改善HHFGNMOS 结构鲁棒性.图5(c)和图5(d)分别是S=0.5,2 µm 及W和D不变时的电流密度分布,由图5(c)可知S较小时,因相邻的凸处距离过近,不利于电流的均匀分布,削弱了comb-like 结构改善效果;而在图5(d)中S较大时,反而会加剧漏区内测的电流集边,这是因为当S过大时,凸处的电势增大也很明显,导致无法利用电流集边效应,反而因为凹处电势的提升,导致漏区内侧的电流集边效应更加剧烈.图5(e)和图5(f)分别是W=0.5,2 µm 及S和D不变时的电流密度分布,由图5(e)可知W=0.5 µm 时电流分布更加密集,这时因为W较小,S相对于W过大,导致凸处电势相对较大,同时凹处电势的提升,使得电流集边非常严重,此时Comblike 结构有着较强的负面作用;当W=2 µm 时,此时因为W过大导致凹处相对凸处电势提升不明显,使得改善效果不佳。

图5 Comb-like 4H-SiC HFGNMOS 结构不同设计变量时漏区电流密度分布 (a) W=1 µm,S=1 µm,D=0.05 µm;(b) W=1 µm,S=1 µm,D=0.15 µm;(c) W=1 µm,S=0.5 µm,D=0.1 µm;(d) W=1 µm,S=2 µm,D=0.1 µm;(e) W=0.5 µm,S=1 µm,D=0.1 µm;(f) W=2 µm,S=1 µm,D=0.1 µmFig.5.Drain current density distribution of Comb-like 4H-SiC HHFGNMOS structure under different design variables: (a) W=1 µm,S=1 µm,D=0.05 µm;(b) W=1 µm,S=1 µm,D=0.15 µm;(c) W=1 µm,S=0.5 µm,D=0.1 µm;(d) W=1 µm,S=2 µm,D=0.1 µm;(e) W=0.5 µm,S=1 µm,D=0.1 µm;(f) W=2 µm,S=1 µm,D=0.1 µm.
因此,不合适的W,S,D取值有时会起到负面作用,使得电流分布更加密集,器件设计时应进行多次仿真,确定合适的W(width),S(spacing),D(depth)值.理想的comb-like 结构使电流的分布更加均匀,有利于提高器件鲁棒性;同时小幅度增大维持电压,改善4H-SiC 传统ESD 器件的剧烈回滞现象.
4 总结
本文通过利用 TCAD 仿真软件对Comb-like 4H-SiC HHFGNMOS 结构进行研究,采用comblike 结构对4H-SiC HHFGNMOS 进行了优化改良,利用电流集边效应,降低原本因为电流集边效应导致的漏极内侧较大的电流密度,使得电流分布更加均匀,与此同时,该结构一定程度增大了泄漏电流,使得器件静态功耗变大.经过仿真发现,在同一应力下,Comb-like 4H-SiC HHFGNMOS 电流密度分布明显更加均匀,最大晶格温度由4HSiC 熔点2073 K 降至1872 K,二次失效电流IT2由17 A 提升至22 A,提高了29%,维持电压VH由118 V 提升至126 V,提高了6.7%,触发电压VT1微弱增加,此外Comb-like 4H-SiC HHFGNMOS的回滞与4H-SiC GGNMOS 及4H-SiC HHFGNMOS相比减小了55.2%和5%.在面积不变、工艺相兼容的情况下较大程度改善了器件的鲁棒性,减小了回滞效应.

