重掺杂多晶硅薄膜中磷氧化物的探究*
王艺琳 兰自轩 杜汇伟 赵磊 马忠权†
1) (上海大学物理系,上海大学索朗光伏材料与器件R&D 联合实验室,上海 200444)
2) (中国计量大学材料与化学学院,杭州 310018)
在 n-型隧穿氧化物钝化接触(n-TOPCon)光伏器件中,高浓度磷掺杂的多晶硅薄膜 (n+ poly-Si) 是电子选择性钝化的关键材料.它的光学和电子学性能取决于化学组态与多晶结构的物相,并依赖于晶态转化过程中的高温退火与结构弛豫.采用低压化学气相沉积技术在 SiOx/n-Si 衬底上生长制备poly-Si (n+) 薄膜,利用带有深度刻蚀特征的 X-射线光电子能谱、高分辨率透射电子显微术和 X-光衍射分析方法,研究了该薄膜的微结构.发现薄膜中氧(O)元素的 O 1s 态的两个拟合峰(O2 和 O3)的结合能分别为 532.1 eV 和 533.7 eV,对应 O—Si 和 O—P 的成键态;而磷(P)元素的P 2p 态的两个拟合峰(P2 和 P3)的结合能分别为 132.4 eV和 135.1 eV,对应着O—P*的同根成键态.电子显微与光衍射分析表明,该多晶硅薄膜具有 (111)晶向择优生长的特点,晶面间距为0.313 nm,平均晶粒尺寸在43.6—55.0 nm.而(111)晶面簇在920 ℃高温退火过程中,产生力学形变与晶界,在局域范围内呈现大晶粒的单晶态.结合热力学函数,如生成焓、反应熵、热容、形成能与吉布斯自由能,以及能量最低原理分析可知,多晶硅薄膜内存在O—Si 和 O—P 键形成的条件,产生了氧化硅和氧化磷的成键态.
1 引言
自从 Feldmann 等[1]于 2014 年首先提出并实施了将 n-型重掺杂多晶硅薄膜(n+poly-Si)用于晶硅光伏器件以来,双层薄膜SiOx/poly-Si (n+)背钝化技术使隧穿氧化物钝化接触(tunneling oxide passivation contact,TOPCon)太阳能电池的光电转化性能得到了长足的发展[2].2021 年德国夫琅禾费研究所在 4.00 cm2的 p-型隧穿氧化硅钝化器件上获得了 26.0% 的超高效率[3-4];而在 n-型硅衬底上,浙江晶科能源经日本 JET 检测实验室认证,在235.79 cm2大尺寸器件上光电转化已达到 25.41%的冠军效率,已接近隧穿氧化硅钝化器件28.70%的效率极限[5].同时,在工业规模化制造领域,如四川通威科技,光电转化效率大于24.40%的M6 尺寸(158 mm×158 mm)的 n-型 TOPCon (n-TOPCon)器件已能批量生产,2022 年底预计能达到25.0%的器件效率[6-7].
相比较硅异质结光伏器件,TOPCon 光伏器件有更高的短路电流密度[8],如通威n-TOPCon (M6)光伏器件的短路电流密度已达到40.97 mA/cm2.众所周知,高短路电流密度的核心在于poly-Si (n+)/SiOx的双钝化机制[9],器件的结构如图1所示.对于n-TOPCon 光伏器件,从原理上讲,小于2.0 nm的超薄隧穿SiOx层提供了化学钝化的功能,减少了n-Si 与poly-Si (n+)界面处的不饱和悬挂键.而带有正电荷的磷重掺杂多晶硅薄膜中,有效激活的P 元素可通过场钝化效应降低n-Si/SiOx/poly-Si (n+)结构界面处电子与空穴的复合,实现电子的选择性输出.一方面,在多晶硅薄膜的制备过程中,后续的高温(850—920 ℃)退火,不仅决定了该薄膜的晶相由非晶态向多晶态转变的程度[10],而且影响着薄膜内部的晶粒质量,以及晶粒之间晶界内载流子的复合概率[11-12].另一方面,重掺杂工艺中的部分P 元素在退火过程中,可实现部分硅元素的替位,成为晶硅(Si)原子点阵结构中的活性杂质,进而产生大量的P+离子,形成正电荷中心,产生的附加静电场起到了场钝化的效果.载流子从而可以选择性传输,减小了poly-Si (n+)/SiOx/n-Si 界面的载流子复合[13-14].
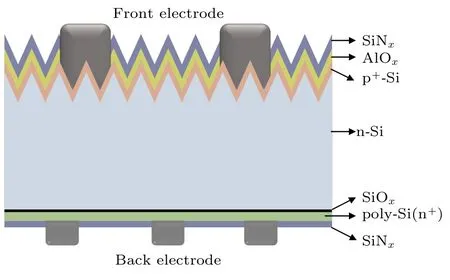
图1 n-TOPCon 器件结构示意图Fig.1.Schematic diagram of n-TOPCon device.
目前,在实验室或工业制备n-TOPCon 器件工艺中,多晶硅薄膜中磷(P)掺杂的浓度通常在2020—2021cm—3水平,由于受到磷元素在硅晶体中固溶度的限制 (<3.0×1020cm—3)[15],在热平衡状态下,一部分磷元素会处在“缺陷态”位置,如晶界或填隙的位置,形成了掺杂和高温退火后的“偏析”现象.同时,该多晶硅薄膜中还存在一定量的氧(O)元素,由于晶硅电子器件可忍受的氧浓度小于7.5×1017cm—3[16],受晶界中的压应力作用和制备工艺中的高温扩散过程,部分氧元素也存在于多晶硅薄膜的晶界处,形成除 Si—Si 或 Si—P 键以外的元素原子团(如 O—O,P—P,O—P,O—Si键)等.这些可能的、新的成键态及其化合物,如果满足热力学条件,则有可能在室温下存在,会对该多晶硅薄膜poly-Si (n+)的性能产生一定的作用,而此项内容的研究尚未见报道.
对此,本文通过带有深度刻蚀的X-射线光电子能谱(X-ray photoelectron spectroscopy,XPS)测量技术、高分辨率透射电子显微术(high-resolution transmission electron microscopy,HR-TEM) 和X-光衍射 (X-ray diffraction,XRD) 分析方法,研究多晶硅薄膜内高浓度磷元素掺杂和高温退火对薄膜物相和化学态的影响,以及多晶硅薄膜内部Si—O 和P—O 键在多晶硅晶界处形成的热力学条件,进一步阐明poly-Si (n+)薄膜在TOPCon光伏器件中存在的意义.
2 实验方法
2.1 样品制备
图1 为n-TOPCon 器件的样品结构和实验中材料堆砌指导图[1],底部的SiOx/poly-Si (n+)薄膜体系的制备流程如下[17]: 采用RCA 工艺[18]对平面 n-Si 衬底清洗并抛光.使用低压原子层沉积薄膜生长技术[19],有机硅源三(二甲胺基)硅烷 [SiH(N(CH3)2)3]和氧气(O2)作为反应源,按反应方程式(1)[20]在n-Si 衬底表面沉积<2.0 nm 的隧穿氧化硅SiOx层,沉积温度为180 ℃,沉积压强为120 Pa,有机硅源与氧气的流量比为 1∶2.

其中(s)代表固态,(g)代表气态.
随后,原位通入SiH4,PH3和N2,利用低压化学气相沉积(low pressure chemical vapor deposition,LPCVD) 技术,在n-Si/SiOx上面沉积高浓度磷掺杂非晶硅薄膜(a-Si)[10],厚度为150 nm,沉积温度为380 ℃,三种气体SiH4,PH3和N2的比例为1∶2∶2.5.最后,该薄膜体系n-Si/SiOx/poly-Si (n+)于N2氛围中,在920 ℃高温下退火45 min,使得a-Si 薄膜转变为poly-Si (n+)结构状态.本文的实验样品为四川通威提供,样品面积为158 mm×158 mm (M6),在AM 1.5G 的标准太阳光照射下,获得该光伏器件的开路电压为713.24 mV,短路电流密度为40.97 mA/cm2,填充因子为83.65%,平均光电转化效率为24.43%;其中器件的并联电阻约 1715.8 Ω,串联电阻约0.57 mΩ.
2.2 表征方法
为了有效测量n-TOPCon 器件中n-Si/SiOx/poly-Si (n+)薄膜体系的微结构(化学组态与物相),待测样品为图1 中去除了背部SiNx薄膜和背电极的状态.分别采用XPS,HR-TEM 和XRD 技术,对样品进行化学组态、固态原子点阵形貌结构和poly-Si (n+)薄膜的物相分析.
XPS (Thermo,ESCALAB 250 Xi)的激发源为Al Kα (1486.68 eV),对 P,Si 和O 三种元素的扫描能量为30 eV,而Ar 离子作为深度刻蚀溅射源,以时间(s)为标度逐层剥离达到不同的深度,所采用离子枪的能量为2.0 keV.在实际测量过程中,中和枪被用来减轻样品表面的电荷积累,避免产生结合能的电荷位移,且所有表面或薄膜内的各元素结合能均经过样品表面污染碳校正(C 1s 电子结合能的标准值为 284.8 eV).
多晶硅薄膜poly-Si (n+)物相的确认,采用了XRD (Rigaku,D/max-2500/PC) 技术,测试功率为40 kV×200 mA (8 kW).利用了广角扫描方式,即2θ=20°—80°.该薄膜体系n-Si/SiOx/poly-Si(n+)内各层材料的点阵形貌与各层之间的界面结构特征,由HR-TEM (JEOL,JEM-2100 F)测试得到,所用工作电压为200 kV.样品先经聚焦离子束(FEI,Helios Nanolab 600i)切割为面积2 mm ×3 mm 大小、厚度为200 nm 的薄片;并在多晶硅薄膜上沉积约3 µm 的金属铂(Pt),以便减少样品表面电荷积累,提高HR-TEM 成像质量.
3 结果与讨论
3.1 Poly-Si (n+) 薄膜的化学组态
含有多晶硅SiOx/poly Si (n+)薄膜体系的XPS-P 2p,Si 2p 和O 1s 态的光电子能谱深度分布如图2(a)—(c)所示,刻蚀时间范围为0—2600 s.实验获得的图2(a)中,P 2p 态光电子峰的中心结合能(BE)在134.5 eV 附近,峰形显示具有较宽的半高全宽值,表明其化学组分不止一种,需要进行峰-峰拟合来确定薄膜内的化学组态.但是,由于Si 2p 态在125—145 eV 区间存在平滑波包式的等离激元损失峰[21],使得 XPS-P 2p 态的能谱受到了Si 2p 态的等离激元损失峰的影响,无法定量化元素P,Si 和O 在薄膜内的质量分数占比.因此,利用未掺杂磷元素(P)的晶硅样品,实测 XPS-Si 2p 态,获得实际等离激元损失峰分布,如图2(a)黄色曲线所示,作为定性参考.对实测中获得的XPS-P 2p态能谱进行峰-峰拟合与数值分析,最佳拟合结果表示有三种化学成分: P1,P2 和 P3.如图3(a)所示,它们峰位处的结合能依次为129.4 eV,132.4 eV和135.1 eV,参考已有的研究结果和报道[21],这三个峰分别对应元素磷及其氧化态的P—P,P—O*和P—O**成键态.如 P0(P-P),P+3(P2O3) 和P+5(P2O5).但是XPS-Si 2p 态的电子能谱只能被拟合成三个子峰,即标识为图3(b)中的Si1,Si2和 Si3,恰当拟合后,分别对应 Si—Si 成键的Si 2p3/2和Si 2p1/2自旋-轨道分裂态和Si—O 成键态,它们的峰位对应的结合能分别为99.2 eV,99.9 eV和100.5 eV,拟合峰的半高全宽分别为 0.72 eV,0.72 eV 和 0.73 eV.

图2 P 2p,Si 2p,O 1s 态的XPS 能谱图(描述了能谱在薄膜不同深度处的强度变化,对应刻蚀时间为a: 0 s,b: 500 s,c: 1500 s,d: 2000 s,e: 2600 s) (a) P 2p 态的XPS 能谱和Si 2p 态的等离激元损失峰;(b) Si 2p 态的XPS 能谱;(c) O 1s 态的XPS 能谱.为了方便显示各元素结合能的变化,对(a)—(c)图谱曲线的强度均做出了调整Fig.2.The XPS spectra of P 2p,Si 2p and O 1s,which describes the changes of density with different depths at etching time of a 0 s,b 500 s,c 1500 s,d 2000 s,and e 2600 s.(a) XPS spectra of P 2p states and Si 2p for plasmon loss peak;(b) XPS spectra of Si 2p states;(c) XPS spectra of O 1s states.In order to display the change of binding energy of each elements intuitively,the intensity of spectrum curves in panel (a)—(c) are adjusted.

图3 刻蚀时间为2000 s 时P 2p 态、Si 2p、O 1s 态的分峰拟合图谱 (a) P 2p 态;(b) Si 2p 态;(c) O 1s 态Fig.3.Fitting peak spectra of P 2p,Si 2p,O 1s state of etching time of 2000 s: (a) P 2p state;(b) Si 2p state;(c) O 1s state.
Poly-Si (n+)薄膜中的氧(O)元素,在XPS-O 1s 态的不同深度均具有较高的强度,如图2(c)所示,表明该薄膜中氧含量较大,这些氧元素来自于原材料和样品制备的各阶段引入.对于O 1s 态的光电子峰进行峰-峰拟合后,同样获得了三种化学组分态,即标识为: O1,O2 和 O3,如图3(b)所示.它们峰位的结合能分别为531.2 eV,532.1 eV 和533.7 eV,对应O—O,O—Si 和 O—P 成键态[22,23].
仔细地分辨O 1s 态的深度分布时,发现有两种情况出现: 1)当利用Ar 离子束连续刻蚀到2000 s时,对应的位置为距多晶硅薄膜表面约120 nm 处(标定的溅射率约为 0.06 nm/s),此时的O2 和O3峰比较明显,表明该薄膜内同时存在Si—O 和P—O 的成键态,或者说,该薄膜内部存在硅氧化物和磷氧化物;2)当刻蚀到2600 s 时,对应的探测位置在距poly-Si (n+)薄膜表面约 156 nm 处,此时获得的信号已接近或进入n-Si/SiOx的过渡区内,发现O 1s 态仍保留了O1 和O2 两个拟合峰,失去了O3 拟合峰,表明此处对应O—O 和 Si—O 的成键态(这里略去了数值拟合的结果).
3.2 Poly-Si (n+)薄膜的物相
n-Si/SiOx/poly Si (n+)样品的XRD 测量结果,如图4 所示.在XRD 谱图中,2θ=28.8°处有一个较强的衍射峰,其次在47.7°和56.6°处对应两个较小的衍射峰,依次对应poly-Si (n+)薄膜的(111),(220)和(311)晶面取向[24].而且(111)晶面的衍射峰强度远远大于其他两个晶面族的衍射峰,体现了该多晶硅薄膜内晶粒的择优生长特点,经Scherrer公式[25]计算得出,该多晶硅薄膜内晶粒的平均尺寸在43.6—55.0 nm,是典型的纳米级多晶结构,必然包含有大量的晶粒和晶界.

图4 n-TOPCon 器件中poly-Si (n+)薄膜的XRD 表征,其中a,b 分别为同一样品的两次测量结果Fig.4.Characterization of poly-Si (n+) film in n-TOPCon device,and a,b are the two measurements for the same sample,respectively.
多晶硅poly-Si (n+)薄膜材料内部的原子点阵排列、晶界、晶面取向和 n-Si/SiOx/poly-Si (n+)薄膜体系中的SiOx厚度、界面结构,由HR-TEM 的高分辨电子束显微图像给出,如图5(a)和图5(b)所示.该多晶硅薄膜内(111)晶面簇的面间距为0.313 nm,点阵形貌也验证了LPCVD 制备过程中,该多晶硅薄膜(111)方向择优取向生长的特征.但由于薄膜生长过程中产生局部的拉伸和压缩,导致薄膜内部局域的力学形变,而薄膜在沉积过程中又受到温度等因素的影响,最终晶核成岛、连续结晶过程中产生了明显的晶界,造成多晶物相[26].但在局域范围内,多晶硅原子点阵排列有序,在大尺寸晶粒内部呈现出单晶态,极大减少了载流子在多晶硅内传输时的散射概率,有效提升了薄膜的电导率,这也是TOPCon 器件高效率的原因之一.图5(b)显示了 n-Si/SiOx/poly-Si (n+)的界面区,存在着超薄氧化硅(SiOx)的过渡区,平均厚度约为1.34 nm,并与衬底n-Si 和poly-Si (n+)的点阵发生交错,原子相互嵌入.
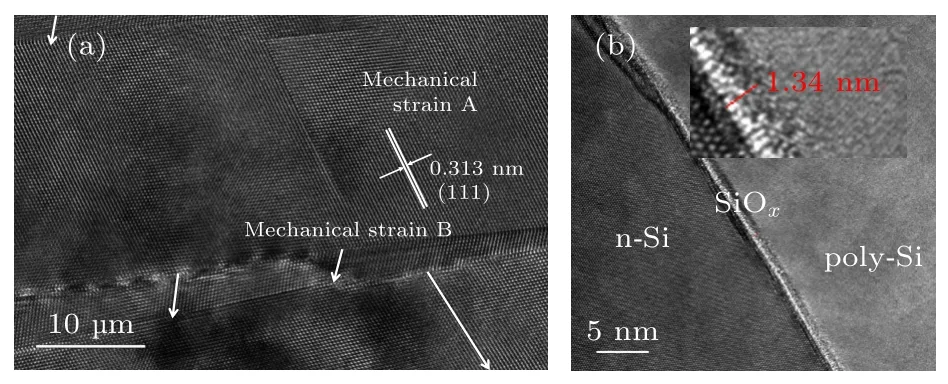
图5 (a) n-TOPCon 器件中poly-Si (n+)薄膜的不同晶面方向与力学形变;(b) poly-Si (n+)/SiOx/n-Si 界面与隧穿氧化硅Fig.5.(a) Characterization of different crystal face orientations and mechanical strains in poly-Si (n+) film of n-TOPCon device;(b) poly-Si (n+)/SiOx/n-Si interface and tunneling silicon oxide.
3.3 Poly-Si (n+) 薄膜的热力学分析
利用上述带有深度刻蚀的XPS,HR-TEM,XRD 三种分析方法,研究了n-Si/SiOx/poly-Si (n+)多层膜系统在薄膜沉积、热扩散掺杂和高温退火过程中,主要由Si,O 和P 元素构成的多粒子系统,从非平衡态过渡到平衡态,产生了多晶硅薄膜内部的多种化学组分,包括P—Si,P—O,Si—O 键及其可能的衍生物.为了进一步从热力学的概念和原理的角度,分析P 元素重掺杂的多晶硅薄膜中的平衡态物质存在的可能性,对该系统进行了半定量分析,从而表明深度剖析XPS 化学组态测量的实验结果是合理的预期.根据Material Project 数据库[27-29],298 K(室温)下 SiP,SiO,SiO2和P2O5的生成焓、热容CP、反应熵和形成能的具体数据如表1 所列.
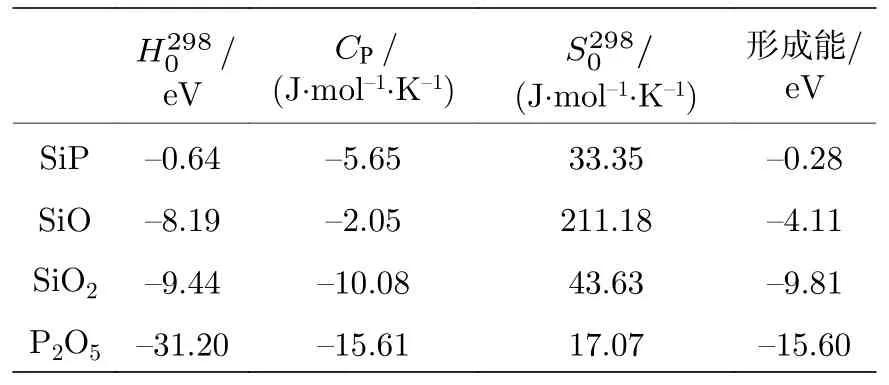
表1 298 K(室温)时,SiP,SiO,SiO2 和P2O5 的热力学函数参数(生成焓、热容、反应熵与形成能)Table 1.Thermodynamic function parameters(formation enthalpy,heat capacity,reaction entropy and formation energy) of SiP,SiO,SiO2 and P2O5 at 298 K (RT).
此外,任意温度(T)下的生成焓、反应熵和吉布斯自由能可由(2)式—(4)式求得[30]:

因此,n-Si/SiOx/poly-Si (n+)薄膜体系于N2氛围中,在920 ℃(1193 K)高温下退火45 min,该温度下计算得到的热力学参数值如表2 所列.其中,考虑到热容随温度的变化非常微弱,在此处将其按常量计算.磷元素经热扩散进入多晶硅薄膜,高温退火后取代原本Si—Si 键中的硅原子,成为替位掺杂(P+),使该薄膜成为n+型导电.另外,尽管室温下,SiO,SiO2和P2O5的形成能均低于SiP,但经计算,SiP 在1193 K 下的生成焓为—53.05 eV,吉布斯自由能为 —53.37 eV.根据能量最低原理,SiO2和P2O5的生成焓和吉布斯自由能均低于SiP,而SiO 则相反[31],验证了退火处理后,该多晶硅薄膜内部,除了大量的施主离子(P+)外,剩余的Si,P 元素有可能生成硅氧化物和磷氧化物,与3.1 节的实验结果相符.但由于Si 2p 的等离激元损失峰的影响,使得无法定量多晶硅薄膜中P,Si和O 三元素各自的含量占比,也无法确定硅氧化物和磷氧化物具体的化学配比.而关于P,Si 和O 元素的衍生物,即磷硅氧三元化合物是否存在于多晶硅薄膜内,参照SiO2-P2O5二元体系的合成方法,SiP2O7要在大于 1000 ℃(1273 K)的高温退火3 h 以上[31-33]才能够合成.本文实验样品并不满足相应的退火温度和时间,因此只能判定在poly-Si (n+)薄膜中存在着Si—O 键和P—O 键,与XPS 的测量结果相一致.
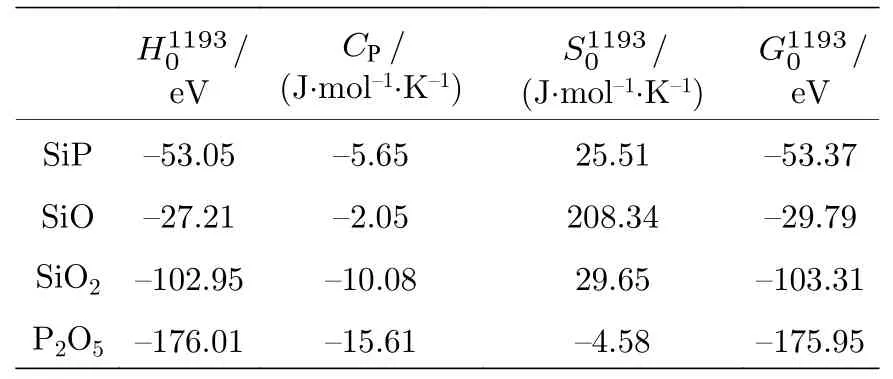
表2 1193 K (920 ℃)时,SiP,SiO,SiO2 和 P2O5的热力学函数参数(生成焓、热容、反应熵与形成能)Table 2.Thermodynamic function parameters(formation enthalpy,heat capacity,reaction entropy and Gibbs free energy) of SiP,SiO,SiO2 and P2O5 at 1193 K.
4 结论
利用通过化学态可进行深度分布分析的XPS技术,结合Ar 离子逐层刻蚀方法,探测了厚度约150 nm 的poly-Si (n+)薄膜内部磷(P)、硅(Si)和氧(O) 元素的化学组态,发现与它们的原子内壳层(P 2p,Si 2p,O 1s)光电子结合能相关联的化学位移,是和薄膜内化学成分的变化有关.经过能谱的峰-峰拟合的退卷积数值处理,确认了P 2p 电子态的三个结合能129.4,132.4 和 135.1 eV,分别对应Si—P 和P—O*(二个)成键态,从性能上讲,分别属于P 元素的施主掺杂(P+)和磷氧化物.从O 1s 态的三个拟合峰的结合能531.2,532.1 和535.1 eV 随深度变化看,也确认了薄膜内Si—O和P—O 化学键的存在,且准确标识了n-Si/SiOx界面区域Si—O 和O—O 化学键存在的事实.同时,薄膜中的Si—O 键也得到了结合能为100.5 eV处的Si 2p 态子峰Si3 的肯定.
借助 XRD 和 HR-TEM 分析获得,该多晶硅薄膜具有 (111) 择优取向,平均晶粒尺寸为 43.6—55.0 nm,内部包含大量的晶界.各晶面簇在 920 ℃高温退火中产生局域力学形变和晶粒内的张应力与晶界上的压应力,局部点阵形貌高度有序,呈现单晶物相.由此可以推测出两个结论: 1) 薄膜的(111) 择优取向应该和晶硅衬底 (n-Si) 表面金字塔的晶面结构有关,不受含有高密度针孔的超薄氧化硅层的影响;2) 薄膜内处于压应力状态的晶界是磷氧键和硅氧键分子的存在之地.
通过室温(298 K)和高温(1193 K)下热力学函数分析发现,薄膜内的Si—P,Si—O 和P—O 键,或 SiP,SiOx和 PxOy分子(广义上,x≠2,y≠5),可以达到热平衡时最低能量原理的要求.并且在1193 K 的退火条件下,只有SiOx,PxOy均低于SiP的生成焓和吉布斯自由能,表明多晶硅薄膜内存在Si—O 和P—O 键形成的条件,验证了XPS 的化学组态分析,poly-Si (n+)薄膜内部可生成氧化硅和氧化磷物质.
所以,该poly-Si (n+)薄膜内部的氧元素,分别在晶界中与硅、磷元素成键形成氧化硅和氧化磷,部分钝化了晶界处的悬挂键缺陷,导致晶硅TOPCon 光伏器件的复合电流密度(J0)和接触电阻(ρc)降低,有效地提升了该光伏器件的开路电压、短路电流和填充因子,以及光电转换效率.
感谢四川通威公司为本课题组提供n-TOPCon 器件.

