基于非线性电阻的GaN HEMT经验基大信号模型
毕磊
(1.天津大学微电子学院,天津 300072;2.青岛市海洋信息感知与传输重点实验室,青岛 266000)
引 言
近年来,宽禁带半导体材料氮化镓(GaN)以其高电子迁移率、高热导率、低介电常数等优势,成为高频大功率微波器件和系统的研究热点[1-3],在民用及国防领域具有广泛的应用前景.器件模型作为连接器件物理特性和电路设计的桥梁,其准确性起着至关重要的作用.GaN高电子迁移率晶体管(high electron mobility transistor,GaN HEMT)大信号模型可分为物理基模型、经验基模型和行为模型.物理基模型算法过于复杂,不利于与仿真软件的结合;行为模型不能像数学解析式那样连续可导,在仿真中可能存在收敛性问题;经验基模型建模效率高,模型简单,收敛性好,建模过程易于标准化,便于用于常用的电路仿真软件,因而得到了广泛的研究[4].
现如今常用的经验基模型有Curtice模型[5]、Angelov模型[6-7]和EEHEMT1模型[8]等,它们各有优缺点.文献[5]提出的Curtice模型在阈值电压附近的精度不够,并且存在收敛性问题;文献[6-7]提出的Angelov模型结构简单且高阶可导,但在阈值区及饱和区的精度不高,且存在“钟形”跨导的限制;文献[8]引用的EEHEMT1模型精度足够高,但存在参数过于复杂,且不能满足高阶可导等问题.文献[9]提出了以广泛使用的Angelov模型为原型,三个基于双曲正切函数的改进的漏极-源极电流(Ids)模型方程.虽然该模型精度高,高阶可导,可以更准确地预测各种非对称跨导(gm)特性的电流-电压(I-V)曲线,但其等效电路参数Rs、Rd为常数,这是目前大多数经验基大信号模型存在的问题.
本论文首先分析了GaN HEMT在高漏极偏置和高电流密度下的电阻特性[10-12],然后将非线性电阻Rs、Rd模型嵌入到文献[9]提出的经验基模型的大信号模型中,提高了原始模型的精度及物理特性,尤其是对功率附加效率(power added efficiency,PAE)预测精度的改善.用栅长0.25 µm,栅宽分别为2×200 µm、2×250 µm、4×200 µm的GaN HEMT测试数据进行大信号输出特性仿真验证,结果证明该模型与测试数据具有较高的吻合性及良好的缩放性.
1 GaN材料特性
作为第三代半导体材料的代表,GaN材料被广泛应用于通信、雷达和探测器等领域.表1为GaN与其他几种典型半导体材料的特性对比.
由表1分析可知:相比较其他几种半导体材料,GaN材料有着更高的禁带宽度,使得GaN HEMT器件具有良好的耐热性,可以在高温下工作;较小的相对介电常数,能够让器件产生较小的寄生电容,从而更适合雷达等电子设备及大功率器件的制作;较高的击穿电场,使得器件可以工作在高电压环境下;较高的电子饱和速率,使得器件可以产生高功率和高开关速度.

表1 几种经典半导体材料的特性对比Tab.1 Comparison of the characteristics of several classic semiconductor materials
上述特点使得GaN材料更适合制作高频、高温及大功率器件.而GaN HEMT的晶体管模型作为电路设计中最基础、最重要的器件,其准确性对于电路系统的性能至关重要.
2 模型介绍
2.1 经验基模型
本文采取的经验基模型是以Angelov模型为原型,结合EEHEMT1模型分段函数的思想提出的三个适用于不同跨导gm特性曲线的非线性I-V模型[9],如公式(1)~(4)所示:

式中:


α、λ、Lsb、Vdg、Vtr等参数与Angelov模型中定义相同[6-7];Ipk为gm达到最大值gmmax时的Ids值 ;P21、P31、P22、P32为不同区域的拟合参数;Ve1和Ve2是 对栅源电压Vgs的修正;Vpk为gm达到最大值gmmax时 的Vgs值 ;为Level-3独有的参数,如公式(13)所示,用于消除Angelov模型受“钟形”跨导的限制,其中Isat为Ids所达到的饱和值.根据实测I-V数据不同的gm特性选择不同层次的模型,如图1所示.

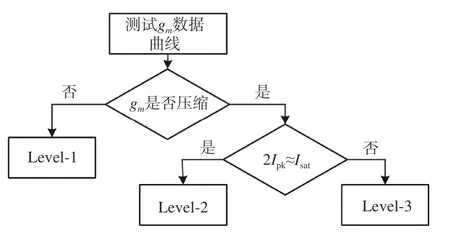
图1 不同层次模型选择Fig.1 Different levels of model selection
在直流条件下,因GaN HEMT受自热效应的影响,高栅压偏置下的Ids在达到饱和值后会随漏压升高而降低[13],需将IpkP1调整为与温度相关的变量:

式中:Tch为 沟道结温[14];Tpk1、Tpk2、TP1为温度调制因子.
2.2 非线性电阻分析
在高漏极偏置和高电流密度条件下,GaN HEMT会产生影响器件性能的物理效应.当漏极处于高电压偏置时,可以施加到器件输入端的射频(radio frequency,RF)电压也会相应增加.这时,通道电流被驱动为大信号模式,输入阻抗成为RF驱动的非线性函数,并对器件性能产生相应的影响[10].
在物理电阻模型中,漏/源电阻由两部分构成:不受偏置影响的接触电阻Rc和受流过接入区电流控制的电阻Rd/s.流经接入区的电流被定义为

式中:W为栅宽;Ng为栅指数;q为电子电荷;ns0为在漏极或源极接入区中二维电子气(two dimensional electron gas, 2DEG)电荷密度;vs为电子速度.vs随着电流增加线性增加,直到达到饱和载流子速度vsat[12].此时,流经接入区的电流可以被定义为

式中:VRsat是接入区域的饱和电压值;Lac是源极或漏极接入区一侧的长度; µac是 载流子迁移率.所以Rd/s可以用漏源电流Ids表示为

式中:Iac_sat=Qac·vsat为饱和电流;Rd0/s0=Lac/(Qac·µac)为低电流时接入区的电阻;Ids等 同于Iac[11].嵌入非线性电阻的电热大信号模型等效电路拓扑结构如图2所示.
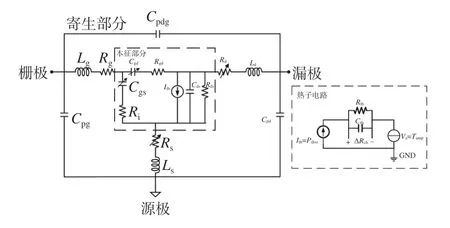
图2 嵌入非线性电阻的电热大信号模型等效电路拓扑结构Fig.2 Equivalent circuit topology structure of electric heating large signal model with embedded nonlinear resistance
2.3 缩放规则
由于目前测量仪器的最大功率、阻抗范围等因素限制,难以对所有所需的器件尺寸完成必要的测试,因此,可缩放模型是大尺寸器件的一个重要的建模手段.对于固定栅长的器件,由于晶体管总输出功率与器件总栅宽成正比,所以,不同尺寸的器件可以根据相对于参考器件的尺寸比列关系建立模型[15],如公式(21)、(22)所示.大信号缩放模型各参数的缩放规则如表2所示.

表2 GaN HEMT大信号模型缩放规则Tab.2 GaN HEMT large signal model scalable rules

式中:Ng_ref、Wg_ref分别代表参考器件的栅指数、单位栅宽;Ng_sc、Wg_sc分别代表待缩放器件的栅指数、单位栅宽.对Ids缩 放时,只需要对参数Ipk及Level-3中特有的参数描述为与总栅宽成正比例关系.
3 模型验证分析
将栅长为0.25 µm,栅宽为2×200 µm的GaN HEMT作为参考器件,将栅宽为2×250 µm、4×200 µm的GaN HEMT作为待缩放器件.采用Agilent 4156C精密半导体参数分析仪和N5245A矢量网络分析仪,对器件的高频和直流特性进行了测试,在测试小信号S参数时采用开路短路去嵌方法.建立模型的步骤如下[16]:
第一步,将参考器件截止状态(Vds= 0 V,Vgs 第二步,利用零偏压状态(Vds=Vgs=0 V)下的S参数去嵌寄生电容之后,变换为Z参数,提取寄生电感和寄生电阻. 第三步,去嵌寄生参数,利用网络参数变化,得到本征参数.通过优化、调谐,获得全部等效电路元件初值. 第四步,由图3可知,GaN HEMT的gm有压缩且Isat>2Ipk.根据图1,电流Ids模型公式选择Level-3,在Matlab中提取Ids模型初值. 图3 Vds=15 V时转移特性曲线及跨导Fig.3 Transfer characteristic curve and transconductance at Vds=15 V 第五步,根据GaN HEMT大信号测试数据获得饱和电流值Isat,结合获得寄生电阻初值Rd0/s0形成非线性电阻模型.在ADS中建立完整的嵌入非线性电阻模型的符号定义模型(symbol definition model,SDD)[17]. 在ADS中搭建直流仿真电路对模型进行直流仿真验证.Vds从 0到28 V,步长为1 V;Vgs从−1.75 V到2 V,步长为0.25 V.直流仿真结果如图4所示,参考器件及缩放器件的直流仿真结果与测试数据吻合性较高,证明模型有着较高精度的直流输出特性以及良好的缩放性,为建立准确的GaN HEMT大信号模型奠定了基础. 图4 不同栅宽GaN HEMT直流仿真与实测数据结果对比Fig.4 Comparison of GaN HEMT DC simulation and measured data results with different gate widths 图5为参考器件大信号输出特性仿真与实测结果对比.偏置为Vgs= −1.7 V,Vds=70 V.输入功率Pin为10~30 dBm.9 GHz时器件最大输出功率的输入阻抗、输出阻抗分别为7.559+j13.882 Ω、75.801+j112.825 Ω.仿真结果证明,在模型的输出功率Pout和增益G与测试数据吻合性很好的情况下,非线性电阻模型的嵌入,使得模型在大信号下对PAE的预测情况得到了明显的改善.由图5(b)可知,原始模型在高功率(>25 dBm)输入条件下对PAE的预测值要明显高于实际测试数据,但嵌入非线性电阻之后模型PAE的预测值能够与测试数据基本吻合. 图5 栅宽为2×200 µm GaN HEMT大信号输出特性仿真与实测结果对比Fig.5 Comparison of simulation and measured results of large-signal output characteristics of GaN HEMT with a gate width of 2×200 µm 为验证模型的缩放性,用栅宽2×250 µm、4×200 µm的GaN HEMT大信号输出特性仿真与实测结果作对比,如图6所示.相同偏置下,9 GHz时器件最大输出功率的输入阻抗和输出阻抗分别为8.803+j10.219 Ω和52.344 +j90.221 Ω、6.260+j4.366 Ω和50.505+j67.725 Ω.仿真结果证明模型具有良好的缩放性,器件模型的输出功率、增益与测试数据吻合较好.虽然有缩放误差的存在,但2×250 µm器件与参考器件尺寸相差不大,所以拟合程度基本一致;而4×200 µm器件模型的PAE预测值则略高于实测数据,但嵌入非线性电阻的大信号模型精度还是要优于原始模型. 图6 不同栅宽缩放模型大信号输出特性仿真与实测结果对比Fig.6 Comparison of simulation and measured results of large signal output characteristics of the scalable model with different gate widths 为了比较改进前后模型对PAE的预测结果,定义均方误差(mean-square error, MSE)为 式中:Emo_i为每个输入功率Pin下模型PAE预测值;Eme_i为每个输入功率Pin下PAE测试值;N为输入功率Pin的总个数. 由表3可以看出,即使有缩放误差的影响,三个尺寸改进模型PAE预测值的MSE还是要低于原始模型,表明嵌入非线性电阻能够有效提升模型PAE的预测精度. 表3 改进前后的模型对PAE预测值的MSE对比Tab.3 MSE comparison of the model before and after the improvement to the predicted value of PAE 本文介绍了一款基于非线性电阻的GaN HEMT经验基大信号模型,通过分析大功率条件下GaN HEMT电阻阻值随输入电流Ids变化而变化的特性,将非线性电阻模型嵌入到经验基大信号模型中,提高了模型物理特性及精度,同时所构建的经验基大信号模型也易于在仿真软件中集成.利用栅长为0.25 µm,栅宽分别为2×200 µm、2×250 µm、4×200 µm的GaN HEMT测试数据进行验证.结果表明,改进的模型仿真得到的器件直流输出特性以及大信号输出特性与实测结果吻合性较好,能够更好地预测大信号条件下GaN HEMT的PAE.三个尺寸改进模型的PAE预测值MSE分别为0.23、0.33、8.24,虽然有缩放误差的影响,但还是明显低于原始模型的MSE,证明该模型具有良好的精度及缩放性,为进一步建立准确的GaN HEMT大信号模型奠定了基础.
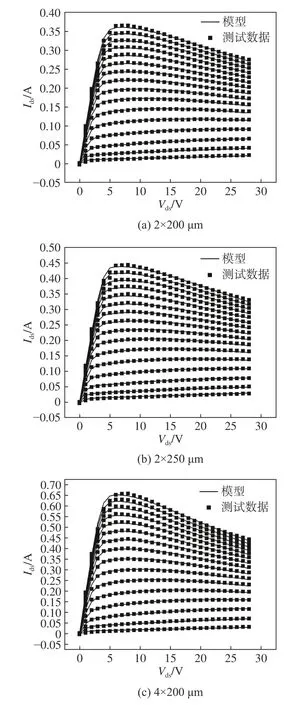
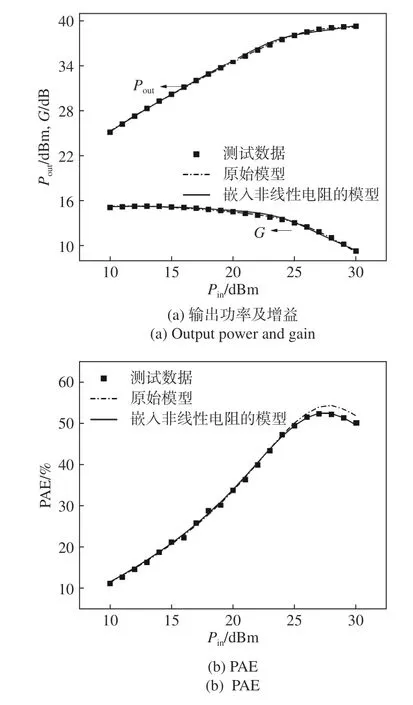
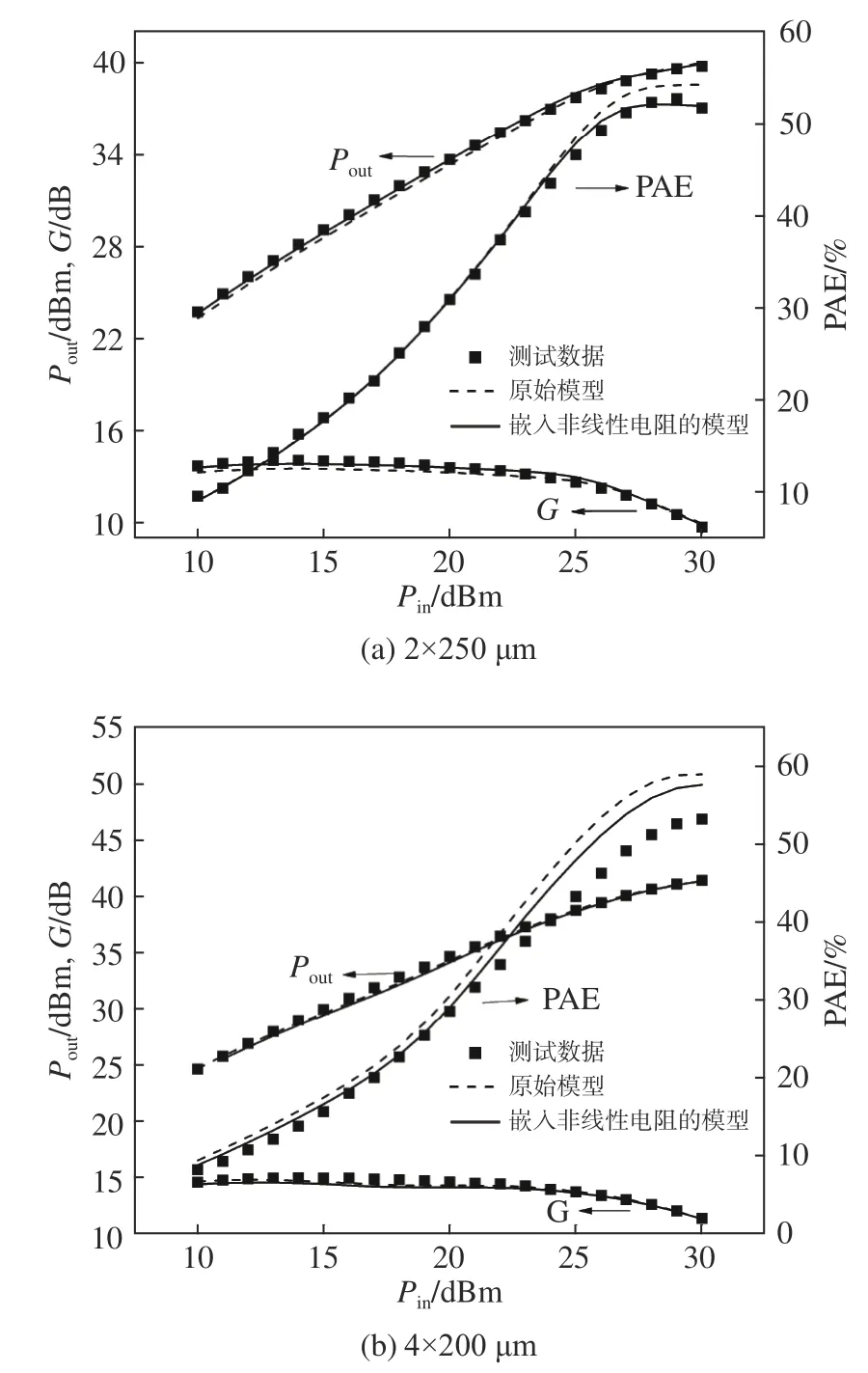


4 结 论

