正向偏置(p)SiC/(n)GaN异质结构稳态导电特性的模拟
张锦涛,赵少云,韦文生,郑君鼎,何明昌
(温州大学数理与电子信息工程学院,浙江温州 325035)
间接带隙碳化硅(SiC)、直接带隙氮化镓(GaN)半导体以其高的禁带宽度、饱和漂移速度、临界击穿场强、热导率等特性成为制造现代电子器件的优选材料[1].SiC/GaN异质结构可以同时发挥SiC的导热好、空穴与电子电离率差异大以及GaN的电子迁移率高、In(Al)xGa1-xN的能带可调等优势,在功率电子、紫外探测等领域具有重要的研发价值[2-3].
已经开展了SiC/GaN异质结构及其器件的理论和实验研究.因为6H-SiC与六方相GaN的晶格失配最小,在6H-SiC的面上生长GaN之前,戴宪起等[4]利用超原胞模型第一性原理赝势方法计算发现,界面能最低时的可能异质结构为6H-SiC/P-6H-GaN/2H-GaN.由于SiC/GaN异质结构界面存在自发、压电极化,Scha等[5]采用介稳异质结构的平衡理论研究了自发、压电极化效应对异质结构性能的影响,发现6H-SiC与应变六方相GaN形成的异质结构界面出现二维空穴气(2DHG),6H-SiC与松弛GaN构筑的异质结构界面产生二维电子气,面密度达到1013cm-2量级.在理论研究的基础上,Topf等[6]利用低压化学气相沉积技术研制了(p)6H-SiC/(n)GaN异质结构,通过异质结构的电致发光谱、热导纳谱、电流-电压(I-V)关系及电容-电压(C-V)关系的特征,发现电致发光谱、低正向电流来自于异质结构界面两侧的载流子通过界面缺陷态隧穿而复合.王晓亮等[7]使用金属有机物化学气相沉积方法研制的 1 mm栅宽6H-SiC/AlGaN/GaN结构高电子迁移率晶体管,漏源电压Vds=34.3 V,输出功率39.13 dBm,功率增益6.7 dB,连续工作半小时只下降了0.3%.本课题组模拟了不同SiC晶型(n)SiC/(p)GaN异质结构的正向恢复行为[8].
(p)SiC/(n)GaN异质结构作为(n)SiC/(p)SiC/(n)GaN异质结构双极晶体管(HBT)的发射结,其价带带阶阻碍空穴从基极返回发射极[9],提高了注入效率.但还未见6H-SiC/GaN、4H-SiC/GaN、3C-SiC/GaN三种异质结构正向稳态导电的对比研究.本文利用MATLAB数值模拟此三种异质结构的载流子分布、电容对电压及温度的依赖性,分析了异质结构I-V关系随p区及n区的少子寿命、掺杂浓度、温度变化的规律.
1 (p)SiC/(n)GaN异质结构模型
图1为(p)SiC/(n)GaN异质结构在热平衡态时的能带示意图.假定异质结构为突变型,不考虑界面缺陷态及隧穿效应,内部保持电中性,只涉及小注入情况.因为SiC、GaN半导体的少子寿命都很短,应考虑空间电荷区的载流子复合.p区SiC、n区GaN的完全电离杂质浓度分别为Na、Nd,电子亲和势分别为χp、χn,异质结构的导带带阶、价带带阶分别为ΔEC、ΔEV.为了方便计算,建立以p/n结界面为原点、垂直于结从p区指向n区的一维坐标系(x轴),示于图1底部,空间电荷区边界在p区、n区的位置分别为x=-xp、x=xn.
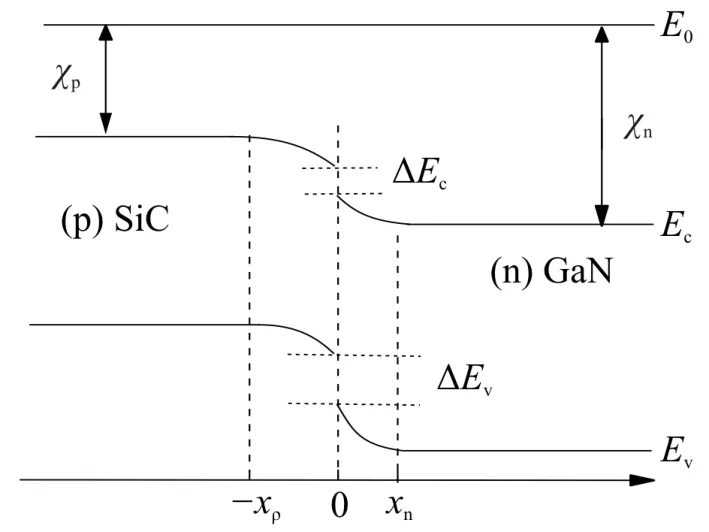
图1 (p)SiC/(n)GaN异质结构在热平衡态时的能带示意图Fig 1 Energy Band Diagram of (p)SiC/(n)GaN Heterostructure under Thermal Equilibrium.
在求解(p)SiC/(n)GaN异质结构基于漂移-扩散模型的泊松方程、电流密度方程、载流子连续性方程时,采用的边界条件为:x=-xp及x=xn处,电场强度E=0,x=-∞处,n1(-∞)=n10,x=-xp处,n1(-xp)=n10exp(qV/kT),其中q、k、T分别为基本电荷电量、玻尔兹曼常数、绝对温度,n1(x)表示p区少子(电子)的浓度分布,n10为平衡时p区的少子浓度.当异质结构加载正向偏压V时,x<-xp区域的少子(电子)浓度n(x)、x>xn范围的少子(空穴)浓度p(x)、载流子复合率U、p区一侧空间电荷区内的少子复合电流Jrb、n区一侧空间电荷区内的少子复合电流Jre、从n区注入p区的电子电流密度Jn、从p区注入n区的空穴电流密度Jp、通过异质结构的总正向电流密度J的表达式可参考文献[10-11].
本文利用MATLAB软件编程计算了(p)SiC/(n)GaN异质结构的载流子分布、J-V及C-V关系等,涉及的SiC、GaN参数来自文献[1]、[3]和[12].
2 结果与分析
2.1 异质结构的载流子分布
2.1.1 正向偏压对载流子分布的影响
图2(a)、(b)、(c)表示T=300K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3,正向偏压分别为V=0.5V、1.0V、1.5V时6H-SiC/GaN、4H-SiC/GaN、3C-SiC/GaN三种异质结构内电子、空穴浓度的分布.给异质结构加载正向偏压V时,空穴从p区越过异质结构势垒向n区注入,电子由n区越过势垒向p区注入.
由图2可见,V一定时,三种异质结构的载流子(空穴、电子)分布稳定.由n区注入到p区的电子浓度、由p区注入到n区的空穴浓度随V升高而增加,越靠近界面越明显.这是因为,热平衡时,异质结构空间电荷区内的载流子浓度很小,电阻很大,而区外的载流子浓度很大,电阻很小.加载的V主要降落在势垒区,削弱了势垒区的内建电场,缩小了势垒区的宽度,加快了电子、空穴分别越过势垒区.异质结构势垒高度随V升高而降低,电子、空穴更加容易越过势垒,所以由n区到p区的电子浓度、由p区到n区的空穴浓度均随V升高而增加.对比图2(a)、(b)、(c)发现,V相同时3C-SiC/GaN异质结构中由n区到p区的电子浓度最大,这是由于3C-SiC的禁带宽度最小,3C-SiC/GaN异质结构势垒最低,电子、空穴最容易越过此势垒所致.而4H-SiC的禁带宽度最大,4H-SiC/GaN异质结构势垒最高,电子、空穴最难越过此势垒,使得n区到p区的电子浓度最低.
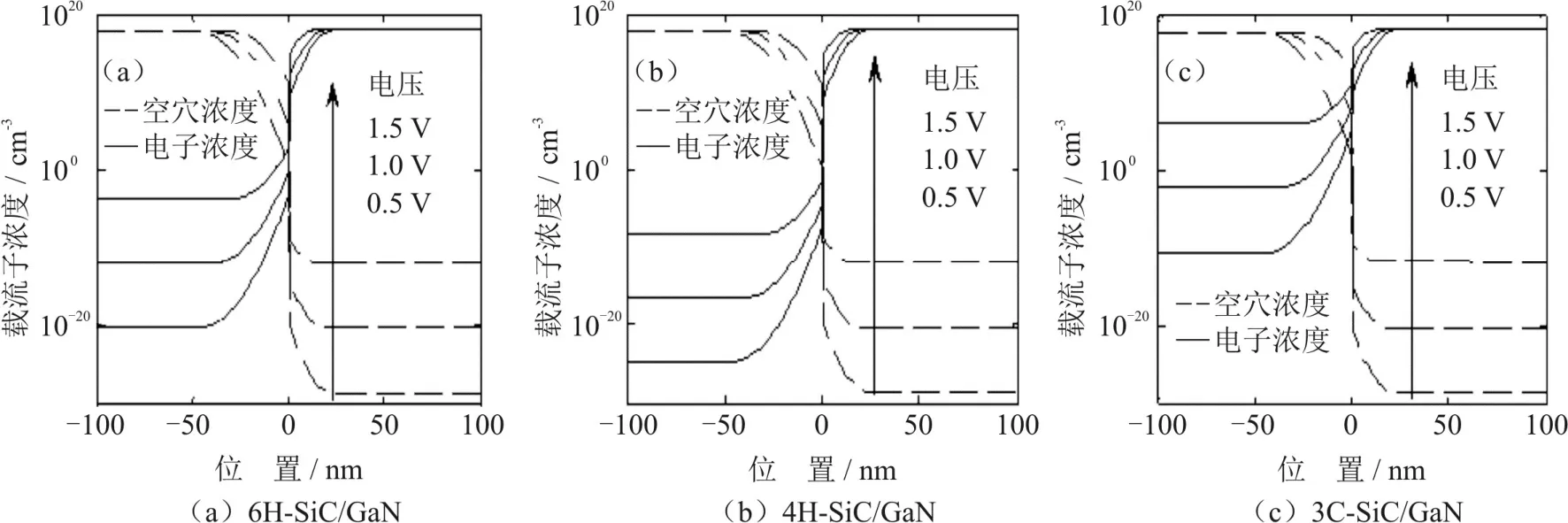
图2 不同正向偏压下三种(p)SiC/(n)GaN异质结构的电子、空穴分布Fig 2 Distributions of Electrons and Holes in Three Kinds of (p)SiC/(n)GaN Heterostructures Biased by Different Forward Voltages
2.1.2 温度对载流子分布的影响
图3(a)、(b)、(c)表示正向偏压V=1.5V、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3,温度分别为T=250K、300K、350K时三种异质结构内电子、空穴浓度的分布.从图3可见,三种异质结构内由n区注入到p区的电子浓度、由p区注入到n区的空穴浓度均随T升高而增加.这是因为,T升高会引起SiC、GaN禁带宽度变窄,SiC/GaN异质结构的势垒高度降低,电子、空穴更加容易越过势垒,导致浓度增加.另一方面,T升高促进SiC、GaN半导体的本征激发及杂质电离,引起异质结构p区、n区的载流子浓度随温度升高而增加.T相同时,3C-SiC/GaN异质结构中由n区到p区的电子浓度最大,4H-SiC/GaN异质结构中从n区到p区的电子浓度最小,原因如同2.1.1部分所述.
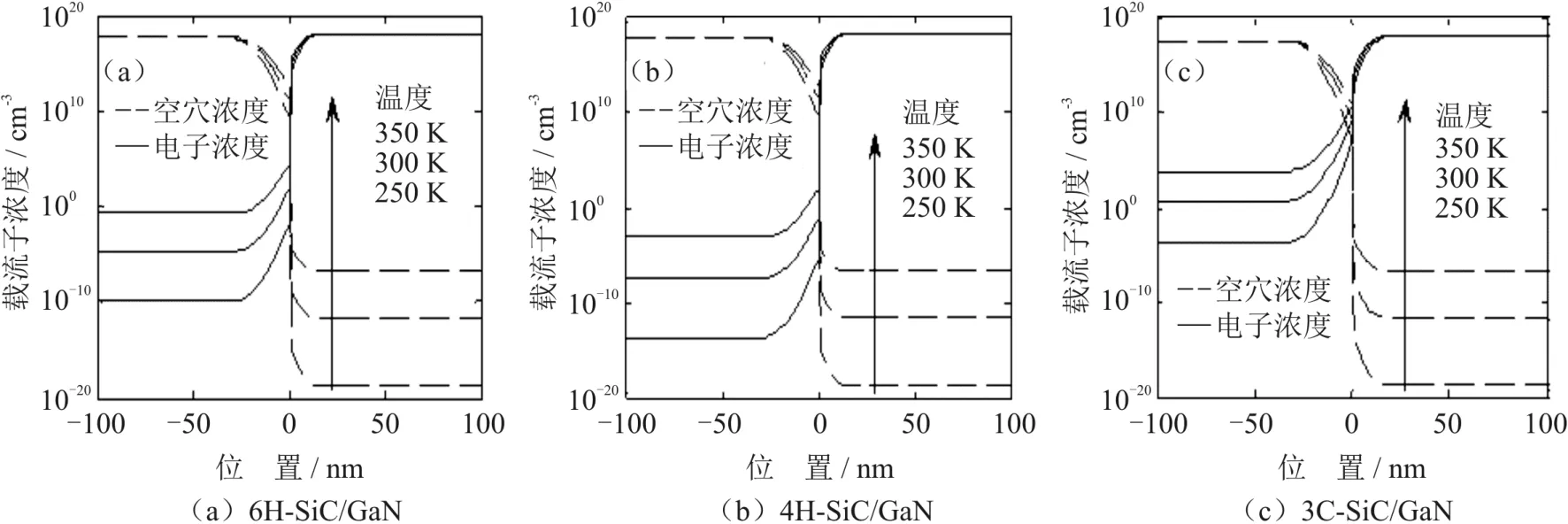
图3 不同温度下三种(p)SiC/(n)GaN异质结构的电子、空穴分布Fig 3 Distributions of Electrons and Holes in Three Kinds of (p)SiC/(n)GaN Heterostructures under Different Temperatures
2.2 正向偏压对载流子复合率的影响
图4(a)、(b)、(c)表示T=300K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3,正向偏压分别为V=0.5V、1.0V、1.5V时三种异质结构内载流子复合率(U)分布随正向偏压V变化的情况.如图4所示,p区的复合率大于n区的值,是因为p区多子(空穴)寿命τp短而复合快引起U高,n区多子(电子)寿命τn长而复合慢导致U低.其它条件不变时,三种异质结构内载流子的U均随V升高而增加.这是因为异质结构势垒高度随V升高而降低,电子、空穴更容易越过势垒,因此由n区到p区的电子浓度、由p区到n区的空穴浓度均随V增大而增加,从而提高载流子的U.V相同时,3C-SiC/GaN异质结构的U最大,4H-SiC/GaN异质结构的U最小,归因于3C-SiC/GaN异质结构势垒最低,4H-SiC/GaN异质结构势垒最高,电子、空穴最容易越过前者而最难越过后者,所以前者的U最大而后者的U最小.

图4 不同正向偏压下三种(p)SiC/(n)GaN异质结构的载流子复合率Fig 4 Carrier Recombination Rates in Three Kinds of (p)SiC/(n)GaN Heterostructures Biased by Different Forward Voltages
2.3 异质结构的C-V特性
2.3.1 三种异质结构C-V特性的比较
图5给出了T=300K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3时三种异质结构的C-V关系.如图5所示,异质结构的C-2值均随V升高而减小,即C均随V升高而变大.这可理解为,其它条件不变时,正向偏置的异质结构势垒区内电场随V升高而减弱,势垒高度降低而且变窄.从图2得到,异质结构中由n区注入到p区的电子浓度、由p区注入到n区的空穴浓度均随着V升高而增加,所以C随V升高而变大,C-2值减小.另外,从图5可见,V相同时3C-SiC/GaN异质结构的C-2最小,该结电容最大,4H-SiC/GaN异质结构的C-2最大,此结电容最小.这是因为,3C-SiC的带隙最窄而4H-SiC的带隙最宽,导致3C-SiC/GaN异质结构势垒最低而4H-SiC/GaN势垒最高.V相同时,前者的载流子注入浓度最大而后者的最小,故而前者的电容最大而后者的最小.

图5 三种(p)SiC/(n)GaN异质结构的C-V关系Fig 5 C-V Relations in Three Kinds of (p)SiC/(n)GaN Heterostructures
2.3.2 温度对异质结构C-V特性的影响
图6(a)、(b)、(c)给出了p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3、温度分别为T=200K、300K、400K时,三种异质结构的电容随温度变化情况.如图6所示,三种异质结构的C-2值均随温度升高而下降,即电容随温度升高而变大.这是因为,其它参数不变时,半导体带隙随着温度升高而变窄,引起异质结构势垒高度随着温度升高而降低.从图3可知,三种异质结构内从n区越过势垒到p区的电子浓度、从p区越过势垒到n区的空穴浓度均随温度升高而增加,即异质结构界面两侧的电子、空穴浓度随温度升高而增加,因此,电容随温度升高而增大.
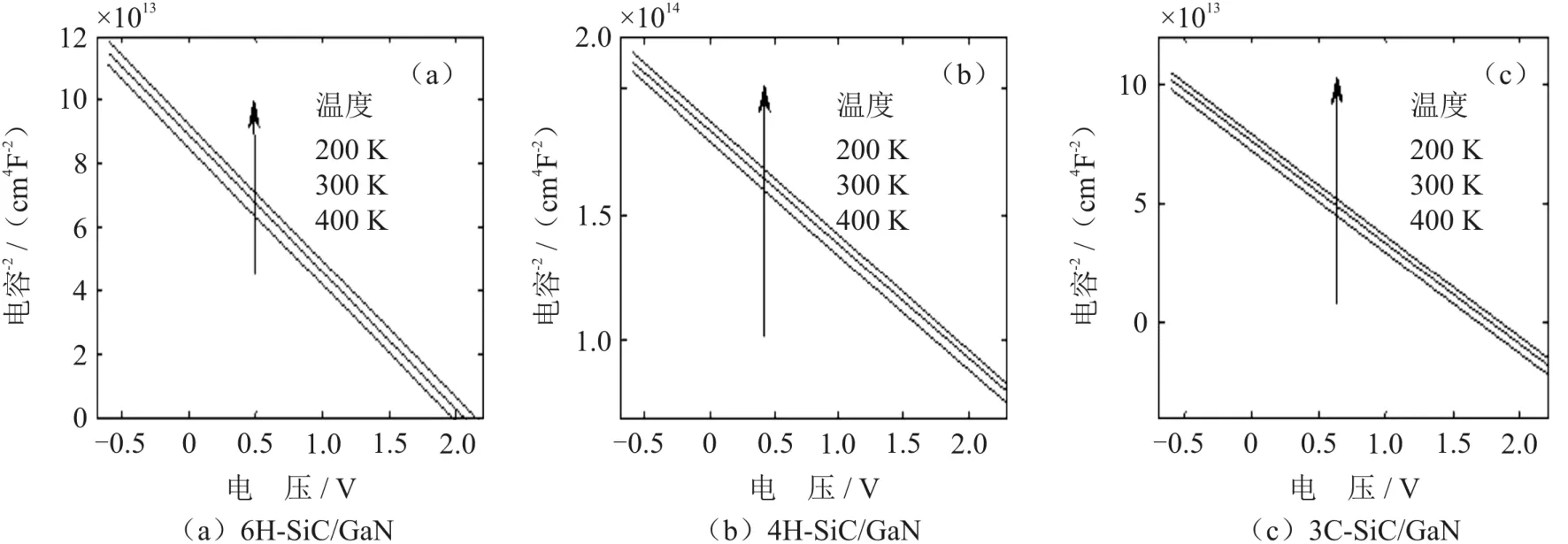
图6 不同温度下三种(p)SiC/(n)GaN异质结构的C-V关系Fig 6 C-V Relations in Three Kinds of (p)SiC/(n)GaN Heterostructures under Different Temperatures
2.4 异质结构的正向J-V特性
图7(a)、(b)、(c)给出了T=300K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3时,三种异质结构的正向电流密度各成分Jn、Jp、Jrb、Jre随正向偏压V变化的情况.因为Na<Nd,导致异质结构空间电荷区在p区侧的宽度大于n区侧的宽度,p区的少子浓度大于n区的相应值;另外,从图4可知,p区的载流子复合率大于n区的相应值,所以Jp<<Jn,Jre<<Jrb,如图7所示.V较低时J的大小主要取决于Jrb;V较高(>约2V)时,J主要取决于Jn.这是因为,V较低时空间电荷区宽,载流子复合占优,可通过图4反映出来;另一方面,异质结构势垒高,载流子通过势垒注入的量很小,此时的J主要取决于p区的复合电流Jrb,与文献[6]的实验结果吻合.随着V升高,异质结构的空间电荷区变窄,势垒降低,n区的载流子越过势垒进入p区的量很大,此时的J主要取决于从n区向p区扩散的电子电流Jn,三种异质结构的情况都如此,分别如图7(a)、(b)、(c)所示.
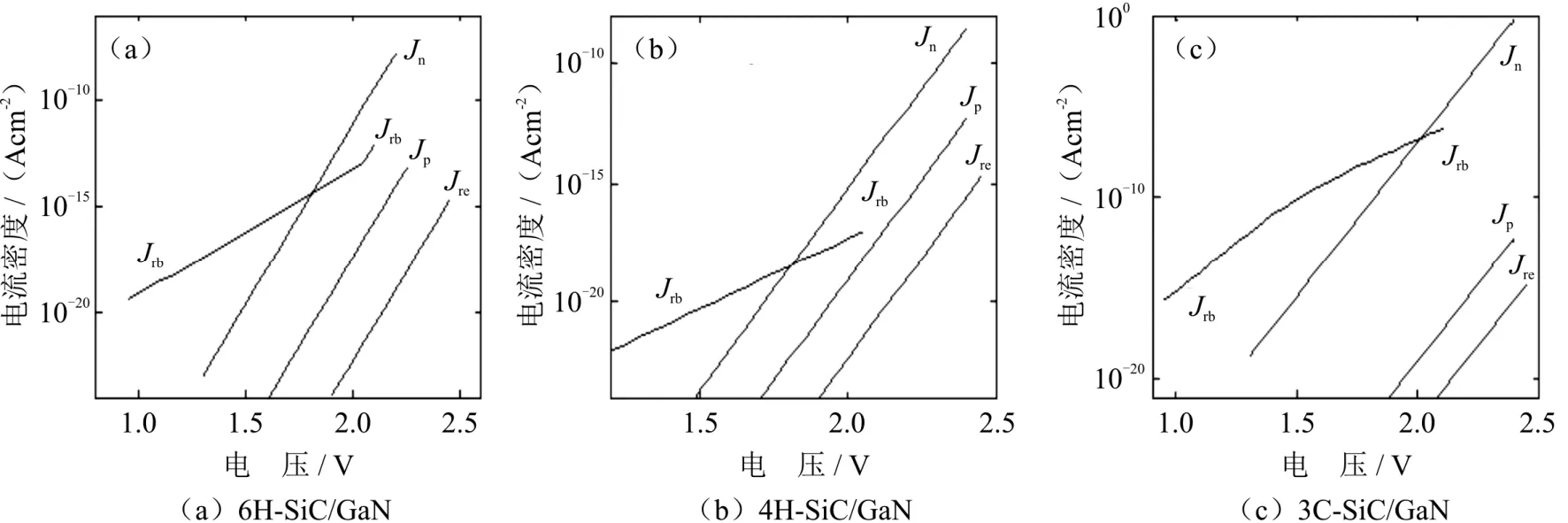
图7 三种(p)SiC/(n)GaN异质结构的正向电流密度各成分随电压的变化Fig 7 Changes of Various Components of Forward Current Density with Biased Voltage in Three Kinds of(p)SiC/(n)GaN Heterostructures
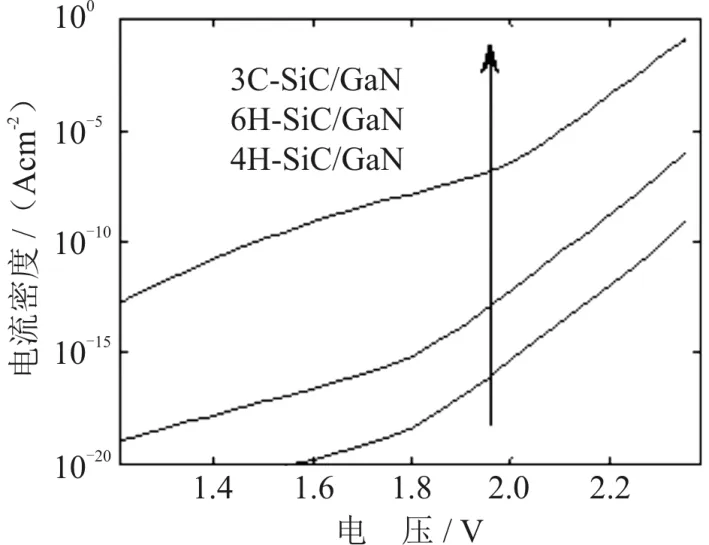
图8 三种(p)SiC/(n)GaN异质结构的J-V特征Fig 8 J-V Characteristics of Three Kinds of (p)SiC/(n)GaN Heterostructures
图8描述了T=300K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3时,三种异质结构的J-V关系,可见各个异质结构的J随V升高而增大.可理解为,异质结构势垒高度随着V升高而降低,载流子越过势垒的数量增大导致J增大.V相同时,3C-SiC/GaN异质结构的J最大,4H-SiC/GaN异质结构的J值最小.这是因为3C-SiC/GaN异质结构势垒最低,4H-SiC/GaN异质结构的势垒最高,载流子最容易越过前者而最难越过后者所致.
2.4.1 异质结构n区、p区少子寿命对正向J-V特性的影响
图9(a)、(b)、(c)分别给出了T=300K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3、n区直接带隙半导体GaN的少子(空穴)寿命τp=1ns、6.5ns、13.0ns时,三种异质结构正向电流密度各成份与正向偏压V的关系.从图9可见,三种异质结构n区少子寿命τp的变化主要影响从p区注入到n区的空穴电流密度Jp、空间电荷区n区侧的复合电流密度Jre,且前者效果显著,而Jn、Jrb几乎不受干扰.从图2图3可知,T、V一定时,异质结构内电子、空穴分布稳定.τp减小意味着相同时间内空穴从p区越过势垒注入到n区的数量需要相应增加,才能维持分布稳定,即Jp随τp减小而增大.因为这三种半导体异质结构属于少子导电系统,从p区注入到n区的空穴导致n区少子总量急剧增加,所以τp对Jp影响更甚.

图9 三种(p)SiC/(n)GaN异质结构中n区少子寿命不同时正向电流密度各成分与电压的关系Fig 9 Relations between Various Components of Forward Current Density and Biased Voltage with Different Minority Lifetimes in n-type Region in Three Kinds of (p)SiC/(n)GaN Heterostructures

图10 三种(p)SiC/(n)GaN异质结构中p区少子寿命不同时的正向J-V关系Fig 10 Forward J-V Relations in Three Kinds of (p)SiC/(n)GaN Heterostructures with Different Minority Lifetimes in p-type Region in Three Kinds of (p)SiC/(n)GaN Heterostructures
图10(a)、(b)、(c)给出了T=300 K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3,p区间接带隙半导体SiC的少子(电子)寿命分别为τn=20 ns、40 ns、60 ns时,三种异质结构的J-V关系.从图2、图3可知,T、V一定时,异质结构内电子、空穴的分布稳定.p区少子(电子)寿命τn缩短,在此区域内电子-空穴复合引起复合电流增大.同时要求从n区注入到p区的电子数量必须相应增加,才能维持稳定的分布,注入电子数目增加则扩散电流增大.计算得到,J随着p区少子寿命τn缩短反而增加,如图10所示.V相同时,3C-SiC/GaN异质结构的J最大,4H-SiC/GaN异质结构的J值最小,归因于前者的势垒最低,载流子最容易越过,因而J值大;后者的势垒最高,载流子最难越过,因而J值小.
2.4.2 异质结构n区、p区掺杂浓度对正向J-V特性的影响
图11给出了T=300K、p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度分别为Nd=6×1017cm-3、8×1017cm-3、1×1018cm-3时,三种异质结构的J-V关系.从图11可见,J随Nd的增加而增大,V较低时增加得更明显,归因于Na<Nd,异质结构势垒区主要位于p区侧,n区多子(电子)随着Nd增加而增多,势垒区变薄,而少子(空穴)减少,少子效应减弱,电子从n区越过异质结构势垒与p区多子(空穴)复合的几率增大,复合电流密度增大,所以J增大.此外,电子从n区越过势垒向p区注入的数量随Nd增大而增多,Jn和J增大.V相同时,3C-SiC/GaN异质结构的J最大,4H-SiC/GaN异质结构的J值最小,原因如同2.4.1部分所述.

图11 三种(p)SiC/(n)GaN异质结构中n区掺杂不同时的正向J-V关系Fig 11 Forward J-V Relations in Three Kinds of (p)SiC/(n)GaN Heterostructures with Different n-type Doping
图12给出了T=300 K、n区掺杂浓度Nd=1×1018cm-3、p区掺杂浓度分别为Na=5×1017cm-3、7×1017cm-3、9×1017cm-3时,三种异质结构的J-V关系.从图12可见,V相同时J随着Na减小而增大.因为Na<Nd,异质结构空间电荷区主要位于p区,p区少子(电子)多于n区少子(空穴).p区少子随Na减小而增多,少子效应加强,p区侧的空间电荷区更宽,越过异质结构势垒的少子在空间电荷区内的复合几率增加,复合电流Jrb增大.计算可知,Na的变化几乎不影响Jn.从图9可知,V相同时其它电流成份与Jn、Jrb相比可忽略,所以异质结构J随着Na的减小而增大.对比图12(a)、(b)、(c),V、Na相同时,3C-SiC/GaN异质结构的J值最大,因为它的势垒最低,载流子最容易越过势垒;反之,4H-SiC/GaN异质结构的J值最小,因为其势垒最高,载流子最难越过势垒.
2.4.3 温度对异质结构正向J-V特性的影响
图13给出了p区掺杂浓度Na=5×1017cm-3、n区掺杂浓度Nd=1×1018cm-3、温度分别为T=250 K、300 K、350 K时,三种异质结构的J-V关系.由图3可见,异质结构的电子、空穴浓度随着T升高而增加,导致复合电流增大.另一方面,异质结构势垒高度随着T升高反而降低,从n区越过异质结构势垒注入到p区的电子以及从p区越过异质结构势垒注入到n区的空穴更多,Jn、Jp增大.所以,V相同时J随T的升高而增大,如图13所示.同样V、T之下,3C-SiC/GaN异质结构的势垒最低,载流子最容易越过,它的J值最大;4H-SiC/GaN异质结构的势垒最高,载流子最难越过,它的J值最小.
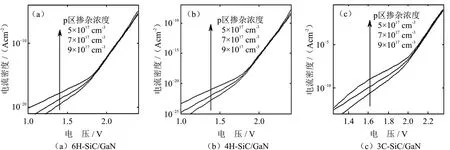
图12 三种(p)SiC/(n)GaN异质结构中p区掺杂不同时的正向J-V关系Fig 12 Forward J-V Relations in Three Kinds of (p)SiC/(n)GaN Heterostructures with Different p-type Doping

图13 温度不同时三种(p)SiC/(n)GaN异质结构的正向J-V关系Fig 13 Forward J-V Relations in Three Kinds of (p)SiC/(n)GaN Heterostructures at Different Temperatures
对照已经研制的不同(p)SiC/(n)GaN异质结构[13-15],本文仿真器件选用的材料掺杂浓度等参数与实验中的对应参数吻合.而且,模拟(p)4H-SiC/(n)GaN异质结构300 K时的C-V(图5)和J-V(图8)数据与文献[13]采用氢化物气相外延(HVPE)技术制备同种结构的同类数据的测量结果一致;仿真(p)6H-SiC/(n)GaN异质结构300 K时的C-V(图6(a))和J-V(图13(a))数据,与利用金属有机物化学气相沉积(MOCVD)方法[14]和HVPE技术[15]研制同种结构的同类数据的实验结果十分接近.实验上难以象本文这样独立设置那么多的参数制备器件并加以测量,因而无法逐一对比,但已不影响本文结果的可靠性.因此,所得结果可为设计(n)SiC/(p)SiC/(n)GaN型HBT等器件提供理论指导.
3 结 论
利用MATLAB软件数值模拟正向偏置(p)SiC/(n)GaN异质结构稳态导电的结果表明:温度及电压一定时,异质结构内电子、空穴分布稳定,异质结构的电容随温度、电压的增加而变大.电压较低时,正向电流密度主要取决于空间电荷区的复合电流;电压>约2 V时,主要由n区注入到p区的电子扩散电流决定.随着温度升高、n区掺杂浓度增加、p区及n区少子寿命缩短、p区掺杂浓度减小,正向电流密度均增大.可调节参数优化(p)SiC/(n)GaN异质结构的正向稳态导电特性,并指导(n)SiC/(p)SiC/(n)GaN型HBT等器件设计.

