磁过滤电弧离子镀制备DLC薄膜的表面形貌和成键状态*
郭朝乾,林松盛,石 倩,韦春贝,李 洪,汪 唯,代明江
广东省新材料研究所,现代材料表面工程技术国家工程实验室,广东省现代表面工程技术重点实验室,广东 广州 510650
类金刚石(diamond-like carbon,DLC)薄膜是一种既含有sp2键又含有sp3键的非晶碳膜,通过改变薄膜内部碳元素的成键状态,可实现对DLC薄膜的硬度、摩擦系数、磨损率、电阻率、导热率等性能的调控.该膜层具有广阔的应用前景[1-2].电弧离子镀技术是制备DLC薄膜的常用手段,可以使薄膜具有很高的硬度[3-5].但镀膜过程中,石墨靶表面产生的大颗粒沉积到薄膜表面,会影响DLC薄膜的质量和性能[3, 6-7].如果在靶材和基体间增加一磁过滤弯管,不带电或带负电的大颗粒沉积到弯管内壁上,而带正电的碳离子在磁场的作用下通过弯管沉积到基体上,从而起到改善薄膜质量的作用[8-10].本文利用磁过滤电弧离子镀技术制备DLC薄膜,研究工作气压和基体偏压占空比对薄膜表面形貌、沉积速率和成键状态影响的规律,为制备高质量的DLC薄膜提供参考.
1 试验部分
1.1 DLC薄膜的制备
采用磁过滤电弧离子镀技术驱动石墨靶(纯度99.9%)在P(100)型单晶硅基体表面沉积DLC薄膜.镀膜前,将Si片放入丙酮和酒精中,分别超声清洗15 min.然后用普通氮气吹掉基体表面的酒精,固定于真空室内.基体正对磁过滤弯管并围绕弯管中心轴旋转[2].真空室抽至5×10-3Pa,通入氩气对Si片进行溅射清洗,压强2.0 Pa,基体负偏压1000 V,占空比30%,频率50 kHz,溅射时间10 min.沉积DLC薄膜时,石墨靶电流100 A,基体负偏压200 V,频率50 kHz,镀膜时间20 min,试验中工作气压和占空比列于表1.
表1 磁过滤电弧离子镀制备DLC薄膜的气压和偏压占空比
Table 1 Work pressure and duty ratio of DLC films deposited by filtered arc ion plating

编号气压/ Pa占空比/%10.120.330.530456780.11530456075
1.2 测 试
通过扫描电子显微镜(SEM,Inspect F50FEI,USA)观察薄膜的表面和截面形貌,利用Image pro-plus(IPP)软件统计薄膜表面大颗粒的占比(大颗粒面积与图像面积的比)和密度,通过截面形貌获得薄膜的厚度.利用拉曼光谱仪(LabRAM HR 800,HORIBAJOBINYVON,France)分析DLC薄膜的化学键状态,激光器波长532 nm,进而比较薄膜中sp3键的含量.
2 试验结果与讨论
2.1 工作气压对DLC薄膜形貌及成键状态的影响
不同工作气压下制备的DLC薄膜表面和截面形貌如图1所示.从图1(a~c)薄膜表面可以观察到尺寸不一的大颗粒.大颗粒的占比及密度随沉积气压变化的趋势如图2所示.图1显示,当沉积气压为0.1 Pa时,薄膜表面大颗粒最少.由图1和图2可知,随沉积气压升高,大颗粒占薄膜表面的总面积增加,但颗粒密度(数量)先上升后下降.说明沉积气压较高时,大颗粒的尺寸较大.由图1可知,随着沉积气压从0.1 Pa升至0.5 Pa,DLC膜的厚度从380 nm降至170 nm.
镀膜时,石墨靶放电产生的离子、原子及大颗粒等经过弯曲的磁过滤弯管到达薄膜表面,这些粒子在运动过程中存在大量的相互碰撞及与Ar原子或离子间的碰撞.气压增加时,碳的离子、原子及大颗粒被碰撞的几率增加,平均自由程变短,这些粒子到达薄膜表面的数量减少,薄膜沉积速率降低,厚度下降.与大颗粒相比,碳的离子或原子质量要小得多,动能较低,到达薄膜表面的难度增加,数量更少.因此,随工作气压增加,薄膜厚度下降,表面大颗粒所占面积增加.另一方面,带正电的碳离子在基体负偏压的作用下,以一定的动能沉积到薄膜表面;不带电的碳原子或带负电的大颗粒在惯性作用下随机运动到薄膜表面.沉积气压较低时,粒子间的碰撞几率较低.在电场力的作用下,被基体负偏压吸引的正离子动能较大,对薄膜的轰击作用明显,将薄膜表面与薄膜结合较差的大颗粒清除,使薄膜表面大颗粒的总量下降.

图1 不同工作气压下DLC薄膜的表面(a~c)和截面形貌(d~f)(a)(d)气压0.1 Pa;(b)(e)气压0.3 Pa;(c)(f)气压0.5 PaFig.1 Surface and cross-sectional morphology of DLC films deposited under different work pressures (a)(d)work pressure 0.1Pa; (b)(e) work pressure 0.3Pa; (c)(f) work pressure 0.5Pa
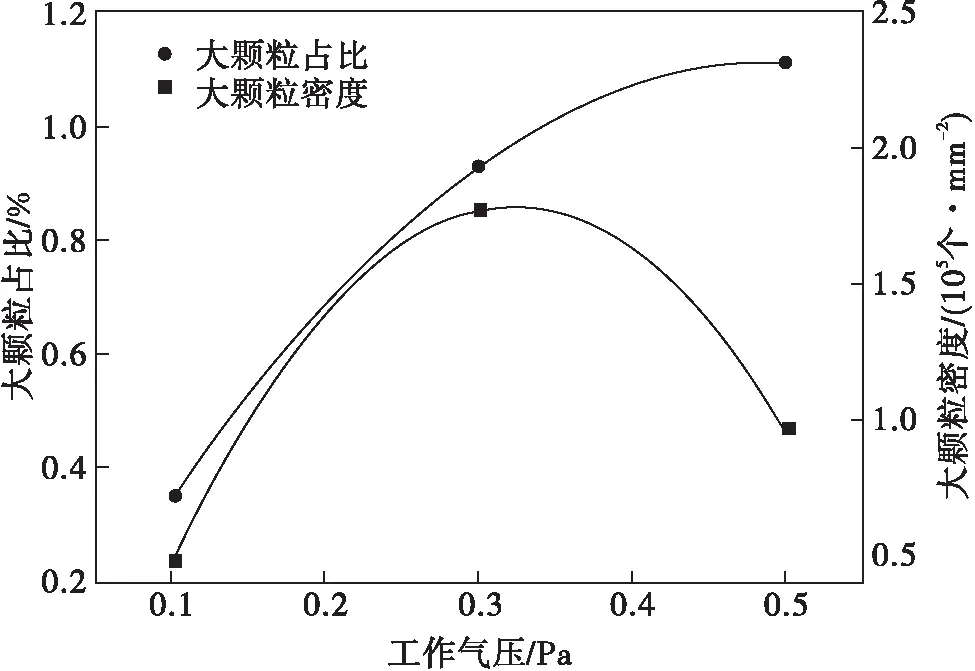
图2 不同工作气压下DLC薄膜表面大颗粒的变化趋势Fig. 2 The trend of large particles on the surface of DLC film deposited under different working pressures
不同沉积气压下制备的DLC薄膜的拉曼光谱分峰拟合后如图3所示.由图3可知,在1380 cm-1和1550 cm-1附近存在典型的D峰和G峰.G峰是由碳环或碳链中sp2原子对拉伸运动产生的;D峰是由碳环中sp2原子呼吸振动模式产生的,没有六角碳环也就没有D峰.因此,可用拉曼谱中D峰和G峰的强度比(ID/IG),来比较不同DLC薄膜中sp3键的含量:ID/IG值越小,说明DLC膜中sp2键的含量越低,sp3键的含量越高[11-12].此外,通过G峰的半高宽(FWHMG)可以判断石墨无序的程度:FWHMG越大,薄膜无序程度增加[13-14].

图3 不同工作气压下DLC薄膜的Raman光谱 (a)气压0.1 Pa;(b)气压0.3 Pa;(c)气压0.5 PaFig.3 Raman spectra of DLC films deposited under different working pressures (a)work pressure 0.1 Pa;(b) work pressure 0.3 Pa;(c) work pressure 0.5 Pa
不同工作气压下DLC薄膜的ID/IG值和G峰半高宽如图4所示.由图4可知,随着沉积气压增加,DLC膜的ID/IG值逐渐下降,说明薄膜中sp3键含量逐渐增加;FWHMG升高,说明DLC膜的无序度增加.气压升高,碳离子向基体运动的过程中,与气体粒子的碰撞增加,到达薄膜表面的能量降低.根据亚注入模型[15-16],DLC膜中sp3键的含量与碳离子的能量有关:碳离子能量较低时,不能穿透薄膜表层原子而沉积在薄膜表面;当碳离子能量较高时,可穿透表层原子而进入薄膜的亚表层,引起局部原子密度、内应力升高,相邻原子间的化学键状态改变,产生更多的sp3键.但碳离子能量存在一阈值,超过这一阈值后,过高的能量产生“热峰效应”,对薄膜局部退火,会降低DLC膜中sp3键的含量[17].本试验中,在工作气压为0.1~0.5 Pa,基体负偏压为200 V的沉积条件下,碳离子的能量可能处于较高的水平,超过了这一阈值.因此,工作气压升高,碳离子能量下降时,DLC膜中sp3键含量升高.

图4 不同工作气压下DLC薄膜的ID/IG值和G峰半高宽Fig.4 ID/IG and G peak FWHM of DLC films deposited under different working pressures
2.2 偏压占空比对DLC薄膜形貌及成键状态的影响
图5为工作气压0.1 Pa时不同偏压占空比的DLC薄膜的表面形貌.占空比对薄膜表面大颗粒的占比及密度的影响,如图6所示.由图6可知,随占空比增加,薄膜表面大颗粒的占比及密度均逐渐升高.偏压占空比增加后,大颗粒被周围电子充电更加充分,所带负电荷增加,但在等离子体鞘层中运动时间延长,与正离子接触机会增多,表面的负电子减少,与基体间的电斥力下降[18].因此,随占空比升高,到达薄膜表面的大颗粒数量增加.

图5 不同偏压占空比的DLC薄膜表面形貌(a) 占空比15%;(b) 占空比30%;(c) 占空比45%;(d) 占空比60%;(e) 占空比75%Fig.5 Surface morphology of DLC films deposited under different duty ratio of substrate’s bias voltage(a) duty ratio 15%; (b) duty ratio 30%; (c) duty ratio 45%; (d) duty ratio 60%; (e) duty ratio 75%

图6 不同偏压占空比DLC薄膜表面大颗粒变化趋势Fig.6 The trend of large particle surface of DLC films deposited under different duty ratio of substrate’s bias voltage
基体偏压占空比从15%升高至75%时,DLC薄膜的截面形貌如图7所示.由图7可知,占空比增加,薄膜厚度下降(由420 nm 降至150 nm).在薄膜沉积过程中,碳离子带正电,偏压占空比增加,虽然施加在基体上的负电压时间延长,可以吸引更多的碳离子向基体运动,但等离子体鞘层存在时间延长,碳离子与其中正离子作用时间增加,在电斥力的作用下,到达DLC薄膜表面的碳离子数量减少,薄膜生长速率下降.相同沉积时间下,薄膜厚度降低.
图8为不同偏压占空比沉积的DLC薄膜的Raman光谱图.DLC薄膜的ID/IG值和G峰半高宽(FWHMG)如图9所示.由图9可知,随占空比增加,ID/IG值先增后降,G峰半高宽先降后增,两者呈相反的变化趋势.当占空比为30%时,DLC的ID/IG值最高,薄膜中sp3键含量最低;FWHMG值最小,说明此时沉积的DLC膜无序度最低.基体与碳离子的引力及等离子体鞘层与碳离子的斥力共同作用,沉积到薄膜表面的碳离子能量不断变化,使DLC薄膜的结构发生改变,ID/IG值和FWHMG呈现出图9的变化趋势.
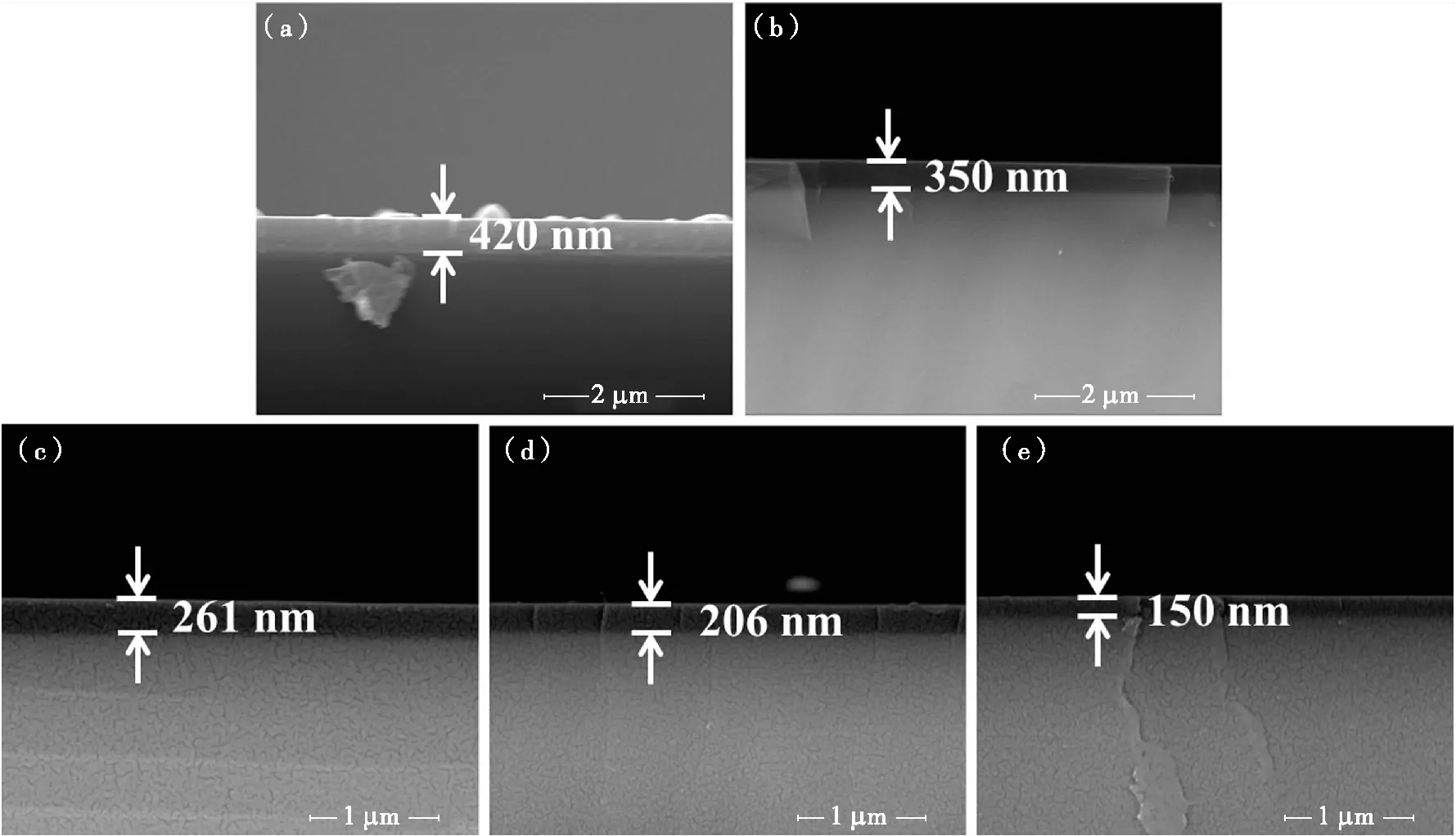
图7 不同偏压占空比的DLC薄膜截面形貌(a) 占空比15%;(b) 占空比30%;(c) 占空比45%;(d) 占空比60%;(e) 占空比75%Fig.7 Cross-sectional morphology of DLC films deposited under different duty ratio of substrate’s bias voltage (a) duty ratio 15%; (b) duty ratio 30%; (c) duty ratio 45%; (d) duty ratio 60%; (e) duty ratio 75%
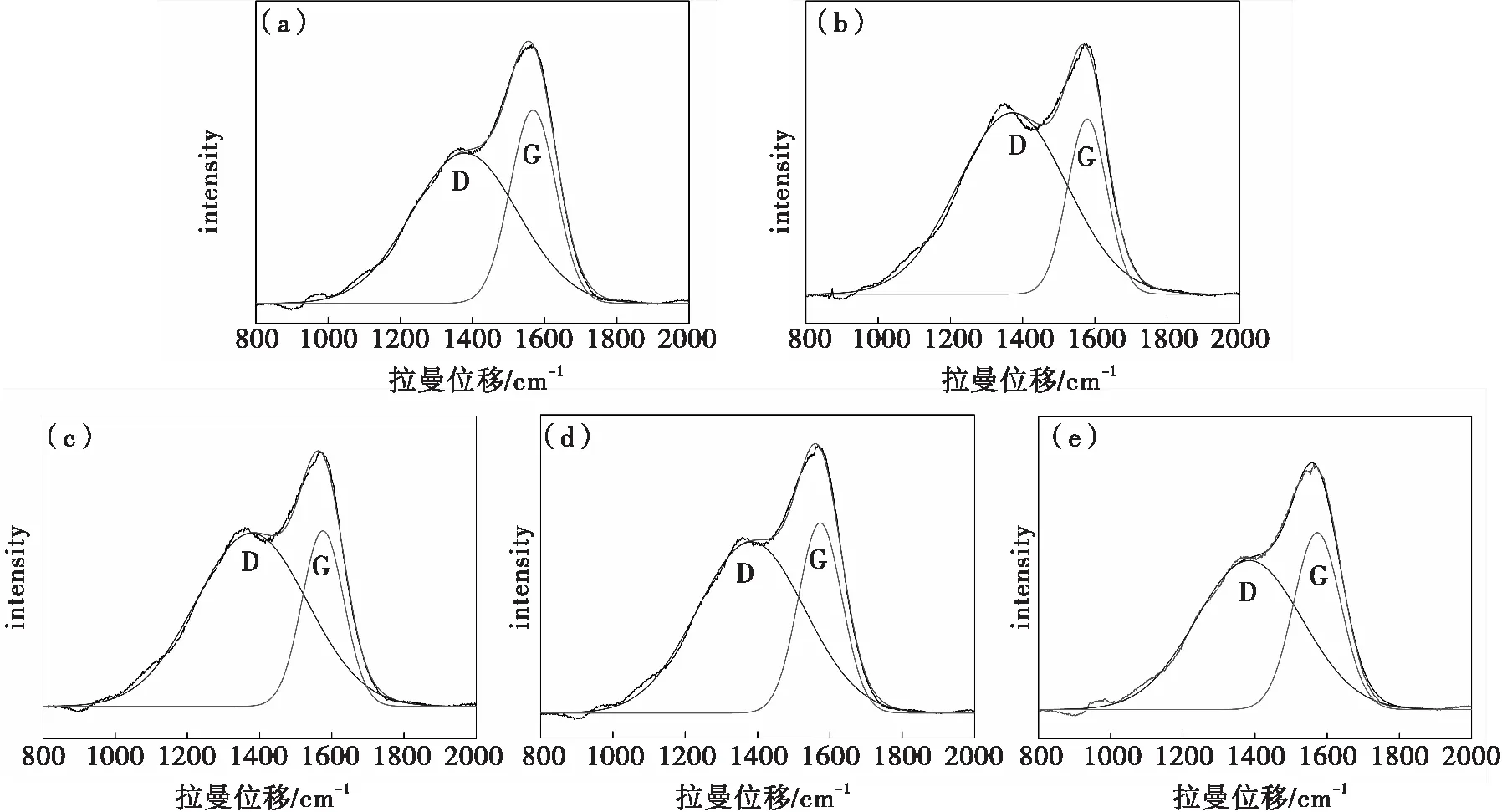
图8 不同偏压占空比DLC薄膜的Raman光谱 (a)占空比15%;(b) 占空比30%;(c) 占空比45%;(d) 占空比60%;(e) 占空比75%Fig.8 Raman spectra of DLC films deposited under different duty ratio of substrate’s bias voltage(a) duty ratio 15%; (b) duty ratio 30%; (c) duty ratio 45%; (d) duty ratio 60%; (e) duty ratio 75%

图9 不同偏压占空比的DLC薄膜的ID/IG值和G峰半高宽Fig.9 ID/IG and G peak FWHM of DLC films deposited under different duty ratio of substrate’s bias voltage
3 结 论
(1)工作气压从0.1 Pa升至0.5 Pa,DLC薄膜表面大颗粒的总面积逐渐增加,沉积速率下降,薄膜中sp3键含量增加.
(2)基体偏压占空比从15%升至75%,DLC薄膜表面大颗粒的总面积和数量均增加,沉积速率下降,薄膜中sp3键含量先降后升.占空比为30%时,sp3键含量最低.

