等离子体辉光发射反馈监控技术在光学薄膜中的应用
郭杏元,罗志鹏,战永刚
(深圳市三海科技有限公司,广东 深圳518112)
在氧气氛下溅射纯硅制备氧化硅薄膜,当氧气流量很小时,靶溅射过程与纯氩溅射类似,溅射速率与纯金属相当,此时称为金属态。当氧气流量增大到一定程度,靶材表面基本氧化完全,溅射速率较慢,此时称为过氧态。在金属态与过氧态之间的状态称为过渡态,此时溅射速率比较大。过渡区的宽度跟材料的种类以及设备的抽速有关。要保证光学薄膜没有吸收,同时又有较高的沉积速率,需要选择一个合适的控制点,并能一直保持在此状态。通过“等离子体辉光发射监控技术(plasma emission monitor,简称PEM)实现这一目的,以提高光学薄膜的生产效率是本文的重点。
PEM系统是在反应溅射过程中,通过实时采集磁控溅射靶前等离子体区辉光发射光谱(optical emission spectroscopy,简称OES)的强度,实时了解靶材情况,通过中央控制系统,配合高速响应的流量计,实时调节气体的输入量,以实现高速闭环反馈控制,将反应溅射稳定在预先设定的状态,达到高速沉积或稳定薄膜品质的目的。PEM反馈控制系统已广泛应用于大面积氧化铟锡(ITO)透明导电薄膜的生产线中[1-2]。此外,PEM也用来制备氧化钛[3]、氧化铌、氮氧化硅、氮铝钛、碳化钨等薄膜。本文拟采用三海科技自主研发的宽光谱等离子体辉光发射监控系统制备光学减反射膜(ARC),测试其对成膜速率提升的贡献以及对光学性能的影响,并评估其生产稳定性。
1 实验
真空腔体直径1 680 mm,靶材长度1 310 mm.系统配置1对圆柱硅靶(99.95%),一对圆柱铌靶(99.95%),一台中频电源。PEM系统包含信号采集探头、光纤、法兰、光谱仪、控制器、快速响应流量计等。其中信号采集探头平行于靶材某一磁力线的切线安装,正对靶材辉光区,距靶平面1 cm左右。光谱仪采用杭州晶飞科技有限公司生产的FLA4 000+光谱仪,采集波长200~1 000 nm.快速流量计为响应时间小于1 s的氧气流量计。控制系统及计算方法由三海自主研发。为了保证反馈控制的灵敏度,需要将反应气体流量计安装在离靶材尽量近的位置,不通过混气罐混气。该系统主要用来反馈控制光学薄膜中的高折射率材料氧化铌薄膜的制备。信号源为OES中氧777 nm处的峰强,简称Eo777.低折射率材料氧化硅薄膜采用电压反馈控制模式。
1)氧化铌薄膜的制备
制备氧化铌薄膜之前,先采集Eo777随氧气流量变化铌靶的滞回曲线。然后在滞回曲线上选择不同的控制点,制备氧化铌薄膜,测试其可见光透过率曲线,采用包络线法计算折射率及吸收系数[9,10],通过光学软件模拟得到实际薄膜膜厚,计算沉积速率。找出沉积速率较快而又能保障没有吸收的控制点进行重复,考察其稳定性,具体工艺参数见表1.

表1 采用PEM反馈控制中频反应溅射制备氧化铌薄膜的工艺参数
2)氧化硅薄膜的制备
制备氧化硅薄膜之前,采用靶电压反馈控制系统获取硅靶的滞回曲线。然后在滞回曲线上选择不同的控制点,制备氧化硅薄膜,测试其可见光透过率曲线,采用麦克劳德光学薄膜设计软件计算折射率及吸收系数,通过软件模拟得到实际薄膜膜厚,计算沉积速率。找出沉积速率较快而又能保障没有吸收的控制点进行重复,考察其稳定性,具体工艺参数见表2.

表2 采用电压反馈控制中频反应溅射制备氧化硅薄膜的工艺参数
3)减反射薄膜的制备
采用麦克劳德光学薄膜设计软件设计一款ARC膜系,采用上述确定的氧化铌、氧化硅反馈控制点制备ARC薄膜,测试其可见光反射率、透过率曲线。具体的氧化硅、氧化铌ARC膜系及工艺参数如表3所示。
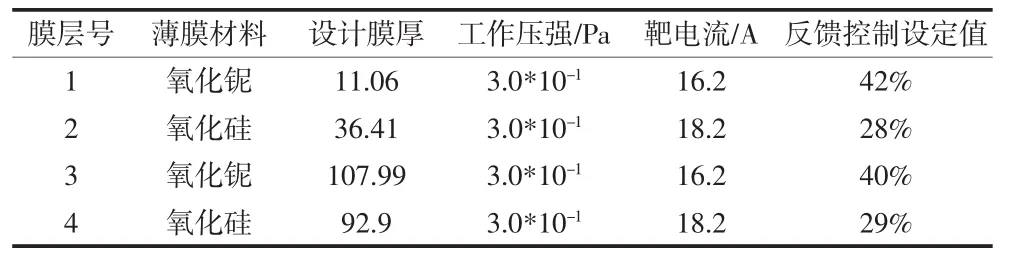
表3 氧化硅、氧化铌ARC膜系及工艺参数
2 结果与讨论
2.1 PEM控制制备氧化铌薄膜
反应磁控溅射制备氧化铌薄膜的氧辉光滞回曲线。当氧气流量从0增加至60 sccm时,氧辉光Eo777强度缓慢增大;随着氧气流量进一步增大到120 sccm,氧辉光Eo777强度迅速增大;进一步增大氧气流量,氧辉光Eo777强度增速变缓。减少氧气流量,氧辉光Eo777强度也随着减少,但开始的时候减少比较缓慢,直到氧气流量减少到60 sccm左右,氧辉光Eo777强度才开始迅速降低。这主要是因为随着氧气流量增加,靶材表面氧化程度逐渐加剧,即使减少氧气,也需要再溅射一段时间才能回到金属的状态。单腔体真空设备需要反复充、放气,靶材初始状态为氧化态,逐渐减少氧气含量,60 sccm氧气流量附近是辉光变化的一个拐点,因此本文着重研究了拐点上方以及拐点下方不同控制点对氧化铌薄膜光学性能及沉积速率的影响。
如表1所示,本文选择了拐点附近三个不同的控制点,35%、37%、42%,同时也制备了纯金属铌薄膜和过氧态氧化铌薄膜作为对比,其PEM辉光控制点分别为12%和85%。当Eo777在12%左右,此时为金属态沉积,其动态沉积速率为15.8 nm/min;若将Eo777设定在85%左右,此时为过氧态,其动态沉积速率仅为1.3 nm/min.随着Eo777设定值的增大,靶材从金属态向过渡态、过氧态转化,动态沉积速率呈下降趋势,且呈现两个不同的下降速率。当Eo777设定值为35%,动态沉积速率为3.3nm/min,当Eo777设定值为37%,动态沉积速率为3.1 nm/min,当Eo777设定值为42%,动态沉积速率为2.63 nm/min,约为过氧态沉积速率的2倍。
显示了在不同Eo777设定值下制备的600 nm左右氧化铌薄膜的可见光透过率曲线。由图可知,与K9玻璃基底对比,所有曲线在短波段均有一定吸收。Eo777设定值为40%时制备的氧化铌薄膜可见光透过率与过氧态制备的相同厚度的氧化铌透过率相当,略高一点;而Eo777设定值为37%时制备的氧化铌薄膜可见光透过率较过氧态制备的相同厚度的氧化铌透过率小一些,特别是在短波波段,415 nm处,透过率降低2%左右。采用包络线算法得出37%Eo777氧化铌的吸收系数较40%Eo777大。因此建议采用40%的设定值作为氧化铌薄膜反馈控制的设定点。另外,值得一提的是,一个光学波长厚度的氧化铌吸收会较600 nm氧化铌小一些。
将Eo777设定为40%重复做了5炉验证,测试其沉积速率,并与过氧态氧化铌薄膜的动态沉积速率进行了对比,结果表40%(Eo777)设定值的沉积速率较过氧态高1倍,且重复性较好。
2.2 电压反馈控制制备氧化硅薄膜
与氧化铌的氧辉光滞回曲线不同,它的金属态范围较宽,且靶电压基本恒定不变,在700 V左右。当氧气流量增大到某一临界值90 sccm,靶电压迅速下降,继续增加氧气至150 sccm,基本进入过氧态,靶电压下降到430 V左右。此时再减少氧气流量,靶电压还会维持430 V左右较长的时间,直至氧气流量降低到某一临界值60 sccm,靶电压开始快速上升,然后回到金属态。电压反馈控制一般选择在滞回曲线减氧过程中临界状态,这样既可以保证氧化硅薄膜氧化充分,又可以尽量提高沉积速率。
不同硅靶电压设定值的动态沉积速率,设定值越高,越接近金属态,沉积速率越高。金属态的沉积速率约为过氧态沉积速率的8倍左右。过渡态沉积速率约为过氧态沉积速率的2-3倍。硅靶电压设定值为28%、29%、30%的动态沉积速率分别为3.0 nm/min、3.33 nm/min、3.66 nm/min.但由图1不同硅靶电压设定值29%、30%制备500 nm左右氧化硅薄膜的可见光透过率曲线可知,靶电压29%设定值与过氧态制备的氧化硅薄膜透过率在各波段基本相当,与K9玻璃基底对比基本无吸收。但30%设定点制备的氧化硅薄膜透过率在各波段均下降,表明薄膜有一定的吸收。因此采用靶电压反馈控制制备氧化硅薄膜的设定值控制在29%.

图1 不同靶电压设定值制备500 nm的氧化硅薄膜可见光透过率曲线
2.3 反馈控制制备氧化铌、氧化硅AR膜
图5显示了设计的AR膜系的实测可见光透过率曲线,第一炉AR1的400~700 nm波段平均透过率为95.05%,第二炉AR2的400~700 nm波段平均透过率为95.11%.与设计曲线平均透过率95.12相当,说明2炉的重复性很好,且膜厚及折射率可控。图3是相应AR膜系的可见光反射率曲线。综合图2与图3可知,AR膜的吸收非常小,重复性、稳定性满足要求。4层膜系中第一层氧化铌采用42%的设定值,第三层氧化铌则采用了40%的设定值;同理第二层氧化硅采用了28%的设定值,第四层氧化硅则采用了29%的设定值。这主要是因为磁控溅射设备是单腔体设备,每次开腔门均会暴露大气,靶材每次的状态都可能不一样,为了降低风险,所以在溅射开始的时候均会稍多充一点氧气。从镀膜速率上看,传统的过氧态成膜,一炉AR镀膜时间约为2.3 h,使用反馈控制后,一炉AR镀膜时间约为1 h,效率提高1倍左右。

图2 5炉靶电压反馈控制与过氧态氧化硅薄膜沉积速率对比

图32 炉PEM反馈控制加靶电压反馈控制制备的ARC可见光反射率曲线
3 结束语
为了提高光学薄膜的沉积速率即提高生产效率,在中频反应溅射系统中增加等离子体辉光发射反馈监控系统以及靶电压反馈监控系统,控制整个成膜状态稳定在过渡态。采用PEM反馈控制中频反应溅射制备氧化铌薄膜,777 nm处氧辉光强度设备值为40%时,沉积速率较传统的过氧态提高1-2倍;采用靶电压反馈控制中频反应溅射制备氧化硅薄膜,靶电压设定值为29%时,其沉积速率是过氧态的2~3倍.可见光透过率曲线显示没有明显增加吸收。按照此设定值制备4层AR膜,单炉镀膜时间由原来的2.3 h(过氧态镀膜)缩减到1 h,产能提高1倍以上。除了上述过渡态成膜可以有效提高沉积速率之外,增加靶功率也能有效提高沉积速率,大功率过渡态成膜的稳定性目前三海科技也在研究当中。

