一种AlGaN/GaN HEMT非线性器件模型参数提取的方法
常永明 毛 维 杜 林 郝 跃
一种AlGaN/GaN HEMT非线性器件模型参数提取的方法
常永明*毛 维 杜 林 郝 跃
(西安电子科技大学宽禁带半导体重点实验室 西安 710071)
该文提出一种新的绝对误差函数,应用该函数进行非线性模型参数提取可以避免计算误差,显著降低参数提取的不准确性。由于氮化物半导体器件,尤其是AlGaN/GaN HEMT器件已经开始得到广泛应用,其模型和参数对射频和电力电子器件和电路设计至关重要,分别使用3种误差函数对 AlGaN/GaN HEMT器件模型进行了参数提取并对比,对比结果表明该文提出的误差函数更加精确和有效。同时为今后的电子器件的模型参数提取提供了一种有效且精确的方法。
AlGaN/GaN HEMT;绝对误差函数;参数提取;遗传算法
1 引言

2 新绝对误差函数构造
通常的器件模型参数提取的目标函数是最小二乘法构架,即用模型计算值和实验数值直接进行相减后平方相加,由于AlGaN/GaN HEMT器件的电流的变化幅度较大,误差数值变化也较大,从而造成误差的失真。针对最小二乘法构架误差函数的缺点,本文提出一种新的绝对误差函数,首先每一个数值除以自己的数量级,使得其数值大于等于1且小于10,然后相减取绝对值,这样既消除了大数和小数相加的问题,避免计算误差,新的绝对误差函数如式(1):

3 器件模型与参数提取方法

AlGaN/GaN HEMTs直流特性可用Kelvin Yuk模型表示[18,19],该模型能较准确地描述器件的输出、转移特性、高频大功率的大型号射频特性。但其包含有28个参数的高维非线性模型,具体为
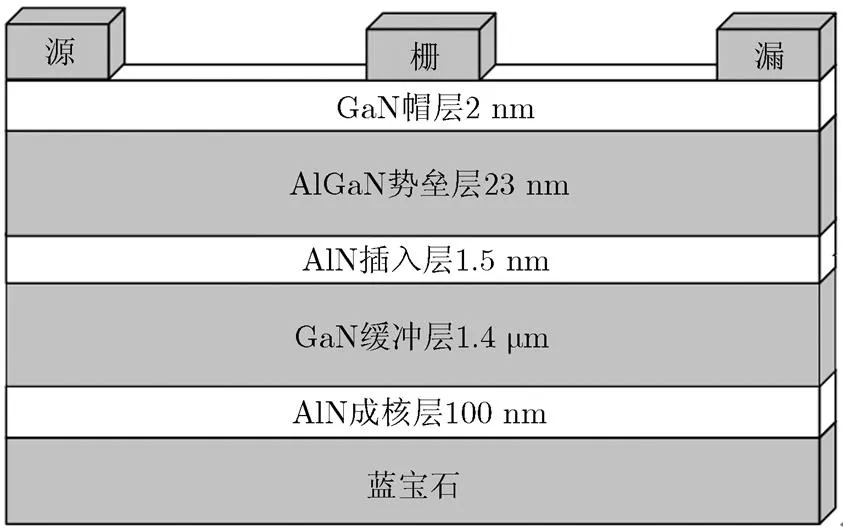
图1 AlGaN/GaN HEMT器件结构

为了测试本文提出的误差函数的精确性和有效性,使用常见的其他两种误差函数作为对比函数进行对照:


采用遗传算法:

(1)适应度函数构建: 本文使用3种误差函数分别进行模型参数进行提取,适应度函数也从基于3种误差函数进行误差函数构建,3种适应度函数分别如式(5)-式(7):



遗传算法的具体步骤:

4 参数提取结果和讨论

表2为3种误差函数的相对平均误差和相对误差的标准方差。
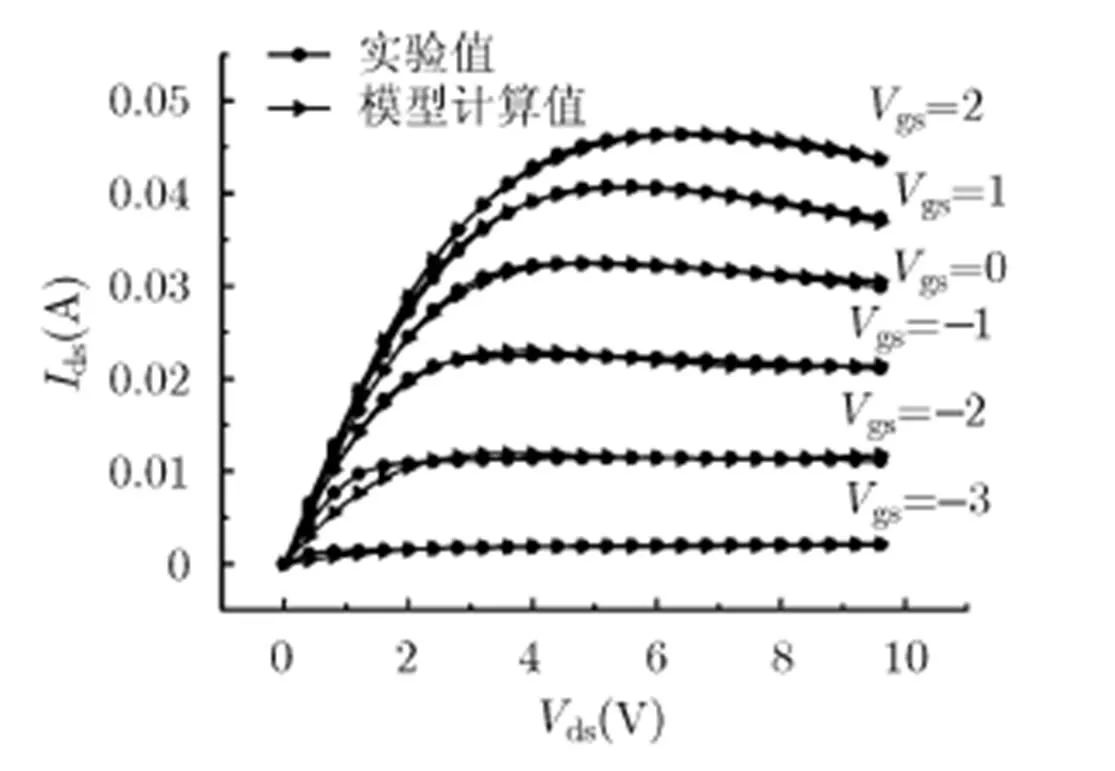
图2 使用最小二乘法误差函数提取的模型参数计算值输出特性曲线与实验测试数据对比
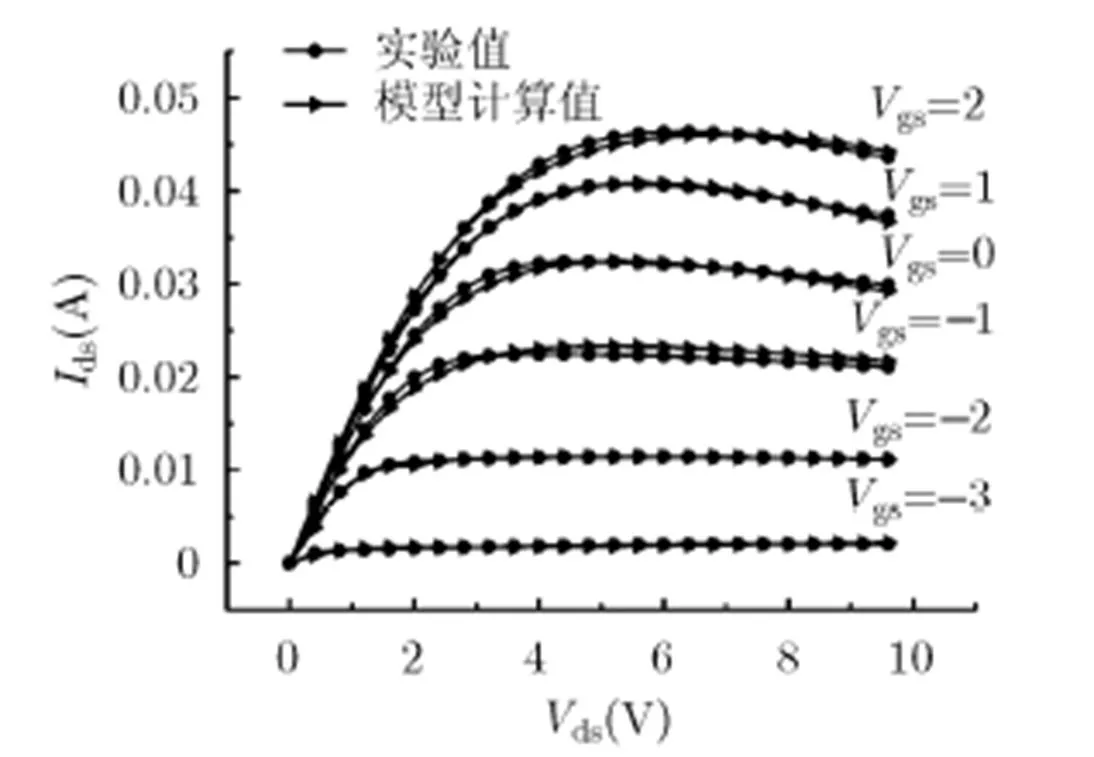
图4 使用相对比例误差函数提取的模型参数计算值输出特性曲线与实验测试数据对比
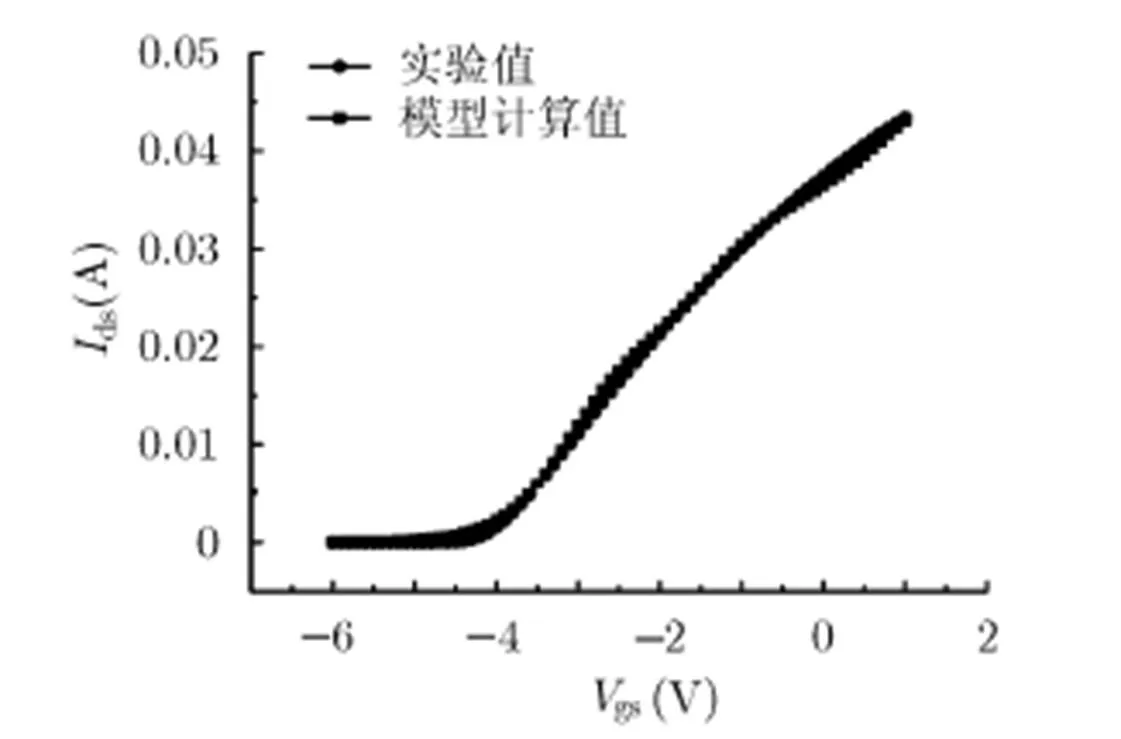
图5 使用相对比例误差函数提取的模型参数计算值转移特性曲线,与实验测试数据对比
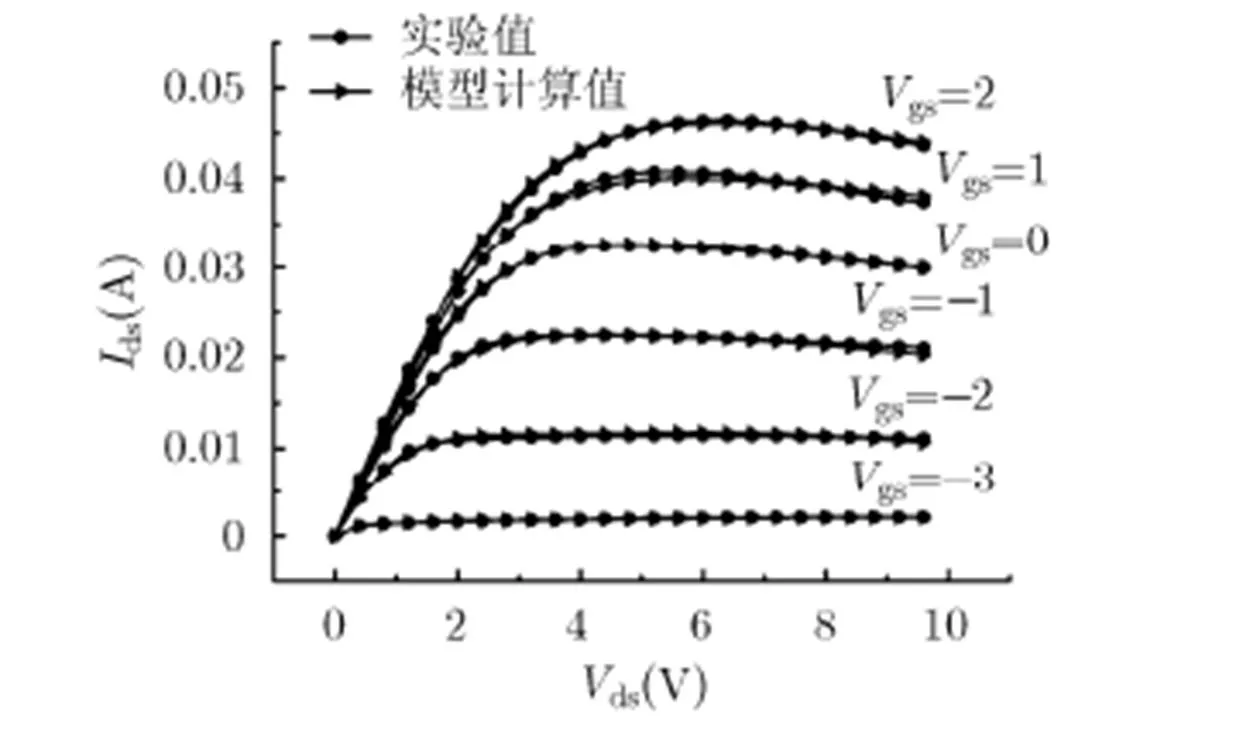
图6 使用本文绝对误差函数提取的模型参数计算值输出特性曲线与实验测试数据对比
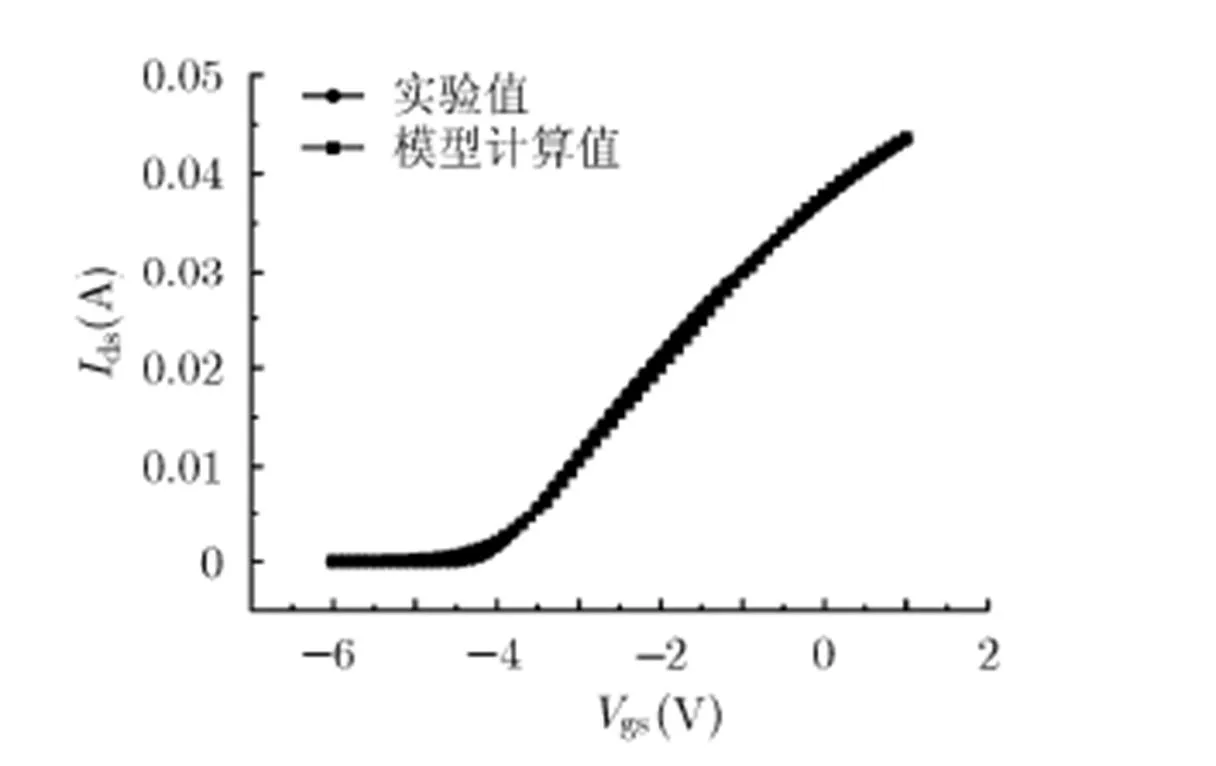
图7 使用本文绝对误差函数提取的模型参数计算值转移特性曲线实验测试数据对比

图8 使用3种误差函数求解的模型计算值,在每个栅压下的输出曲线与实验测试数据平均相对误差对比
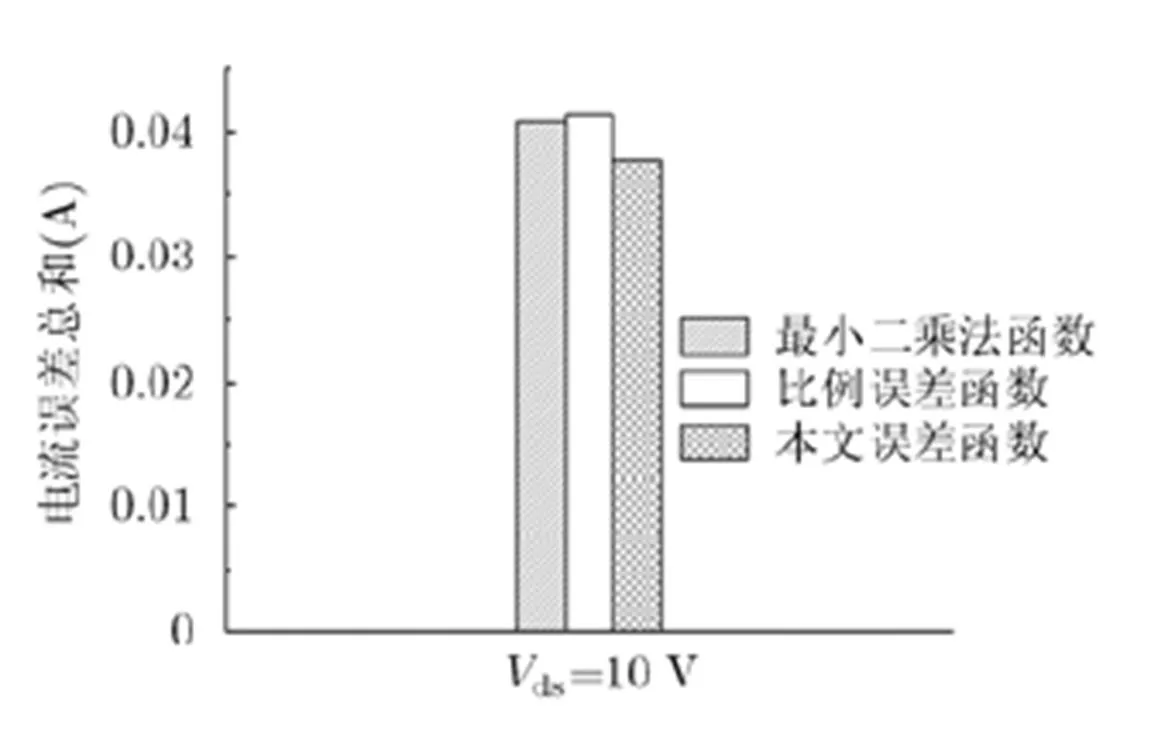
图9 使用3种误差函数求解的模型计算值转移特性曲线与实验测试数据整体绝对误差比
5 结论
本文提出了一种新的绝对误差函数,并应用于AlGaN/GaN HEMT器件非线性直流模型参数提取。分别使用本文提出的新绝对误差函数,最小二乘法误差函数和比例误差函数3种误差函数对Kelvin Yuk模型进行参数提取,通过和实验数据进行对比,结果表明使用最小二乘法误差函数提取的模型参数对于小电流不精确,应用比例相对误差函数提取的模型参数,对于较大电流不精确,应用本文提出的绝对误差函数提取的模型参数对于大电流和小电流都较为精确,每个栅压下的整体误差分布较为均匀,可以避免以上两种误差函数的缺点,使得模型计算值与实验测量值拟合得很好,从而使得模型更加准确地描述器件特性。同时表明本文提出的新绝对误差函数应用于AlGaN/GaN HEMTs器件直流模型参数提取的有效性和精确性。该误差函数和提取方法具有很好的移植性,其可应用于其他器件的各种模型的参数提取,从而提供了一种精确而有效的器件模型参数提取方法同时为器件应用于电路设计和制造提供有效的方法。
表1使用3种尺度函数提取的模型参数值

参数本文最小二乘法比例误差参数本文最小二乘法比例误差 -0.3855 0.2929 0.1039 0.0465 0.2429-3.1484 0.0060-0.0024 0.0027-1.1124 0.5160-0.8101 -0.1488 0.0422 0.4103-1.0028-0.0052 0.0320 -0.1296-0.1022-0.1137 0.0499 0.0013-0.0040 1.7082 4.9992 4.9133-0.0000-0.0052-0.0000 -0.2031-0.9514 0.1819-0.4195-0.0013 0.0282 -0.0004 0.0002 0.0001-0.1810 0.0000 0.0825 -0.0514 0.0822 0.0431 0.9618 0.1700-0.3335 -0.1851 0.8642-0.2972-0.0197 0.0470 1.7354 0.0032-0.9701-1.5501 1.7424-0.0510 1.3896 0.2598-0.0767 0.1797 0.5086 1.3309 4.2685 0.0004 0.0001-2.7535-3.2817-3.0749 4.0092 0.0645 0.0994-0.0200-0.0472 0.0342 0.0241 -0.0134 0.2066 0.0728-0.3139 0.4315 0.3451

模型相对平均误差 相对误差的标准方差 最小二乘法误差函数6.85 4.08 相对比例误差函数本文绝对误差函数6.26 4.135.25 3.77
[1] XU Ke, WANG Jianfeng, and REN Guoqiang. Progress in bulk GaN growth[J]., 2015, 24(6): 1-16. doi: 10.1088/1674-1056/24/6/066105.
[2] ZHANG Zhili, YU Guotao, ZHANG Xiaodong,. 16.8 A/600 V AlGaN/GaN MIS-HEMTs employing LPCVD- Si3N4as gate insulator[J]., 2015, 51(15): 1201-1203. doi: 10.1049/el.2015.1018.
[3] DU Jiangfeng, CHEN Nanting, PAN Peilin,. High breakdown voltage AlGaN/GaN HEMT with high-K/low-K compoundpassiv-ation[J]., 2015, 51(1): 104-106. doi: 10.1049/el.2014.3252.
[4] HIROSHI O, KANEDA N, FUMIMASA H,. Vertical GaN p-n junction diodes with high breakdown voltages over 4 kV[J]., 2015, 36(11): 1180-1182. doi: 10.1109/LED.2015. 2478907.
[5] SUN H, POMEROY J W, SIMON R B,. Temperature-dependent thermal resistance of GaN-on- diamond HEMT wafers[J]., 2016, 37(5): 621-624. doi: 10.1109/LED.2016.2537835.
[6] TANG Y, SHINOHARA K, REGAN D,. Ultrahigh- speed GaN high-electron-mobility transistors with f/maxof 454/444 GHz[J]., 2015, 36(6): 549-551. doi: 10.1109/LED.2015.2421311.
[7] GREENLEE J D, SPECHT P, ANDERSON T J,. Degradation mechanisms of 2 MeV proton irradiated AlGaN/GaN HEMTs[J]., 2015, 107(8): 287-290. doi: 10.1063/1.4929583.
[8] XI, Yuyin, HWANG Y H, HSIEH Y L,. Effect of proton irradiation on DC performance and reliability of circular- shaped AlGaN/GaN high electron mobility transistors[J]., 2014, 61(4): 179-185. doi: 10.1149/06104. 0179ecst.
[9] FITCH R C, WALKER D E, GREEN A J,. Implementation of high power density X-band AlGaN/GaN High Electron Mobility Transistors (HEMTs) in a millimeter- wave monolithic microwave integrated circuit (MMIC) process[J]., 2015, 36(10): 1004-1007. doi: 10.1109/LED.2015.2474265.
[10] SABAT S L, COELHO L D S, and ABRAHAM A. MESFET DC model parameter extraction using quantum particle swarm optimization[J]., 2009, 49(6): 660-666. doi: 10.1016/j.microrel.2009.03.005.
[11] HALCHIN D, MILLER M, GOLIO M,. HEMT models for large signal circuit simulation[C]. IEEE MTT-S International Microwave Symposium Digest, 1994, 2: 985-988. doi: 10.1109/MWSYM.1994.335191.
[12] WANG K and YE M. Parameter determination of Schottky- barrier diode model using differential evolution[J].-, 2009, 53(2): 234-240. doi: 10.1016/j.sse. 2008.11.010.
[13] HAOUARI MERBAH M, BELHAMEL M, TOBIAS I,. Extraction and analysis of solar cell parameters from the illuminated current–voltage curve[J].&, 2005, 87(1-4): 225-233. doi: 10.1016/j.solmat. 2004.07.019.
[14] KATABOGA N, KOCKANAT S, and DOGAN H. The parameter extraction of the thermally annealed Schottky barrier diode using the modified artificial bee colony[J]., 2013, 38(3): 279-288. doi: 10.1007/ s10489-012-0372-x.
[15] MEMON Q D, AHMED M M, MEMON N M,. An efficient mechanism to simulate DC characteristics of GaAs MESFETs using swarm optimization[C]. IEEE International Conference on Emerging Technologies, Ankara, Turkey, 2013: 1-5. doi: 10.1109/ICET. 2013.6743542.
[16] THAKKER R A, PATIL M B, and ANIL K G. Parameter extraction for PSP MOSFET model using hierarchical particle swarm optimization[J]., 2009, 22(2): 317-328. doi: 10.1016/j. engappai.2008.07.001.
[17] 毛维, 杨翠, 郝跃, 等. 场板抑制GaN高电子迁移率晶体管电流崩塌的机理研究[J]. 物理学报, 2011, 60(1): 586-591.
MAO Wei, YANG Cui, and HAO Yue. Study on the suppression mechanism of current collapse with field-plates in GaN high-electron mobility transistors[J]., 2011, 60(1): 586-591.
[18] YUK K S, BRANNER G R, and MCQUATE D J. A wideband multiharmonic empirical large-signal model for high-power GaN HEMTs with self-heating and charge- trapping effects[J].&, 2009, 57(12): 3322-3332. doi: 10.1109/TMTT. 2009.2033299.
[19] YUK K, BRANNER G R, and MCQUATE D. An improved empirical large-signal model for high-power GaN HEMTs includin g self-heating and charge-trapping effects[C]. IEEE International Microwave Symposium Digest, Boston, America, 2009: 753-756. doi: 10.1109/MWSYM.2009. 5165806.
常永明: 男,1983年生,博士生,研究方向为GaN器件建模、仿真与遗传算法.
毛 维: 男,1981年生,副教授,硕士生导师,主要研究方向为宽禁带半导体微波功率器件与半导体器件的理论建模.
杜 林: 男,1979年生,博士生,研究方向为微波器件及电路设计.
郝 跃: 男,1958年生,教授,博士生导师,主要研究方向为宽禁带半导体材料与器件、微纳米半导体新器件及其可靠性.
A Method for AlGaN/GaN HEMT Nonlinear DeviceModel Parameter Extraction
CHANG Yongming MAO Wei DU Lin HAO Yue
(-,,,710071,)
A new absolute error function is presented in this paper. The function is applied to extract parameters of the nonlinear model, which can avoid the calculation error and reduce the inaccurate parameter extraction significantly. Nitride semiconductor devices are widely used, especially the AlGaN/GaN HEMT devices. The AlGaN/GaN HEMT model and parameters is very important to radio frequency, power electronic devices and circuit design. The new absolute error function is applied to extract the parameters of AlGaN/GaN HEMT nonlinear devices model. Through comparing three kinds of error function, the results show that the proposed error function is more accurate and effective. At the same time, a precise and effective method is provided to extract the parameters of electronic devices in the future.
AlGaN/GaN HEMT; Absolute error function; Parameter extraction; Genetic algorithm
O47
A
1009-5896(2017)12-3039-06
10.11999/JEIT170097
2017-01-24;
2017-09-18;
2017-10-27
通信作者:常永明 yongmingchang@163.com
国家自然科学基金(61574112 ),陕西省自然科学基础研究计划(605119425012)
: The National Natural Science Foundation of China (61574112), The Natural Science Foundation Research Project of Shaanxi Provience (605119425012)

