元器件二次筛选过程中的质量控制
王小萍(中国电子科技集团公司第55研究所,南京210016)
元器件二次筛选过程中的质量控制
王小萍
(中国电子科技集团公司第55研究所,南京210016)
元器件二次筛选的目的是在于通过对产品实施非破坏性筛选试验,剔除具有潜在缺陷的早期失效产品,为整机的可靠性提供重要保证.为了获得良好的筛选效果,需要选择有效的筛选项目和方法.电容器和分立器件由于结构材料特殊,应用广泛,也容易在二筛过程中造成误判或由于操作不当引入新的失效或隐患,二次筛选过程中的质量控制尤为重要.选择电容器和分立器件,从筛选中最为重要的测试和电老炼两个方面着手,结合静电防护,对二筛过程的质量控制进行阐述.
二次筛选;静电防护;测试;电老化
1 引言
电子元器件的质量是整个产品质量的基础,一个小小的元器件失效可能会导致整机失效,造成重大损失,所以军工产品所用的元器件均要求进行100%二次筛选.元器件二次筛选的目的是通过对产品实施非破坏性筛选试验,剔除具有潜在缺陷的早期失效产品,以提高批产品的可靠性,同时加强对进口元器件的管理和质量控制.
2 元器件筛选项目
国内许多军工单位为了提高整机产品的质量可靠性,依据GJB7243-2011《军用电子元器件筛选技术要求》等标准,各自制定了相应元器件的二次筛选规范,但这些规范中的筛选项目和筛选要求总体一致.
元件的二次筛选项目一般为外观检查→常温初测→温度循环→高温电老炼→常温终测→外观复查;以电容为例,筛选过程中常见的失效模式有击穿、开路、电参数超差(电容量超差、损耗角正切增大、绝缘电阻下降或漏电流上升、介质耐压下降等).
器件的二次筛选项目一般为外观检查→常温初测→高温贮存→温度循环→恒定加速度(空腔器件)→PIND(空腔器件)→高温反偏→常温中测→电老炼→密封性检查→常温终测→外观复查.以分立器件为例,筛选过程中常见的失效模式为反向漏电流增大、击穿电压下降、工作性能退化、空腔内有活动多余物、漏气等.
塑封器件由于其结构的特殊性,依据NASA标准PEM-INST-001《塑封微电路选择、筛选和鉴定指南》,筛选项目一般为外观检查→温度循环→声扫→X射线检查→测试→外观检查,试验结束后再抽样进行DPA试验.由于要去除声扫中的水汽,试验结束后应进行125℃、16~24 h的高温烘培.塑封器件常见的失效模式为内部分层、开裂.
3 筛选过程中的质量控制
元器件二次筛选的具体要求主要按照GJB360、GJB128、GJB548及各自的总规范.在元器件的二次筛选中,由于经验不足会造成误判,或由于操作不当会引入其他缺陷或隐患,因此元器件二次筛选过程中的质量控制尤为重要.元器件品种繁多,不可能一一列举,而电容器和分立器件由于结构材料比较特殊,容易在二筛过程中误判或引入新的失效,而且微波管由于频率高,测试和老化有一定的难度.下面就选取电容器和分立器件,从筛选中最为重要的测试和电老炼两个方面着手,阐述二筛过程中的质量控制.
3.1元器件的测试
夹取元器件时应轻拿轻放,插入或拔出测试夹具时不易用力过猛,否则容易造成管腿弯曲变形;不得用手直接接触元器件,以免手上的汗渍腐蚀管腿;根据元器件不同的防静电级别,做好相应的防静电措施.
3.1.1固体钽电容测试
固体钽电容为有极性电容器,所以不能施加反向电压.由于钽电容的容值和损耗角正切需要在1 V的交流下测试,为了平衡负压,测试时一定要加上2 V左右的直流偏置.国产钽电容每个产品说明书中都有明确的直流偏置的规定,但进口钽电容(如KEMET公司)只在产品手册总的概述里提过,所有具体型号的手册里都没有表明直流偏置电压,如果工作经验不足,会给测试的钽电容留下安全隐患.
在测试过程中,如不慎使钽电容承受了不应有的反向电压,即使其各项参数仍然合格,也应将该钽电容报废,因为其寿命会大大缩短.
固体钽电容的电参数恶化主要表现为漏电流偏大,这是决定电容器寿命的固有因数,因此虽然所有的产品手册中都规定了漏电流的测试时间为5 min,但实际测试时间为10 s以内(特殊大电容除外),生产厂家一般控制在5 s.
固体钽电容在测试后应充分放电,防止钽电容之间互相放电失效.
3.1.2瓷介电容器测试
当C≥1 μF时采用并联测试法,当C<1 μF时采用串联测试法.
测试电压和频率对大容量二类瓷介电容器的电容值测试值影响较大,有时测试结果偏低是由于待测电容容值大,漏电流偏大,引起测试仪器提供的测试电压小于规定值.国内使用的仪表大多为安捷伦LCR测试仪,请将Automatic Level Control(ALC)的功能设为"on".
二类瓷介电容器的容值和介质损耗会随时间发生衰减,这种现象就是电容器的"老化",测试前需要对已发生"老化"现象的电容器进行"去老化"处理,一般方法为在上极限温度(或高于极限温度,最高温度可达150℃)下放置1 h再在常温下恢复24 h后,再进行测试.片电容为了防止电极氧化,去老化时一定要将电容抽真空或放置在充氮气的环境中加以保护.
空气中湿度过高时,水膜会凝聚在电容器表面,还可能渗透到电容器介质内部,使得电容器的绝缘电阻和介电强度下降,导致测试结果不合格.所以测试环境应满足温度在(25±3)℃之间,湿度在40~60%RH之间.
3.1.3分立器件测试
静电放电对半导体器件造成的损伤具有隐蔽性和发展性,这一点使得防静电措施更有必要,总的防范原则一是避免静电,设法消除一切可能出现的静电源;二是消除静电,即设法加速静电荷的逸散泄露,防止静电荷的积累.静电防护区的湿度低于30%时一定要进行人工加湿,用加湿器进行加湿时最好用纯水或蒸馏水,以免自来水中含有的氯使器件引线或金属管壳被腐蚀.
在仪器处于待测状态下再将器件放入测试夹具内,关闭电源前一定要将器件从夹具盒内取出.
半导体器件在电源开关瞬间、交流电源电压不稳或测试仪器接地不良等情况下,会受到一种随机的短时间高电压或强电流冲击,引起器件芯片发生过电应力损伤.器件的过电应力失效和静电放电失效二者有时在失效现象上无法区分,可以对正常样品进行过电应力和静电放电损伤的模拟试验.比较两者的显微图像,图1和图2是日本富士通生产的FHX76场效应管失效样品的显微图像和声扫图像.
在测试产品的极限参数时,测试应力应缓慢逐渐增加,而且不宜超过手册规定的最大值.如在测试FHX76场效应管的UGSO(栅源击穿电压)时,手册中规定测试条件是IGS=-10 μA,合格判据为UGSO≥-3 V.测试时只要将栅源电压加至-3V,判断IGS是否小于-10μA就可以了,不要测出IGS=-10 μA时的栅源电压,以免不小心击穿管子.对于高频分立器件,为了解测试时有无自激振荡,通常使用半导体器件参数分析仪进行动态测试,判断的依据是显示屏上的特性曲线是否平滑,所以不能使用自动测试系统.

图1 栅坝完全烧毁(过电应力)

图2 栅坝上的击穿点(静电放电)
测试三极管的放大倍数β和场效应管的跨导gm时,如果测试功率过大,测试夹具不能足够散热,产生的热效应就会影响测试结果或者损坏器件,这时就需要尽量缩短测试时间或采用脉冲测试法.
在所有测试过程中都必须确保无自激振荡出现.对于微波器件,消除自激目前一般采用馈电网络或在敏感部位贴吸收材料;图3是CaAs场效应管的直流测试和直流老炼推荐使用电路,必要时可在微波输入和输出两端加微波负载电阻进行匹配.

图3 CaAs场效应管的测试和老炼推荐使用电路
利用高温烘箱进行高温测试时,烘箱的外壳和金属内壁应接地良好,防止空间静电场损伤器件;低温测试时,一定要注意测试过程中器件表面不要有凝霜或水汽现象出现,以免损坏器件.
3.2元器件的电老化
功率老化是在一定的温度下通过对产品施加一定的电应力,促使早期失效器件存在的潜在缺陷尽快暴露而被剔除,是一种很有效的筛选方法.
3.2.1钽电容电化筛选
瓷介电容器通常采用极限温度下额定电压或2倍额定电压老化,但钽电容只能采用85℃下额定电压老化.
钽电容的电老化方法通常采用有阻老化和无阻老化两种方法.有阻老化是在每个电容器的正极串一只1 kΩ的电阻,优点是当电容器漏电流增加时会自动降低电容器上的电压,不会烧毁电容,缺点是容易使有缺陷的电容产生自愈恢复,自愈恢复的钽电容寿命会大大缩短,可靠性存在很大的隐患,而且这种电容无法通过测试等手段检测出来;无阻老化时在老化电路中不加保护电阻,优点是能将所有有缺陷的电容剔除,缺点是漏电流持续增加会突然引起有缺陷的电容燃烧,燃烧释放的烟雾又会污染相邻的电容器,造成更多的外观不合格品.目前的电容器自动老炼台有效解决了这个难题,它能在漏电流增加到一定数值时,自动切断此工位的老炼电压,并报警记录.但由于钽电容在高温高压下会突然发生漏电流急剧恶化,过程极为短暂,有时自动老炼台在切断电源前电容器已发生炸毁现象.因此对于小尺寸大容量的钽电容,如果测试时漏电流下降缓慢,电老化时应先取部分钽电容进行评价,且装夹时每个钽电容的安装距离应足够大,以免钽电容高温下突然击穿烧毁而烧坏老化夹具,又污染了邻近的电容.
3.2.2分立器件老化筛选
晶体管是电流控制器,用很小的基极电流IB(通常为微安级)来控制比较大的集电极电流.老化电路通常采用分压器偏压电路,基本示意图如图4所示.但由于每只管子的β不一样,很难得到统一的IC,二筛人员需要将β一样的管子放在一起老炼,还需要调整R1和R2的大小,才能勉强达到需要的IC,由于二筛的元器件数量较多,这样的筛选方法非常繁琐.我们采用在R2上并联一个几千欧姆电位器的方法可以轻松解决这个问题,如图5所示.通过调节电位器的电阻大小来调节R1和R2的比值,从而达到要求的集电极电流.
场效应管是电压控制器,通过改变栅源之间的电压UGS来控制漏极电流,老化通常使用自偏压老炼电路,是利用源极上的串联电阻电压给栅极供电,基本示意图如图6所示.同样的道理,要在栅源之间串联一个电位器,通过改变电位器电阻的大小来改变栅源之间的电压,从而达到所需要的漏极电流,如图7所示.
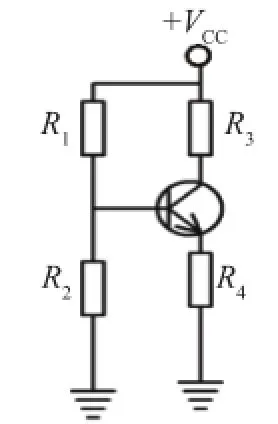
图4 分压器偏压电路基本示意图
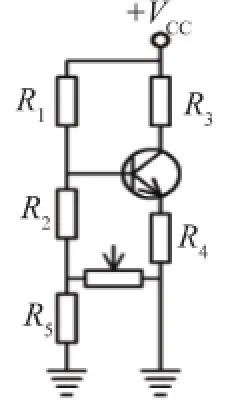
图5 图4改进后电路图
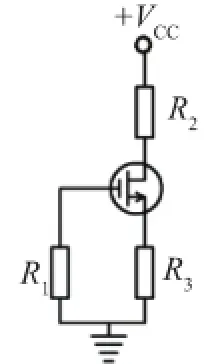
图6 自偏压老炼电路基本示意图

图7 图6改进后电路图
分立器件通常采用常温老化和高温老化两种方式,在筛选的过程中,结温的控制非常关键.芯片的结温表示公式为:

式中TJ表示芯片结温,TA表示环境温度,P表示器件老化功率,RJA表示芯片结到环境的热阻,TC表示壳温,RJC表示芯片结到壳的热阻.
在公式中,TJ、RJA和RJC由手册中可直接查到,P为对老化器件所施加的直流电压与电流的乘积,是二筛人员根据产品手册和实际使用条件,结合环境温度或实际测量的壳温来决定的.决定的依据是让器件在结温下老炼,所加的功率也不得高于器件所能承受的最大功耗.
由于器件的散热面通常紧贴散热块,壳温的测量较为困难,通常将热电偶探头通过老炼夹具上的微型测温孔粘到器件的散热表面来测量.我们以器件的结温为控制目标,以器件的壳温作为反馈量,根据壳温动态调整老炼箱的温度或每个工位的加热电阻器,以达到较为精确地控制结温的目的.
壳温的大小跟烘箱的温度高低、散热片面积大小、热阻、施加的电压和电流大小有关,热电偶探头安装位置不同,测试结果也可能不一致.对于新增的器件要经过反复验证才能批量投入筛选.
4 小结
元器件的质量是整机产品可靠性的保障,所以二次筛选前一定要正确了解各种元器件的工作原理和使用注意事项,选取合适的二筛条件和二筛项目,这样才能防止二筛过程中出现人为失效,从而通过剔除早期不合格品,提高整机的可靠性水平.
[1]孙青,庄奕琪,王锡吉,刘发.电子元器件可靠性工程[M].北京:电子工业出版社,2002.
[2]姚立真.可靠性物理[M].北京:电子工业出版社,2004.
[3]王弘英,王长河,等.微波晶体管测试夹具技术的研究[J].封装、检测与设备,2011,08.014.
[4]Thomas L Floyd(美).电子器件[M].北京:科学出版社, 2007.
Electronic Components Quality Control During Secondary Screening Process
WANG Xiaoping
(China Electronics Technology Group Corporation No.55 Research Institute,Nanjing 210016,China)
The purpose of the secondary screening is to eliminate the early failure products with potential defects through non-destructive screening test and to guarantee the reliability of the whole machine.In order to achieve a good screening effect,effective screening items and methods are very important.Capacitor and discrete components may easily introduce defects or cause failure in the process of secondary screening due to improper operation.The quality control of capacitor and discrete components in secondary screening process is particularly important.The article highlights the two typical tests during the secondary screening to give detailed explanation of the quality control for secondary screening.
secondary screening;electrostatic protection;test;electrical aging

TN306
A
1681-1070(2016)06-0039-04
2016-3-9
王小萍(1975-),女,江苏泰州人,工程师,工作于中国电子科技集团公司第55研究所,多年来一直从事电子元器件二次筛选工作.

