半导体桥芯片静电加固的研究
李 静,张文超,秦志春,叶家海,田桂蓉,徐振相
(南京理工大学化工学院,江苏 南京,210094)
半导体桥芯片静电加固的研究
李静,张文超,秦志春,叶家海,田桂蓉,徐振相
(南京理工大学化工学院,江苏 南京,210094)
针对桥区形状为尖角形的半导体桥在尖角处电流密度过于集中、易发生静电损伤的问题,提出将半导体桥的尖角部分设计为圆弧的形状,达到提高半导体桥抗静电能力的目的。静电实验发现圆弧型半导体桥在10 000pF电容、25kV电压并且串联5 000Ω电阻的静电冲击条件下完好无损。33μF电容、19V电压放电模式下,静电冲击前后圆弧型半导体桥的发火时间基本没变,而尖角型半导体桥的发火时间发生了较长的延迟,证明圆弧型半导体桥在保证发火的前提下抗静电能力得到增强。
半导体桥;静电加固;点火
在火工装置的生产、运输和装配使用等过程中,由于摩擦、撞击、接触分离等极易产生静电积累,静电作用在火工装置上产生热量,造成其意外发火或失效,对火工装置本身及弹药的安全性和可靠性均构成严重威胁[1]。
半导体桥芯片(以下简称半导体桥)是半导体桥火工品的关键元件,是指由半导体膜或者金属-半导体复合膜作为换能元件的小型点火器件,其结构和性能直接决定了半导体桥火工品的性能[2-5]。
郭晓蓉[6]等人通过对尖角型半导体桥进行静电冲击实验和点火实验,得到了在模拟人体静电放电条件(500pF电容、25kV电压并且串联5 000Ω电阻)下,尖角型半导体桥的发火概率为0,而且桥膜表面不出现任何损伤。进一步增加静电冲击强度,将实验电容改为10 000pF时,静电冲击在其V形尖角处造成了半导体桥桥膜的烧蚀,点火实验发现静电冲击后半导体桥的点火时间延长,点火可靠性降低。由此可见:虽然传统的半导体桥火工品本身具有一定的抗电磁性能,但随着电磁环境恶劣程度的加强以及科学技术的发展,对它的安全性能特别是抗电磁能力提出更高的要求。由于传统的半导体桥的电磁防护措施会在一定程度上增加制造工序和技术难度,不可避免地带来产品可靠性的降低和生产成本的提高,因此有必要对半导体桥的抗电磁能力特别是其抗静电能力进行专门的研究。
本文在总结前人研究成果的基础上,针对尖角型半导体桥在受到静电冲击时容易在其V形尖角处受到损伤的不足,在不增加额外制造工序的情况下,通过改变半导体桥的桥膜形状来改进不足,提高其抗静电的能力。
1 静电作用于半导体桥的分析及半导体桥的设计
对于尖角型半导体桥,在静电对半导体桥桥膜的实际作用过程中,由于V形尖角的存在,通过桥表面各处的电流密度不是均匀分布的。因此有必要研究不同形状的桥膜在静电作用下、不同位置的温度变化情况。根据静电对半导体桥作用的电-热分析,可以将静电放电过程等效为储能电阻(负载)电容放电过程,为了简化分析其作用过程,做如下假设:(1)假设静电作用未使半导体桥爆发,且作用过程中桥膜温度在厚度方向上处处相等;(2)由于静电作用时间极快,因此不考虑桥膜上热量的损失和电路损耗;(3)半导体桥桥膜温度升高的能量全部由静电放电产生的焦耳热提供;(4)桥膜的左右边界初始温度为环境温度,能量在两种材料的交界面处以热的形式进行交换。
基于以上假设,半导体桥桥膜温度升高主要来源于静电放电形成的电流带来的焦耳热,因此只要分析在静电作用下电流密度的分布情况就可以大致得到温度变化的分布状况。电流密度大的地方,显然其温度的升高就会更快,更容易产生损伤甚至发火。由于是电容放电,电流I是随时间t变化的,并且桥膜电流密度J满足热传导类型的偏微分方程:

式(1)中k=1/(μm·σ),σ为半导体桥的电导率,μm为半导体桥的磁导率。而电流密度和电流的关系满足微分方程:

根据式(1)~(2)外加边界条件,就可以得知电流密度在桥区空间上的分布。图1(a)所示为现有的尖角型半导体桥的桥形状,其形状特征为在长方形的上下两个边上分别截去一个三角形,使其在两头呈现出对称的V形尖角。对于尖角型的半导体桥,在尖角处其电流密度最大、温度升高最快,在静电放电时最容易在此产生损伤,而尖角处急剧的曲率变化是导致上述结果的原因。为了尽可能地使桥表面各处电流密度均匀分布,本研究将尖角型半导体桥的V形尖角设计成圆弧形,在避免尖端出现的同时又不影响桥区中间区域电流密度整体上的增加,具体形状如图1(b)所示。

图1 两种半导体桥的桥形状示意图Fig.1 Images of two kinds of semiconductor bridges
2 实验
2.1样品参数
尖角型与圆弧型半导体桥的尺寸统一为80μm× 380μm×2μm的“H”型重掺杂复合半导体桥,电阻约为1Ω。
2.2实验仪器
JGY-50Ⅲ静电感度测试仪,KH-7700三维视屏显微镜,ALG-CNI储能放电起爆仪,LeCroy44Xs示波器,直流稳压电源,储能电容,电阻,REDLAKE HG-100K高速摄像机。
2.3实验过程
为了测试半导体桥的抗静电性能,通常采用在串联电阻情况下,以电容放电实验来模拟静电放电对半导体桥的影响,图2为半导体桥电容充放电静电实验电路图。
具体实验步骤为:分别将相同规格的尖角型与圆弧型半导体桥在10 000pF电容、25kV电压并且串联5 000Ω电阻条件下,利用静电感度仪进行静电测试。
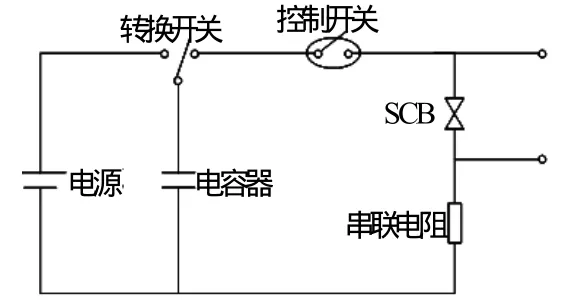
图2 半导体桥静电实验电路原理图Fig.2 Circuit diagram of electrostatic experiment for semiconductor bridge
为了检测静电冲击前后静电对半导体桥的损伤程度,利用储能放电起爆仪在33μF电容、19V充电电压的测试条件下,分别对两种类型的半导体桥进行静电冲击前后的发火性能对比试验,利用示波器记录半导体桥上的电流电压变化过程与发火时间,并利用高速摄影机对圆弧型半导体桥静电冲击前后的发火过程进行采集。
3 结果与讨论
3.1尖角型与圆弧型半导体桥的静电测试
分别将5发相同规格的尖角型与圆弧型半导体桥在10 000pF电容、25kV电压并且串联5 000Ω电阻条件下,利用静电感度仪做静电测试,并在显微镜下观察。发现在此条件下尖角型半导体桥有3发尖角处的材料被汽化,其桥区在静电后呈现对称性的烧蚀现像,如图3(a)所示,而圆弧型半导体桥5发全部完好无损,其桥区静电冲击后的照片如图3(b)所示。

图3 两种半导体桥静电作用后照片Fig.3 Pictures of two kinds of semiconductor bridge after electrostatic experiment
由图3可见在相同条件下的静电冲击后,尖角型半导体桥桥区出现烧蚀现象,而圆弧型半导体桥没有出现此现象。根据静电对半导体桥的电-热分析可知,半导体桥桥膜温度升高主要来源于静电放电形成的电流带来的焦耳热。对于尖角型半导体桥,电流流过半导体桥桥区时在两个尖角处电流密度最大,因此产生的热也最多,当静电冲击达到一定强度时,静电放电产生的热量会使得两个尖角区域最先熔化而受到损伤,呈现对称性的烧蚀现象,文献[6]的实验结果也验证了上述情况的发生。而圆弧型半导体桥克服了尖角型半导体桥在尖角处电流密度过于集中的问题,其桥区的电流密度比较均匀,从而导致静电产生的热量在桥区分布不集中,因此圆弧型半导体桥能够较好地经受静电的冲击。
3.2尖角型与圆弧型半导体桥的发火性能试验
半导体桥在33μF电容、19V电压放电条件下的电流、电压变化的典型曲线如图4所示。
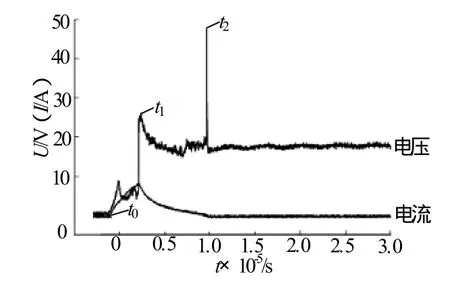
图4 半导体桥电压、电流随时间的变化曲线Fig.4 The time vs voltage and time vs current curves of semiconductor bridge
由文献[4]可知:半导体桥在电流的作用下硅桥因焦耳热迅速熔化、汽化并在电场的作用下形成等离子体。参考文献[4],规定电容开始放电的时刻为t0,半导体桥发火生成等离子体的时刻为t1,电容对半导体桥停止作用的时刻为t2,由于在实际应用中,半导体桥上通常都有药剂,故规定所有的发火时间均取电容开始放电(t0)到电容对半导体桥停止作用为止(t2)之间的时间差,即t2-t0。
取尖角型和圆弧型半导体桥各6发样品,测试其在静电冲击前后在33μF电容、19V电压放电条件下发火所需的时间,其中每种样品中的3发没受静电冲击,而另3发被静电冲击,半导体桥发火所需时间的实验数据如表1所示。

表1 半导体桥发火时间测试结果Tab.1 Test data of firing time of semiconductor bridge
从表1中对应的数据可以看出,在33μF电容、19V电压的试验条件下,圆弧型在静电前后的平均发火时间分别为25.16μs与24.99μs,几乎没有变化,但是尖角型在静电前后的平均发火时间分别为24.86μs与28.18μs,发生了11.78%的延迟,远大于圆弧型的-0.68%的延迟。造成这种情况的原因是静电作用使得尖角型桥区的部分硅材料发生熔化,桥膜受到损伤,因此对输入的电流脉冲的响应变得钝感,导致发火时间延长。由此可得到:圆弧型半导体桥的点火性能相比尖角型受静电作用的影响更小。
3.3圆弧型半导体桥静电前后发火过程比较
对静电作用前后的圆弧型半导体桥分别进行发火试验,并利用高速摄像机记录其发火过程,图5分别为圆弧型半导体桥静电冲击前后发火过程照片。

图5 圆弧型半导体桥静电冲击前后发火过程的高速照片Fig.5 High-speed photos of ignition process of arc-shaped semiconductor bridge before and after electrostatic experiment
从图5中可以发现,静电作用前后圆弧型半导体桥均能够发火,这表明了圆弧型半导体桥在静电作用后发火性能没有改变。仔细观察发现,静电冲击后的高速照片中火花尺寸较静电冲击前的小,这是由于高速摄影采集照片的时间为50μs/帧,而半导体桥的发火持续时间较短,因此不能保证每次高速摄影采集到的图像为半导体桥发火产生最大火花瞬间的图像。今后通过采用间隔时间更短的高速摄像机以解决上述问题。
4 结论
(1)由于尖角型即V型半导体桥的尖角处电流密度最大,升温最快,最容易受到静电损伤,故在受到静电冲击后尖角处出现烧蚀现象,而圆弧型半导体桥由于电流密度比较均匀,未出现此现象,防静电能力强。
(2)通过静电冲击前后发火性能试验,可知尖角型半导体桥在静电后发火时间延长,推迟百分比为11.78%,而圆弧型半导体桥发火时间推迟百分比为-0.68%,受静电影响较小。
(3)利用高速摄像机对圆弧型半导体桥进行静电冲击前后发火过程记录,得知其在静电冲击前后均出现火光,其点火性能没有改变。
[1] 杨洁,马宏萱,王海.电火工品防静电结构的研究[J].火工品,2003(2)∶40-43.
[2]刘西广,徐振相.半导体桥火工品的发展[J].爆破器材,1995,24(4)∶12-17.
[3]张文超,张伟,徐振相,等.半导体桥的研究进展与发展趋势[J].爆破器材,2009,38(2)∶21-24.
[4]张文超,王文,周彬,等.半导体桥生成等离子体温度的测量[J].含能材料,2009,17(3)∶344-348.
[5]张文超,叶家海,秦志春,等.半导体桥电爆过程的能量转换测量与计算[J].含能材料,2008,16(5)∶564-566.
[6]郭晓荣.半导体桥火工品静电危害特性研究[D].南京∶南京理工大学,2012.
Research of Electrostatic Reinforcement for Semiconductor Bridge Chip
LI Jing, ZHANG Wen-chao, QIN Zhi-chun, YE Jia-hai, TIAN Gui-rong, XU Zhen-xiang
(School of Chemical Engineering, NUST, Nanjing, 210094)
An arc-shaped semiconductor bridge has been designed, in order to solve the problem that cusp-shaped one is prone to electrostatic damage due to the concentrated current density at the cusp region. The result of the electrostatic shock experiment showed that the arc-shaped semiconductor bridge was intact after electrostatic shock under the condition of 10 000pF,25kV and 5 000Ω. Meanwhile, the ignition time of the arc-shaped was not changed compared to that of the cusp-shaped, which has obvious delay under the condition of 33μF and 19V, and it proves that the antistatic ability of arc-shaped is enhanced without sacrificing the ignition capability.
Semiconductor bridge;Electrostatic reinforcement;Ignition
TJ450.3
A
1003-1480(2015)01-0014-04
2014-11-07
李静(1989-),女,在读硕士研究生,从事含能材料制备相关技术研究。
基金课题:预研基金资助(9140A05070113BQ02070)。

