蓝宝石衬底CMP中温度控制对速率的影响
牛新环,黄雅欢,王嘉欣,王建超
(河北工业大学 电子信息工程学院,天津市电子材料与器件重点实验室,天津 300130)
0 引言
随蓝宝石衬底材料需求量的日益增加及表面质量要求的日益提高,对蓝宝石CMP机理及技术的研究就尤为重要.近几年来,以提高蓝宝石衬底材料的CMP质量为目的的研究已成为世界科技界研究的热点之一[1-4].
Kim H J[5]和H L等[6]研究了化学机械抛光中摩擦力和热现象对去除速率的作用机理.前者分析了去除速率随温度变化的关系,指出温度主要通过化学作用影响去除速率,材料去除速率在抛光过程中是不断变化的.后者发现了蓝宝石表面在化学反应中会生成反应层,抛光正压力决定摩擦力.
牛新环[7]和刘玉岭等[8]研究了温度对蓝宝石CMP粗糙度和去除速率的影响.结果表明,抛光温度升高时,去除速率相应提高,质量传递和温度是正相关的关系.
本文研究在蓝宝石CMP过程前期温度变化对抛光结果的影响,探索温度上升过程与去除速率和速率均匀性的关系.
1 作用机理
对蓝宝石衬底抛光时,利用抛光液中的化学物质与衬底片发生化学反应,在抛光片表面生成硬度比基体小的水合层,基体材料及其水合物与碱反应生成可溶的AlO2,同时利用机械力作用于抛光片表面,去除反应产物,达到抛光效果.在蓝宝石抛光过程中有如下反应[9].

影响蓝宝石衬底最终抛光质量的因素很多,如抛光温度、压力、相对转速、抛光液的化学成分、pH值、磨料颗粒尺寸、抛光液供给速度等等,由于蓝宝石衬底抛光过程中是以化学作用为主要过程,所以温度变化对抛光效果影响尤为重要.
2 实验
实验采用2英寸的蓝宝石晶片,晶向c[0001].抛光液为河北工业大学微电子研究所研制的碱性蓝宝石抛光液,pH值10.82,粒径63.1 nm,并加入适当表面活性剂和助剂.实验设备为X62815-1型单面抛光机,抛光垫为天津海伦晶片科技有限公司生产的CP-P830PAD,粗糙度检测采用Agilent5600LSAFM,厚度测量采用HEIDENHAIN ND280厚度测试仪.
工艺采用先轻抛、后重抛、再水抛的方法,压力设定轻抛时为0 MPa,时间1.5m in,重抛时为0.1MPa,转速60RPM,流量70~80m L/m in,时间60m in.每个抛光盘上有8个晶片.
抛光过程中温度是影响化学反应速率的主要因素之一,为确定实验后期抛光稳定时的温度范围,根据范特霍夫规则:K+10K/K 2~4,估算出相对于起始温度,抛光过程温度每提高10K,抛光速率提高2到4倍,结合实验经验,选取抛光过程中温度升高至35℃为稳定状态,并设温度升高至35℃的时间长度为控制变量,前期通过短时间内减小抛光液流量提高抛光温度,之后通过吹风冷却使抛光温度维持在35~38℃,设定6组实验,变量取值分别为10m in、15m in、20m in、25m in、30m in、35m in,如表1所示.

表1 抛光温度上升至35℃所需时间Tab.1 Time of polishing temperature up to 35℃
3 结果分析
图1为抛光速率随着设定时间变化的关系.在设定时间为10 m in时,测得抛光速率为5.03 m/h,在设定时间为35min时,抛光速率为1.94 m/h.在考虑温度与反应速率的关系时,最常用的是Arrhenius方程:

式中: 是反应速率; 是一个与反应物分子相互碰撞有关的常数; 是与材料性质相关的常数; 是绝对温度; 是反应的活化能.
可以看出,式(5)中反应速率与温度成指数关系,温度的上升会加快反应速率.在蓝宝石晶片抛光过程中,前期采用小流量快启动的方式,通过减少抛光液流量,增大抛光过程中晶片与抛光垫间的摩擦力,增大摩擦生热,尽早的使温度提升到一个较高水平,可以提高蓝宝石的有效抛光时间,增加抛光速率.同时由于抛光后期减少温度波动,避免了过高温度出现,抛光蜡的稳定性得到提升,减少了晶片松动导致的抛光不均匀和碎片现象.
图2为片内非均匀性随设定时间变化的规律.

图1 升温时间与去除速率的关系Fig.1 Effectof temperature rising timeon remol rate

图2 升温时间与速率均匀性的关系Fig.2 Effectof temperature rising timeon removl rateun-uniform ity
片内非均匀性的计算公式[10]:

式中: 为 去除速率非均匀性; 为各测试点去除速率均方根,为各测试点去除速率的均值,
由图2可知,在设定时间为10m in时,速率非均匀性为8.06%,在设定时间为15m in时,速率非均匀性为4.73%,在设定时间为35 m in时,速率非均匀性为22.01%,可以看出,当温度上升时间过长时,速率非均匀性值较大,随着温度上升时间减小,速率非均匀性减小,当温度上升过快时,速率非均匀性变大.
将式 (5)取对数得

微分式

将式 (8)从1到2积分

活化能 在实验温度范围内可视为常数,从式 (9)中可以看出,在 较小时比在 较大时提升相同的温度,对反应速率变化率影响更大,对抛光过程来说,晶圆抛光速率的快速变化,会导致晶片各处抛光速率不均匀现象加重,热量传递受影响.
在温度上升过程中,由于热量传递不均衡,不同位置处温度不同,温度高的地方抛光速率快,温度低的地方抛光速率慢,温度差存在的时间越久,抛光厚度差越大,抛光速率非均匀性值越大.当温度维持在一较高范围时,温度变化小,各处温度差值小,抛光速率非均匀性值较小.
图3为设定时间为15m in时抛光前后蓝宝石衬底表面粗糙度的原子力显微镜图像,从图中可以看出,抛光后蓝宝石表面无划痕,粗糙度为0.174 nm.
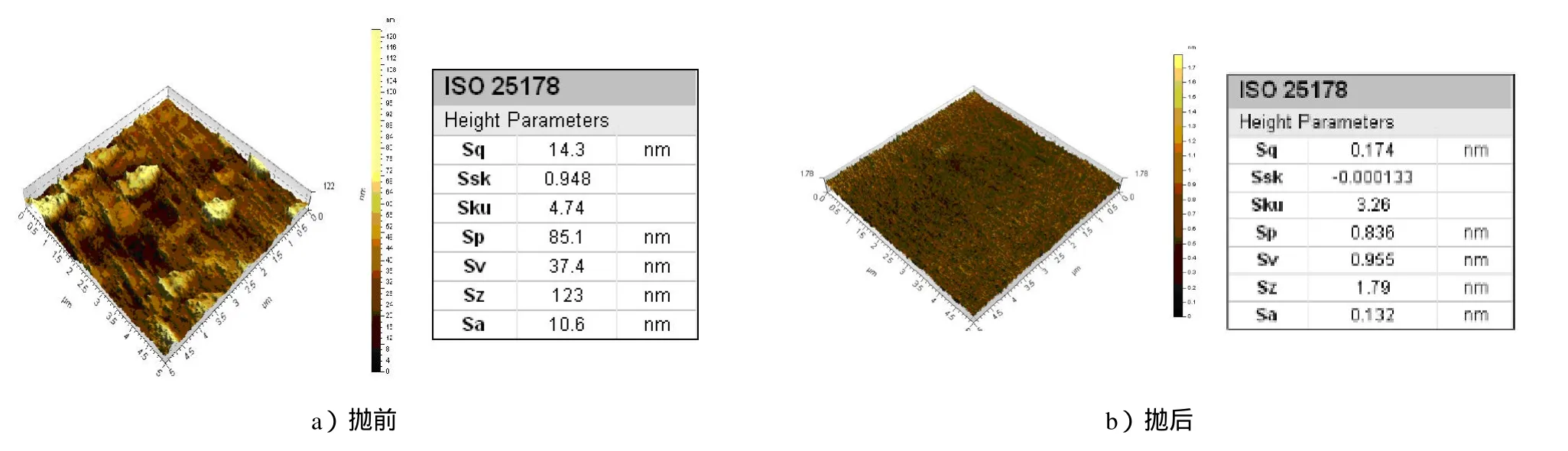
图3 蓝宝石衬底抛光前后粗糙度测试结果Fig.3 Sapphire surface roughnesspre-CMPand post-CMP
4 结论
综上所述,在蓝宝石抛光过程中,抛光前期应该采取小流量快速启动的方式,在短时间内提高抛光温度,减少低温区抛光时间,在温度达到35~38℃左右时,保持温度,可以得到较高的去除速率和较好的去除速率均匀性.在工作压力为0.1MPa,转速60 r/m in,流量70~80m L/m in时,抛光开始15min后使温度提升到35℃,抛光速率为4.07 m/h,片内速率非均匀性为4.73%,粗糙度为0.174nm,满足工业生产要求.
[1]Han Jiecai,LiChangqing.An investigation of longpulsed laserinduced damage in sapphire[J].Opticsamp;LaserTechnology,2009,41:339-344.
[2]Lin Zone-Ching,Wang Ren-Yuan.Abrasive removaldepth for polishing a sapphire waferby a cross-patterned polishing pad w ith differentabrasive particle sizes[J].International Journal of Adbanced Manufacturing Technology,2014,74:1-4.
[3]Grac_aa S,Trabadelo a V,Neels A.Influence of mosaicity on the fracture behavior of sapphire[J].ActaMaterialia,2014,67:67-80.
[4]Thomas Stirne.Ab initio Hartree-Fock simulation of r-plane sapphire[J].Physics Procedia,2012,32:635-639.
[5]Kim H J,Kim H Y,Jeong H D,etal.Friction and the rmalphenomena in chem icalmechanicalpolishing[J].JournalofMaterials Processing Technology,2002,130(2):334-338.
[6]H L,H J.Macroscopicandmicroscopic investigationon chemicalmechanicalpolishing of sapphirewafer[J].JournalofNanoscienceamp;Nanotechnology,2012,12(2):1256-1259.
[7]Niu Xinhuan.High precision finishing process for sapphire substrate surface[J].半导体学报,2007,25:48-51.
[8]刘玉岭,牛新环,檀柏梅,等.固体表面高精密平面化技术研究进展 [J].河北工业大学学报,2009,38(2):1-8.
[9]Niuxinhuan,Huang Yahuan,Zhou Jianwei,etal.Influence of nanoa brasiveon chem ical mechanicalultra-precision machining of sap phiresubstrate surfaces[J].Key Engineering Materials,2014,609-610:130-134.
[10]尹康达,王胜利,刘玉岭,等.铜CMP中温度与质量传递对速率均匀性的影响 [J].半导体技术,2012,10:768-771.

